在 FOWLP 中存在兩個重要概念, 即扇出型封裝和晶圓級封裝。如圖 1 所示, 扇出型封裝(Fan-out)是與扇入型封裝(Fan-in)對立的概念, 傳統扇入型封裝的 I/ O 接口均位于晶粒
2024-04-07 08:41:00 2959
2959 
常規IC封裝需經過將晶圓與IC封裝基板焊接,再將IC基板焊接至普通PCB的復雜過程。與之不同,WLP基于IC晶圓,借助PCB制造技術,在晶圓上構建類似IC封裝基板的結構,塑封后可直接安裝在普通PCB
2025-05-14 11:08:16 2423
2423 
傳蘋果(Apple)決定在下一款iPhone上采用扇出型晶圓級封裝(Fan-out WLP;FOWLP)技術。由于半導體技術日趨先進,無須印刷電路板(PCB)的封裝技術出現,未來恐發生印刷電路板市場逐漸萎縮的現象。
2016-05-06 09:05:33 2138
2138 高密度扇出型封裝技術滿足了移動手機封裝的外形尺寸與性能要求,因此獲得了技術界的廣泛關注。
2020-07-13 15:03:21 1588
1588 
近幾年中,芯片特征尺寸已接近物理極限,而先進封裝技術成為延續摩爾定律的重要途徑。一系列新型封裝技術出現在人們視野之中。而其中扇出型晶圓級封裝(FOWLP)被寄予厚望,它將為下一代緊湊型、高性能的電子設備提供堅實而有力的支持。
2022-07-10 15:06:32 15700
15700 硅通孔(TSV) 是當前技術先進性最高的封裝互連技術之一。基于 TSV 封裝的核心工藝包括 TSV 制造、RDL/微凸點加工、襯底減薄、圓片鍵合與薄圓片拿持等。
2023-05-08 10:35:24 5731
5731 
板級埋人式封裝是一種在基板制造工藝的基礎上融合芯片封裝工藝及 SMT工藝的集成封裝技術,既可以是單芯片封裝、多芯片封裝,也可以是模組封裝、堆疊封裝。與傳統封裝中在基板表面貼裝芯片或元件不同,板級埋人
2023-05-09 10:21:53 2411
2411 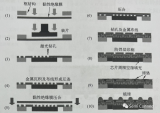
系統級封裝 (System in Package, SiP)是指將單個或多個芯片與各類元件通過系統設計及特定的封裝工藝集成于單一封裝體或模塊,從而實現具完整功能的電路集成,如圖 7-115 所示
2023-05-10 16:54:32 2488
2488 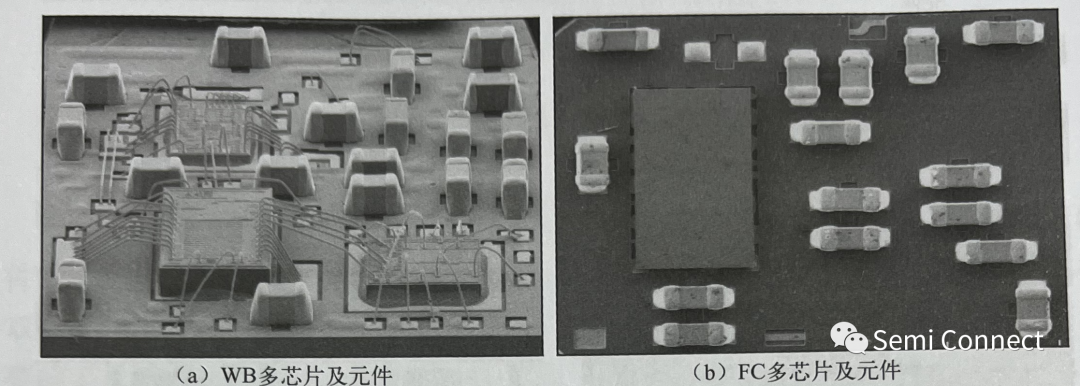
扇出型晶圓級封裝技術采取在芯片尺寸以外的區域做I/O接點的布線設計,提高I/O接點數量。采用RDL工藝讓芯片可以使用的布線區域增加,充分利用到芯片的有效面積,達到降低成本的目的。扇出型封裝技術完成芯片錫球連接后,不需要使用封裝載板便可直接焊接在印刷線路板上,這樣可以縮短信號傳輸距離,提高電學性能。
2023-09-25 09:38:05 3212
3212 
介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP
2023-11-08 09:20:19 11649
11649 
在上篇文章中介紹了扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP)、重新分配層(RDL)封裝、倒片(Flip Chip)封裝,這篇文章著重介紹硅通孔(TSV)封裝工藝。
2023-11-08 10:05:53 7069
7069 
晶圓承載系統是指針對晶圓背面減薄進行進一步加工的系統,該工藝一般在背面研磨前使用。晶圓承載系統工序涉及兩個步驟:首先是載片鍵合,需將被用于硅通孔封裝的晶圓貼附于載片上;其次是載片脫粘,即在如晶圓背面凸點制作等流程完工后,將載片分離。
2023-11-13 14:02:49 6499
6499 
隨著晶圓級封裝技術的不斷提升,眾多芯片設計及封測公司開始思考并嘗試采用晶圓級封裝技術替代傳統封裝。其中HRP(Heat?Re-distribution?Packaging)晶圓級先進封裝工藝技術
2023-11-30 09:23:24 3833
3833 
扇出型封裝一般是指,晶圓級/面板級封裝情境下,封裝面積與die不一樣,且不需要基板的封裝,也就是我們常說的FOWLP/FOPLP。扇出型封裝的核心要素就是芯片上的RDL重布線層(可參考下面圖表說明
2023-11-27 16:02:01 17600
17600 
IGBT模塊的封裝技術難度高,高可靠性設計和封裝工藝控制是其技術難點。IGBT模塊具有使用時間長的特點,汽車級模塊的使用時間可達15年。因此在封裝過程中,模塊對產品的可靠性和質量穩定性要求非常高。高可靠性設計需要考慮材料匹配、高效散熱、低寄生參數、高集成度。
2023-12-29 09:45:05 2958
2958 
在晶圓制作完成后,會出貨給封裝廠,封裝廠再將一粒粒的芯片封裝起來。我這里所說的傳統封裝是指以打線為主的封裝方式,比如DIP,QFP,SOP,QFN等,不包括倒裝。這里就簡單介紹一下傳統封裝的工藝流程及工藝特點。
2024-01-05 09:56:11 3004
3004 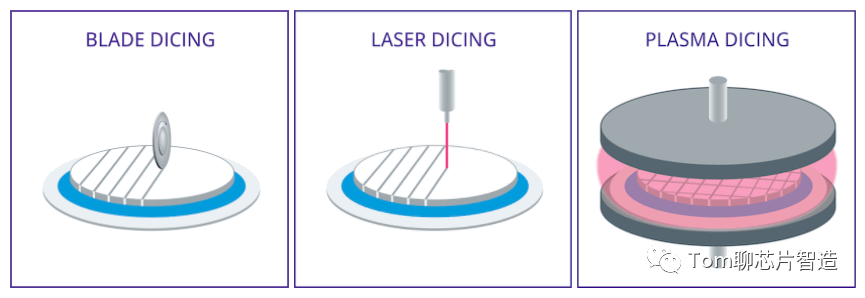
扇出型晶圓級中介層封裝( FOWLP)以及封裝堆疊(Package-on-Package, PoP)設計在移動應用中具有許多優勢,例如低功耗、短信號路徑、小外形尺寸以及多功能的異構集成。此外,它還
2025-01-22 14:57:52 4508
4508 
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、上焊錫、打碼、外觀檢查、成品測試和包裝出庫,涵蓋了前段(FOL)、中段(EOL)、電鍍(plating)、后段(EOL)以及終測(final test)等多個關鍵環節。
2025-05-08 15:15:06 4326
4326 
我們看下一個先進封裝的關鍵概念——晶圓級封裝(Wafer Level Package,WLP)。
2025-05-14 10:32:30 1534
1534 
晶圓級扇出封裝(FO-WLP)通過環氧樹脂模塑料(EMC)擴展芯片有效面積,突破了扇入型封裝的I/O密度限制,但其技術復雜度呈指數級增長。
2025-06-05 16:25:57 2152
2152 
晶圓級扇出型封裝產業化項目。中科智芯半導體封測項目位于徐州經濟技術開發區鳳凰灣電子信息產業園,占地50畝,投資20億元,項目分兩期建設。 2018年9月一期開工建設,投資5億元,建成后將可形成年月能為12萬片12英寸晶圓。主廠房于2018年11月底封
2019-08-02 11:38:29 4829
4829 `各位大神,小弟初學LV,想編一個工藝流程仿真計算的軟件,類似這樣一個東西如圖所示:先設置每一個單體設備的具體參數,然后運行,得出工藝流程仿真計算的結果,計算模型有很多公式,可以直接編程。但要想達到
2015-11-17 17:18:22
芯片封裝工藝流程IMPORTANT NOTICETexas Instruments Incorporated and its subsidiaries (TI) reserve the right
2008-05-26 14:08:14
PCB工藝流程詳解PCB工藝流程詳解
2013-05-22 14:46:02
PCB制造工藝流程是怎樣的?
2021-11-04 06:44:39
天線在分切過程中放卷復卷造成的損傷,這對比較敏感的銀漿印制天線尤其重要,同時生產速度也高很多。等產品從該生產線上下來,RFID標簽的整套工藝就結束了。二、標簽封裝流程1、涉及集成電路封裝技術,比較特殊
2008-05-26 14:21:40
Memory、PLL 鎖相環電路、起振電路與溫補電路。上面六幅圖揭示了整個SITIME晶振生產工藝流程,SITIME MEMS 電子發燒友振采用上下兩個晶圓疊加的方式,外部用 IC 通用的塑料做為封裝。不僅大大減少的石英晶振的工序,而且更全面提升了產品性能。
2017-04-06 14:22:11
各種電子元器件,所以這使得SMT組裝貼片加工顯得尤為重要。
電子產品各式各樣,PCB板種類眾多,SMT貼片加工也需不同的工藝流程,才能應對各種PCB板的組裝,本篇為大家介紹各種PCB板SMT組裝工藝流程
2023-10-20 10:31:48
安裝各種電子元器件,所以這使得SMT組裝貼片加工顯得尤為重要。
電子產品各式各樣,PCB板種類眾多,SMT貼片加工也需不同的工藝流程,才能應對各種PCB板的組裝,本篇為大家介紹各種PCB板SMT組裝工藝流程
2023-10-17 18:10:08
各種電子元器件,所以這使得SMT組裝貼片加工顯得尤為重要。
電子產品各式各樣,PCB板種類眾多,SMT貼片加工也需不同的工藝流程,才能應對各種PCB板的組裝,本篇為大家介紹各種PCB板SMT組裝工藝流程
2023-10-20 10:33:59
電極和焊區。為提高生產效率,一條基片上通常含有多個PBG基板。2、封裝工藝流程圓片減薄→圓片切削→芯片粘結→等離子清洗→引線鍵合→等離子清洗→模塑封裝→裝配焊料球→回流焊→表面打標→分離→最終檢查→測試
2018-09-18 13:23:59
1.一般的混合組裝工藝流程 在半導體后端組裝工廠中,現在有兩種模塊組裝方法。在兩次回流焊工藝中,先在單獨的SMT生產線上組裝SMT 元件,該生產線由絲網印刷機、芯片貼裝機和第一個回流焊爐組成
2018-11-23 16:00:22
沒有塑封體,芯片背面可用散熱片等進行有效的冷卻,使電路的可靠性得到提高; (5)倒裝凸點等制備基本以圓片、芯片為單位,較單根引線為單位的引線鍵合互連來講,生產效率高,降低了批量封裝的成本。 3.倒裝
2020-07-06 17:53:32
關于黑孔化工藝流程和工藝說明,看完你就懂了
2021-04-23 06:42:18
與工藝開發等技術工作;7. 完成領導安排的其他日常工作。封裝工藝/設備工程師崗位要求:1. 3年以上半導體行業封裝設備工作經驗;2. 熟悉大功率半導體器件封裝關鍵工藝流程;3. 大學本科及以上學歷,電氣
2022-02-22 11:15:35
有人又將其稱為圓片級-芯片尺寸封裝(WLP-CSP),以晶圓圓片為加工對象,在晶圓上封裝芯片。晶圓封裝中最關鍵的工藝為晶圓鍵合,即是通過化學或物理的方法將兩片晶圓結合在一起,以達到密封效果。如下
2021-02-23 16:35:18
晶圓級CSP的裝配對貼裝壓力控制、貼裝精度及穩定性、照相機和影像處理技術、吸嘴的選擇、助焊劑應 用單元和供料器,以及板支撐及定位系統的要求類似倒裝晶片對設備的要求。WLCSP貼裝工藝的控制可以參
2018-09-06 16:32:18
先進封裝發展背景晶圓級三維封裝技術發展
2020-12-28 07:15:50
晶圓級芯片封裝技術是對整片晶圓進行封裝測試后再切割得到單個成品芯片的技術,封裝后的芯片尺寸與裸片一致。
2019-09-18 09:02:14
。 隨著越來越多晶圓焊凸專業廠家將焊膏印刷工藝用于WLP封裝,批量壓印技術開始在半導體封裝領域中廣泛普及。然而,大型EMS企業也走進了WLP領域。封裝和板卡之間的邊界,以及封裝與組裝工藝之間的邊界日漸模糊,迫使企業必須具備晶圓級和芯片級工藝技術來為客戶服務`
2011-12-01 14:33:02
`晶圓制造總的工藝流程芯片的制造過程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測工序(Wafer Probe)、構裝工序(Packaging)、測試工序(Initial
2011-12-01 15:43:10
晶體管管芯的工藝流程?光刻的工藝流程?pcb制版工藝流程?薄膜制備工藝流程?求大佬解答
2019-05-26 21:16:27
板上芯片封裝的焊接方法及工藝流程簡述
2012-08-20 21:57:02
樣板貼片的工藝流程是什么
2021-04-26 06:43:58
隨著集成電路設計師將更復雜的功能嵌入更狹小的空間,異構集成包括器件的3D堆疊已成為混合與連接各種功能技術的一種更為實用且經濟的方式。作為異構集成平臺之一,高密度扇出型晶圓級封裝技術正獲得越來越多
2020-07-07 11:04:42
芯片制造全工藝流程詳情
2020-12-28 06:20:25
芯片生產工藝流程是怎樣的?
2021-06-08 06:49:47
請詳細敘述腐蝕工藝工段的工藝流程以及整個前道的工藝技術
2011-04-13 18:34:13
組裝工藝流程有以下6種,每種工藝對設備的要求有所不同,詳細情況見表1。 表1 不同工藝流程對設備的要求不同 表1中特別提到的是單面混裝中,A面THC和B面SMD的生產,板的工藝流程不同,設備
2018-11-27 10:18:33
貼片電阻的生產工藝流程如何
2021-03-11 07:27:02
《集成電路芯片封裝技術》是一本通用的集成電路芯片封裝技術通用教材,全書共分13章,內容包括:集成電路芯片封裝概述、封裝工藝流程、厚膜與薄膜技術、焊接材料、印制電路板、元件與電路板的連接、封膠材料
2012-01-13 13:59:52
芯片封裝工藝流程,整個流程都介紹的很詳細。FOL,EOL。
2008-05-26 15:18:28 389
389 IC封裝工藝流程圖:貼膜,磨片,貼片,裝片,鍵合,電鍍,打印,切筋等流程。
2010-07-18 10:35:26 440
440 晶圓級CSP的裝配工藝流程
目前有兩種典型的工藝流程,一種是考慮與其他元件的SMT配,首先是錫膏印刷,然后貼裝CSP,回流焊接
2009-11-20 15:44:59 1607
1607 BGA的封裝工藝流程基本知識簡介
基板或中間層是BGA封裝中非常重要的部分,除了用于互連布線以外,還可用于阻抗控制及用于電感/電阻/電容的集成。因此要求
2010-03-04 13:44:06 7030
7030 LAMP-LED封裝工藝流程圖
2010-03-29 09:29:52 3828
3828 文章介紹了幾種新的封裝工藝,如新型圓片級封裝工藝OSmium 圓片級封裝工藝,它能夠把裸片面積減少一半;新型SiP封裝工藝Smafti封裝工藝,它改進了傳統SiP封裝工藝,把傳輸速度提高了
2011-12-29 15:34:45 83
83 對基于BCB的圓片級封裝工藝進行了研究,該工藝代表了MEMS加速度計傳感器封裝的發展趨勢,是MEMS加速度計產業化的關鍵。選用3000系列BCB材料進行MEMS傳感器的粘結鍵合工藝試驗,解決了
2012-09-21 17:14:24 0
0 WILSONVILLE, Ore., 2016年3月15日— Mentor Graphics公司(納斯達克代碼:MENT)今天發布了一款結合設計、版圖布局和驗證的解決方案,為TSMC集成扇出型 (InFO) 晶圓級封裝技術的設計應用提供支持。
2016-03-15 14:06:02 1296
1296 傳蘋果在2016年秋天即將推出的新款智能型手機iPhone 7(暫訂)上,將搭載采用扇出型晶圓級封裝(Fan-out WLP;FOWLP)的芯片,讓新iPhone更輕薄,制造成本更低。那什么是FOWLP封裝技術呢?
2016-05-06 17:59:35 5105
5105 晶圓制造總的工藝流程 芯片的制造過程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測工序(Wafer Probe)、構裝工序(Packaging)、測試工序(Initial
2017-12-20 10:46:54 35404
35404 由于晶圓級封裝不需要中介層、填充物與導線架,并且省略黏晶、打線等制程,能夠大幅減少材料以及人工成本;已經成為強調輕薄短小特性的可攜式電子產品 IC 封裝應用的之選。FuzionSC貼片機能應對這種先進工藝。
2018-05-11 16:52:52 53962
53962 
工藝。典型的封裝工藝流程為:劃片 裝片 鍵合 塑封 去飛邊 電鍍 打印 切筋和成型 外觀檢查 成品測試包裝出貨。 半導體封裝是指將通過測試的晶圓按照產品型號及功能需求加工得到獨立芯片的過程。封裝過程為:來自晶圓前道工藝的晶圓通過劃片工藝后被切割為小的晶片(Die),然后
2020-03-27 16:40:06 9622
9622 原文標題:工藝 | IC封裝測試工藝流程 文章出處:【微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。 責任編輯:haq
2020-10-10 17:42:13 9091
9091 
摩爾定律在晶圓工藝制程方面已是強弩之末,此時先進的封裝技術拿起了接力棒。扇出型晶圓級封裝(FOWLP)等先進技術可以提高器件密度、提升性能,并突破芯片I/O數量的限制。然而,要成功利用這類技術,在芯片設計之初就要開始考慮其封裝。
2020-11-12 16:55:39 1147
1147 Durendal?工藝提供了一種經濟高效的方式進行單個晶片堆疊,并能產出高良率以及穩固可靠的連接。在未來,我們期待Durendal?工藝能促進扇出型晶圓級封裝在單個晶片堆疊中得到更廣泛的應用。
2020-12-24 17:39:43 1299
1299 集成電路芯片封裝工藝流程有哪些?
2021-07-28 15:28:16 13906
13906 、粘貼固定和連接,經過接線端子后用塑封固定,形成了立體結構的工藝。 芯片封裝工藝流程 1.磨片 將晶圓進行背面研磨,讓晶圓達到封裝要的厚度。 2.劃片 將晶圓粘貼在藍膜上,讓晶圓被切割開后不會散落。 3.裝片 把芯片裝到管殼底座
2021-08-09 11:53:54 72669
72669 Chip First工藝 自從Fan-Out封裝問世以來,經過多年的技術發展,扇出式封裝已經形成了多種封裝流程、封裝結構以適應不同產品需要,根據工藝流程,可以分為先貼芯片后加工RDL的Chip
2021-10-12 10:17:51 13257
13257 從晶圓到芯片,有哪些工藝流程?晶圓制造工藝流程步驟如下: 1.表面清洗 2.初次氧化 3.CVD 4.涂敷光刻膠 5.用干法氧化法將氮化硅去除 6.去除光刻膠 7.用熱磷酸去除氮化硅層 8.退火處理
2021-12-30 11:11:16 20885
20885 扇出型晶圓級封裝最大的優勢,就是令具有成千上萬I/O點的半導體器件,通過二到五微米間隔線實現無縫連接,使互連密度最大化,實現高帶寬數據傳輸,去除基板成本。
2022-03-23 14:02:25 2885
2885 芯片封裝的目的在于確保芯片經過封裝之后具有較強的機械性能、良好的電氣性能和散熱性能,可以對芯片起到機械和環境保護的作用,保證芯片能夠保持高效穩定的正常工作。那么,芯片封裝工藝流程是什么呢?
2022-10-31 10:14:25 12612
12612 封裝工藝流程--芯片互連技術
2022-12-05 13:53:52 2343
2343 功率半導體分立器件的主要工藝流程包括:在硅圓片上加工芯片(主要流程為薄膜制造、曝光和刻蝕),進行芯片封裝,對加工完畢的芯片進行技術性能指標測試,其中主要生產工藝有外延工藝、光刻工藝、刻蝕工藝、離子注入工藝和擴散工藝等。
2023-02-24 15:34:13 6139
6139 據業內人士透露,三星電子已加緊布局扇出型(FO)晶圓級封裝領域,并計劃在日本設立相關生產線。
2023-04-10 09:06:50 2851
2851 當的方式為激光解鍵合。鴻浩半導體設備所生產的UV激光解鍵合設備具備低溫、不傷晶圓等技術特點,并且提供合理的制程成本,十分適合應用于扇出晶圓級封裝。 01 扇出晶圓級封裝簡介 扇出晶圓級封裝(Fan Out Wafer Level Packaging, FOWLP,簡稱扇出
2023-04-28 17:44:43 2743
2743 
圓片級芯片尺寸封裝(WLCSP)是指在圓片狀態下完成再布線,凸點下金屬和焊錫球的制備,以及圓片級的探針測試,然后再將圓片進行背面研磨減薄
2023-05-06 09:06:41 4461
4461 
當前紅外熱成像行業內非制冷紅外探測器的封裝工藝主要有金屬封裝、陶瓷封裝、晶圓級封裝三種形式。金屬封裝是業內最早的封裝形式。金屬封裝非制冷紅外探測器制作工藝上,首先對讀出電路的晶圓片進行加工,在讀
2022-10-13 17:53:27 4945
4945 
當我們購買電子產品時,比如手機、電視或計算機,這些設備內部都有一個重要的組成部分,那就是半導體芯片。半導體芯片是由許多微小的電子元件組成的,為了保護和使用這些芯片,它們需要經過一個被稱為封裝的工藝流程。下面是半導體芯片封裝的通俗易懂的工藝流程。
2023-06-26 13:50:43 3310
3310 QFN封裝工藝流程包括以下步驟磨片:對晶圓廠出來的圓片進行減薄處理,方便在有限的空間中進行封裝。劃片:將圓片上成千上萬個獨立功能的芯片進行切割分離。裝片:將芯片裝入QFN封裝殼中。焊線:將芯片與殼體
2023-06-27 15:30:52 1980
1980 
結合 FOWLP 近期技術發展和 應用的現狀, 總結了發展趨勢; 從 FOWLP 結構的工藝缺陷和失效模式出發, 闡述了 FOWLP 的工藝流程和重點工藝環節。
2023-07-01 17:48:39 3931
3931 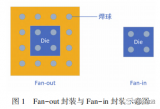
半導體:生產過程主要可分為(晶圓制造 Wafer Fabrication) 、(封裝工序 Packaging)、(測試工序 Test) 幾個步驟。
2023-07-19 09:47:49 3919
3919 
,必然需要安裝各種電子元器件,所以這使得SMT組裝貼片加工顯得尤為重要。 電子產品各式各樣,PCB板種類眾多,SMT貼片加工也需不同的工藝流程,才能應對各種PCB板的組裝,本篇為大家介紹各種PCB板SMT組裝工藝流程的應用場景。 ? ? ? ? 01 單面純貼片工
2023-10-18 08:36:08 1800
1800 
晶圓級封裝是指晶圓切割前的工藝。晶圓級封裝分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶圓始終保持完整。
2023-10-18 09:31:05 4921
4921 
濺射是一種在晶圓表面形成金屬薄膜的物理氣相沉積(PVD)6工藝。如果晶圓上形成的金屬薄膜低于倒片封裝中的凸點,則被稱為凸點下金屬層(UBM,Under Bump Metallurgy)。通常凸點下
2023-10-20 09:42:21 13583
13583 
扇出型晶圓級封裝技術的優勢在于能夠利用高密度布線制造工藝,形成功率損耗更低、功能性更強的芯片封裝結構,讓系統級封裝(System in a Package, SiP)和3D芯片封裝更愿意采用扇出型晶圓級封裝工藝。
2023-10-25 15:16:14 2051
2051 
IGBT模塊的封裝技術難度高,高可靠性設計和封裝工藝控制是其技術難點。
2023-11-21 15:49:45 2832
2832 
LED顯示屏行業發展至今,已經出現過多種生產封裝工藝,小間距市場目前以SMT貼片技術為主,在微間距市場,COB封裝技術憑借更高像素密度,更精密的顯示效果,越來越獲得市場認可。
2023-12-27 09:46:21 5488
5488 分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶
2024-03-05 08:42:13 3555
3555 
如今,再分布層(RDL)在高級封裝方案中得到了廣泛應用,包括扇出封裝、扇出芯片對基板方法、扇出封裝對封裝、硅光子學和2.5D/3D集成方法。
2024-04-08 11:36:48 5976
5976 
在本系列第七篇文章中,介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝
2024-08-21 15:10:38 4450
4450 
SMT(Surface Mount Technology)貼片是一種電子元器件的表面貼裝技術,也是現代電子制造中最常用的一種工藝。以下是對SMT貼片貼裝工藝流程以及SMT貼片焊接技術的介紹: 一
2024-11-23 09:52:34 2481
2481 半導體晶圓制造是現代電子產業中不可或缺的一環,它是整個電子行業的基礎。這項工藝的流程非常復雜,包含了很多步驟和技術,下面將詳細介紹其主要的制造工藝流程。第一步:晶圓生長晶圓生長是半導體制造的第一步
2024-12-24 14:30:56 5107
5107 
本文介紹了背金工藝的工藝流程。 本文將解析一下背金工藝的具體的工藝流程及每步的工藝原理。 背金工藝的工藝流程 ? 如上圖,步驟為: ? tape→grinding →Si etch?→ Detape
2025-02-12 09:33:18 2057
2057 
實現芯片與外部電路電氣連接的關鍵結構。本文將深入解析晶圓級封裝Bump工藝的關鍵點,探討其技術原理、工藝流程、關鍵參數以及面臨的挑戰和解決方案。
2025-03-04 10:52:57 4980
4980 
晶圓濕法清洗工作臺是一個復雜的工藝,那我們下面就來看看具體的工藝流程。不得不說的是,既然是復雜的工藝每個流程都很重要,為此我們需要仔細謹慎,這樣才能獲得最高品質的產品或者達到最佳效果。 晶圓濕法清洗
2025-04-01 11:16:27 1009
1009 晶圓蝕刻與擴散是半導體制造中兩個關鍵工藝步驟,分別用于圖形化蝕刻和雜質摻雜。以下是兩者的工藝流程、原理及技術要點的詳細介紹:一、晶圓蝕刻工藝流程1.蝕刻的目的圖形化轉移:將光刻膠圖案轉移到晶圓表面
2025-07-15 15:00:22 1224
1224 
扇出型晶圓級封裝(FOWLP)的概念最早由德國英飛凌提出,自2016 年以來,業界一直致力于FOWLP 技術的發展。
2026-01-04 14:40:30 199
199 
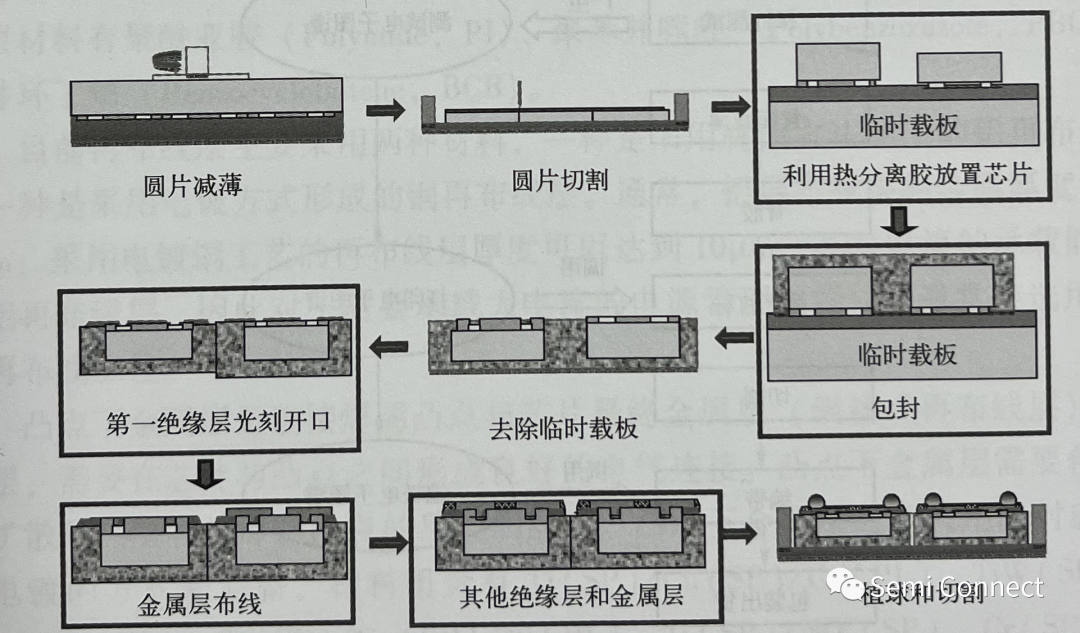
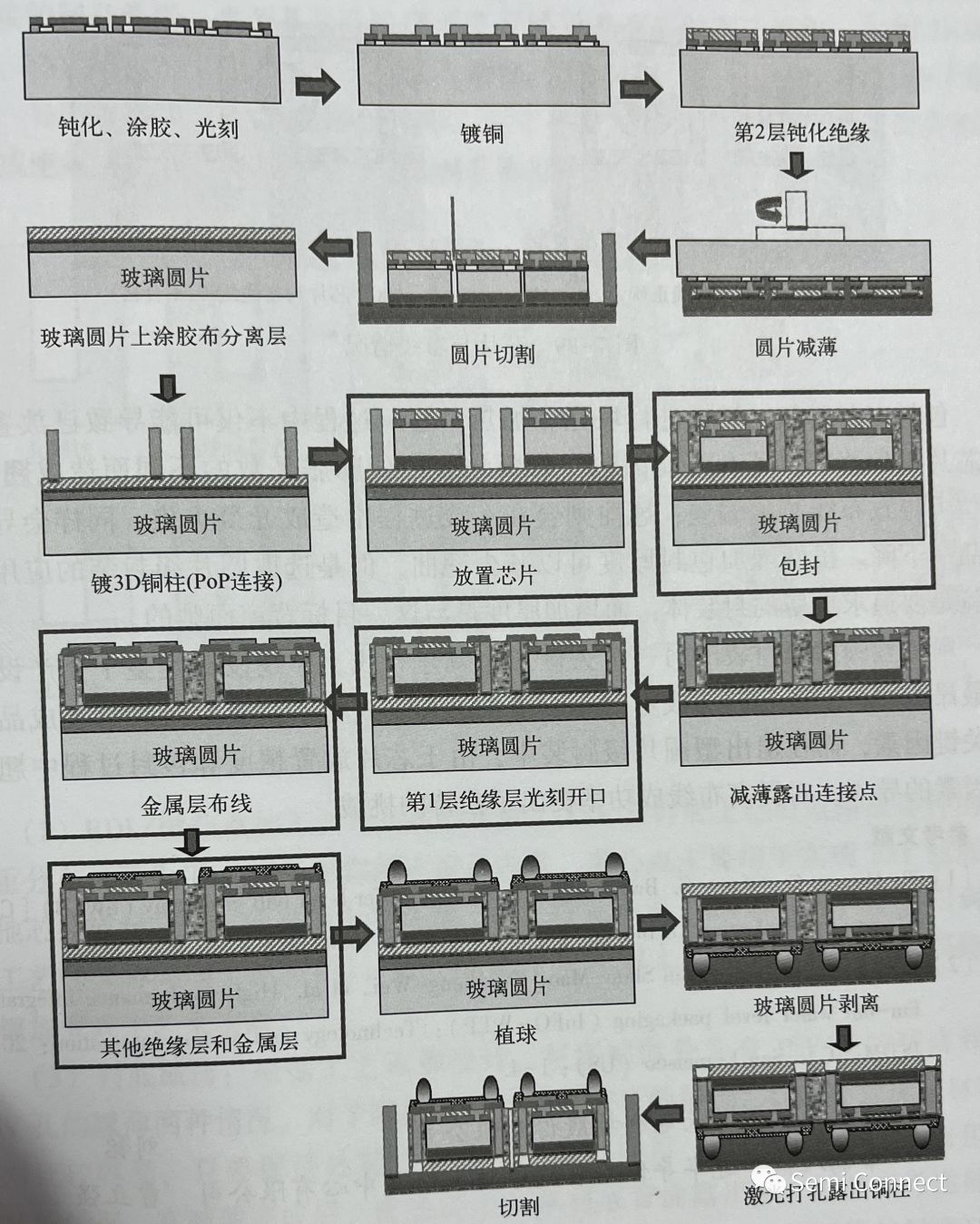
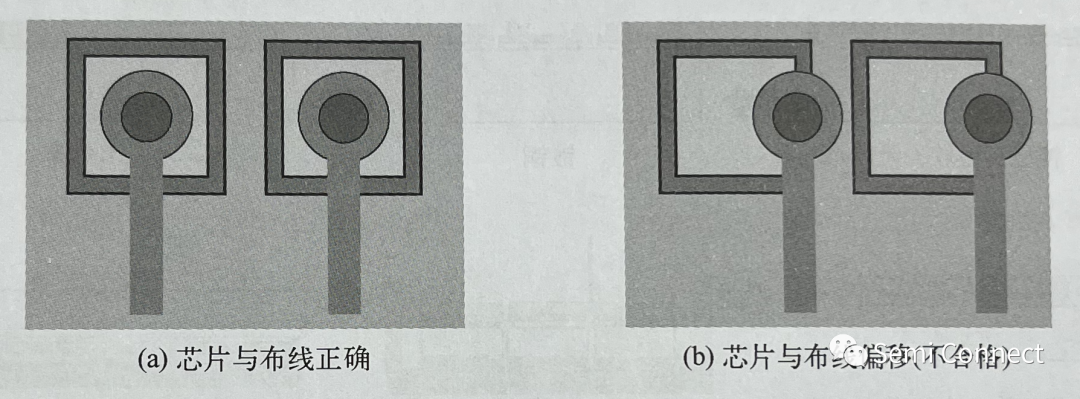
 電子發燒友App
電子發燒友App













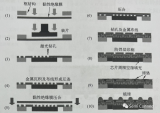
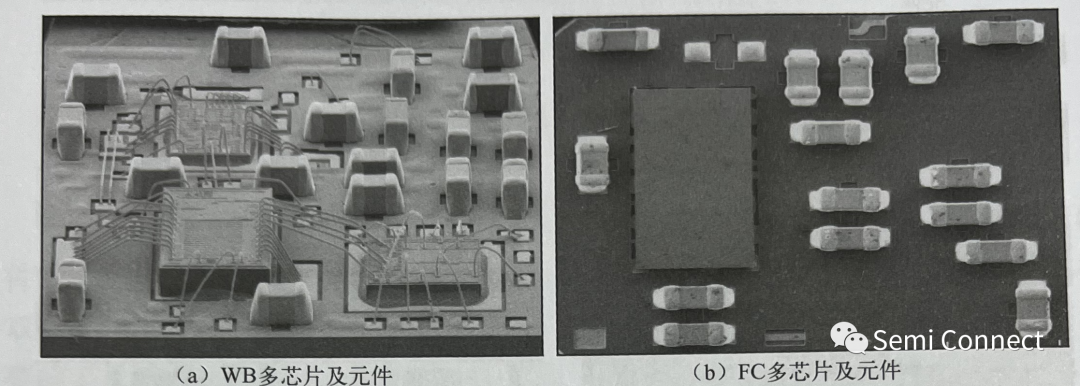







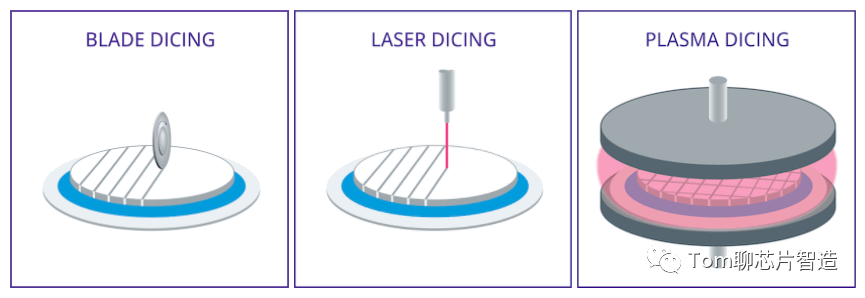











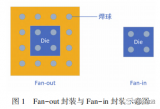

















評論