電子發(fā)燒友網(wǎng)報(bào)道(文/黃山明)芯片,一直被譽(yù)為 人類智慧、工程協(xié)作與精密制造的集大成者 ,而制造芯片的重要設(shè)備光刻機(jī)就是 雕刻這個(gè)結(jié)晶的 “ 神之手 ”。但僅有光刻機(jī)還不夠,還需要光刻膠、掩膜版以及
2025-10-28 08:53:35 6234
6234 電子發(fā)燒友網(wǎng)綜合報(bào)道 在芯片制造領(lǐng)域,光刻膠用光引發(fā)劑長期被美日韓企業(yè)壟斷,成為制約我國半導(dǎo)體產(chǎn)業(yè)發(fā)展的關(guān)鍵“卡脖子”技術(shù)。近日,這一局面被打破——湖北興福電子材料股份有限公司以4626.78萬元
2025-12-17 09:16:27 5950
5950 在半導(dǎo)體制造過程中,晶圓去膠工藝之后確實(shí)需要進(jìn)行清洗和干燥步驟。以下是具體介紹:一、清洗的必要性去除殘留物光刻膠碎片:盡管去膠工藝旨在完全去除光刻膠,但在實(shí)際操作中,可能會有一些微小的光刻膠顆粒殘留
2025-12-16 11:22:10 110
110 
SPM(硫酸-過氧化氫混合液)清洗是半導(dǎo)體制造中關(guān)鍵的濕法清洗工藝,主要用于去除晶圓表面的有機(jī)物、光刻膠殘留及金屬污染。以下是SPM清洗的標(biāo)準(zhǔn)化步驟及技術(shù)要點(diǎn):一、溶液配制配比與成分典型體積比
2025-12-15 13:23:26 392
392 
剝離SPM通過高溫(120–150℃)下的強(qiáng)氧化反應(yīng),將光刻膠分解為可溶性小分子。例如,在5nm以下制程中,SPM結(jié)合超聲波空化效應(yīng),可實(shí)現(xiàn)無殘留剝離,同時(shí)避
2025-12-15 13:20:31 201
201 
在化工、石油等嚴(yán)苛化學(xué)腐蝕環(huán)境中,如何選擇合適的灌封膠?本文聚焦耐化學(xué)腐蝕灌封膠的類型對比、核心選型要點(diǎn)及應(yīng)用建議,幫助您快速掌握專業(yè)防護(hù)方案。 | 鉻銳特實(shí)業(yè) 三
2025-12-13 00:24:01 201
201 
晶圓清洗是半導(dǎo)體制造中至關(guān)重要的環(huán)節(jié),直接影響芯片良率和性能。其工藝要點(diǎn)可歸納為以下六個(gè)方面:一、污染物分類與針對性處理顆粒污染:硅粉、光刻膠殘留等,需通過物理擦洗或兆聲波空化效應(yīng)剝離。有機(jī)污染
2025-12-09 10:12:30 236
236 
、有機(jī)物及金屬離子污染。方法:采用化學(xué)溶液(如SPM混合液)結(jié)合物理沖洗,通過高溫增強(qiáng)化學(xué)反應(yīng)效率,溶解并剝離表面殘留的光刻膠等物質(zhì)。二、核心清洗步驟有機(jī)溶劑處理
2025-12-08 11:24:01 236
236 
在芯片制造這場微觀世界的雕刻盛宴中,光刻膠(PR)如同一位技藝精湛的工匠手中的隱形畫筆,在硅片這片“晶圓畫布”上勾勒出億萬個(gè)晶體管組成的復(fù)雜電路。然而,這支“畫筆”卻成了中國芯片產(chǎn)業(yè)最難突破的瓶頸之一:
2025-11-29 09:31:00 4626
4626 
晶圓邊緣曝光(WEE)作為半導(dǎo)體制造關(guān)鍵精密工藝,核心是通過光刻膠光化學(xué)反應(yīng)去除晶圓邊緣多余膠層,從源頭減少污染、提升產(chǎn)品良率。文章聚焦其四階段工作流程、核心參數(shù)要求及光機(jī)電協(xié)同等技術(shù)難點(diǎn)。友思特
2025-11-27 23:40:39 243
243 
要素的解析: 一、核心化學(xué)溶液體系 SPM(硫酸/雙氧水混合液) 作用 :通過強(qiáng)氧化性分解有機(jī)物(如光刻膠殘留),并去除金屬雜質(zhì)。 典型配比 :濃硫酸與雙氧水按7:3體積比混合,高溫(100~150℃)下反應(yīng)生成過氧酸,增強(qiáng)氧化能力
2025-11-24 15:07:29 283
283 模塊有符合 RoHS 豁免條款的部件,需同步準(zhǔn)備豁免證明文件。
REACH 認(rèn)證REACH 管控歐盟市場上化學(xué)物質(zhì)及其制品,低功耗藍(lán)牙模塊的外殼塑料、電路板涂層等含有的化學(xué)物質(zhì)均需符合其要求,流程如下
2025-11-17 15:39:38
顯微鏡可三維成像表面形貌,通過粗糙度參數(shù)評估微觀均勻性。有機(jī)物與金屬污染檢測紫外光譜/傅里葉紅外光譜:識別有機(jī)殘留(如光刻膠)。電感耦合等離子體質(zhì)譜:量化金屬雜質(zhì)含量
2025-11-11 13:25:37 350
350 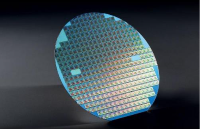
半導(dǎo)體清洗中SPM(硫酸-過氧化氫混合液)的最佳使用溫度需根據(jù)具體工藝目標(biāo)、污染物類型及設(shè)備條件綜合確定,以下是關(guān)鍵分析: 高溫場景(120–150℃) 適用場景:主要用于光刻膠剝離、重度有機(jī)污染
2025-11-11 10:32:03 253
253 去除表面污染物,保障工藝精度顆粒物清除:在半導(dǎo)體制造過程中,晶圓表面極易附著微小的顆粒雜質(zhì)。這些顆粒若未被及時(shí)清除,可能會在后續(xù)的光刻、刻蝕等工序中引發(fā)問題。例如,它們可能導(dǎo)致光刻膠涂層不均勻
2025-10-30 10:47:11 354
354 
電子發(fā)燒友網(wǎng)綜合報(bào)道 近日,我國半導(dǎo)體材料領(lǐng)域迎來重大突破。北京大學(xué)化學(xué)與分子工程學(xué)院彭海琳教授團(tuán)隊(duì)及合作者通過冷凍電子斷層掃描技術(shù),首次在原位狀態(tài)下解析了光刻膠分子在液相環(huán)境中的微觀三維結(jié)構(gòu)、界面
2025-10-27 09:13:04 6180
6180 
污染物類型 不同工序產(chǎn)生的殘留物差異顯著(如光刻膠殘余、金屬離子沉積、顆粒物或氧化層缺陷)。例如: 前端硅片預(yù)處理需去除表面有機(jī)物和自然氧化層; CMP拋光后需清理研磨液中的磨料顆粒; 金屬互連前的清洗則側(cè)重于消除電
2025-10-22 14:47:39 257
257 顆粒物附著 :空氣中懸浮的微塵落在涂覆光刻膠的晶圓表面,形成掩膜圖案外的異常散射中心。 有機(jī)揮發(fā)物(VOCs) :光刻膠溶劑殘留或環(huán)境中的有機(jī)物吸附于晶圓邊緣,導(dǎo)致顯影不完全或線寬失真。 靜電吸附 :干燥環(huán)境下積累的靜電荷會吸引周圍粒子至晶圓表面
2025-10-21 14:28:36 688
688 選擇合適的SC1溶液清洗硅片需要綜合考慮多個(gè)因素,以下是具體的方法和要點(diǎn):明確污染物類型與污染程度有機(jī)物污染為主時(shí):如果硅片表面主要是光刻膠、油脂等有機(jī)污染物,應(yīng)適當(dāng)增加過氧化氫(H?O?)的比例
2025-10-20 11:18:44 460
460 
步驟:爐前清洗:在擴(kuò)散工藝前對硅片進(jìn)行徹底清潔,去除可能影響摻雜均勻性的污染物。光刻后清洗:有效去除殘留的光刻膠,為后續(xù)工序提供潔凈的表面條件。氧化前自動(dòng)清洗:在
2025-10-16 17:42:03 741
741 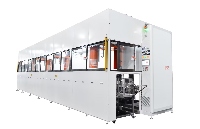
,分解有機(jī)污染物(如光刻膠殘留物)或金屬腐蝕產(chǎn)物(如銅氧化物)。例如,在類似SC2清洗液體系中,它可能替代部分鹽酸,通過氧化反應(yīng)去除金屬雜質(zhì);緩沖與pH調(diào)節(jié):作為緩
2025-10-14 13:08:41 203
203 
本文從焊料應(yīng)用工程師視角,解析了錫膏與錫膠的核心差異:成分上,錫膏以金屬合金粉為核心,助焊劑輔助焊接;錫膠含熱固樹脂,兼顧焊接與補(bǔ)強(qiáng)。性能上,錫膏導(dǎo)電導(dǎo)熱更優(yōu),耐受高溫;錫膠低溫固化,殘留物絕緣性好。應(yīng)用場景上,錫膏適配手機(jī)主板、汽車VCU等量產(chǎn)高精度產(chǎn)品;錫膠用于折疊屏、醫(yī)療傳感器等特種場景。
2025-10-10 11:06:36 585
585 
徘徊在我們的水、血液和環(huán)境中,是出了名的難以檢測的“永遠(yuǎn)的化學(xué)物質(zhì)” ,其中一些對人類有毒。 ? 芝加哥大學(xué)普利茲克分子工程學(xué)院(UChicago PME)和美國阿貢國家實(shí)驗(yàn)室(Argonne
2025-10-09 19:47:05 128
128 中產(chǎn)生空化效應(yīng),形成微小氣泡破裂時(shí)釋放的能量可剝離晶圓表面的顆粒物和有機(jī)膜層。該方法對去除光刻膠殘?jiān)葹橛行В夷艽┩笍?fù)雜結(jié)構(gòu)如溝槽和通孔進(jìn)行深度清潔。高壓噴淋沖洗
2025-10-09 13:46:43 472
472 
清洗策略半導(dǎo)體制造過程中產(chǎn)生的污染物可分為四類:顆粒物(灰塵/碎屑)、有機(jī)殘留(光刻膠/油污)、金屬離子污染、氧化層。針對不同類型需采用差異化的解決方案:顆粒物清除
2025-10-09 13:40:46 705
705 
的電子元器件必須符合RoHS要求,以確保產(chǎn)品不會對環(huán)境和人類健康造成傷害。
REACH認(rèn)證 :全稱為《化學(xué)品注冊、評估、授權(quán)和限制法規(guī)》,要求電子元器件中的化學(xué)物質(zhì)必須注冊、評估,并限制或禁止某些高風(fēng)險(xiǎn)
2025-09-29 15:28:50
半導(dǎo)體腐蝕清洗機(jī)是集成電路制造過程中不可或缺的關(guān)鍵設(shè)備,其作用貫穿晶圓加工的多個(gè)核心環(huán)節(jié),具體體現(xiàn)在以下幾個(gè)方面:一、精準(zhǔn)去除表面污染物與殘留物在半導(dǎo)體工藝中,光刻、刻蝕、離子注入等步驟會留下多種
2025-09-25 13:56:46 497
497 
濕法去膠工藝中出現(xiàn)化學(xué)殘留的原因復(fù)雜多樣,涉及化學(xué)反應(yīng)、工藝參數(shù)、設(shè)備性能及材料特性等多方面因素。以下是具體分析:化學(xué)反應(yīng)不完全或副產(chǎn)物生成溶劑選擇不當(dāng):若使用的化學(xué)試劑與光刻膠成分不匹配(如堿性
2025-09-23 11:10:12 497
497 
、金屬屑),優(yōu)先選擇物理作用強(qiáng)的超聲波或兆聲波模塊;針對有機(jī)殘留(光刻膠、樹脂)、油污等,則需化學(xué)溶解能力強(qiáng)的噴淋系統(tǒng)配合溶劑(如丙酮、NMP)。對于金屬離子污染,
2025-09-22 11:04:05 464
464 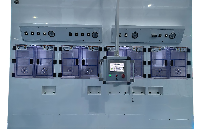
什么是離子污染物離子污染物是指產(chǎn)品表面未被清洗掉的殘留物質(zhì),這些物質(zhì)在潮濕環(huán)境中會電離為導(dǎo)電離子,例如電鍍藥水、助焊劑、清洗劑、人工汗液等,很容易在產(chǎn)品上形成離子殘留。一旦這些物質(zhì)在產(chǎn)品表面殘留并
2025-09-18 11:38:28 502
502 
光刻膠剝離工藝是半導(dǎo)體制造和微納加工中的關(guān)鍵步驟,其核心目標(biāo)是高效、精準(zhǔn)地去除光刻膠而不損傷基底材料或已形成的結(jié)構(gòu)。以下是該工藝的主要類型及實(shí)施要點(diǎn):濕法剝離技術(shù)有機(jī)溶劑溶解法原理:使用丙酮、NMP
2025-09-17 11:01:27 1282
1282 
在半導(dǎo)體制造過程中,若濕法去膠第一次未能完全去除干凈,可能引發(fā)一系列連鎖反應(yīng),對后續(xù)工藝和產(chǎn)品質(zhì)量造成顯著影響。以下是具體后果及分析:殘留物導(dǎo)致后續(xù)工藝缺陷薄膜沉積異常:未清除的光刻膠殘留會作為異物
2025-09-16 13:42:02 447
447 
薄膜或散射光異常區(qū)域,初步區(qū)分有機(jī)物、無機(jī)鹽還是金屬殘留。例如,油性光澤可能指向光刻膠殘余,而白色結(jié)晶多為銨鹽類無機(jī)物。儀器驗(yàn)證:借助FTIR光譜分析官能團(tuán)特征峰識
2025-09-16 13:37:42 580
580 
提高光刻膠殘留清洗效率需要結(jié)合工藝優(yōu)化、設(shè)備升級和材料創(chuàng)新等多方面策略,以下是具體方法及技術(shù)要點(diǎn):1.工藝參數(shù)精準(zhǔn)控制動(dòng)態(tài)調(diào)整化學(xué)配方根據(jù)殘留類型(正膠/負(fù)膠、厚膜/薄膜)實(shí)時(shí)匹配最佳溶劑組合。例如
2025-09-09 11:29:06 629
629 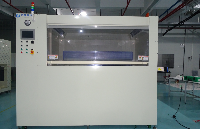
?)、石墨化殘留物及金屬雜質(zhì),開發(fā)多組分混合酸液體系。例如,采用HF/HNO?/HAc緩沖溶液實(shí)現(xiàn)各向同性蝕刻,既能有效去除損傷層又不引入表面粗糙化。通過電化學(xué)阻抗譜監(jiān)測
2025-09-08 13:14:28 621
621 
想到,除了研究大腦的抽象數(shù)學(xué)模型外,能否拋棄傳統(tǒng)的芯片實(shí)現(xiàn)方式,以化學(xué)物質(zhì)和生物組件、材料及相關(guān)現(xiàn)象來構(gòu)建人工神經(jīng)網(wǎng)絡(luò)或提取其功能來用于AI處理,甚至直接用生物體來實(shí)現(xiàn)AI功能,這就是從AI硬件走向AI
2025-09-06 19:12:03
預(yù)處理與初步去污將硅片浸入盛有丙酮或異丙醇溶液的容器中超聲清洗10–15分鐘,利用有機(jī)溶劑溶解并去除表面附著的光刻膠、油脂及其他疏水性污染物。此過程通過高頻振動(dòng)加速分子運(yùn)動(dòng),使大塊殘留物脫離基底進(jìn)入
2025-09-03 10:05:38 603
603 
引言 晶圓光刻圖形是半導(dǎo)體制造中通過光刻工藝形成的微米至納米級三維結(jié)構(gòu)(如光刻膠線條、接觸孔、柵極圖形等),其線寬、高度、邊緣粗糙度等參數(shù)直接決定后續(xù)蝕刻、沉積工藝的精度,進(jìn)而影響器件性能。傳統(tǒng)
2025-09-03 09:25:20 650
650 
相似相溶原理快速溶解有機(jī)污漬(如油脂、光刻膠殘留物),適用于初步去脂或特定聚合物材料的清除。例如,在CCD芯片清洗中,常采用“蒸餾水→異丙醇→純丙酮”的順序循環(huán)噴淋
2025-09-01 11:21:59 1000
1000 
在芯片制造領(lǐng)域的光刻工藝中,光刻膠旋涂是不可或缺的基石環(huán)節(jié),而保障光刻膠旋涂的厚度是電路圖案精度的前提。優(yōu)可測薄膜厚度測量儀AF系列憑借高精度、高速度的特點(diǎn),為光刻膠厚度監(jiān)測提供了可靠解決方案。
2025-08-22 17:52:46 1542
1542 
一、工藝參數(shù)精細(xì)化調(diào)控1.化學(xué)配方動(dòng)態(tài)適配根據(jù)污染物類型(有機(jī)物/金屬離子/顆粒物)設(shè)計(jì)階梯式清洗方案。例如:去除光刻膠殘留時(shí)采用SC1配方(H?O?:NH?OH=1:1),配合60℃恒溫增強(qiáng)氧化
2025-08-20 12:00:26 1247
1247 
這一突破的核心力量。 ? 然而,EUV光刻的廣泛應(yīng)用并非坦途,其光源本身存在反射損耗大、亮度低等固有缺陷,這對配套的光刻膠材料提出了前所未有的嚴(yán)苛要求——不僅需要具備高效的EUV吸收能力,還要在反應(yīng)機(jī)制的穩(wěn)定性、缺陷控制的精準(zhǔn)度等方面實(shí)
2025-08-17 00:03:00 4220
4220 電子束光刻(EBL)是一種無需掩模的直接寫入式光刻技術(shù),其工作原理是通過聚焦電子束在電子敏感光刻膠表面進(jìn)行納米級圖案直寫。
2025-08-14 10:07:21 2553
2553 
。 從光固化龍頭到半導(dǎo)體材料新銳 久日新材的戰(zhàn)略轉(zhuǎn)型始于2020年。通過收購大晶信息、大晶新材等企業(yè),強(qiáng)勢切入半導(dǎo)體化學(xué)材料賽道。2024年11月,久日新材控股公司年產(chǎn)4500噸光刻膠項(xiàng)目進(jìn)入試生產(chǎn)階段,其中面板光刻膠4000噸、半導(dǎo)體光刻膠500噸
2025-08-12 16:45:38 1162
1162 的相互作用,而反應(yīng)速度直接受溫度影響。例如:高溫加速反應(yīng)(如硫酸+雙氧水混合液在80℃下快速剝離光刻膠);低溫導(dǎo)致反應(yīng)滯后或不徹底,造成殘留物污染后續(xù)工序。溫度波動(dòng)±1
2025-08-12 11:23:14 660
660 
半導(dǎo)體濕法去膠是一種通過化學(xué)溶解與物理輔助相結(jié)合的技術(shù),用于高效、可控地去除晶圓表面的光刻膠及其他工藝殘留物。以下是其核心原理及關(guān)鍵機(jī)制的詳細(xì)說明:化學(xué)溶解作用溶劑選擇與反應(yīng)機(jī)制有機(jī)溶劑體系:針對正性光刻膠
2025-08-12 11:02:51 1506
1506 
? 電子發(fā)燒友網(wǎng)綜合報(bào)道 近日,八億時(shí)空宣布其KrF光刻膠萬噸級半導(dǎo)體制程高自動(dòng)化研發(fā)/量產(chǎn)雙產(chǎn)線順利建成,標(biāo)志著我國在中高端光刻膠領(lǐng)域的自主化進(jìn)程邁出關(guān)鍵一步。 ? 此次建成的KrF光刻膠產(chǎn)線采用
2025-08-10 03:26:00 9092
9092 光刻工藝是芯片制造的關(guān)鍵步驟,其精度直接決定集成電路的性能與良率。隨著制程邁向3nm及以下,光刻膠圖案三維結(jié)構(gòu)和層間對準(zhǔn)精度的控制要求達(dá)納米級,傳統(tǒng)檢測手段難滿足需求。光子灣3D共聚焦顯微鏡憑借非
2025-08-05 17:46:43 944
944 
浸泡的方式,用去離子水(DIWater)或其他溶劑清除晶圓表面的殘留物(如光刻膠碎片、蝕刻劑副產(chǎn)物、顆粒污染物等)。主要作用:確保前一道工序后的有害物質(zhì)被徹底去除
2025-08-04 14:53:23 1078
1078 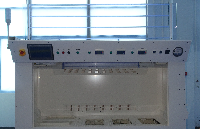
→光阻去除核心目的:清除完成圖案轉(zhuǎn)移后剩余的光刻膠層,暴露出需要進(jìn)一步加工(如蝕刻、離子注入或金屬沉積)的芯片區(qū)域。承上啟下作用:連接前期的光刻圖案化與后續(xù)的材料
2025-07-30 13:33:02 1121
1121 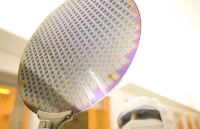
光阻去除工藝(即去膠工藝)是半導(dǎo)體制造中的關(guān)鍵步驟,旨在清除曝光后的光刻膠而不損傷底層材料。以下是主流的技術(shù)方案及其特點(diǎn):一、濕法去膠技術(shù)1.有機(jī)溶劑溶解法原理:利用丙酮、NMP(N-甲基吡咯烷酮
2025-07-30 13:25:43 916
916 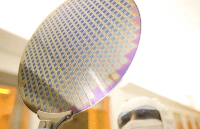
于:光刻工藝后清洗:去除光刻膠殘留及顯影液副產(chǎn)物。刻蝕后清潔:清除蝕刻副產(chǎn)物及側(cè)壁顆粒。先進(jìn)封裝:TSV(硅通孔)、Bumping(凸點(diǎn))等3D結(jié)構(gòu)的窄縫污染物清除。
2025-07-23 15:06:54
、氧化物等。表面預(yù)處理:為光刻、沉積、刻蝕等工藝提供潔凈表面。化學(xué)機(jī)械拋光(CMP)后清洗:去除磨料殘留和表面損傷層。二、突出特點(diǎn)1. 高效批量處理能力多槽聯(lián)動(dòng)設(shè)計(jì):
2025-07-23 15:01:01
光刻膠殘留)發(fā)生氧化反應(yīng),生成CO?和H?O等揮發(fā)性物質(zhì)1。表面活化:增強(qiáng)晶圓表面親水性,為后續(xù)工藝(如CVD)提供更好的附著力3。優(yōu)勢:高效去除有機(jī)污染,適用于光
2025-07-23 14:41:42 496
496 
晶圓蝕刻與擴(kuò)散是半導(dǎo)體制造中兩個(gè)關(guān)鍵工藝步驟,分別用于圖形化蝕刻和雜質(zhì)摻雜。以下是兩者的工藝流程、原理及技術(shù)要點(diǎn)的詳細(xì)介紹:一、晶圓蝕刻工藝流程1.蝕刻的目的圖形化轉(zhuǎn)移:將光刻膠圖案轉(zhuǎn)移到晶圓表面
2025-07-15 15:00:22 1224
1224 
晶圓蝕刻后的清洗是半導(dǎo)體制造中的關(guān)鍵步驟,旨在去除蝕刻殘留物(如光刻膠、蝕刻產(chǎn)物、污染物等),同時(shí)避免對晶圓表面或結(jié)構(gòu)造成損傷。以下是常見的清洗方法及其原理:一、濕法清洗1.溶劑清洗目的:去除光刻膠
2025-07-15 14:59:01 1622
1622 
污染物。 方法:濕法化學(xué)清洗(如SC-1溶液)或超聲波清洗。 硅片拋光后清洗 目的:清除拋光液殘留(如氧化層、納米顆粒),避免影響后續(xù)光刻精度。 方法:DHF(氫氟酸)腐蝕+去離子水沖洗。 2. 光刻工序 光刻膠涂覆前清洗 目的:去除硅
2025-07-14 14:10:02 1016
1016 ? 電子發(fā)燒友網(wǎng)綜合報(bào)道 光刻膠作為芯片制造光刻環(huán)節(jié)的核心耗材,尤其高端材料長期被日美巨頭壟斷,國外企業(yè)對原料和配方高度保密,我國九成以上光刻膠依賴進(jìn)口。不過近期,國產(chǎn)光刻膠領(lǐng)域捷報(bào)頻傳——從KrF
2025-07-13 07:22:00 6083
6083 光刻膠,又稱光致抗蝕劑,是一種關(guān)鍵的耐蝕劑刻薄膜材料。它在紫外光、電子束、離子束、X 射線等的照射或輻射下,溶解度會發(fā)生變化,主要應(yīng)用于顯示面板、集成電路和半導(dǎo)體分立器件等細(xì)微圖形加工作業(yè)。由于
2025-07-11 15:53:24 430
430 
的應(yīng)用。 改善光刻圖形線寬變化的方法 優(yōu)化曝光工藝參數(shù) 曝光是決定光刻圖形線寬的關(guān)鍵步驟。精確控制曝光劑量,可避免因曝光過度導(dǎo)致光刻膠過度反應(yīng),使線寬變寬;或曝光不足造成線寬變窄。采用先進(jìn)的曝光設(shè)備,如極紫外(EUV)光刻機(jī)
2025-06-30 15:24:55 740
740 
在半導(dǎo)體芯片制造的精密流程中,晶圓清洗臺通風(fēng)櫥扮演著至關(guān)重要的角色。晶圓清洗是芯片制造的核心環(huán)節(jié)之一,旨在去除晶圓表面的雜質(zhì)、微粒以及前道工序殘留的化學(xué)物質(zhì),確保晶圓表面的潔凈度達(dá)到極高的標(biāo)準(zhǔn),為
2025-06-30 13:58:12
深入探討白光干涉儀在光刻圖形測量中的應(yīng)用。 改善光刻圖形垂直度的方法 優(yōu)化光刻膠性能 光刻膠的特性直接影響圖形垂直度。選用高對比度、低膨脹系數(shù)的光刻膠,可減少曝光和顯影過程中的圖形變形。例如,化學(xué)增幅型光刻膠具有良
2025-06-30 09:59:13 489
489 
鍵設(shè)備的技術(shù)價(jià)值與產(chǎn)業(yè)意義。一、晶圓濕法清洗:為何不可或缺?晶圓在制造過程中會經(jīng)歷多次光刻、刻蝕、沉積等工藝,表面不可避免地殘留光刻膠、金屬污染物、氧化物或顆粒。這些污染
2025-06-25 10:26:37
干涉儀在光刻圖形測量中的應(yīng)用。 針對晶圓上芯片工藝的光刻膠剝離方法 濕法剝離 濕法剝離是晶圓芯片工藝中常用的光刻膠去除方式。通過將涂覆光刻膠的晶圓浸入含有特定化學(xué)成分的剝離液中,利用剝離液與光刻膠發(fā)生化學(xué)反應(yīng),
2025-06-25 10:19:48 815
815 
物的應(yīng)用,并探討白光干涉儀在光刻圖形測量中的作用。 金屬低蝕刻率光刻膠剝離液組合物 配方組成 金屬低蝕刻率光刻膠剝離液組合物主要由有機(jī)溶劑、堿性助劑、緩蝕體系和添加劑構(gòu)成。有機(jī)溶劑如 N - 甲基 - 2 - 吡咯烷酮(NMP),
2025-06-24 10:58:22 565
565 
引言 在顯示面板制造的 ARRAY 制程工藝中,光刻膠剝離是關(guān)鍵環(huán)節(jié)。銅布線在制程中廣泛應(yīng)用,但傳統(tǒng)光刻膠剝離液易對銅產(chǎn)生腐蝕,影響器件性能。同時(shí),光刻圖形的精準(zhǔn)測量對確保 ARRAY 制程工藝精度
2025-06-18 09:56:08 693
693 
一、產(chǎn)品概述全自動(dòng)Mask掩膜板清洗機(jī)是半導(dǎo)體光刻工藝中用于清潔光罩(Reticle/Mask)表面的核心設(shè)備,主要去除光刻膠殘留、顆粒污染、金屬有機(jī)物沉積及蝕刻副產(chǎn)物。其技術(shù)覆蓋濕法化學(xué)清洗、兆
2025-06-17 11:06:03
測量對工藝優(yōu)化和產(chǎn)品質(zhì)量控制至關(guān)重要。本文將探討低含量 NMF 光刻膠剝離液及其制備方法,并介紹白光干涉儀在光刻圖形測量中的應(yīng)用。 低含量 NMF 光刻膠剝離液及制備方法 配方組成 低含量 NMF 光刻膠剝離液主要由低濃度 NMF、助溶劑、堿性物質(zhì)、緩蝕劑
2025-06-17 10:01:01 678
678 
通過使用光掩膜和光刻膠在基板上復(fù)制流體圖案的過程。基板將涂覆硅二氧化層絕緣層和光刻膠。光刻膠在被紫外光照射后可以容易地用顯影劑溶解,然后在腐蝕后,流體圖案將留在基板上。無塵室(Cleanroom)排除掉空間范圍內(nèi)空氣中的微
2025-06-16 14:36:25 1070
1070 介紹白光干涉儀在光刻圖形測量中的作用。 金屬低刻蝕的光刻膠剝離液 配方設(shè)計(jì) 金屬低刻蝕光刻膠剝離液需平衡光刻膠溶解能力與金屬保護(hù)性能。其核心成分包括有機(jī)溶劑、堿性物質(zhì)和緩蝕劑。有機(jī)溶劑(如 N - 甲基吡咯烷酮)負(fù)責(zé)溶
2025-06-16 09:31:51 586
586 
? ? 引言 ? 在半導(dǎo)體制造領(lǐng)域,光刻膠剝離工藝是關(guān)鍵環(huán)節(jié),但其可能對器件性能產(chǎn)生負(fù)面影響。同時(shí),光刻圖形的精確測量對于保證芯片制造質(zhì)量至關(guān)重要。本文將探討減少光刻膠剝離工藝影響的方法,并介紹白光
2025-06-14 09:42:56 736
736 
全息圖樣對應(yīng)的物光源。加密過程中,讓兩束光干涉疊加得到干涉圖樣,并用膠片或者光刻膠記錄下來,得到一個(gè)全息圖;解密時(shí),只使用復(fù)雜的隨機(jī)圖樣照射前面形成的全息圖就可以獲得物光源信息。
圖1是加密過程示意圖
2025-06-13 08:42:59
一、光刻工藝概述 光刻工藝是半導(dǎo)體制造的核心技術(shù),通過光刻膠在特殊波長光線或者電子束下發(fā)生化學(xué)變化,再經(jīng)過曝光、顯影、刻蝕等工藝過程,將設(shè)計(jì)在掩膜上的圖形轉(zhuǎn)移到襯底上,是現(xiàn)代半導(dǎo)體、微電子、信息產(chǎn)業(yè)
2025-06-09 15:51:16 2127
2127 如果說最終制造出來的芯片是一道美食,那么光刻膠就是最初的重要原材料之一,而且是那種看起來可能不起眼,但卻能決定一道菜味道的關(guān)鍵輔料。 光刻膠(photoresist),在業(yè)內(nèi)又被稱為光阻或光阻劑
2025-06-04 13:22:51 992
992 引言 在半導(dǎo)體制造與微納加工領(lǐng)域,光刻膠剝離液是光刻膠剝離環(huán)節(jié)的核心材料,其性能優(yōu)劣直接影響光刻膠去除效果與基片質(zhì)量。同時(shí),精準(zhǔn)測量光刻圖形對把控工藝質(zhì)量意義重大,白光干涉儀為此提供了有力的技術(shù)保障
2025-05-29 09:38:53 1108
1108 
優(yōu)勢,為光刻圖形測量提供了可靠手段。 ? Micro OLED 陽極像素定義層制備方法 ? 傳統(tǒng)光刻工藝 ? 傳統(tǒng) Micro OLED 陽極像素定義層制備常采用光刻剝離工藝。首先在基板上沉積金屬層作為陽極材料,接著旋涂光刻膠,通過掩模版曝光使光刻膠發(fā)生光化學(xué)反應(yīng),隨后
2025-05-23 09:39:17 628
628 
,如超聲波清洗、高壓噴淋、毛刷機(jī)械清洗、化學(xué)濕法清洗等,可有效去除光罩表面的油污、灰塵、微粒及化學(xué)殘留物125。部分高端機(jī)型支持真空超聲清洗和超臨界流體清洗,提升
2025-05-12 09:03:45
:去除硅片表面的顆粒、有機(jī)物和氧化層,確保光刻膠均勻涂覆。 清洗對象: 顆粒污染:通過物理或化學(xué)方法(如SC1槽的堿性清洗)剝離硅片表面的微小顆粒。 有機(jī)物殘留:清除光刻膠殘?jiān)蚯暗拦に嚵粝碌挠袡C(jī)污染物(如SC2槽的酸性清洗)
2025-04-30 09:23:27 478
478 光刻膠類型及特性光刻膠(Photoresist),又稱光致抗蝕劑,是芯片制造中光刻工藝的核心材料。其性能直接影響芯片制造的精度、效率和可靠性。本文介紹了光刻膠類型和光刻膠特性。
2025-04-29 13:59:33 7833
7833 
及應(yīng)用的詳細(xì)介紹: 一、技術(shù)原理 化學(xué)反應(yīng)機(jī)制 氨水(NH?OH):提供堿性環(huán)境,腐蝕硅片表面的自然氧化層(SiO?),使附著的顆粒脫離晶圓表面。 過氧化氫(H?O?):作為強(qiáng)氧化劑,分解有機(jī)物(如光刻膠殘留)并氧化硅片表面,形成新的親水性
2025-04-28 17:22:33 4239
4239 下的潛在影響。 SPM清洗的化學(xué)特性 SPM成分:硫酸(H?SO?)與過氧化氫(H?O?)的混合液,通常比例為2:1至4:1(體積比),溫度控制在80-120℃35。 主要作用: 強(qiáng)氧化性:分解有機(jī)物(如光刻膠殘留)、氧化金屬污染物; 表面氧化:在硅表面生成親水
2025-04-27 11:31:40 866
866 刻蝕工藝的核心機(jī)理與重要性 刻蝕工藝是半導(dǎo)體圖案化過程中的關(guān)鍵環(huán)節(jié),與光刻機(jī)和薄膜沉積設(shè)備并稱為半導(dǎo)體制造的三大核心設(shè)備。刻蝕的主要作用是將光刻膠上的圖形轉(zhuǎn)移到功能膜層,具體而言,是通過物理及化學(xué)
2025-04-27 10:42:45 2200
2200 
第9章 集成電路制造工藝概況 第10章 氧化 第11章 淀積 第12章 金屬化 第13章 光刻:氣相成底膜到軟烘 第14章 光刻:對準(zhǔn)和曝光 第15章 光刻:光刻膠顯影和先進(jìn)的光刻技術(shù) 第16章
2025-04-15 13:52:11
助焊劑殘留物可能導(dǎo)致電路板電化學(xué)腐蝕、絕緣下降及可靠性隱患,其危害源于殘留物質(zhì)與環(huán)境的化學(xué)作用。通過表面絕緣電阻測試、銅鏡腐蝕測試等方法可評估風(fēng)險(xiǎn)。科學(xué)應(yīng)對需從材料選型(無鹵素助焊劑)、工藝優(yōu)化
2025-04-14 15:13:37 2234
2234 
的光刻膠,剩下未感光的光刻膠。
最后進(jìn)行刻蝕,第五步是通過物理和化學(xué)手段把SiO2薄層上未被光刻膠保護(hù)的SiO2“刻蝕”掉,只保留受光刻膠保護(hù)的SiO2;第六步是把SiO2材料上的光刻膠清除掉,這樣圖形
2025-04-02 15:59:44
工藝:光刻膠除膠,蝕刻未被保護(hù)的SiO2,顯影,除膠。 材料:晶圓,研磨拋光材料,光按模板材料。光刻膠,電子化學(xué)品。工業(yè)氣體,靶材,封裝材料 硅片制造:單晶硅棒拉制,硅棒切片,硅片研磨拋光,硅片氧化
2025-03-27 16:38:20
(或其他感光材料)上時(shí),光子能量被光刻膠分子吸收,使分子內(nèi)部能量升高并引發(fā)化學(xué)反應(yīng),通常為化學(xué)鍵的斷裂或者交聯(lián)等反應(yīng)。然后通過顯影過程選擇性去除特定區(qū)域的光刻膠形成期望的圖形。不同類型和波長的激光可以
2025-03-25 17:42:21
微流控芯片制造過程中,勻膠是關(guān)鍵步驟之一,而勻膠機(jī)轉(zhuǎn)速會在多個(gè)方面對微流控芯片的精度產(chǎn)生影響: 對光刻膠厚度的影響 勻膠機(jī)轉(zhuǎn)速與光刻膠厚度成反比關(guān)系。旋轉(zhuǎn)速度影響勻膠時(shí)的離心力,轉(zhuǎn)速越大,角速度越大
2025-03-24 14:57:16 751
751 光刻膠(Photoresist)又稱光致抗蝕劑,是指通過紫外光、電子束、離子束、X射線等的照射或輻射,其溶解度發(fā)生變化的耐蝕劑刻薄膜材料。由感光樹脂、增感劑和溶劑3種主要成分組成的對光敏感的混合液
2025-03-18 13:59:53 3008
3008 
不同材料的刻蝕速率比,達(dá)到?>5:1?甚至更高的選擇比標(biāo)準(zhǔn)?。 一、核心價(jià)值與定義 l?精準(zhǔn)材料去除? 高選擇性蝕刻通過調(diào)整反應(yīng)條件,使目標(biāo)材料(如多晶硅、氮化硅)的刻蝕速率遠(yuǎn)高于掩膜或底層材料(如氧化硅、光刻膠),實(shí)現(xiàn)
2025-03-12 17:02:49 809
809 是一種用于高效、無損地清洗半導(dǎo)體晶圓表面及內(nèi)部污染物的關(guān)鍵設(shè)備。簡單來說,這個(gè)機(jī)器具有以下這些特點(diǎn): 清洗效果好:能夠有效去除晶圓表面的顆粒、有機(jī)物、金屬雜質(zhì)、光刻膠殘留等各種污染物,滿足半導(dǎo)體制造對晶圓清潔度
2025-03-07 09:24:56 1037
1037 所需的厚度。在微流控領(lǐng)域,勻膠機(jī)主要用于光刻膠的涂覆,以確保光刻過程的均勻性和質(zhì)量。 勻膠機(jī)的主要組成部分 旋轉(zhuǎn)平臺:承載基片的平臺,通過高速旋轉(zhuǎn)產(chǎn)生離心力。 滴膠裝置:控制膠液的滴落量和位置。 控制系統(tǒng):調(diào)節(jié)旋轉(zhuǎn)速
2025-03-06 13:34:21 678
678 蓄電池放電原理主要基于其內(nèi)部的化學(xué)反應(yīng),將儲存的化學(xué)能轉(zhuǎn)化為電能。以下是對蓄電池放電原理的詳細(xì)解析:
基本原理:當(dāng)蓄電池處于放電狀態(tài)時(shí),內(nèi)部的化學(xué)物質(zhì)發(fā)生反應(yīng),產(chǎn)生電流。這一過程中,正極和負(fù)極上
2025-02-10 16:11:02
機(jī)和光刻膠: ? 光掩膜:如同芯片的藍(lán)圖,上面印有每一層結(jié)構(gòu)的圖案。 ? ? ?光刻機(jī):像一把精確的畫筆,能夠引導(dǎo)光線在光刻膠上刻畫出圖案。 ? 光刻膠:一種特殊的感光材料,通過光刻過程在光刻膠上形成圖案,進(jìn)而構(gòu)建出三維結(jié)構(gòu)。
2025-01-28 16:36:00 3591
3591 
、化學(xué)物質(zhì)、溫度變化等,主要是提供一層保護(hù)性涂層,以確保電子元件在不同環(huán)境條件下能夠穩(wěn)定、可靠地運(yùn)行,延長其壽命并提高其性能。PCB元件焊點(diǎn)保護(hù)膠種類有哪些?PCB元
2025-01-16 15:17:19 1308
1308 
,作為影響PCB板清潔度的重要因素之一,其控制變得尤為關(guān)鍵。PCB線路板在潮濕環(huán)境中運(yùn)行時(shí),可能會遭遇各種離子污染殘留物的問題。這些殘留物可能來自助焊劑殘留、化學(xué)清
2025-01-14 11:58:30 1671
1671 
半導(dǎo)體濕法刻蝕過程中殘留物的形成,其背后的機(jī)制涵蓋了化學(xué)反應(yīng)、表面交互作用以及側(cè)壁防護(hù)等多個(gè)層面,下面是對這些機(jī)制的深入剖析: 化學(xué)反應(yīng)層面 1 刻蝕劑與半導(dǎo)體材料的交互:濕法刻蝕技術(shù)依賴于特定
2025-01-08 16:57:45 1468
1468 用先進(jìn)材料項(xiàng)目等。 恒坤新材成立于2004年12月,是中國境內(nèi)少數(shù)具備12英寸集成電路晶圓制造關(guān)鍵材料研發(fā)和量產(chǎn)能力的創(chuàng)新企業(yè)之一。據(jù)其股東廈門市產(chǎn)業(yè)投資基金披露,恒坤新材是國內(nèi)12英寸晶圓制造先進(jìn)制程上出貨量最大的光刻膠企業(yè)。 根據(jù)弗若斯特沙利文市
2025-01-07 17:38:55 843
843 光刻膠在這些物理或化學(xué)過程中具有更好的工藝穩(wěn)定性和效果。 增強(qiáng)光刻膠與基片的粘附 烘膠有助于除去顯影后殘留于膠膜中的溶劑或水分,從而使膠膜與基片緊密粘附,防止膠層脫落。這一過程在微流控芯片的光刻工藝中是重要的一環(huán),保障了
2025-01-07 15:18:06 824
824
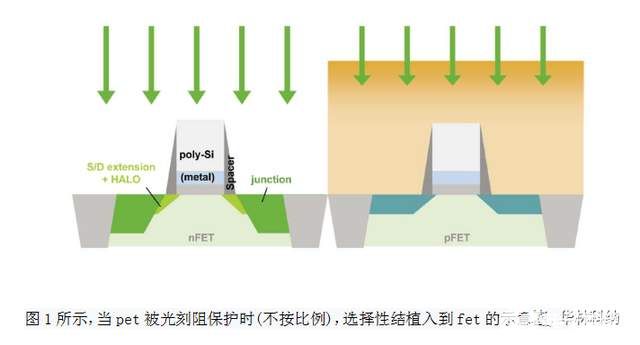
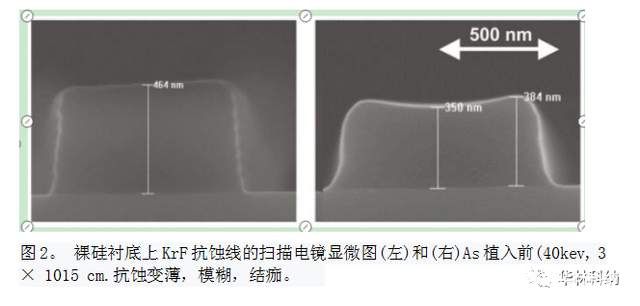

 電子發(fā)燒友App
電子發(fā)燒友App

















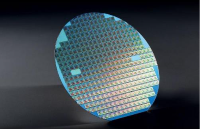



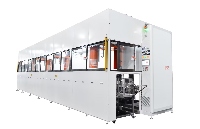





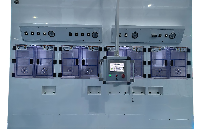



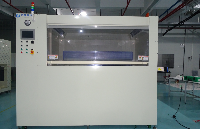









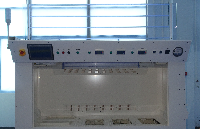
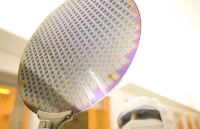
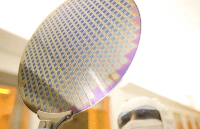















評論