光刻膠剝離工藝是半導體制造和微納加工中的關鍵步驟,其核心目標是高效、精準地去除光刻膠而不損傷基底材料或已形成的結構。以下是該工藝的主要類型及實施要點:
濕法剝離技術
有機溶劑溶解法
原理:使用丙酮、NMP(N-甲基吡咯烷酮)、乳酸乙酯等強極性溶劑溶脹并溶解光刻膠分子鏈,適用于傳統g線/i線正膠體系。例如,NMP因低蒸氣壓可加熱至80℃以增強對交聯型光刻膠的去除能力,而DMSO作為其安全替代品,在60–80℃時表現相似性能。
特點:成本低且設備簡單,適合批量處理;但對新型化學放大型抗蝕劑效果有限,且溶劑揮發可能造成環境污染。
酸堿顯影液剝離
堿性配方:采用TMAH(氫氧化四甲銨)、KOH稀溶液等,通過水解反應破壞負性光阻的交聯網絡;高濃度堿性溶液可能腐蝕硅基板,需謹慎控制濃度與作用時間。
酸性變體:如硫酸+雙氧水混合液(類似SPM溶液),可氧化分解金屬表面的殘留物,常用于特殊清洗場景。
臭氧化水處理系統
機制:將臭氧氣體鼓入超純水中生成強氧化性自由基(·OH),高效降解有機物的同時抑制金屬離子再沉積,尤其適用于先進封裝工藝中的UBM層清洗。該技術具有較低的VOC排放和廢水可回收優勢。
干法剝離技術
等離子體灰化
工作模式:在低壓腔室內通入O?/N?混合氣體產生電感耦合等離子體(ICP),活性粒子轟擊使光刻膠碳化揮發。通過調節氧氣比例可控制刻蝕速率與選擇性,射頻功率密度通常維持在5–15W/cm2區間,壓力為50–200mTorr以保證各向異性刻蝕特性。此方法適合三維結構器件及高深寬比溝槽內的殘膠清除。
反應離子刻蝕(RIE)輔助去膠
復合效應:結合物理濺射與化學腐蝕雙重作用,CF?/Ar氣體混合物既能斷裂C-H鍵又提供橫向剝離力,適用于堅硬的化學增幅型光阻層剝離。采用脈沖式偏壓供電可減少電荷積累導致的器件損傷。
特殊應用方案
升降溫沖擊剝離法
熱力學原理:交替施加高溫烘烤(軟化光刻膠)與液氮急冷(產生收縮應力),促使整片脫落。常用于晶圓級光學元件保護層的去除,需精確控制溫差梯度以避免熱震裂紋產生。
激光輔助分解技術
前沿探索:使用UV激光照射引發光刻膠分子鍵斷裂,隨后用弱堿性溶液沖洗即可完成去除。實驗室數據顯示對EUV光阻的處理效率顯著提升,但產業化面臨設備成本高和光束均勻性待優化的挑戰。
工藝優化與監測
水平式剝離設備的應用
優勢:將基片水平放置,通過噴淋或旋轉涂覆使剝離液均勻覆蓋表面,避免重力導致的分布不均問題,減少殘留風險。白光干涉儀可用于實時監測光刻膠厚度變化及圖形形貌,確保剝離過程可控。
級聯清洗策略
流程設計:針對復雜結構或頑固殘留,采用多級浴槽依次處理(如初洗、精洗、終洗),逐步降低溶液中顆粒濃度以提高清潔度。超聲或兆聲輔助可加速反應,但需注意保護敏感結構免受機械振動影響。
參數控制要點
溫度管理:避免高溫導致正膠熱交聯(如超過140℃會降低溶解度);對于負膠則需防止后續工藝加強其交聯程度;
濃度匹配:根據光刻膠類型選擇適配的剝離液配方,確保與圖形膜無化學反應且無殘留;
干燥方式:氮氣吹掃或熱風干燥可防止水漬殘留,超臨界CO?干燥則用于高精度需求場景。
光刻膠剝離工藝的選擇需綜合考慮材料兼容性、環境負荷、成本效益及精度要求。濕法適用于通用型大面積處理,干法則側重精密結構維護;新興技術如激光剝離雖具潛力,但仍需突破產業化瓶頸。
-
材料
+關注
關注
3文章
1549瀏覽量
28672 -
半導體制造
+關注
關注
8文章
519瀏覽量
26267 -
光刻膠
+關注
關注
10文章
356瀏覽量
31811
發布評論請先 登錄
一文詳解光刻膠剝離工藝

圖形反轉工藝用于金屬層剝離的研究
Futurrex高端光刻膠
泛林集團旗下GAMMA?系列干式光刻膠剝離系統推出最新一代產品
光刻膠剝離工藝—《華林科納-半導體工藝》
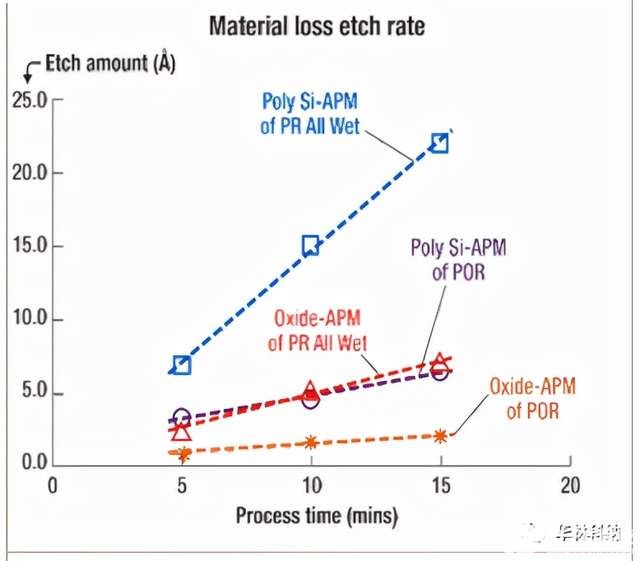
光刻膠剝離工藝的基本原理
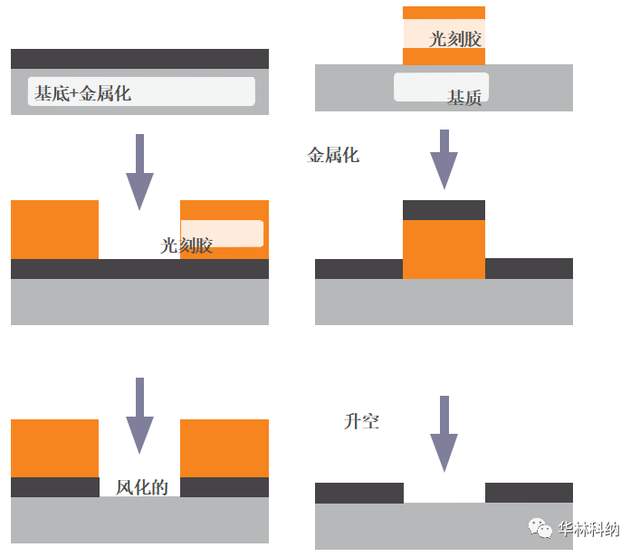
具有獨特底部輪廓的剝離光刻膠的開發
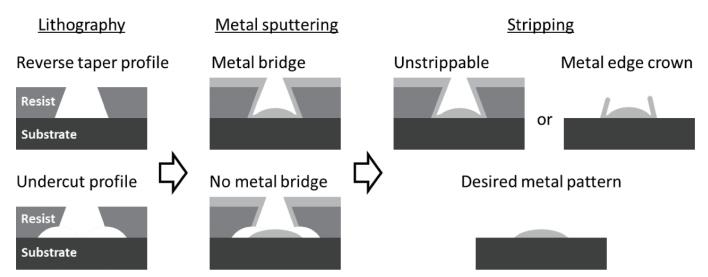
減少光刻膠剝離工藝對器件性能影響的方法及白光干涉儀在光刻圖形的測量

低含量 NMF 光刻膠剝離液和制備方法及白光干涉儀在光刻圖形的測量

用于 ARRAY 制程工藝的低銅腐蝕光刻膠剝離液及白光干涉儀在光刻圖形的測量

金屬低蝕刻率光刻膠剝離液組合物應用及白光干涉儀在光刻圖形的測量

針對晶圓上芯片工藝的光刻膠剝離方法及白光干涉儀在光刻圖形的測量




 光刻膠剝離工藝
光刻膠剝離工藝

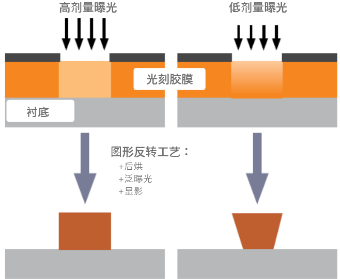




評論