引言
晶圓光刻圖形是半導體制造中通過光刻工藝形成的微米至納米級三維結構(如光刻膠線條、接觸孔、柵極圖形等),其線寬、高度、邊緣粗糙度等參數直接決定后續蝕刻、沉積工藝的精度,進而影響器件性能。傳統測量方法中,掃描電鏡需真空環境且無法直接獲取高度信息,原子力顯微鏡效率低難以覆蓋大面積檢測。白光干涉儀憑借非接觸、高精度、快速三維成像的特性,成為光刻圖形測量的核心工具,為光刻膠涂覆、曝光、顯影等工藝的參數優化提供關鍵數據支撐。
晶圓光刻圖形測量的核心需求
晶圓光刻圖形測量需滿足三項核心指標:一是亞納米級精度,線寬(10nm-5μm)和高度(50nm-2μm)的測量誤差需控制在 ±2% 以內,以評估光刻對準精度和臨界尺寸(CD)偏差;二是全參數表征,需同步獲取線寬均勻性、邊緣粗糙度(LER)、高度差、側壁傾角等參數,避免單一維度測量導致的工藝誤判;三是高效無損檢測,單片晶圓需在 5 分鐘內完成多個曝光場的掃描,且不能損傷光刻膠的化學穩定性。
接觸式測量易造成光刻膠變形(如高寬比 > 2 的細線條),光學顯微鏡僅能提供二維輪廓,均無法滿足需求。白光干涉儀的技術特性恰好適配這些測量難點。
白光干涉儀的技術適配性
高精度微納測量能力
白光干涉儀的垂直分辨率可達 0.1nm,橫向分辨率達 0.2μm,能捕捉光刻圖形 1nm 級的高度波動和 5nm 級的線寬變化。通過相移干涉算法,線寬測量重復性誤差 < 0.3%,高度測量精度 ±1nm,滿足 7nm 制程中 CD 均勻性(3σ<1.5nm)的嚴苛要求。例如,對 1μm 高的光刻膠線條,其高度測量偏差可控制在 2nm 以內。
材料兼容性與非接觸優勢
采用光學干涉原理,測量過程無物理接觸,避免了光刻膠的刮擦或化學損傷。寬光譜光源(400-700nm)可適配正性 / 負性光刻膠、SiNx 掩膜等材料,通過調整光源偏振態,能有效抑制透明基底(如石英掩模版)的反光干擾,確保光刻膠圖形信號的純凈性。
大面積掃描與自動化分析
通過精密 XY 平臺拼接掃描,可在 6 分鐘內完成 300mm 晶圓上 5mm×5mm 區域的三維成像,覆蓋數百個光刻圖形單元。結合機器視覺算法,能自動識別圖形缺陷(如線寬縮頸、邊緣鋸齒)、計算 LER(≤0.5nm)和線寬均勻性,并生成曝光場級的參數分布熱力圖,大幅提升檢測效率。
具體測量流程與關鍵技術
測量系統配置
需配備超高數值孔徑物鏡(NA=1.4)以提升橫向分辨率,同時采用低相干光源(相干長度 < 5μm)減少基底反射干擾;結合納米級壓電掃描臺(行程 50μm,步長 0.5nm)實現 Z 向精密掃描。測量前用標準光刻膠樣板(線寬 500nm,高度 1μm)校準,確保跨批次測量偏差 < 1%。
數據采集與處理流程
晶圓經真空吸附固定后,系統通過 alignment 標記自動定位至曝光場,掃描獲取干涉數據。數據處理包括三步:一是圖形分割,基于灰度閾值區分光刻膠與基底;二是參數提取,計算線寬(50% 高度處橫向尺寸)、高度(頂點 - 基底差值)、LER(邊緣偏離度);三是工藝評估,與設計值比對,標記超差區域(如線寬偏差 > 3% 的圖形)。
典型應用案例
在 7nm 邏輯芯片的柵極光刻測量中,白光干涉儀檢測出曝光場邊緣的光刻膠線條高度降低 15nm(設計高度 800nm),LER 增至 1.2nm(正常區域 < 0.8nm),推測為曝光劑量不均導致,為調整光刻機劑量分布提供依據。在極紫外(EUV)光刻膠測量中,通過反射模式有效穿透超薄光刻膠層(<50nm),清晰識別出 0.3nm 級的表面起伏。
應用中的挑戰與解決方案
超薄圖形的信號提取
對 < 50nm 的光刻膠圖形,信號強度易受基底噪聲干擾。采用鎖相放大技術可提升信噪比 10 倍以上,確保超薄圖形參數的穩定提取。
高陡度側壁的測量
光刻膠側壁傾角(通常 85°-90°)測量易因信號衰減導致誤差。通過多角度照明(±15°)和三維建模算法,可將傾角測量精度提升至 ±0.5°,滿足蝕刻轉移工藝的預評估需求。
大視野 3D 白光干涉儀:納米級測量全域解決方案
突破傳統局限,定義測量新范式!大視野 3D 白光干涉儀憑借創新技術,一機解鎖納米級全場景測量,重新詮釋精密測量的高效精密。

三大核心技術革新
1)智能操作革命:告別傳統白光干涉儀復雜操作流程,一鍵智能聚焦掃描功能,輕松實現亞納米精度測量,且重復性表現卓越,讓精密測量觸手可及。
2)超大視野 + 超高精度:搭載 0.6 倍鏡頭,擁有 15mm 單幅超大視野,結合 0.1nm 級測量精度,既能滿足納米級微觀結構的精細檢測,又能無縫完成 8 寸晶圓 FULL MAPPING 掃描,實現大視野與高精度的完美融合。
3)動態測量新維度:可集成多普勒激光測振系統,打破靜態測量邊界,實現 “動態” 3D 輪廓測量,為復雜工況下的測量需求提供全新解決方案。
實測驗證硬核實力
1)硅片表面粗糙度檢測:憑借優于 1nm 的超高分辨率,精準捕捉硅片表面微觀起伏,實測粗糙度 Ra 值低至 0.7nm,為半導體制造品質把控提供可靠數據支撐。

(以上數據為新啟航實測結果)
有機油膜厚度掃描:毫米級超大視野,輕松覆蓋 5nm 級有機油膜,實現全區域高精度厚度檢測,助力潤滑材料研發與質量檢測。

高深寬比結構測量:面對深蝕刻工藝形成的深槽結構,展現強大測量能力,精準獲取槽深、槽寬數據,解決行業測量難題。
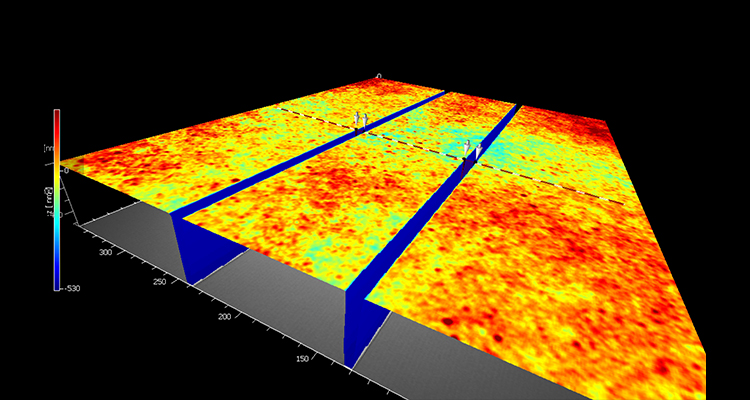
分層膜厚無損檢測:采用非接觸、非破壞測量方式,對多層薄膜進行 3D 形貌重構,精準分析各層膜厚分布,為薄膜材料研究提供無損檢測新方案。
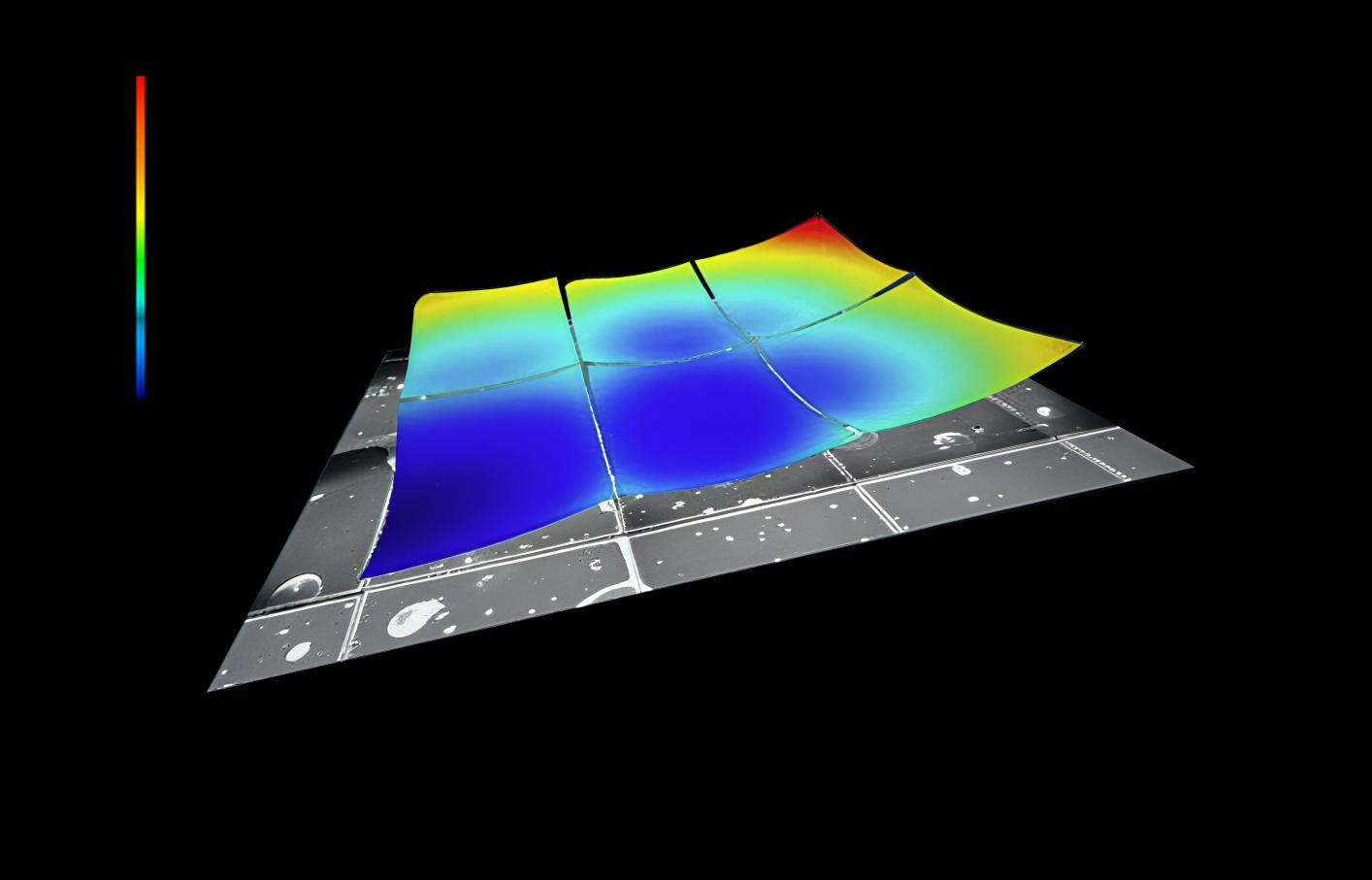
新啟航半導體,專業提供綜合光學3D測量解決方案!
審核編輯 黃宇
-
晶圓
+關注
關注
53文章
5438瀏覽量
132617 -
光刻
+關注
關注
8文章
367瀏覽量
31379
發布評論請先 登錄
晶圓表面的納米級缺陷光學3D輪廓測量-3D白光干涉儀

PLC平面光波導的圖形凹槽深度測量-3D白光干涉儀應用

納米壓印的光柵圖形形貌3D測量-3D白光干涉儀應用

白光干涉儀與激光干涉儀的區別及應用解析
Micro OLED 陽極像素定義層制備方法及白光干涉儀在光刻圖形的測量




 白光干涉儀在晶圓光刻圖形 3D 輪廓測量中的應用解析
白光干涉儀在晶圓光刻圖形 3D 輪廓測量中的應用解析





評論