電子束光刻(EBL)是一種無需掩模的直接寫入式光刻技術,其工作原理是通過聚焦電子束在電子敏感光刻膠表面進行納米級圖案直寫。該技術具有兩大顯著優(yōu)勢:一是具備超高的圖形分辨率(可實現(xiàn)<10nm的極限特征尺寸),二是支持靈活的無掩模圖形設計。然而,由于存在曝光效率較低、系統(tǒng)控制復雜等局限性,電子束光刻目前主要應用于三個領域:光刻掩模版的制作、先進原理樣機的開發(fā),以及納米尺度的科學研究與器件研制。這種技術特別適合小批量、高精度的微納結構加工需求。
發(fā)展歷史
電子束光刻(EBL)的發(fā)展歷程可追溯至20世紀初期聚焦電子束技術的起源。其技術演進與光學光刻幾乎同步,但兩者最終形成了互補并存的格局
技術雛形階段
?早期的聚焦電子束技術應用于陰極射線管(CRT)顯示器,而1960年代掃描電子顯微鏡(SEM)的出現(xiàn)奠定了電子束曝光機的基本結構框架。然而,真正的電子束光刻技術始于電子束敏感抗蝕劑的開發(fā)。
關鍵突破時期(1950s–1970s)??
1958年:麻省理工學院研究人員首次利用電子誘導碳污染形成刻蝕掩模,實現(xiàn)高分辨率二維圖形制備。
1965年:電子束曝光技術突破100nm結構加工。
1968年:PMMA被確立為電子束光刻膠,大幅推動圖形精度提升。
1970年:采用PMMA制作出0.15μm聲表面波器件。
1972年:在硅表面實現(xiàn)60nm×60nm橫截面的鋁金屬線條加工。?
1980年代,電子束光刻一度被視為光學光刻的替代方案,但因其曝光效率低、成本高等固有局限,最終未能取代光學光刻。經(jīng)過數(shù)十年發(fā)展,兩者形成明確分工:電子束光刻專注于掩模制備、納米級科研樣機開發(fā)和小批量高精度加工,而光學光刻主導大規(guī)模集成電路生產(chǎn)。
理論基礎
光刻技術的核心原理,是利用光輻照聚合物使其發(fā)生變化,進而形成所需圖形。在光學曝光中,分辨率受到光波長的顯著限制。為了突破這一限制、提高分辨率,光波的選擇經(jīng)歷了持續(xù)縮短的發(fā)展歷程,從最初的 G 線、I 線,逐步發(fā)展到深紫外,再到如今的極紫外。?

電子束從本質上來說是一種帶電粒子,根據(jù)波粒二象性理論,其波長可通過特定公式計算得出。由此可知,電子束的加速電壓越高,對應的電子束波長就越小,這一特性與電子束曝光系統(tǒng)究竟是高電壓系統(tǒng)還是低電壓系統(tǒng)直接相關。例如,在 100KV 的加速電壓系統(tǒng)下,電子波長僅為 0.12nm,這也正是電子束光刻能夠實現(xiàn)高分辨率的基礎保障。不過,傳統(tǒng)的電子束光刻采用直寫模式,這一模式是目前電子束光刻效率較低的重要原因,但它也具備顯著優(yōu)點 —— 直寫過程無需掩膜版,操作簡單且靈活性強。?
和紫外光一樣,電子束也能使部分聚合物發(fā)生化學鍵斷裂或交聯(lián)反應,從而在顯影過程中形成相應的圖形。甚至一些紫外光刻膠本身就可以當作電子束光刻膠使用,所以二者在本質上并沒有太大區(qū)別。為了加以區(qū)分,我們有時會將電子束光刻膠稱為抗蝕劑。然而,由于電子束在與物質相互作用時會產(chǎn)生散射,這使得其作用過程比紫外光刻復雜得多。
電子束曝光系統(tǒng)
電子束光刻技術起源于掃描電鏡,它是一種基于聚焦電子束掃描原理的圖形轉印技術。?
電子束光刻系統(tǒng)的構成較為復雜,主要包含 3 個基本部件和若干輔助部件。其中,基本部件為電子槍、電子透鏡和電子偏轉器;輔助部件則有真空系統(tǒng)、工件臺控制系統(tǒng)等。?
電子槍的作用是產(chǎn)生可被控制和聚焦的電子,根據(jù)工作方式的不同,通常可分為熱電子源(thermionic sources)和場發(fā)射源(field emission sources)。熱電子源的工作原理是,將陰極加熱到足夠高的溫度,使陰極材料中的電子獲得充足的動能,從而突破電子槍金屬功函數(shù)的勢壘并發(fā)射出來,形成電子束。而場發(fā)射源則是通過加強電場,讓電子隧穿勢壘來形成電子源。?
電子發(fā)射源出射的電子束,其聚焦和偏轉過程是在電子光柱體中完成的。電子光柱體由一系列電子透鏡、光闌、擋板等裝置組成。具體來說,電子先通過光闌成型,接著經(jīng)過電子透鏡會聚成束斑,再通過偏轉系統(tǒng)在工作臺上進行曝光。

電子束曝光系統(tǒng)的重要指標
電子束曝光系統(tǒng)有多項重要指標,具體如下:?
最小束直徑:它直接影響曝光圖形的最小尺寸。若想獲得更小的束斑直徑,可通過以下措施調整:①設置盡量高的加速電壓;②采用較小尺寸的光闌孔徑;③采用小的工作距離;④設置小的掃描場;⑤設置小的曝光步長。?
加速電壓:其數(shù)值一般在 10~100kv 之間。加速電壓越高,系統(tǒng)的分辨率就越高,曝光產(chǎn)生的鄰近效應也越小,同時還能夠曝光更厚的抗蝕劑。?
電子束流:束流越大,曝光速度就越快,但最大曝光速度會受到掃描頻率的限制,而且大束流對應的束斑也會較大。?
掃描速度:掃描速度越快,曝光速度也就越快,通常以頻率來表示(例如:50MHz)。?
掃描場大小:若掃描場較大,那么曝光圖形的大部分就可以在掃描場內完成曝光,從而避免因掃描場拼接而引起的誤差。?
此外,還有工作臺移動精度、套準精度、場拼接精度等指標也較為重要。
電子束曝光方式分類
電子束曝光方式可從不同角度進行分類,具體如下:?
按工作方式,可分為投影式曝光和直寫式曝光。其中,投影式曝光需要掩模,而直寫式曝光則不需要掩模。
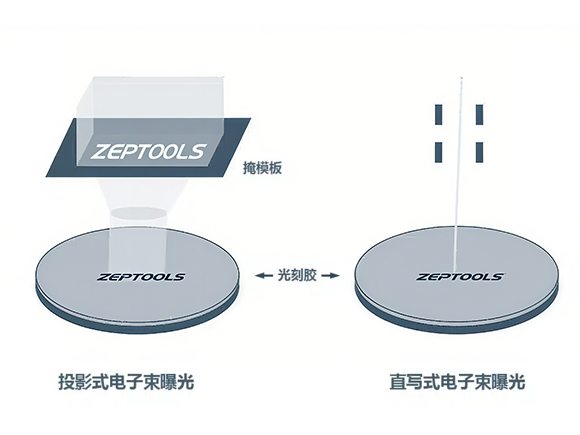
按掃描方式,可分為光柵掃描(raster scan)和矢量掃描(vector scan)。光柵掃描采用高斯圓形束,電子束在整個掃描場里作連續(xù)逐點掃描,通過控制快門(束閘)的通斷來進行圖形的曝光。它的優(yōu)點是控制簡單,不需對偏轉系統(tǒng)進行控制;但缺點是生產(chǎn)效率低,且由于掃描場的范圍較小,必須配合工件臺的移動來完成曝光。矢量掃描的優(yōu)點是曝光效率高,只在有圖形區(qū)域進行掃描曝光,減少了鏡頭在非圖形區(qū)域所花費的時間,而且可采用可變矩形束;不過其缺點是控制系統(tǒng)復雜,因為矢量掃描必須對偏轉器進行控制,不像光柵掃描那樣采用固定的偏轉方式。?
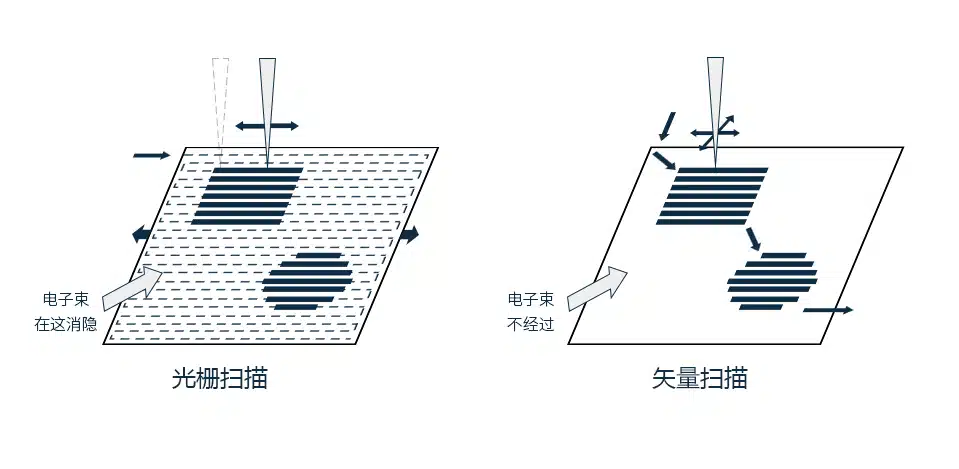
按電子束形狀,可分為高斯束(圓形束)和變形電子束(矩形束)。在矢量掃描模式下,圖形的曝光時間與束斑投射次數(shù)有關,在固定高斯束(圓形束)斑模式下,需要進行 24 次投射。?
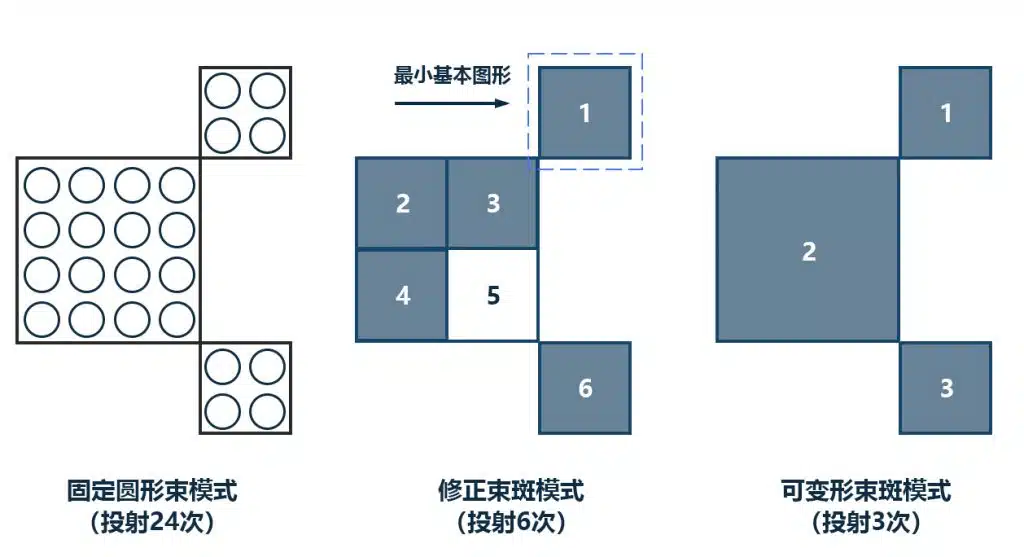
為了加快曝光速率,可將圖形分解為最小基本圖形的組合,以最小基本圖形作為電子束斑的形狀。在這種修正束斑模式下,只需 6 次投射即可。但在實際生產(chǎn)過程中,圖形并非一成不變,需要經(jīng)常重設基本束斑形狀,因此需要一種更加靈活的投射方式。一種束斑可變的模式能夠應用于圖形多樣化的情況,如下圖所示,在可變束斑模式下,電子束斑可根據(jù)具體的圖形進行調整,改變束斑的基本形狀,從而將投射次數(shù)減少到 3 次。
電子束光刻膠介紹
光刻膠(Photoresist,又稱光致抗蝕劑)是一種耐刻蝕薄膜材料,它在紫外光、準分子激光、電子束、離子束、X 射線等光源的照射或輻射下,溶解度會發(fā)生變化。?
電子束光刻膠是光刻膠的一種,通常可分為正性光刻膠和負性光刻膠,其分類依據(jù)是光刻膠在受到照射后,交聯(lián)反應和化學鍵斷裂這兩種反應中哪種占主導地位。不過,光刻膠的正負特性并非絕對,例如電子束正膠 PMMA,當受到 10 倍正常曝光劑量的照射時,曝光區(qū)域的膠會發(fā)生碳化,在顯影過程中會殘留下來,此時它的特性就可以當作負膠來使用。?
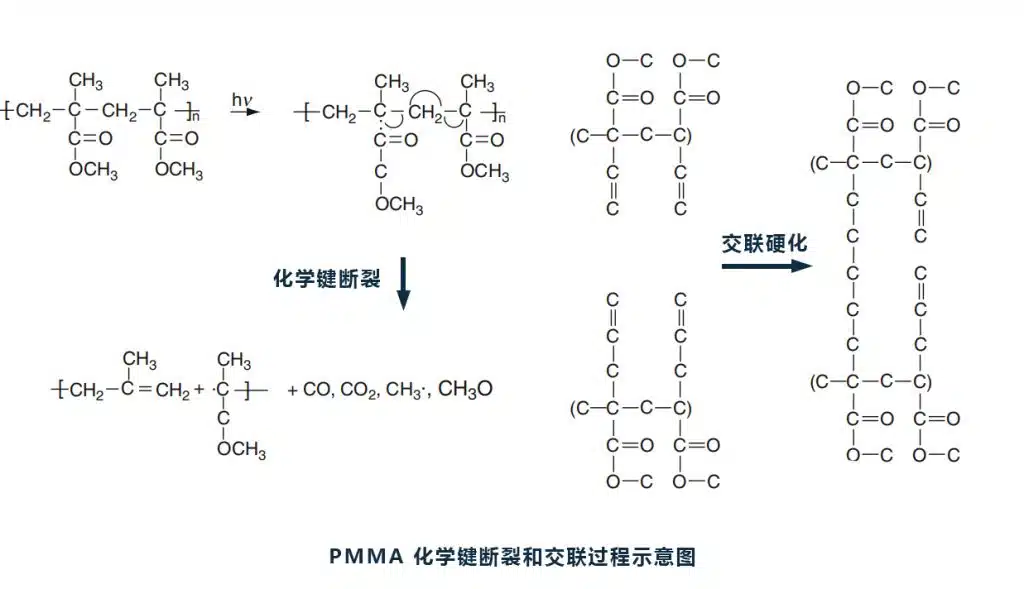
正性光刻膠(簡稱正膠)的特點是,在曝光區(qū)域,光刻膠中的化學鍵斷裂反應占主導,使得該區(qū)域的光刻膠容易溶解于顯影液。?
負性光刻膠(簡稱負膠)則不同,在曝光區(qū)域,光刻膠中的交聯(lián)反應占主導,小分子會通過交聯(lián)聚合形成大分子,從而導致該區(qū)域的光刻膠難以溶解于顯影液。

光刻膠的關鍵參數(shù)
紫外光刻膠類似,我們在選擇或評價一款光刻膠在工藝中的應用時,通常會參考以下四個關鍵參數(shù):靈敏度、對比度、分辨率和抗蝕刻性。?
靈敏度:光刻膠的靈敏度越高,所需的曝光劑量(照射量)就越小。其靈敏度會受到電子能力 keV(或加速電壓 kV)、基底材料、工藝條件、使用的顯影劑等多種因素的影響。?
對比度:高對比度的光刻膠能夠獲得更陡的側壁,提供更大的加工余地,實現(xiàn)更好的分辨率和更高縱橫比的結構,同時使其對鄰近效應不太敏感,圖案密度也更高。而低對比度的光刻膠僅適用于 3D 灰度光刻。?
分辨率:該參數(shù)定義了能夠獲得的最小特征的大小,或者兩個結構之間的最小距離。?
抗刻蝕性:如果后續(xù)工藝中有刻蝕需求,應選擇能在化學(濕)刻蝕和物理(干)刻蝕過程中保持自身完整特性的光刻膠。?
此外,在選擇適合的光刻膠時,還需要結合光刻膠的正負特性、工藝寬容度、附著力、熱流動性、膨脹效應、儲存壽命等參數(shù)綜合考慮。
常用的光刻膠
針對不同的應用場景,需要采用不同的光刻膠。本節(jié)主要介紹實驗中常用的幾種電子束光刻膠,包括正膠 PMMA、ZEP-520A、AR-P 6200(SCAR62)以及負膠 HSQ。?
PMMA(正膠)?
PMMA(poly-methyl methacrylate,聚甲基丙烯酸甲酯)是一種高分子聚合物,又稱亞克力或有機玻璃,是目前應用最廣泛的電子束光刻膠。將 5%~10% 的 PMMA 粉末與氯苯或苯甲醚(毒性較小,濃度為 2-4%)充分混合,即可制成 PMMA 光刻膠。?
它具有便宜、耐用、易操作的特點,同時擁有非常高的分辨率和對比度,但靈敏度較低,且耐干刻蝕性差(這一特性有利于剝離 lift-off 工藝,卻不適合直接刻蝕的圖案轉移)。其靈敏度會隨相對分子質量的減小而增加,PMMA 典型的相對分子質量有 495 kg/mol 和 950 kg/mol。另外,對比度和靈敏度可通過改變顯影劑混合物(MIBK:IPA)中 MIBK 的比例來調控,靈敏度會隨顯影劑中 MIBK 比例的增加而增加,而對比度則相反。?
Zep-520A(正膠)?
Zep-520A 是最受歡迎的商用光刻膠,由日本 Nippon Zeon 開發(fā)。它是一種 PMMA 加苯環(huán)的改性膠,由 α- 氯甲基丙烯酸酯(α-chloromethacrylate)和 α- 甲基苯乙烯(α-methylstyrene)的共聚物組成,常用于替代 PMMA。?
該光刻膠具有高分辨率和高對比度,能實現(xiàn) 10-30nm 的圖形結構,分辨率與 PMMA 相當;同時擁有比 PMMA 更高的靈敏度(為其 3~5 倍)和高抗干刻蝕性(相較 PMMA 有 5 倍以上的抗干刻蝕性能)。不過,它價格較貴,保質期為一年。需要注意的是,對于超高分辨率(亞 10nm)的需求,使用 PMMA 可能更好。此外,ZEP-520A 在曝光、顯影和堅膜烘烤后不容易去除,通常采用 ZDMAC 進行去膠。?
AR-P 6200 (CSAR62) (正膠)?
AR-P 6200 (CSAR62) 具有超高分辨率(<10nm)和高靈敏度,且靈敏度可通過選擇合適的顯影液來調控,同時具備高對比度(>15)和高深寬比(可達 20:1)。?
它還具有良好的工藝穩(wěn)定性和抗干刻蝕性,抗干刻蝕性是 PMMA 的 2 倍;與基片的粘著力好,不易發(fā)生脫膠和龜裂現(xiàn)象。但也存在一些缺點,如楊氏模量偏低,容易出現(xiàn)坍塌、粘連、倒覆的情況;熔點較低,會產(chǎn)生抗蝕劑熔融現(xiàn)象;圖形表面易發(fā)生收縮現(xiàn)象。?
HSQ(負膠)?
HSQ 由 Dow Corning 開發(fā),其成分是基于二氧化硅的無機類化合物,由甲基異丁基酮 (methylisobutylketone, MIBK) 極性溶劑中的含氫硅酸鹽類 (hydrogen silsesquioxane ,HSQ) 樹脂構成。?
HSQ 具有極高的分辨率(<10nm),但靈敏度低,曝光時間長。它通過化學反應進行顯影(未曝光的 HSQ 與稀釋的 NH4OH 或 NaOH 顯影劑反應生成 H2),而非通過溶解顯影,顯影后的工藝穩(wěn)定性好。此外,它在電子顯微鏡下的觀察性能好,不需要鍍金,是很好的刻蝕硅的掩模材料。?
不過,HSQ 的保質期較短,存放周期只有 6 個月,而粉末狀的 HSQ(H-SiOx)保質期會更長。其保存條件也較為苛刻,膠體暴露在空氣中易被氧化,出現(xiàn)膠凍固化現(xiàn)象,需要在低溫(5℃)下密封保存。同時,它具有極高反差,容易制備剖面陡直的高高寬比結構,屬于伸縮性光刻膠,顯影后線條邊緣垂直度好,且粘附力好、韌性好、不容易斷裂。
領近效應
電子束曝光的鄰近效應,指的是當兩個曝光圖形距離較近時,由于電子在光刻膠和襯底中發(fā)生散射,導致電子偏離原本的入射方向。這會使得原本不應曝光的鄰近區(qū)域被曝光,而一些應該曝光的區(qū)域卻得不到足夠的曝光量,最終造成曝光圖形發(fā)生畸變,進而帶來對比度降低、分辨率下降等問題。?
校正方式?
鄰近效應的校正主要有三種方法:①劑量校正;②圖形尺寸補償;③背景曝光補償。?
劑量校正是應用最普遍且效果最好的一種方法,其原理是通過人為調控,讓所有曝光圖形都獲得均勻一致的曝光能量。劑量校正又可分為自洽技術(物理校正)和幾何圖形切割法。其中,自洽技術(物理校正)的校正結果比較精準,但對于大規(guī)模集成電路設計而言,計算量較大;幾何圖形切割法計算得到的曝光劑量分布相對粗糙,不過計算速度非常快。?
圖形尺寸補償則是通過縮小或增大每個圖形的尺寸,來補償局部能量過高或過低造成的影響,這種方法適用于簡單且周期重復的圖形。?
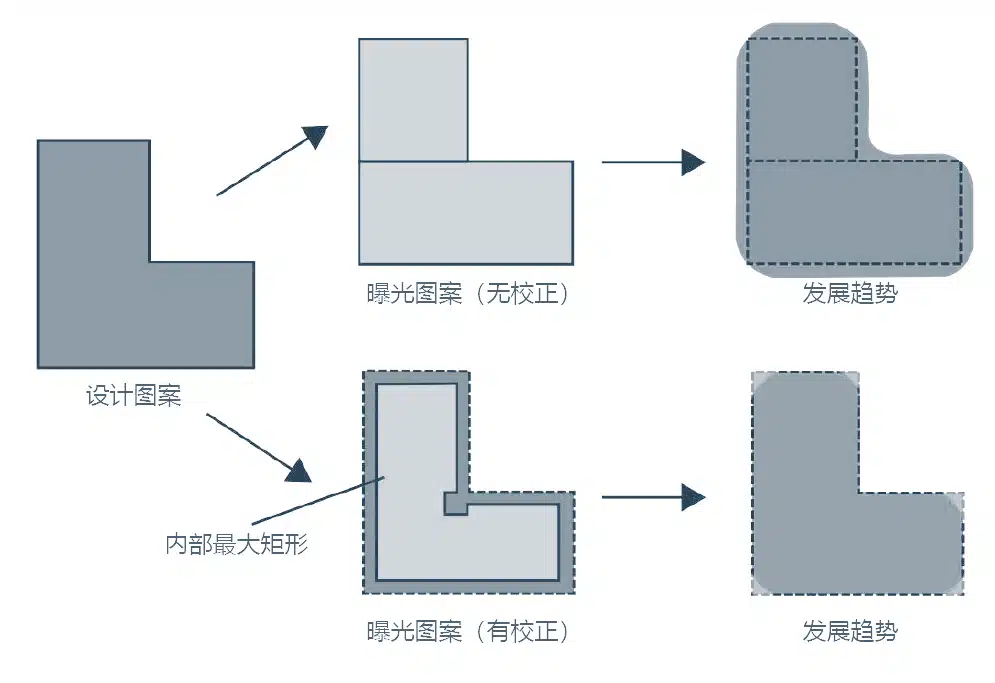
背景曝光補償是通過二次曝光的能量疊加,使各處的能量分布達到均衡。該方法不需要計算能量分布,但可能會導致曝光圖形的對比度有所下降,適用于光柵掃描曝光系統(tǒng)。?
此外,最簡單且有效的減少鄰近效應的方法是提高電子束能量和減少電子束光刻膠厚度,但需要考慮到高電子束能量可能會對基底造成損傷和導致過熱的問題。

應用案例
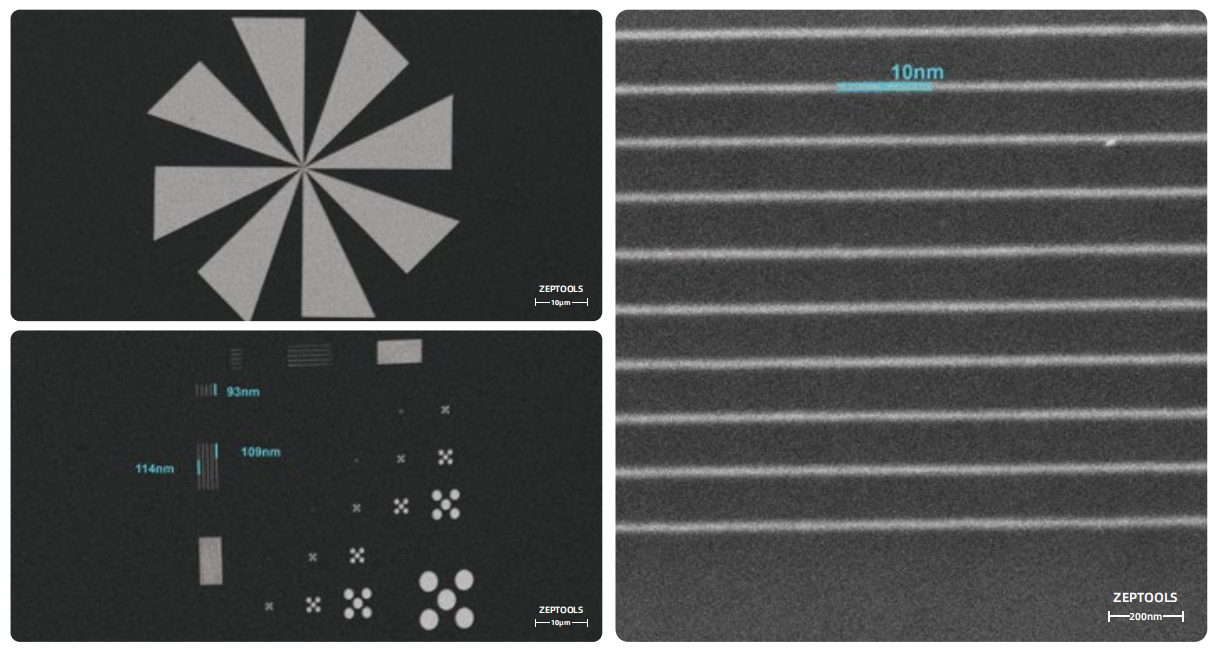 大寫場測試(左)最小線寬展示(右)
大寫場測試(左)最小線寬展示(右)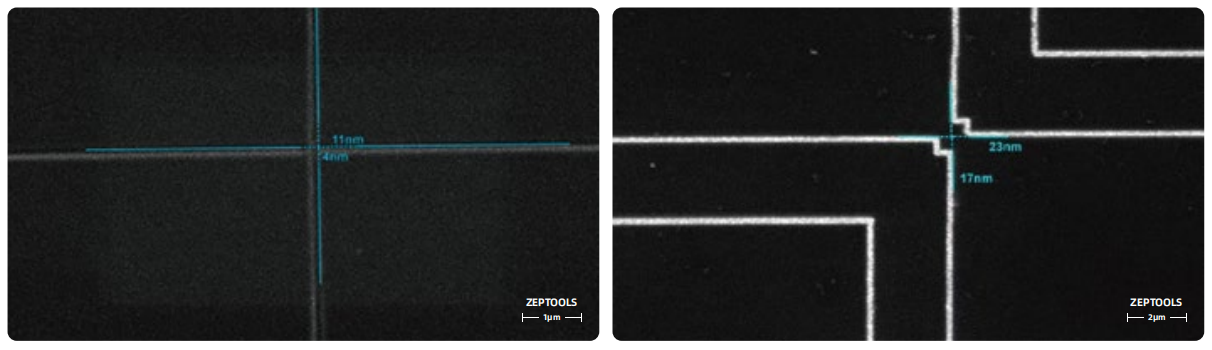 場拼接精度測試(左)套刻精度測試(右)
場拼接精度測試(左)套刻精度測試(右) HSQ膠
HSQ膠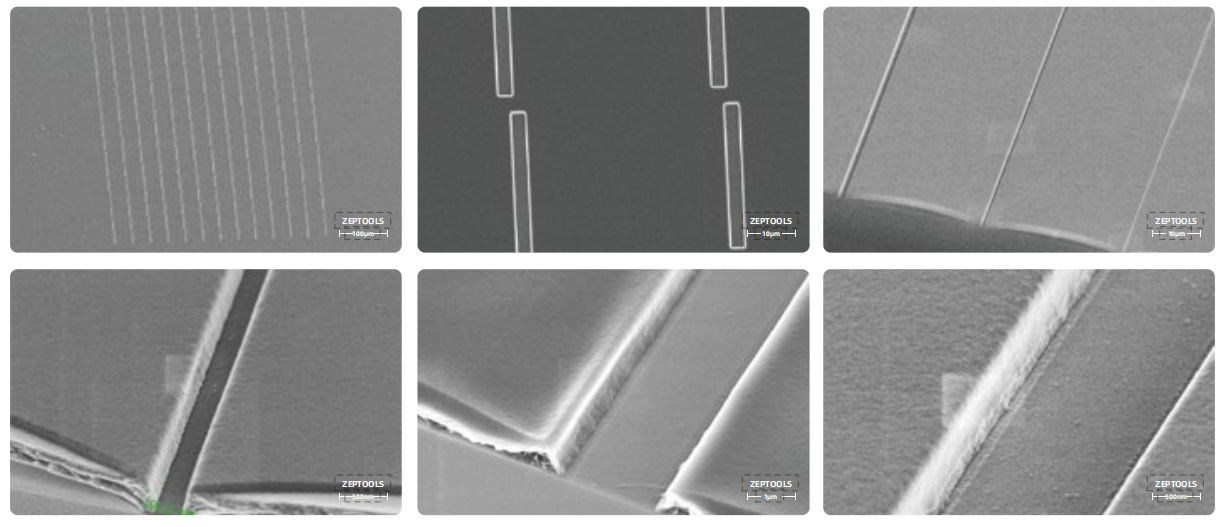 厚膠測試
厚膠測試 澤攸科技EBL電子束光刻機
澤攸科技EBL電子束光刻機 -
電子束
+關注
關注
2文章
135瀏覽量
14057 -
光刻機
+關注
關注
31文章
1199瀏覽量
48969
發(fā)布評論請先 登錄
今日看點丨全國首臺國產(chǎn)商業(yè)電子束光刻機問世;智元機器人發(fā)布行業(yè)首個機器人世界模型開源平臺

現(xiàn)代焊接技術中的電子束焊接技術
MIT實現(xiàn)9納米工藝電子束光刻技術
如何進行電子束光刻中的相互鄰近效應校正技術研究與分析

美國公司Zyvex使用電子束光刻制造出0.7nm芯片
氦質譜檢漏儀電子束***檢漏

德累斯頓工廠的電子束光刻系統(tǒng)
新思科技x Multibeam推出業(yè)界首款可量產(chǎn)電子束光刻系統(tǒng) 無需掩膜
電子束光刻技術實現(xiàn)對納米結構特征的精細控制
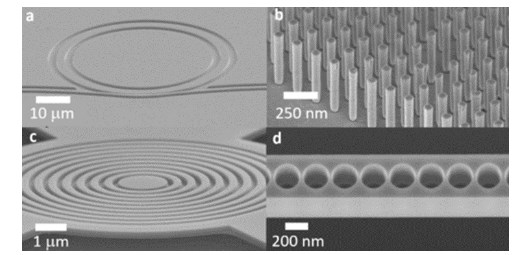
泊蘇 Type C 系列防震基座在半導體光刻加工電子束光刻設備的應用案例-江蘇泊蘇系統(tǒng)集成有限公司




 澤攸科技 | 電子束光刻(EBL)技術介紹
澤攸科技 | 電子束光刻(EBL)技術介紹

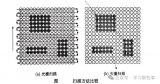
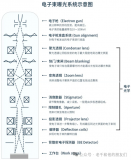
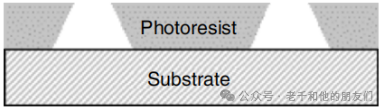




評論