【博主簡介】本人“愛在七夕時(shí)”,系一名半導(dǎo)體行業(yè)質(zhì)量管理從業(yè)者,旨在業(yè)余時(shí)間不定期的分享半導(dǎo)體行業(yè)中的:產(chǎn)品質(zhì)量、失效分析、可靠性分析和產(chǎn)品基礎(chǔ)應(yīng)用等相關(guān)知識。常言:真知不問出處,所分享的內(nèi)容如有雷同或是不當(dāng)之處,還請大家海涵。當(dāng)前在各網(wǎng)絡(luò)平臺上均以此昵稱為ID跟大家一起交流學(xué)習(xí)!

芯片是業(yè)內(nèi)外認(rèn)識避不開的話題。而光刻膠(PR)是芯片八大核心材料之一。據(jù)統(tǒng)計(jì),光刻膠(PR)在半導(dǎo)體晶圓制造材料價(jià)值占比5%,光刻膠(PR)輔助材料占比7%,二者合計(jì)占比12%,光刻膠(PR)及輔助材料是繼硅片、電子特氣和光掩模之后的第四大半導(dǎo)體材料。
而嚴(yán)格來說,在芯片制造這場微觀世界的雕刻盛宴中,光刻膠(PR)如同一位技藝精湛的工匠手中的隱形畫筆,在硅片這片“晶圓畫布”上勾勒出億萬個(gè)晶體管組成的復(fù)雜電路。然而,這支“畫筆”卻成了中國芯片產(chǎn)業(yè)最難突破的瓶頸之一:
全球高端光刻膠(PR)市場93%的份額被日本企業(yè)壟斷,我國KrF、ArF、EUV等高端光刻膠(PR)自給率不足5%。更嚴(yán)峻的是,光刻膠(PR)保質(zhì)期僅6-12個(gè)月,無法囤貨,中芯國際、長江存儲等頭部晶圓廠隨時(shí)面臨斷供停產(chǎn)風(fēng)險(xiǎn)。

一、光刻膠(PR)的起源
光刻開始于一種稱作光刻膠(PR)的感光性液體的應(yīng)用。圖形能被映射到光刻膠(PR)上,然后用一個(gè)developer就能做出需要的模板圖案。光刻膠(PR)溶液通常被旋轉(zhuǎn)式滴入wafer。wafer被裝到一個(gè)每分鐘能轉(zhuǎn)幾千轉(zhuǎn)的轉(zhuǎn)盤上。幾滴光刻膠(PR)溶液就被滴到旋轉(zhuǎn)中的wafer的中心,離心力把溶液甩到表面的所有地方。光刻膠(PR)溶液黏著在wafer上形成一層均勻的薄膜。多余的溶液從旋轉(zhuǎn)中的wafer上被甩掉。薄膜在幾秒鐘之內(nèi)就縮到它最終的厚度,溶劑很快就蒸發(fā)掉了,wafer上就留下了一薄層光刻膠(PR)。最后通過烘焙去掉最后剩下的溶劑并使光刻膠(PR)變硬以更后續(xù)處理。鍍過膜的wafer對特定波成的光線很敏感,特別是紫外(UV)線。相對來說他們?nèi)耘f對其他波長的,包括紅,橙和黃光不太敏感。所以大多數(shù)光刻車間有特殊的黃光系統(tǒng)。

二、光刻膠(PR)的發(fā)展歷史
1826年,法國人涅普斯(J. N. Niepce)最先發(fā)現(xiàn)了具有感光性的天然瀝青,使用低黏度優(yōu)質(zhì)瀝青涂覆玻璃板,預(yù)干后,置于相機(jī)暗盒內(nèi),開啟曝光窗,經(jīng)光學(xué)鏡頭長時(shí)間曝光后,瀝青涂層感光逐漸交聯(lián)固化,形成潛像,再經(jīng)溶劑松節(jié)油清洗定影,獲得最早的瀝青成像圖案。
1832年,德國人舒柯(G. Suckow)發(fā)現(xiàn)重鉻酸鹽在明膠等有機(jī)物中具有感光性。
1839年,英國人龐頓(S. M. Ponton)首先將重鉻酸鹽用于照相研究。
1850年,英國人塔爾博特(F. Talbot)將重鉻酸鹽與明膠混合后涂在鋼板上制作照相凹版獲得了成功。
19世紀(jì)中葉,德國人格里斯(J. P. Griess)合成出芳香族重氮化合物,并發(fā)現(xiàn)重氮化合物不但遇熱不穩(wěn)定,而且對光照也不穩(wěn)定。
1884年,德國人韋斯特(West)首先利用重氮化合物的感光性顯示出影像。
1890年。德國人格林(Green)和格羅斯(Gross)等人將重氮化的混合物制成感光材料。取得了第一個(gè)重氮感光材料的專利。不久,德國的卡勒(Kalle)公司推出了重氮印相紙,從而使重氮感光材料商品化,并逐漸代替了鐵印相技術(shù)。
1921年,美國人畢勃(M. C. Beeb)等人將碘仿與芳香胺混合在一起,用紫外光照射得到染料像,稱它為自由基成像體系。
1925年,美國柯達(dá)(Eastman-Kodak)公司發(fā)現(xiàn)了聚乙烯醇和肉桂酸酯在紫外光下有很強(qiáng)的交聯(lián)反應(yīng)并且感光度很高,隨后用于光學(xué)玻璃的光柵蝕刻,成為光刻膠的先驅(qū)。
1942年,英國Eisler發(fā)明印刷電路板 [39],重鉻酸鹽感光材料作為光敏抗蝕劑用于制造印刷線路板。重鉻酸在紫外光作用下還原成三價(jià)鉻離子,三價(jià)鉻離子可和水溶性聚合物中的羰基、胺基、羥基等作用形成不溶的配位絡(luò)合物。
1943年,美國杜邦公司提交了世界第一份有關(guān)光引發(fā)劑的發(fā)明專利,盡管這種二硫代氨基甲酸酯化合物感光活性較低,后來也未能轉(zhuǎn)化為實(shí)際應(yīng)用,但確實(shí)開啟了一種全新的聚合物材料加工技術(shù)。
1948年,美國專利中出現(xiàn)第一個(gè)光固化油墨配方和實(shí)施技術(shù)的專利。
1949年德國Kalle公司首先開發(fā)成功紫外正性光刻膠。
1954年,由柯達(dá)公司的明斯克(L. M. Minsk)等人研究成功的光敏劑增感的聚乙烯醇肉桂酸酯成為第一個(gè)光固化性能的光刻膠 [39],牌號KPR。先用于印刷工業(yè),后用于電子工業(yè)。
1958年,柯達(dá)公司發(fā)展出了疊氮-橡膠系的負(fù)性光刻膠 ,牌號為KMER和KTFR。
1960年,出現(xiàn)鄰重氮萘醌-酚醛樹脂紫外正性光刻膠 。
1968年美國IBM公司的Haller等人發(fā)明聚甲基丙烯酸甲酯電子束光刻膠。
1973年由Bell實(shí)驗(yàn)室和Bowden發(fā)明聚烯砜類電子束光刻膠。
1976年,美國麻省理工學(xué)院的H. Smith提出X射線曝光技術(shù)。
1989年,日本科學(xué)家Kinoshita提出極紫外光刻技術(shù)(EUVL)。
1990年后,開始出現(xiàn)248 nm化學(xué)增幅型光刻膠。
1992年,IBM使用甲基丙烯酸異丁酯的聚合物作為化學(xué)增幅的193 nm光刻膠材料。同年Kaimoto等也發(fā)現(xiàn)了非芳香性的抗蝕刻劑,而且在193 nm有較好的透光性 。
20世紀(jì)90年代中期,美國明尼蘇達(dá)大學(xué)納米結(jié)構(gòu)實(shí)驗(yàn)室提出了一種叫做“納米壓印成像”(nanoimprint lithography)的新技術(shù)。
1996年,歐洲主要成立了4個(gè)極紫外光刻相關(guān)研究項(xiàng)目,約110個(gè)研究單位參與,其中比較重要的項(xiàng)目為MEDEA和MORE MOORE。
1997年,Intel公司成立了包括AMD、Motorola、Micron、Infineon和IBM的EUV LLC,并與由LBNL、LLNL和SNL組成的國家技術(shù)實(shí)驗(yàn)室(VNL)簽訂了極紫外光刻聯(lián)合研發(fā)協(xié)議(CRADA)。
1998年,日本開始極紫外光刻研究工作,并于2002年6月成立極紫外光刻系統(tǒng)研究協(xié)會(EUVA) 。
1962年,中國北京化工廠接受中國科學(xué)院半導(dǎo)體研究所的委托,著手研究光刻膠,以吡啶為原料,采用熱法工藝,制成聚乙烯醇肉桂酸酯膠。
1967年,中國第一個(gè)KPR型負(fù)性光刻膠投產(chǎn)。
1970年,103B型、106型兩種負(fù)膠投產(chǎn),環(huán)化橡膠系負(fù)膠BN-302、BN-303也相繼開發(fā)成功。
2018年5月24日,國家科技重大專項(xiàng)(02專項(xiàng))極紫外光刻膠項(xiàng)目順利通過國家驗(yàn)收。
2018年5月30日,國家科技重大專項(xiàng)“極大規(guī)模集成電路制造裝備與成套工藝”專項(xiàng)(02專項(xiàng))項(xiàng)目“極紫外光刻膠材料與實(shí)驗(yàn)室檢測技術(shù)研究”,經(jīng)過項(xiàng)目組全體成員的努力攻關(guān),完成了EUV光刻膠關(guān)鍵材料的設(shè)計(jì)、制備和合成工藝研究、配方組成和光刻膠制備、實(shí)驗(yàn)室光刻膠性能的初步評價(jià)裝備的研發(fā),達(dá)到了任務(wù)書中規(guī)定的材料和裝備的考核指標(biāo)。
2019年11月25日,8種“光刻膠及其關(guān)鍵原材料和配套試劑”入選工信部《重點(diǎn)新材料首批次應(yīng)用示范指導(dǎo)目錄(2019年版)》 。

三、光刻膠(PR)的介紹
光刻膠,英文全稱:Photoresist,簡稱:PR,也稱為光致抗蝕劑。光刻膠(PR)是一種對光敏感的混合液體,是微電子技術(shù)中微細(xì)圖形加工的關(guān)鍵材料。它由光引發(fā)劑(光增感劑、光致產(chǎn)酸劑)、光刻膠(PR)樹脂、溶材料劑、單體(活性稀釋劑)和其他助劑組成。

四、光刻膠(PR)的成分組成
光刻膠是一種對光敏感的混合液體,主要由以下部分組成:
1、基體材料
通常為樹脂,一種惰性的聚合物,是用于粘合光刻膠中的不同成分,構(gòu)成光刻膠(PR)的基本骨架,決定其機(jī)械性能和化學(xué)穩(wěn)定性。提高光刻膠的化學(xué)抗腐蝕性能和膠膜厚度等基本性能。
2、感光化合物(PAC)
控制光刻膠在曝光前后的溶解性變化。
3、正性光刻膠
PAC在曝光前抑制溶解,曝光后促進(jìn)溶解。
4、負(fù)性光刻膠
PAC在曝光后引發(fā)交聯(lián)反應(yīng),使曝光區(qū)域不溶解。
5、溶劑
調(diào)節(jié)光刻膠的黏滯性,溶解光刻膠的各種組成成分,確保其在涂覆時(shí)保持液體狀態(tài),并均勻成膜,也是后續(xù)光刻化學(xué)反應(yīng)的介質(zhì)。

五、光刻膠(PR)基礎(chǔ)知識分享
以下就是本章節(jié)要跟大家分享的:半導(dǎo)體芯片材料“光刻膠(Photoresist)”基礎(chǔ)知識培訓(xùn)的內(nèi)容,如有遺漏或是不足之處,希望大家見諒,分享內(nèi)容如下:
















http://weixin.qq.com/r/QhAjO9TE64mUrZBY90VQ (二維碼自動(dòng)識別)
因?yàn)楸綪PT章節(jié)太多,剩下部分如有朋友有需要,可私信我邀請您加入我“知識星球”免費(fèi)下載PDF版本。注意:此資料只可供自己學(xué)習(xí),不可傳閱,平臺有下載記錄,切記!歡迎加入后一起交流學(xué)習(xí)。

六、光刻膠(PR)的主要技術(shù)參數(shù)
1、分辨率(resolution)
區(qū)別硅片表面相鄰圖形特征的能力。一般用關(guān)鍵尺寸(CD,Criical Dimension)來衡量分辨率。形成的關(guān)鍵尺寸越小,光刻膠(PR)的分辨率越好。
2、對比度(Contrast)
指光刻膠(PR)從曝光區(qū)到非曝光區(qū)過渡的陡度。對比度越好,形成圖形的側(cè)壁越陡峭,分辨率越好。
3、敏感度(Sensitivity)
光刻膠(PR)上產(chǎn)生一個(gè)良好的圖形所需一定波長光的最小能量值(或最小曝光量)。單位:毫焦/平方厘米或mJ/cm2。光刻膠(PR)的敏感性對于波長更短的深紫外光(DUV)、極深紫外光(EUV)等尤為重要。
4、粘滯性/黏度(Viscosiy)
衡量光刻膠(PR)流動(dòng)特性的參數(shù)。粘滯性隨著光刻膠(PR)中的溶劑的減少而增加;高的粘滯性會產(chǎn)生厚的光刻膠(PR);越小的粘滯性,就有越均勻的光刻膠(PR)厚度。光刻膠(PR)的比重(SG,Specifc Gravitvy)是衡量光刻膠(PR)的密度的指標(biāo)。它與光刻膠(PR)中的固體含量有關(guān)。較大的比重意味著光刻膠(PR)中含有更多的固體,粘滯性更高、流動(dòng)性更差。粘度的單 位:泊(poise),光刻膠(PR)一般用厘泊(cps,厘泊為1%泊)來度量。百分泊即厘泊為絕對粘滯率;運(yùn)動(dòng)粘滯率定義為:運(yùn)動(dòng)粘滯率=絕對粘滯率/比重。 單位:百分斯托克斯(cs)=cps/SG。
5、粘附性(Adherence)
表征光刻膠(PR)粘著于襯底的強(qiáng)度。光刻膠(PR)的粘附性不足會導(dǎo)致硅片表面的圖形變形。光刻膠(PR)的粘附性必須經(jīng)受住后續(xù)工藝(刻蝕、離子注入等)。
6、抗蝕性(Anti-etching)
光刻膠(PR)必須保持它的粘附性,在后續(xù)的刻蝕工序中保護(hù)襯底表面。耐熱穩(wěn)定性、抗刻蝕能力和抗離子轟擊能力。
7、表面張力(Suface Tension)
液體中將表面分子拉向液體主體內(nèi)的分子間吸引力。光刻膠(PR)應(yīng)該具有比較小的表面張力,使光刻膠(PR)具有良好的流動(dòng)性和覆蓋。
8、存儲和傳送(Storage and Transmision)
能量(光和熱)可以激活光刻膠(PR)。應(yīng)該存儲在密閉、低溫、不透光的盒中。同時(shí)必須規(guī)定光刻膠(PR)的閑置期限和存貯溫度環(huán)境。一旦超過存儲時(shí)間或較高的溫度范圍,負(fù)膠會發(fā)生交聯(lián),正膠會發(fā)生感光延遲。

七、光刻膠(PR)的分類
光刻膠(PR)并非單一產(chǎn)品,而是一個(gè)龐大的家族。
1、根據(jù)光刻膠按照如何響應(yīng)紫外光的特性可以分為兩類:負(fù)性光刻膠和正性光刻膠。

a. 負(fù)性光刻膠(Negative Photo Resist)
最早使用,一直到20世紀(jì)70年代。曝光區(qū)域發(fā)生交聯(lián),難溶于顯影液。
原理:曝光區(qū)域PAC引發(fā)交聯(lián)反應(yīng),形成不溶性網(wǎng)狀結(jié)構(gòu),未曝光部分溶解。
特性:良好的粘附能力、良好的阻擋作用、感光速度快;顯影時(shí)發(fā)生變形和膨脹。所以只能用于2um的分辨率。
應(yīng)用場景:厚膜光刻、特殊封裝工藝。

b. 正性光刻膠(Positive Photo Resist)
20世紀(jì)70年代,有負(fù)性轉(zhuǎn)用正性。正性光刻膠的曝光區(qū)域更加容易溶解于顯影液。
原理:曝光區(qū)域PAC發(fā)生光化學(xué)反應(yīng),從抑制劑變?yōu)榇龠M(jìn)劑,使曝光部分溶于顯影液
特性:分臺階覆蓋好、對比度好;粘附性差、抗刻蝕能力差、高成本。辨率高。
主流應(yīng)用:先進(jìn)芯片制造(如邏輯電路、存儲器)、微機(jī)電系統(tǒng)(MEMS)。

正膠與負(fù)膠優(yōu)缺點(diǎn)的對比:

正膠與負(fù)膠的區(qū)別:
負(fù)膠是最早使用,一直到20世紀(jì)70年代。特性為,具有良好的粘附能力和阻擋作用、感光速度快;顯影時(shí)發(fā)生變形和膨脹,所以只能用于2μm的分辨率。
負(fù)膠顯影中保留部分的膠會吸收顯影液,造成光刻膠的變相“膨脹”,從而使圖形扭曲,一般分辨率只能達(dá)到光刻膠厚度的2-3倍;而正膠在顯影過程中則不會吸收顯影液,從而獲得較高的分辨率!
20世紀(jì)70年代,有負(fù)性轉(zhuǎn)用正性。正膠具有很好的對比度,所以生成的圖形具有良好的分辨率,其他特性如,臺階覆蓋好、對比度好;粘附性差、抗刻蝕能力差、高成本。
現(xiàn)在最小尺寸小于3um一般都會用正膠!
目前一般都是用正膠,對于線寬要求不高的時(shí)候或者一些特殊的用途(比如PSS等)可以選擇負(fù)膠。

2、根據(jù)光刻膠能形成圖形的最小光刻尺寸來分:傳統(tǒng)光刻膠和化學(xué)放大光刻膠。
a. 傳統(tǒng)光刻膠
適用于I線(365nm)、H線(405nm)和G線(436nm),關(guān)鍵尺寸在0.35um及其以上。
b. 化學(xué)放大光刻膠(CAR,ChemicalAmplifedResist)
適用于深紫外線(DUV)波長的光刻膠。KrF(248nm)和ArF(193nm)。
其實(shí),關(guān)于光刻膠(PR)的分類,根據(jù)應(yīng)用行業(yè)、顯示效果、化學(xué)結(jié)構(gòu)、曝光波長......等等,可分的類別太多太多了,這里我就不一一贅述了。

八、光刻膠(PR)的工作原理
光刻膠的基本原理是利用紫外線或電子束等高能輻射照射光刻膠,使其發(fā)生化學(xué)或物理變化,形成圖案。具體來說,光刻膠通常由兩層組成,即敏化劑層和樹脂層。敏化劑層包含一些化學(xué)物質(zhì),可以吸收光線并將其轉(zhuǎn)化為化學(xué)能,從而導(dǎo)致光刻膠的化學(xué)反應(yīng)發(fā)生變化。而樹脂層則是一種聚合物材料,其化學(xué)性質(zhì)可以受到敏化劑層的影響,從而發(fā)生聚合或交聯(lián)反應(yīng),形成所需的圖案。
在光刻過程中,首先將光刻膠涂覆在襯底表面,并進(jìn)行軟烤處理,使光刻膠形成一定的膜厚和表面特性。然后,將光掩模置于光刻膠表面,利用紫外線或電子束等高能輻射照射光刻膠,使得光刻膠在照射區(qū)域發(fā)生化學(xué)或物理變化。經(jīng)過顯影處理后,未被照射的區(qū)域的光刻膠被去除,而被照射的區(qū)域的光刻膠則被保留在襯底表面上,形成所需的圖案。
不同類型的光刻膠,其化學(xué)體系和工作機(jī)制也大相徑庭。
g線和i線光刻膠均使用線性酚醛樹脂作為樹脂主體,重氮萘醌(DQN體系)作為感光劑。
曝光后,重氮萘醌基團(tuán)轉(zhuǎn)變?yōu)橄┩c水接觸時(shí),進(jìn)一步轉(zhuǎn)變?yōu)檐崃u酸,從而在曝光區(qū)被稀堿水顯影時(shí)除去。
而KrF(248nm)和ArF(193nm)等深紫外光刻膠則采取了完全不同的技術(shù)體系——化學(xué)放大光阻體系(CAR,Chemically Amplified Resist)。
在CAR技術(shù)體系中,光刻膠中的光致酸劑(PAG,Photo Acid Generator)經(jīng)過曝光后并不直接改變光刻膠在顯影液中的溶解度,而是產(chǎn)生酸。
在后續(xù)的熱烘焙流程(PEB,Post-Exposure Bake)的高溫環(huán)境下,曝光產(chǎn)生的酸作為催化劑改變光刻膠在顯影液中的溶解度。
CAR光刻膠的光敏感性很強(qiáng),所需要從深紫外輻射中吸收的能量很少,大大提高了光刻的效率,其曝光速度是DQN光刻膠的10倍左右。

九、光刻膠(PR)的應(yīng)用和未來發(fā)展方向
1、新型微電子器件的制造
光刻膠在微電子器件的制造中已經(jīng)得到廣泛應(yīng)用。未來,隨著微納技術(shù)的不斷發(fā)展和新型器件的出現(xiàn),光刻膠的應(yīng)用將更加多樣化和精細(xì)化,如制造高速器件、量子器件等。
2、3D微納加工技術(shù)的發(fā)展
隨著3D打印技術(shù)的發(fā)展,3D微納加工技術(shù)也逐漸成為一個(gè)新的研究熱點(diǎn)。光刻膠在3D微納加工中具有重要的應(yīng)用前景,可以制造出更加復(fù)雜的三維微納結(jié)構(gòu)。
3、生物醫(yī)學(xué)領(lǐng)域的應(yīng)用
光刻膠在生物醫(yī)學(xué)領(lǐng)域中的應(yīng)用也有很大的潛力。未來,光刻膠可以用于制備更加復(fù)雜的生物芯片、微型醫(yī)療器械、組織工程等。
4、納米光學(xué)器件的制備
光刻膠在納米光學(xué)器件的制備中具有重要的應(yīng)用前景,如制造表面等離子體共振傳感器、納米光學(xué)器件等。
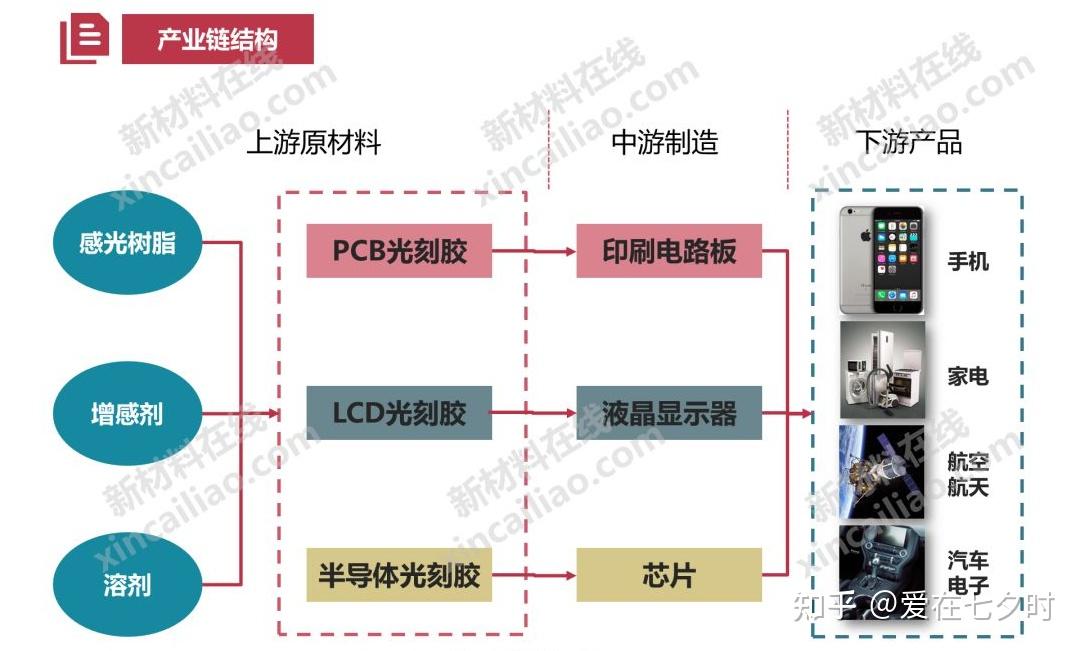
十、光刻膠(PR)的未來展望
中國光刻膠產(chǎn)業(yè)要實(shí)現(xiàn)真正的突破,必須從產(chǎn)業(yè)鏈、技術(shù)研發(fā)和產(chǎn)業(yè)生態(tài)三方面著手。
1、在產(chǎn)業(yè)鏈方面,必須實(shí)現(xiàn)全鏈條協(xié)同發(fā)展。
光刻膠的發(fā)展離不開光刻機(jī)的進(jìn)步。目前,我國光刻機(jī)的國產(chǎn)化率不足3%,2023年進(jìn)口光刻機(jī)數(shù)量高達(dá)225臺,進(jìn)口金額高達(dá)87.54億美元。僅有上海微電子能制造90nm工藝節(jié)點(diǎn)DUV光刻機(jī),與ASML差距極大。
2、在技術(shù)研發(fā)方面,需要持續(xù)加大投入,尤其是在新型光刻膠的研發(fā)上。
近期,清華大學(xué)與浙江大學(xué)的聯(lián)合團(tuán)隊(duì)全球首次提出了“點(diǎn)擊光刻”新方法,并成功開發(fā)出與之匹配的超高感光度光刻膠樣品。這種新型的光刻膠材料,能在極低曝光劑量下實(shí)現(xiàn)高對比度成像,大大降低了光刻曝光劑量,提高光刻效率。
3、在產(chǎn)業(yè)生態(tài)方面,必須與下游企業(yè)深度合作,形成自己的產(chǎn)業(yè)生態(tài)體系。
就像日本光刻膠企業(yè)一樣,與晶圓廠深度合作,嵌入其全產(chǎn)業(yè)生態(tài)中,構(gòu)建起牢不可破的產(chǎn)業(yè)壁壘。隨著芯片制程不斷邁向7nm、5nm、3nm乃至更小線寬,光刻技術(shù)也在不斷演進(jìn)。在EUV光刻膠領(lǐng)域,中國雖然起步較晚,但通過產(chǎn)學(xué)研各界的共同努力,正逐步縮小與國際先進(jìn)水平的差距,一步步點(diǎn)亮芯片制造的關(guān)鍵材料版圖。

十一、寫在最后面的話
回顧光刻膠的歷史和發(fā)展,我們可以看到一個(gè)從簡單到復(fù)雜,從微觀到納米的進(jìn)化軌跡。這種材料不僅推動(dòng)了電子產(chǎn)業(yè)的進(jìn)步,還成為跨學(xué)科研究和應(yīng)用的橋梁。面對未來,光刻膠將繼續(xù)與時(shí)俱進(jìn),滿足我們對更高技術(shù)標(biāo)準(zhǔn)的追求,同時(shí)為新的創(chuàng)新和發(fā)現(xiàn)奠定基礎(chǔ)。
伴隨全球半導(dǎo)體產(chǎn)業(yè)東移,加上我國持續(xù)增長的下游需求和政策支持力度。同時(shí),國內(nèi)晶圓廠進(jìn)入投產(chǎn)高峰期,由于半導(dǎo)體光刻膠與下游晶圓廠具有伴生性特點(diǎn),國內(nèi)光刻膠廠商將直接受益于晶圓廠制造產(chǎn)能的大幅擴(kuò)張。當(dāng)前我國高端光刻膠與全球先進(jìn)水平有近40年的差距,半導(dǎo)體國產(chǎn)化的大趨勢下,國內(nèi)企業(yè)有望逐步突破與國內(nèi)集成電路制造工藝相匹配的光刻膠,所以我們必須要對光刻膠足夠的重視,不斷向日本和歐美等發(fā)達(dá)國家學(xué)習(xí),努力開發(fā)出性能優(yōu)異的國產(chǎn)光刻膠,使我國在未來的市場中占據(jù)一席之地。
參考資料
1. 證券時(shí)報(bào)網(wǎng),《填補(bǔ)空白!EUV光刻膠標(biāo)準(zhǔn)立項(xiàng),技術(shù)突破好消息不斷(附股)》,2025年
2. 新材料在線,《光刻膠》
3. 中國科學(xué)院深圳先進(jìn)技術(shù)研究院大型儀器共享平臺,《光刻工藝簡要流程介紹》,2025年
4. 中商情報(bào)網(wǎng),《2025年中國光刻膠行業(yè)企業(yè)核心競爭力排名》,2025年
5. 36氪,《中國光刻膠,如何突圍?》,2025年
6. 雪球,《2025當(dāng)下,全球高端光刻膠市場被日本企業(yè)壟斷93%份額》,2025年
7. 英語詞典,《固體光刻膠》
8. OFweek光刻膠網(wǎng),《一文看懂光刻膠技術(shù)發(fā)展史》,2021年
9. 應(yīng)用化學(xué),《g-線/i-線光刻膠研究進(jìn)展》,2021年
10. 科普中國,《光刻》,2021年

免責(zé)聲明
【我們尊重原創(chuàng),也注重分享。文中的文字、圖片版權(quán)歸原作者所有,轉(zhuǎn)載目的在于分享更多信息,不代表本號立場,如有侵犯您的權(quán)益請及時(shí)私信聯(lián)系,我們將第一時(shí)間跟蹤核實(shí)并作處理,謝謝!】
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
31077瀏覽量
265765 -
光刻膠材
+關(guān)注
關(guān)注
0文章
5瀏覽量
6692 -
光刻膠
+關(guān)注
關(guān)注
10文章
356瀏覽量
31832
發(fā)布評論請先 登錄
國產(chǎn)光刻膠開啟“鉗形攻勢”
臺階儀在集成電路制造中的應(yīng)用:高端光刻膠材料純化研究進(jìn)展

國產(chǎn)光刻膠重磅突破:攻克5nm芯片制造關(guān)鍵難題

光刻膠剝離工藝

從光固化到半導(dǎo)體材料:久日新材的光刻膠國產(chǎn)替代之路
國產(chǎn)光刻膠突圍,日企壟斷終松動(dòng)
行業(yè)案例|膜厚儀應(yīng)用測量之光刻膠厚度測量

針對晶圓上芯片工藝的光刻膠剝離方法及白光干涉儀在光刻圖形的測量

低含量 NMF 光刻膠剝離液和制備方法及白光干涉儀在光刻圖形的測量

金屬低刻蝕的光刻膠剝離液及其應(yīng)用及白光干涉儀在光刻圖形的測量

減少光刻膠剝離工藝對器件性能影響的方法及白光干涉儀在光刻圖形的測量

光刻膠產(chǎn)業(yè)國內(nèi)發(fā)展現(xiàn)狀
光刻膠剝離液及其制備方法及白光干涉儀在光刻圖形的測量




 半導(dǎo)體芯片制造核心材料“光刻膠(Photoresist)”的詳解
半導(dǎo)體芯片制造核心材料“光刻膠(Photoresist)”的詳解





評論