
隨著科技不斷發展,芯片制造領域逐漸從微米時代邁向納米時代,許多高新企業在這微觀尺寸中不斷追求卓越的技術創新。而目前的主流芯片制造中,光刻工藝是形成精細電路圖案的核心技術之一。
光刻圖案的形成離不開光刻膠的涂覆,我們可以通過三種方法將光刻膠涂覆在晶圓上,包括旋涂(Spin Coating)、薄膜層壓(Film Lamination)和噴涂(Spray Coating),其中應用較多的是旋涂技術。今天,優可測與你一起探索光刻膠旋涂背后的奧秘!
|
光刻膠旋涂
光刻工藝流程基石
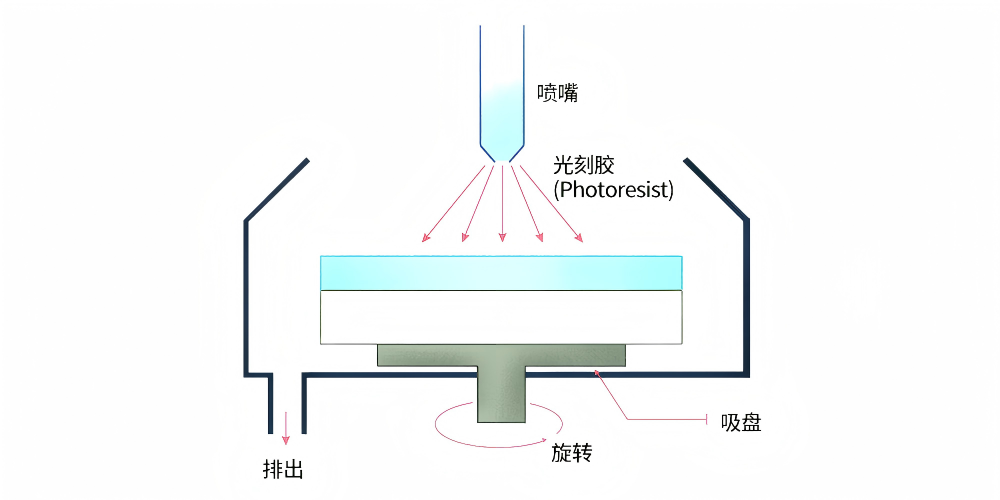
光刻膠旋涂主要是通過旋轉襯底的方式涂覆光刻膠,不同的光刻膠有不同的工藝參數要求,比如溫度、光刻膠厚度、旋轉速度等。
光刻工藝流程主要包括膜底準備→光刻膠旋涂→軟烘→對準與曝光 →曝光后烘→顯影→堅膜→檢測。
光刻膠旋涂處于流程的起始階段,為后續的曝光等步驟提供了均勻的感光介質,保證曝光區域的感光效果一致。
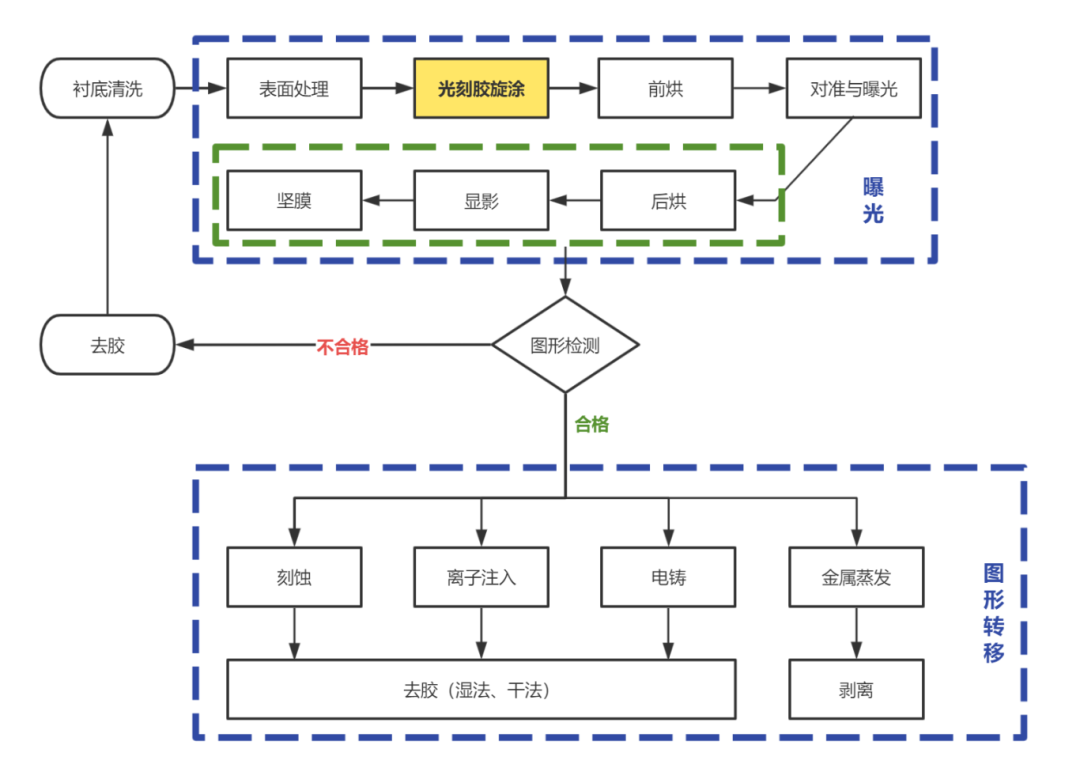
|
監測旋涂厚度
保障光刻圖案精度
有統計數據顯示,因光刻膠旋涂不良導致的芯片報廢率每降低1%,每年可為芯片制造企業節省數百萬美元的成本 。差之毫厘,謬以千里,監測光刻膠旋涂厚度對整個芯片制造流程的質量與效益起著關鍵作用。
在曝光環節,光刻膠的厚度關聯著曝光過程中的光吸收量,依據光學吸收定律,光刻膠的厚度波動會導致光吸收的不均勻性,進而致使曝光后的線條出現變寬、變形等問題。
在刻蝕環節,光刻膠需要承擔保護不需要刻蝕區域的責任。厚度過薄,光刻膠難以抵御刻蝕液的侵蝕,導致不該刻蝕的區域被破壞;厚度過厚,則容易殘留雜質,同樣會影響電路結構。2020 年發表于《半導體技術》期刊的一項研究指出,在刻蝕過程中,光刻膠厚度的均勻性偏差每增加1%,刻蝕后電路圖案的線寬偏差會增大3%-5%,這表明了光刻膠厚度對刻蝕精度的重要影響。
|
光刻膠旋涂的厚度監測
單點測量時間<0.5s
為保障光刻線路圖案精度,某半導體客戶需要監測產線上的光刻膠厚度,精度要求納米級,同時需要兼顧測量效率。
針對客戶需求,我們采用了優可測薄膜厚度測量儀AF-3000系列,為客戶搭建Mapping解決方案:快速分析光刻膠、刻蝕厚度的均一性,提供工藝調整方向。
薄膜厚度測量儀AF系列舍棄傳統的LED光源,而是采用了光強均勻、頻道穩定的“氘燈”和“鎢鹵素燈”,支持測單層膜、多層膜、液態膜、氣隙層、粗糙/光滑層,最高可測10層膜。一臺機器覆蓋多臺機器的測量范圍,測量結果更加精準。

經過實測,AF系列測量精度可達0.1nm,匹配度達0.308420,單點測量時間<0.5s,充分滿足客戶所需測量精度及效率,成功幫助客戶在光刻膠涂覆環節節省光刻膠成本、提升檢測效率、提高產品良率!

測量波形圖

測量2D結果圖

測量3D結果圖

測量結果數據表格
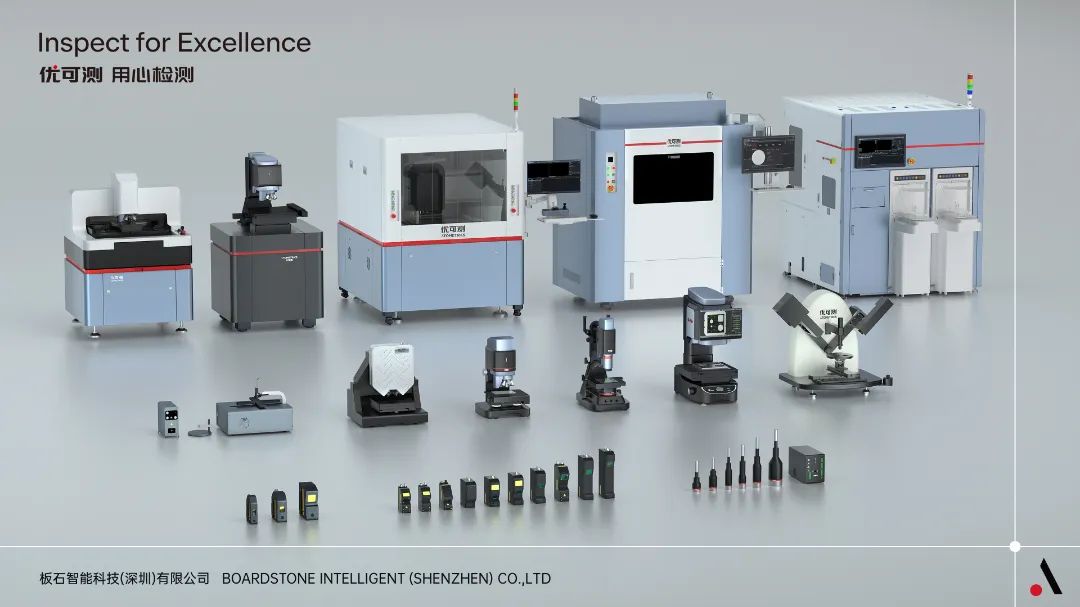
-
半導體
+關注
關注
339文章
31008瀏覽量
265495 -
光刻膠
+關注
關注
10文章
356瀏覽量
31827 -
薄膜厚度
+關注
關注
0文章
15瀏覽量
1803
發布評論請先 登錄
Futurrex高端光刻膠
光刻膠殘留要怎么解決?
Microchem SU-8光刻膠 2000系列
光刻膠在集成電路制造中的應用
光刻膠和光刻機的關系
光刻膠的原理和正負光刻膠的主要組分是什么
光刻膠黏度如何測量?光刻膠需要稀釋嗎?
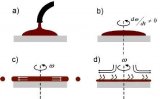



 光刻膠旋涂的重要性及厚度監測方法
光刻膠旋涂的重要性及厚度監測方法






評論