隨著電子行業不斷提高遵守ROHS 標準的程度,使用普通共晶錫鉛焊錫的元件越來越少。人們廣泛地把鉛從電子系統中拿走,但是,錫須可能引起故障的風險卻十分普遍。
錫須是微米數量級的金屬細絲,它在純錫的表面出現,不可預見,像針狀細絲,或者“突然冒出來的奇形怪狀”、向外伸出來的細絲,或者不規則的小結節狀的“凸起物”。它們是單晶體,導電,并且能夠生長到相當的長度(> 2.0毫米),從而有可能在緊密排列的導線、走線和焊點之間形成電氣短路。
人們普遍認為,薄錫層的形態和它們下面的基板(包括、但不限于錫和銅之間的界面上形成的Cu6Sn5 金屬互化物),還有應力條件和/ 或應力梯度以及可能的環境條件,也許這些因素都可能在晶須的生長中起著有意義的作用。
科學界依然不懈地努力,試圖揭開形成錫須的物理機制,一些人則著重研究減少錫須的方法,以應對純錫表面出現的不可預測知的問題,提高組件的可靠性。本文的目的是后者。本文擴大了我們以前的工作。我們以前工作的結論是,納米多晶錫和多晶銅上面的多晶錫在1000 次熱循環后形成混合晶須的情況得到減輕。
背景
這項研究的目的是延伸我們以前的工作 。在以前的工作中,我們探討了影響傳統鍍錫層表面上面的納米晶體銅底面層的影響,以及生長晶須的程度。在以前的研究中,我們發現,在用電子束蒸鍍(物理氣相鍍膜(PVD)技術)鍍錫或者電鍍亮錫后,納米銅減少了錫須的密度。
通過電鍍亮錫把多晶錫電鍍在銅表面層上,銅層的平均晶粒尺寸為100 納米時,晶須完全消除了 。
在目前的工作中,分別通過鍍暗錫和鍍亮錫,在納米晶體銅和多晶銅覆蓋的基板上鍍一層薄純錫。我們研究的變量包括電鍍的占空比和摻入的晶粒細化劑數量。對這些樣本進行熱循環,促進晶須在易受影響的樣品上生長。本文還討論了最后得到的表面形態,應力水平和生長晶須的程度。
納米結構層的沉積通常是通過脈沖電子束鍍膜(PED)完成,加入有機添加劑,如復雜的成形劑和抑制劑以便得到較小的晶粒。這些添加劑能夠抑制晶粒的生長,從而得到比較細的晶粒結構。在這方面,我們根據我們先前的發現,即鍍層中含的電解液添加劑(即增白劑和抗氧化劑)和我們的PVD 層(表面上看是“純”)一樣,與晶須的生長無關,因此,在研究中我們可以根據研究的需要使用電鍍添加劑來減少晶須生長。
實驗細節
鍍銅與分析
我們在研究中使用的測試基板是1“×1”×0.010“的銅基板。納米晶體銅的電鍍沉積是銅電鍍槽中用PED 鍍膜形成,銅電鍍槽中的電鍍液由硫酸銅、硫酸銨和檸檬酸組成,檸檬酸作為晶粒細化添加劑。銅電鍍膜是用電流密度0.165A/ 平方英尺、峰值電流為10A 的電流進行電鍍得到。多晶銅薄膜是用直流標準硫酸銅工藝得到。電鍍銅膜的厚度為5 微米。
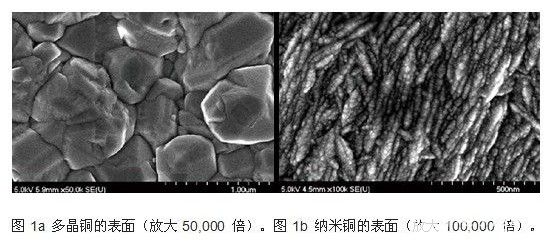
圖1a 和1b 分別是多晶銅和納米晶體銅薄膜形態的掃描型電子顯微鏡(SEM)顯微照片。多晶銅的平均晶粒尺寸為2 微米,納米晶體銅的平均晶粒尺寸為100 納米。
鍍錫膜
添加晶粒細化劑,分別用鍍暗錫和鍍亮錫把純凈的錫鍍在多晶銅和納米晶體銅基板上。電流密度為0.170A/平方英寸,峰值電流為10A,采用不同的占空比。使用純錫陽極,陽極的工作溫度為25℃,連續進行機械攪拌。鍍亮錫和鍍暗錫(表1-2 中為BC 和MC)的對照基板,是用直流鍍膜,不使用晶粒細化劑,以便進行比較。對樣品進行鍍暗錫和鍍亮錫的工藝參數分別見表1 和表2。

正如以前的研究中所說的,我們選擇的鍍錫層厚度為2 微米,由于這個厚度在20 微米之內,低于減少錫須閾值的上限,大于1μm 的減少晶須閾值的下限,這個閾值是Ostermann 提出的,不過,由于這個厚度接近閾值的下限,晶須生長比較慢。
熱循環
鍍錫后,所有樣品按照IEC60068-2-82 的規定進行熱循環。熱循環的溫度范圍為-55℃到+85℃,持續 10 分鐘,歷時9 天(總共進行168 個熱循環)。
微觀分析
所有的熱老化完成后,立即用掃描電子顯微鏡(SEM)進行分析。一系列的顯微照片顯示,“對照的”(多晶)鍍錫層的形態,通過改變晶粒的細化程度,鍍錫層的形態不一樣,圖2a 至2c 是鍍亮錫的顯微照片,圖3a-3c 是鍍暗的顯微照片。


在納米晶體銅上鍍亮錫情況中,顯微照片中有清晰的、橢圓形長晶粒演化為逐漸聚結的情況,平均表面粗糙度直線下降。在納米晶體銅上的鍍暗錫的情形,對于多晶控制,在兩個細晶粒樣品中有一個粗糙度的非線性發展過程,但是平滑清晰。

圖4 左圖是多晶銅襯層上面的錫膜,右圖是納米晶銅襯層上面的錫膜。這兩個錫膜是同樣的,數字對應于表1 和表2 中所列的序號。
在圖4 中,把顯微照片放在一起,對比多晶錫上面的錫膜和下面的納米晶體銅層。對于研究中使用的所有配方,觀察鍍錫層的表面結構表明,鍍錫層下面的銅層對鍍錫層的表面結構沒有任何影響。
應力和表面粗糙度
八種不同類型錫的表面粗糙度分別稱作IPC-1 到IPC-8(見表3),表面粗糙度使用Veeco Wyko NT1100 光學輪廓測定系統測定,放大倍率為50 倍,每個圖像為1374 幀。

我們用KLA Tencor 公司的激光FLX 薄膜應力測量系統測量了IPC1-IPC8 的沉積應力。用來進行應力和表面粗糙度測量的測試基板由4 英寸圓形硅晶片構成,用電子束蒸鍍300A 的鉻、1 微米的銅(作為芯晶層)對硅晶片進行金屬化,然后電鍍2 微米的錫(樣品IPC1- IPC8 參數見表3)。在芯晶蒸鍍(作為基礎)之后,測量曲率半徑和弓度,然后,在鍍錫后再測量曲率半徑和弓度,得到一個應力讀數以進行比較。

表4 中的數據表明,納米晶體膜的應力沒有明顯的不同,或者相對多晶銅膜在大小方面呈線線性關系。IPC2和IPC3(都是納米晶體暗錫)的表面粗糙度小于IPC1(多晶暗錫),而IPC4(納米晶體暗錫)的表面粗糙度稍大些。另一方面,和IPC5(多晶亮錫)相比,IPC7 和 IPC8(兩者都是納米晶體亮錫)的表面粗糙度都比較大,而IPC6(也是納米晶體亮錫)的表面粗糙度比較小。

錫須
用納米銅襯層制備的14 個亮錫樣品中,只有三個樣品有晶須(序號4、6、和10)。
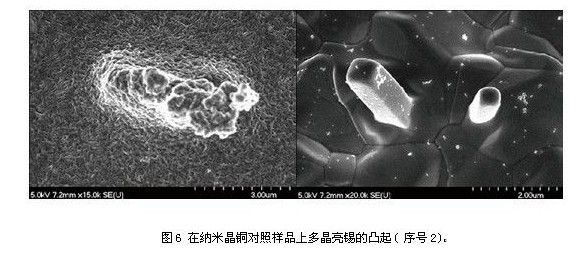
我們觀察到各種形態的晶須,包括典型的條紋形針狀細絲、形狀古怪的細絲、凸起、以及光滑的長方形晶須。圖6 是一個凸起(老化后它可能最終演變為晶須),是在鍍亮錫對照樣品(序號2)的表面上形成的,圖7 是長方形晶須,在鍍暗錫對照樣品(序號15)的表面上形成的。與以前的工作[1] 不一樣的是,我們發現,多晶銅上面的多晶暗錫的確形成晶須(圖8),而納米晶體銅上面的暗錫沒有形成晶須(圖3a)。
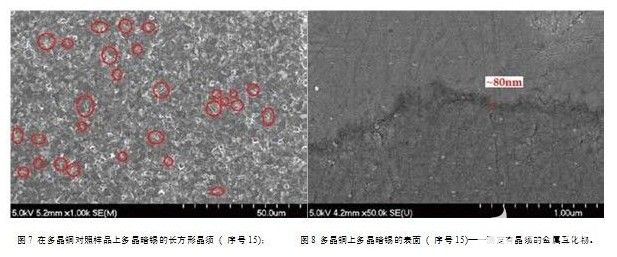
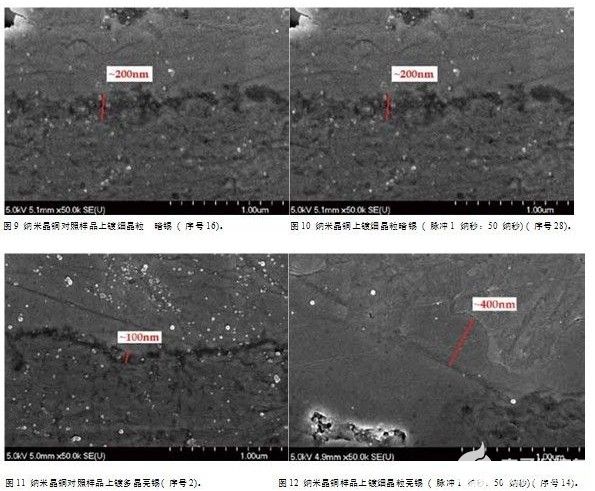
收集了SEM 檢查的平面掃描照片之后,把4 個樣品作罐封,并作切面。對錫和銅界面上的金屬互化物(IMC)部位作了兩次成像:一次是在機械拋光后(圖9 - 12),一次是使用商用錫剝離劑進行兩分鐘的濕法化學腐蝕之后(圖13 - 16)。在腐蝕之前,蜿蜒的分界線清晰可見,估計了厚度。與多晶錫相比,對于細晶粒錫,在暗錫和亮錫兩種情況下,金屬互化物在體積和厚度方面都比較大。
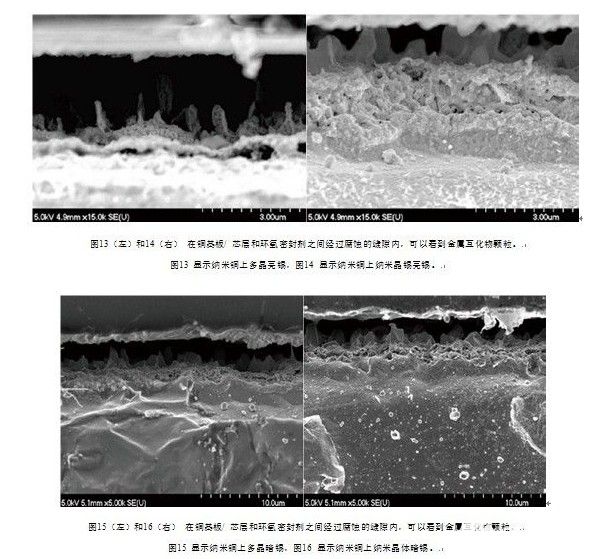
結論
我們已經成功地證明,通過脈沖鍍膜和加入晶粒細化劑,能夠改變錫的晶粒尺寸、形狀和晶體結構。樣品在腐蝕前和腐蝕后的切面可能說明,對于納米晶銅上面的細晶粒錫,樣品中的金屬互化物體積增大。錫與銅之間界面的金屬互化物(IMC)部位的初步成像表明,納米銅襯層防止多晶錫形成晶須,多晶銅襯層則不能夠——和我們先前的發現[1] 相反。
我們準備在下一年對所有的28 個樣品進行環境老化,隋后進行顯微鏡分析,從納米結構程度和/ 或表面平滑程度方面評估所有晶須在生長傾向上的差別。對于今天的微電子行業,使用無鉛焊錫已是現實,對于微電子行業,不可預知的錫須性是重大挑戰,它決定著微電子器件的可靠性。
在決定是否改變鍍層內部晶粒形態方面必須做進一步的研究(和計劃),這些工作可能有助于重新分配電鍍時的應力和逐漸變化的應力,也能延緩或防止生長錫須。
圖1a 和1b 分別是多晶銅和納米晶體銅薄膜形態的掃描型電子顯微鏡(SEM)顯微照片。多晶銅的平均晶粒尺寸為2 微米,納米晶體銅的平均晶粒尺寸為100 納米。
鍍錫膜
添加晶粒細化劑,分別用鍍暗錫和鍍亮錫把純凈的錫鍍在多晶銅和納米晶體銅基板上。電流密度為0.170A/平方英寸,峰值電流為10A,采用不同的占空比。使用純錫陽極,陽極的工作溫度為25℃,連續進行機械攪拌。鍍亮錫和鍍暗錫(表1-2 中為BC 和MC)的對照基板,是用直流鍍膜,不使用晶粒細化劑,以便進行比較。對樣品進行鍍暗錫和鍍亮錫的工藝參數分別見表1和表2。
編輯:YYX
 電子發燒友App
電子發燒友App













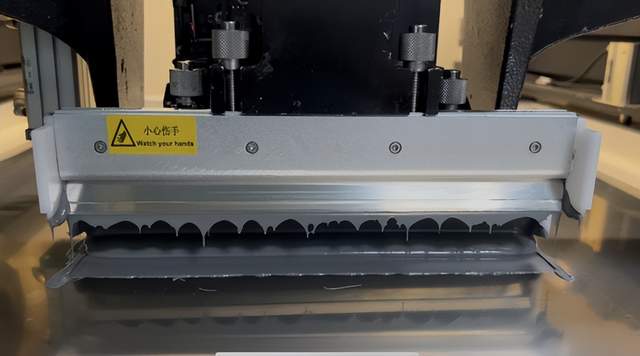



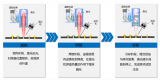
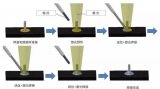

































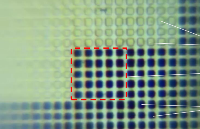

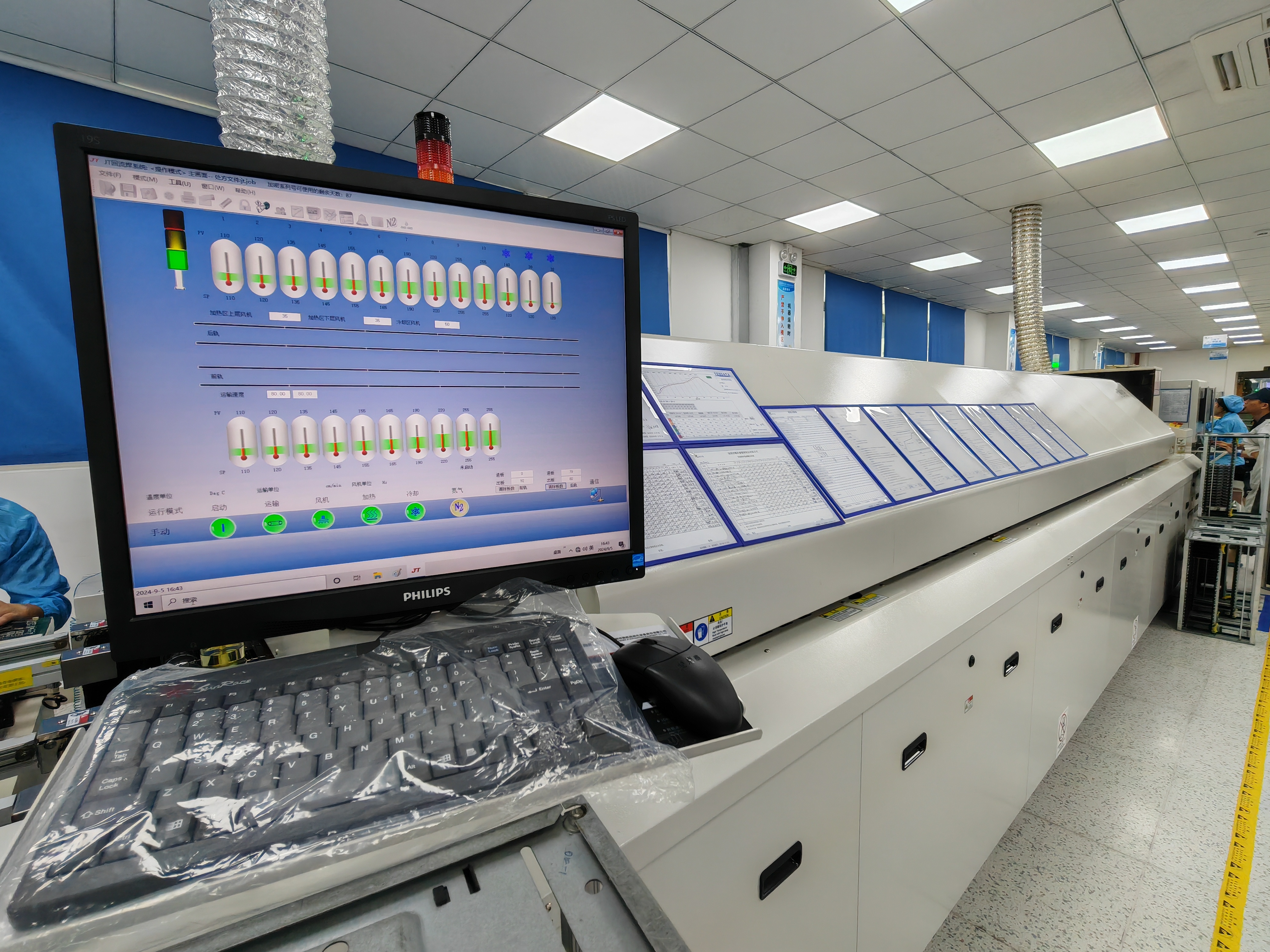





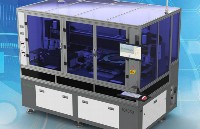
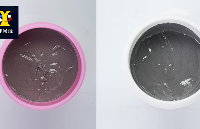








評論