在芯片焊接到 PCB 的過程中,使用無鹵錫線配合助焊劑時出現錫球炸錫(飛濺、爆錫)現象,本質是焊接過程中局部產生的氣體或雜質在高溫下快速膨脹、逸出時引發的錫液飛濺。作為專業封裝焊接材料的廠家,傲牛科技工程師根據客戶實際應用,結合無鹵錫線、助焊劑特性及工藝細節,從以下幾類展開分析炸錫的具體原因。
一、助焊劑特性與狀態問題
助焊劑是焊接中控制界面反應和減少氧化的核心材料,其成分、狀態直接影響炸錫風險:
1、揮發物殘留或揮發速率失衡:無鹵助焊劑通常以醇類、酯類等有機溶劑為載體,若助焊劑中溶劑沸點過低(或含量過高),焊接時烙鐵高溫會導致溶劑瞬間劇烈揮發;若溶劑沸點過高(或涂覆量過多),則溶劑未在預熱階段充分揮發,高溫下被包裹在熔融錫中,突然汽化膨脹會沖破錫層引發炸錫。
2、活性不足或雜質殘留:無鹵助焊劑不含鹵素(如 Cl?、Br?),活性通常低于傳統有鹵助焊劑,若焊盤 / 錫球存在輕微氧化,助焊劑無法徹底清除氧化層,焊接時氧化層與熔融錫反應會產生氣體(如 SnO 與焊劑中的有機酸反應生成 CO?),氣體逸出時導致錫液飛濺。
3、吸潮或污染:無鹵助焊劑吸濕性較強,若存放環境濕度高(如 RH>60%),助焊劑會吸收水分;或助焊劑開封后未密封,混入灰塵、油污等雜質,焊接時水分 / 雜質在高溫下汽化、燃燒,引發炸錫。
二、錫線與錫球的質量問題
無鹵錫線的合金成分、內部結構及錫球狀態是炸錫的重要誘因:
1、錫線內部雜質或缺陷:無鹵錫線(如 Sn-Ag-Cu 系)若生產過程中混入氧化錫顆粒、氣泡或金屬雜質(如 Fe、Cu 超標),焊接時雜質受熱膨脹,或氣泡破裂,會導致熔融錫液飛濺;此外,錫線中心的助焊劑芯分布不均(如局部助焊劑過多 / 過少),也會因揮發物局部聚集引發炸錫。
2、錫球表面氧化或污染:錫球在存放過程中若暴露在空氣中未做好防氧化處理(如未涂覆保護劑),表面會形成氧化膜(SnO 或 SnO?);或錫球接觸過手指(殘留油脂)、灰塵,焊接時氧化膜阻礙錫液潤濕,高溫下氧化膜破裂,結合助焊劑揮發氣體,易引發炸錫。
3、錫線合金配比不當:無鹵錫線的合金成分(如 Ag、Cu 含量)若偏離標準,可能導致熔點異常或流動性變差,焊接時錫液凝固速度不均勻,局部應力釋放時伴隨飛濺。
三、焊接工藝參數不合理
工藝參數的控制直接影響熱量傳遞和界面反應節奏:
1、溫度過高或升溫速度過快:若烙鐵溫度超過錫線熔點過多(如 Sn-Ag-Cu 熔點約 217℃,烙鐵溫度>350℃),或烙鐵瞬間接觸焊盤,高溫會導致助焊劑溶劑 “閃蒸”(瞬間揮發),同時錫液快速熔融,氣體來不及逸出就被包裹,最終沖破錫層形成炸錫。
2、焊接壓力與接觸方式不當:壓力過小會導致烙鐵與焊盤 / 錫球接觸不良,熱量傳遞不均,局部過熱引發炸錫;壓力過大則會擠出過多助焊劑,導致助焊劑在錫液外過早揮發,失去保護作用,同時錫液被擠壓后流動性紊亂,易伴隨飛濺。
3、預熱不足:若 PCB 或芯片焊盤未經過充分預熱(尤其對于多層 PCB 或大型焊盤),焊接時烙鐵熱量集中在局部,助焊劑在低溫區域未提前揮發,接觸高溫后突然汽化,引發炸錫。
四、PCB 與焊盤的預處理問題
PCB 焊盤和芯片引腳的清潔度是焊接穩定性的基礎:
1、焊盤氧化或污染:PCB 焊盤若存儲時間過長(超過保質期),表面會生成氧化層;或 PCB 加工后殘留助焊劑殘渣、阻焊劑溢膠,未經過清洗(如超聲波清洗),焊接時污染物在高溫下燃燒、揮發,導致錫液飛濺。
2、焊盤鍍層不良:PCB 焊盤的鍍層(如 Ni/Au、OSP)若厚度不均、存在針孔或露銅,焊接時鍍層與錫液反應異常(如 Au 與 Sn 形成脆性合金 AuSn?,局部應力過大),可能伴隨氣體釋放和錫液飛濺。
五、環境與工具因素
1、環境濕度超標:焊接環境濕度高(如 RH>70%)時,PCB、錫線或助焊劑易吸附水分,水分在焊接高溫下轉化為蒸汽,體積急劇膨脹(約 1700 倍),直接引發炸錫。
2、焊接工具污染:烙鐵頭表面氧化、殘留錫渣或助焊劑碳化層,會導致熱傳導效率下降,局部溫度過高;或烙鐵頭清潔不徹底,攜帶的雜質混入焊接區域,成為炸錫的觸發點。
綜上,炸錫是助焊劑揮發特性、錫材質量、工藝參數、基材清潔度等多因素共同作用的結果,排查時需優先檢查助焊劑狀態(揮發物、吸潮)、錫線 / 錫球氧化情況,再優化焊接溫度、壓力等參數,同時確保 PCB 焊盤清潔和環境濕度可控。
-
pcb
+關注
關注
4411文章
23916瀏覽量
425410 -
焊接
+關注
關注
38文章
3575瀏覽量
63372 -
焊盤
+關注
關注
6文章
604瀏覽量
39845 -
助焊劑
+關注
關注
3文章
150瀏覽量
12379
發布評論請先 登錄



 芯片焊接中無鹵錫線炸錫現象的原因分析
芯片焊接中無鹵錫線炸錫現象的原因分析





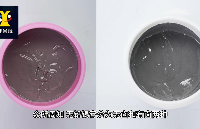




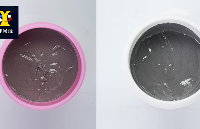




評論