HDI PCB具有高密度屬性,包括激光微孔、挨次層壓布局、細線和高性能薄質(zhì)料。這種增加的密度使每個單位面積的功效更多。先進技術(shù)HDI PCB具有多層添補銅的堆積微通孔,締造了允許更復(fù)雜的連接布局。這些復(fù)雜的布局為當(dāng)今高科技產(chǎn)品中的大引腳數(shù)目、細間距和高速芯片提供了須要的布線和燈號完備性辦理方案。
HDI PCB行使可用的非常新技術(shù)增加功效,使用更細的隔斷,使用同樣少的面積進步PCB的完備性。PCB技術(shù)的這一進步支持革新性新品的高端功效,包括:5G、通訊、網(wǎng)絡(luò)裝備、物聯(lián)網(wǎng)、醫(yī)療患者監(jiān)測的可穿戴裝備、自主使用的PCB、激光雷達體系、車輛到達全部切割(V2X)、通訊和軍事衛(wèi)星、航空電器和智能彈藥等使用。
高級功效:微孔。
激光鉆孔微通孔的鉆孔直徑小至0.004“;(100m),與小至0.008”;(200支m)的焊盤直徑光學(xué)對齊,增加了布線密度。微通孔可以是焊盤中通孔(用于干脆元件安置)、偏移、交錯或堆疊、非導(dǎo)電添補、頂部鍍銅或添補或鍍實銅。從細間間隔BGA(比方,0.8毫米間距部件和以下部件)布線時,微孔會增加代價。
另外,從可以使用交錯微孔的0.5毫米隔斷裝備接線時,微孔會增加代價。但是,布線微型的BGA(比方,0.4毫米、0.3毫米或0.25毫米的隔斷裝備)需要使用倒金字塔布線技術(shù)的堆疊微通孔。
Anaren擁有多年的HDI產(chǎn)品經(jīng)驗,是第二代微孔或疊加微孔的先鋒。具有實心銅疊加微孔的疊加微孔技術(shù)可以為超高速和微型,BGA可以提供布線辦理方案。
Anaren為下一代產(chǎn)品提供微孔技術(shù)辦理方案。
NextGen-SMV技術(shù)。
Anaren開發(fā),現(xiàn)在提供第三代微孔和NextGen-SMV。可以定時(5-7號)提供堆積微孔的制造。NextGen-SMV技術(shù)允許快速轉(zhuǎn)換具有復(fù)雜通孔布局的PCB設(shè)計。只需要一個層壓輪回,就能削減熱偏移(質(zhì)料的熱分解)和輪回時間。
NextGen-SMV,消除了內(nèi)層鍍銅輪回,進步了阻抗容差,削減了整體厚度,改進了電氣特性。另外,NextGen-SMV為設(shè)計者提供了天真性,可以通過導(dǎo)電膏和內(nèi)層銅之間的冶金結(jié)合實現(xiàn)任意層的通孔連接。須要時,SMV技術(shù)還可以與NextGen-SMV一起用于表面或外部微通孔,建立實心銅通孔。
別的,NextGen,Sub-Link,Technology,允許多包含高科技或標準技術(shù)的子連接。該技術(shù)允許只在需要或需要的地方使用高性能質(zhì)料。
超級BGA。
它是網(wǎng)絡(luò)、高端服務(wù)器、電信、軍事和醫(yī)療環(huán)境趨勢的辦理方案——速度、靠得住性和增加的燈號I/O務(wù)必與削減的尺寸、重量和功率(SWap)相結(jié)合。
25微米線和空間。
RAD 耐受。
高速。
CoreEZ? 半導(dǎo)體封裝。
CoreEZ、半導(dǎo)體封裝使用HyperBGA,是一個制造平臺。是低老本構(gòu)建質(zhì)料和高靠得住性、高性能、可布線性使用的絕佳選定。
28微米線和空間。
RAD很硬。
慎密套準確立技術(shù)。
深圳市立維創(chuàng)展科技是Anaren品牌的經(jīng)銷商,主要提供貼片混合耦合器、巴倫變壓器、延遲線、定向耦合器、Doherty合路器、功分器、微蜂窩型耦合器、 RF Crossovers產(chǎn)品,產(chǎn)品原裝庫存,極具價格優(yōu)勢,歡迎咨詢。
責(zé)任編輯:tzh
 電子發(fā)燒友App
電子發(fā)燒友App


















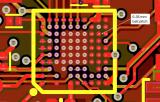

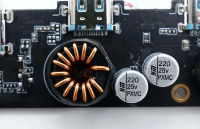








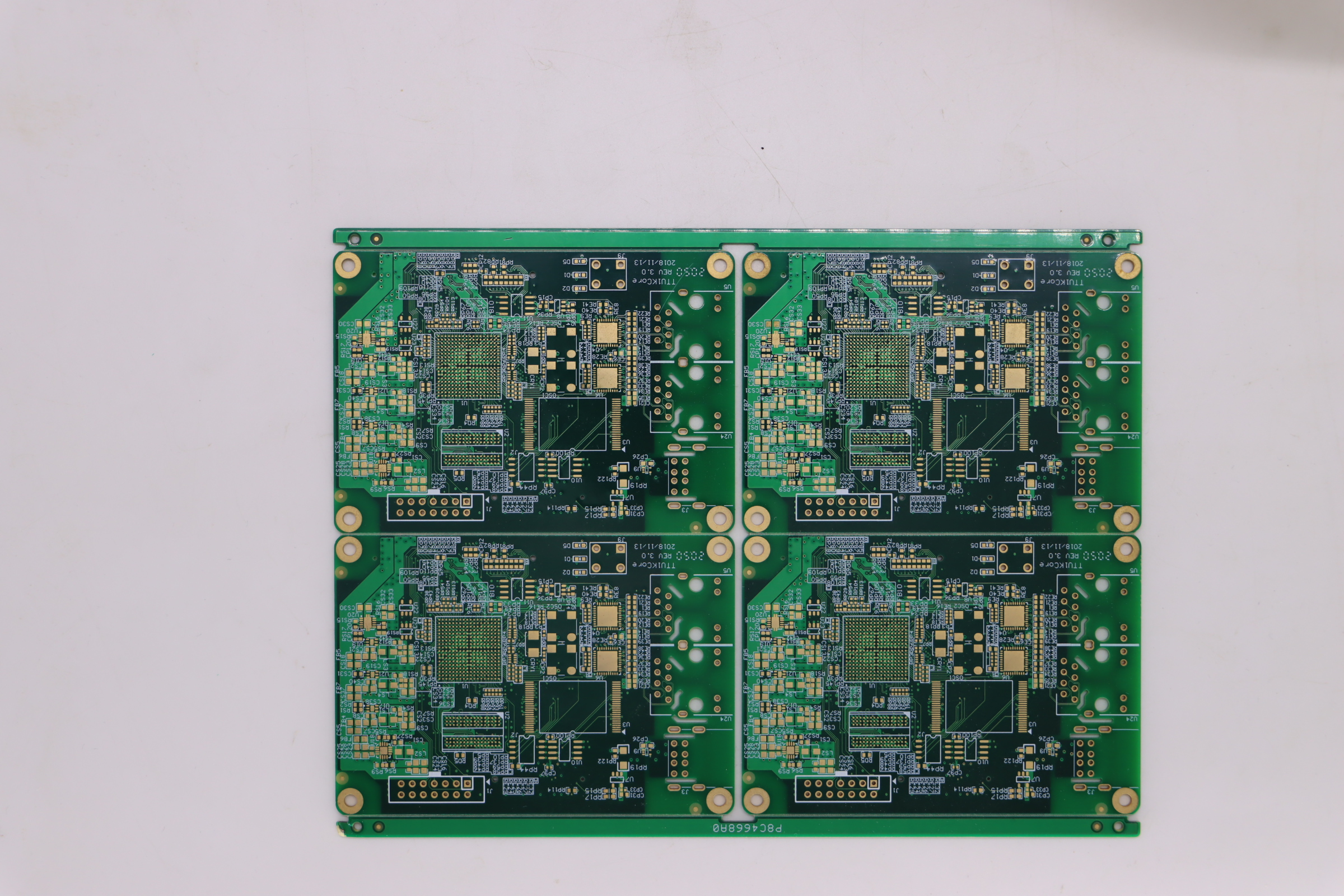





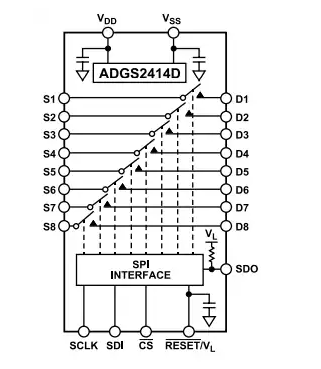

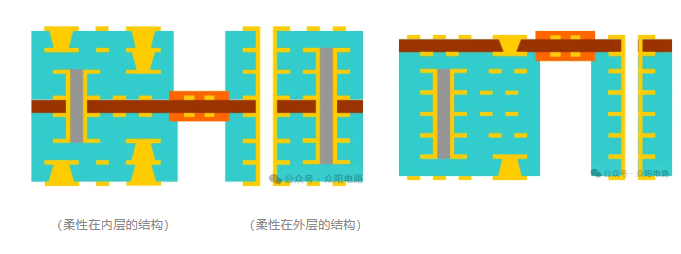




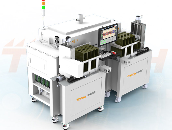
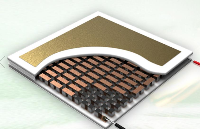



















評論