本文轉(zhuǎn)發(fā)連云港杰瑞電子有限公司的臧艷麗等發(fā)表在《電子工藝技術(shù)》上的“基于疊層組裝和雙腔體結(jié)構(gòu)的高密度集成技術(shù)”,文中基于芯片堆疊和多層HTCC管殼開發(fā)了一款產(chǎn)品,在此予以介紹,供大家學(xué)習(xí)。
01雙腔產(chǎn)品結(jié)構(gòu)設(shè)計
產(chǎn)品集成11顆芯片,58個無源元件,采用雙面陶瓷管殼作為載體,進行雙層芯片疊裝和組裝,實現(xiàn)高密度集成。殼體工藝采用高溫多層陶瓷共燒工藝,可以最大限度地增加布線密度和縮短互連線長度,從而提高組件密度和信號傳輸速度。如下圖所示,腔體內(nèi)部設(shè)計兩層深腔,留有多層芯片疊裝的立體組裝空間,設(shè)計兩層臺階鍵合區(qū)域,便于空間鍵合走線實現(xiàn)電氣連接。陶瓷基板上設(shè)計電路,通過金絲鍵合實現(xiàn)電氣互連。雙面組裝完成后進行雙面平行封焊,最后進行引腳成型。

02關(guān)鍵工藝技術(shù)
1)三維芯片堆疊技術(shù)
芯片堆疊結(jié)構(gòu)有三種典型的疊裝方式:1)小芯片疊裝大芯片的金字塔式;2)芯片兩側(cè)出鍵合線的十字交叉式;3)同尺寸的芯片通過墊片疊裝的懸臂梁式。前兩種芯片堆疊方式難度不大,本部分重點分析懸臂梁式芯片疊裝。
該技術(shù)難點主要有三個:1)芯片與墊片粘接、芯片與芯片粘接材料的選擇,既要具有較高粘接強度又要具有緩沖結(jié)構(gòu)應(yīng)力的能力,以適應(yīng)芯片疊裝的應(yīng)用;2)控制芯片與芯片間粘接膠量,避免溢出膠污染到鍵合區(qū),需要采用自動粘接設(shè)備;3)空間鍵合難度大,疊層芯片組裝的垂直空間極為有限,因此要求鍵合線必須具有盡可能低的弧高,采用反向鍵合的工藝方法,適當(dāng)?shù)臅r候使用等離子清洗避免洇膠影響鍵合質(zhì)量。
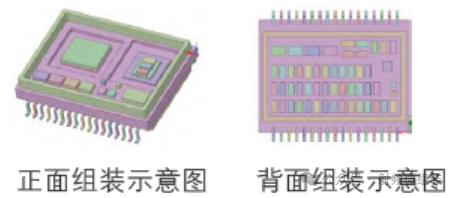
2)一體化雙面腔體組裝技術(shù)
該技術(shù)可實現(xiàn)高密度模塊的組裝,雙面安裝元器件,實現(xiàn)立體組裝,較單腔模塊體積可縮小1/3以上,雙面腔體密封,耐環(huán)境應(yīng)力可靠性高。該技術(shù)主要有兩個工藝難點:1)雙面腔體元器件的粘接、鍵合工藝;2)雙面腔體封焊技術(shù)。封焊技術(shù)目前有激光封焊、平行縫焊、真空熔焊等,根據(jù)所選擇的工藝和腔體材料的不同,選擇合適的封焊技術(shù)。
3)后引腳成型技術(shù)
引腳作為電氣連接和結(jié)構(gòu)支撐的用途,設(shè)計類似芯片小外形封裝,兩側(cè)出引腳數(shù)量34根,引腳材料采用柯伐合金材料。產(chǎn)品通過引腳與印制板實現(xiàn)電氣連接,整個大腔體依靠引腳支撐存在風(fēng)險,設(shè)計增加背面腔體也起到結(jié)構(gòu)支撐作用。如果采用背面同步焊接的方式,引腳成型過程需要確保引腳底面與底層腔體蓋板面共平面,需要定制專門的工裝,背面腔與引腳的共面性要求高度差小于0.1 mm,這對引腳成型過程的控制要求更高。另一種方式采用側(cè)面打膠加固,此方法對引腳底面和底層腔體的共面性要求不高,引腳成型工藝更容易實現(xiàn)。
03芯片疊層和雙腔體工藝設(shè)計
1)客戶使用工藝性設(shè)計
客戶使用的是采用貼裝的方式將轉(zhuǎn)換器組裝到印制板上,通過34根引腳與印制板實現(xiàn)電氣連接,背面蓋板表面鍍鎳,通過Sn63Pb37與印制板表面焊接固定,焊料共晶溫度點183 ℃,側(cè)面點膠加固,背面蓋板和引腳同時起固定支撐作用。

模擬回流焊接曲線如下圖所示,經(jīng)過回流焊接過程各重要器件溫度分布情況見下表。

通過溫度分布結(jié)果顯示:芯片、元器件超過200 ℃的時間均控制在25 s以內(nèi),雙腔體封裝后的產(chǎn)品經(jīng)過回流焊接,溫度分布對元器件影響不大,產(chǎn)品元件的可耐受峰值溫度和時間可控。
2)可靠性預(yù)測分析
高密度集成封裝中,芯片疊層技術(shù)是封裝中的薄弱點,因為芯片、墊片、陶瓷管殼三種材料熱膨脹系數(shù)存在差異,硅芯片又屬于脆性材料,粘接材料的選擇是提高芯片堆疊可靠性的基礎(chǔ),通過查閱相關(guān)文獻,選擇低應(yīng)力粘接材料,匹配真實的產(chǎn)品數(shù)據(jù)進行了溫度沖擊、機械沖擊、恒定加速度模擬分析,可靠性試驗?zāi)M結(jié)果見下表。通過預(yù)測模擬分析結(jié)果顯示:1)在經(jīng)受-65~150 ℃溫度循環(huán)試驗時,每種材料由于收縮程度不一致,芯片疊裝結(jié)構(gòu)內(nèi)部會產(chǎn)生內(nèi)應(yīng)力,2層芯片堆疊結(jié)構(gòu)的最大應(yīng)力100MPa,硅的破壞強度較高,在5~10GPa,實際損壞強度遠低于理論強度,只有30%~70%,,按照30%的破壞強度,受到的應(yīng)力依然是小于芯片材料的強度值,不會出現(xiàn)芯片開裂的問題,芯片翹曲變形最大是在最頂層,變形量最小是在最底層。

2)機械沖擊條件1500g ,0.5ms的條件作用于模型結(jié)構(gòu),芯片受到最大等效應(yīng)力5.83MPa小于Si芯片的損壞強度;恒定加速度5000g ,Y2方向時間1min,芯片受到的等效最大應(yīng)力5.57MPa遠小于芯片的損壞強度,芯片間的絕緣膠在機械沖擊和恒定加速度條件下,對芯片有緩沖作用,芯片受到的應(yīng)力遠小于芯片的破壞強度。
基于真實的產(chǎn)品數(shù)據(jù)進行了溫度沖擊、隨機振動、恒定加速度模擬分析,結(jié)果證明該產(chǎn)品的低應(yīng)力粘接膠和結(jié)構(gòu)能夠滿足產(chǎn)品的使用要求。
-
芯片
+關(guān)注
關(guān)注
463文章
54144瀏覽量
467518 -
無源元件
+關(guān)注
關(guān)注
1文章
1295瀏覽量
17516 -
芯片堆疊
+關(guān)注
關(guān)注
0文章
19瀏覽量
14881 -
陶瓷基板
+關(guān)注
關(guān)注
5文章
265瀏覽量
12414
原文標題:基于疊層組裝和雙腔體結(jié)構(gòu)的高密度集成技術(shù)
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
器件高密度BGA封裝設(shè)計
高密度印制電路板(HDI)簡介
高密度電路板的塞孔制程
探討高密度小間距LED屏工藝
高速高密度PCB設(shè)計的關(guān)鍵技術(shù)問題是什么?
高密度PCB(HDI)檢驗標準
Cyntec高密度uPOL模塊的特點
什么是高密度DDR芯片
揭秘高密度有機基板:分類、特性與應(yīng)用全解析

光纖高密度odf是怎么樣的
高密度配線架和中密度的區(qū)別
高密度疊層母排 (Laminated Busbar) 雜散電感優(yōu)化指南




 基于疊層組裝和雙腔體結(jié)構(gòu)的高密度集成技術(shù)
基于疊層組裝和雙腔體結(jié)構(gòu)的高密度集成技術(shù)





評論