越來越大,供電和散熱也面臨著巨大的挑戰。Chiplet(芯粒)技術是SoC集成發展到當今時代,摩爾定律逐漸放緩情況下,持續提高集成度和芯片算力的重要途徑。工業界近期已經有多個基于Chiplet的產品
2022-08-18 09:59:58 1476
1476 Chiplet可以使用更可靠和更便宜的技術制造。較小的硅片本身也不太容易產生制造缺陷。此外,Chiplet芯片也不需要采用同樣的工藝,不同工藝制造的Chiplet可以通過先進封裝技術集成在一起。
2022-10-06 06:25:00 29744
29744 最近兩天經常看到Chiplet這個詞,以為是什么新技術呢,google一下這不就是幾年前都在提的先進封裝嗎。最近資本市場帶動了芯片投資市場,和chiplet有關的公司身價直接飛天。帶著好奇今天扒一扒
2022-10-20 17:42:16 8824
8824 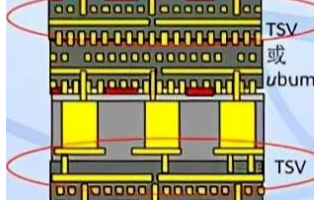
先進封裝處于晶圓制造與封測的交叉區域 先進封裝處于晶圓制造與封測制程中的交叉區域,涉及IDM、晶圓代工、封測廠商。先進封裝要求在晶圓劃片前融入封裝工藝步驟,具體包括應用晶圓研磨薄化、重布線(RDL
2023-08-07 10:59:46 3328
3328 
Redistribution layer (再分布層,RDL),是添加到集成電路或微芯片中以重新分配電氣連接的金屬層。這種RDL技術是一種用于集成電路(IC)的先進封裝解決方案,允許將多個芯片集成到
2023-12-06 18:18:29 42013
42013 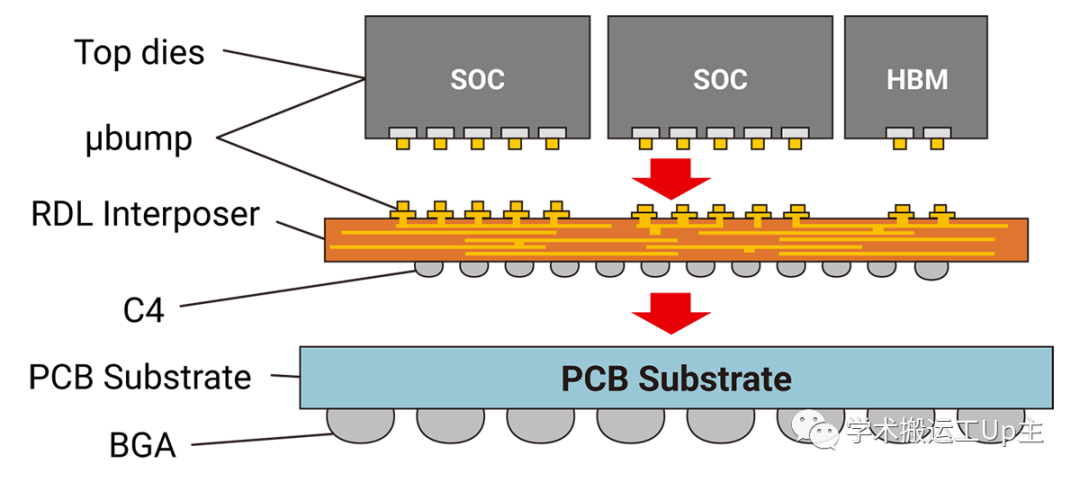
上篇文章提到用于 IC 封裝的再分布層(RDL)技術Redistribution layer, RDL 的基本概念是將 I/O 焊盤的位置分配到芯片的其他位置,即用RDL轉接到錫球焊接的著陸焊盤位置。
2023-12-06 18:19:48 17860
17860 
如之前的介紹用于 IC 封裝的再分布層(RDL)技術及晶圓級封裝中的窄間距RDL技術及應用]技術通常用于芯片封裝中的信號和電源引腳映射,用于實現芯片與封裝之間的連接。然而,對于高功率應用,尤其是需要傳輸大電流或高功率的電路,額外的考慮和技術措施是必要的。
2023-12-06 18:26:46 6069
6069 
隨著摩爾定律逐步達到極限,大量行業巨頭暫停了 7 nm 以下工藝的研發,轉而將目光投向先進封裝領域。其中再布線先行( RDL-first ) 工藝作為先進封裝技術的重要組成部分,因其具備高良率
2023-12-07 11:33:44 3904
3904 
可以應用于多種封裝平臺,包括PoP、系統級封裝(SiP)和芯片尺寸封裝( CSP)。這些優勢來源于一種稱為再分布層(Redistribution Layer, RDL)的先進互連技術。
2025-01-22 14:57:52 4508
4508 
`三種SMA接口pcb封裝`
2016-01-25 16:04:41
大的電流。然而,在高頻情況下線圈阻抗也變成高阻抗了。對于一個給定的驅動器電壓幅度,線圈電流反比于線圈阻抗。因此影響磁場的兩個相反因素是電流和頻率。實現高頻磁場是很困難的。本文討論了三種幫助高頻亥姆霍茲線圈產生強磁場的技術。
2019-06-24 08:16:49
三種常見的PCB錯誤是什么
2021-03-12 06:29:32
三種常見的光刻技術方法根據暴光方法的不同,可以劃分為接觸式光刻,接近式光刻和投影式光刻三種光刻技術。 ◆投影式暴光是利用透鏡或反射鏡將掩膜版上的圖形投影到襯底上的暴光方法.在這種暴光方法中,由于掩膜
2012-01-12 10:56:23
的開發周期和極大的靈活性。圖9顯示了一個SiP封裝中引線鍵合、倒裝芯片和硅片鍵合各有所用,共同存在的情況。這三種封裝內部連接方式將一起長期被應用在未來的半導體封裝當中。5 結論隨著集成電路的發展,封裝
2018-11-23 17:03:35
下面跟大家分享Altium Designer畫元器件封裝的三種方法。如有錯誤,望大家指正。
2019-07-22 06:47:13
PCB設計技術會對下面三種效應都產生影響: 1. 靜電放電之前靜電場的效應 2. 放電產生的電荷注入效應 3. 靜電放電電流產生的場效應 但是,主要是對第三種效應產生影響。下面的討論
2018-08-29 10:28:15
QFP(quad flat package)四側引腳扁平封裝。表面貼裝型封裝之一,引腳從四個側面引出呈海鷗翼(L)型。基材有 陶 瓷、金屬和塑料三種。
2020-04-07 09:01:08
QSPI特點QSPI三種工作模式
2020-12-31 06:36:55
while的三種使用形式是什么樣的?
2021-11-02 08:35:34
關于In-Cell、On-Cell、OGS三種屏幕技術的知識點看完你就懂了
2021-06-03 06:22:30
關于TFT-LCD的三種廣視角技術解析,不看肯定后悔
2021-06-04 06:09:29
多芯片整合封測技術--種用先進封裝技術讓系統芯片與內存達到高速傳輸ASIC 的演進重復了從Gate Array 到Cell Base IC,再到系統芯片的變遷,在產業上也就出現了,負責技術開發的IC
2009-10-05 08:11:50
(b)、圖1(c)分別給出了三種不同引線鍵合(Non-Wire Bond)的集成功率模塊技術:(a)嵌人功率器件(CPES,1999),(b)層疊式器件PowerOverlay,(c)倒裝芯片法
2018-11-23 16:56:26
、AuSn、In等。 3.3 3D封裝 3D封裝主要有三種類型,即埋置型3D封裝,當前主要有三種途徑:一種是在各類基板內或多層布線介質層中"埋置"R、C或IC等元器件,最上層再貼
2018-09-12 15:15:28
先進封裝發展背景晶圓級三維封裝技術發展
2020-12-28 07:15:50
下表對WCDMA、TD-SCDMA和CDMA2000三種主流標準的主要技術性能進行了比較。其中僅有TD—SCDMA方式使用了智能天線、聯合檢測和同步CDMA等先進技術,所以在系統容量、頻譜利用率和抗干擾能力方面具有突出的優勢。
2019-07-03 06:50:57
進程類型進程的三種狀態
2021-04-02 07:06:39
研究院(先進電子封裝材料廣東省創新團隊)、上海張江創新學院、深圳集成電路設計產業化基地管理中心、桂林電子科技大學機電工程學院承辦的 “第二期集成電路封裝技術 (IC Packaging
2016-03-21 10:39:20
3G技術發展趨勢及三種技術比:
2009-06-19 15:27:05 38
38 教你如何識別和挑選LED三種背光技術
百大家電工程師解釋:目前市面上的LED液晶產品在背光技術上主要分為三種:直下式、RGB直下式和側光式。
&n
2009-12-01 10:34:28 1599
1599 三種投影機散熱技術是哪三種
如今在日常的學習、工作、生活中,投影機的應用越來越頻繁。由于投影機屬于高
2010-02-06 10:33:41 635
635 激光顯示技術目前有三種光源技術方式,一種以紅、綠、藍(RGB)三基色激光為光源(以下簡稱 RGB 光源技術),一種以藍色激光激發熒光粉產生紅光、綠光不直接透過的藍色激光為光源(以下簡稱 LPL 光源
2017-09-29 10:17:59 16
16 本文以MIMO技術為中心,主要介紹了mimo技術的三種模式介紹,mimo技術作用,mimo技術種類以及mimo技術在生活當中的應用。
2017-12-12 15:58:51 68338
68338 
我們在看各種投影機廣告和參數表時,經常能看到3LCD、DLP之類的詞匯。視頻內容給大家普及投影知識小知識——三種主流投影儀技術類型。3LCD、DLP和LCOS其實是投影機的技術分類,也就是投影機實現
2018-12-18 10:39:43 30655
30655 關鍵詞:液晶面板 五年之前關于液晶面板的爭論就已經開始了,不過那個時候制造商們一致認為三種主流面板技術IPS、VA和TN最終只會留存一種,其他兩種技術將被淘汰。不過五年后的現在看到三種技術還在并存
2019-02-19 12:43:01 1662
1662 大體來說,無人零售需要三種技術方案及對應的軟硬件配置:一是采用機器視覺、傳感器融合技術和設備部署;二是采用成熟的RFID標簽識別技術和設備部署,三是采用二維碼識別技術。
2020-03-26 11:17:17 3801
3801 MEMS器件利用半導體加工技術來制造三維機械結構,三種最常用的MEMS制造技術包括體微加工(Bulk Micro Machining)、表面微加工(Surface Micro Machining)和LIGA。
2020-07-29 17:42:58 8760
8760 在實現物聯網的短距無線通訊技術里面,藍牙、Wi-Fi、zigbee是目前應用最為廣泛的三種短距無線通訊技術。
2020-08-18 17:27:54 4986
4986 
SiP和Chiplet也是長電科技重點發展的技術。“目前我們重點發展幾種類型的先進封裝技術。首先就是系統級封裝(SiP),隨著5G的部署加快,這類封裝技術的應用范圍將越來越廣泛。其次是應用于
2020-09-17 17:43:20 10638
10638 技術發展方向 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2020-10-12 11:34:36 19530
19530 
目前人們如果想探測環境深度信息,主要依賴于三種技術,分別是相機陣列, TOF(time of flight)技術,以及基于結構光的深度探測技術。
2021-01-05 02:30:00 5
5 一項技術能從相對狹窄的專業領域變得廣為人知,有歷史的原因,也離不開著名公司的推波助瀾,把SiP帶給大眾的是蘋果(Apple),而先進封裝能引起公眾廣泛關注則是因為臺積電(TSMC)。 蘋果說,我的i
2021-04-01 16:07:24 37630
37630 
通富微電、華天科技也表示已儲備Chiplet相關技術。Chiplet是先進封裝技術之一,除此以外,先進封裝概念股也受到市場關注。4連板大港股份表示已儲備TSV、micro-bumping(微凸點)和RDL等先進封裝核心技術。
2022-08-08 12:01:23 1646
1646 超高速、超高密度和超低延時的封裝技術,用來解決Chiplet之間遠低于單芯片內部的布線密度、高速可靠的信號傳輸帶寬和超低延時的信號交互。目前主流的封裝技術包括但不限于MCM、CoWoS、EMIB等。
2022-08-17 11:33:24 2570
2570 因此,該行業已轉向使用chiplet來組合更大的封裝,以繼續滿足計算需求。將芯片分解成許多chiplet并超過標線限制(光刻工具的圖案化限制的物理限制)將實現持續縮放,但這種范例仍然存在問題。即使
2022-08-24 09:46:33 3016
3016 近日, 芯動科技高速接口IP三件套之明星產品--Innolink?Chiplet互連解決方案, 相繼亮相第二屆中國互連技術與產業大會、智東西Chiplet公開課。芯動科技技術總監高專分享了兩場專業
2022-12-23 20:55:03 2907
2907 ”和“功能墻”)制約,以芯粒(Chiplet)異質集成為核心的先進封裝技術,將成為集成電路發展的關鍵路徑和突破口。文章概述近年來國際上具有“里程碑”意義的先進封裝技術,闡述中國大陸先進封裝領域發展的現狀與優勢,分析中國大陸先進封裝關鍵技術與世界先進水平的差距,最后對未來中國大陸先進封裝發展提出建議。
2022-12-28 14:16:29 6381
6381 Chiplet 封裝領域,目前呈現出百花齊放的局面。Chiplet 的核心是實現芯片間的高速互 聯,同時兼顧多芯片互聯后的重新布線。
2023-01-05 10:15:28 1623
1623 先進封裝/Chiplet可以釋放一部分先進制程產能,使之用于更有急迫需求的場景。從上文分析可見,通過降制程和芯片堆疊,在一些沒有功耗限制和體積空間限制、芯片成本不敏感的場景,能夠減少對先進制程的依賴。
2023-01-31 10:04:16 5493
5493 與SoC相反,Chiplet是將一塊原本復雜的SoC芯片,從設計時就先按照不同的計算單元或功能單元對其進行分解,然后每個單元選擇最適合的半導體制程工藝進行分別制造,再通過先進封裝技術將各個單元彼此互聯,最終集成封裝為一個系統級芯片組。
2023-03-29 10:59:32 3937
3937 Chiplet技術對芯片設計與制造的各個環節都帶來了劇烈的變革,首當其沖的就是chiplet接口電路IP、EDA工具以及先進封裝。
2023-04-03 11:33:33 868
868 全球化的先進制程中分一杯羹,手機、HPC等需要先進制程的芯片供應受到嚴重阻礙,亟需另辟蹊徑。而先進封裝/Chiplet等技術,能夠一定程度彌補先進制程的缺失,用面積和堆疊換取算力和性能。
2023-04-15 09:48:56 4395
4395 Android開發——近場通信技術特點分析及對比三種近場通信技術特點 NFC 主要技術特點 Blue Tooth 主要技術特點 WIFI 主要技術特點 三種技術對比三種近場通信技術的未來應用場
2023-05-19 17:44:42 0
0 三種近場通信技術的特點 1、三種類別 1、藍牙 2、WIFI 3、NFC 2、三種技術的特點以及應用場景 1、藍牙 2、WIFI 3、NFC特點: 二、三種近場通信技術的未來展望 1、藍牙 2
2023-05-25 17:20:19 0
0 目錄三種近場通信技術的特點——①NFC 三種近場通信技術的特點——②WiFi 三種近場通信技術的特點——③藍牙 未來近場通信技術的應用場景的分析與預測 三種近場通信技術的特點——①NFC NFC
2023-05-18 11:15:04 2
2 先進封裝是對應于先進圓晶制程而衍生出來的概念,一般指將不同系統集成到同一封裝內以實現更高效系統效率的封裝技術。
2023-06-13 11:33:24 878
878 
一、核心結論 ?1、先進制程受限,先進封裝/Chiplet提升算力,必有取舍。在技術可獲得的前提下,提升芯片性能,先進制程升級是首選,先進封裝則錦上添花。 2、大功耗、高算力的場景,先進封裝
2023-06-13 11:38:05 2117
2117 
隨著摩爾定律的放緩以及前沿節點復雜性和成本的增加,先進封裝正在成為將多個裸片集成到單個封裝中的關鍵解決方案,并有可能結合成熟和先進的節點。
2023-06-16 17:50:09 1597
1597 
來源:光學半導體與元宇宙Chiplet將滿足特定功能的裸芯片通過Die-to-Die內部互聯技術,實現多個模塊芯片與底層基礎芯片的系統封裝,實現一種新形勢的IP復用。Chiplet將是國內突破技術
2023-05-16 09:20:49 2711
2711 
先進的半導體封裝既不是常規操作,目前成本也是相當高的。但如果可以實現規模化,那么該行業可能會觸發一場chiplet革命,使IP供應商可以銷售芯片,顛覆半導體供應鏈。
2023-06-21 08:56:39 879
879 Chiplet俗稱“芯粒”或“小芯片組”,通過將原來集成于同一 SoC 中的各個元件分拆,獨立 為多個具特定功能的 Chiplet,分開制造后再通過先進封裝技術將彼此互聯,最終集成封裝 為一個系統芯片。
2023-06-25 15:12:20 3864
3864 
組合成為特定功能的大系統。那么半導體Chiplet技術分別有哪些優點和缺點呢? 一、核心結論 1. 先進制程受限,先進封裝/Chiplet提升算力,必有取舍。 在技術可獲得的前提下,提升芯片性能,先進制程升級是首選,先進封裝則錦上添花。 2. 大功耗、高算
2023-06-25 16:35:15 4307
4307 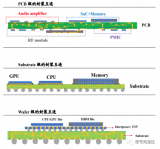
Chiplet 俗稱“芯粒”或“小芯片組”,通過將原來集成于同一 SoC 中的各個元件分拆,獨立 為多個具特定功能的 Chiplet,分開制造后再通過先進封裝技術將彼此互聯,最終集成封裝 為一個系統芯片。
2023-07-04 10:23:22 1964
1964 
Chiplet,就是小芯片/芯粒,是通過將原來集成于同一系統單晶片中的各個元件分拆,獨立為多個具特定功能的Chiplet,分開制造后再透過先進封裝技術將彼此互聯,最終集成封裝為一系統晶片組。
2023-07-06 11:28:23 1210
1210 
1. 先進制程受限,先進封裝/Chiplet提升算力,必有取舍。
2023-07-07 09:42:04 3279
3279 
Chiplet技術是一種利用先進封裝方法將不同工藝/功能的芯片進行異質集成的技術。這種技術設計的核心思想是先分后合,即先將單芯片中的功能塊拆分出來,再通過先進封裝模塊將其集成為大的單芯片。
2023-07-17 09:21:50 7024
7024 
半導體產業正在進入后摩爾時代,Chiplet應運而生。介紹了Chiplet技術現狀與接口標準,闡述了應用于Chiplet的先進封裝種類:多芯片模塊(MCM)封裝、2.5D封裝和3D封裝,并從技術特征
2023-07-17 16:36:08 2169
2169 
level package),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2023-08-05 09:54:29 1021
1021 
(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。免責聲明:本文轉自網絡,版權歸原作者所有,如涉及作品版權問題,
2023-08-14 09:59:24 1258
1258 
先進封裝技術以SiP、WLP、2.5D/3D為三大發展重點。先進封裝核心技術包括Bumping凸點、RDL重布線、硅中介層和TSV通孔等,依托這些技術的組合各廠商發展出了滿足多樣化需求的封裝解決方案,SiP系統級封裝、WLP晶圓級封裝、2.5D/3D封裝為三大發展重點。
2023-09-28 15:29:37 4970
4970 
Chiplet主流封裝技術都有哪些?? 隨著處理器和芯片設計的發展,芯片的封裝技術也在不斷地更新和改進。Chiplet是一種新型的封裝技術,它可以將不同的芯片功能模塊制造在不同的芯片中,并通過
2023-09-28 16:41:00 2931
2931 此時先進封裝開始嶄露頭角,以蘋果和臺積電為代表,開啟了一場新的革命,其主要分為兩大類,一種是基于XY平面延伸的先進封裝技術,主要通過RDL進行信號的延伸和互連;第二種則是基于Z軸延伸的先進封裝技術,主要通過TSV進行信號延伸和互連。
2023-10-10 17:04:30 2241
2241 
半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2023-10-31 09:16:29 3859
3859 
、主流技術和應用場景,以及面臨的挑戰和問題。進而提出采用Chiplet技術,將不同的功能模塊獨立集成為獨立的Chiplet,并融合在一個AI芯片上,從而實現更高的計算能力。該設計不僅允許獨立開發和升級各個模塊,還可在封裝過程中將它們巧妙組合起
2023-12-08 10:28:07 2174
2174 
Chiplet技術是一種將集成電路設計和制造的方法,其中一個芯片被分割成多個較小的獨立單元,這些單元通常被稱為“chiplets”。每個chiplet可以包含特定的功能塊、處理器核心、內存單元或其他
2024-01-08 09:22:08 6862
6862 level package),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。 審核編輯 黃宇
2024-02-21 10:34:20 1565
1565 
什么是Chiplet技術?Chiplet技術是一種在半導體設計和制造中將大型芯片的不同功能分解并分散實現在多個較小和專用的芯片(Chiplets)上的方法。這些較小的芯片隨后通過高速互連方式集成到一個封裝中,共同實現全功能的芯片系統。
2024-01-25 10:43:32 4059
4059 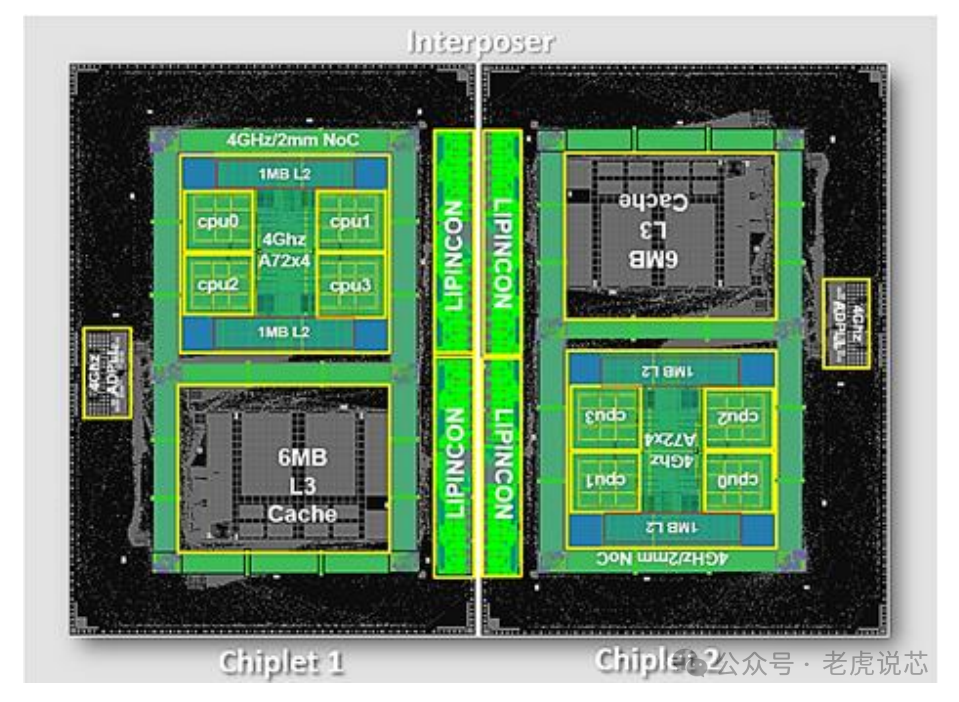
的基礎。而Chiplet先進封裝技術讓AI訓練/推理芯片的量產成為可能,所以AI網絡的物理層底座即芯片先進封裝技術。“ AI技術的發展極大地推動了對先進封裝技術的需求,在高密度,高速度,高帶寬這“三高”方面提出了嚴苛的要求。 高密度:?AI芯片通常
2024-09-11 09:47:02 1888
1888 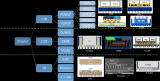
文章來源:學習那些事 原文作者:新手求學 RDL是一層布線金屬互連層,可將I/O重新分配到芯片的不同位置。 Redistribution layer(RDL)是將半導體封裝的一部分電連接到另一
2024-09-20 16:29:37 3696
3696 
談一談先進封裝中的互連工藝,包括凸塊、RDL、TSV、混合鍵合,有哪些新進展?可以說,互連工藝是先進封裝的關鍵技術之一。在市場需求的推動下,傳統封裝不斷創新、演變,出現了各種新型的封裝結構。 下游
2024-11-21 10:14:40 4681
4681 
混合鍵合技術(下) 先進封裝技術(Semiconductor Advanced Packaging) - 3 Chiplet 異構集成(上) 先進封裝技術(Semiconductor
2024-12-06 11:37:46 3694
3694 
混合鍵合技術(下) 先進封裝技術(Semiconductor Advanced Packaging) - 3 Chiplet 異構集成(上) 先進封裝技術(Semiconductor
2024-12-06 11:43:41 4730
4730 
Chiplet標志著半導體創新的新時代,封裝是這個設計事業的內在組成部分。然而,雖然Chiplet和封裝技術攜手合作,重新定義了芯片集成的可能性,但這種技術合作并不是那么簡單和直接。 在芯片封裝中
2024-12-10 11:04:52 1261
1261 
的示意圖和實物照片,顯示了垂直互聯結構。 XY平面和Z軸延伸的關鍵技術 現代先進封裝可分為兩種主要方式:XY平面延伸和Z軸延伸。XY平面延伸主要利用重布線層(RDL)技術進行信號布線,而Z軸延伸則采用硅通孔(TSV)技術實現垂直連接。 圖2展示了扇入和扇出
2024-12-18 09:59:38 2451
2451 
在先進封裝技術蓬勃發展的背景下,瑞沃微先進封裝:1、首創面板級化學I/O鍵合技術。2、無載板鍵合RDL一次生成技術。3、新型TSV/TGV技術。4、新型Bumping技術。5、小于10微米精細線寬RDL技術。6、新型巨量轉移貼片技術等六大技術緊隨其后!
2024-12-03 13:49:08 1387
1387 
混合鍵合技術(下) 先進封裝技術(Semiconductor Advanced Packaging) - 3 Chiplet 異構集成(上) 先進封裝技術(Semiconductor
2024-12-24 10:57:32 3383
3383 
混合鍵合技術(下) 先進封裝技術(Semiconductor Advanced Packaging) - 3 Chiplet 異構集成(上) 先進封裝技術(Semiconductor
2024-12-24 10:59:43 3078
3078 
Hello,大家好,今天我們來聊聊,先進封裝中RDL工藝。 RDL:Re-Distribution Layer,稱之為重布線層。是先進封裝的關鍵互連工藝之一,目的是將多個芯片集成到單個封裝中。先在介
2025-01-03 10:27:24 5838
5838 
如今,算力極限挑戰正推動著芯片設計的技術邊界。Chiplet的誕生不僅僅是技術的迭代,更是對未來芯片架構的革命性改變。然而,要真正解鎖Chiplet技術的無限潛力, 先進封裝技術 成為了不可或缺
2025-01-05 10:18:07 2060
2060 
混合鍵合技術(下) 先進封裝技術(Semiconductor Advanced Packaging) - 3 Chiplet 異構集成(上) 先進封裝技術(Semiconductor
2025-01-08 11:17:01 3032
3032 
封裝方式的演進,2.5D/3D、Chiplet等先進封裝技術市場規模逐漸擴大。 傳統有機基板在先進封裝中面臨晶圓翹曲、焊點可靠性問題、封裝散熱等問題,硅基封裝晶體管數量即將達技術極限。 相比于有機基板,玻璃基板可顯著改善電氣和機械性能,
2025-01-09 15:07:14 3196
3196 
在新能源時代,鋰電池作為核心動力與儲能單元,其重要性不言而喻。而在鋰電池的諸多特性中,封裝形狀這一外在表現形式,實則蘊含著復雜的技術考量與工藝邏輯。方形、圓柱、軟包三種主流封裝形狀,各自對應著獨特
2025-02-17 10:10:38 2228
2228 
封裝中的RDL(Redistribution Layer,重分布層)是集成電路封裝設計中的一個重要層次,主要用于實現芯片內電氣連接的重新分配,并且在封裝中起到連接芯片和外部引腳之間的橋梁作用。RDL的設計和實現直接影響到封裝的電氣性能、可靠性和制造成本。
2025-03-04 17:08:35 4660
4660 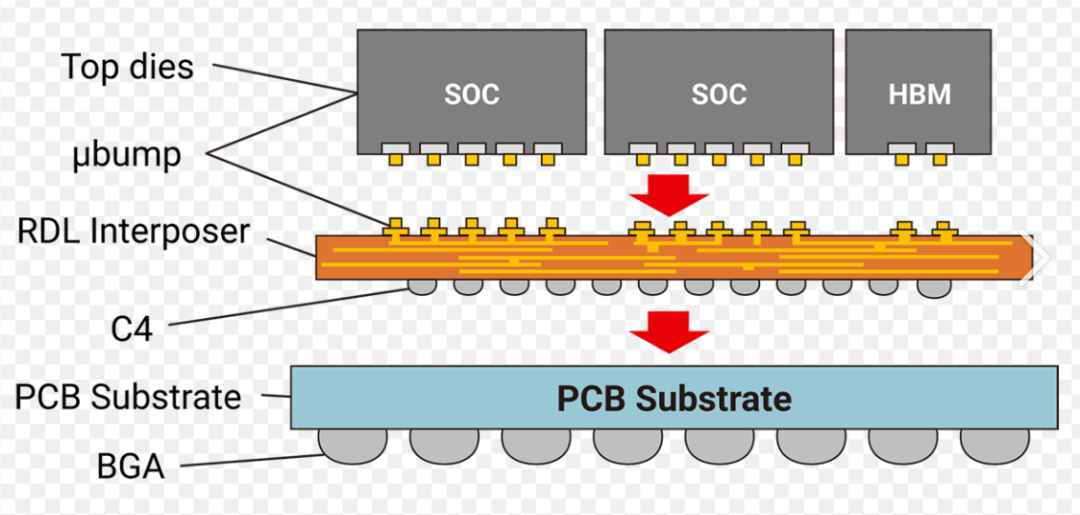
隨著半導體行業的技術進步,尤其是摩爾定律的放緩,芯片設計和制造商們逐漸轉向了更為靈活的解決方案,其中“Chiplet”和“先進封裝”成為了熱門的概念。
2025-04-14 11:35:18 1170
1170 
Chiplet和先進封裝通常是互為補充的。Chiplet技術使得復雜芯片可以通過多個相對較小的模塊來實現,而先進封裝則提供了一種高效的方式來將這些模塊集成到一個封裝中。
2025-04-21 15:13:56 1839
1839 
引發行業高度關注,為其在芯片領域的持續創新注入強大動力。 堆疊封裝,創新架構 華為公布的 “一種芯片堆疊封裝及終端設備” 專利顯示,其芯片堆疊封裝技術通過將多個芯片或芯粒(Chiplet)以堆疊方式成在同一封裝體內,實
2025-06-19 11:28:07 1256
1256 前面分享了先進封裝的四要素一分鐘讓你明白什么是先進封裝,今天分享一下先進封裝四要素中的再布線(RDL)。
2025-07-09 11:17:14 3219
3219 
 電子發燒友App
電子發燒友App









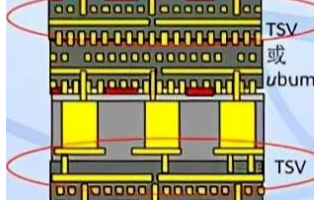

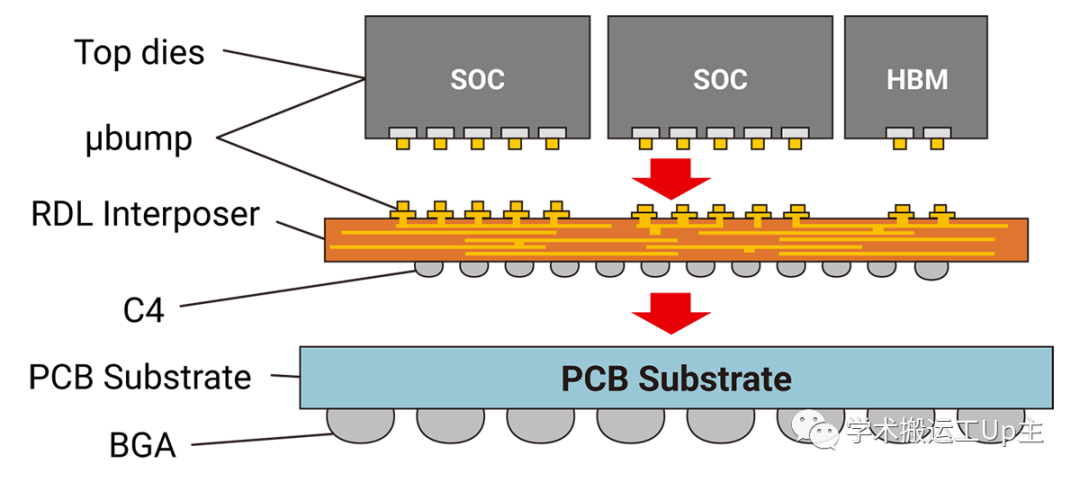














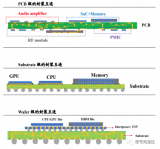












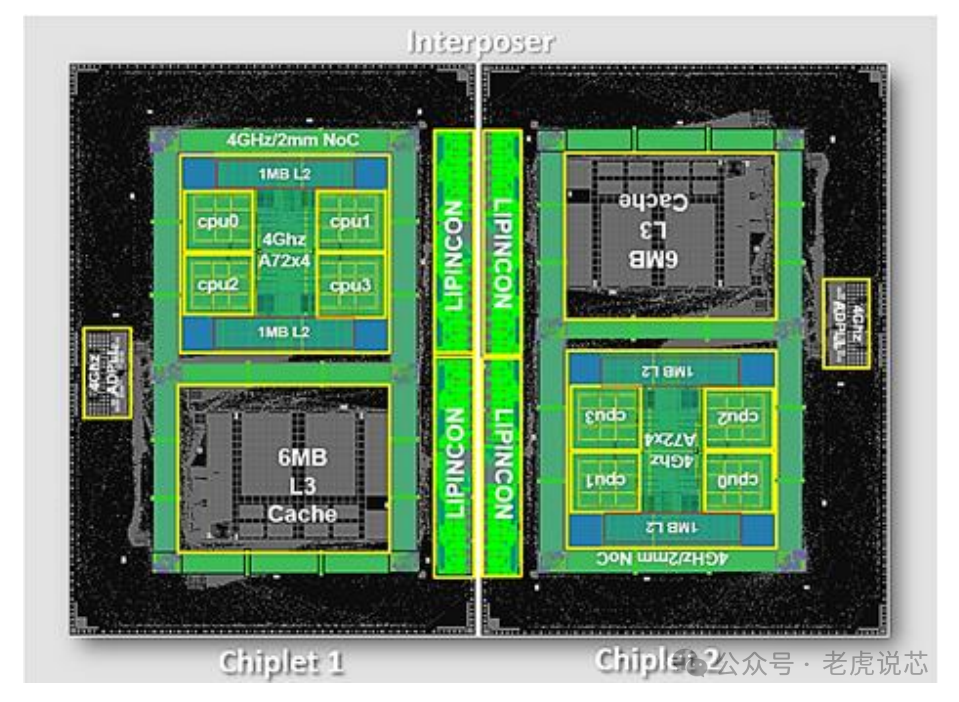
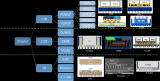














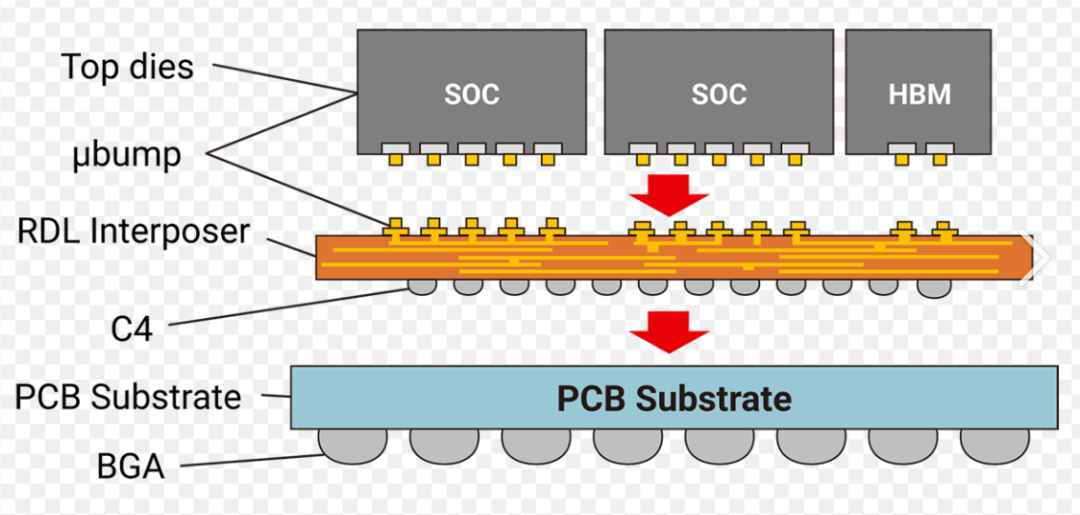






評論