ZnO是一種寬帶隙半導體,可摻雜為透明導電氧化物(TCO),用于無機和有機光伏器件,為了更好地理解ZnO薄膜的腐蝕過程,我們華林科納發現了一種原子力顯微鏡(AFM)重新排列腐蝕步驟的方法,使用這種方法,觀察了多晶ZnO薄膜上HCl腐蝕的發展,結果表明這種觀察方法沒有改變蝕刻行為,停止和重新開始蝕刻也沒有改變侵蝕點,表明HCl侵蝕點是隨著它們的生長而形成在膜中的。此外我們華林科納研究了先前在KOH中蝕刻的ZnO表面上的HCl蝕刻的演變,并且發現酸性和堿性溶液的蝕刻位置是相同的。我們的結論是,在生長過程中,誘導加速腐蝕的“特殊”缺陷形成于薄膜中,并且這些缺陷可以以與單晶ZnO中的螺旋位錯類似的方式延伸部分或全部穿過薄膜。
多晶ZnO:Al薄膜通過使用射頻(RF)-濺射(VISS 300,VAAT)在清潔的康寧玻璃襯底上沉積大約800 nm的ZnO:Al來制備,為了將樣品可重復地定位在多個蝕刻步驟之間的m級上,使用了四種逐漸變小的對準方法,如圖1所示:a)使用金剛石尖端進行大規模手動標記,用于樣品的mm級對準b)使用光刻制備的網格在30 μm內排列樣品,網格由直徑約3-4 μm、間距為8 μm、厚度為50 nm的熱蒸發銀點組成,選擇缺陷作為標記和掃描區域,因為它們獨特地分布在ZnO表面上,并提供大的可用掃描區域c)使用大型AFM (SIS nanostation 300)掃描來進一步定位(在1米內)Ag網格中的感興趣的缺陷d)感興趣的區域,在這種情況下大約為12*12 m2,沿著銀點精確對準并掃描。
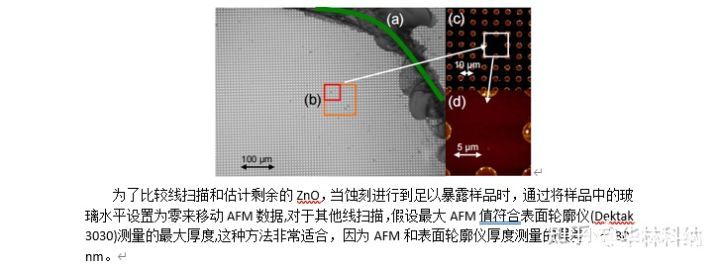
?
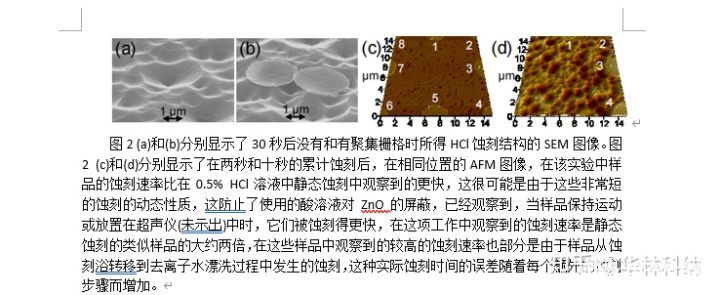
在蝕刻過程的不同步驟中在ZnO表面的相同位置拍攝的AFM圖像中,即使蝕刻過程被停止和重新開始許多次,在隨后的蝕刻步驟中也選擇了相同的攻擊點,在同一位置進行單線掃描時,這一點更加明顯,相對于總掃描面積的線的位置,雖然一些蝕刻位點在最初的蝕刻步驟中存在,然后消失,而其他的僅在稍后出現,但是大多數存在于整個蝕刻過程中。蝕刻18秒后,在一些點上到達玻璃,而其它點的厚度仍超過660 nm,表明蝕刻位置和膜表面其它位置之間的蝕刻速率可變化約4.5倍。
進一步的AFM數據分析產生了原始ZnO材料剩余的部分,作為累積蝕刻時間的函數,線性擬合與數據的匹配度高達18秒,表明ZnO以3.9 %/s的恒定速率被蝕刻,在更長時間內與另一線性擬合1.9 %/s的偏差可歸因于幾個因素,首先,18秒是玻璃第一次出現的時間點,與早期蝕刻步驟相比,暴露于HCl溶液中的ZnO較少;第二,在玻璃出現后,進行更長的蝕刻步驟(4秒而不是2秒)。這種較長的蝕刻時間可以允許更大的屏蔽效果。
為了進一步研究腐蝕位置的發展,現在將這種方法應用于酸性和堿性溶液中的腐蝕,KOH蝕刻的表面結構較軟,但蝕刻點的密度與圖中觀察到的類似,這與之前的結論一致。
從AFM數據中,提取了不同蝕刻步驟的線跡,雖然攻擊點在鹽酸蝕刻中變得更加明顯,但攻擊點通常已經在氫氧化鉀蝕刻中存在,由于氧化鋅是一種兩性氧化物,所以它在堿性和酸性溶液中同時蝕刻也就不足為奇了,有趣的是,這些溶液攻擊相同的點,而在單晶中,O端和鋅表面分別禁止在堿和鋅端表面蝕刻,只有在缺陷時才可能。
從鹽酸蝕刻的演變,可以得出結論,在生長過程中,攻擊點是建立在薄膜中的,如果攻擊點是由于樣品在鹽酸溶液中的狀態或氧化鋅表面的特定吸附物,氫氧化鉀和鹽酸攻擊相同的觀點,支持了這一結論。進一步得出結論,蝕刻攻擊是由結構缺陷引起的,而不是像極性這樣的局部化學性質,因為極性在酸和堿中的作用是不同的。這些多晶ZnO:Al膜具有大約50-200nm的晶粒尺寸,因此具有比蝕刻點高得多的缺陷密度,為了解釋ZnO的蝕刻行為,假設存在某些在酸性和堿性溶液中蝕刻更快的“特殊”缺陷,這些缺陷通常貫穿整個薄膜,但它們似乎也具有短程效應:蝕刻位點可能始于ZnO薄膜的表面或本體中的某處,并可能貫穿薄膜的一部分或全部。
使用AFM重新定位方法,已經能夠在小的蝕刻步驟之間成像相同的位置,利用這種技術,研究了多晶ZnO上HCl腐蝕的演化,以及在酸性和堿性溶液中腐蝕的關系,具體來說,觀察到停止和重新開始蝕刻過程不會改變侵蝕點,酸性和堿性溶液都會侵蝕相同的點,結果我們排除了靠近膜表面的溶液狀態和作為蝕刻催化劑的吸附分子,因為這兩個因素在蝕刻步驟之間會改變,還排除了局部化學效應,如鋅微晶的極性,因為在酸性和堿性溶液中蝕刻的攻擊點不同,我們得出結論,在生長過程中,在薄膜中存在引起加速蝕刻的特殊缺陷,并且這些缺陷可以以與單晶ZnO中的螺旋位錯類似的方式延伸部分或全部穿過薄膜。
審核編輯:湯梓紅
 電子發燒友App
電子發燒友App















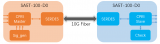




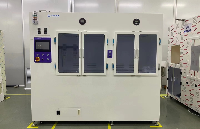



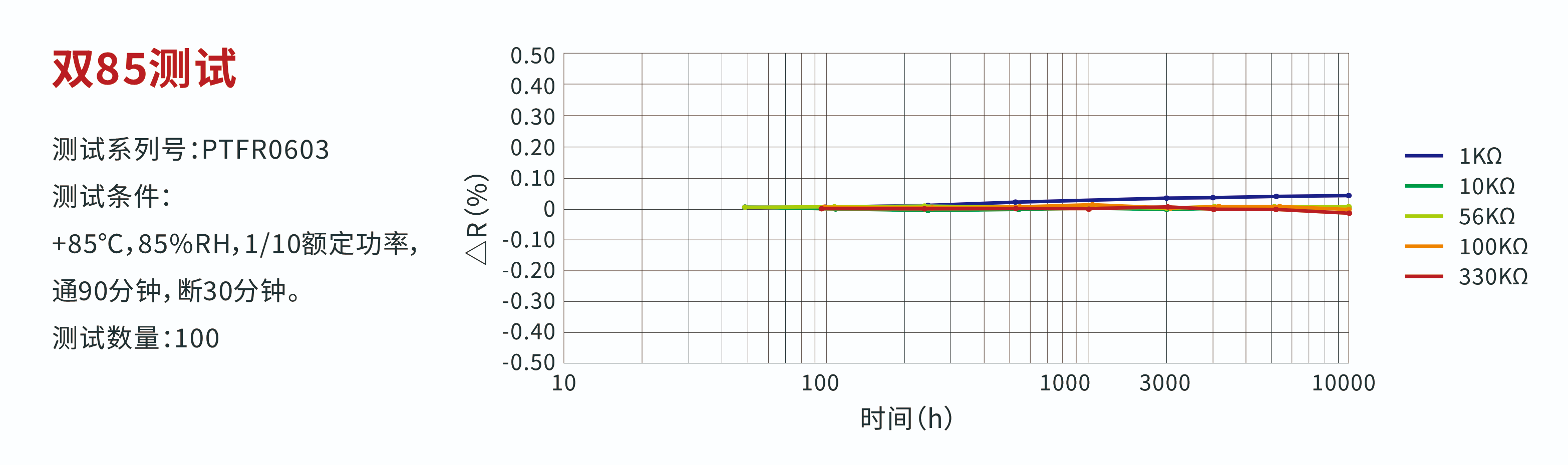
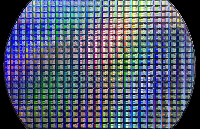


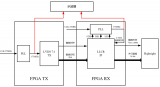








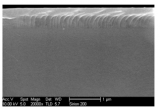

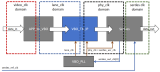










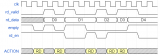

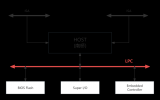
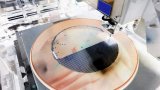






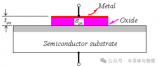
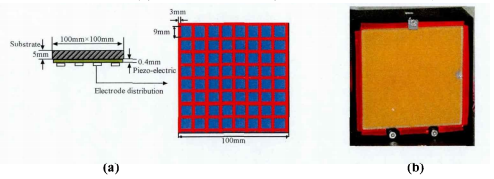












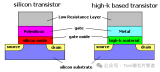

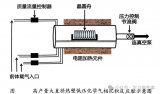






評論