薄膜厚度的測量在芯片制造和集成電路等領域中發揮著重要作用。橢偏法具備高測量精度的優點,利用寬譜測量方式可得到全光譜的橢偏參數,實現納米級薄膜的厚度測量。Flexfilm全光譜橢偏儀可以非接觸對薄膜的厚度與折射率的高精度表征,廣泛應用于薄膜材料、半導體和表面科學等領域。
為解決半導體領域常見的透明硅基底上薄膜厚度測量的問題并消除硅層的疊加信號,本文提出基于光譜干涉橢偏法的偏振分離式馬赫曾德測量系統,以近紅外飛秒激光器為光源,獨立探測偏振信息,針對硅基底上二氧化硅薄膜開展測量,且該方法適用于透明或非透明基底薄膜測量,無需檢測矯正步驟或光源更換,可應用于化學氣相沉積、分子束外延等薄膜制備工藝成品的高精度檢測。
1
橢偏儀基本原理
flexfilm

光譜干涉解算原理
橢偏法通過測量經過樣品透射或反射的橢偏參數 (ψ,Δ) 并結合非線性最小二乘迭代過程,擬合得到薄膜的參數信息。
橢偏參數主要包括水平偏振分量p和垂直偏振分量s的振幅比和相位差,以反射型為例:

Rp:水平偏振分量的復振幅反射系數;Rs:垂直偏振分量的復振幅反射系數;i:虛數單位
不同偏振分量的復振幅反射系數可表示為:

r1,r2為與每一層的復折射率 N 和入射角 θ1有關的不同介質界面的振幅反射系數
正交的偏振分量的表示方法不同,可通過菲涅爾公式推導得到;β為薄膜的位相厚度,可表示為:

N 為薄膜層的復折射率;h為薄膜層的幾何厚度;θ2為薄膜中的折射角;λ為光在真空中的波長。多層介質膜的橢偏參數可通過導納矩陣和遞推關系得到。
在其他條件固定時,橢偏參數是薄膜折射率、厚度和波長的函數,因相位差比強度比更具準確性與靈敏度,獲取寬光譜橢偏參數后,利用多波長下的相位差可準確解耦薄膜厚度。光譜干涉橢偏法能獲取水平偏振分量Ip和垂直偏振分量Is的光譜干涉強度信息。

將正交的偏振分量的相位作差即可得到橢偏參數,利用非線性最小二乘迭代橢偏公式,即可擬合得到薄膜的待測信息。
2
實驗系統
flexfilm
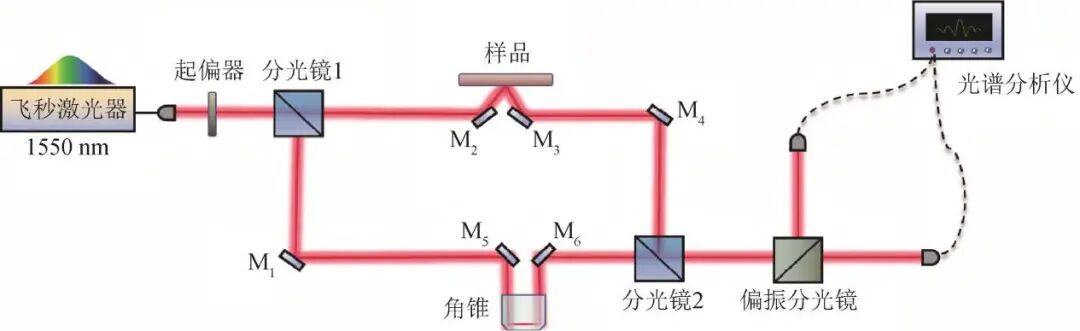
偏振分離式實驗裝置圖
實驗所用光源為實驗室自制的非線性偏振旋轉型光纖飛秒激光器,其中心波長為 1550 nm,輸出功率約 8 mW,半高寬約 50 nm。種子光經準直器輸出平行光進入空間系統,經過起偏器產生偏振方向為 45° 的線偏光,該線偏光被分光鏡 1 分成兩束進入馬赫曾德系統,一束光傾斜照射到待測樣品上,另一束光經過角錐產生等臂光束,這兩束光在分光鏡 2 處合光,最終由偏振分光鏡分成正交偏振的兩束光,分別被光譜分析儀探測。

系統標定初相位(a)干涉圖(b)初相位

傅里葉變換域
由于各光學元件表面鍍有介質膜,在測量過程中會引入系統誤差,因此需要利用單面拋光的未鍍膜純硅片進行初相位標定,待測橢偏相位需減去該標定初相位。為進一步判斷相位的準確性及系統的可復現性,通過移動角錐改變系統的初始光程,光程變化范圍設定為 0.4 ~ 1.5 mm,觀察移動過程中標定相位是否發生變化。從中可分析出依次上移 0.1rad 的偏置情況。為初步驗證系統測量透明基底的可行性,利用該實驗系統測量了雙面拋光的純硅片,通過傅里葉域濾波過程,能夠消除后表面的誤差信號,進而消除硅層的疊加信號。
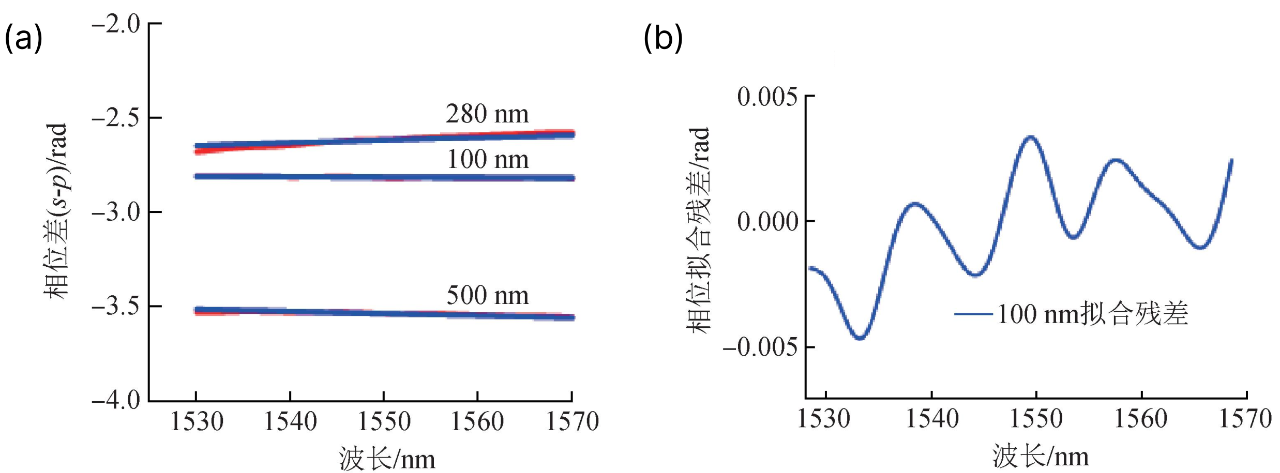
角度擬合結果
為標定入射角,實驗采用三個標稱膜厚值分別為100nm、280nm、500nm的沉積在單拋硅基底上的二氧化硅薄膜作為樣品,并利用商用橢偏儀在1500 ~ 1600 nm光譜范圍和 0.1nm 光譜分辨力下提前對這些樣品的膜厚值進行測量,將測量結果作為已知值。以入射角作為迭代目標,以實測橢偏相位和理論橢偏相位為研究對象,找出殘差最小處的入射角度,經過迭代計算和平均后,確定入射角為 48.4°。
3
實驗結果
flexfilm
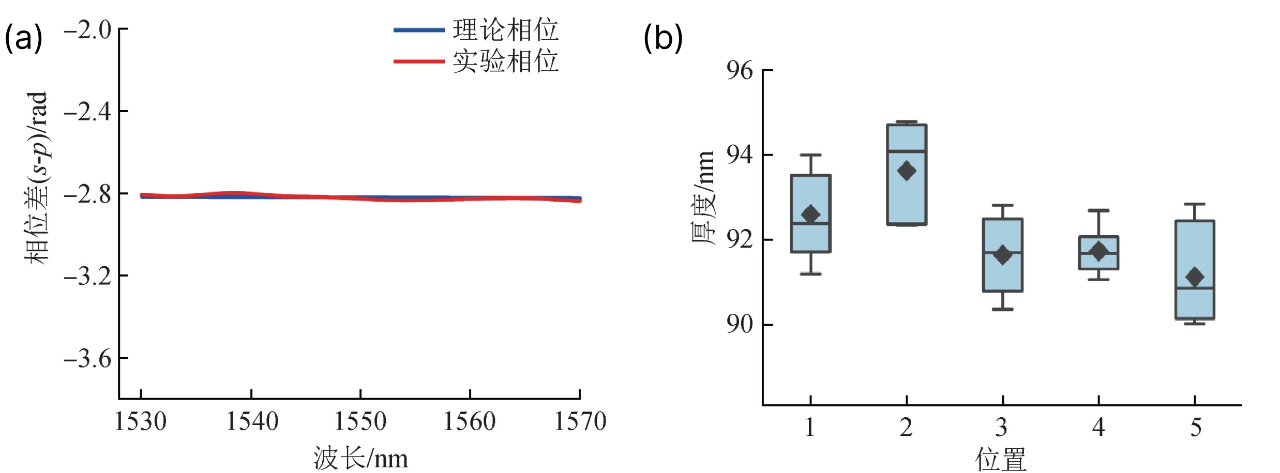
(a)實驗和理論相位(b)測量結果
實驗以透明雙拋硅基底上鍍二氧化硅薄膜作為樣品,以 100nm 厚度的薄膜為例,測試該系統的薄膜厚度測量效果。

樣品5個位置的測量結果
該系統對膜厚的測量精度可達到納米級,對應相位差的穩定性可達10-3,這主要得益于光譜干涉法的高測量精度。為衡量測量結果的準確性,利用商用橢偏儀在待測中心區域選擇相同的 5 個位置(由于無法保證商用橢偏儀和實驗測量位置完全相同,因此采用 5 次測量結果的平均值來評估測量結果的準確性)進行測量,商用橢偏儀的厚度測量平均值為 92.04nm,實驗的厚度測量平均值為 92.3nm,考慮到樣品的均勻性誤差和儀器的測量誤差,該測量結果處于誤差允許范圍內。
本文提出了基于光譜干涉橢偏法的透明基底上薄膜厚度測量方法,建立了偏振分離式馬赫曾德測量系統,并針對雙拋硅基底上所鍍二氧化硅薄膜厚度開展測量實驗,以驗證基于光譜干涉橢偏法的薄膜厚度測量方法的可行性與準確性。實驗結果表明,該方法能夠有效消除硅層的疊加信號,針對 100nm 厚度的二氧化硅薄膜,實現了納米級的測量標準差。基于光譜干涉橢偏法的薄膜厚度測量方法具有準確性高、抗擾動性好的優點,可應用于對精度要求較高的光刻制造、顯示設備研發、集成電路研制等領域。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領域中單層或多層納米薄膜的層構參數(如厚度)和物理參數(如折射率n、消光系數k)
- 先進的旋轉補償器測量技術:無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術,高信噪比的探測技術。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm全光譜橢偏儀能非破壞、非接觸地原位精確測量超薄圖案化薄膜的厚度、折射率,結合費曼儀器全流程薄膜測量技術,助力半導體薄膜材料領域的高質量發展。
原文參考:《基于光譜干涉橢偏法的薄膜厚度測量》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
半導體
+關注
關注
339文章
30895瀏覽量
265143 -
薄膜
+關注
關注
1文章
363瀏覽量
46232 -
厚度測量
+關注
關注
0文章
18瀏覽量
6963
發布評論請先 登錄
橢偏儀的原理和應用 | 薄膜材料或塊體材料光學參數和厚度的測量

橢偏儀在半導體的應用|不同厚度c-AlN外延薄膜的結構和光學性質




 橢偏儀在半導體薄膜厚度測量中的應用:基于光譜干涉橢偏法研究
橢偏儀在半導體薄膜厚度測量中的應用:基于光譜干涉橢偏法研究






評論