關鍵詞:反應離子刻蝕,加載和滯后效應,微掩膜,氮化鎵,GaAs,磷化銦,納米光子學
摘要
本文將描述反應離子刻蝕技術的一般方面,如各向異性、負載效應、滯后效應、反應離子刻蝕化學和微掩模,然后簡要概述刻蝕電介質(二氧化硅、氮化硅)和晶體硅。論文的第二部分致力于蝕刻ⅲ-ⅴ族化合物半導體,其中基于氮化鎵材料的反應離子刻蝕結果,揭示了一種簡單實用的熱力學方法,解釋了選擇蝕刻特定材料的最佳化學物質的標準,并解釋了氮化鎵蝕刻結果。最后,將討論使用各種化學物質蝕刻磷化銦基材料的綜合研究,以及它們的各種光子應用。
介紹
等離子體蝕刻、干法蝕刻和反應離子蝕刻(RIE)都描述了處理技術,這些技術具有共同的第四種物質狀態:等離子體,也稱為材料的電離狀態。等離子體狀態描述了一種情況,其中一種或多種氣體被保持在一定的壓力下,并被施加電勢,導致氣體原子的部分電離[1]。在等離子體中,正離子、自由基和電子共存。大約30年前,大多數半導體器件的工業工藝嚴重依賴濕法蝕刻技術;然而,等離子體工藝,更具體地說是RIE,逐漸取代了濕法蝕刻技術。這是因為它們具有優異的均勻性、可重復性,更重要的是,隨著允許批量處理的設備的出現,它們具有高產量。
文獻中已經廣泛報道了干法蝕刻的主題,并且涵蓋了跨越電介質(氧化物和氮化物)、聚合物、半導體材料甚至金屬的各種化學和材料。本文旨在提供一種實用的方法來解決與各種材料的等離子體蝕刻有關的問題。
反應離子刻蝕的一般方面
滯后效應:RIE滯后效應是對特征尺寸導致的蝕刻深度差異的限定。例如,當通過掩模中不同的開口尺寸進行蝕刻時,與較小尺寸的開口相比,大的開口區域中的蝕刻深度可以大得多。這種不均勻蝕刻與蝕刻反應物和產物進出蝕刻孔的擴散過程有關:尺寸越小,反應物到達孔底部所需的時間越長。類似地,蝕刻產物向外擴散需要更長的時間。圖2很好地說明了這種反應離子刻蝕滯后效應,顯示了一個使用Cl2 :Ar:H2刻蝕磷化銦的電感耦合等離子體反應離子刻蝕工藝的掃描電鏡照片。圖案由寬度從1米到100納米的直線(溝槽)組成,以100納米的步長變化,溝槽之間的間隙也相應變化。值得注意的是,最小開口處(300納米及以下)蝕刻深度的減少是顯著的。
CCP和電感耦合等離子體系統中的直流偏置:在電容耦合(CCP)反應器中,當產生一定的放電時,施加到下電極的射頻功率與所謂的直流偏壓直接相關:在與離子電荷和電極電勢成比例的撞擊能量下,負電勢響應或吸引位置到電極。當增加射頻功率時,等離子體變得更致密,直流偏壓也增加。因此,在這種反應器中,等離子體密度與較高的直流偏壓相關,從而產生較高的離子轟擊。
干蝕刻中的各向異性,負載作用,微掩蔽,化學選擇 略
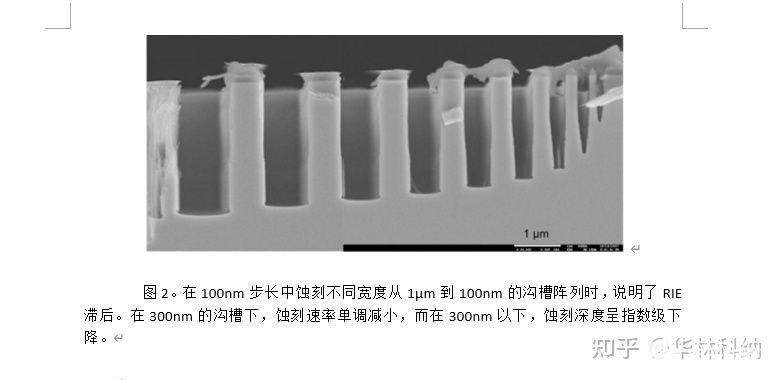
硅、二氧化硅和氮化硅的干法刻蝕
硅、多晶硅和無定形硅、二氧化硅和氮化硅通常在氟基化學中被蝕刻,其中蝕刻產物主要是揮發性的四氧化硅。因此,在這些材料中可以獲得相當好的蝕刻速率,這取決于反應器精確使用化學及其應用。根據具體情況,可以考慮不同的變化,例如用于蝕刻硅的CHF3和SF6,其中SF6是主要的化學試劑,CHF3提供一些鈍化,實現各向異性蝕刻。在這一類別中,博世工藝最為人所知。它需要兩種氣體的混合物,其中一種確保材料的良好蝕刻,而第二種產生鈍化層以抑制側壁蝕刻。SF6是選擇用于硅的快速蝕刻的氣體,而C4F8是鈍化氣體。在博世工藝中,兩種氣體交替使用,通常SF6在較低壓力下運行7–8秒(以產生垂直蝕刻 ,而C4F8在較高壓力下運行2–3秒,以增強側壁鈍化。因此,后者在晶片水平表面以及蝕刻的側壁上產生薄保護層。
ⅲ-ⅴ族半導體的干法刻蝕
氮化鎵的干法刻蝕 略
其他ⅲ-ⅴ族半導體的反應離子刻蝕
基于cl2的化學及其子變體,用于蝕刻基于砷化鎵-、InP-和基于gan的結構,用于各種器件應用。主要的蝕刻成分是與所有III和V元素發生反應的氯自由基。可以根據應用程序考慮許多子變體。h2通常作為一種鈍化劑添加,允許更好的各向異性和更平滑的側壁。這對于蝕刻波導(集成光學和激光器)非常重要。或者,甲烷也可以添加到氯氣:h2組合中進行額外的鈍化,但這將會減緩蝕刻速率,同時惡化對所使用的掩模的選擇性。另一種替代氯氣:h2混合物是添加少量的Ar,這可以更好地平衡物理蝕刻和鈍化,從而導致高各向異性和光滑的側壁。當Al是iii元素之一時,氯氣:甲烷:H2是一種可能性,但更常見的是三氯化硼或四氯化硅可以被添加到氯氣中。另一種常見的組合是氯氣:O2,這是一種流行的化學方法,可以實現phc型模式中的高長寬比,其中孔的直徑通常在200-300nm的范圍內,所需的蝕刻深度為3μm或更多。
為了實現高縱橫比結構,如PhC柱和DBR光柵反射鏡,在400納米SiNx上使用ZEP520A抗蝕劑的標準技術失敗了,因為需要更厚和更抗蝕的掩模來實現亞微米圖案。能夠蝕刻較厚掩模層的一個簡單技巧是使用水平掩模;即。添加耐氟等離子體的中間金屬層。中間金屬層可以是鉻或鋁,兩種金屬氟化物都是非揮發性的。因此,這種三級技術是在500納米二氧化硅上使用50或60納米鉻層開發的 。
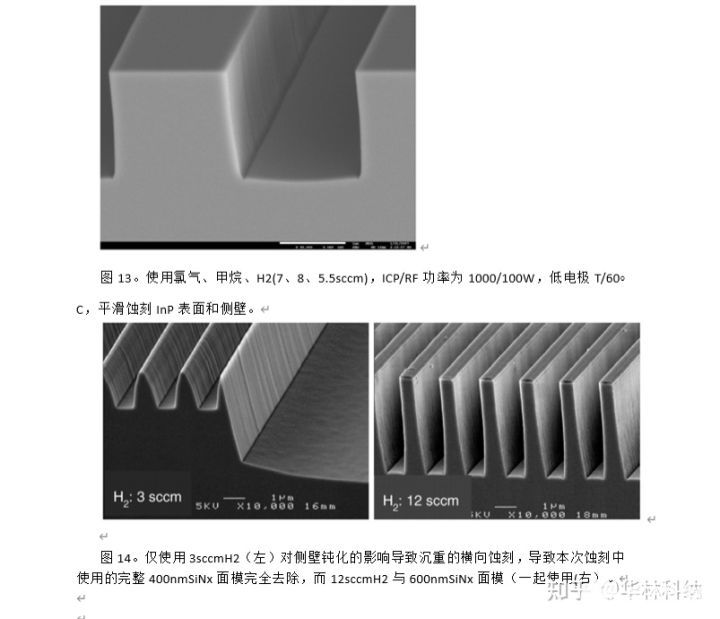
結論
我們描述了RIE的一般但重要的方面,如各向異性、加載效應、滯后效應、直流偏倚、化學選擇,并對其進行了廣泛的實驗研究微掩蔽,我們演示了如何避免蝕刻inp基的典型微掩蔽材料。后一個簡短的部分Si,SiOx和SiNx,詳細研究蝕刻氮化鎵,包括大型討論部分解釋氮化鎵蝕刻率增加四倍時引入六氟化硫氯化氣體,使用一個簡單的方法和熱力學數據。最后,綜述和討論了四種蝕刻inp基結構的化學方法。
審核編輯:鄢孟繁
 電子發燒友App
電子發燒友App










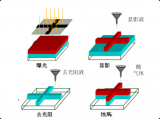



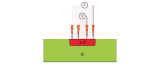

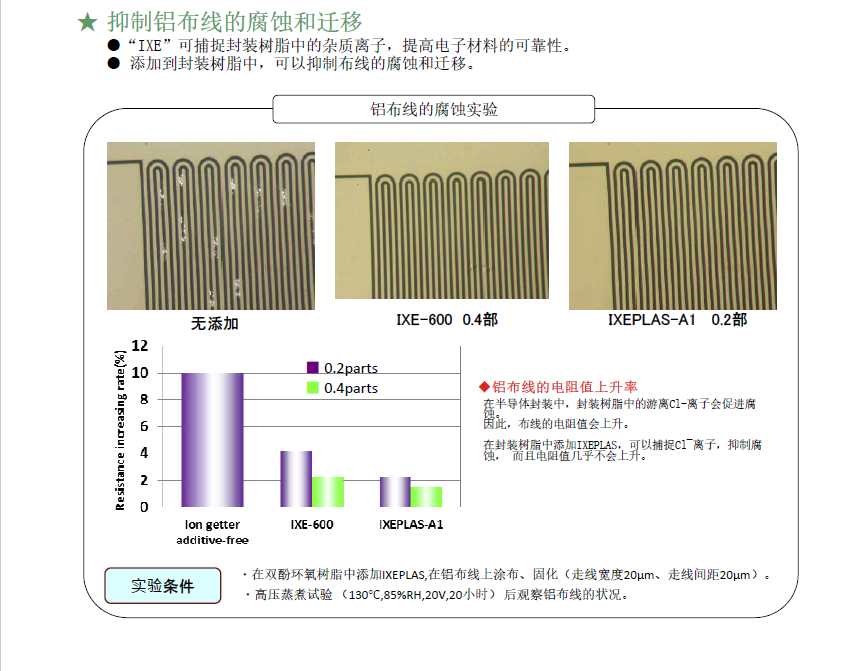
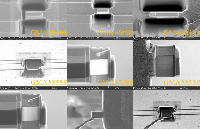



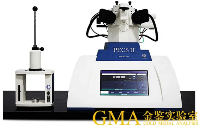
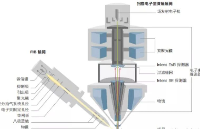





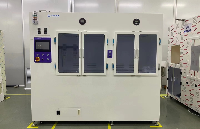



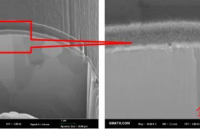
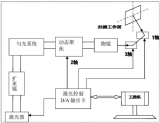


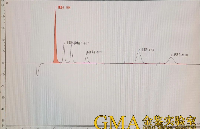








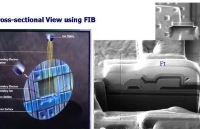

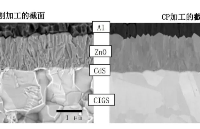
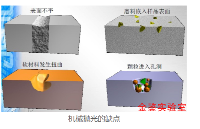




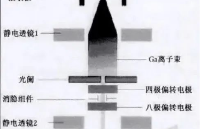



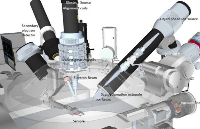
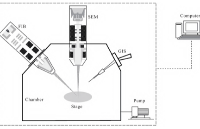







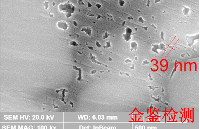




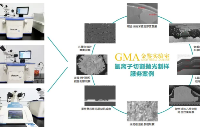
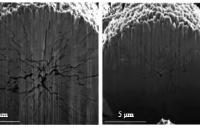

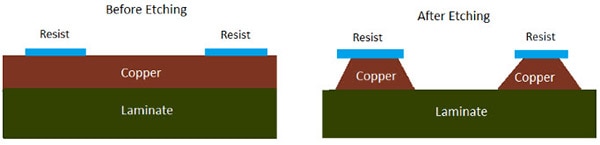




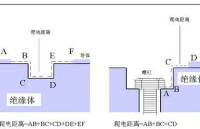
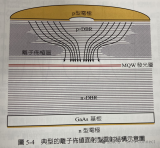





評論