文章來源:學(xué)習(xí)那些事
原文作者:前路漫漫
本文主要講述離子注入后的質(zhì)量測量與工藝管控。
離子注入后的質(zhì)量測量與工藝管控
在集成電路制造的離子注入工藝中,完成離子注入與退火處理后,需對(duì)注入結(jié)果進(jìn)行嚴(yán)格的質(zhì)量檢查,以確保摻雜效果符合器件設(shè)計(jì)要求。當(dāng)前主流的質(zhì)量檢查方法主要有兩種:四探針法與熱波法,兩種方法各有特點(diǎn),適用于不同的檢測場景。
質(zhì)量測量方法
1. 四探針法
四探針法的核心原理是通過兩對(duì)探針分別測量電壓與電流,計(jì)算得到半導(dǎo)體材料的薄層電阻,其檢測裝置結(jié)構(gòu)如圖 1 所示。具體操作中,將四根探針按一定間距接觸晶圓表面,其中外側(cè)兩根探針通入恒定電流,內(nèi)側(cè)兩根探針測量電流流經(jīng)晶圓時(shí)產(chǎn)生的電壓降;根據(jù)歐姆定律與特定計(jì)算公式,可推導(dǎo)得出晶圓表面摻雜層的薄層電阻。

薄層電阻是反映摻雜效果的關(guān)鍵參數(shù),其數(shù)值直接與摻雜濃度和 PN 結(jié)深度相關(guān):摻雜濃度越高,薄層電阻越小;結(jié)深越大,薄層電阻也會(huì)相應(yīng)變化。因此,通過四探針法測量的薄層電阻,可直接評(píng)估摻雜工藝的準(zhǔn)確性與均勻性。該方法屬于直接測量技術(shù),測量結(jié)果精度較高,但由于探針需與晶圓表面直接接觸,會(huì)對(duì)晶圓造成輕微物理影響,更適合用于晶圓批次的抽樣檢測,而非全量量產(chǎn)晶圓的檢測。
2. 熱波法
熱波法是一種基于熱波擴(kuò)散原理的間接測量技術(shù),其核心機(jī)制為:當(dāng)激光照射硅襯底表面時(shí),會(huì)在襯底內(nèi)部激發(fā)熱波并向內(nèi)部擴(kuò)散;若襯底內(nèi)存在離子注入后形成的晶格缺陷(如原子排列紊亂區(qū)域),熱波的擴(kuò)散會(huì)受到阻擋,導(dǎo)致該區(qū)域的熱密度高于無缺陷區(qū)域;熱密度差異會(huì)使襯底表面產(chǎn)生微小的熱膨脹,進(jìn)而改變硅材料的反射率。通過檢測反射率的變化幅度與分布,可間接判斷晶圓內(nèi)晶格損傷的程度;而晶格損傷的嚴(yán)重程度與離子注入劑量呈正相關(guān),因此可進(jìn)一步反推出摻雜劑量的大小,實(shí)現(xiàn)對(duì)摻雜效果的評(píng)估。
熱波法具有嚴(yán)格的檢測時(shí)效性,需在離子注入工藝剛完成后立即進(jìn)行 —— 若延遲檢測,晶格缺陷可能隨時(shí)間自然恢復(fù),導(dǎo)致熱波信號(hào)發(fā)生變化,影響測量準(zhǔn)確性。該方法最大的優(yōu)勢(shì)是非破壞性,無需與晶圓表面直接接觸,不會(huì)對(duì)晶圓造成損傷,因此適用于量產(chǎn)晶圓的全量檢測;但其缺點(diǎn)也較為明顯:測量精度低于四探針法,且熱波信號(hào)易受環(huán)境溫度、激光功率穩(wěn)定性等因素影響,長期穩(wěn)定性較差。
離子注入工藝中的常見問題及解決方案
在離子注入工藝實(shí)施過程中,易出現(xiàn)多種問題,影響摻雜質(zhì)量與器件性能,主要包括晶圓充電、顆粒沾污、金屬沾污及工藝缺陷四類,需針對(duì)性采取管控措施。
1. 晶圓充電
離子注入設(shè)備運(yùn)行時(shí),大量高能電子會(huì)轟擊并附著在晶圓表面,導(dǎo)致晶圓帶電(即晶圓充電)。這種現(xiàn)象對(duì) MOS 器件中的薄柵氧介質(zhì)層危害極大 —— 二氧化硅(SiO?)的介電強(qiáng)度約為 10MV/cm,若柵氧厚度為 4nm,其擊穿電壓僅需 4V;晶圓表面的電荷積累易產(chǎn)生局部高壓,導(dǎo)致柵氧介質(zhì)層擊穿,引發(fā)器件失效。
針對(duì)晶圓充電問題,行業(yè)主要采用兩種解決方案:一是在設(shè)備中增設(shè)專門設(shè)計(jì)的電子槍,通過發(fā)射低能電子中和晶圓表面的多余電荷,減少高能電子對(duì)晶圓的轟擊;二是在晶圓附近設(shè)置正電荷吸附裝置,利用正負(fù)電荷相互吸引的原理,中和晶圓表面的負(fù)電荷,避免電荷積累。
2. 顆粒沾污
隨著集成電路特征尺寸不斷縮小,器件內(nèi)部結(jié)構(gòu)的尺寸已達(dá)到納米級(jí)別,若晶圓表面或注入腔體內(nèi)存在微小顆粒(如塵埃、工藝殘留碎屑),這些顆粒可能會(huì)阻擋離子束的運(yùn)動(dòng)路徑 —— 尤其在低能離子注入場景中,離子束穿透力較弱,更易被顆粒阻擋。一旦發(fā)生這種情況,顆粒遮擋區(qū)域的襯底無法接受離子注入,導(dǎo)致該區(qū)域未形成預(yù)期的摻雜層,影響器件的電學(xué)性能(如導(dǎo)通電阻異常、漏電流增大),最終造成芯片良率下降。顆粒沾污導(dǎo)致的未摻雜區(qū)域示意圖如圖 2 所示,圖中中間區(qū)域因被顆粒遮擋,未形成摻雜層。
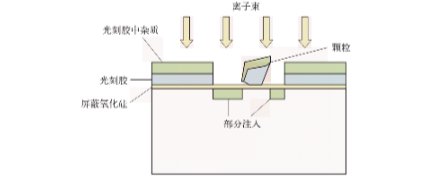
解決顆粒沾污問題的核心在于強(qiáng)化清潔管控:一是在離子注入工藝前,增加晶圓表面的清潔步驟(如 RCA 清洗、兆聲清洗),徹底去除晶圓表面的顆粒與有機(jī)物殘留;二是定期對(duì)離子注入設(shè)備的腔體、離子束通道進(jìn)行清潔維護(hù),減少設(shè)備內(nèi)部的顆粒積累;三是在工藝環(huán)境中采用高效空氣過濾器(HEPA),降低潔凈室內(nèi)的顆粒濃度,從源頭減少顆粒沾污的風(fēng)險(xiǎn)。
3. 金屬沾污
離子注入機(jī)中的質(zhì)量分析器主要通過 “荷質(zhì)比”(電荷與質(zhì)量的比值)篩選目標(biāo)摻雜離子,但部分金屬離子的荷質(zhì)比與目標(biāo)摻雜離子的荷質(zhì)比完全相同,導(dǎo)致質(zhì)量分析器無法區(qū)分,金屬離子會(huì)隨目標(biāo)離子一同被注入晶圓,造成金屬沾污。這種沾污屬于可動(dòng)離子沾污,金屬離子在后續(xù)高溫工藝中會(huì)發(fā)生遷移,進(jìn)入器件的有源區(qū)或柵氧層,導(dǎo)致器件閾值電壓漂移、漏電流增大等問題。例如,鉬離子(Mo?)與三氟化硼離子(BF??)的荷質(zhì)比均為 1:49,質(zhì)量分析器無法將兩者分離,Mo?的混入會(huì)對(duì)晶圓造成嚴(yán)重的金屬沾污。
為避免金屬沾污,需從設(shè)備材料選型入手:摒棄傳統(tǒng)的不銹鋼材料作為離子源容器,改用化學(xué)性質(zhì)穩(wěn)定、不易釋放金屬離子的石墨或鉭材料 —— 石墨與鉭在高溫下幾乎不產(chǎn)生金屬離子揮發(fā),可有效減少金屬離子的引入,降低金屬沾污風(fēng)險(xiǎn)。
4. 工藝缺陷
離子注入工藝中的缺陷主要由 “溝道效應(yīng)” 與 “注入陰影效應(yīng)” 引起,兩種效應(yīng)均會(huì)導(dǎo)致?lián)诫s分布異常,影響器件性能。
溝道效應(yīng):當(dāng)注入離子的運(yùn)動(dòng)方向與硅晶格的原子排列方向一致時(shí),離子易沿晶格間隙穿行,導(dǎo)致?lián)诫s深度遠(yuǎn)大于設(shè)計(jì)值,形成 “過深摻雜”。這種效應(yīng)會(huì)破壞 PN 結(jié)的預(yù)期結(jié)構(gòu),導(dǎo)致器件擊穿電壓降低、漏電流增大。為抑制溝道效應(yīng),行業(yè)普遍采用 “傾斜入射” 方案 —— 調(diào)整離子束與晶圓表面的夾角,使離子運(yùn)動(dòng)方向偏離硅晶格的間隙方向,增加離子與晶格原子的碰撞概率,限制離子的穿透深度,確保摻雜深度符合設(shè)計(jì)要求。
注入陰影效應(yīng):傾斜入射方案雖能解決溝道效應(yīng),但會(huì)引發(fā)新的問題 —— 若晶圓表面存在凸起結(jié)構(gòu)(如多晶硅柵極),傾斜的離子束會(huì)被凸起結(jié)構(gòu)阻擋,在凸起結(jié)構(gòu)后方形成 “陰影區(qū)域”,該區(qū)域無法接受離子注入,導(dǎo)致局部未摻雜,如圖 3 所示(圖中向上箭頭所指處為陰影區(qū)域)。這種效應(yīng)會(huì)導(dǎo)致器件有源區(qū)摻雜不完整,影響器件的導(dǎo)通性能。針對(duì)注入陰影效應(yīng),需通過優(yōu)化離子束傾斜角度、調(diào)整晶圓定位精度等方式,減少陰影區(qū)域的面積;同時(shí),在器件設(shè)計(jì)階段,合理規(guī)劃凸起結(jié)構(gòu)的尺寸與分布,避免大面積陰影區(qū)域的形成。

離子注入工藝的安全注意事項(xiàng)
離子注入是半導(dǎo)體工業(yè)中風(fēng)險(xiǎn)較高的工藝之一,涉及化學(xué)、電磁、機(jī)械、輻射四類安全隱患,需嚴(yán)格遵守安全操作規(guī)程,確保人員與設(shè)備安全。
安全操作的通用準(zhǔn)則為:若發(fā)生安全事故,現(xiàn)場人員應(yīng)立即撤離至安全區(qū)域,避免盲目處置;事故處理與調(diào)查工作需由接受過專業(yè)培訓(xùn)的人員負(fù)責(zé),確保處置過程的安全性與專業(yè)性。
1. 化學(xué)安全
大部分離子注入所用的摻雜源材料具有劇毒、易燃易爆特性:例如,砷化氫(AsH?)、磷化氫(PH?)、乙硼烷(B?H?)均屬于易燃易爆氣體,且具有強(qiáng)烈毒性;磷(P)、硼(B)、砷(As)、銻(Sb)等摻雜元素的單質(zhì)或化合物也具有毒性;三氟化硼(BF?)作為常用摻雜源,具有強(qiáng)腐蝕性,其與空氣中的水分反應(yīng)會(huì)生成氫氟酸(HF),對(duì)人體皮膚、呼吸道及設(shè)備部件造成腐蝕。
針對(duì)化學(xué)安全風(fēng)險(xiǎn),需采取多重防護(hù)措施:一是在工藝區(qū)域設(shè)置氣體泄漏檢測裝置,實(shí)時(shí)監(jiān)測摻雜源氣體濃度,一旦發(fā)生泄漏立即觸發(fā)報(bào)警并切斷氣源;二是操作人員在接觸摻雜源材料或進(jìn)行設(shè)備內(nèi)部部件濕法清洗時(shí),需佩戴雙層防護(hù)手套(內(nèi)層為普通潔凈室手套,外層為耐化學(xué)腐蝕的橡膠手套),避免皮膚直接接觸腐蝕性物質(zhì);三是定期對(duì)氣體輸送管道、閥門進(jìn)行密封性檢測,防止氣體泄漏。
2. 電磁安全
離子注入機(jī)內(nèi)部的加速電極需施加高壓(最高可達(dá) 50kV)以加速離子束,高壓系統(tǒng)存在電擊風(fēng)險(xiǎn)。操作人員需避免在設(shè)備運(yùn)行時(shí)接觸高壓部件,設(shè)備需設(shè)置接地保護(hù)裝置,防止高壓泄漏;同時(shí),設(shè)備外殼需采用絕緣材料,減少電磁輻射對(duì)人員的影響。
3. 機(jī)械安全
離子注入設(shè)備包含多種可移動(dòng)部件(如晶圓傳輸機(jī)械臂、腔體門閥),且部分部件在運(yùn)行時(shí)會(huì)處于高溫狀態(tài)(如離子源加熱部件),易引發(fā)機(jī)械碰撞或燙傷事故。需在設(shè)備可移動(dòng)部件的運(yùn)動(dòng)路徑上設(shè)置安全防護(hù)欄與光電傳感器,一旦檢測到人員靠近立即停止運(yùn)動(dòng);高溫部件需加裝隔熱防護(hù)罩,并張貼高溫警示標(biāo)識(shí),避免人員誤觸。
4. 輻射安全
高能離子在加速過程中會(huì)激發(fā) X 射線輻射,雖設(shè)備正常運(yùn)行時(shí),X 射線會(huì)被腔體的屏蔽層阻擋,不會(huì)向外溢出,但仍需定期檢查屏蔽層的完整性(如是否存在裂縫、破損);操作人員需佩戴輻射劑量監(jiān)測儀,定期檢測輻射暴露劑量,確保符合安全標(biāo)準(zhǔn);設(shè)備需設(shè)置輻射泄漏報(bào)警裝置,一旦檢測到輻射超標(biāo)立即停機(jī),排查故障。
-
集成電路
+關(guān)注
關(guān)注
5447文章
12492瀏覽量
372994 -
晶圓
+關(guān)注
關(guān)注
53文章
5353瀏覽量
131809 -
離子注入
+關(guān)注
關(guān)注
5文章
70瀏覽量
10621
原文標(biāo)題:離子注入后的質(zhì)量測量與工藝管控
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
離子注入的特點(diǎn)
離子注入工藝 (課程設(shè)計(jì)資料)
離子注入知識(shí)常見問答
離子注入技術(shù)
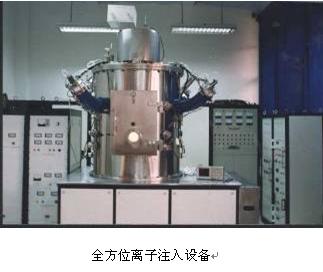
離子注入工藝的設(shè)計(jì)與計(jì)算簡介
半導(dǎo)體離子注入工藝評(píng)估

離子注入仿真用什么模型
什么是離子注入?離子注入的應(yīng)用介紹
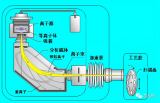
SiC的離子注入工藝及其注意事項(xiàng)
離子注入技術(shù)的常見問題






 離子注入工藝中的常見問題及解決方案
離子注入工藝中的常見問題及解決方案















評(píng)論