聚焦離子束技術(shù)(FIB)
聚焦離子束技術(shù)(Focused Ion beam,F(xiàn)IB)是利用電透鏡將離子束聚焦成非常小尺寸的離子束轟擊材料表面,實現(xiàn)材料的剝離、沉積、注入、切割和改性。隨著納米科技的發(fā)展,納米尺度制造業(yè)發(fā)展迅速,而納米加工就是納米制造業(yè)的核心部分,納米加工的代表性方法就是聚焦離子束。近年來發(fā)展起來的聚焦離子束技術(shù)(FIB)利用高強度聚焦離子束對材料進(jìn)行納米加工,配合掃描電鏡(SEM)等高倍數(shù)電子顯微鏡實時觀察,成為了納米級分析、制造的主要方法。目前已廣泛應(yīng)用于半導(dǎo)體集成電路修改、離子注入、切割和故障分析等。
FIB在產(chǎn)品質(zhì)量問題分析中的典型應(yīng)用
1. 集成電路修補與線路修改
在集成電路制造與封裝階段,常出現(xiàn)微區(qū)電路蝕刻錯誤或邏輯設(shè)計缺陷。傳統(tǒng)方法難以在納米尺度進(jìn)行修復(fù),而FIB技術(shù)可通過精確切割移除錯誤連接,再通過離子束誘導(dǎo)沉積技術(shù)(如噴鉑或噴碳)重新搭建電路路徑,修改精度可達(dá)5 nm以下。該技術(shù)不僅節(jié)省了因完全重新流片產(chǎn)生的時間和成本,也極大提高了原型驗證和故障恢復(fù)的效率。
2. 表面缺陷與界面分析
產(chǎn)品在工藝或服役中可能出現(xiàn)微納米尺度的缺陷,如顆粒污染、局部腐蝕、氧化層破裂等。FIB可對缺陷區(qū)域進(jìn)行定點切割,制備高質(zhì)量的截面樣品,從而暴露缺陷與基材的界面結(jié)構(gòu)。結(jié)合SEM或能譜儀(EDS)進(jìn)行成分與形貌分析,可明確缺陷成因,指導(dǎo)工藝改進(jìn)。
3. 涂層與薄膜結(jié)構(gòu)表征
許多產(chǎn)品需通過表面鍍膜提升性能,如耐磨層、防腐涂層或光學(xué)薄膜。利用FIB可制備橫截面樣品,觀察薄膜的厚度、結(jié)構(gòu)、一致性以及與基體的結(jié)合情況,判斷是否存在剝落、孔洞或互擴散現(xiàn)象。這對于評估涂層可靠性與壽命至關(guān)重要。
4. 先進(jìn)封裝與三維集成檢測
在2.5D/3D集成電路、硅通孔(TSV)、微機電系統(tǒng)(MEMS)等先進(jìn)封裝結(jié)構(gòu)中,F(xiàn)IB可用于截面制備、連接點檢測、層間通孔質(zhì)量評估等。其高定位精度和微區(qū)處理能力特別適用于復(fù)雜三維結(jié)構(gòu)的故障定位與分析。
聚焦離子束技術(shù)(FIB)注意事項
- 樣品大小5×5×1cm,當(dāng)樣品過大需切割取樣。
- 樣品需導(dǎo)電,不導(dǎo)電樣品必須能噴金增加導(dǎo)電性。
- 切割深度必須小于10微米。
FIB與其他分析技術(shù)的聯(lián)用趨勢
如今FIB不再局限于獨立加工與截面制備,越來越多地與多種顯微分析和成分譜學(xué)技術(shù)聯(lián)用,包括:
FIB-SEM-EDS:實現(xiàn)加工-形貌觀察-元素分析一體化;
FIB-原子探針斷層掃描(APT):用于提取納米針尖樣品并進(jìn)行三維原子尺度成分分析;
FIB-透射電鏡(TEM)樣品制備:是制備電子透明薄片的標(biāo)準(zhǔn)方法。
-
fib
+關(guān)注
關(guān)注
1文章
128瀏覽量
11756 -
離子束
+關(guān)注
關(guān)注
0文章
113瀏覽量
8100
發(fā)布評論請先 登錄
FIB聚焦離子束電路修改服務(wù)
聚焦離子束顯微鏡(FIB-SEM)
聚焦離子束應(yīng)用介紹
聚焦離子束(FIB)技術(shù)的特點、優(yōu)勢以及應(yīng)用

一文帶你了解聚焦離子束(FIB)
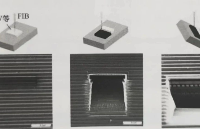
聚焦離子束顯微鏡(FIB):原理揭秘與應(yīng)用實例

聚焦離子束雙束系統(tǒng) FIB - SEM 的技術(shù)剖析與應(yīng)用拓展
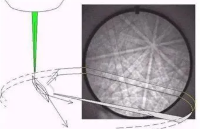
一文了解聚焦離子束(FIB)技術(shù)及聯(lián)用技術(shù)
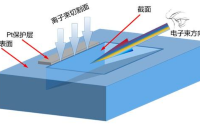



 聚焦離子束(FIB)技術(shù)分析
聚焦離子束(FIB)技術(shù)分析






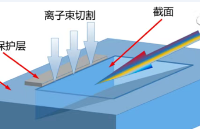



評論