引言 橢偏光譜(SE)、原子力顯微鏡(AFM)、X射線光電子能譜(XPS)、潤濕性和光致發光(PL)測量研究了HF水 溶液中化學清洗的GaP(OOl)表面。SE數據清楚地表明,溶液在浸入樣品后(W1
2021-12-22 17:30:40 2639
2639 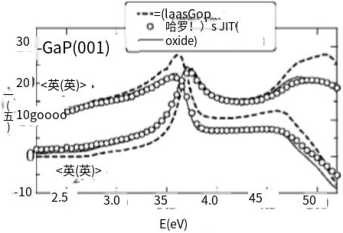
陶瓷在內的大量固體廢物的排放,自然資源和填埋場的枯竭正成為一個嚴重的問題。為了解決這些問題,有必要為這些陶瓷開發一個回收系統。然而,精細陶瓷回收的研究和開發還沒有進行。 實驗 si3n 4陶瓷的水熱處理使用在JFCC,通過添
2021-12-23 16:39:45 2262
2262 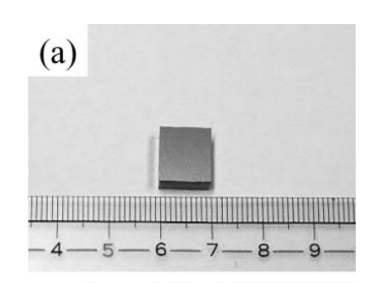
集成電路制造的一個基本步驟。Mat和Looney~研究了二氧化硅在高頻溶液中的蝕刻速率作為濃度、溫度、氧化物生長過程和溶液攪拌的函數。 ? 介紹 稀釋度高頻解中的平衡點 ?在稀高頻溶液中,高頻=H++F([3]HF+F-=;對于平衡常數(反應r~和r2的1和K2,其值分別為6.8510 4 工具
2021-12-31 11:08:01 5943
5943 
劃分為與晶體表面的不同狀態和各種蝕刻機制相對應的部分。蝕刻后的晶體表面的形狀與同一溶液中沿同一方向蝕刻的凹槽的輪廓密切相關。 介紹 本文研究(100)砷化鎵在硫酸、過氧化氫和水溶液中的化學蝕刻具有重要的技術和科學意義。該解決方案通常用于
2022-01-25 10:32:24 3235
3235 
硅的各向異性蝕刻是指定向依賴的蝕刻,通常通過堿性蝕刻劑如水溶液氫氧化鉀,TMAH和其他羥化物如氫氧化鈉。由于蝕刻速率對晶體取向、蝕刻劑濃度和溫度的強烈依賴性,可以以高度可控和可重復的方式制備多種硅
2022-03-08 14:07:25 2479
2479 
本文研究了硅的氧化物和氮化物的氣相氟化氫蝕刻作用,新的氧化物選擇性模式,概述了通過將無水高頻與控制量的水蒸汽混合而產生高頻蒸汽蝕刻劑的實現方法,描述了一種通過將氮氣通過高頻水溶液而引入高頻蒸汽的系統。
2022-04-11 16:41:19 1960
1960 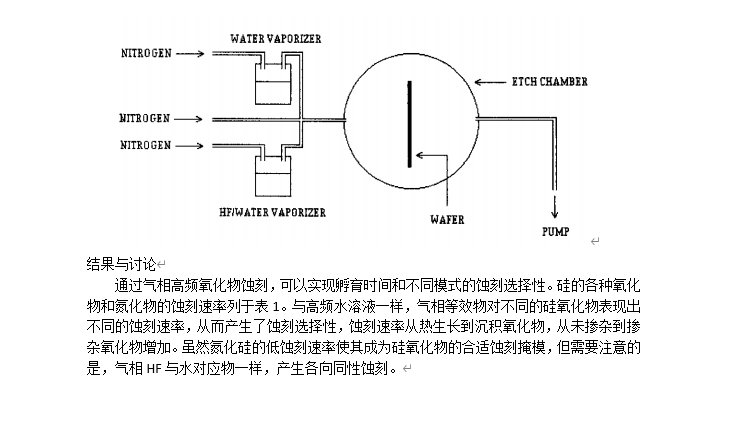
在濕法各向異性蝕刻中,底切凸角的蝕刻輪廓取決于蝕刻劑的類型。已經進行了大量的研究來解釋這種凸角底切并確定底切平面的方向。然而,還不清楚為什么不同蝕刻劑會出現不同形狀的底切前沿。
2022-05-24 14:27:26 3001
3001 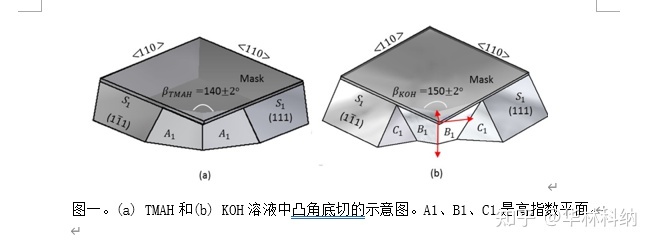
本文描述了我們華林科納用于III族氮化物半導體的選擇性側壁外延的具有平面側壁刻面的硅微米和納米鰭的形成。通過濕法蝕刻取向的硅晶片生產鰭片。使用等離子體增強化學氣相沉積來沉積二氧化硅,以產生硬掩模
2022-07-08 15:46:16 2154
2154 
反應離子蝕刻 (RIE)是一種干法蝕刻工藝,與半導體工業中使用的互補金屬氧化物半導體(CMOS)方法兼容。
2023-04-14 14:26:16 2584
2584 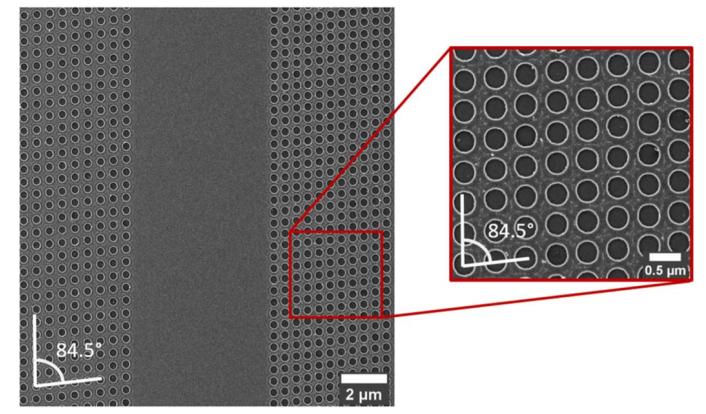
需要全部蝕刻,而留下的另一層就是電路。蝕刻的方法,我們主要討論化學方法,主要分為浸漬蝕刻、攪拌蝕刻以及噴射蝕刻。浸漬蝕刻就是把線路板進入容器中,容器中盛有蝕刻藥液。這種蝕刻方法比較慢,而且會存在凹陷
2017-02-21 17:44:26
為了在基板上形成功能性的MEMS結構,必須蝕刻先前沉積的薄膜和/或基板本身。通常,蝕刻過程分為兩類:浸入化學溶液后材料溶解的濕法蝕刻干蝕刻,其中使用反應性離子或氣相蝕刻劑濺射或溶解材料在下文中,我們將簡要討論最流行的濕法和干法蝕刻技術。
2021-01-09 10:17:20
連續再生循環使用,成本低。 2.蝕刻過程中的主要化學反應在氯化銅溶液中加入氨水,發生絡合反應:CuCl2+4NH3 →Cu(NH3)4Cl2在蝕刻過程中,板面上的銅被[Cu(NH3)4]2+絡離子氧化
2018-02-09 09:26:59
蝕問題,蝕刻后的導線側壁接近垂直。 3)溫度:溫度對蝕刻液特性的影響比較大,通常在化學反應過程中,溫度對加速溶液的流動性和減小蝕刻液的粘度,提高蝕刻速率起著很重要的作用。但溫度過高,也容易引起蝕刻液
2018-09-11 15:19:38
中的氨(NH3)來決定。因此用新鮮溶液與蝕刻表面作用,其目的主要有兩個:一是沖掉剛剛產生的銅離子;二是不斷提供進行反應所需要的氨(NH3)。 在印制電路工業的傳統知識里,特別是印制電路原料的供應商
2018-11-26 16:58:50
的規定或適當降低抽風量執行。 (3)按工藝要求排放出部分比重高的溶液經分析后補加氯化銨和氨的水溶液,使蝕刻液的比重調整到工藝充許的范圍。 3.問題:印制電路中金屬抗蝕鍍層被浸蝕 原因: (1
2018-09-19 16:00:15
所有其它參數不變,那么蝕刻速率主要由蝕刻液中的氨(NH3)來決定。因此用新鮮溶液與蝕刻表面作用,其目的主要有兩個:一是沖掉剛剛產生的銅離子;二是不斷提供進行反應所需要的氨(NH3)。 在印制電路工業
2018-09-13 15:46:18
重要材料的濕法腐蝕,即氧化鋅、氮化鎵和碳化硅。雖然氧化鋅很容易在許多酸溶液中蝕刻,包括硝酸/鹽酸和氫氟酸/硝酸,在非酸性乙酰丙酮中,第三族氮化物和碳化硅很難濕法蝕刻,通常使用干法蝕刻。已經研究了用于氮化
2021-10-14 11:48:31
常見的加工方法進行。對于我們的第一步,我們使用了幾種不同的處理方法,包括氯基等離子體中的反應離子蝕刻、KOH 溶液中的 PEC 蝕刻和切割。第二步是通過浸入能夠在晶體學上蝕刻 GaN 的化學品中完成
2021-07-07 10:24:07
過程具有反應受限的性質。HClH3PO4:H2O2 蝕刻劑是 HCl 和 H2O2 在 H3PO4 中的非水溶液溶劑。作為氧化劑的H2O2起著非常重要的作用。單獨的鹽酸,不含 H2O2,不會侵蝕 GaAs
2021-07-09 10:23:37
問題,因為涉及的損害很低。此外,它們比干法蝕刻方法更便宜且不復雜。另一個重要的優點是濕法蝕刻可以選擇性地去除不同的材料。本文介紹了n型氮化鎵在幾種電解質水溶液中(光)電化學行為的基礎研究結果,以及在
2021-10-13 14:43:35
氟化氫 (HF))的混合溶液中,使用貴金屬(例如 Au、Ag 或 Pt)蝕刻其下方的硅。1,3圖1描繪了MacEtch過程的示意圖。圖 2 顯示了 MacEtch 工藝流程。從圖 1 中可以看出,通過
2021-07-06 09:33:58
,那么蝕刻速率主要由蝕刻液中的氨(NH3)來決定。因此用新鮮溶液與蝕刻表面作用,其目的主要有兩個:一是沖掉剛剛產生的銅離子;二是不斷提供進行反應所需要的氨(NH3)。在印制電路工業的傳統知識里,特別是
2018-04-05 19:27:39
典型的硅刻蝕是用含氮的物質與氫氟酸的混合水溶液。這一配比規則在控制刻蝕中成為一個重要的因素。在一些比率上,刻蝕硅會有放熱反應。加熱反應所產生的熱可加速刻蝕反應,接下來又產生更多的熱,這樣進行下去會
2018-12-21 13:49:20
的關系 在蝕刻過程中,蝕刻液中的反應離子是通過流體運動,擴散運動達到露銅箔的表面并與銅發生化學反應的。流體運動的速度與擴散層的厚度決定著反應的速率。在流體運動時,其受到銅箔表面流體的阻力f作用。根據
2018-09-10 15:56:56
x500) mm 的板子。在印制電路板制作中,在第二個蝕刻周期前放置板子的架子可以旋轉180° ,此外還提供了一個刷洗槽以沖洗蝕刻后的板子。這套設備蝕刻的極子走線分辨率可達小于(大于?)0. 1mm ,而且在新的FeCI3蝕刻溶液中其蝕刻速度只能達到90s 。
2018-09-11 15:27:47
P FIB 與DB FIB師出同源,最大差異在離子源與蝕刻效率。DB FIB的離子源Ga+容易附著在樣品表面,P FIB使用Xe可減少樣品Ga污染問題。P FIB可大范圍面積快速執行,蝕刻速率提升20倍。
2019-08-15 15:57:55
﹐就是盡速讓金屬表面不斷地接觸新鮮的蝕刻液。 在氨性蝕刻中﹐假定所有參數不變﹐那么蝕刻的速率將主要由蝕刻液中的氨(NH3)來決定。因此, 使用新鮮溶液與蝕刻表面相互作用﹐其主要目的有兩個﹕沖掉剛產生的銅
2017-06-23 16:01:38
怎么用LABVIEW索引出對應溫度(列)和體積濃度(行,百分比)下的乙二醇水溶液的密度(中間的數值)
2017-08-12 20:41:36
,LiNbO3材料,頻譜儀,線圈等。實驗內容:提出了一款工作在45kHz的壓電天線。分析壓電天線的遠場磁感應強度和輻射效率的理論計算公式,并通過在COMSOL中仿真不同壓電材料,不同圓柱體尺寸、不同鍍金厚度
2021-11-10 08:00:00
適當的清潔或對溶液進行補加。 蝕刻過程中應注意的問題 減少側蝕和突沿﹐提高蝕刻系數 側蝕會產生突沿。通常印制板在蝕刻液中的時間越長,側蝕的情況越嚴重。側蝕將嚴重影響印制導線的精度,嚴重的側蝕將不
2017-06-24 11:56:41
。2.克升濃度計算: 定義:一升溶液里所含溶質的克數。 舉例:100克硫酸銅溶于水溶液10升,問一升濃度是多少? 100/10=10克/升3.重量百分比濃度計算 (1)定義:用溶質的重量占全部溶液
2018-08-29 10:20:51
速率主要由蝕刻液中的氨(NH3)來決定。因此用新鮮溶液與蝕刻表面作用,其目的主要有兩個:一是沖掉剛剛產生的銅離子;二是不斷提供進行反應所需要的氨(NH3)。 在印制電路工業的傳統知識里,特別是
2018-09-19 15:39:21
鋅銅電池通常包含兩個燒杯、鋅片、銅片、鹽橋和導線。裝置如下圖。鋅片放出電子變成鋅離子,進入溶液中。電子經由外電路到達銅片。銅片的作用只是傳遞電子給水溶液中的銅離子。
2019-09-10 10:42:39
超聲波輻照水溶液時,空化泡在聲波的作用下形成、振蕩、生長、收縮至崩潰。空化泡崩潰時在空化泡周圍的極小空間內可以產生5000K以上的高溫和高達5 X 107Pa的高壓等極端物理條件
2008-11-24 21:51:53 12
12 分析了厚電極厚緩沖層的共面波導Mach-Zehnder行波電極LiNbO3光調制器,討論了電極厚度和緩沖層厚度對調制器特性參數的影響,得到了調制器的有效折射率、特征阻抗、半波電壓及
2009-02-28 10:36:10 33
33 因產品配置不同, 價格貨期需要電議, 圖片僅供參考, 一切以實際成交合同為準伯東公司日本原裝設計制造離子蝕刻機 IBE. 提供微米級刻蝕, 均勻性: ≤±5%, 滿足
2022-11-07 16:27:40
因產品配置不同, 價格貨期需要電議, 圖片僅供參考, 一切以實際成交合同為準離子蝕刻機 4 IBE伯東公司日本原裝進口小型離子蝕刻機, 適用于科研院所
2022-11-07 16:30:42
因產品配置不同, 價格貨期需要電議, 圖片僅供參考, 一切以實際成交合同為準伯東公司日本原裝進口小型離子蝕刻機, 適用于科研院所, 實驗室研究, 干式制程的微細加工
2022-11-07 16:38:17
斜輻照激光等離子體輻射X光子特性:在神光Ⅱ高功率激光裝置上,實驗研究了激光斜輻照形成的激光等離子體輻射X射線光子的特性及真空噴射熱等離子體流的方向。采用
2009-10-29 14:11:39 15
15 Eu3 + 摻雜LiNbO3 晶體的變溫發射光譜特征
在488 nm 波長光的激發下, 研究了用坩堝下降法生長的摻雜Eu3 + 離子的下部與上部LiNbO3 晶體從77 到600 K的變溫發射光譜特征。實
2010-02-22 11:53:54 10
10 摘要 分析了在垂直LiNbO3晶體光軸方向加電壓,光沿近光軸方向傳播時,入射光偏振方向對電光調制器的影響.通過計算加電場后雙折射光程差的變化和偏光振動方向的轉動,畫出在正交
2010-11-30 13:12:35 23
23 1. 克升濃度計算:
定義:一升溶液里所含溶質的克數。
舉例:100克硫酸銅溶于水溶液10升,問一升濃度是多少?
10
2010-10-26 17:33:24 2514
2514 對于我們常用的不可充電的原電池,國際標準IEC 60086-5“原電池—-第5部分:水溶液電解質電池的安全”中就對其安全使用提出了諸多建議。
2012-05-30 15:39:24 1618
1618 鋁離子是在化學反應中,鋁原子失去電子,從而使參加反應的鋁原子帶上3個正電荷。帶電荷的鋁原子叫做鋁離子。在弱酸性溶液(加入pH5.0~6.0的緩沖溶液)中,鋁離子與過量的EDTA絡合,用氯化鋅標準溶液滴定過量的EDTA。
2018-02-27 14:41:54 11587
11587 本文主要介紹了配比鹽霧試驗所用鹽水溶液的三種方法。
2018-06-21 12:00:00 0
0 通常所指蝕刻也稱腐蝕或光化學蝕刻(photochemicaletching),指通過曝光制版、顯影后,將要蝕刻區域的保護膜去除,在蝕刻時接觸化學溶液,達到溶解腐蝕的作用,形成凹凸或者鏤空成型的效果。
2019-04-25 15:41:36 17776
17776 按工藝要求排放出部分比重高的溶液經分析后補加氯化銨和氨的水溶液,使蝕刻液的比重調整到工藝充許的范圍。
2019-06-10 16:31:11 2693
2693 如今,鋰離子電池充電越來越快且性能也越來越高,但也越來越昂貴且越來越易燃。
2019-12-21 10:42:55 859
859 內部,正極和負極兩個電極浸在液體電解質中。電池充放電時,液體電解質就會傳導離子。水溶液電解質因不可燃性而備受關注。而且,在制造過程中,與非水電解質不同,水溶液電解質不易受水分影響,更方便操作,成本更低。對于這種材料來說,最大的挑戰在于如何保持性能。
2020-10-29 22:27:00 1472
1472 在壓電天線的諧振頻率的實測中,利用函數信號發生器發送45 kHz的正弦波,再利用ATA- -2161電壓放大器將正弦波的電壓幅度放大,將放大的電壓輸入到LiNbO3晶體兩端,再利用接收線圈接收
2021-11-05 16:51:50 3584
3584 我們華林科納研究了不同醇類添加劑對氫氧化鉀溶液的影響。據說醇導致硅蝕刻各向異性的改變。具有一個羥基的醇表現出與異丙醇相似的效果。它們導致(hh 1)型平面的蝕刻速率大大降低,通常在蝕刻凸形圖形的側壁處發展。這就是凸角根切減少的原因。具有一個以上羥基的醇不影響蝕刻各向異性,并導致表面光潔度變差。
2021-12-17 15:27:53 1194
1194 引言 鈮酸鋰是一種廣泛應用于光學和聲表面波器件的鐵電材料。鈮酸鋰通常不用于微機電系統(MEMS)應用,部分原因是鈮酸鋰的體微加工不如與其他材料的加工那樣好理解。已經公布了硅和石英對晶體取向的完全蝕刻
2021-12-24 15:43:43 1504
1504 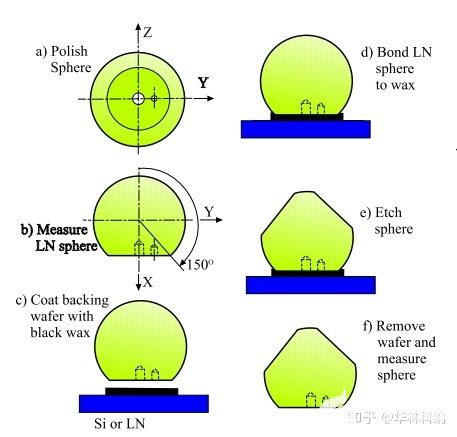
方法。本文結合理論模擬和實驗,綜合分析了所提出的旋轉交換濕蝕刻法的蝕刻結果。發現質子交換層可以很容易地使用氫氟酸/硝酸混合酸蝕刻阻擋層,從而改善提取率和表面形貌。最佳波導的最低粗糙度被測量為0.81毫米,這有利于基
2021-12-24 16:24:52 1107
1107 
引言 我們研究了四種硅在高頻水溶液中的陽極電流-電勢特性。根據不同電位陽極氧化的樣品的表面條件,電流-電位曲線上通常有三個區域:電流隨電位指數變化區域的多孔硅形成,恒流區域的硅的電泳拋光,以及
2021-12-28 16:40:16 1563
1563 
引言 到目前為止,GaAs晶片的直接再利用受到晶片表面上的殘留物的限制,這些殘留物不能利用一般的清洗方法方式去除。因此,用顯微技術、輪廓術和x光電子能譜研究了氫氟酸對GaAs晶片的腐蝕。發現在蝕刻
2021-12-28 16:34:37 1396
1396 
上降低了(100)和(h11)面的蝕刻速率。 為了在低氫氧化鉀濃度下獲得低粗糙度的(100)表面,蝕刻溶液必須含有飽和水平的異丙醇。在我們的研究中,我們研究了異丙醇濃度對具有不同晶體取向的硅襯底的蝕刻速率和表面形態的影響。還研究了氫氧化鉀濃度對(
2022-01-13 13:47:26 2752
2752 
HF/HNO 3的溶液中進行酸性蝕刻來實現。酸性溶液各向同性地蝕刻多晶硅晶片,即在所有晶體取向上產生圓形紋理。然而,酸性蝕刻工藝難以控制,并且化學廢物的處理昂貴。 為了克服這種對環境有害的酸性蝕刻工藝,同時保持mc-Si晶片
2022-01-13 14:47:19 1346
1346 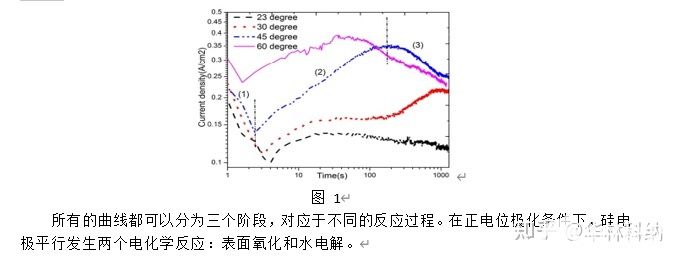
引言 我們華林科納研究了KOH基溶液中AIN的濕式化學蝕刻與蝕刻溫度和材料質量的關系。這兩種材料的蝕刻速率都隨著蝕刻溫度的增加而增加,從20~80°C不等。通過在1100°C下快速熱退火,提高了反應
2022-01-17 16:21:48 754
754 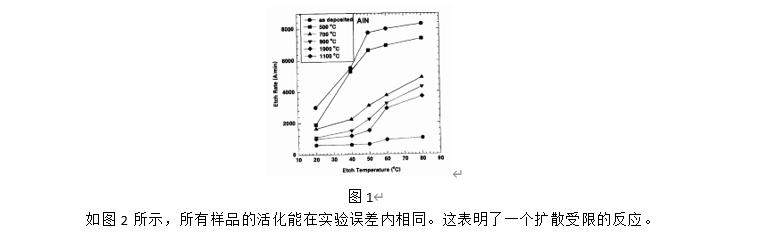
的溶液的化學組成,隨后是使用電子和光學顯微鏡獲得的結果。蝕刻的機理,雖然沒有完全理解,將在下面的章節中討論。 氫氟硅酸H2SiF6用于沉積二氧化硅,在二氧化硅中發現其蒸汽含有過量的四氟化鈉,四氟化鈉與水結合會產生二氧化硅。在更具體的應用中
2022-01-20 16:46:48 1197
1197 
,表面的Ga-As鍵斷裂,元素砷留在砷化鎵表面。此外,用鹽酸+2-丙醇溶液蝕刻時可以觀察到吸附的2-丙醇分子,但用氨水溶液蝕刻時沒有檢測到吸附的水分子。 介紹 濕式化學蝕刻工藝在器件制造中已被廣泛應用。半導體/電解質界面上發生的過程
2022-01-24 15:07:30 2419
2419 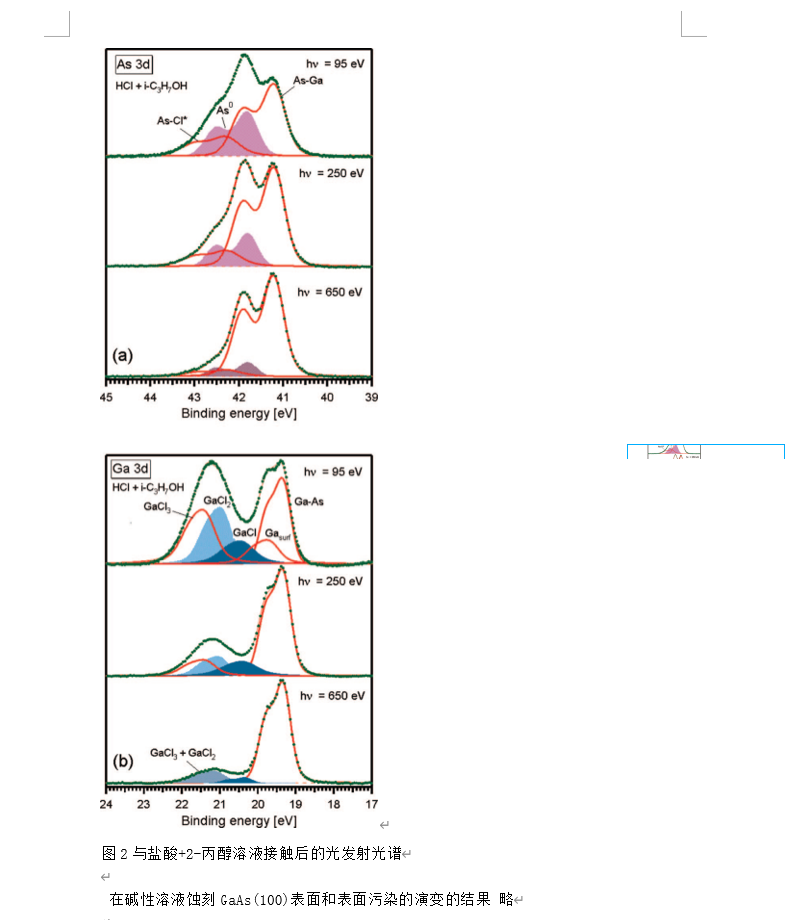
。此外,用離子色譜法測定稀釋蝕刻劑溶液中亞硝酸鹽離子濃度作為濃縮蝕刻劑中活性NIII的參數,確定了兩種不同的蝕刻機制。在亞硝酸鹽濃度高的區域,蝕刻速率明顯與亞硝酸鹽濃度無關。在較低的亞硝酸鹽濃度下,蝕刻速率隨亞硝酸鹽c呈線性
2022-01-24 15:41:13 2458
2458 
本文探討了紫外輻照對生長在藍寶石襯底上的非有意摻雜n型氮化鎵(GaN)層的濕法化學刻蝕的影響。實驗過程中,我們發現氮化鎵的蝕刻發生在pH值分別為2-1和11-15的磷酸水溶液和氫氧化鉀溶液中。在稀釋
2022-01-24 16:30:31 1662
1662 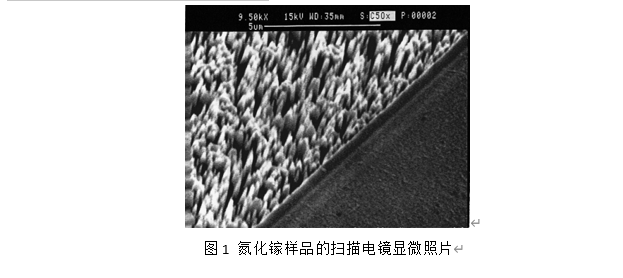
刻蝕電介質(二氧化硅、氮化硅)和晶體硅。論文的第二部分致力于蝕刻ⅲ-ⅴ族化合物半導體,其中基于氮化鎵材料的反應離子刻蝕結果,揭示了一種簡單實用的熱力學方法,解釋了選擇蝕刻特定材料的最佳化學物質的標準,并解釋了氮化鎵蝕刻
2022-02-07 14:39:36 2711
2711 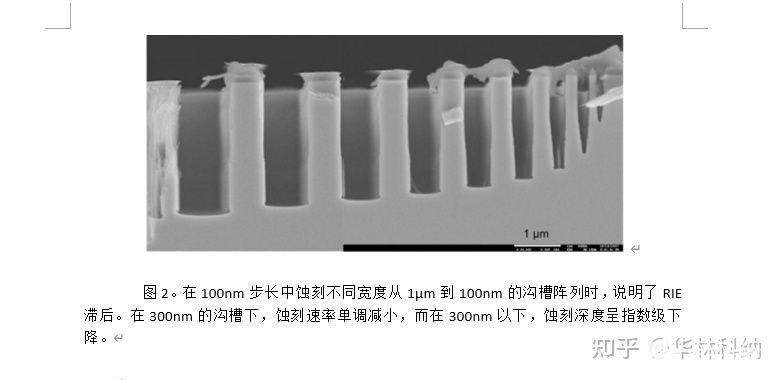
基于HC1的蝕刻劑被廣泛應用于InP半導體器件,HC1溶液中其他酸的存在對蝕刻速率有顯著影響,然而,InP并不溶在涉及簡單氧化劑的傳統蝕刻劑中,為了解決溶解機理的問題,我們江蘇華林科納研究了p-InP在不同HC1溶液中的刻蝕作用和電化學反應。
2022-02-09 10:54:58 1600
1600 
引言 拋光液中的污染物和表面劃痕、挖掘和亞表面損傷(固態硬盤)等缺陷是激光損傷的主要前兆。我們提出了在拋光后使用HF/HNO3或KOH溶液進行深度濕法蝕刻,以提高熔融石英光學器件在351 nm波長下
2022-02-24 16:26:03 4173
4173 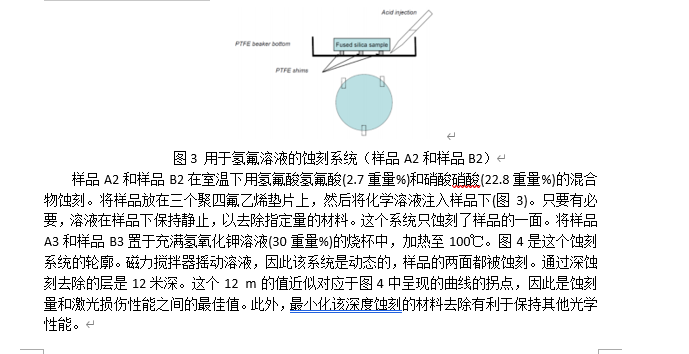
在 KOH 水溶液中進行濕法化學蝕刻期間,硅 (1 1 1) 的絕對蝕刻速率已通過光學干涉測量法使用掩膜樣品進行了研究。蝕刻速率恒定為0.62 ± 0.07 μm/h 且與 60 時 1–5 M
2022-03-04 15:07:09 1824
1824 
在高頻水溶液中,SiO的蝕刻可以通過電場的應用而被阻礙或停止。在CMOS制造中,非常低水平的光可以導致這種影響。對溶解過程提出了平行反應路徑,并加上電場在中間步驟中停止或重定向反應的能力。
2022-03-07 15:28:24 2561
2561 
HF對基片進行了研究,主要分為隨機蝕刻和周期性蝕刻。 我們討論了蝕刻的問題機理、蝕刻速率、硬掩膜材料、周期性光俘獲結構。
2022-03-08 11:52:41 1825
1825 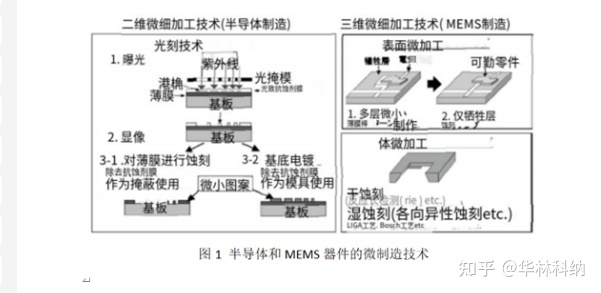
在本文中,我們首次報道了實現硅111和100晶片的晶體蝕刻的酸性溶液。通過使用六氟硅酸(也稱為氟硅酸)和硝酸的混合物,獲得暴露出各種面外111平面的硅111的晶體蝕刻。本文描述了用于該研究的溶液的化學組成,隨后是使用電子和光學顯微鏡獲得的結果。蝕刻的機理,雖然沒有完全理解,將在下面的章節中討論。
2022-03-09 14:35:42 1073
1073 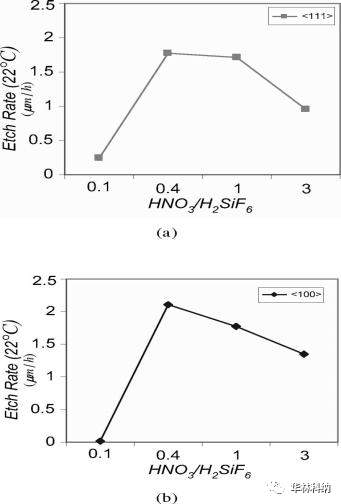
本文研究了KOH基溶液中AIN的濕式化學蝕刻與蝕刻溫度和材料質量的關系。這兩種材料的蝕刻速率都隨著蝕刻溫度的增加而增加,從20~80°C不等。通過在1100°C下快速熱退火,提高了反應性濺射制備
2022-03-09 14:37:47 815
815 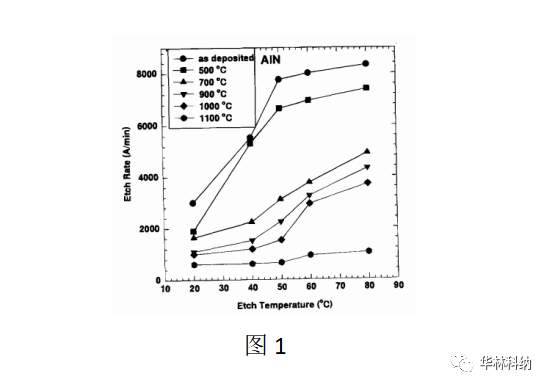
本文研究了用金剛石線鋸切和標準漿料鋸切制成的180微米厚5英寸半寬直拉單晶硅片與蝕刻時間的關系,目的是確定FAS晶片損傷蝕刻期間蝕刻速率降低的根本原因,無論是與表面結構相關,缺陷相關,由于表面存在的氧化層,還是由于有機殘差。
2022-03-16 13:08:09 1159
1159 
本文根據測量的OCP和平帶電壓,構建了氫氧化鉀水溶液中n-St的定量能帶圖,建立了同一電解質中p-St的能帶圖,進行了輸入電壓特性的測量來驗證這些能帶圖,硅在陽極偏置下的鈍化作用歸因于氧化物膜的形成
2022-03-17 17:00:08 2042
2042 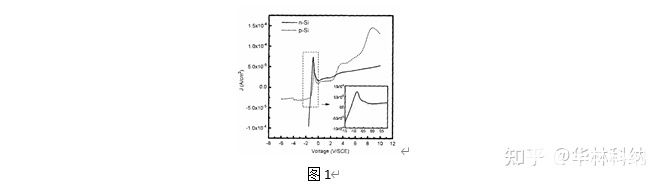
本文我們華林科納半導體有限公司研究了類似的現象是否發生在氫氧化鉀溶液中添加的其他醇,詳細研究了丁基醇濃度對(100)和(110)Si平面表面形貌和蝕刻速率的影響,并給出了異丙醇對氫氧化鉀溶液的蝕刻結果,為了研究醇分子在蝕刻溶液中的行為機理,我們還對溶液的表面張力進行了測量。
2022-03-18 13:53:01 769
769 
使用酸性或氟化物溶液對硅表面進行濕蝕刻具有重大意義,這將用于生產微電子包裝所需厚度的可靠硅芯片。本文研究了濕蝕刻對浸入48%高頻/水溶液中的硅片厚度耗散、減重、蝕刻速率、表面形貌和結晶性
2022-03-18 16:43:11 1211
1211 
薄晶片已成為各種新型微電子產品的基本需求。 需要更薄的模具來適應更薄的包裝。 使用最后的濕蝕刻工藝在背面變薄的晶圓與標準的機械背面磨削相比,應力更小。 硅的各向同性濕蝕刻通常是用硝酸和氫氟酸的混合物
2022-04-07 14:46:33 1278
1278 
在集成電路的許多生產步驟中,晶片被一層材料(如二氧化硅或某種金屬)完全覆蓋。通過對掩模的蝕刻有選擇性地除去不需要的材料,從而創建電路模板、電互連以及必須擴散的或者金屬沉積的區域。等離子蝕刻工序在這
2022-04-25 16:14:11 564
564 
金屬涂層,如銅膜,可以很容易地沉積在半導體材料上,如硅晶片,而無需使無電鍍工藝進行預先的表面預處理。然而,銅膜的粘附性可能非常弱,并且容易剝離。在本研究中,研究了在氫氟酸溶液中蝕刻作為硅晶片化學鍍前
2022-04-29 15:09:06 1103
1103 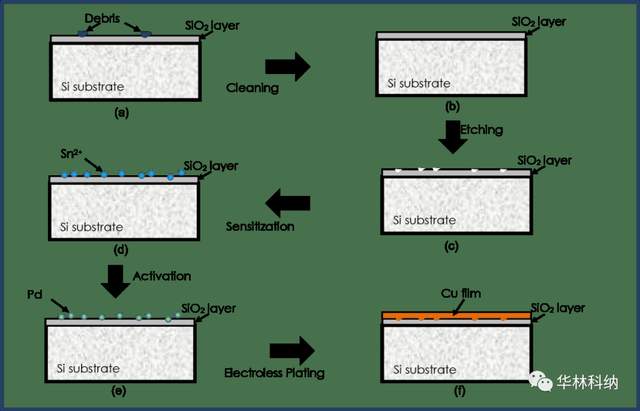
我們華林科納研究探索了一種新的濕法腐蝕方法和減薄厚度在100 μm以下玻璃的解決方案,為了用低氫氟酸制備蝕刻溶液,使用NH4F或nh4hf 2作為主要成分并加入硫酸或硝酸是有效的,研究了混合酸溶液
2022-05-20 16:20:24 5686
5686 認為是一個速度源,這是我們提出的一個數學概念,也適用于位錯和晶界,速度源的活動取決于相關的M111N平面與掩模之間的夾角,因此在微觀機械結構中蝕刻的薄壁相對的M111N側可以有不同的值。 在圖1a中,示出了S 100T單晶硅爐和部分覆蓋它的惰性掩
2022-05-20 17:12:59 1881
1881 
摘要 微流體和光學傳感平臺通常由玻璃和熔融石英(石英)制成,因為它們具有光學透明性和化學惰性。氫氟酸(HF)溶液是用于深度蝕刻二氧化硅襯底的選擇的蝕刻介質,但是由于HF遷移穿過大多數掩模材料的侵蝕性
2022-05-23 17:22:14 2377
2377 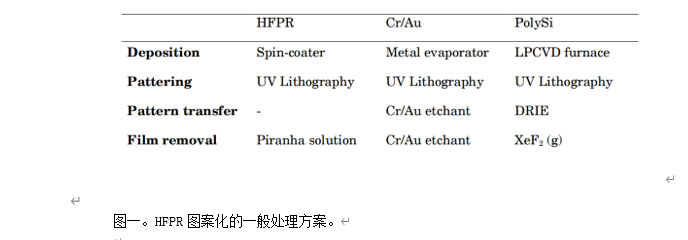
本文介紹了我們華林科納采用混合酸溶液(H3PO4 : H2SO4 = 1 : 3)和熔融KOH作為濕法腐蝕介質,鹽酸作為陽極腐蝕介質,用掃描電鏡和透射電鏡分別觀察了蝕坑和T-Ds。
2022-05-27 16:56:03 1164
1164 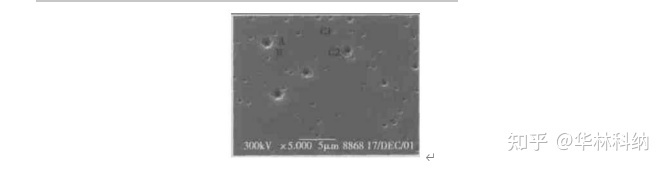
引用 本文介紹了我們華林科納半導體研究了取向硅在氫氧化鉀水溶液中的各向異性腐蝕特性和凸角底切機理。首先,確定控制底切的蝕刻前沿的晶面,并測量它們的蝕刻速率。然后,基于測量數據,檢驗了凸角補償技術
2022-06-10 17:03:48 2252
2252 
的蝕刻去除了金屬污染物。用氰化氫HCN水溶液清洗被金屬污染的碳化硅,然后進行RCA清洗,反之亦然,可以完全去除它們。結果表明,強吸附金屬和粗糙碳化硅表面底部區域的金屬不能分別用RCA法和HCN法去除。由于
2022-09-08 17:25:46 3011
3011 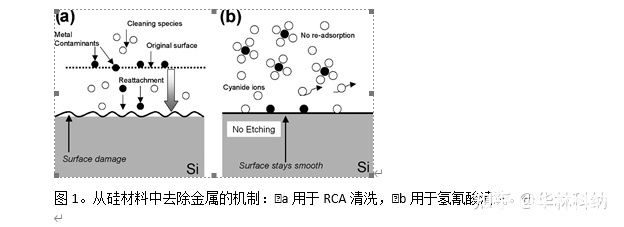
反應性離子蝕刻綜合了離子蝕刻和等離子蝕刻的效果:其具有一定的各向異性,而且未與自由基發生化學反應的材料會被蝕刻。首先,蝕刻速率顯著增加。通過離子轟擊,基材分子會進入激發態,從而更加易于發生反應。
2022-09-19 15:17:55 6526
6526 在濕蝕刻的情況下,隨著SiNx/SiOy層的厚度減小,剩余的SiOy層由于表面張力而坍塌,蝕刻溶液對孔的滲透變得更具挑戰性。
2023-03-27 10:17:49 1539
1539 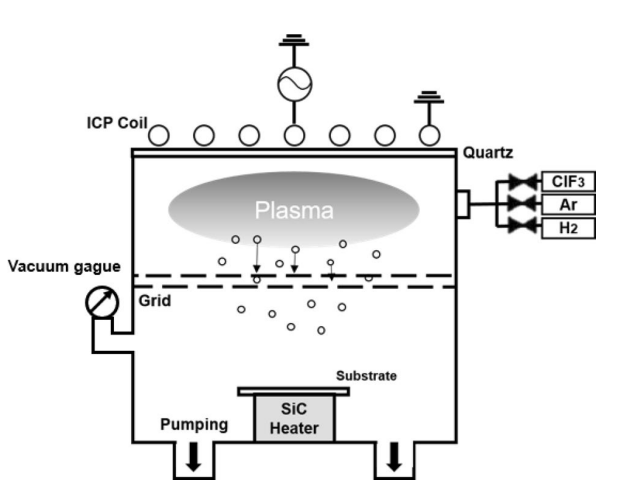
過去利用堿氫氧化物水溶液研究了硅的取向依賴蝕刻,這是制造硅中微結構的一種非常有用的技術。以10M氫氧化鉀(KOH)為蝕刻劑,研究了單晶硅球和晶片的各向異性蝕刻過程,測量了沿多個矢量方向的蝕刻速率,用單晶球發現了最慢的蝕刻面。英思特利用這些數據,提出了一種預測不同方向表面的傾角的方法
2023-05-29 09:42:40 3202
3202 
隨著集成電路互連線的寬度和間距接近3pm,鋁和鋁合金的等離子體蝕刻變得更有必要。為了防止蝕刻掩模下的橫向蝕刻,我們需要一個側壁鈍化機制。盡管AlCl和AlBr都具有可觀的蒸氣壓,但大多數鋁蝕刻的研究
2023-06-27 13:24:11 1278
1278 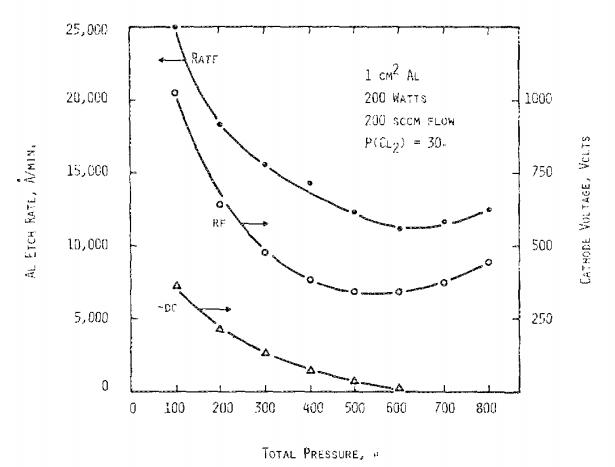
硅在暴露在空氣中時會形成一層氧化硅(SiO2)層。在許多制程步驟中,如在熱處理過程之前,需要移除這層氧化硅。氫氟酸是唯一能夠有效清洗硅片表面氧化硅的化學品。氫氟酸能夠與SiO2發生反應,生成揮發性的氟硅酸,從而清除硅片表面的氧化物層。
2023-08-02 10:40:25 2711
2711 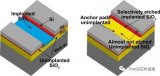
目前,大多數III族氮化物的加工都是通過干法等離子體蝕刻完成的。干法蝕刻有幾個缺點,包括產生離子誘導損傷和難以獲得激光器所需的光滑蝕刻側壁。干法蝕刻產生的側壁典型均方根(rms)粗糙度約為50納米
2023-11-24 14:10:30 2150
2150 
按工藝要求排放出部分比重高的溶液經分析后補加氯化銨和氨的水溶液,使蝕刻液的比重調整到工藝充許的范圍。
2023-12-06 15:01:46 5138
5138 氨水溶液換熱器作為一種重要的化工設備,廣泛應用于化工、制冷等領域。在殼程為循環水、管程介質為氨水溶液的工況下,列管換熱器管板腐蝕問題成為影響設備安全運行的關鍵因素。因此,研究有效的防腐技術對于延長設備壽命、保障生產安全具有重要意義。
2024-06-21 16:08:59 1323
1323 
鈦酸鉛 PZT , 鈮酸鋰 LiNbO3 和 氮化鋁鈧 AlScN, 或用于 MRAM 和 STT-MRAM 的材料(如
2024-11-27 10:06:34 1179
1179 
芯片濕法蝕刻工藝是一種在半導體制造中使用的關鍵技術,主要用于通過化學溶液去除硅片上不需要的材料。 基本概念 濕法蝕刻是一種將硅片浸入特定的化學溶液中以去除不需要材料的工藝,廣泛應用于半導體器件如芯片
2024-12-27 11:12:40 1538
1538 什么是離子色譜離子色譜(IonChromatography,IC)是高效液相色譜(HPLC)家族中的專門分支,其核心任務是對水溶液中呈離子態的化合物進行分離與定量。儀器通過高壓輸液泵將流動相(淋洗
2025-08-08 11:41:05 859
859 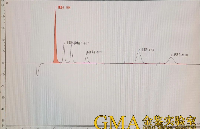
晶圓蝕刻過程中確實可能用到硝酸鈉溶液,但其應用場景較為特定且需嚴格控制條件。以下是具體分析:潛在作用機制氧化性輔助清潔:在酸性環境中(如與氫氟酸或硫酸混合),硝酸鈉釋放的NO??離子可作為強氧化劑
2025-10-14 13:08:41 203
203 
濕法蝕刻的最佳刻蝕條件需綜合溶液體系、溫度控制、時間管理及材料特性等因素,具體如下: 溶液體系與濃度 氫氟酸緩沖體系(BOE):采用HF:NH?F:H?O=6:1:1的體積比配置,pH值控制在3
2025-11-11 10:28:48 269
269 成特定的圖形才能用于芯片, 因 LiNbO3 惰性特性, 使用 ICP 或 RIE 工藝無法完成刻蝕, 上海伯東 IBE 離子束刻蝕機為鈮酸鋰 LiNbO3 薄膜
2024-09-13 10:59:11
 電子發燒友App
電子發燒友App









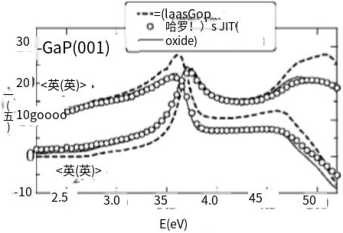
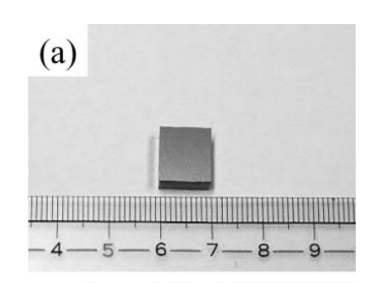



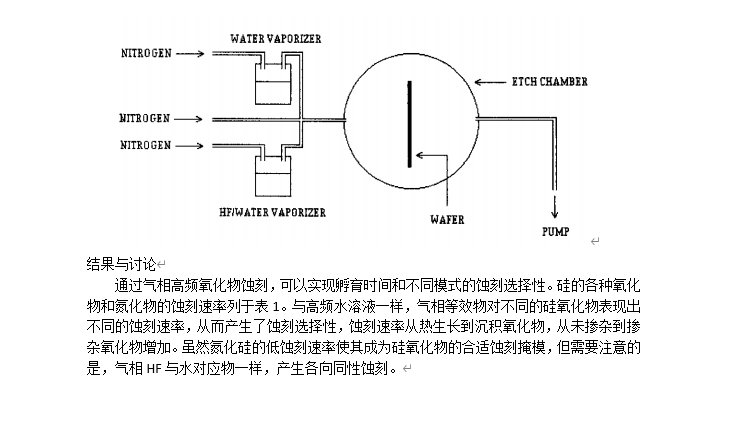
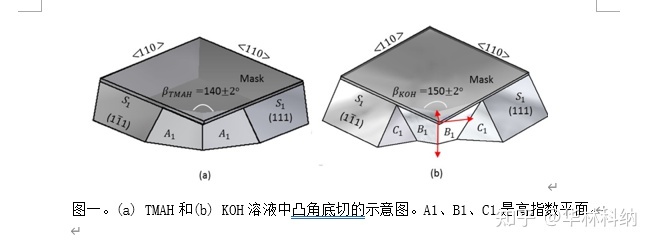

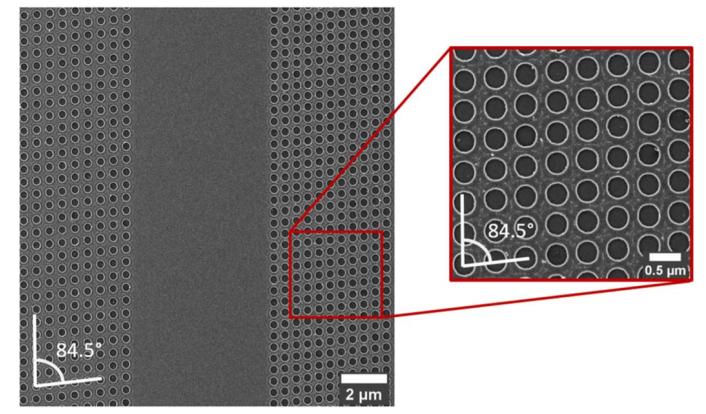

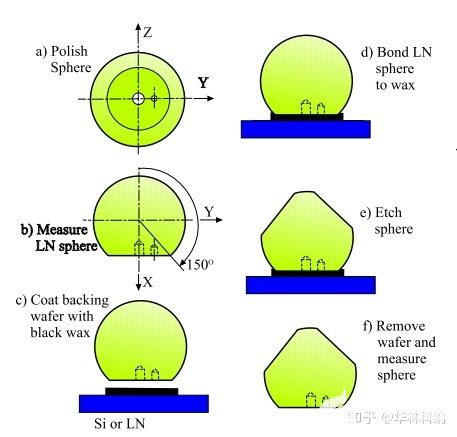




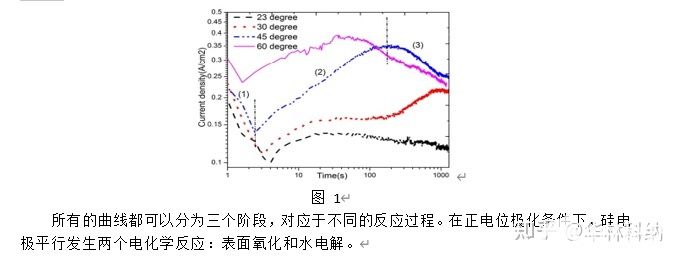
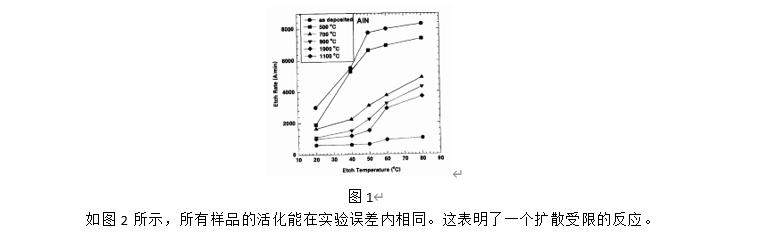

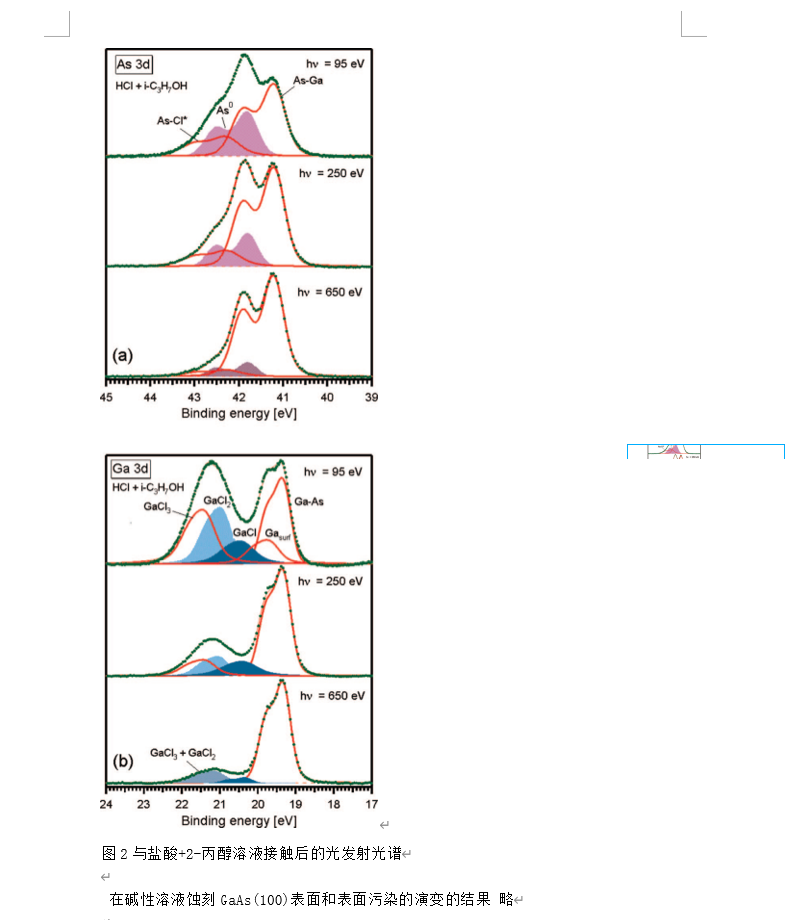

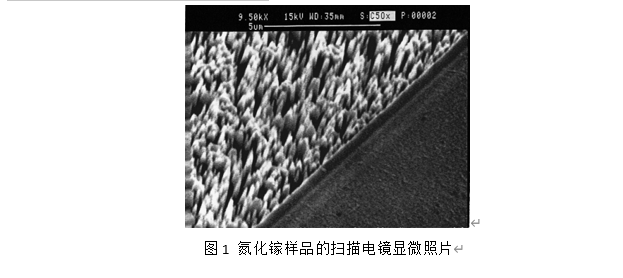
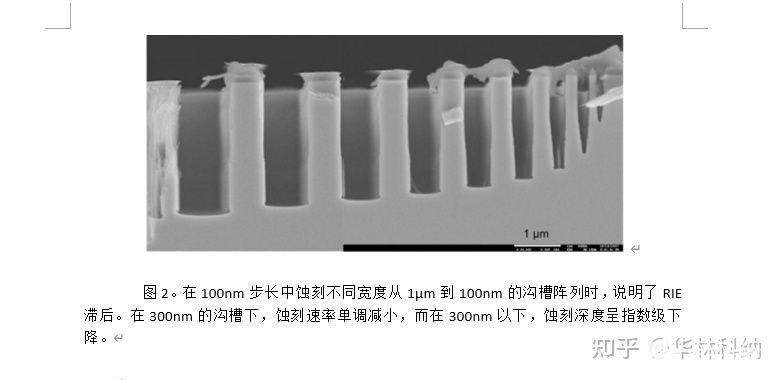

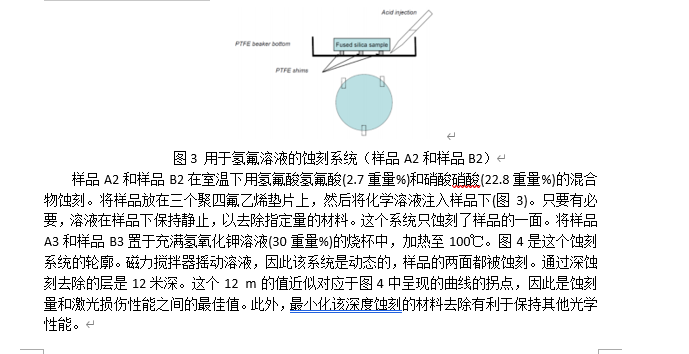


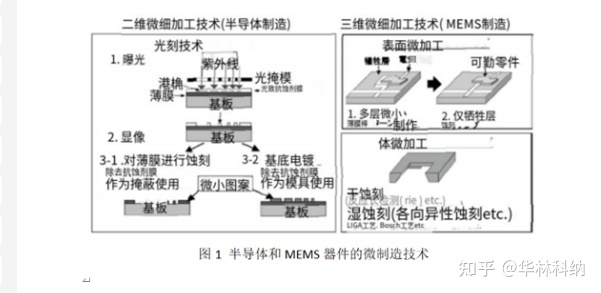
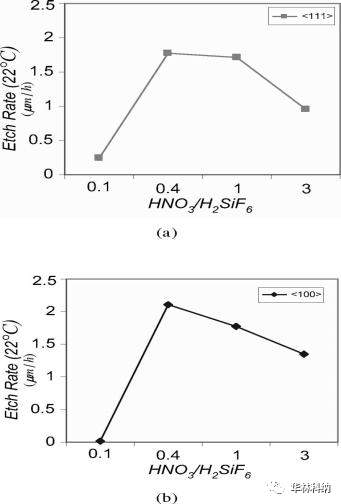
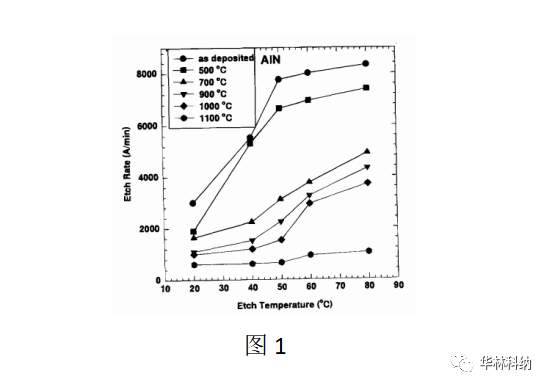

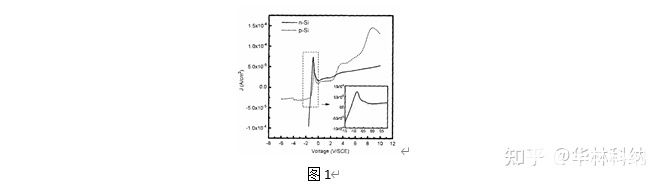




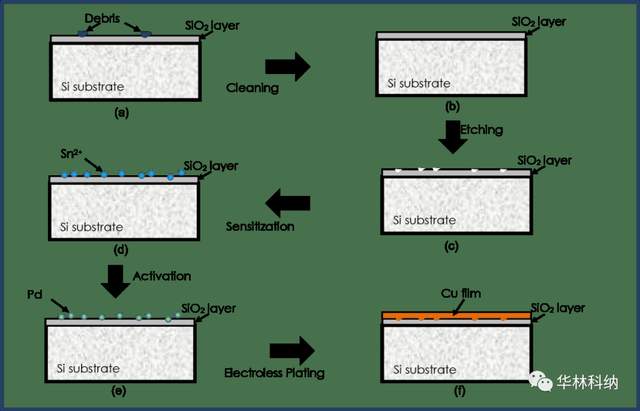

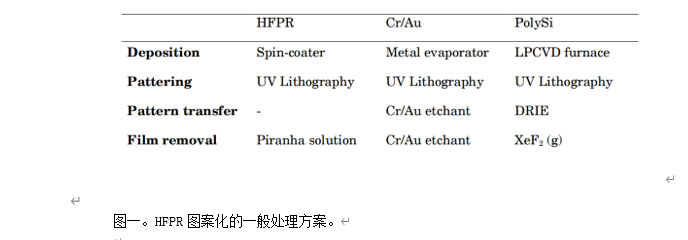
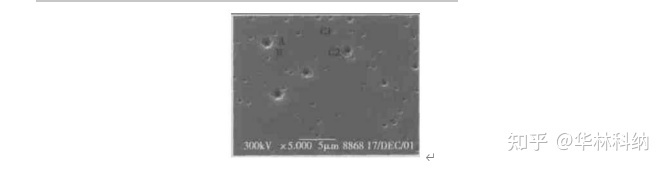

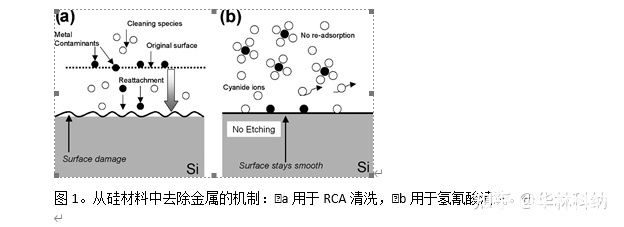

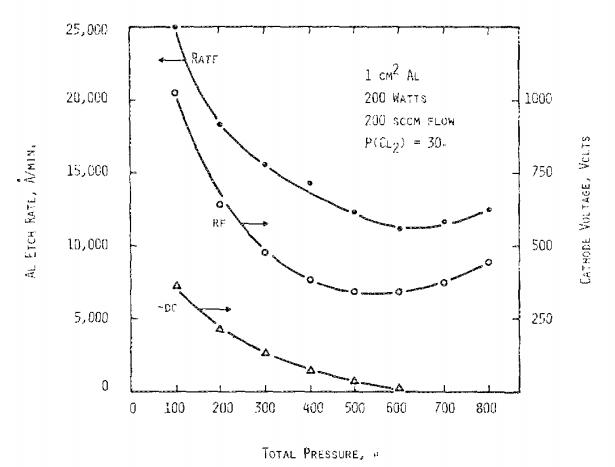
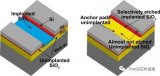



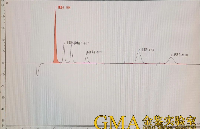




評論