基于HC1的蝕刻劑被廣泛應用于InP半導體器件,HC1溶液中其他酸的存在對蝕刻速率有顯著影響,然而,InP并不溶在涉及簡單氧化劑的傳統蝕刻劑中,為了解決溶解機理的問題,我們江蘇華林科納研究了p-InP在不同HC1溶液中的刻蝕作用和電化學反應。
本研究中使用的p型InP切片由液體封裝的佐克拉爾斯基材料制成,載流子密度為1-210,范圍為cm-3,電極的直徑為3ram,但InP旋轉圓盤的直徑為4mm,以Pt對映電極和飽和熱量電極(SCE)為參考,在常規電池的電位控制下進行電流電位測量,采用太陽能加速器1172頻率響應分析儀測定平帶電位,所有阻抗測量均在10kHz的頻率下進行。
通過電感耦合等離子體(ICP)發射光譜法測定蝕刻溶液中的銦濃度,分析測定了不同電位下InP的總溶解速率,實驗通過InP電極,InP電極安裝在玻璃微電化學流動電池中,銦濃度可低至0.5ppm,相對準確度約為5%,采用LKB可變蠕動泵通過流動池,使用著色探測器管法(“Dr~ger”管)對氣體進行了定性分析,在我們的病例中,該方法給出了對磷堿有特異性的顏色反應,采用氣體滴定管進行氣體定量分析。



我們還測量了圖中使用的每個解的莫特-肖特基圖,平帶電位并不依賴于HC1濃度:所有情況下的VrB=0.725-+0.050V。隨著HC1濃度的增加,莫特-肖特基圖的斜率略有減小。這可能是由于蝕刻導致的粗糙化導致的電極表面積增加,為了避免用水將HC1稀釋時所涉及的不確定性,我們研究了HC1-乙酸溶液中的溶解速率,HC1在乙酸(Ka=10-s~5)中的解離常數遠低于水(Ka=10+3),因此,即使在低濃度的HC1下,HC1的解離程度也可以忽略不計。因此,化學蝕刻速率可以作為分子HCt濃度的函數來研究。
蝕刻速率與InP電極的旋轉速率無關,這意味著化學蝕刻速率是由這些HC1分子在動力學上決定的。格瑞舍和華倫提出的半導體化學溶解機制包括對稱雙功能的蝕刻劑,雖然在目前的工作中,我們正在處理一個不對稱的HC1分子,但我們提出了一種類似于對稱劑的反應方案。InP在HC1溶液中的化學蝕刻速率與電勢無關,在接近平帶值的電位時,陽極模蝕刻的速率隨著表面空穴濃度的增加而增加,即隨著電位的增大而增加。在HC1水溶液中,我們已經證明了需要6個孔來溶解一個內p實體,這意味著In和P都被氧化為三價態,這對IILV材料很常見。
審核編輯:湯梓紅
 電子發燒友App
電子發燒友App











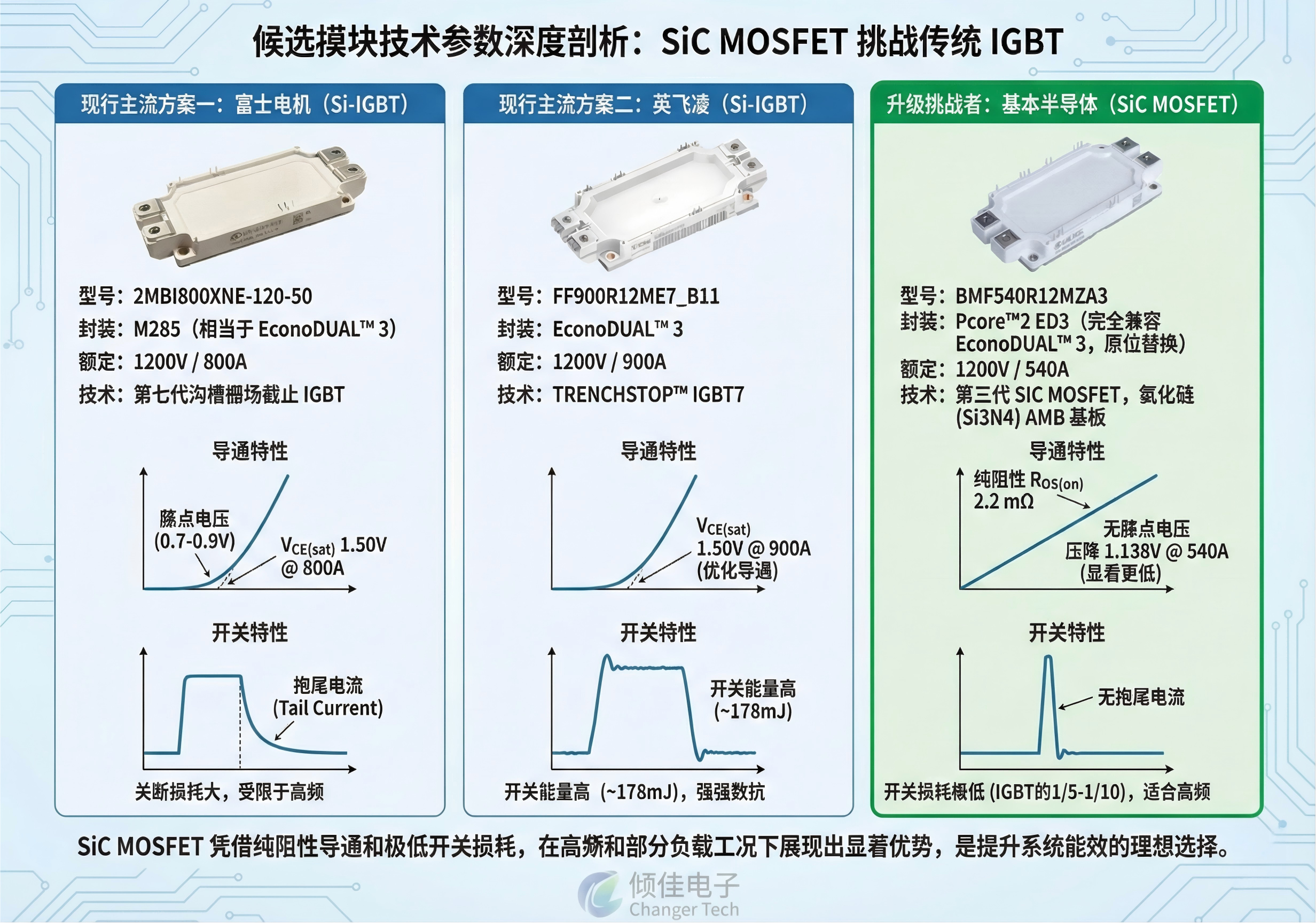
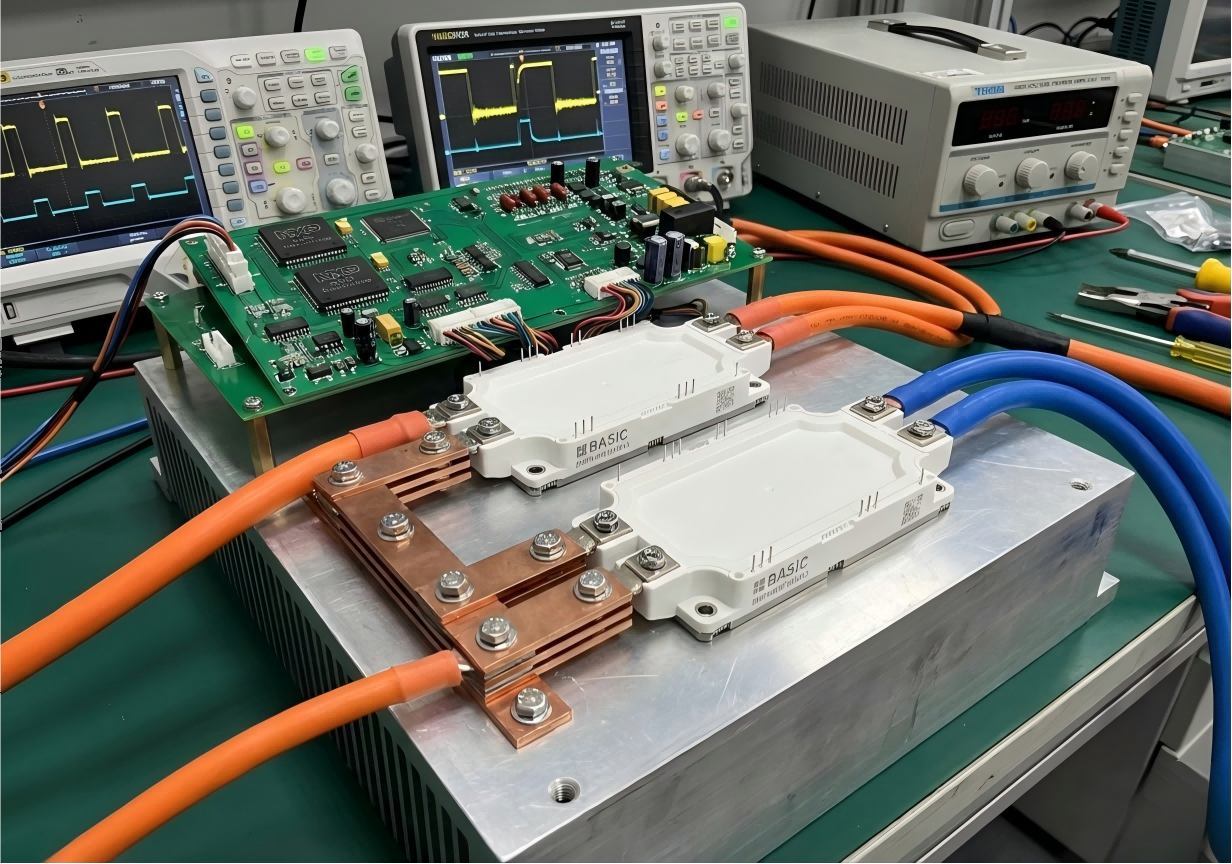


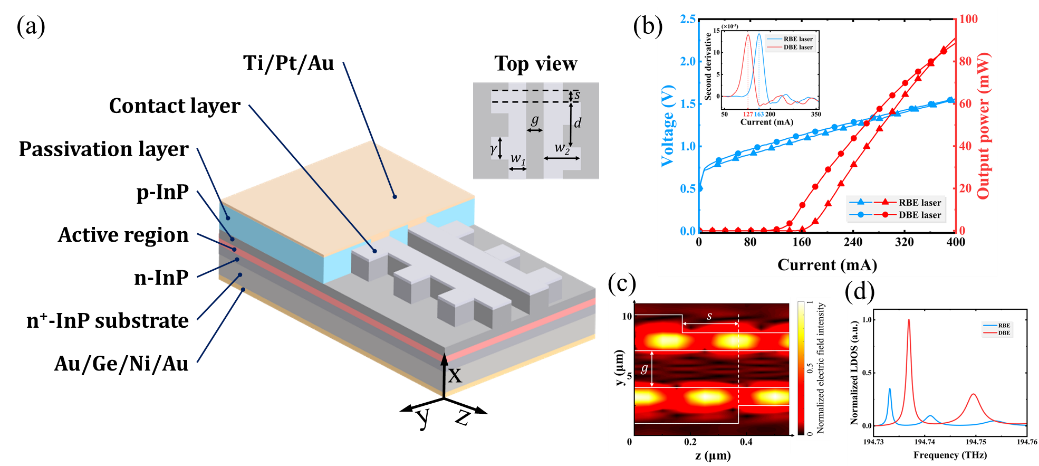









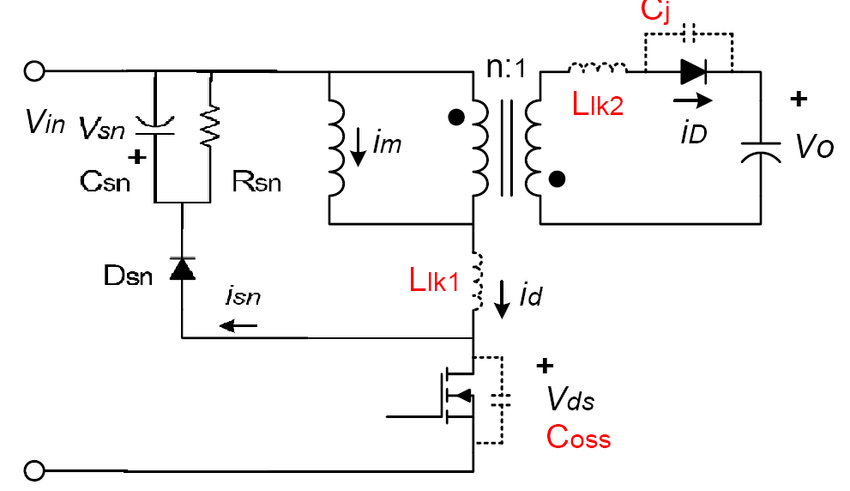


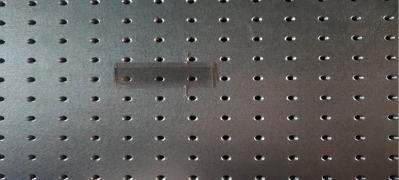



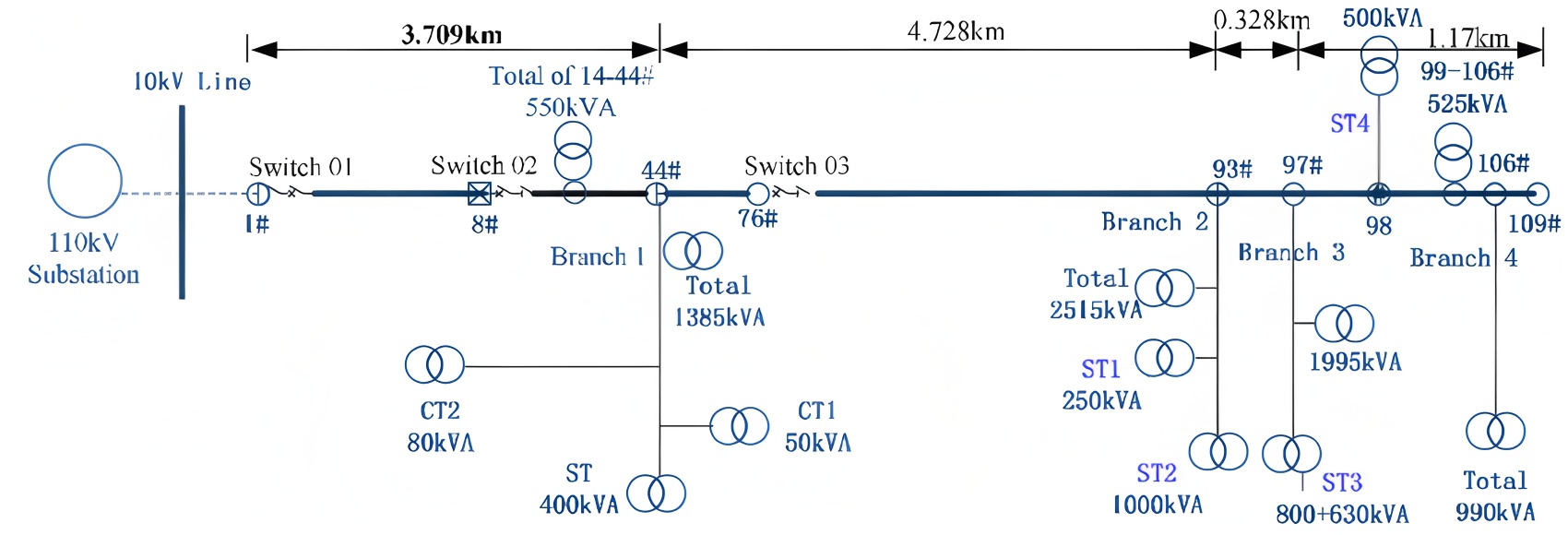

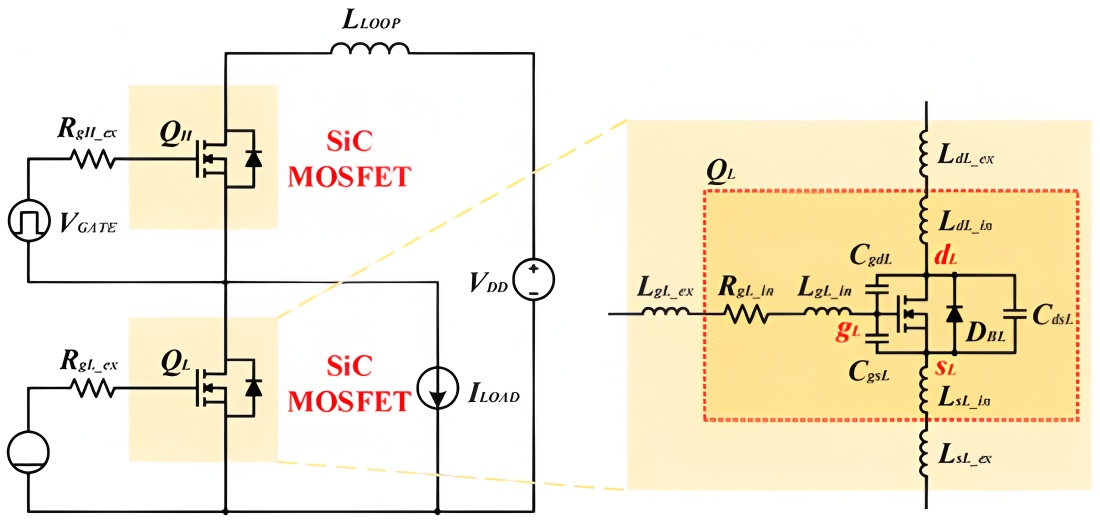

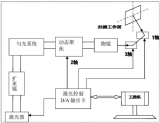






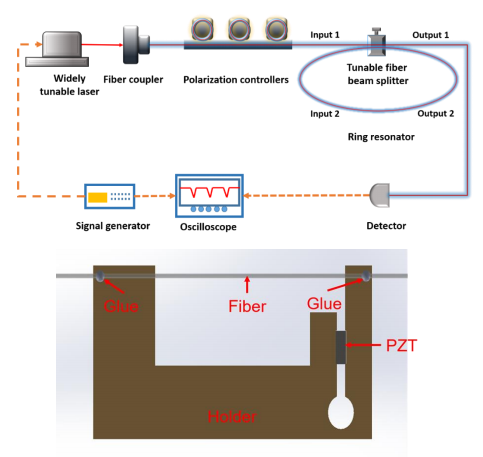




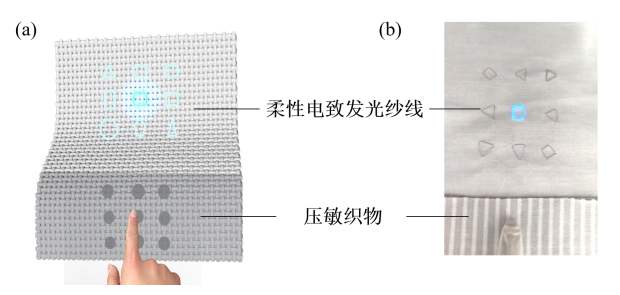


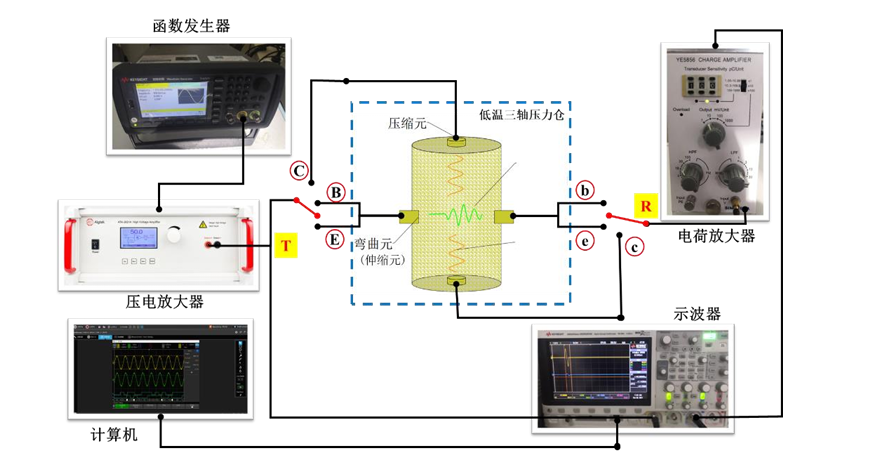
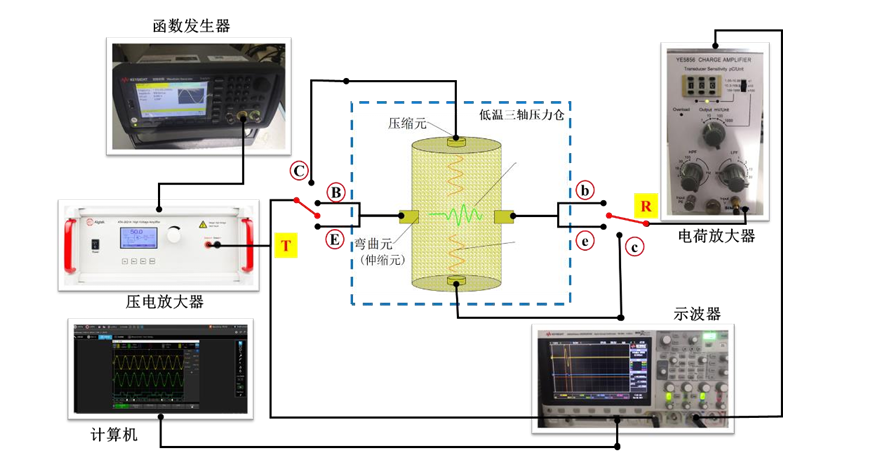
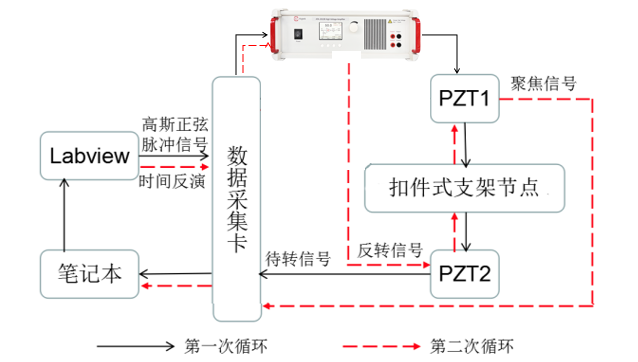
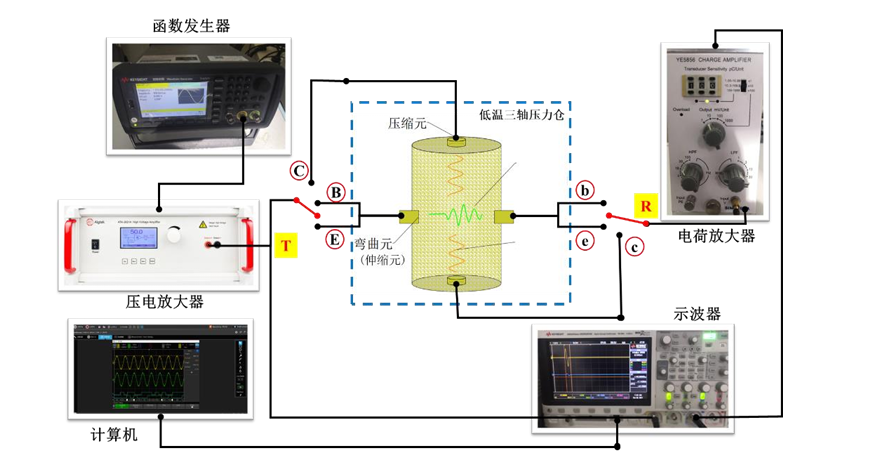






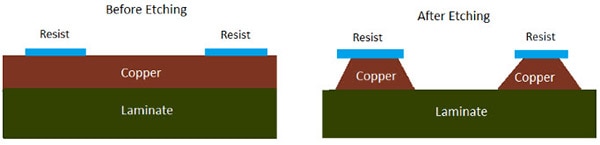






評論