本文以金鑒自研發的顯微紅外定位系統來定位漏電失效的SiC MOSFET芯片,并與OBIRCH對比定位效果,然后用FIB做定點截面切割,觀察到金屬化薄膜鋁條被熔斷。
案例分析:
據客戶反饋,應用于新能源汽車SiC MOSFET器件芯片部分出現電學失效現象:共16個器件,其中5個正常,11個失效。其中失效情況:芯片漏電,及部分芯片燒毀。
金鑒工程師隨機抽取其中一個漏電失效MOS管器件芯片樣品進行初步漏電失效分析。
測試樣品發射率,更精準測溫:
調整芯片發射率后利用金鑒顯微紅外熱點定位測試系統測得樣品熱點溫度為70 ℃,A點溫度為56 ℃。
測試原理:精密半導體器件存在缺陷異常或性能不佳的情況下,通常會表現出異常局部功耗分布,最終會導致局部溫度升高。金鑒顯微紅外熱點定位系統利用新型高分辨率微觀缺陷定位技術進行熱點鎖定(lock in) ,可快速而準確地探測細微缺陷(異常點)位置。
OBIRCH在顯示SiC芯片漏電點上的效果一樣,但是價格卻大大降低。
對熱點進行FIB切割分析:
我們觀察到此發熱點金屬化薄膜鋁條被熔斷。
存在缺陷或性能不佳的半導體器件通常會表現出異常的局部功耗分布,最終會導致局部溫度增高。金鑒顯微紅外熱點定位測試系統利用熱點鎖定技術,可準確而高效地確定這些關注區域的位置。在SiC Mos等功率器件分析中,可用來確定線路短路、ESD擊穿等。該測試技術是在自然周圍環境下執行的,無需液氮制冷和遮光箱。
責任編輯:tzh
 電子發燒友App
電子發燒友App











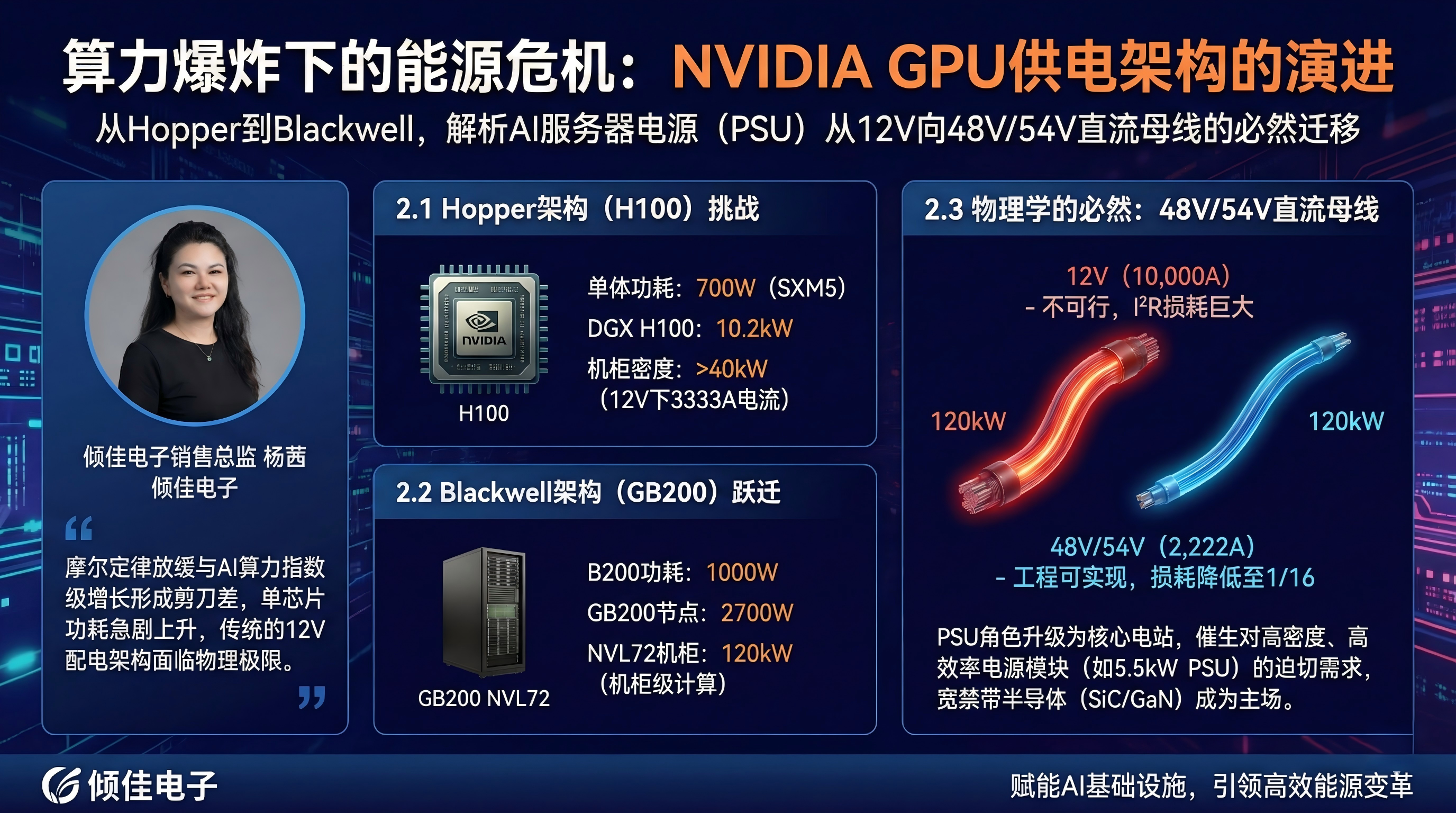


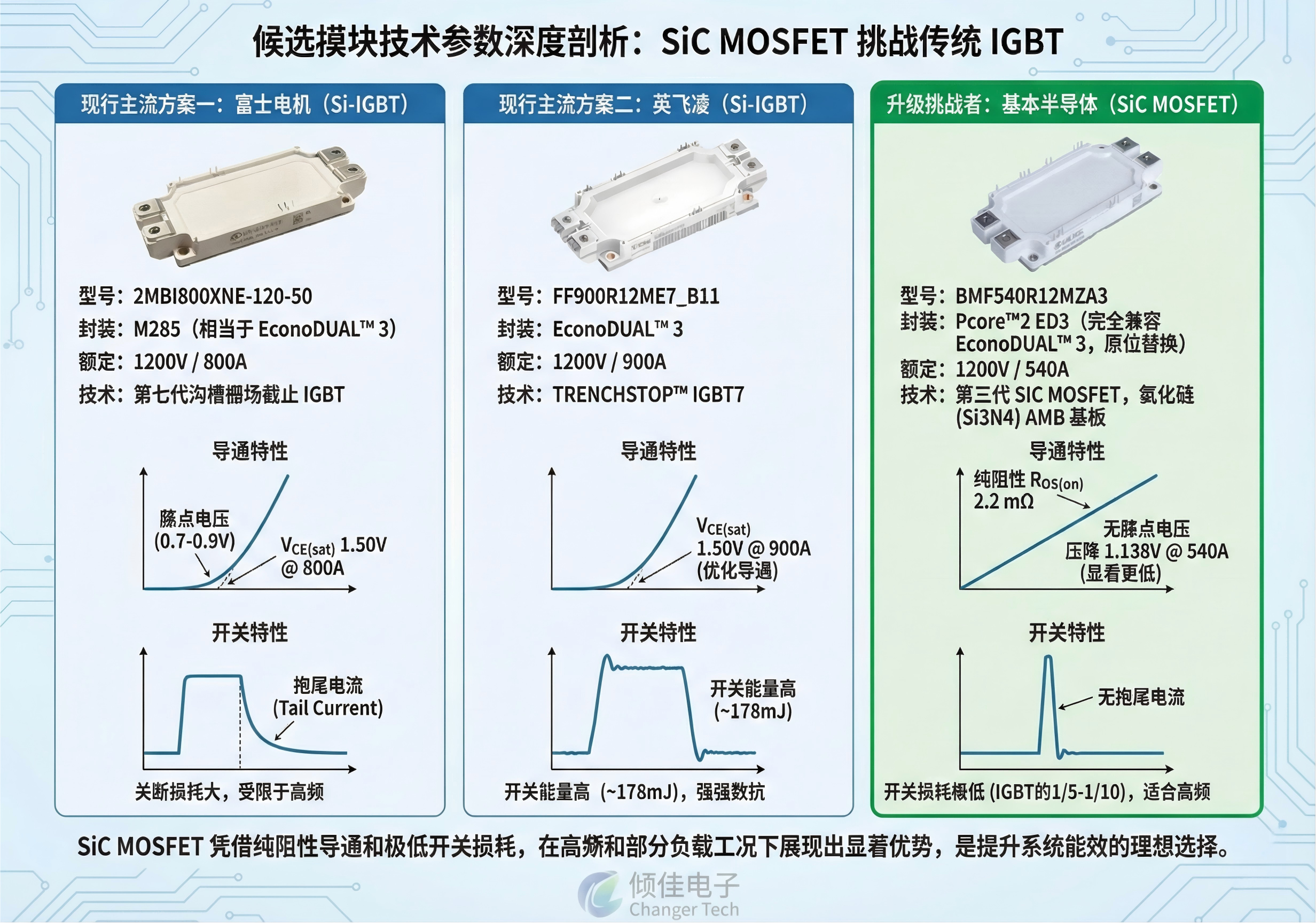












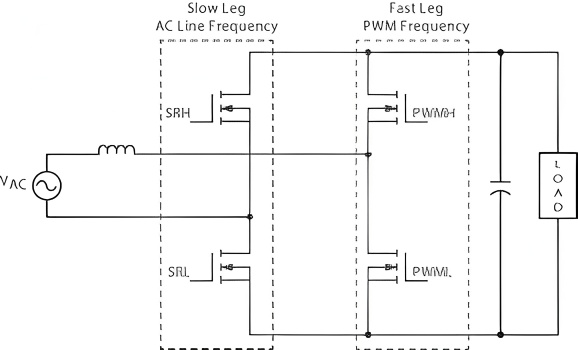

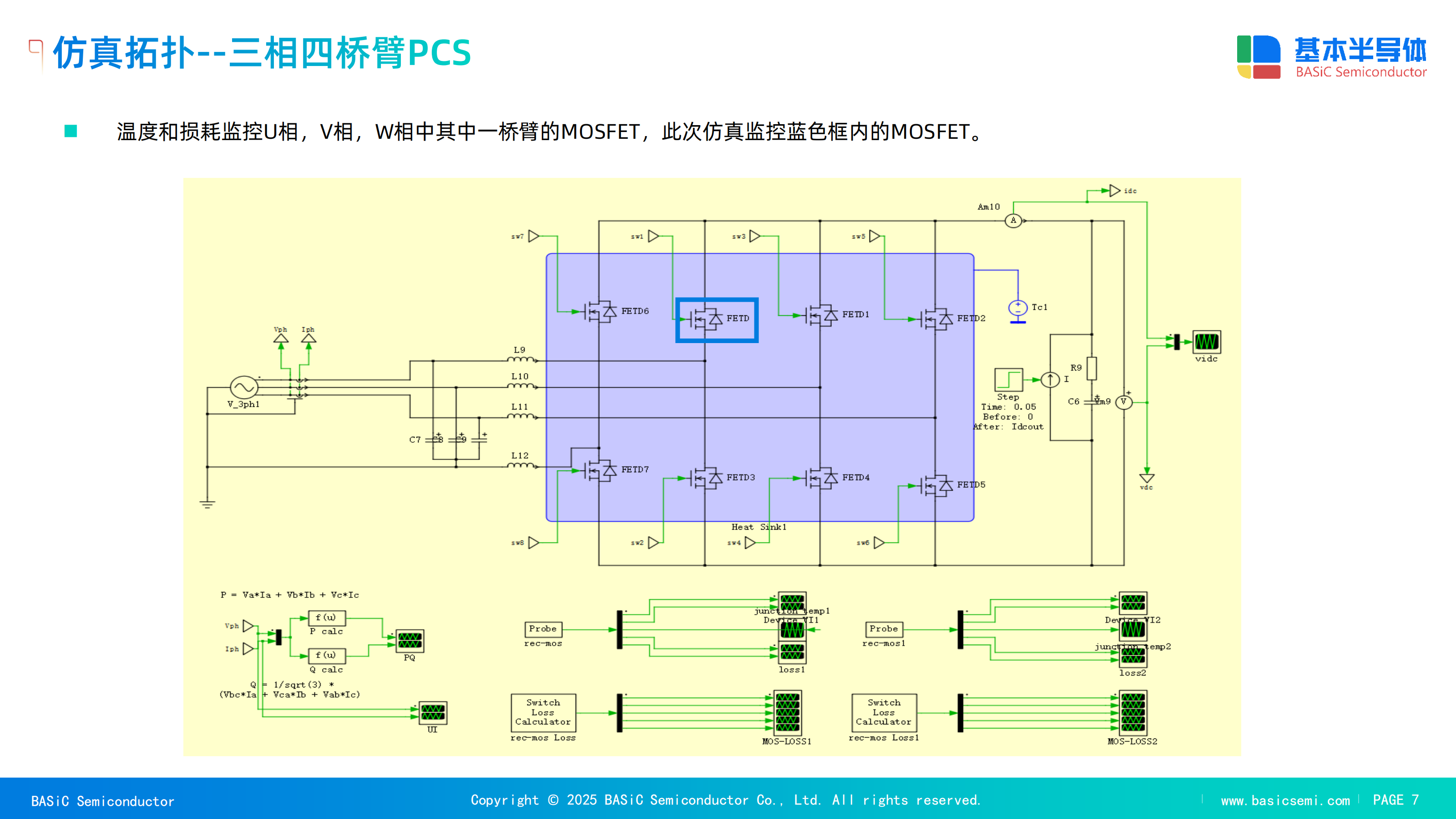
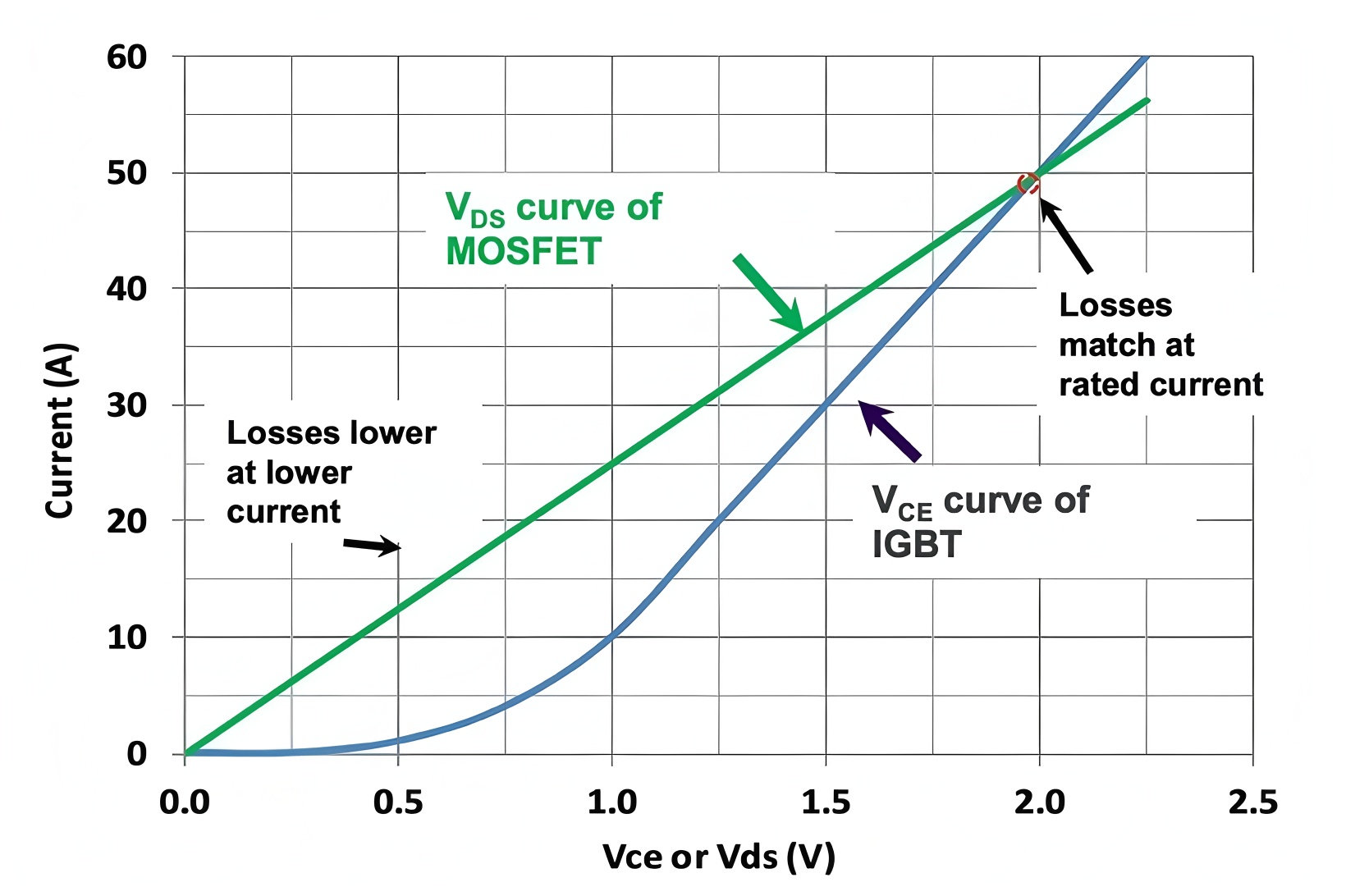

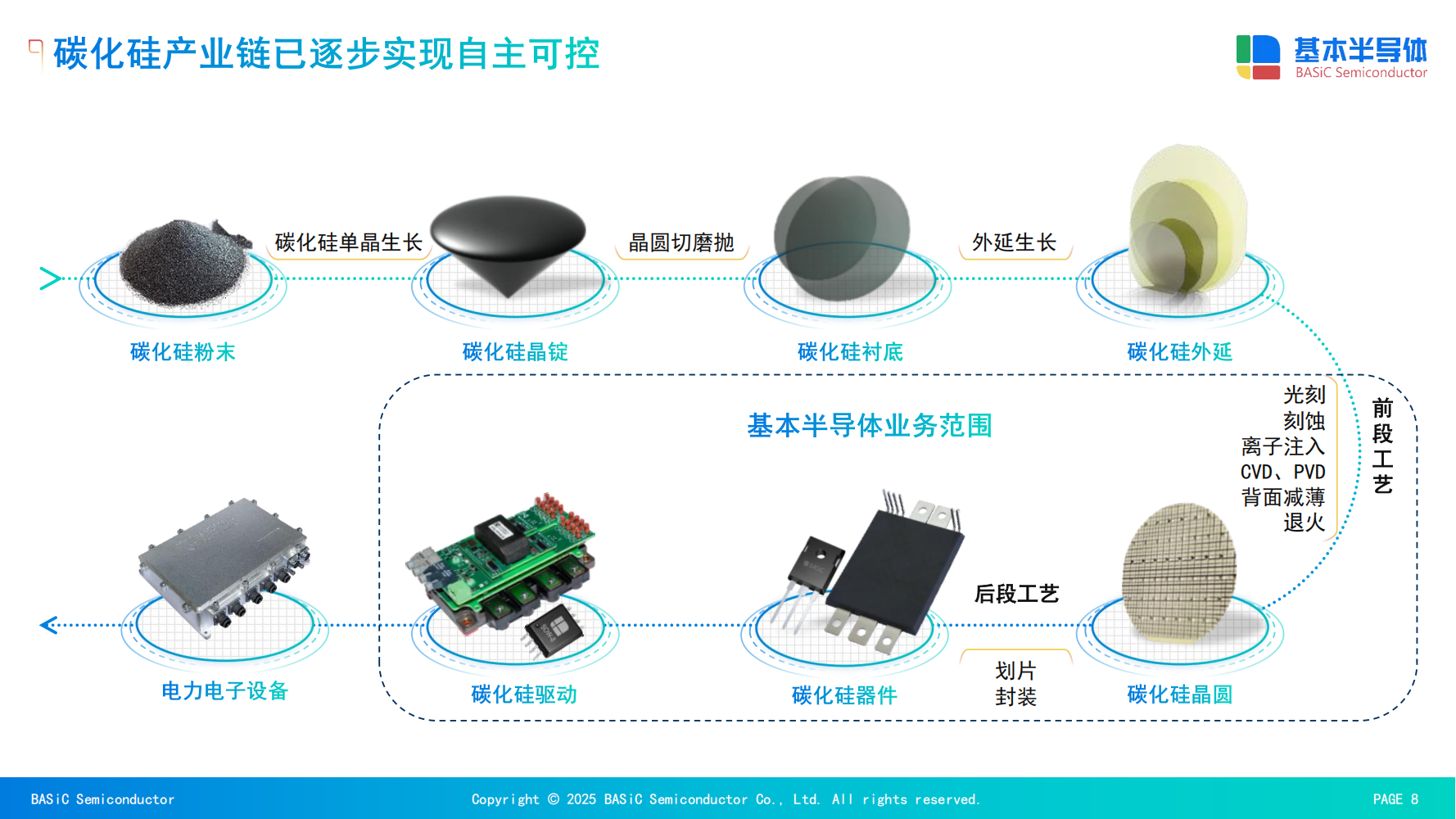


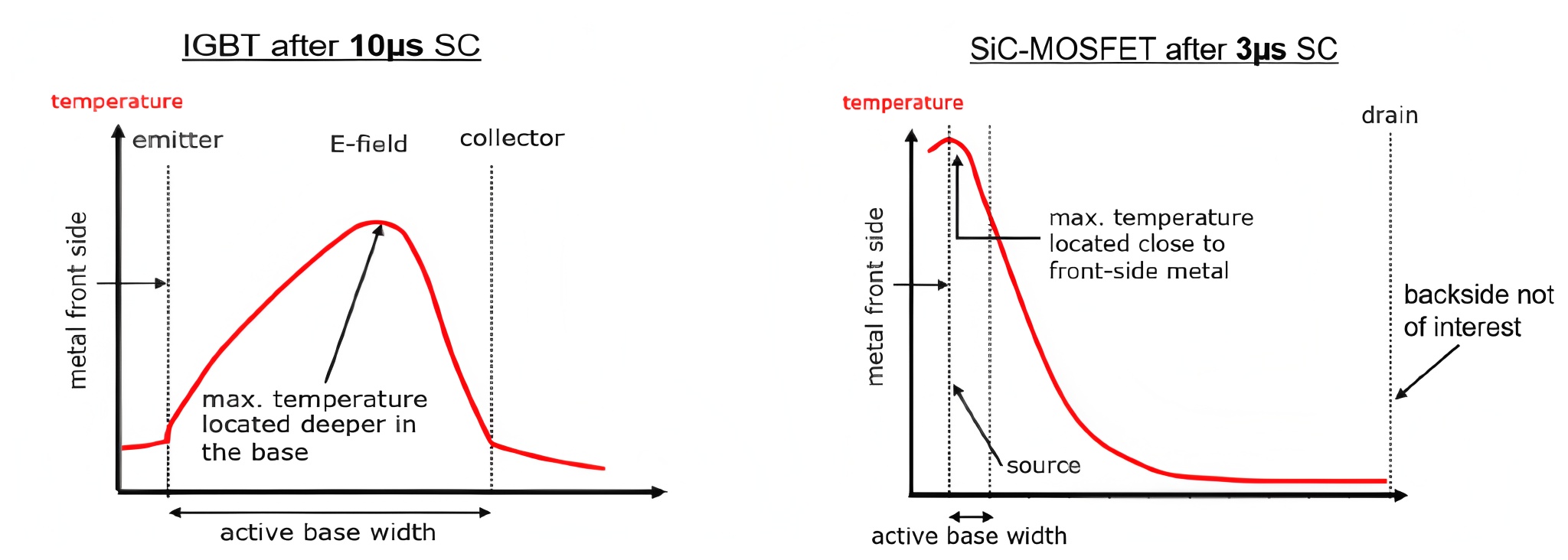


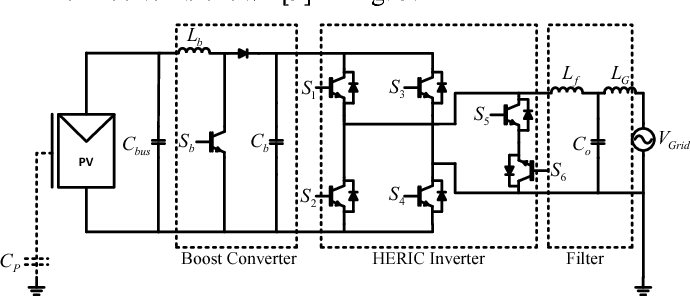


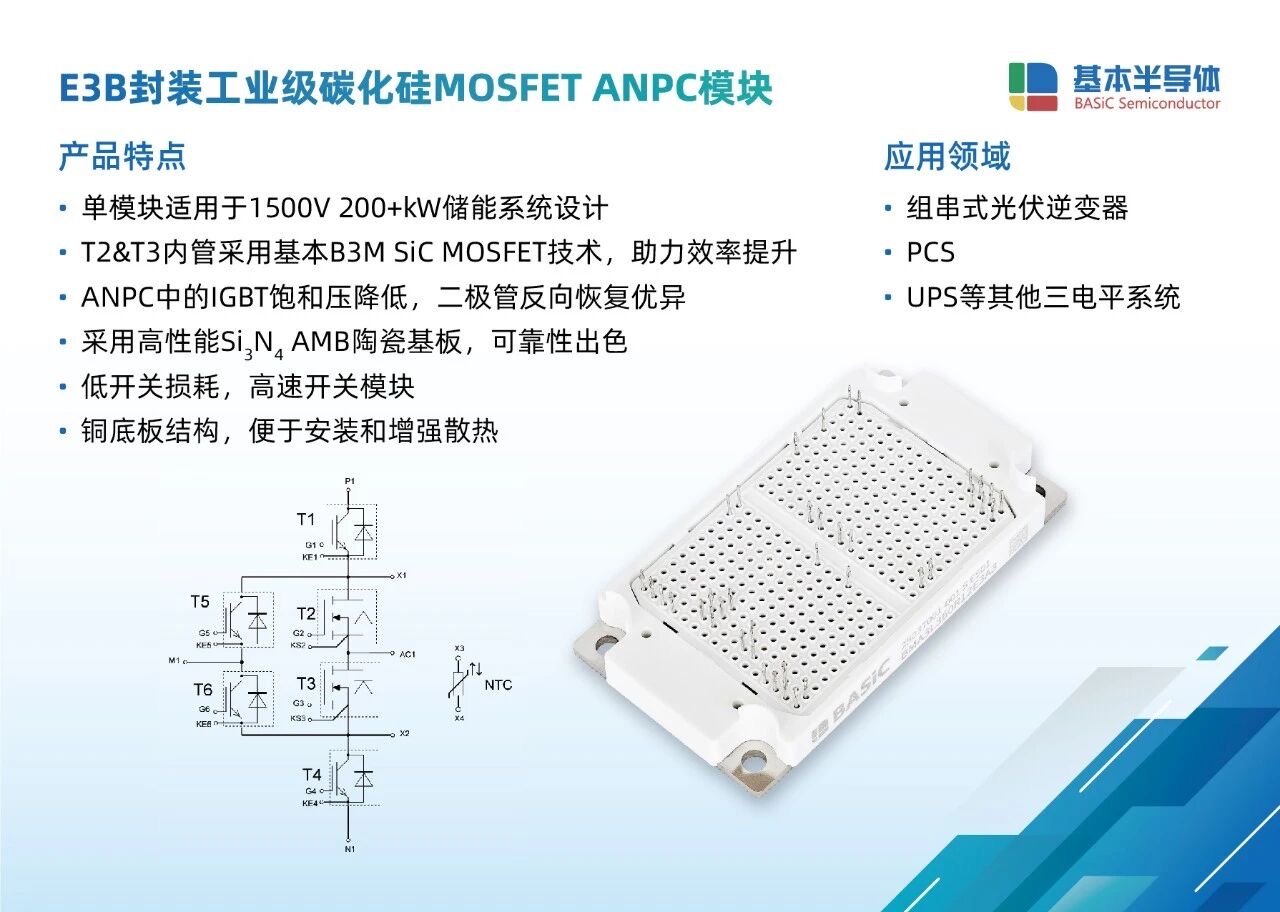






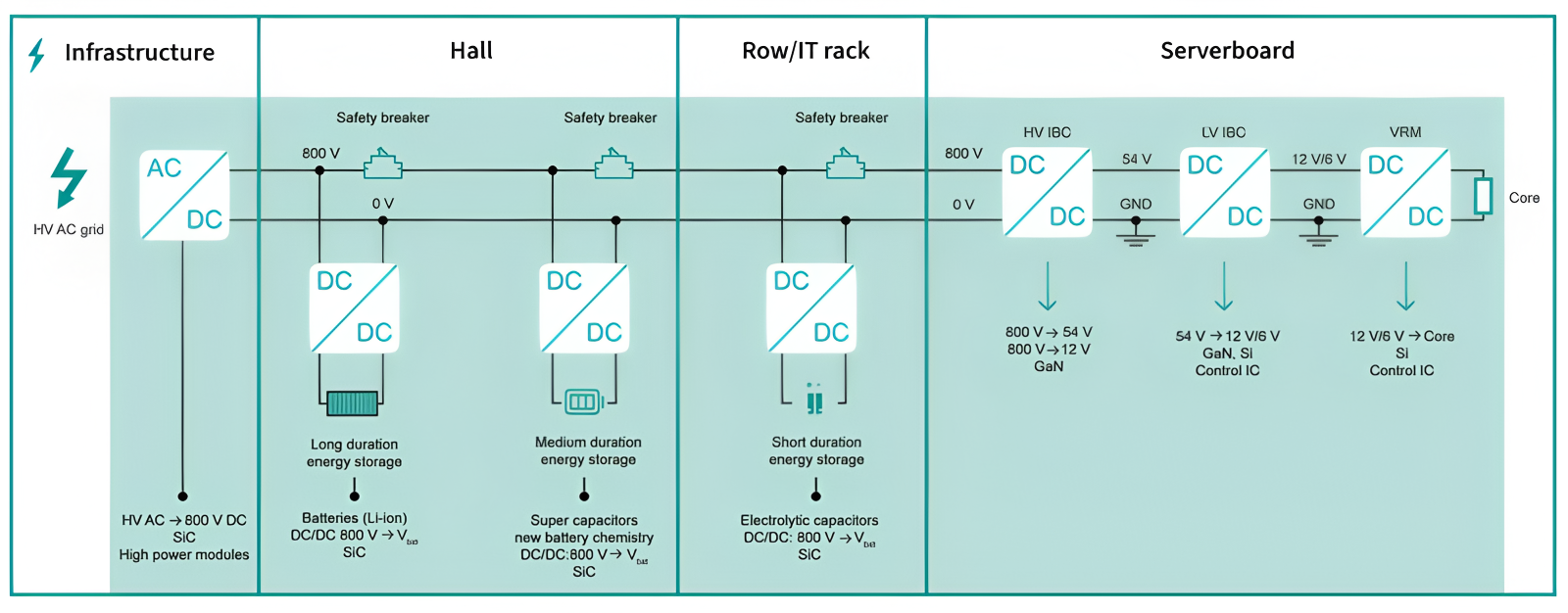
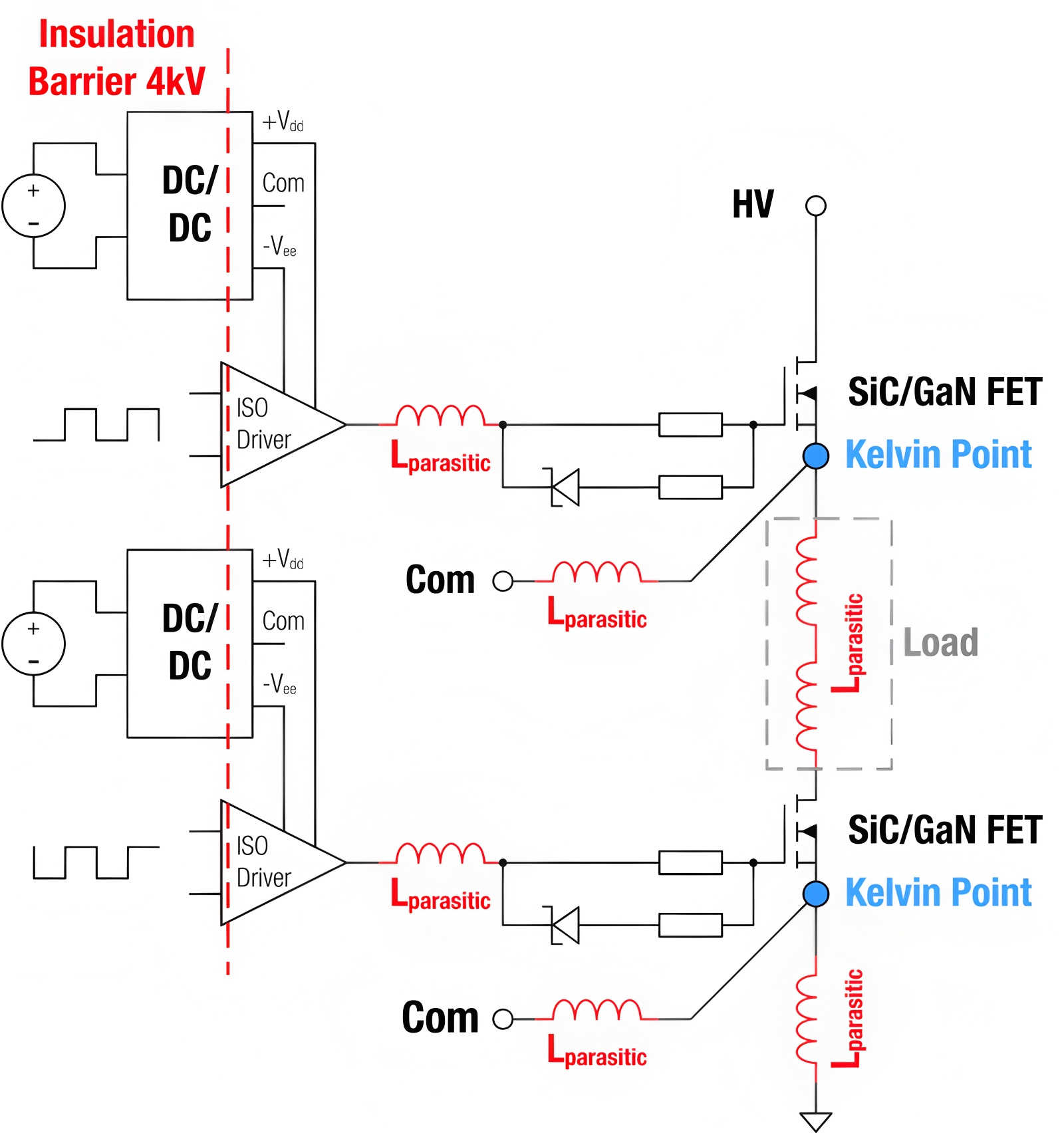
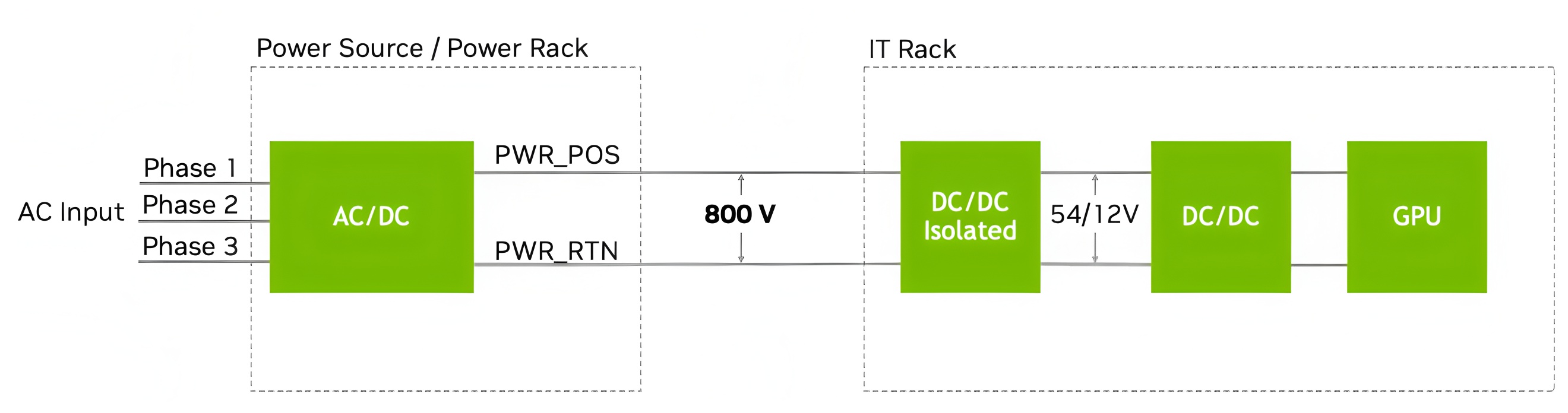
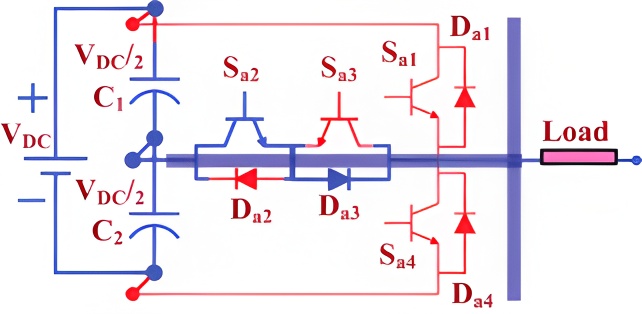
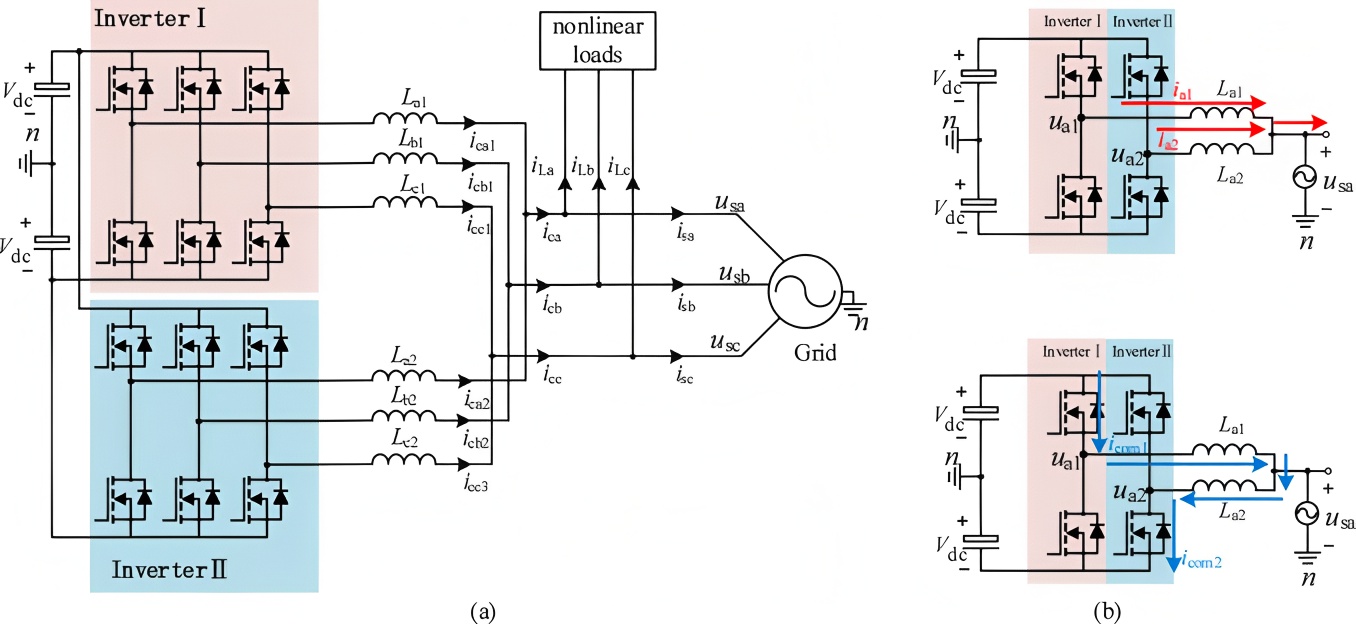



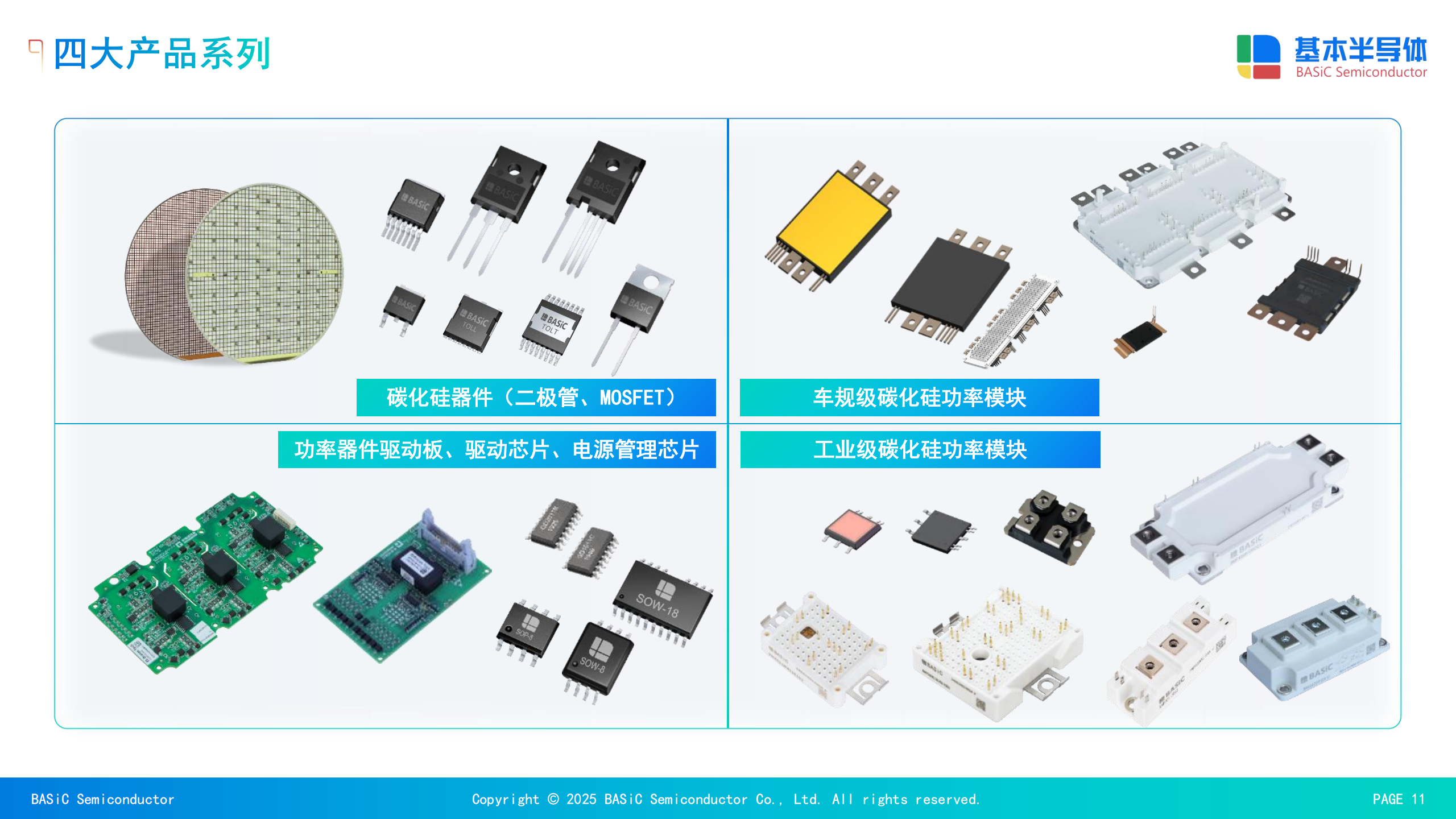
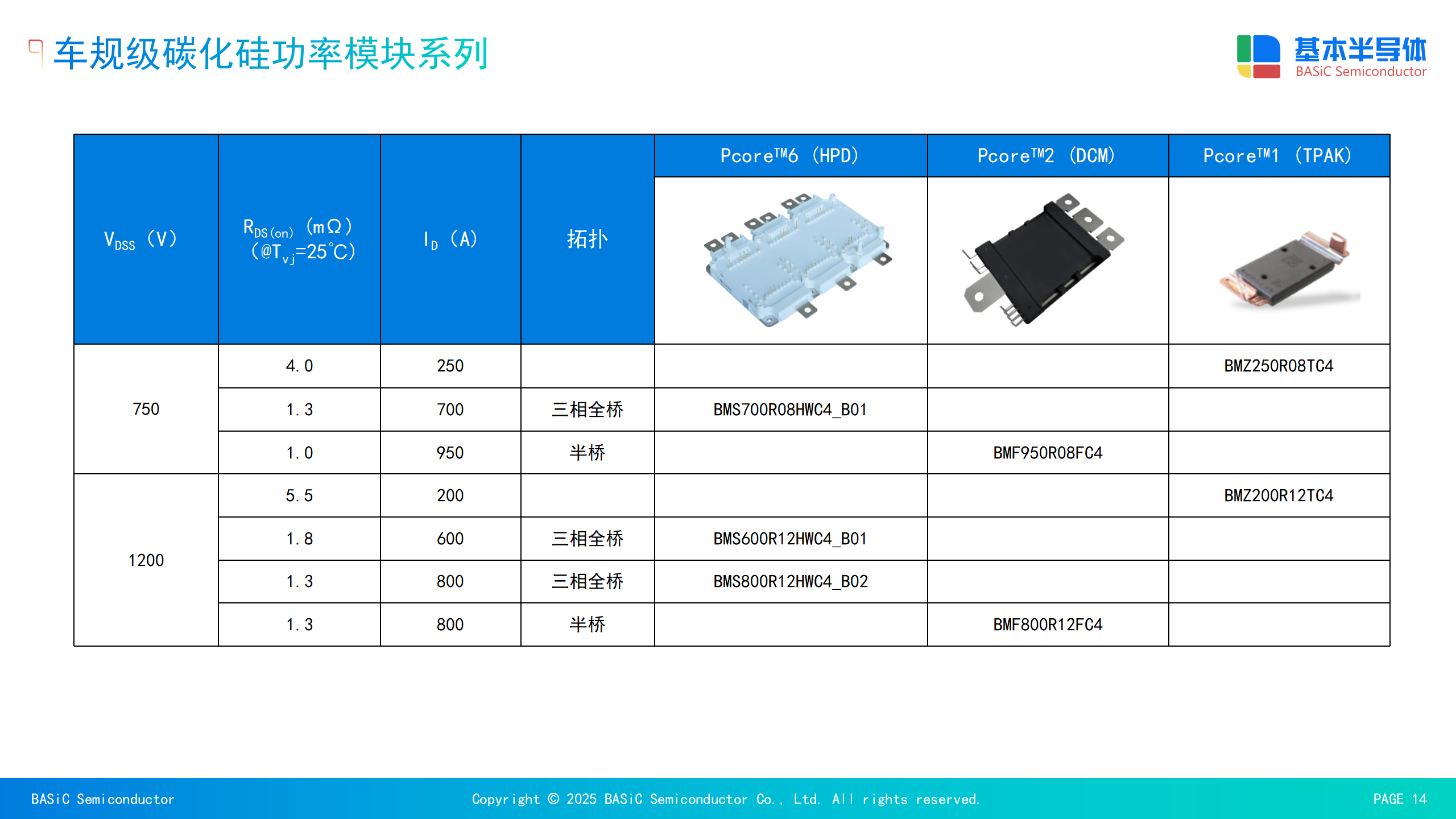
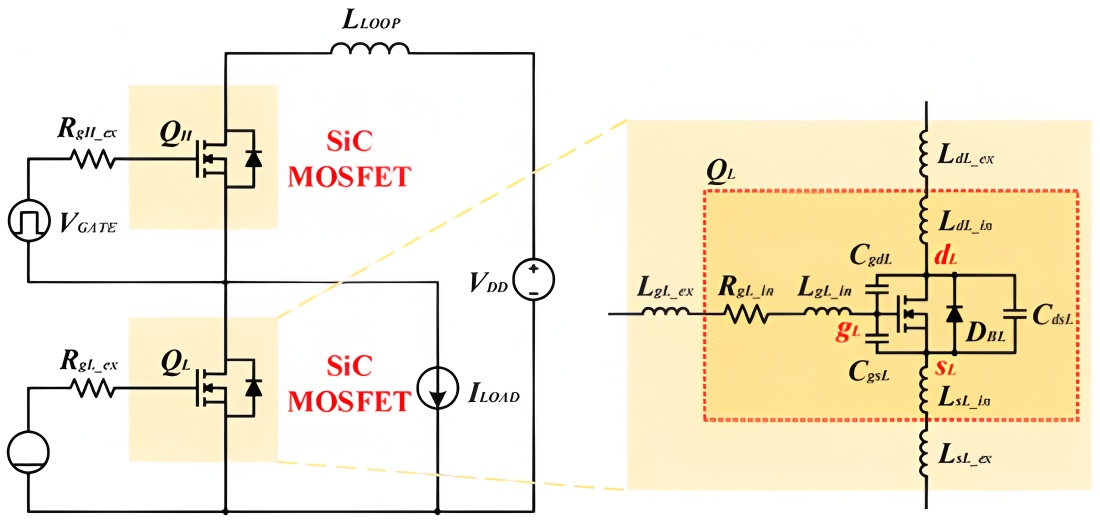
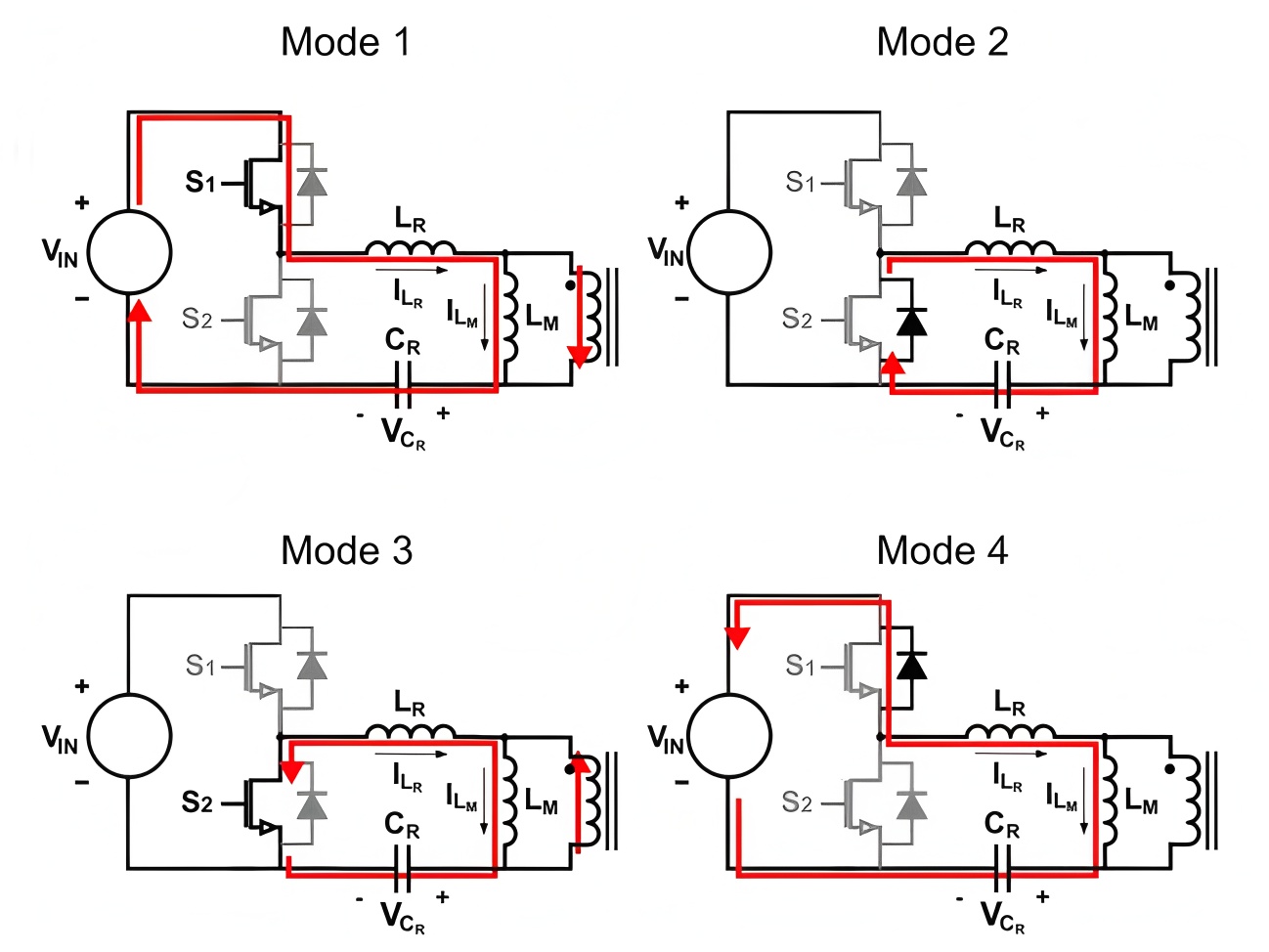

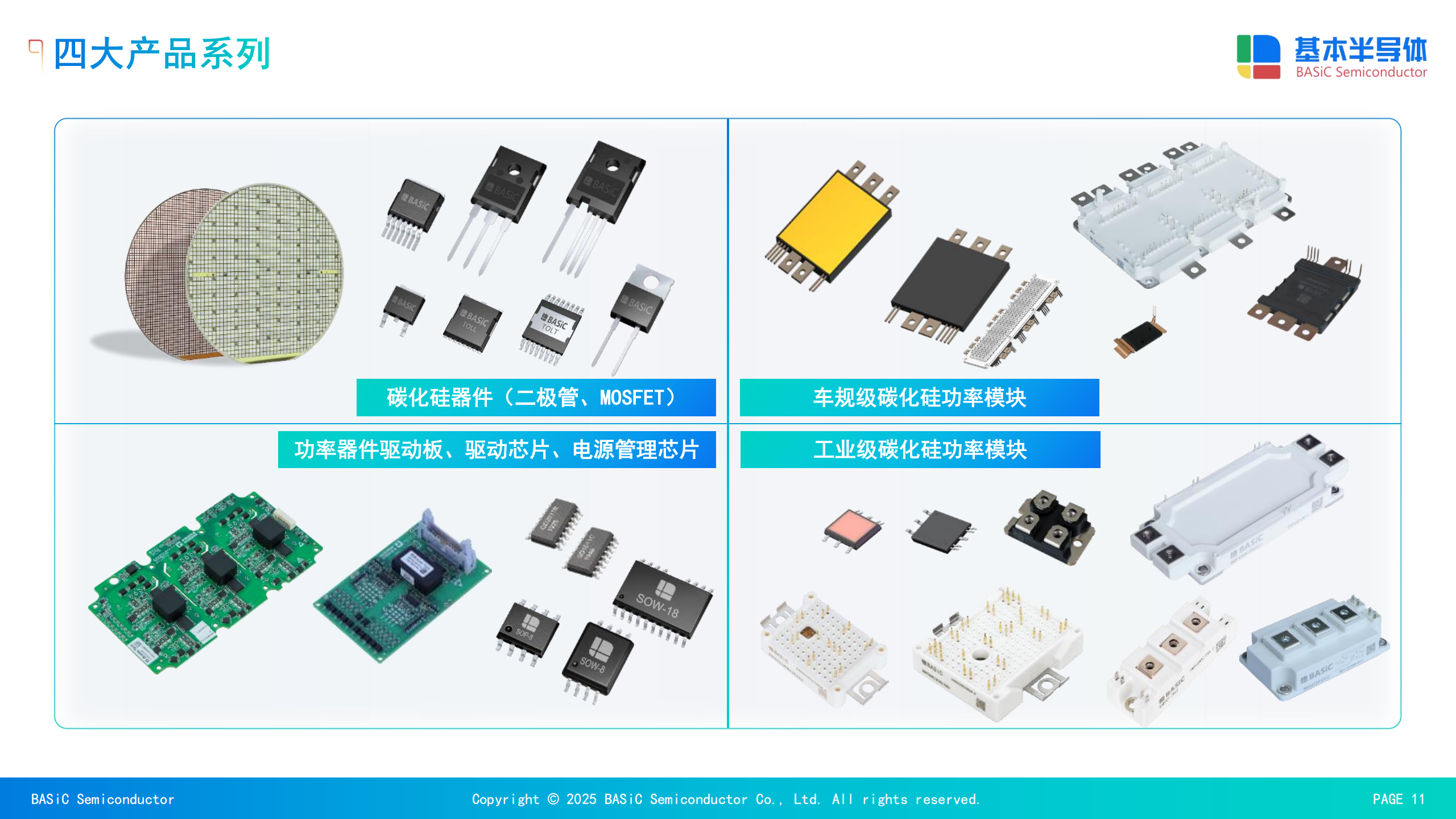


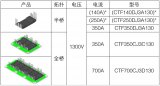
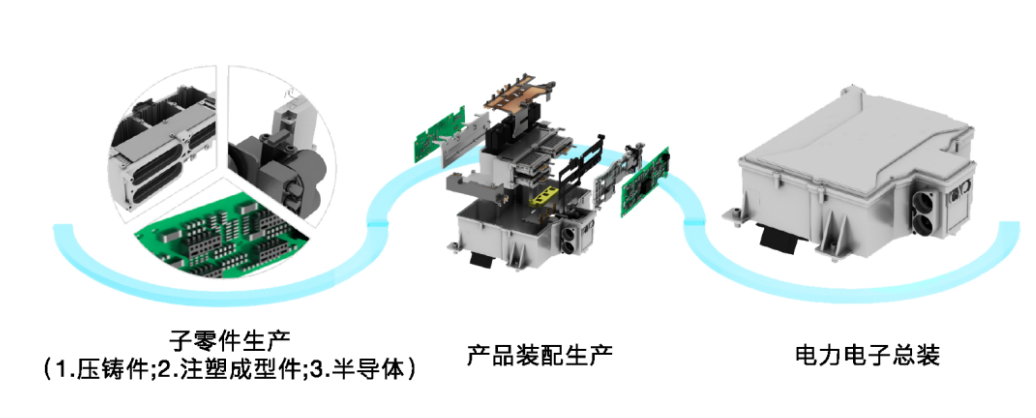






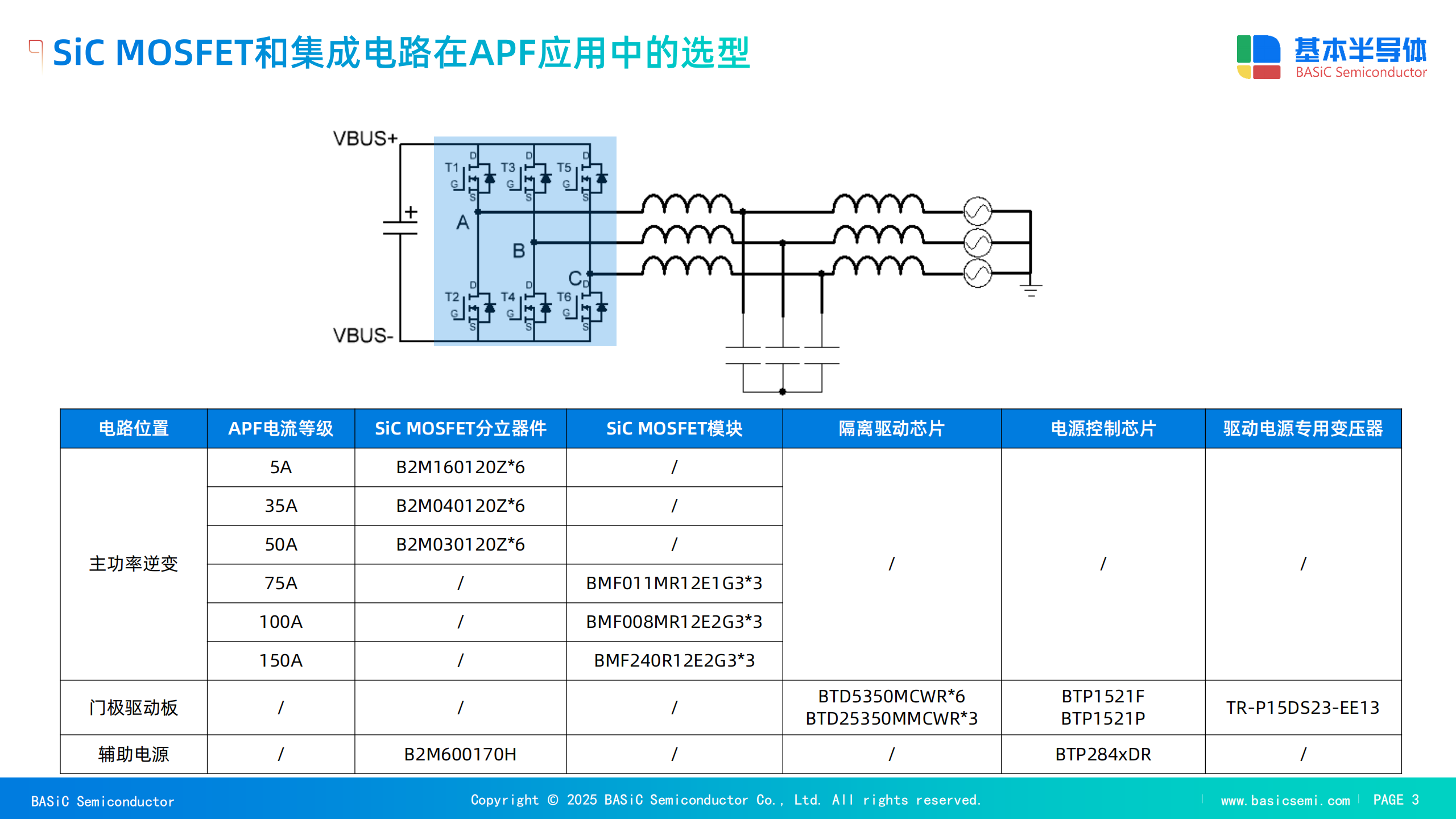
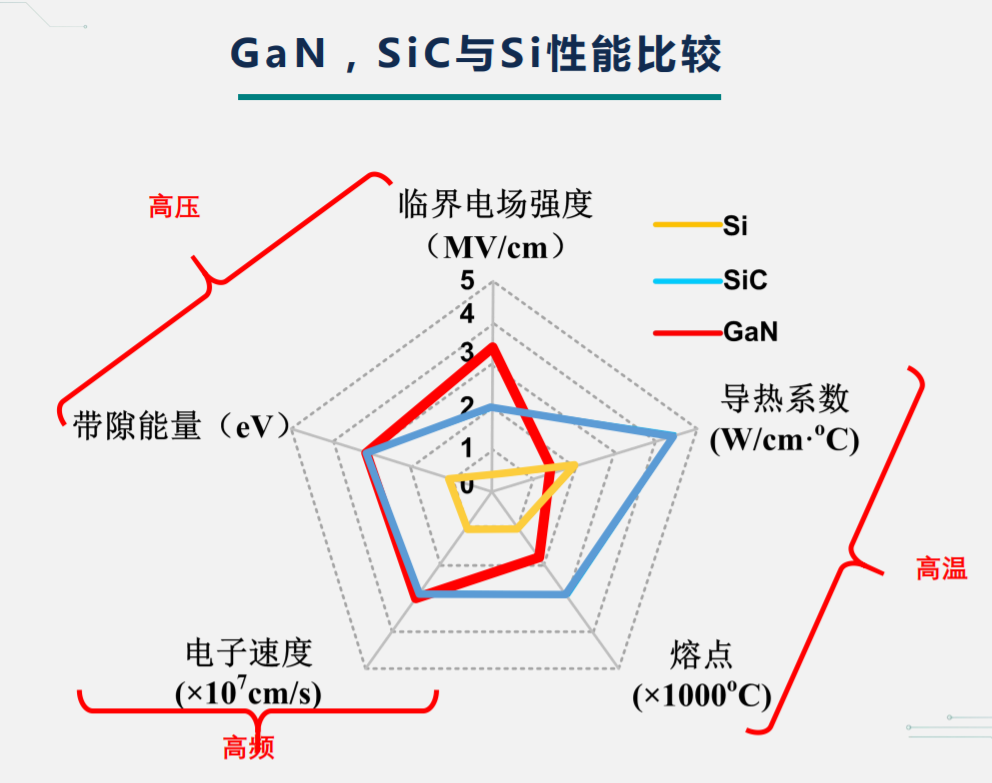
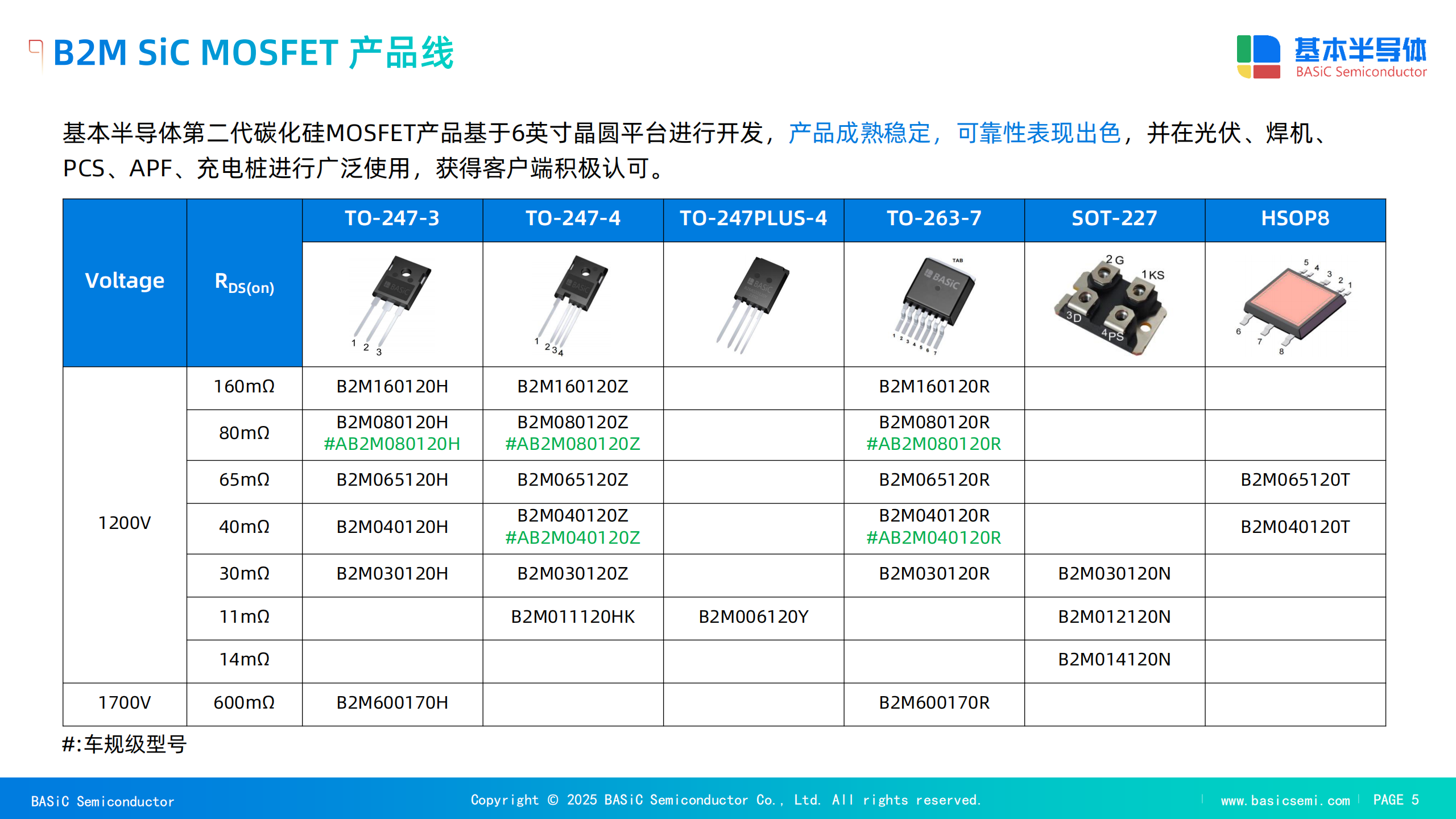
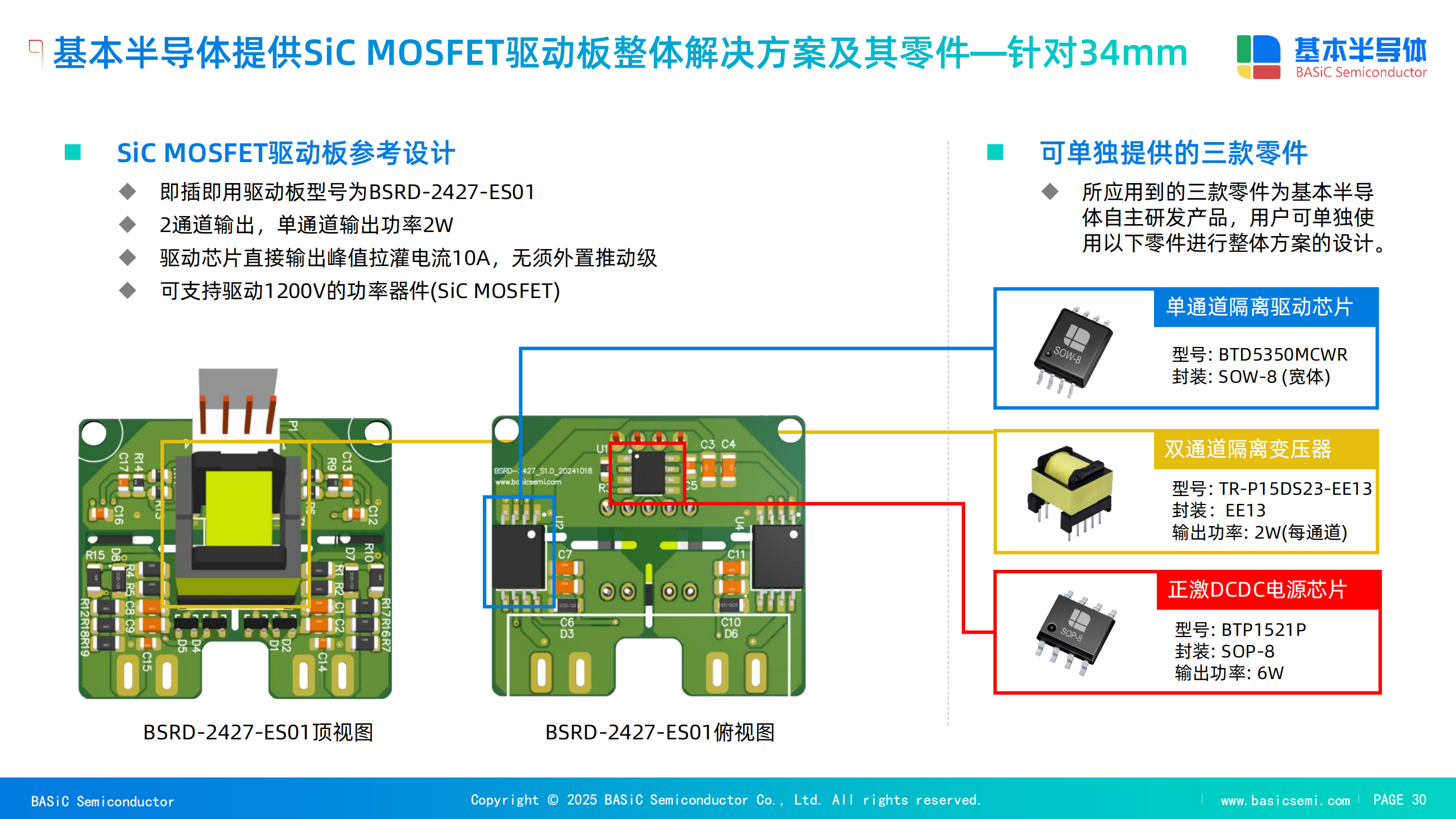
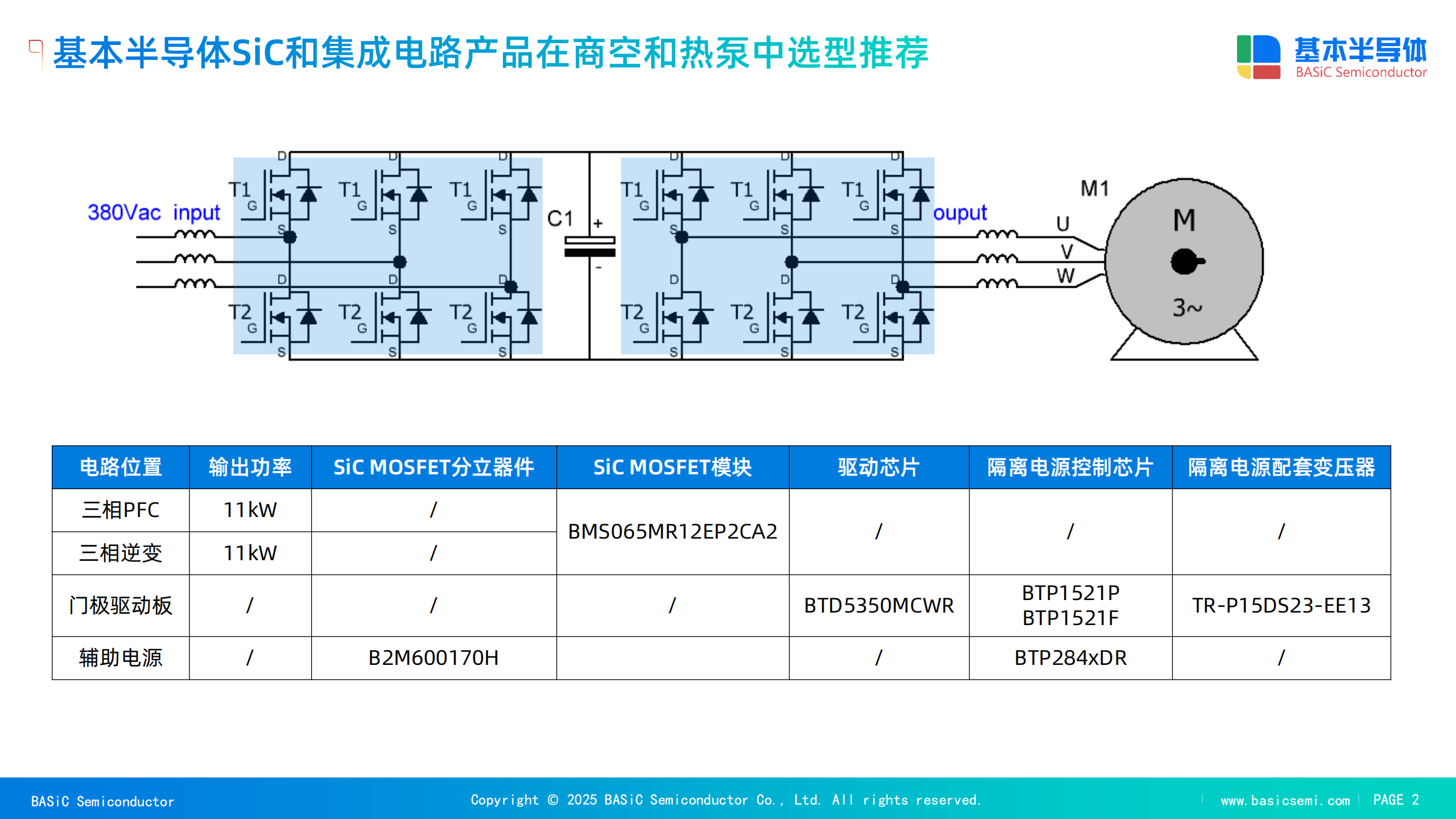

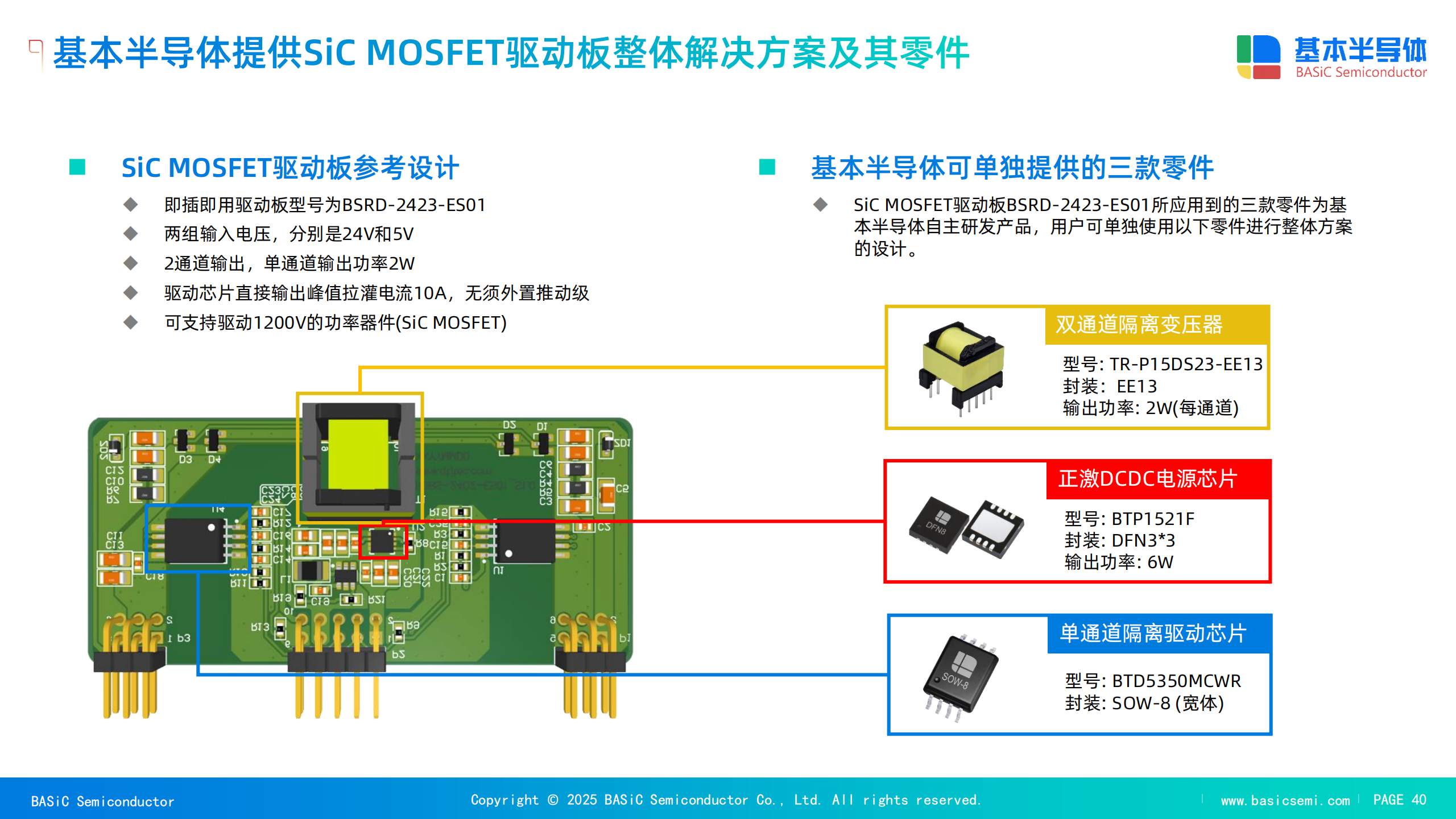
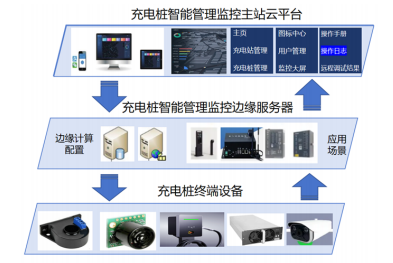

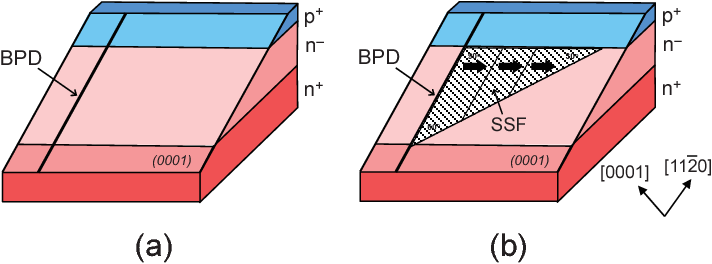






評論