傾佳電子戶儲與工商業混合逆變器功率器件從IGBT向SiC MOSFET全面轉型的驅動因素深度研究報告
傾佳電子(Changer Tech)是一家專注于功率半導體和新能源汽車連接器的分銷商。主要服務于中國工業電源、電力電子設備和新能源汽車產業鏈。傾佳電子聚焦于新能源、交通電動化和數字化轉型三大方向,分銷代理BASiC基本半導體SiC碳化硅MOSFET單管,SiC碳化硅MOSFET功率模塊,SiC模塊驅動板等功率半導體器件以及新能源汽車連接器。?
傾佳電子楊茜致力于推動國產SiC碳化硅模塊在電力電子應用中全面取代進口IGBT模塊,助力電力電子行業自主可控和產業升級!
傾佳電子楊茜咬住SiC碳化硅MOSFET功率器件三個必然,勇立功率半導體器件變革潮頭:
傾佳電子楊茜咬住SiC碳化硅MOSFET模塊全面取代IGBT模塊和IPM模塊的必然趨勢!
傾佳電子楊茜咬住SiC碳化硅MOSFET單管全面取代IGBT單管和大于650V的高壓硅MOSFET的必然趨勢!
傾佳電子楊茜咬住650V SiC碳化硅MOSFET單管全面取代SJ超結MOSFET和高壓GaN 器件的必然趨勢!
1. 概述:能源變革下的功率器件范式轉移
全球能源結構正在經歷一場深刻的變革,分布式光伏與儲能系統的深度融合已成為戶用及工商業能源轉型的核心路徑。在此背景下,作為能量轉換心臟的混合逆變器(Hybrid Inverter),其技術架構正處于從硅基(Silicon, Si)絕緣柵雙極型晶體管(IGBT)向碳化硅(Silicon Carbide, SiC)金屬-氧化物半導體場效應晶體管(MOSFET)全面轉型的關鍵拐點。

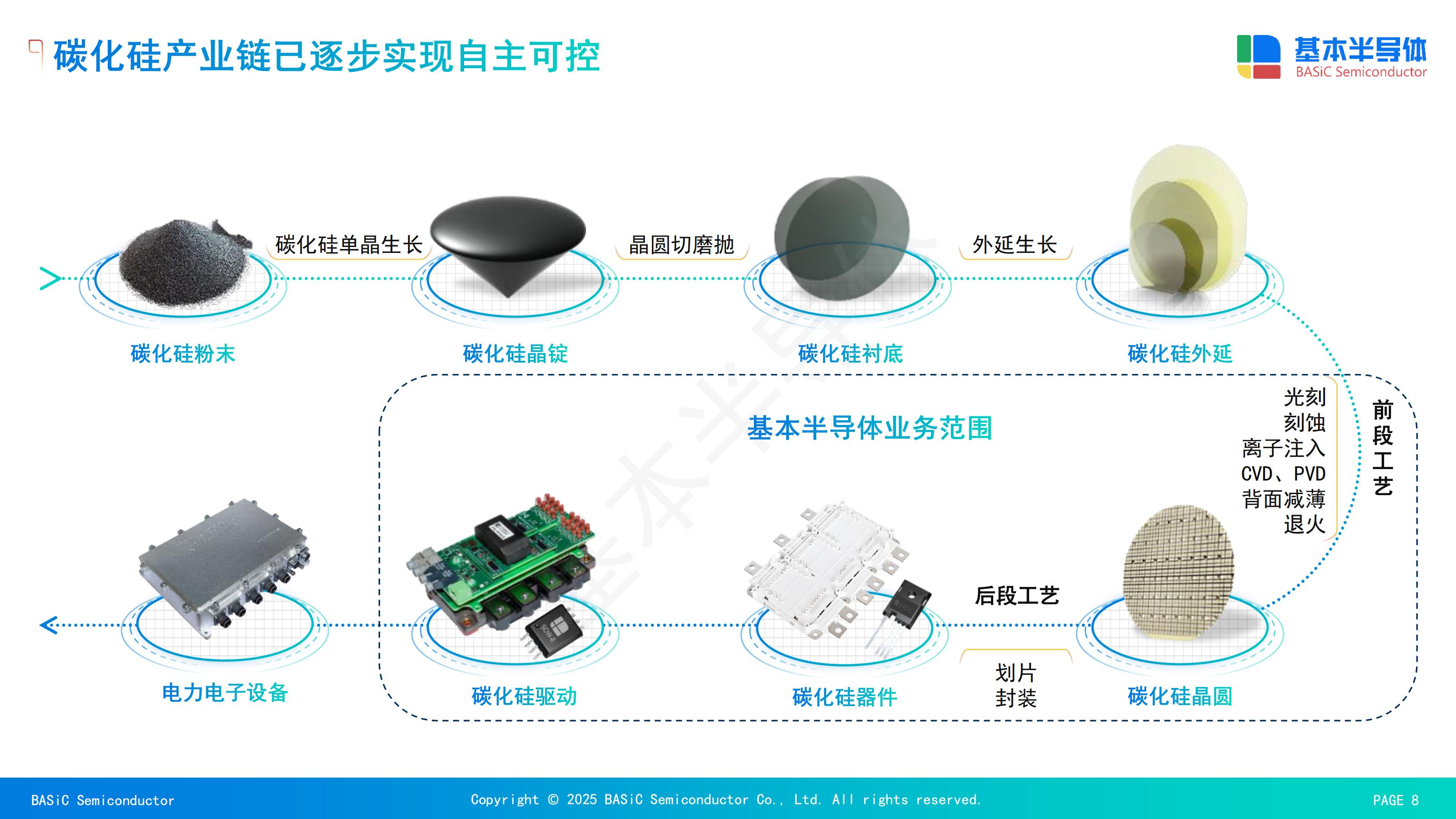

傾佳電子基于最新的第三代半導體技術資料、詳細的器件規格說明書及產業戰略文檔,對造就這一全面加速趨勢的深層因素進行詳盡的剖析。研究發現,這一轉型并非單一維度的性能升級,而是由材料物理極限的突破、系統級能效需求的倒逼、封裝工藝的代際演進以及供應鏈成熟度的提升共同促成的系統性變革。從戶用儲能系統對靜音、緊湊設計的極致追求,到工商業儲能對高壓直流母線(DC-Link)效率的嚴苛考量,SiC MOSFET憑借其在寬禁帶特性、電阻特性及熱力學特性上的壓倒性優勢,正在重塑電力電子的底層邏輯。
2. 材料物理屬性的代際跨越:轉型的底層邏輯
驅動功率器件從IGBT轉向SiC MOSFET的根本動力,源于碳化硅材料本身相對于硅材料在物理屬性上的代際跨越。這種物理層面的優勢決定了器件性能的理論天花板,從而在源頭上定義了逆變器系統的效率與體積極限。
2.1 寬禁帶與臨界擊穿場強的數量級優勢
碳化硅屬于第三代寬禁帶半導體材料,其禁帶寬度(Bandgap Energy)約為3.26 eV,是硅材料(1.12 eV)的近三倍1。這一基本物理屬性直接導致了SiC的臨界擊穿場強(Critical Breakdown Field)達到硅的10倍以上。
在戶儲和工商業逆變器的高壓應用場景中(通常涉及400V至1000V甚至更高的直流母線電壓),這一特性至關重要。對于傳統硅器件,為了承受高電壓,必須大幅增加漂移區的厚度,這會導致導通電阻呈指數級上升。為了解決這一矛盾,硅器件不得不采用IGBT的雙極型結構,利用電導調制效應來降低電阻,但代價是引入了關斷拖尾電流。

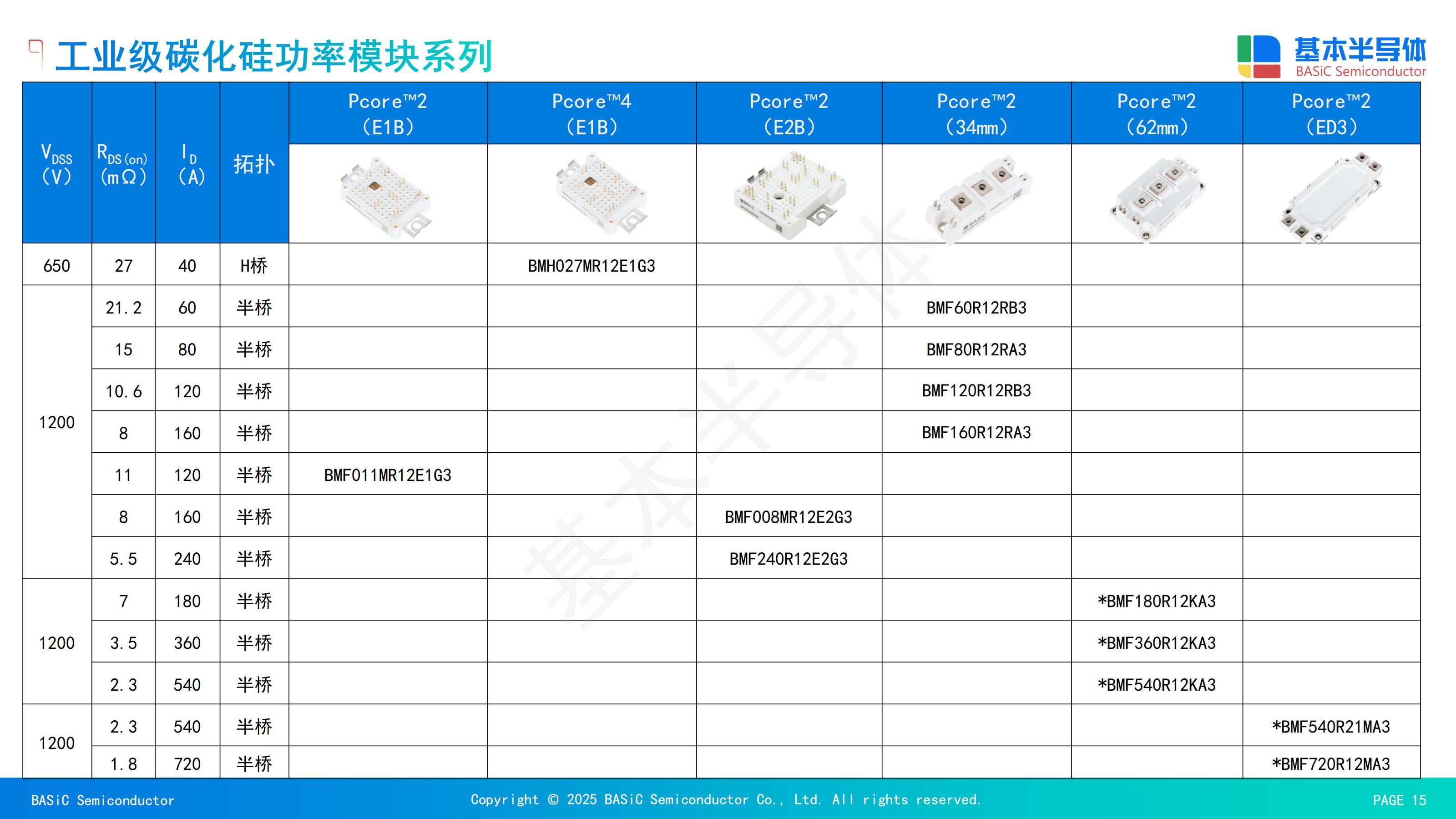
相比之下,SiC MOSFET利用高臨界擊穿場強,可以在極薄的漂移層厚度下實現極高的耐壓能力。例如,基本半導體(Basic Semiconductor)推出的B3M010140Y器件,在實現高達1400V擊穿電壓的同時,仍能保持僅10 mΩ的超低導通電阻。這種物理特性的突破,使得在高壓領域采用單極型MOSFET結構成為可能,從而在根本上消除了IGBT固有的拖尾電流問題,為逆變器的高頻化奠定了物理基礎。
2.2 熱導率與高溫運行能力的提升
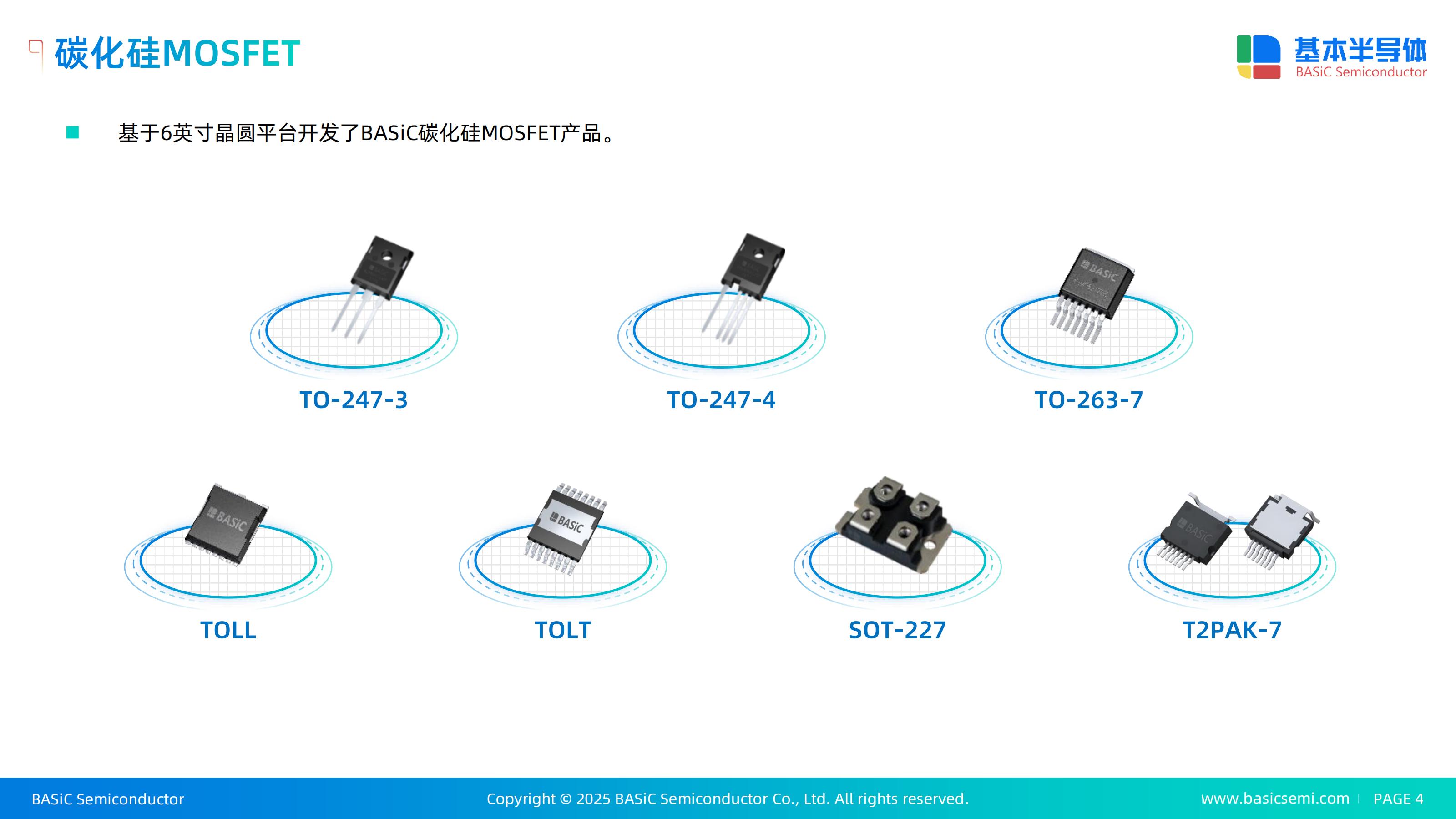

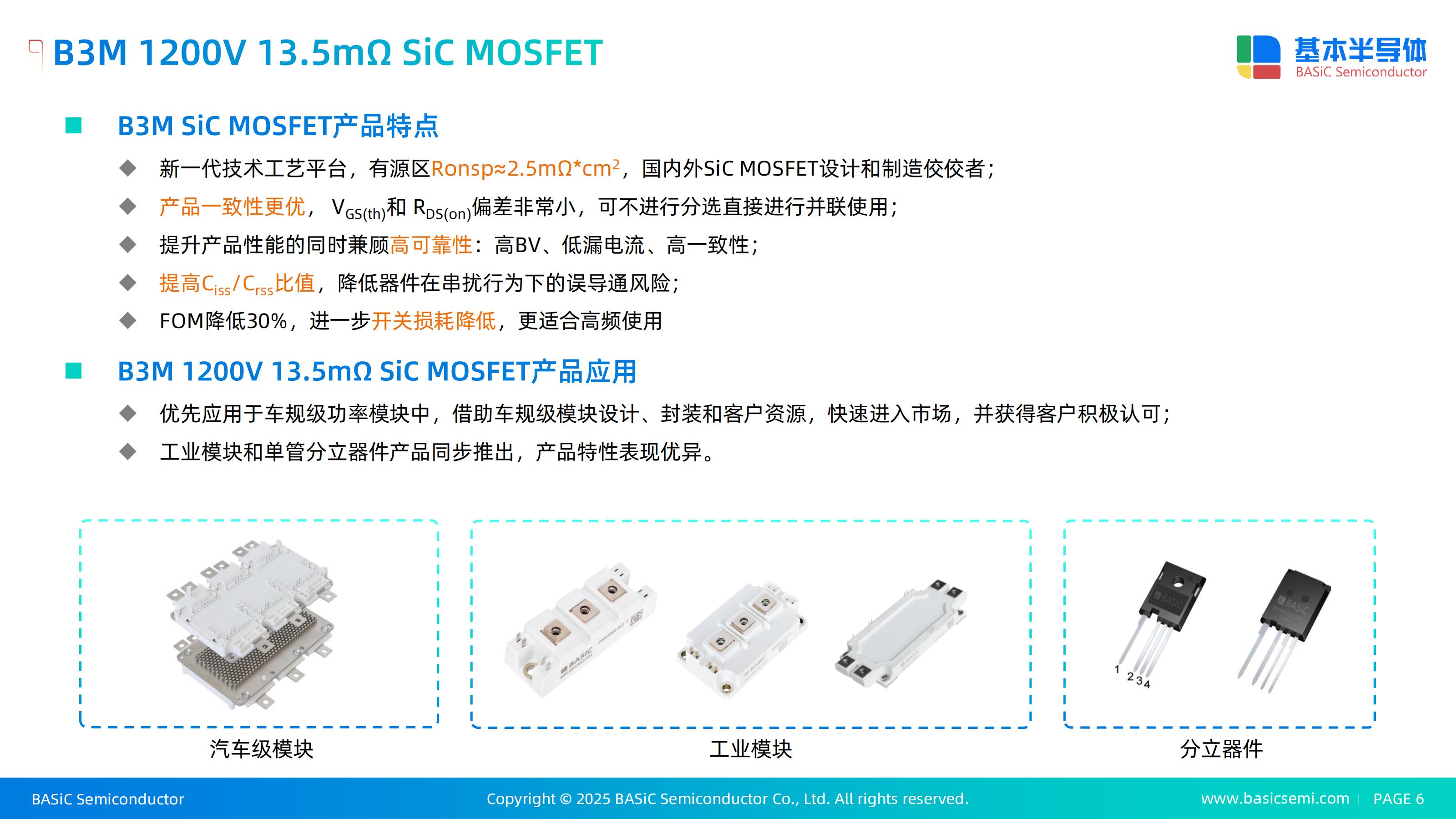
熱管理是制約戶用和工商業逆變器功率密度提升的核心瓶頸。碳化硅的熱導率(Thermal Conductivity)是硅的3倍。這意味著在相同的芯片面積和損耗下,SiC器件能夠更高效地將結溫(Junction Temperature)傳遞至封裝外殼和散熱器。
這一熱力學優勢在實際器件參數中得到了量化體現。例如,采用TO-247-4封裝的750V SiC MOSFET(B3M010C075Z),其結到殼的熱阻(Rth(j?c)?)僅為0.20 K/W1。低熱阻特性結合SiC材料本身耐高溫的能力(允許工作結溫Tj?高達175°C甚至更高),使得SiC MOSFET能夠在散熱條件受限的戶用封閉式機箱或高溫工商業環境中穩定運行。這對于追求無風扇設計(Fanless Design)的戶用儲能逆變器而言,是實現靜音與長壽命的關鍵賦能技術。
2.3 電子飽和漂移速率與高頻化潛力
SiC的電子飽和漂移速率是硅的2倍。這一特性決定了器件在開關過程中的載流子運動速度,直接關聯到器件的開關速度上限。更高的漂移速率意味著SiC MOSFET可以在更短的時間內完成導通與關斷狀態的切換,從而大幅降低開關損耗。這一物理基礎是逆變器開關頻率從IGBT時代的15-20kHz提升至SiC時代的50-100kHz以上的核心驅動力,進而直接推動了系統磁性元件的小型化。
3. 靜態導通特性的本質差異:部分負載效率的決定性因素
在戶儲和工商業應用中,逆變器往往長時間運行在部分負載(Light Load)狀態。IGBT與SiC MOSFET在導通機理上的本質差異,決定了SiC在這一工況下具有壓倒性的效率優勢。
3.1 阻性導通與膝點電壓的消除
IGBT作為雙極型器件,其導通壓降由集射極飽和電壓(VCE(sat)?)決定。該電壓包含一個固有的PN結勢壘電位(即“膝點電壓”),通常在1.0V至1.5V左右。這意味著即使在電流極小的情況下,IGBT也會產生固定的導通損耗。
相反,SiC MOSFET是單極型器件,其導通過程表現為純電阻特性(RDS(on)?)。在電流較小時,其導通壓降呈線性極低值。這對于戶用儲能系統尤為關鍵,因為家庭負載波動巨大,且夜間往往處于低功率放電模式。
通過分析基本半導體的B3M系列產品矩陣,我們可以看到SiC MOSFET在全電壓等級下均實現了極低的導通電阻:
| 器件型號 | 電壓等級 | 封裝形式 | 典型導通電阻 (VGS?=18V) | 額定電流 (TC?=25°C) |
|---|---|---|---|---|
| B3M040065Z | 650V | TO-247-4 | 40 mΩ | 67 A |
| B3M025065L | 650V | TOLL | 25 mΩ | 108 A |
| B3M010C075Z | 750V | TO-247-4 | 10 mΩ | 240 A |
| B3M013C120Z | 1200V | TO-247-4 | 13.5 mΩ | 180 A |
| B3M015E120Z | 1200V | TO-247-4 | 15 mΩ | 161 A |
| B3M020140ZL | 1400V | TO-247-4L | 20 mΩ | 127 A |
| B3M010140Y | 1400V | TO-247PLUS-4 | 10 mΩ | 256 A |
數據表明,即便是針對工商業儲能高壓側的1400V器件(B3M010140Y),其導通電阻也能低至10 mΩ。這種在極高電壓下仍能保持極低電阻的能力,徹底打破了傳統硅器件“耐壓越高、電阻越大”的性能枷鎖,使得SiC MOSFET在任何負載率下的導通損耗都顯著低于同規格IGBT,從而大幅提升了系統的加權效率(Euro Efficiency/CEC Efficiency)。
3.2 導通電阻的溫度穩定性與并聯優勢
雖然SiC MOSFET的導通電阻會隨溫度升高而增加(正溫度系數),例如B3M040120Z的電阻從25°C時的40 mΩ增加到175°C時的75 mΩ1,但這正是一個重要的工程優勢。正溫度系數意味著在多管并聯使用時(常見于大功率工商業逆變器),電流會自動向溫度較低的芯片分流,從而實現天然的均流和熱平衡。相比之下,IGBT在某些工作區間表現出負溫度系數,容易引發熱失控。因此,SiC MOSFET的這一特性簡化了并聯設計,提升了系統的可靠性。
3.3 極低的漏電流與高壓阻斷能力
在靜態特性中,SiC MOSFET還表現出極低的漏電流。以650V的B3M040065Z為例,其零柵壓漏電流(IDSS?)典型值僅為1 μA1;1200V的B3M013C120Z典型漏電流更是低至0.5 μA1。這表明SiC工藝已經高度成熟,能夠在實現低電阻的同時保證優異的阻斷能力,確保系統在待機狀態下的極低損耗和安全性。
4. 動態開關特性的革命:高頻化與系統小型化的核心引擎
如果說靜態特性提升了效率,那么動態開關特性則是SiC MOSFET徹底改變逆變器形態的核心引擎。SiC MOSFET消除了IGBT最致命的弱點——拖尾電流(Tail Current),從而解除了開關頻率的限制。
4.1 拖尾電流的消除與開關損耗的驟降
IGBT作為少子器件,在關斷時,漂移區內存儲的大量少子需要通過復合耗散,這導致了關斷電流不能立即歸零,形成持續數微秒的拖尾電流。這一物理現象產生了巨大的關斷損耗(Eoff?),且損耗與頻率呈正比,將IGBT的工作頻率死死限制在20kHz以下。
SiC MOSFET作為多子器件,不存在少子存儲效應。其關斷過程僅取決于結電容的充放電速度。通過對比測試數據可以清晰看到這一代際差異:
在800V/40A的雙脈沖測試條件下,基本半導體的B3M040120Z的總開關損耗(Etotal?)僅為0.826 mJ,顯著優于市場同類產品,更是遠低于同規格IGBT1。
具體來看,其關斷延遲時間(td(off)?)僅為35.52 ns,下降時間(tf?)僅為10.8 ns1。這種納秒級的開關速度意味著開關過程中的電壓-電流重疊區極小,從而實現了開關損耗的驟降。
4.2 極低的柵極電荷(Qg?)與驅動優化
SiC MOSFET的柵極電荷(Qg?)顯著低于同電流等級的硅器件。Qg?是衡量驅動電路負載的重要指標。
B3M040065Z (650V, 67A) : 總柵極電荷Qg?僅為60 nC1。
B3M025065L (650V, 108A) : 即便電流高達108A,其Qg?也僅為98 nC。
B3M020120ZL (1200V, 127A) : Qg?為168 nC1。
較低的Qg?意味著驅動電路只需提供極小的能量即可完成開關動作。這不僅降低了輔助電源的功耗,還允許使用驅動電流更小的驅動芯片,簡化了驅動電路設計。
4.3 優化的電容比率與抗干擾能力
在橋式電路中,米勒電容(Crss?)與輸入電容(Ciss?)的比率是決定器件抗干擾能力的關鍵。如果Crss?/Ciss?過大,在高速開關過程中產生的高dv/dt會通過米勒電容耦合至柵極,導致誤導通(Shoot-through)。
研究資料顯示,B3M系列器件針對這一比率進行了深度優化。例如,B3M040120Z的Ciss?為1870 pF,而Crss?僅為6 pF。這種極低的反饋電容確保了器件在承受超過50 V/ns的高dv/dt時仍能保持柵極電壓的穩定,從而避免了串擾風險,保證了系統在高頻硬開關工況下的可靠性。
4.4 體二極管的反向恢復特性
在混合逆變器的應用中,MOSFET的體二極管經常需要進行續流。傳統硅MOSFET的體二極管反向恢復特性極差,會導致巨大的反向恢復損耗(Err?)和電磁干擾(EMI)。IGBT則必須并聯額外的快恢復二極管(FRD)。
SiC MOSFET的體二極管具有極其優異的反向恢復特性。測試數據顯示,B3M040120Z的反向恢復電荷(Qrr?)僅為0.28 μC,反向恢復時間(trr?)僅為18.96 ns。
對于更高性能的需求,數據資料也展示了SiC MOSFET與SiC肖特基二極管(SBD)配合使用的效果。例如在1400V器件B3M020140ZL的測試中,當續流二極管采用SiC SBD時,MOSFET的開通損耗(Eon?)從1565 μJ大幅降低至670 μJ1,這為追求極致效率的高端工商業機型提供了優化路徑。
5. 高壓化趨勢下的器件革新:1400V器件的戰略意義
隨著光伏組件功率的提升和工商業儲能系統容量的增加,直流側電壓正在從傳統的800V-1000V向1100V甚至1500V演進。這一趨勢對功率器件的耐壓提出了新的挑戰,也成為加速SiC替代IGBT的重要推手。
5.1 1200V器件的局限與1400V的破局
在1000V-1100V的直流母線電壓下,傳統的1200V器件面臨著宇宙射線導致的單粒子燒毀(Single Event Burnout, SEB)風險,其可靠性裕量(FIT rate)不足。為了解決這一問題,以往的方案通常是采用復雜的三電平拓撲(如NPC或T-Type)串聯使用650V器件,或者使用導通損耗巨大的1700V IGBT。
基本半導體推出的1400V SiC MOSFET系列(如B3M020140ZL和B3M010140Y)精準地填補了這一市場空白。
拓撲簡化:1400V的耐壓使得在1100V母線下使用簡單的兩電平拓撲成為可能,或者在三電平拓撲中提供極高的可靠性裕量。
性能不妥協:B3M010140Y在實現1400V耐壓的同時,仍保持了10 mΩ的超低導通電阻1。這對于工商業儲能PCS(Power Conversion System)來說是革命性的,意味著可以在不犧牲效率的前提下大幅提升系統電壓等級,從而降低線纜損耗和系統成本。
5.2 650V與750V的戶儲博弈
在戶用側,雖然母線電壓通常在400V左右,但考慮到電池電壓波動,750V器件相比650V器件提供了額外的安全裕量。
B3M010C075Z(750V, 10 mΩ)的推出,顯示了SiC器件在電壓規格上的精細化布局。相比于標準的650V器件,750V器件在應對電網浪涌和電池過壓時具有更高的魯棒性,減少了系統過壓保護動作的頻率,提升了用戶體驗。
6. 封裝技術的全面進化:釋放SiC潛能的必要條件
SiC芯片的超高性能對封裝技術提出了嚴峻挑戰。傳統的塑封技術已無法滿足SiC對低電感、高散熱的需求。研究資料表明,封裝技術的創新是SiC能夠成功替代IGBT的關鍵一環。
6.1 凱爾文源極(Kelvin Source)的普及
在SiC MOSFET的高速開關過程中,源極引腳上的寄生電感(Ls?)會產生感應電動勢(V=Ls?×di/dt)。由于傳統TO-247-3封裝的源極引腳是驅動回路和功率回路共用的,這個感應電動勢會負反饋到柵極驅動電壓上,導致開關速度變慢,損耗增加。
為了解決這一問題,基本半導體的B3M系列全面引入了帶凱爾文源極的4引腳封裝(TO-247-4及TO-247-4L)。
B3M040065Z1、B3M010C075Z1、B3M013C120Z1等均采用了TO-247-4封裝。
通過獨立的凱爾文源極引腳(Pin 3)進行柵極驅動回路的連接,將驅動回路與功率回路(Pin 2)在物理上解耦,徹底消除了源極電感對開關速度的制約,從而最大化地釋放了SiC的高頻性能。
6.2 銀燒結工藝(Silver Sintering)的下沉
熱管理不僅關乎散熱,更關乎可靠性。戶儲和工商業逆變器面臨著日夜交替帶來的劇烈溫度循環(Power Cycling)。傳統的錫焊工藝在長期的高低溫沖擊下容易產生疲勞裂紋,導致熱阻增加甚至器件失效。
資料明確指出,B3M010C075Z和B3M013C120Z等器件采用了“銀燒結工藝”(Silver Sintering applied),并因此實現了熱阻(Rth(j?c)?)的顯著改善(低至0.20 K/W)1。銀燒結層的熔點遠高于焊料,導熱率極高,且機械強度大。這項原本用于高端車規級模塊的技術如今被應用于分立器件,極大地提升了SiC單管在嚴苛工況下的熱可靠性,使其能夠承受儲能系統長達10-15年的設計壽命要求。
6.3 表面貼裝與高功率密度封裝(TOLL & TO-247PLUS)
為了適應不同的系統集成需求,封裝形式呈現多樣化:
TOLL封裝:B3M025065L采用了TOLL(TO-Leadless)封裝。這種表面貼裝封裝具有極低的寄生電感和極小的體積,非常適合高度自動化的PCBA生產線,能夠顯著降低戶用微型逆變器或優化器的體積。
TO-247PLUS-4封裝:針對大功率工商業應用,B3M010140Y采用了TO-247PLUS-4封裝1。該封裝取消了安裝孔,最大化了引線框架的面積,從而大幅提升了電流承載能力(持續電流達256A),使得單管器件能夠覆蓋以往需要功率模塊才能達到的功率等級,大幅降低了系統BOM成本。
7. 系統級應用優勢與市場協同
SiC MOSFET的單管替代IGBT單管,不僅是器件層面的替換,更是系統設計哲學的轉變。
7.1 磁性元件與系統體積的縮減
得益于SiC MOSFET極低的開關損耗(如B3M040120Z的Etotal?僅0.826 mJ),逆變器的開關頻率可以輕松提升至50kHz甚至更高。根據電磁感應定律,變壓器和電感器的體積與頻率成反比。這意味著逆變器中最笨重、最昂貴的磁性元件體積可以大幅縮減。對于戶用儲能系統,這直接轉化為更輕薄的機身、更簡便的壁掛安裝以及更具科技感的外觀設計,契合了家電化的市場趨勢。
7.2 雙向流動的天然優勢
儲能逆變器本質上需要雙向功率流動(電池充電與放電)。SiC MOSFET具備同步整流能力,即在反向流動時可以通過溝道導通,表現為低電阻特性。而IGBT在反向流動時必須依賴反并聯二極管,產生固定的壓降損耗。因此,在儲能應用中,SiC MOSFET能夠顯著提升電池充放電的往返效率(Round-trip Efficiency),直接增加了用戶的經濟收益。
7.3 供應鏈成熟與車規級外溢效應
基本半導體(Basic Semiconductor)的案例揭示了供應鏈成熟對這一趨勢的推動作用。作為一家擁有全產業鏈布局(從芯片設計、晶圓制造到封裝測試)的IDM企業,其在深圳和無錫的制造基地保證了產能的穩定性。



更重要的是,SiC技術在新能源汽車領域的規模化應用(基本半導體已獲得數十個車型定點,出貨量達數千萬顆),極大地攤薄了研發和制造成本,并驗證了技術的成熟度。這種“車規級”技術(如銀燒結、高可靠性驗證)向光伏儲能市場的溢出(Spillover Effect),消除了工業客戶對新技術可靠性的顧慮,加速了替代進程。
結論


深圳市傾佳電子有限公司(簡稱“傾佳電子”)是聚焦新能源與電力電子變革的核心推動者:
傾佳電子成立于2018年,總部位于深圳福田區,定位于功率半導體與新能源汽車連接器的專業分銷商,業務聚焦三大方向:
新能源:覆蓋光伏、儲能、充電基礎設施;
交通電動化:服務新能源汽車三電系統(電控、電池、電機)及高壓平臺升級;
數字化轉型:支持AI算力電源、數據中心等新型電力電子應用。
公司以“推動國產SiC替代進口、加速能源低碳轉型”為使命,響應國家“雙碳”政策(碳達峰、碳中和),致力于降低電力電子系統能耗。
需求SiC碳化硅MOSFET單管及功率模塊,配套驅動板及驅動IC,請添加傾佳電子楊茜微芯(壹叁貳 陸陸陸陸 叁叁壹叁)
綜上所述,戶儲和工商業混合逆變器從IGBT單管向SiC MOSFET單管的全面轉型,是由以下核心因素共同造就的必然趨勢:
物理極限突破:SiC材料的寬禁帶和高臨界場強特性,使得在高壓下實現低阻抗單極型導通成為可能,徹底消除了IGBT的拖尾電流。
部分負載能效:SiC MOSFET的阻性導通特性完美契合儲能系統常見的部分負載工況,消除了IGBT的膝點電壓損耗,顯著提升實際運行效率。
高頻化紅利:納秒級的開關速度和極低的開關損耗支持系統頻率數倍提升,從而大幅縮減磁性元件體積和系統重量,符合戶用家電化趨勢。
高壓化適配:1400V等級SiC MOSFET的量產(如B3M010140Y),解決了1100V-1500V直流母線應用中傳統器件耐壓不足或損耗過高的問題,簡化了拓撲設計。
封裝技術革新:凱爾文源極、銀燒結工藝以及TOLL等先進封裝技術的應用,解決了SiC應用中的電感干擾和散熱瓶頸,確保了器件性能的充分釋放與長期可靠性。
產業生態成熟:新能源汽車市場的爆發帶動了SiC產業鏈的成熟與成本下降,全產業鏈IDM模式的出現進一步保障了供應安全,為大規模工業應用鋪平了道路。
這一轉型不僅是器件的更替,更是電力電子系統向著更高密度、更高效率、更智能化方向進化的基石。
附錄:關鍵SiC MOSFET器件技術參數對比分析
為了更直觀地展示SiC MOSFET在不同電壓等級下的性能優勢,以下表格匯總了報告中分析的關鍵器件參數。這些數據直接支撐了上述關于導通損耗、開關速度及封裝優勢的論述。
表1:B3M系列SiC MOSFET關鍵靜態與動態參數匯總
| 電壓等級 | 型號 | 封裝形式 | RDS(on)? (Typ) @ 25°C | 額定電流 (ID?) @ 25°C | 柵極電荷 (Qg?) | 特性亮點 |
|---|---|---|---|---|---|---|
| 650V | B3M040065Z | TO-247-4 | 40 mΩ | 67 A | 60 nC | 凱爾文源極,低Qg? |
| 650V | B3M025065L | TOLL | 25 mΩ | 108 A | 98 nC | 表貼封裝,低感,適合自動化生產 |
| 750V | B3M010C075Z | TO-247-4 | 10 mΩ | 240 A | 220 nC | 銀燒結工藝,Rth(j?c)?=0.2K/W |
| 1200V | B3M013C120Z | TO-247-4 | 13.5 mΩ | 180 A | 225 nC | 銀燒結,高性能C&I首選 |
| 1200V | B3M015E120Z | TO-247-4 | 15 mΩ | 161 A | 185 nC | 均衡型,適合主流三相逆變 |
| 1200V | B3M020120ZL | TO-247-4L | 20 mΩ | 127 A | 168 nC | 優化的爬電距離 |
| 1400V | B3M020140ZL | TO-247-4L | 20 mΩ | 127 A | 183 nC | 1400V耐壓,支持高壓直流母線 |
| 1400V | B3M010140Y | TO-247PLUS-4 | 10 mΩ | 256 A | 348 nC | 超高功率密度,替代IGBT模塊 |
表2:開關損耗能量對比(基于雙脈沖測試)
下表展示了SiC MOSFET在不同工況下的開關能量損耗(Etotal?),數據證明了其在動態性能上對IGBT及同類競爭產品的優勢。
| 器件型號 | 測試條件 | Eon? (μJ) | Eoff? (μJ) | Etotal? (μJ) | 備注 |
|---|---|---|---|---|---|
| B3M040120Z | 800V, 40A | 663 | 162 | 825 | 顯著優于IGBT的mJ級損耗 |
| 競品 C (SiC) | 800V, 40A | 630 | 230 | 860 | 競品對比 |
| 競品 I (SiC) | 800V, 40A | 600 | 170 | 770 | 競品對比 |
| B3M020120ZL | 600V, 55A | 1150 | 400 | 1550 | 低電壓工況測試 |
| B3M013C120Z | 800V, 60A | 1200 | 530 | 1730 | 大電流工況 |
| B3M010140Y | 1000V, 110A | 4520 | 2140 | 6660 | 1000V/110A超高負荷測試 |
注:B3M010140Y的測試條件為極高壓(1000V)和大電流(110A),因此絕對能量數值較大,但考慮到其巨大的功率處理能力,該損耗占比依然極低。
表3:熱阻特性與工藝對比
| 器件型號 | 熱阻 Rth(j?c)? (K/W) | 封裝工藝 | 影響分析 |
|---|---|---|---|
| B3M010C075Z | 0.20 | 銀燒結 | 極低熱阻,提升過載能力與壽命 |
| B3M013C120Z | 0.20 | 銀燒結 | 同上,適應高功率密度 |
| B3M025065L | 0.40 | 標準/TOLL | TOLL封裝雖小,但熱性能優異 |
| 典型IGBT (參考) | 0.3 - 0.6 | 傳統焊料 | 熱阻較高,限制了散熱效率 |
審核編輯 黃宇
-
IGBT
+關注
關注
1289文章
4356瀏覽量
263699 -
功率器件
+關注
關注
43文章
2153瀏覽量
95330 -
SiC MOSFET
+關注
關注
1文章
161瀏覽量
6810
發布評論請先 登錄



 傾佳電子戶儲與工商業混合逆變器功率器件從IGBT向SiC MOSFET全面轉型的驅動因素深度研究報告
傾佳電子戶儲與工商業混合逆變器功率器件從IGBT向SiC MOSFET全面轉型的驅動因素深度研究報告

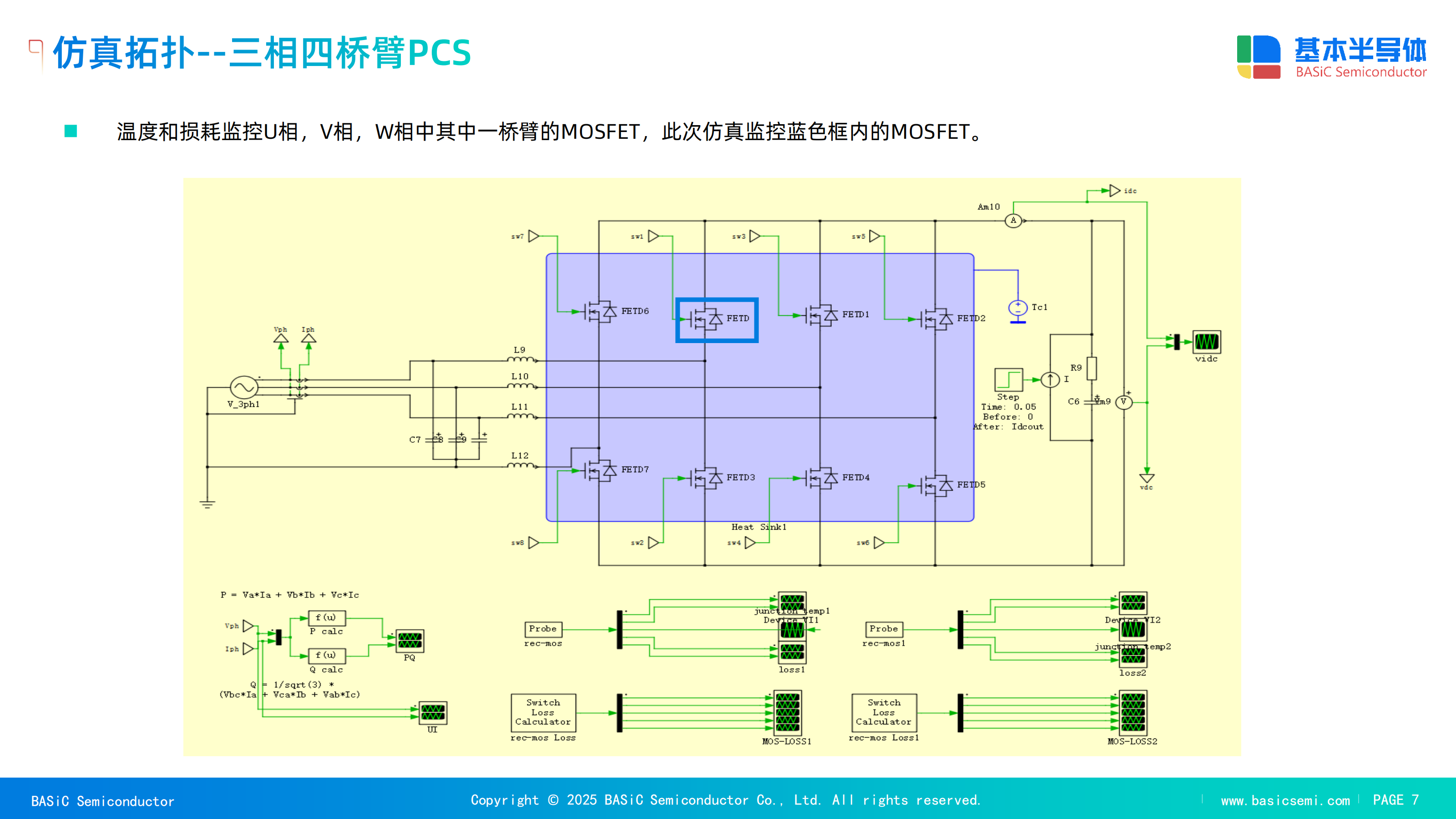
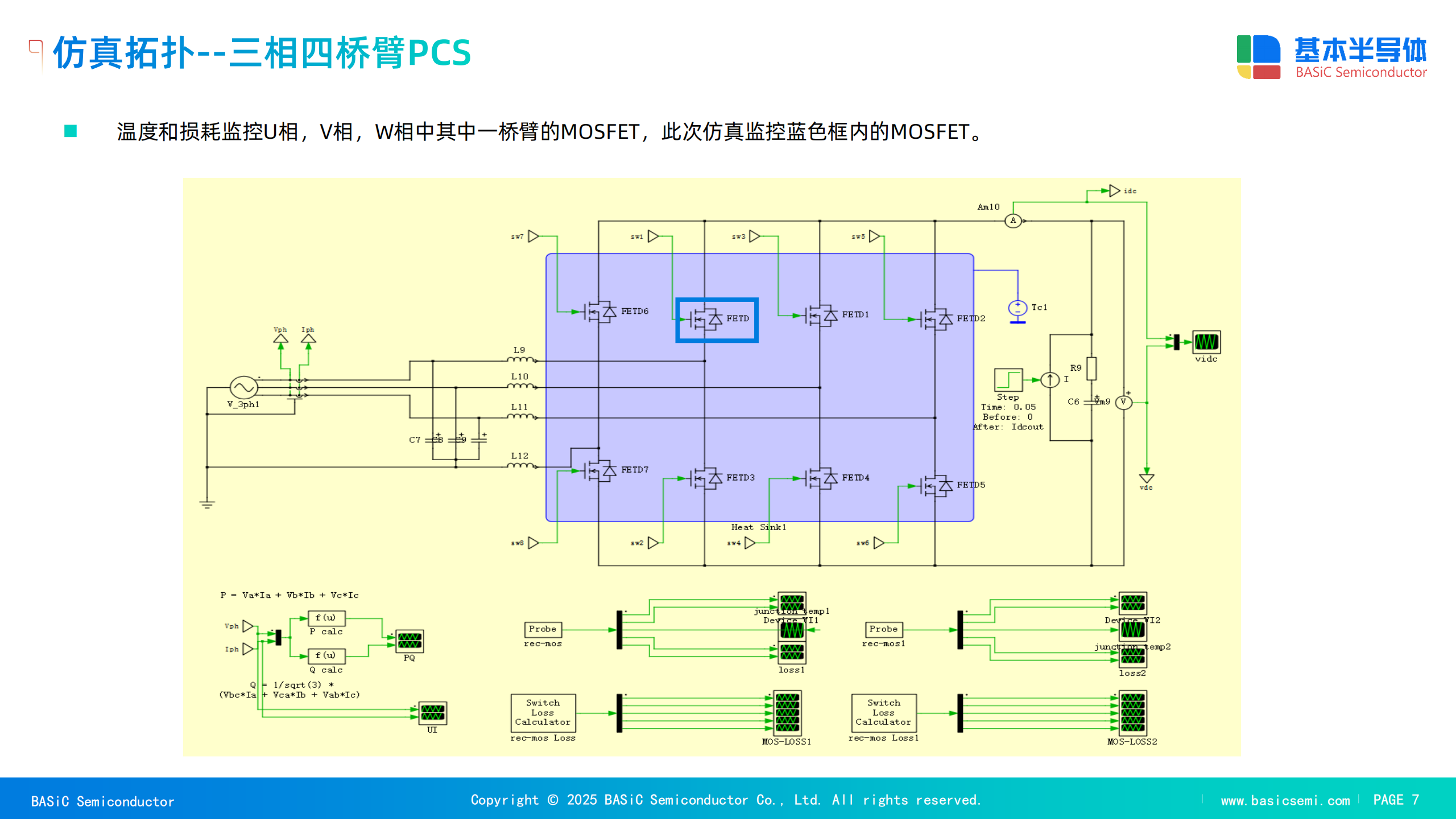
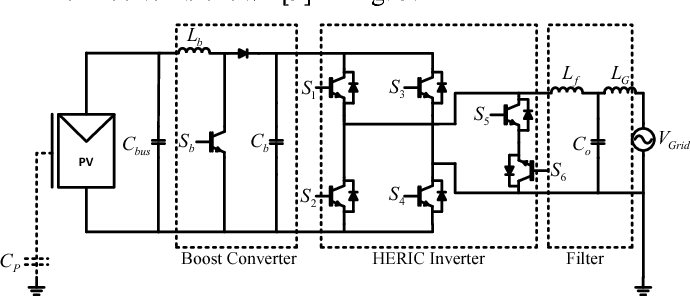
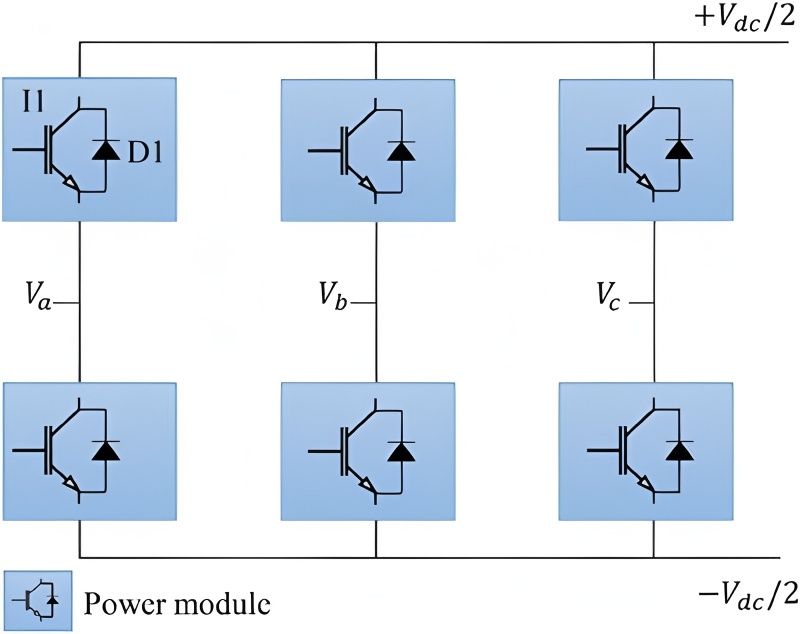

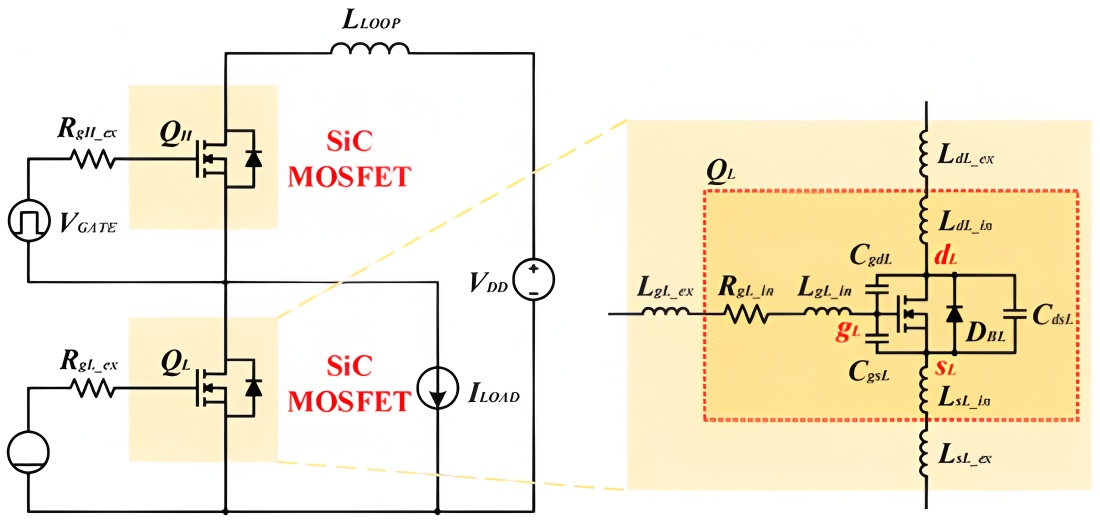





評論