1997年,富士通公司研發出一種名為芯片上引線(Lead On Chip,LOC)的封裝形式,稱作LOC型CSP。為契合CSP的設計需求,LOC封裝相較于傳統引線框架CSP做出了一系列革新設計:將
2025-07-17 11:41:26 3727
3727 
發光二極體(LED)封裝廠在生態系統將日趨邊緣化。上游LED晶粒廠為降低制造成本與微型化晶片尺寸,競相展開晶粒尺寸封裝(Chip Scale Package, CSP)技術布局,且該技術省略封裝制程,遂讓磊晶廠未來營運模式將跳過封裝廠,直接與下游燈具系統商合作,導致封裝廠在供應鏈的重要性大幅下降。
2014-05-06 09:03:50 3787
3787 LED封裝技術出現新面孔。一般半導體廠商已經相當熟悉的芯片級封裝(Chip Scale Package, CSP),正逐漸滲透到LED領域,如手機閃光燈與液晶電視背光用的LED皆已開始導入此一技術。
2017-03-27 09:32:36 3386
3386 
挑戰散熱性能的局限:良好的散熱性對大電流直流電感的功能的改善作用。
2021-07-01 14:29:24 4655
4655 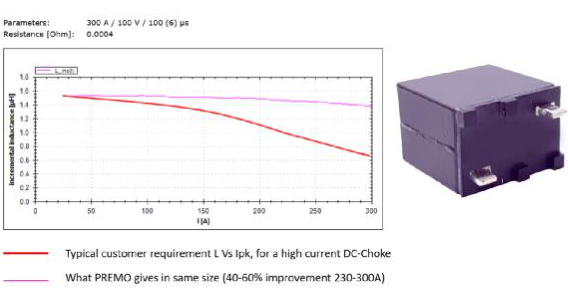
1. BGA和CSP封裝技術詳解 2.?干貨分享丨BGA開路金相切片分析 (BGA Open Cross-Section) ? ? ? 審核編輯:彭靜
2022-07-26 14:43:18 7462
7462 對于FCBGA(Flip Chip Ball Grid Array)倒裝球柵陣列封裝的CPU芯片來說,通常有2個傳熱路徑:一部分熱量通過封裝底面的焊盤傳導至主板上進行散熱;另外一部分熱量通過封裝頂面
2023-04-14 12:31:53 5488
5488 隨著半導體技術的不斷發展,芯片封裝技術也在持續進步。目前,2D封裝和3D封裝是兩種主流的封裝技術。這兩種封裝技術在散熱路徑和熱設計方面有著各自的特點和挑戰。本文將深入探討2D封裝和3D封裝的散熱路徑及熱設計考慮。
2024-07-25 09:46:28 2651
2651 
奧地利微電子應用工程師徐兵兵先生發表精彩演講,介紹了解決平板、手機散熱問題的新方案。隨著科技的進步,手機、電腦等消費電子正朝著輕薄短小的方向發展,隨之而來的是散熱的挑戰.
2013-10-28 09:53:27 1975
1975 在本技術白皮書中,英飛凌審視了車載充電器設計人員面臨的挑戰,細致深入地考察了半導體封裝對于打造解決方案所起的作用。本文還探討了一種頂部散熱的創新方法,該方法可用于一系列高性能元器件,以供設計人員選用。
2022-03-17 16:24:37 2992
2992 
不久前,英飛凌科技股份公司宣布其適用于高壓MOSFET的QDPAK和DDPAK頂部散熱(TSC)封裝技術正式注冊為JEDEC標準。
2023-04-29 03:28:00 8612
8612 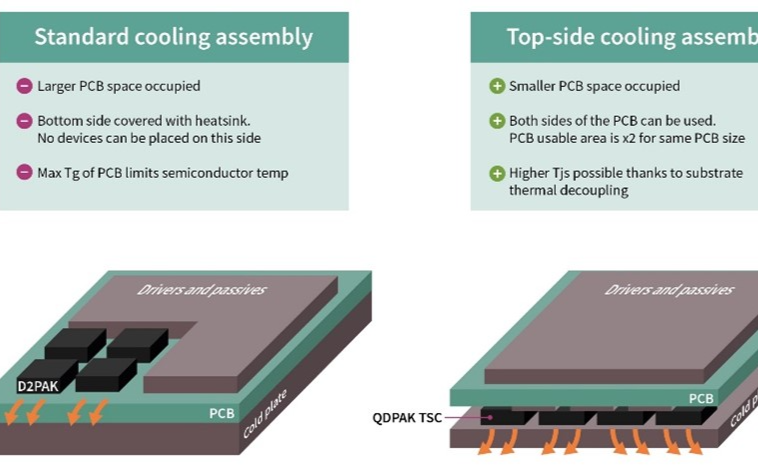
請問大家,0.4pitch的CSP封裝是怎么布線的,間距太小了
2016-06-29 21:36:01
在便攜式、低引腳數和低功率產品中應用廣泛,主要用于閃存、RAM、DRAM存儲器等產品中。目前,超過100家公司開發CSP產品:Amkor、Tessera、Chip-scale、Sharp等,市場潛力巨大。
2020-03-18 09:01:54
csp模式不知道是哪里出現了問題?csp模式為什么不能讓電機轉起來?
2021-09-24 06:24:56
、無阻抗IC白/藍膜片、長期高價求購封裝測試廠淘汰的廢舊QFN、PLCC、BGA、CSP、WL-CSP等各種封裝后的IC芯片、Blue tape、chip、wafer.藍膜片、白膜片、IC硅片、IC晶
2020-12-29 08:27:02
現有裝配架構輕松采用等特性。芯片級封裝 (CSP) 能在提供裸片的尺寸優勢的同時還可以帶來封裝的許多優勢。在無線手持終端市場需求的推動下,CSP產品正不斷推陳出新。例如,采用0.84 x
2011-06-16 16:12:03
瓶頸。為了幫助客戶了解產品,克服行業瓶頸,評估LED封裝器件的散熱水平,金鑒檢測LED品質實驗室專門推出“LED封裝器件的熱阻測試及散熱能力評估”的業務。服務客戶:LED封裝廠、LED燈具廠、LED芯片廠、器件
2015-07-29 16:05:13
MUN12AD03-SEC是一款非隔離DC-DC轉換器,適配多種需要穩定、高效電源供應的電子系統。MUN12AD03-SEC的封裝設計在提高散熱效率、降低模塊溫度、提高模塊可靠性和性能方面起著
2025-05-19 10:02:47
初學者,請老師們幫忙解疑!PBGA,CSP,SOP分別是什么意思.
2013-01-17 16:52:09
改變板鍵合盤尺寸,就能明顯提高可靠性。 CSP應用 如今人們常見的一種關鍵技術是CSP。CSP技術的魅力在于它具有諸多優點,如減小封裝尺寸、增加針數、功能∕性能增強以及封裝的可返工性等。 CSP
2013-10-22 11:43:49
。典型封裝昂貴而易損壞,特別是在器件引線成形之后。這些復雜技術的設計指導原則也與普通SMT工藝有很大差異,因為在確保組裝生產率和產品可靠性方面,板設計扮演著更為重要的角色; 例如,對CSP焊接互連
2018-09-10 15:46:13
摘要傳統焊線式 (wire-bond) SOT-23封裝的散熱能力不甚佳;覆晶式 (FCOL) SOT-23 封裝因內部結構不同,有較好的散熱能力。本應用須知將比較這兩種封裝技術,且提出關于改進
2018-05-23 17:05:37
; CSP封裝優勢 ü 封裝尺寸更小,功率更大ü 體積更小,設計更靈活ü 無框架載體,寄生參數小ü 散熱好ü 先進制程,成品率高ü 高可靠性,高生產效率 微小型CSP封裝 適合TVS,diodes
2020-07-30 14:40:36
ads1291 QFN封裝的散熱PAD接AVSS還是DGND?官方的參考原理圖是QFP封裝,沒有散熱PAD。
2024-12-06 07:03:19
qfpn封裝的散熱焊盤的soldmask層為什么要按照下圖的來做
2014-11-15 14:51:23
`什么? 你對CSP的了解還不夠?趕快來圍觀吧! 首先,得知道什么叫CSPCSP(Chip Scale Package),又稱為芯片級封裝器件, 其技術性主要體現為讓芯片面積與封裝面積之比超過1
2017-02-24 16:36:32
ADL5530數據手冊中關于散熱功耗的描述是:5V,110mA,散熱功耗為0.55W,這樣豈不是全部都轉化為熱能?那么發射功率0.1W在哪里?另外,這封裝的芯片節點到散熱盤的熱阻:154℃/W,那么工作之后溫度大概在84.7+室溫?接地焊盤和空氣都會有助于散熱,總的來說元器件溫度還是很高的。
2018-12-13 11:30:33
無線手持設備、掌上電腦以及其他移動電子設備的增加導致了消費者對各種小外形、特征豐富產品的需要。為了滿足越來越小的器件同時具有更多功能的市場趨勢和移動設計要求,業界開發了芯片級封裝(CSP)形式的特定
2018-11-23 16:58:54
大功率白光LED散熱及封裝大功率白光LED散熱LED發光是靠電子在能帶間躍遷產生光,其光譜中不包含紅外部分,LED的熱址不能靠輻射散出,因此LED是“冷”光源。目前LED的發光效率僅能達到10%一
2013-06-08 22:16:40
器(eTEG)薄膜技術解決了當今電子行業中最具挑戰性的熱管理和電源管理問題。不過,只有極少數廠商能以相同技術實現這兩種應用:熱源單點散熱解決方案和利用廢熱發電的新方法。對于裸片、芯片、電路板和系統級實施的熱管
2020-03-10 08:06:25
;導熱膠:硅樹脂;散熱板:銅。目前,國際上FCBGA的典型系列示于表1。 3.2 芯片尺寸封裝(CSP) CSP(Chip Scale Package)封裝,是芯片級封裝的意思。CSP封裝最新一代
2018-09-12 15:15:28
晶圓級CSP的返修工藝包括哪幾個步驟?晶圓級CSP對返修設備的要求是什么?
2021-04-25 08:33:16
,20世紀最后二十年,隨著微電子、光電子工業的巨變,為封裝技術的發展創造了許多機遇和挑戰,各種先進的封裝技術不斷涌現,如BGA、CSP、FCIP、WLP、MCM、SIP等,市場份額不斷增加,2000年已達
2018-08-23 12:47:17
應對上述挑戰,現代電腦廣泛采用以下散熱技術: 1. 石墨片石墨片憑借其高導熱系數和超薄特性,被用于均熱和快速導引熱量。在筆記本電腦中,石墨片常貼附于主板或電池表面,將局部高溫區域的熱量均勻擴散至金屬
2025-03-20 09:39:58
;導熱膠:硅樹脂;散熱板:銅。目前,國際上FCBGA的典型系列示于表1。
3.2 芯片尺寸封裝(CSP)
CSP(Chip Scale Package)封裝,是芯片級封裝的意思。CSP封裝最新一代
2023-12-11 01:02:56
芯片封裝測試流程詳解ppt?按封裝外型可分為:SOT 、QFN 、SOIC、TSSOP、QFP、BGA、CSP等;? 決定封裝形式的兩個關鍵因素:?封裝效率。芯片面積/封裝面積,盡量接近1:1
2012-01-13 11:46:32
`1.對于SOP/DIP封裝的功放芯片,請問該如何散熱?2.帶4歐姆3W的喇叭需不需要散熱?如下圖,是一位發燒友給藍牙模塊搭的外圍電路,每個功放芯片帶了一個4歐姆3W的喇叭,為什么板上沒有加散熱,不需要?可以的話,請對散熱這一門學問論述論述`
2017-11-07 15:36:37
請問ADN4670BCPZ焊接溫度曲線有么?以及這種CSP封裝的焊接需要注意的事項有哪些?
2019-01-18 16:44:20
基于進程代數的CSP 方法是一種重要的形式化協議分析驗證方法。本文首先簡單介紹了CSP 相關理論,并以NSPK 協議為例系統概述了安全協議的CSP 建模方法。為更好的查明協議的安全缺
2009-08-06 11:22:16 12
12 封裝外殼散熱技術及其應用
微電子器件的封裝密度不斷增長,導致其功率密度也相應提高,單位體積發熱量也有所增加。為此,文章綜述了封裝外殼散熱技術
2010-04-19 15:37:53 55
55 文章論述了大功率LED封裝中的散熱問題,說明它對器件的輸出功率和壽命有很大的影響,分析了小功率、大功率LED 模塊的封裝中的散熱對光效和壽命的影響。對封裝及應用而言,
2010-10-22 08:53:33 136
136 Vette公司針對采用球柵陣列(BGA)封裝的IC推出新型散熱解決方案。新的BGA散熱片針對傳統高容量主板、視頻卡和聯網板卡應用。 &nb
2006-03-13 13:09:32 920
920 可以解決眾多封裝難題的CSP-ASIP
無線手持設備、掌上電腦以及其他移動電子設備的增加導致了消費者對各種小外形、特征豐富產品的需要。為了滿足越來越小的器件同時具有
2009-03-28 17:02:02 1320
1320 摘要:本文詳細討論了Maxim的晶片級封裝(WL-CSP),其中包括:晶圓架構、卷帶包裝、PCB布局、安裝及回流焊等問題。本文還按照IPC和JEDEC標準提供了可靠性測試數據。 注
2009-04-21 11:30:27 9869
9869 
利用QFN封裝解決LED 顯示屏散熱問題
現今大多數的LED屏幕(LED顯示屏)廠商,于PCB設計時幾乎都會面臨到散熱的問題,尤其是因為驅動芯
2009-11-17 09:22:58 1775
1775 CSP封裝內存
CSP(Chip Scale Package),是芯片級封裝的意思。CSP封裝最新一代的內存芯片封裝技術,其技術性能又有了新的提升。CSP封裝可以讓芯片面積與封裝面積之比超
2009-12-25 14:24:49 810
810 創新封裝將功率MOSFET散熱效率提升80%
德州儀器 (TI) 公司采用創新的封裝技術,面向高電流DC/DC應用,推出5款目前業界首個采用封裝頂部散熱的標
2010-03-01 11:37:22 1113
1113 
高級封裝,高級封裝是什么意思
晶片級封裝CSP(Chip Scale Package)。幾年之前以上所有的封裝其封裝本體面積與芯片面積之比通常都是
2010-03-04 11:13:29 1774
1774 什么是CSP封裝
近幾年的硬件發展是日新月異,處理器已經進入G赫茲時代,封裝形式也是經歷了數種變化。不過,光有一顆速急力猛的芯還遠遠不夠
2010-03-04 11:43:25 15859
15859 CSP封裝芯片的量產測試采用類似晶圓測試的方法進行,但是兩者的區別在于:晶圓的測試,探針是扎在管芯的PAD(通常情況下為鋁金屬)上,而CSP封裝的測試座,探針是扎到CSP封裝的錫
2012-05-02 10:00:40 2018
2018 OV2715_CSP3_Datasheet
2016-12-25 23:00:49 5
5 芯片級封裝介紹本應用筆記提供指引使用與PCB安裝設備相關的芯片級封裝。包括系統的PCB布局信息制造業工程師和制造工藝工藝工程師。 包概述 倒裝芯片CSP的包概述半導體封裝提供的芯片級封裝代表最小
2017-03-31 10:57:32 45
45 超級CSP——讓倒裝芯片獲得最大可靠性一種晶圓片級封裝
2017-09-14 11:31:37 22
22 CSP封裝的芯片測試,由于其封裝較小,采用普通的機械手測試無法實現,目前主要采用類似晶圓測試的方法,在芯片完成置球封裝后,先不做劃片,而直接用探針卡進行測試,測試完成后,再實行劃片、分選和包裝。
2017-10-27 15:11:10 8857
8857 模型檢測是通信順序進程(communicatmg sequential processes,簡稱CSP)形式化驗證的重要手段.當前,CSP模型檢測方法基于操作語義,需將進程轉化為遷移系統,進而
2018-01-23 16:03:53 1
1 目前CSP LED的主流結構可分為有基板和無基板,也可分為五面發光與單面發光。所說的基板自然可以視為一種支架。很顯然,為了滿足CSP對封裝尺寸的要求,傳統的支架,如2835,的確不能使用,但并不
2018-07-12 14:34:00 11195
11195 CSP(chip scale package)封裝是指一種封裝自身的體積大小不超過芯片自身大小的20%的封裝技術(下一代技術為襯底級別封裝,其封裝大小與芯片相同)。為了達成這一目的,制造商盡可能
2018-08-10 15:43:52 16130
16130 CSP(Chip Scale Package)封裝,是芯片級封裝的意思。CSP封裝最新一代的內存芯片封裝技術,其技術性能又有了新的提升。CSP封CSP封裝裝可以讓芯片面積與封裝面積之比超過1
2018-08-17 15:25:38 18958
18958 CSP封裝是最新一代的內存芯片封裝技術,其技術性能又有了新的提升。CSP封裝可以讓芯片面積與封裝面積之比超過1:1.14,已經相當接近1:1的理想情況,絕對尺寸也僅有32平方毫米,約為普通的BGA
2019-06-24 14:12:36 21830
21830 電子發燒友網為你提供TE(ti)CAT-CSP-5T相關產品參數、數據手冊,更有CAT-CSP-5T的引腳圖、接線圖、封裝手冊、中文資料、英文資料,CAT-CSP-5T真值表,CAT-CSP-5T管腳等資料,希望可以幫助到廣大的電子工程師們。
2021-07-08 21:00:04
隨著集成電路的廣泛應用,集成度越來越高,在BGA技術開始推廣的同時,另外一種從BGA發展來的CSP封裝技術正在逐漸展現它的生力軍本色。作為新一代的芯片封裝技術,CSP封裝可以讓芯片面積與封裝面積之比
2021-12-03 13:58:36 4049
4049 先進封裝形式μBGA、CSP的回流焊接技術介紹說明。
2022-05-06 15:17:46 4
4 倒裝芯片 CSP 封裝
2022-11-14 21:07:58 22
22 先進封裝芯片不僅能滿足高性能計算、人工智能、功率密度增長等的需求,同時先進封裝的散熱問題也變得復雜。因為一個芯片上的熱點會影響到鄰近芯片的熱量分布。芯片之間的互連速度在模塊中也比在SoC中要慢。
2022-12-05 14:45:06 2349
2349 點擊藍字?關注我們 電源應用中的 MOSFET 大多是表面貼裝器件 (SMD),包括 SO8FL、u8FL 和 LFPAK 等封裝。通常選擇這些 SMD 的原因是它們具有良好的功率能力,同時尺寸較小
2023-03-10 21:50:04 2469
2469 CSP封裝(Chip Scale Package)是指芯片級封裝,其封裝尺寸和芯片核心尺寸基本相同,一般芯片面積與封裝面積的比例約在1:1.1。CSP封裝最先規模應用在消費電子和個人電腦,與我們的生活息息相關。
2023-03-28 14:52:09 17728
17728 芯片封裝是半導體產業中的一個重要環節,它是芯片與外界信號互連的通道,同時對裸芯片起到固定、密封、散熱、保護等多種功能。
2023-04-01 09:51:18 5611
5611 摘要:散熱設計是芯片封裝設計中非常重要的一環,直接影響芯片運行時的溫度和可靠性。芯片內部封裝材料的尺寸參數和物理特性對芯片散熱有較大影響,可以用芯片熱阻或結溫的高低來衡量其散熱性能的好壞。通過
2023-04-14 09:23:22 3576
3576 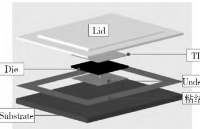
貼片化是從帶獨立散熱片的插件封裝走向更高功率散熱的第一步。一般貼片封裝的散熱主要是靠芯片底部跟PCB(印刷電路板)之間的接觸,利用PCB銅箔把芯片產生的熱量傳導出去。
2023-05-06 11:52:43 1357
1357 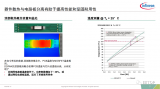
工程師們正在尋找從復雜模塊中有效散熱的方法。
2023-05-29 14:12:50 1107
1107 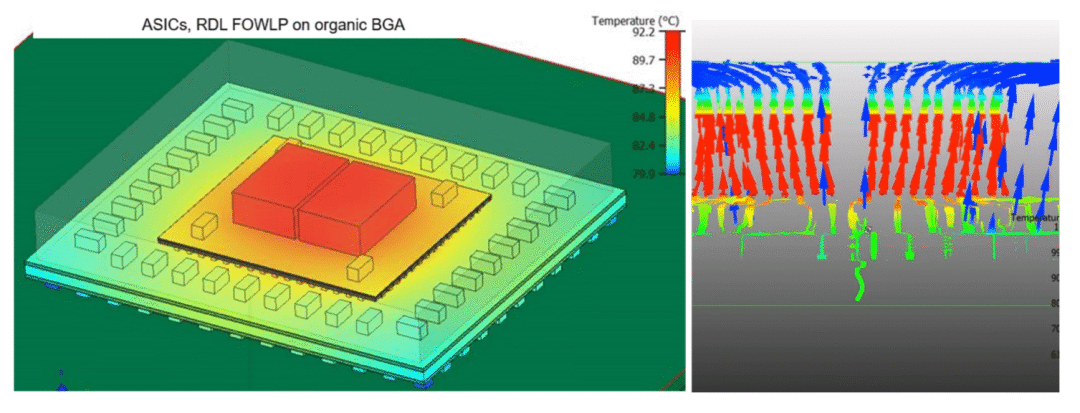
CSP(Chip Scale Package)封裝芯片是一種高密度、小尺寸的封裝形式,它在集成電路行業中具有廣泛的應用。對于CSP封裝芯片的測試方法而言,主要涉及到以下幾個方面:
2023-06-03 10:58:16 2567
2567 隨著芯片集成度的不斷提高,芯片封裝密度也在不斷增加,這給芯片散熱帶來了巨大的挑戰。高溫會導致芯片性能下降,甚至會造成芯片損壞。因此,解決芯片封裝散熱問題是一項至關重要的任務。
2023-06-04 14:33:00 10550
10550 來源:半導體芯科技工程師們正在尋找從復雜模塊中有效散熱的方法。將多個芯片并排置于同一封裝中可以緩解熱問題,但隨著公司進一步深入研究芯片堆疊和更密集的封裝,以提高性能和降低功率,他們正在與一系列與熱有關的新問題作斗爭。先進封裝芯片不僅能滿足高性能計算、
2022-11-29 18:02:09 1561
1561 
光電傳感器WL-CSP封裝芯片底部填充膠應用由漢思新材料提供光電傳感器芯片(CCD)經過聯系客戶工程技術和研究其提供的封裝工藝流程。了解到以下信息。客戶用膠項目是:光電傳感器芯片(CCD
2023-05-18 05:00:00 1791
1791 
電子封裝是現代電子產品中不可或缺的一部分,它將電子元件組裝在一起,形成了一個完整的電子系統。其中,BGA和CSP是兩種常見的電子封裝技術,它們各有優缺點,廣泛應用于半導體制造、LCD顯示器等領域
2023-06-14 09:11:18 2824
2824 
左右,同時CSP的抗噪能力強,開關噪聲只有DIP(雙列直插式封裝)的1/2。這些主要電學性能指標已經接近裸芯片的水平,在時鐘頻率己超過雙G的高速通信領域,LSI芯片的CSP將是十分理想的選擇。
2023-08-20 09:42:07 4008
4008 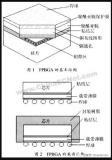
CSP是近幾年才出現的一種集成電路的封裝形式,目前已有上百種CSP產品,并且還在不斷出現一些新的品種。盡管如此,CSP技術還是處于發展的初期階段,因此還沒有形成統一的標準。不同的廠家生產不同的CSP
2023-09-08 14:09:40 1230
1230 BGA和CSP封裝技術詳解
2023-09-20 09:20:14 4693
4693 
簡要解讀BGA、CSP封裝中的球窩缺陷
2023-10-08 08:47:53 1615
1615 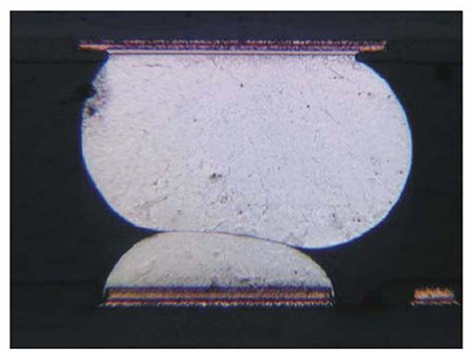
為了滿足應用的散熱要求,設計人員需要比較不同半導體封裝類型的熱特性。在本博客中, Nexperia(安世半導體)討論了其焊線封裝和夾片粘合封裝的散熱通道,以便設計人員選擇更合適的封裝。 焊線器件中
2023-11-20 01:35:37 1008
1008 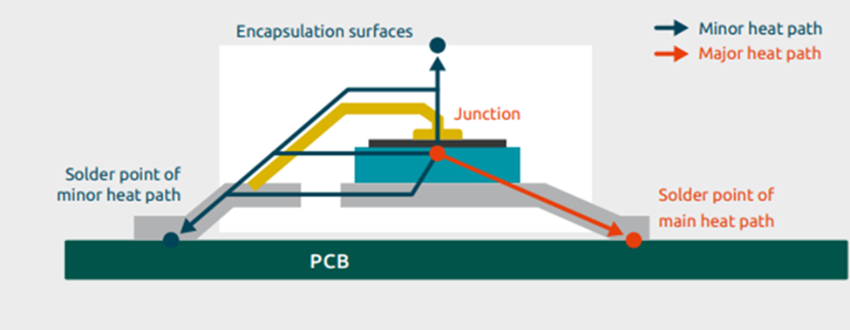
為了實現集成電路芯片的電通路,一般需要將芯片裝配到在塑料或陶瓷載體上,這一過程可以稱為CSP。CSP的尺寸只是略大于芯片,通常封裝尺寸不大于芯片面積的1.5倍或不大于芯片寬度或長度的?1.2?倍
2023-12-22 09:08:31 4183
4183 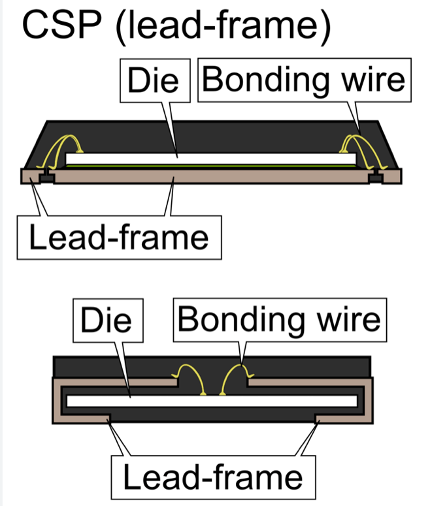
立錡推出的低壓輸入、CSP 小封裝降壓轉換器系列,不僅滿足各式小型穿戴式和 IoT 物聯網應用的需求,更在性能和尺寸上取得了絕佳平衡。
2024-03-14 15:03:10 1173
1173 隨著BGA、CSP封裝器件向密間距、微型化的方向發展,無鉛制程的廣泛應用給電子裝聯工藝帶來了新的挑戰。球窩(Pillow-head Effect)缺陷是BGA、CSP類器件回流焊接中特有的一種缺陷
2024-04-10 09:08:24 1617
1617 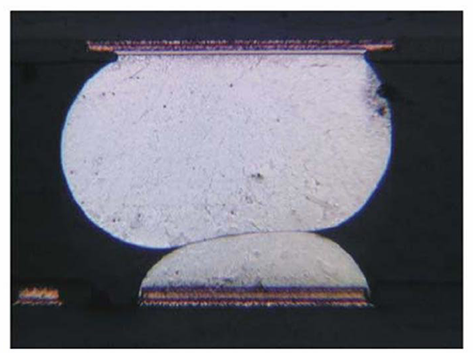
芯片功耗提升,散熱重要性凸顯1,芯片性能提升催生散熱需求,封裝材料市場穩健增長AI需求驅動硬件高散熱需求。根據Canalys預測,兼容AI的個人電腦將從2025年開始快速普及,預計至2027年約占
2024-06-05 08:10:28 2368
2368 
摘要:本論文探討了在現代電子器件設計和制造中,封裝與散熱的關鍵優化策略。通過選擇封裝形式和材料,重建引腳布局,封裝密封的方法優化封裝設計,從而保護內部元件免受外部環境的影響,提高產品的壽命和可靠性
2024-06-09 08:10:04 2186
2186 
瑞沃微CSP封裝技術在手機閃光燈照明領域具有廣泛的應用前景和顯著的優勢。隨著技術的不斷進步和消費者需求的不斷提升,瑞沃微CSP封裝技術將繼續在手機閃光燈照明領域發揮重要作用
2024-08-28 16:30:09 1242
1242 電子發燒友網站提供《如何使用MCF831x來解決散熱和快速啟動挑戰.pdf》資料免費下載
2024-08-30 09:21:24 0
0 近日,納芯微正式推出了CSP封裝12V共漏極雙N溝道MOSFET——NPM12023A系列產品。這款新品以其優異的短路過流能力與雪崩過壓能力,以及更強的機械壓力耐受能力,為便攜式鋰電設備的充放電提供了全面的保護。
2024-10-17 15:59:21 1392
1392 在半導體技術的快速發展中,封裝技術作為連接芯片與外部世界的橋梁,其重要性不言而喻。CSP(Chip Scale Package),即芯片級封裝技術,正是近年來備受矚目的一種先進封裝技術。今天,請跟隨瑞沃微的腳步,一起深入了解CSP芯片級封裝工藝的奧秘。
2024-11-06 10:53:34 4752
4752 
了這一挑戰,華潤微電子封測事業群(以下簡稱ATBG)不斷迭進新技術,研發了TOLT-16L、QDPAK、TCPAK5X7-10L三款新的頂部散熱MOSFET先進封裝工藝平臺,為市場提供更卓越
2024-11-15 10:21:24 2696
2696 
隨著電子技術的發展,集成電路的集成度越來越高,功耗也隨之增加。散熱問題成為制約電子設備性能和可靠性的關鍵因素之一。BGA封裝作為一種先進的封裝技術,其散熱性能直接影響到電子設備的正常工作和壽命
2024-11-20 09:30:19 2482
2482 本文介紹塑封及切筋打彎工藝設計重點,除此之外,封裝散熱設計是確保功率器件穩定運行和延長使用壽命的重要環節。通過優化散熱通道、選擇合適的材料和結構以及精確測量熱阻等步驟,可以設計出具有優異散熱
2024-11-26 10:46:06 2397
2397 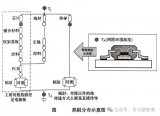
納芯微正式發布全新一代CSP封裝12V共漏極雙N溝道MOSFET——NPM12017A系列,該系列產品是對納芯微已量產的CSP MOS的完美升級與補充。新一代CSP MOS進一步優化了性能表現,顯著
2025-03-12 10:33:11 2854
2854 瑞沃微作為半導體封裝行業上先進封裝高新技術企業,對CSP(芯片級封裝)技術在不同領域的應用有不同見解。CSP封裝憑借其極致小型化、高集成度和性能優越性,在LED、SI基IC等領域展現出獨特優勢,但也存在一定劣勢。
2025-05-16 11:26:25 1126
1126 
瑞沃微CSP封裝光學技術憑借其極致小型化、高集成度、優良電學性能和散熱性能,在照明、顯示及高端電子領域展現出顯著優勢。
2025-06-24 16:54:18 645
645 
不久前推出的QDPAK封裝也是目前英飛凌量產的封裝中最大尺寸的頂部散熱產品。QDPAK封裝目前包含600V,650V,750V,1200V電壓等級的SiCMOSFE
2025-12-18 17:08:27 544
544 
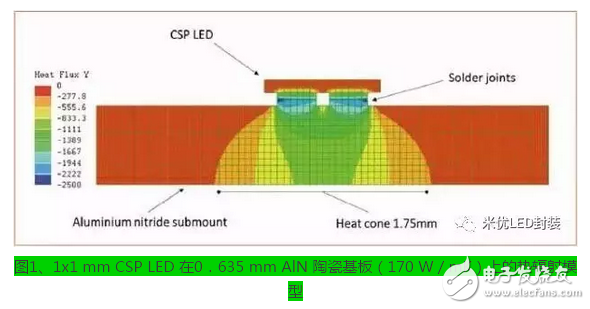
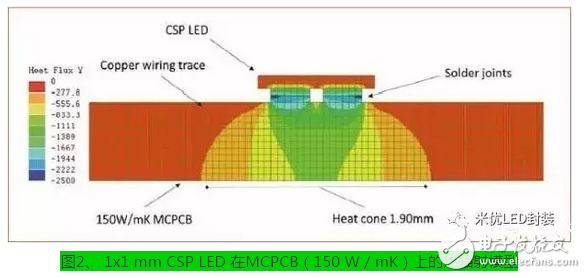
 電子發燒友App
電子發燒友App











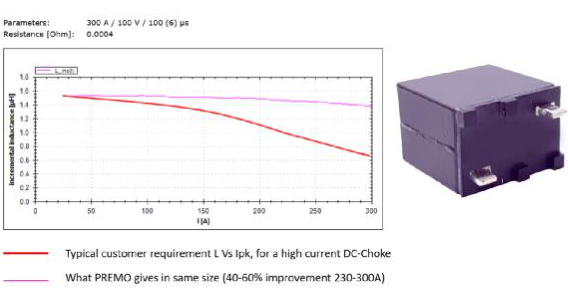


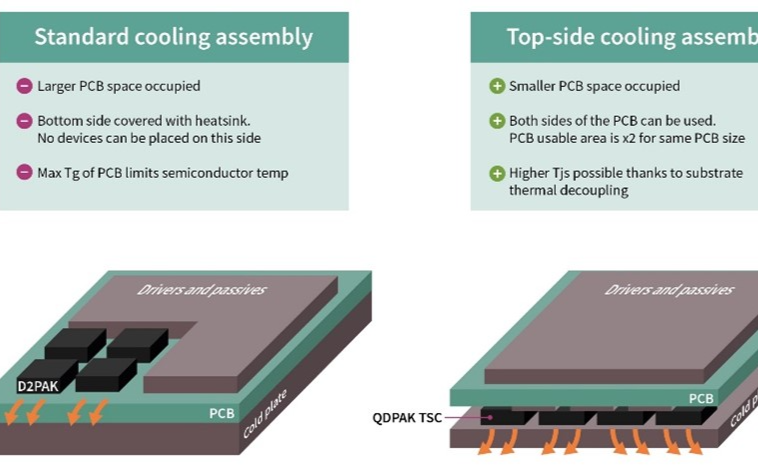



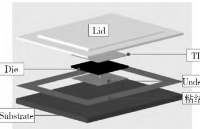
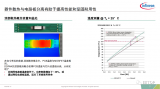
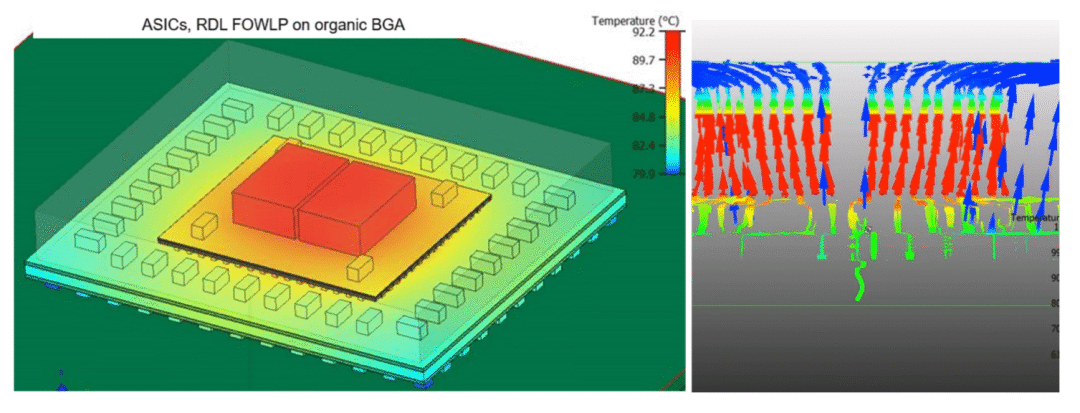



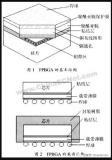

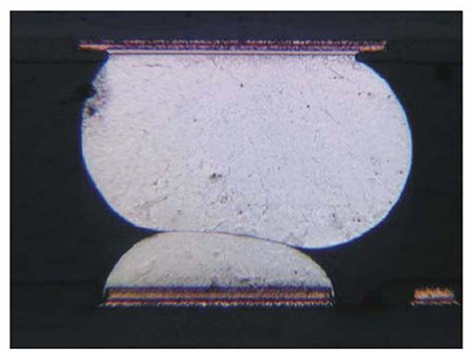
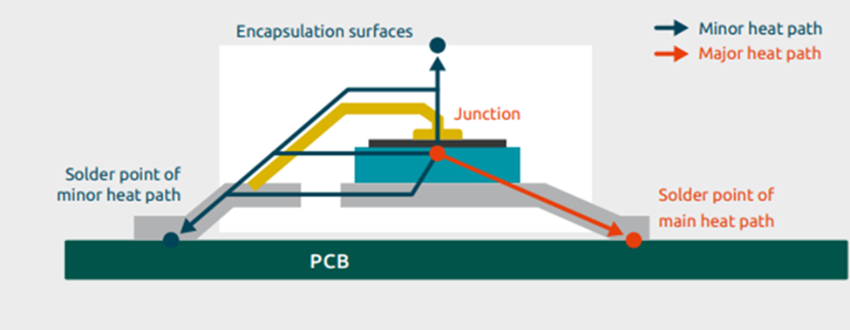
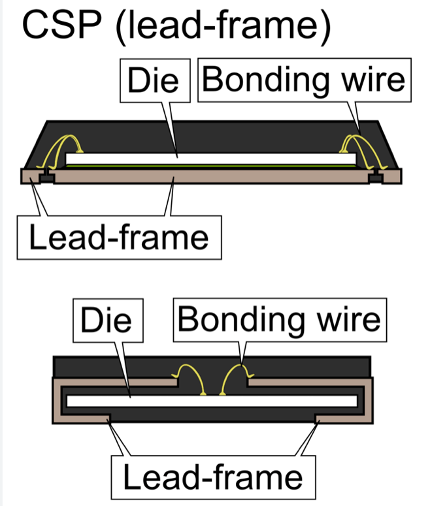
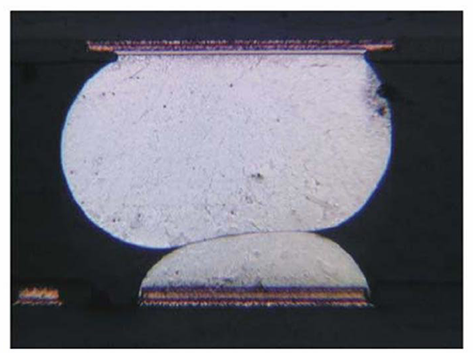


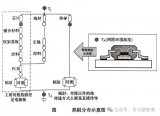






評論