不久前,英飛凌科技股份公司宣布其適用于高壓MOSFET的QDPAK和DDPAK頂部散熱(TSC)封裝技術正式注冊為JEDEC標準。按照JEDEC的規定,一家廠商的技術注冊和認證成為JEDEC標準之后,其他廠商便可以免費從JEDEC標準組織下載并使用這些標準,只要遵守標準所定義的尺寸和公差,就能夠在行業里聲稱是跟JEDEC標準兼容,并且不設置專利門檻。廠家只需要制造符合此業界通行標準的產品即可。

也就是說,QDPAK和DDPAK表面貼裝(SMD)TSC封裝設計將會與TO247和TO220一樣,可供業界免費使用,并成為行業標準。
不久前,英飛凌科技電源與傳感系統事業部大中華區應用市場總監程文濤還與業內媒體一道交流了QDPAK和DDPAK SMD TSC封裝設計的研發背景、技術優勢,和在推廣該封裝技術過程中面臨的挑戰以及英飛凌如何解決這些挑戰等話題。

圖:英飛凌科技電源與傳感系統事業部大中華區應用市場總監程文濤
為何要推出TSC封裝設計?
在半導體行業發展的相當一段時間里,不論是功率半導體、模擬半導體,還是數字半導體,芯片的尺寸都在不斷地縮小,工藝在不斷地微縮。具體到功率半導體方面,過去十多年的芯片演進主要在晶圓部分,比如使用更小的芯片尺寸,實現更低的導通阻抗等等,“隨著時間的推移,英飛凌逐漸發現封裝技術成為了突破瓶頸的關鍵方式,”程文濤在與媒體交流時表示。

高壓超結硅功率器件的FOM值基本已經達到了物理極限,在此情況下要想繼續降低導通阻抗或者是實現更高的能效,封裝技術是繼續把硅的功率發揮到極致的必經之路。不僅是硅基半導體,現在大熱的寬禁帶半導體SiC/GaN也需要仰仗新的封裝技術。
據程文濤介紹,英飛凌的TSC封裝技術名稱叫QDPAK與DDPAK,“其前身就是我們所熟知的DPAK,即TO252封裝。其中QDPAK相當于4個DPAK并排;DDPAK則是兩個DPAK并排在一起。”他解釋道。
QDPAK封裝的主要優勢有四個:
滿足更大功率需求:優化利用電路板空間,采用開爾文源極連接,減少源極寄生電感;
提高功率密度:頂部散熱可實現最高電路板利用率;
提高效率: 經優化的結構具有低電阻和超低寄生電感,可實現更高效率;
減輕重量:綜合優化散熱和發熱,有助于打造更小巧的外殼,從而減少用料,減輕重量
TSC封裝為客戶帶來的裨益
其實QDPAK和DDPAK這兩大頂部散熱封裝技術能夠帶來最大的益處在于:高度優化了生產工藝,讓整個裝配過程步驟變少,自動化制造流程更簡潔,最終在下游廠商端實現包括PCB數量、層級和板間連接器用量減少,帶來裝配及整體系統成本大幅降低。

優化MOSFET應用需要盡可能降低系統熱阻(Rthja),同時實現最高結溫(Tj)。如此一來能夠最大限度地增加流入散熱片的熱量,并最大限度地減少流入PCB的熱量。
熟悉功率半導體行業的讀者應該還有印象,10年前千瓦及以上的大功率應用基本以插件封裝(THD)技術為主,例如大家熟知的TO247、TO220封裝。這類插件封裝技術的優勢在于,在當時的裝配和封裝工藝下能使工程師最大限度地利用外加的散熱片,非常高效地將芯片內部產生的熱量散發出芯片之外,讓芯片能夠工作在一個大功率的應用場景中。
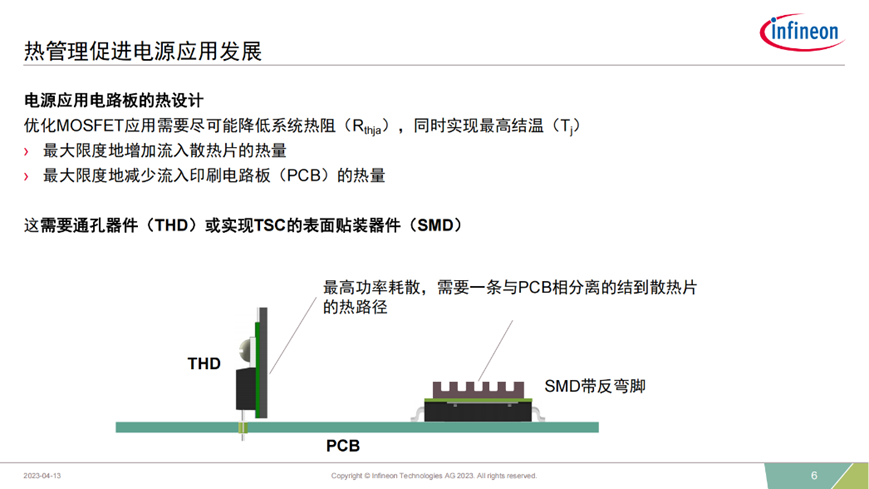
但隨著數據中心、4G及5G無線通信宏基站等設備對于功率密度的要求越來越高,設備尺寸越做越小。開始要求電源應用的電路板設計中采用更少,或不用獨立散熱片,同時把更多的熱量均勻地散發到整個設備之外。英飛凌經過長時間與產業鏈下游的行業頭部客戶以及工程師討論,最終在業界達成共識,那就是頂部散熱才是解決這一矛盾的根本途徑。
貼片化是從帶獨立散熱片的插件封裝走向更高功率散熱的第一步。一般貼片封裝的散熱主要是靠芯片底部跟PCB(印刷電路板)之間的接觸,利用PCB銅箔把芯片產生的熱量散發出去。但是這樣做的一個明顯弊端在于,它需要耗費比較大的PCB銅箔面積,才能有效地把熱量散發出去。如果在此期間不能夠用面積足夠大的PCB銅箔,那么在芯片底部就會形成一個熱點,而這個熱點會給PCB帶來很大的壓力。目前業界常用的PCB是FR4材質,該材質的最高溫度上限為110℃左右。在更高的功率設計中,底部散熱封裝無法通過貼片和PCB之間結合均勻地把更多熱量散出去,導致這種散熱方式走到了瓶頸。

而頂部散熱只需要在頂部使用一個薄薄的散熱片,而不靠底部的散熱片去散熱,它可以在同樣的PCB材質下,更有效、更均勻地把熱量散發出去。同時,它給用戶帶來的好處便是在同樣的散熱面積下,可提升整個設備對外輸出的功率。。
由于貼片頂部散熱封裝技術需要所有的器件都貼在同樣一個平面的PCB板上。如果對成本進行權衡,客戶希望用相同厚度的散熱片即可把設備中的熱量均勻地散發出去。由此看出,同等的器件高度就成為關鍵因素所在。因此,英飛凌在其頂部散熱封裝技術設計內定義的封裝厚度為2.3毫米,英飛凌希望通過這次跟JEDEC標準組織的互動,能夠使2.3毫米的厚度成為一個業界通行的做法。
至于為何會選擇2.3毫米,程文濤解釋說,首先要考慮到頂部散熱的做法不能成為其它非頂部散熱芯片的應用障礙,如果其它非頂部散熱的封裝厚度比較厚,那么頂部散熱的封裝就不能比它薄,否則會產生熱量散不掉的問題,或是需要加很厚的散熱墊。
二是,英飛凌研究了行業中很多的貼片封裝尺寸,在大部分的非頂部散熱以及頂部散熱封裝共存的情況下,選擇了2.3毫米。這樣的厚度能夠讓足夠多的器件并存在同一塊PCB板上。
TSC封裝的普及面臨哪些挑戰?
其實英飛凌推廣TSC封裝技術已有3年之久,程文濤回憶英飛凌在推廣TSC封裝技術遇到的挑戰時表示,在行業內做一個創新的推廣,阻力是來自方方面面的,包括生產線方面、安規方面的要求以及散熱材料配合等阻力。要想完成TSC封裝技術的推廣,則需要整個產業鏈相互配合才能讓一個創新最終落地。
首先面臨的是接受度的問題,最開始會受到電源領域工程師的質疑,他們之前最為信賴的有效散熱封裝技術是TO247和TO220,他們會首先質疑新的封裝形式在散熱能力上是否比原有的散熱方式更好;
二是之前生產線上的加工工藝不能滿足頂部散熱的安裝需求。在此需要解決的問題是,在同樣一個PCB板上焊接多個頂部散熱的芯片,怎樣才能保證這些頂部散熱的芯片的高度是一致的,利用同樣一個模具所加工出來的平面散熱片,怎樣才能均勻地貼在這些使用頂部散熱的芯片上,并且能夠保證它們之間的熱阻基本一致等等。
英飛凌與大客戶一起共同摸索,經過近兩年的時間找到了一些行之有效的應對辦法。一般頂部散熱接觸的電平是處理高壓的MOS管漏極,需要經過安全可靠的隔離才能接觸外部設備,這一點與插件式封裝非常類似。
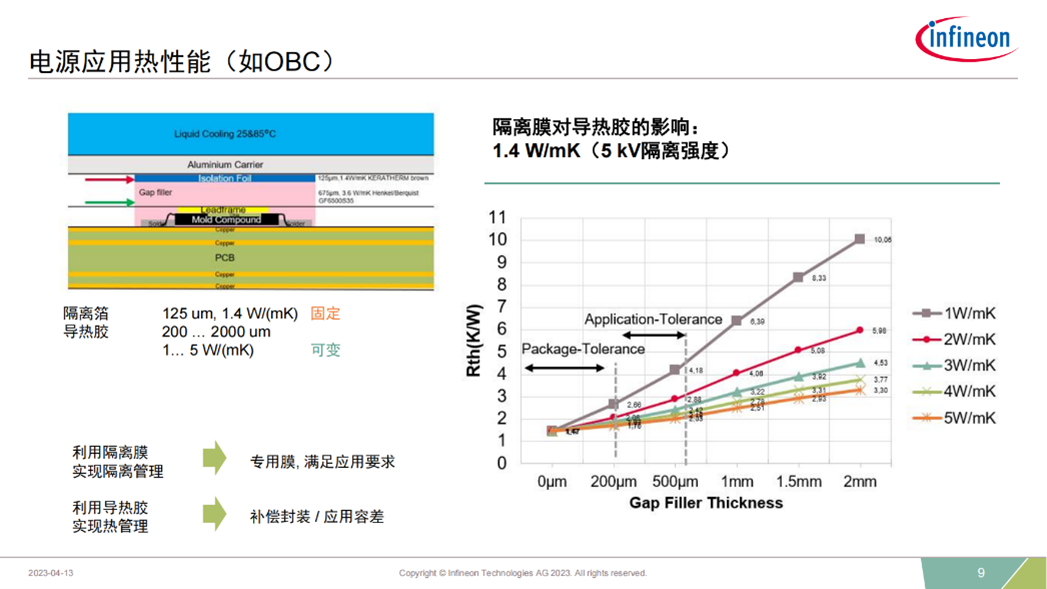
但如何將多個并聯,或者并排擺放的頂部散熱芯片里面的熱量均勻地散發出去呢?“目前最有效的方式就是用Gap Filler導熱膠均勻地把熱量傳導到頂部的散熱片里面去。在這里列出了不同導熱能力的導熱膠所產生的效果。在目前很多的應用里面,要實現這種采用一個頂部平面的均勻散熱,最有效的方式就是用一層能夠適應公差的導熱膠+隔離片,讓所有并排擺放的頂部散熱芯片的熱量能夠均勻地傳導到一個平面的散熱片上,這是目前業界共同接受的方法。而如果只需要對單獨一個頂部散熱芯片進行散熱,則可以采用鎖螺絲、銅夾子甚至焊接等多種選擇。但是從加工的速度、制造的成本上來看,這種方法是最行之有效的。”程文濤解釋說。
三是需要做更多的驗證。因為頂部散熱芯片,一般是不會用螺絲進行固定的,而是使用一塊很大面積的平板散熱片與底層大面積的PCB板中間搭載多顆芯片。那么,這種情形下,它的抗震等級可不可靠,EMI問題嚴不嚴重等很多方面的相關問題,在推行之初,需要廠商做很多的實驗去驗證目前采用的方案是否可行。
當然,雖然問題很多,但程文濤感到欣慰的是,現在越來越多的廠商看到了TSC封裝的優勢,大家都進行了良性的互動,“盡管挑戰是多方面的,但隨著產業鏈上下游共同分工配合,困難就會快速高效的被解決。”
結語
TSC封裝最為適合數據中心、通信基站、電動汽車等需要產品具有體積小、重量輕、功率密度高、效率高等特性的應用場景中。其實,在JEDEC標準里面,英飛凌不是唯一一家做頂部散熱封裝技術的公司,不同的企業提出的頂部散熱封裝技術設計方案都有他們自己的設計和考慮,最終哪一個封裝會成為業界公認的標準,還需要看廠商對終端應用的理解,以及終端客戶的接受程度。
-
英飛凌
+關注
關注
68文章
2556瀏覽量
143104 -
功率器件
+關注
關注
43文章
2182瀏覽量
95392
發布評論請先 登錄
新品 | 采用頂部散熱Q-DPAK封裝CoolSiC? G2 1200V MOSFET 產品擴展

巧妙分離電氣通路與散熱通路的碳化硅Q-DPAK頂部散熱封裝,實現極致功率密度

Wolfspeed發布新一代TOLT頂部散熱封裝產品組合
安森美推出采用T2PAK頂部冷卻封裝的EliteSiC MOSFET
TSC封裝:功率器件冰涼體驗
解析Wolfspeed頂部散熱碳化硅功率器件

Wolfspeed推SiC MOSFET/SBD新品:頂部散熱封裝
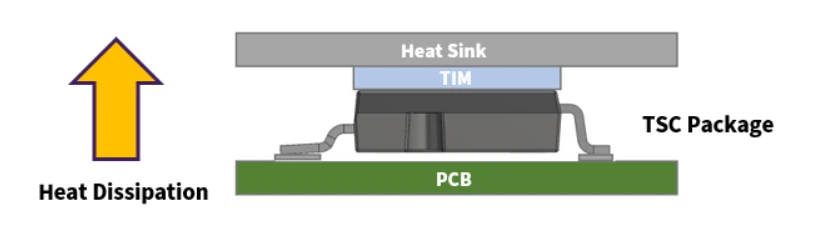
新品 | 采用頂部散熱 Q-DPAK封裝的 CoolSiC? 1200V G2 SiC MOSFET

新品 | 采用頂部散熱QDPAK的CoolSiC? 1200V G2 SiC MOSFET半橋產品

JSAB推出應用于工業伺服及變頻的頂部散熱TO-263T單管




 功率器件頂部散熱封裝技術的優勢及普及挑戰
功率器件頂部散熱封裝技術的優勢及普及挑戰

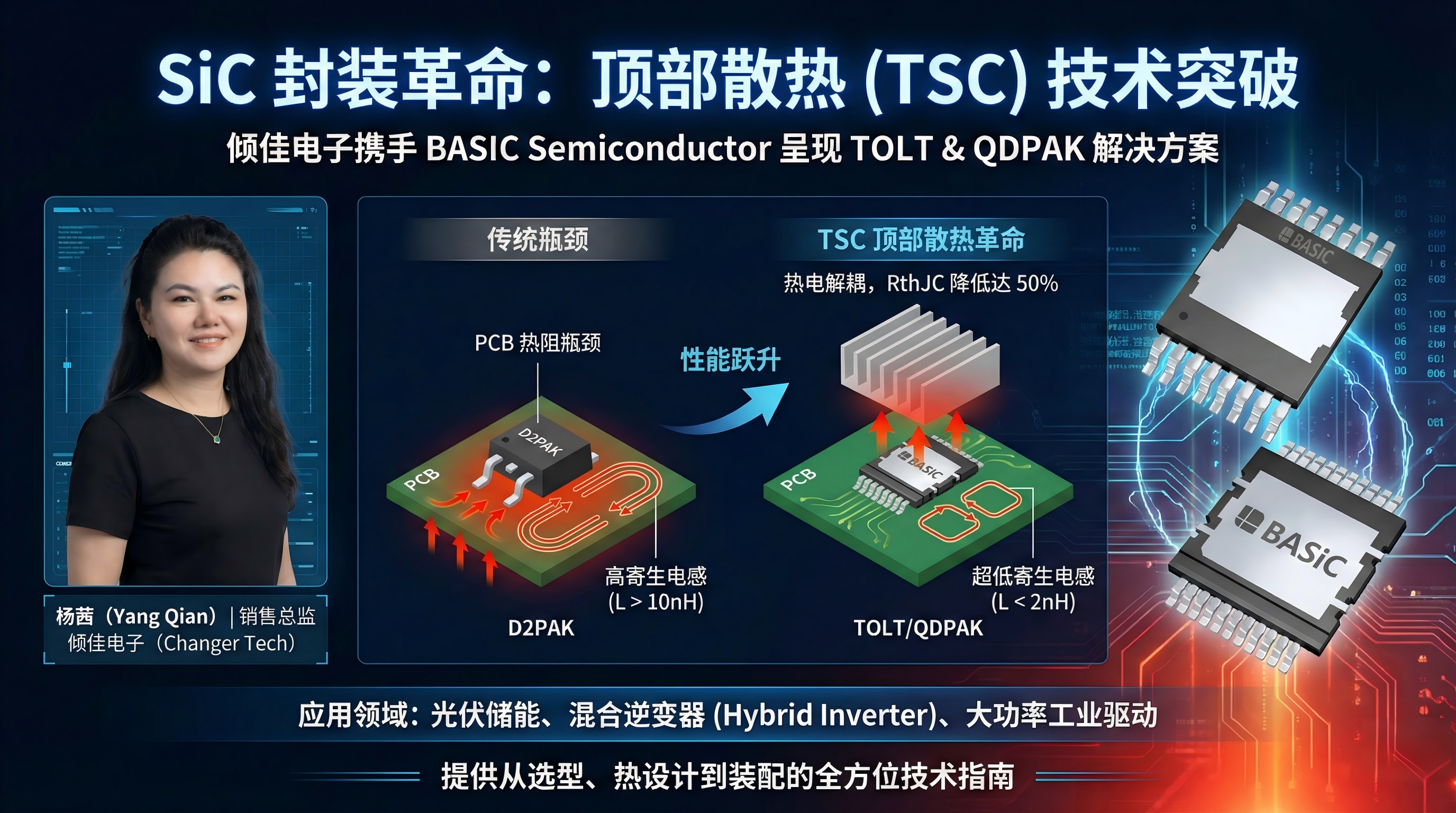
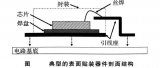
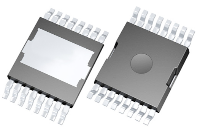



評論