引言
近十年來,濕化學法制備超薄二氧化硅/硅和超薄二氧化硅/硅結(jié)構(gòu)的技術(shù)和研究取得了迅速發(fā)展。這種結(jié)構(gòu)最重要是與大尺寸硅晶片上氧化物層的均勻生長有關(guān)。
在硝酸溶液中濕法制備的氧化物(通常標記為氫氧化鈉)的性質(zhì)在于通過傅里葉變換紅外光譜測定的高氧化物密度,因此,產(chǎn)生了制備具有優(yōu)異絕緣性能的超薄氧化物層的可能性。
實驗
我們使用了電阻率為10厘米的適度n型和p型硅(100)晶片。
所有硅襯底的表面在氧化之前都用標準的RCA工藝清洗(即。浸泡在NH4OH+H2O2水溶液和然后用5wt %蝕刻氫氟酸。近十年來,濕化學法制備超薄二氧化硅結(jié)構(gòu)的技術(shù)和研究得到了迅速發(fā)展。這種結(jié)構(gòu)最重要的優(yōu)點之一與大尺寸硅晶片上氧化物層的均勻生長有關(guān)。當然,氧化層和氧化物/硅界面的質(zhì)量也非常好。在硝酸溶液中濕法制備的氧化物(通常標記為氫氧化鈉)的非常有趣的性質(zhì)在于通過傅里葉變換紅外光譜測定的高氧化物密度,因此,產(chǎn)生了制備具有優(yōu)異絕緣性能的超薄氧化物層的可能性。
討論
3.1。采用后氧化退火和HCN處理的與NAOS相關(guān)的金屬氧化物半導體結(jié)構(gòu)的電學特性
第一組制備好的樣品在N2氣氛中于700℃退火20分鐘。它們被標記為氧化后退火后的樣品。第二組制備好的樣品在室溫下在0.1M水溶液中處理
3.2。氧化后退火樣品和金屬化后退火樣品(PMA)

通過原子發(fā)射光譜法獲得的穿過極薄的氫氧化鈉氧化層的氧、碳和硅原子的深度分布圖。
漏電流的減小,界面態(tài)密度的降低,懸空鍵結(jié)構(gòu)的轉(zhuǎn)變,以及SiOx沉淀的形成。
在PMA之后,我們觀察到激活能為0.05–0.2eV的連續(xù)缺陷態(tài)譜。在圖1所示的情況下。10A,是0.14eV。結(jié)構(gòu)熱穩(wěn)定后,可能形成二氧化硅沉淀。我們認為它們是深陷阱,活化能為0.26電子伏——見圖。10B 。
這種類型的陷阱已經(jīng)在POA樣品中發(fā)現(xiàn)——見表3,因此我們假設(shè)PMA結(jié)構(gòu)的界面性質(zhì)沒有發(fā)生質(zhì)的變化。當然,PMA結(jié)構(gòu)的電學性質(zhì),如漏電流和界面態(tài)密度,都得到了改善。
3.3。6K下的光致發(fā)光測量

硅晶片的機械和化學預處理的使用方式可以影響觀察到的光致發(fā)光振幅的值(而不是能量尺度上的最大值位置)以及界面缺陷狀態(tài)密度,因此在本實驗中使用的所有硅晶片組上進行相同的標準RCA程序。
我們認為,多孔硅內(nèi)部的原子無序程度會影響室溫下記錄的主要光致發(fā)光光譜。這種光譜在能量尺度上的位置與本文中給出的光譜有很大的不同,它們來自樣品中與硅晶體相關(guān)的部分,在6K溫度下測量。
結(jié)論
我們研究了在硝酸溶液中濕法化學氧化制備的結(jié)構(gòu)中光學、結(jié)構(gòu)和電學性質(zhì)。光譜橢偏法表明,形成的超薄氧化層的復折射率實部比二氧化硅的復折射率大。
原子力顯微鏡測量證實,與參考清潔表面相比,覆蓋有超薄氧化物的樣品的表面粗糙度僅略有變化。相應的值相差0.07納米。
在POA后極薄的NAOS氧化物/Si界面上,形成了更多類型的離散深陷阱。幾乎所有的深陷阱都與界面區(qū)域中更多類型的硅懸空鍵的形成有關(guān)。應力還會引起硅帶隙中陷阱的能量位置的變化。因此,我們不能排除它在這種情況下的作用。在極薄的氧化物/硅結(jié)構(gòu)上應用HCN水溶液后,觀察到了相當強的鈍化效應,這是由CN基團飽和硅懸掛鍵和將界面缺陷態(tài)密度降低大約一個數(shù)量級引起的。此外,鈍化過程可能導致形成新的深界面陷阱,盡管它們的密度很低。另一方面,我們不得不承認,我們可以觀察到相同類型的深陷阱(如鈍化過程之前),其活化能因應力變化而改變。此時此刻,我們無法區(qū)分哪種效應占主導地位。在兩種類型的硅襯底的中間間隙水平上觀察到最強烈的鈍化過程。如果使用p型硅襯底,記錄在NAOS/Si樣品上的深陷阱譜更簡單。
審核編輯:湯梓紅
 電子發(fā)燒友App
電子發(fā)燒友App















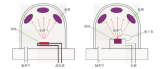

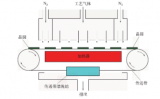






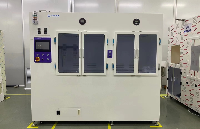




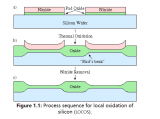
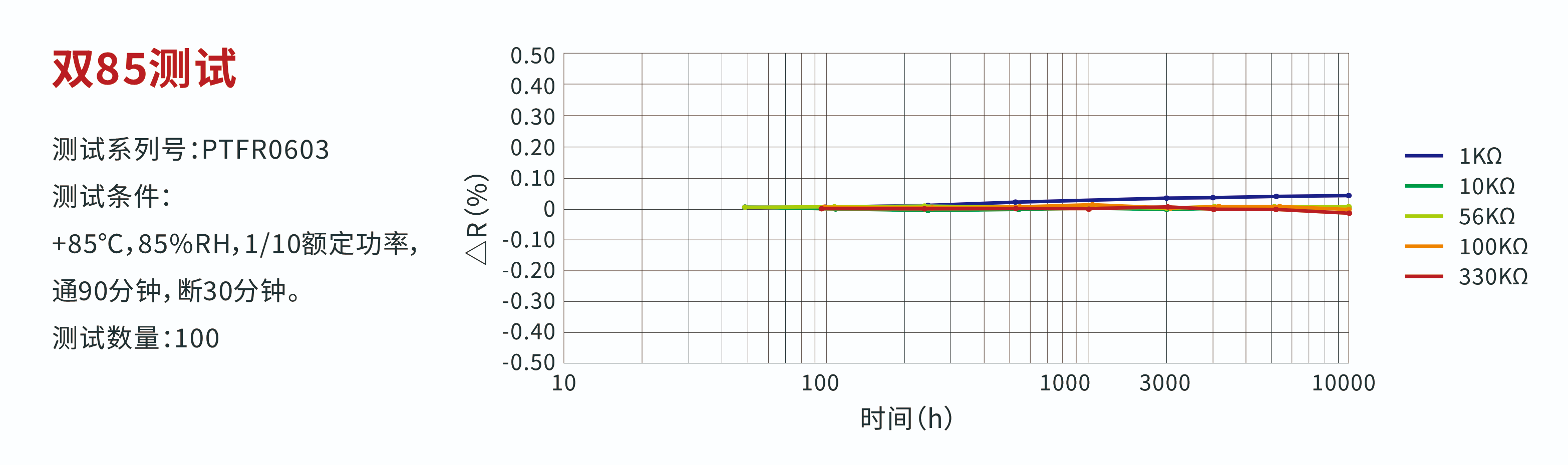

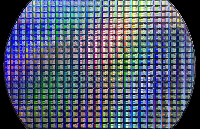


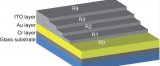






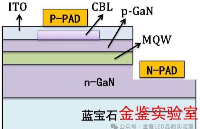
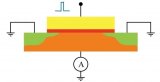

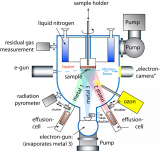



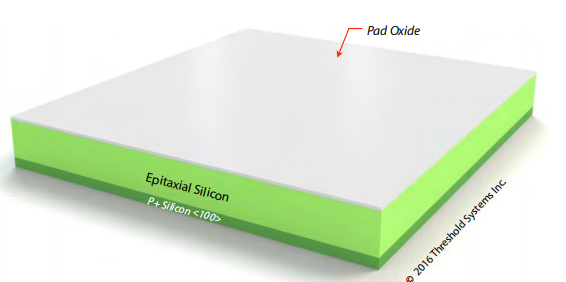




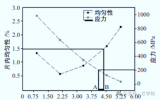



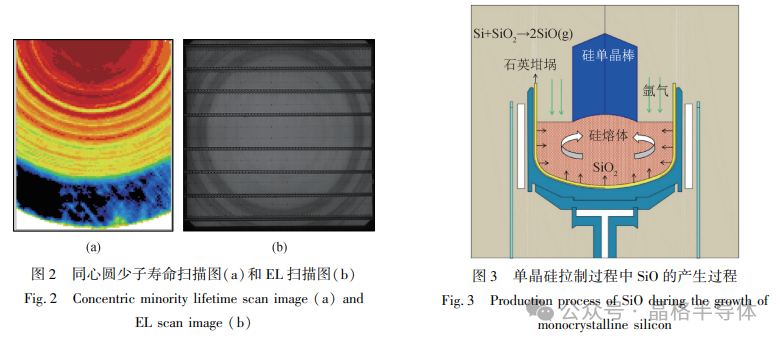
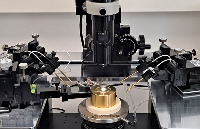



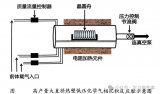


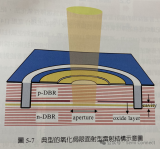




評論