本征氫化非晶氧化硅(i-a-SiO?:H)是 a-Si:H/c-Si 異質(zhì)結太陽電池的重要鈍化材料,兼具PECVD低溫沉積、帶隙寬等優(yōu)勢,但 i-a-SiO?:H鈍化性能與制備工藝、儀器密切相關;目前室溫(25℃)下在n型直拉單晶硅(n-Cz-Si)表面沉積 i-a-SiO?:H 時,硅片少子壽命極低,鈍化效果差,且襯底溫度對其鈍化性能的影響尚不明確;Flexfilm全光譜橢偏儀可以非接觸對薄膜的厚度與折射率的高精度表征,廣泛應用于薄膜材料、半導體和表面科學等領域。
本研究采用等離子體增強化學氣相沉積法(PECVD)制備i-a-SiO?:H薄膜,通過微波光電導(MW-PCD)、射頻光電導(RF-PCD)測少子壽命,光譜型橢偏儀驗晶型,探究不同襯底溫度的影響,結果顯示薄膜均為非晶相,200℃~220℃時少子壽命最高、鈍化效果最優(yōu)。
1
實驗材料與設備
flexfilm
襯底材料:選用n型直拉單晶硅片(n-Cz-Si),晶向為(100),厚度約 180μm,尺寸為 40mm×40mm;硅片經(jīng)激光切割后,采用RCA清洗法去除表面雜質(zhì)與氧化層,確保襯底潔凈。
實驗工藝參數(shù):實驗中,僅將襯底溫度作為變量,其余工藝參數(shù)保持固定:沉積功率 12W、沉積氣壓 22Pa、反應氣體流量比(SiH?CO?)為 30.6 mL/min、沉積時間 10min。襯底溫度共設置 6 個梯度:25℃(室溫)、100℃、180℃、200℃、220℃、250℃,以系統(tǒng)分析溫度對鈍化性能的影響規(guī)律。
2
室溫沉積 i-a-SiO?:H 的性能表征
flexfilm
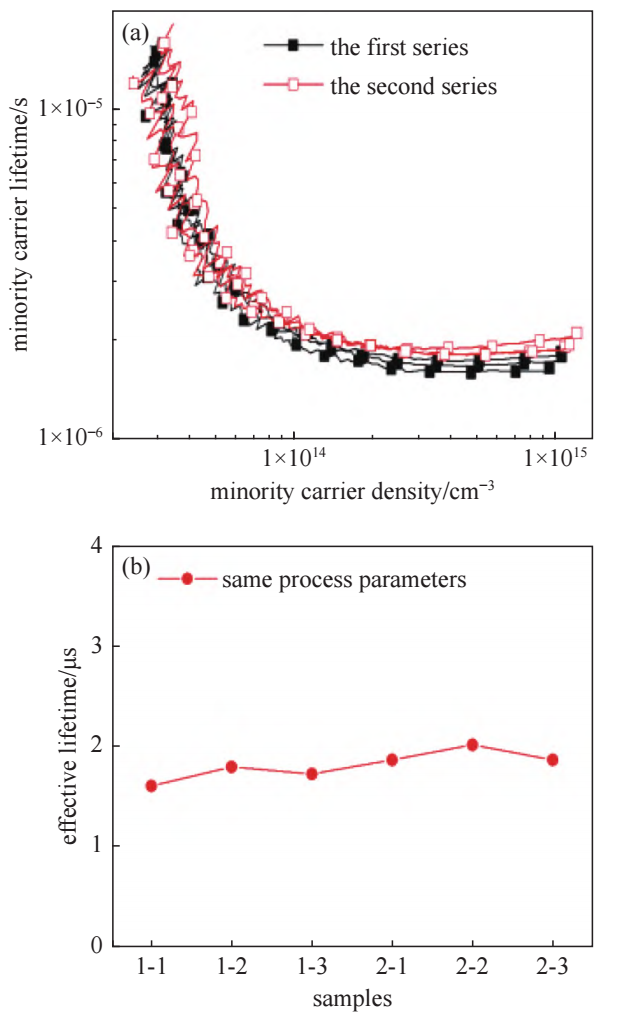
(a) 少子壽命隨注入濃度變化,(b) 注入濃度1×101?cm?3硅片少子壽命
少子壽命:鈍化效果不理想。結果顯示室溫下該薄膜對 n-Cz-Si 的鈍化效果較差。從少子壽命與注入濃度的關系曲線可見,少子壽命隨注入濃度增加顯著下降,說明沉積后硅片表面仍存在較多空位與缺陷;當注入濃度為 1×101?cm?3 時,少子壽命僅為 1~2 μs。這一現(xiàn)象與室溫沉積 i-a-Si:H 的鈍化性能不佳原因相似—低溫無法有效鈍化硅片表面的懸掛鍵。

(a) 實部,(b) 虛部
橢偏儀檢測:確認為非晶相。采用橢偏儀測試室溫沉積薄膜的介電常數(shù)(包括實部 ε?與虛部 ε?),結果顯示:該薄膜的介電常數(shù)特征峰與非晶硅的特征峰高度吻合,證明室溫下沉積的 i-a-SiO?:H 薄膜為非晶相,完全符合實驗對鈍化層晶型的預期要求。
3
不同襯底溫度對薄膜鈍化性能的影響
少子壽命:先增后減,200℃~220℃最優(yōu)

(a) 不同注入濃度硅片少子壽命,(b) 注入濃度為1×101?cm?3時少子壽命

不同襯底溫度i-a-SiOx:H 膜鈍化后硅片少子壽命
以 1 號位置硅片為研究對象,測試不同溫度下的少子壽命發(fā)現(xiàn):i-a-SiO?:H 的鈍化性能與襯底溫度高度相關。
當溫度低于 100℃時,硅片少子壽命不足 10μs,鈍化效果差。原因是低溫不利于 SiH?熱分解—而 SiH?分解產(chǎn)生的硅原子、氫原子(及 H?中的氫原子),是補償硅片懸掛鍵、實現(xiàn)鈍化的關鍵,低溫會導致這一過程難以充分進行。
隨溫度升高,少子壽命呈“先增后減”趨勢:220℃時,注入濃度 1×101?cm?3 條件下,少子壽命達到最大值 747μs。
為驗證結果可靠性,對 3 個硅片(均取注入濃度 1×101?cm?3)重復測試,發(fā)現(xiàn) 3 個樣品的少子壽命隨溫度變化趨勢完全一致,最優(yōu)鈍化溫度集中在200℃~220℃(不同位置略有差異)。結合本實驗的設備與工藝參數(shù),建議 PECVD 法沉積 i-a-SiO?:H 時,襯底溫度可設為 210℃,該結論與相關文獻研究結果基本一致。
鈍化均勻性:溫度越高,均勻性越差

i-a-SiOx:H 膜鈍化后硅片少子壽命
通過 MW-PCD 對 1 號位置硅片進行少子壽命掃描(掃描圖中,深黑色代表少子壽命高,紅色代表少子壽命低),結果顯示:整塊硅片的少子壽命存在不均勻性,且溫度越高,不均勻性越明顯。這是因為硅片表面各處氣流存在差異,導致輝光放電狀態(tài)不同,進而使薄膜厚度與成分在不同區(qū)域出現(xiàn)差異。
兩種 PCD 測試方法對比:原理不同,RF-PCD 更可靠

MW-PCD 法測試硅片少子壽命主要特征值(單位:μs)
兩種方法均驗證了“少子壽命隨溫度先增后減、220℃達最大”的規(guī)律,證明溫度對鈍化性能的影響具有可靠性。
但兩種方法的測試數(shù)據(jù)存在差異,核心原因是測試原理不同:MW-PCD 為瞬態(tài)方法,通過 200ns 波長 904nm 的脈沖激光注入產(chǎn)生非平衡載流子,記錄硅片反射微波功率的時間變化;RF-PCD 為非接觸式方法,可選擇瞬態(tài)或準瞬態(tài)測試模式。
由于薄膜均勻性較差,少子壽命分布不均,綜合來看,RF-PCD 的測試結果更具可靠性。
橢偏儀表征:所有溫度下均為非晶相

不同襯底溫度沉積i-a-SiOx:H 膜硅片介電常數(shù)譜:(a)實部,(b)虛部
對不同溫度下沉積的 i-a-SiO?:H 薄膜進行橢偏儀測試,結果顯示:無論襯底溫度如何變化,薄膜的介電常數(shù)實部與虛部均符合非晶硅的特征峰,證明所有溫度條件下沉積的 i-a-SiO?:H 薄膜均為非晶相,完全滿足實驗設計要求。
本研究明確了襯底溫度對i-a-SiO?:H薄膜鈍化性能的重要影響,確定了200-220℃為PECVD工藝的最佳溫度窗口。該研究結果為優(yōu)化a-Si:H/c-Si異質(zhì)結太陽電池的界面鈍化工藝提供了重要實驗依據(jù),對提升太陽電池轉(zhuǎn)換效率具有實際指導意義。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領域中單層或多層納米薄膜的層構參數(shù)(如厚度)和物理參數(shù)(如折射率n、消光系數(shù)k)
- 先進的旋轉(zhuǎn)補償器測量技術:無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術,高信噪比的探測技術。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm全光譜橢偏儀能非破壞、非接觸地原位精確測量超薄圖案化薄膜的厚度、折射率,結合費曼儀器全流程薄膜測量技術,助力半導體薄膜材料領域的高質(zhì)量發(fā)展。
原文參考:《襯底溫度對氫化非晶氧化硅(i-a-SiOx:H)鈍化性能的影響研究》
*特別聲明:本公眾號所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學術分享和傳遞行業(yè)相關信息。未經(jīng)授權,不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號相關權益的行為。內(nèi)容僅供參考,如涉及版權問題,敬請聯(lián)系,我們將在第一時間核實并處理。
-
太陽能電池
+關注
關注
22文章
1284瀏覽量
73251 -
光學
+關注
關注
4文章
866瀏覽量
38108
發(fā)布評論請先 登錄
VirtualLab Fusion應用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
VirtualLab Fusion應用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
橢偏儀原理和應用 | 精準測量不同基底光學薄膜TiO?/SiO?的光學常數(shù)

橢偏儀的原理和應用 | 薄膜材料或塊體材料光學參數(shù)和厚度的測量

橢偏儀在半導體薄膜厚度測量中的應用:基于光譜干涉橢偏法研究

橢偏儀在半導體的應用|不同厚度c-AlN外延薄膜的結構和光學性質(zhì)

基于橢偏光譜法研究不同基底對TiO?/SiO?薄膜光學常數(shù)的影響




 橢偏儀表征薄膜非晶相 | 精準分析不同襯底溫度下氫化非晶氧化硅(i-a-SiO?:H)薄膜的光學性質(zhì)與結構
橢偏儀表征薄膜非晶相 | 精準分析不同襯底溫度下氫化非晶氧化硅(i-a-SiO?:H)薄膜的光學性質(zhì)與結構

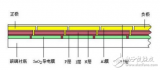



評論