IGBT熱阻的研究對于延長IGBT的使用壽命和提高其應(yīng)用可靠性具有重要的現(xiàn)實意義,目前獲取IGBT熱阻參數(shù)的試驗方法多為熱敏參數(shù)法,該方法方便簡潔、對硬件要求低,但是傳統(tǒng)的熱敏參數(shù)法需要測量器件的殼溫,而IGBT器件由于封裝尺寸遠大于芯片尺寸,所以殼溫不易準(zhǔn)確測量,測量過程中引入的誤差較多,最終無法得到器件真正的熱阻值。
與傳統(tǒng)測試方法相比,JESD51-14熱阻瞬態(tài)雙界面測試法具有更高的準(zhǔn)確性和重現(xiàn)性,而T3ster是目前全球唯一滿足此測試標(biāo)準(zhǔn)的儀器。使用T3ster對IGBT器件進行測試,可以記錄模塊結(jié)溫瞬態(tài)變化過程,能得到穩(wěn)態(tài)的結(jié)殼熱阻數(shù)據(jù),也能得到結(jié)溫隨時間變化的瞬態(tài)曲線,還可以通過結(jié)構(gòu)函數(shù)分析器件熱傳導(dǎo)路徑上各層結(jié)構(gòu)的熱阻值。
金鑒實驗室近期推出了“IGBT器件結(jié)殼熱阻測試”,并成功應(yīng)用于英飛凌IGBT產(chǎn)品上。
服務(wù)客戶:IGBT器件廠家、代理商、用戶等
服務(wù)內(nèi)容:
1.器件結(jié)殼熱阻測試
2.芯片結(jié)溫測試
3.結(jié)構(gòu)無損檢測
4.封裝材料和工藝優(yōu)化
5.器件可靠性篩選
6.老化試驗表征手段
測試數(shù)據(jù)包括:(1)瞬態(tài)溫度響應(yīng)曲線;(2)熱阻抗曲線;(3)頻域響應(yīng);(4)脈沖熱阻;(5)積分結(jié)構(gòu)函數(shù)與微分結(jié)構(gòu)函數(shù)。
一、金鑒實驗室應(yīng)用舉例:
某客戶委托金鑒對近期購買的英飛凌IGBT器件進行結(jié)殼熱阻測試,要求分別測試IGBT芯片及二極管芯片的結(jié)殼熱阻值,測試結(jié)果如下所示:
IGBT芯片結(jié)殼熱阻測試:
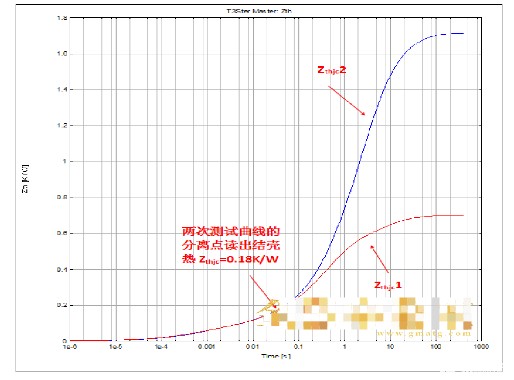
雙界面測試法熱阻抗曲線
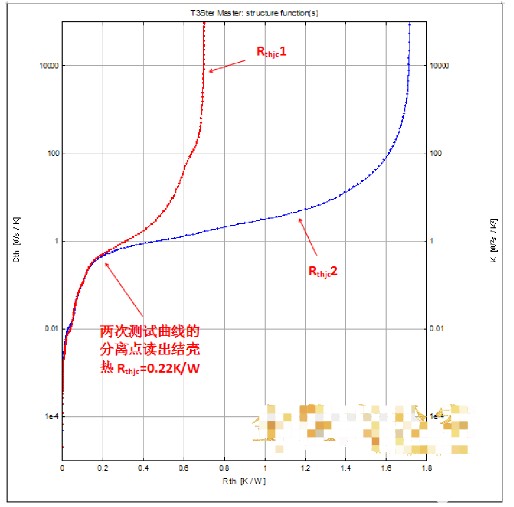
雙界面測試法結(jié)構(gòu)函數(shù)曲線
Zthjc1和Zthjc2兩曲線在分離點的值Zthjc(ts)不一定等于穩(wěn)態(tài)時的結(jié)殼熱阻Rthjc,原因是在穩(wěn)態(tài)時(需要很長時間)和在瞬態(tài)ts時器件內(nèi)部的熱流分布不一樣。當(dāng)Zthjc(ts)
二極管結(jié)殼熱阻測試:
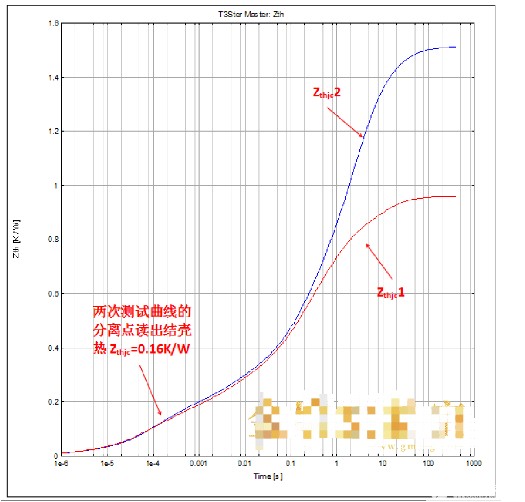
雙界面測試法瞬態(tài)熱阻曲線
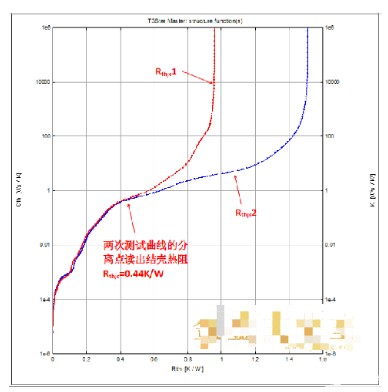
雙界面測試法結(jié)構(gòu)函數(shù)曲線
二極管芯片測試結(jié)果也是Zthjc(ts)
二、溫度循環(huán)下IGBT熱阻退化模型的研究
研究IGBT功率器件在熱應(yīng)力不斷沖擊過程中熱阻的老化規(guī)律,并以此為依據(jù)對器件的健康狀態(tài)進行評估,預(yù)測器件的剩余壽命具有十分重要的科學(xué)意義。
實驗過程:先測試IGBT的初始熱阻,再將IGBT器件放入老化設(shè)備中,每經(jīng)過1000次溫度循環(huán),重新測量器件的結(jié)殼熱阻值,直到器件失效為止。下圖是溫度循環(huán)下IGBT熱阻及其偏移量的波形。

由圖可知,隨著熱應(yīng)力的不斷沖擊,IGBT的性能發(fā)生了一定程度的退化,熱阻隨著溫度循環(huán)次數(shù)的增多不斷增大,這代表器件焊接層出現(xiàn)了疲勞損傷。其它研究表明IGBT器件先發(fā)生焊接層失效,當(dāng)焊接層失效到一定程度后鋁引線才開始失效,所以監(jiān)測IGBT器件熱阻情況更能有效的掌握其健康狀態(tài)。
? ? ? ? 責(zé)任編輯:tzh
 電子發(fā)燒友App
電子發(fā)燒友App













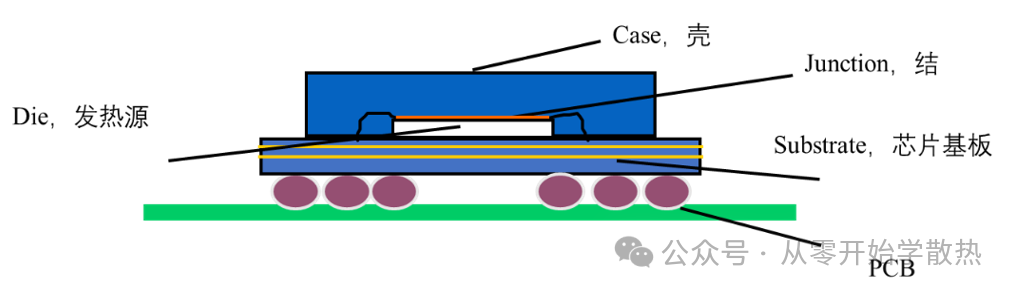


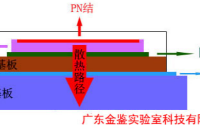


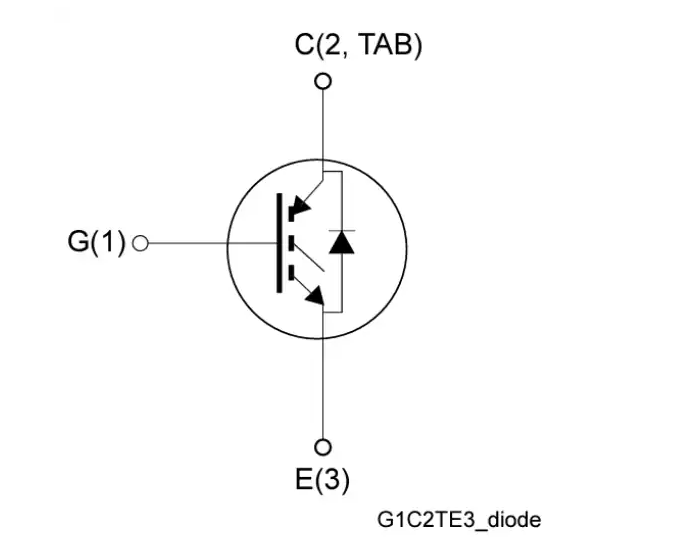











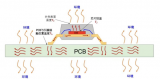
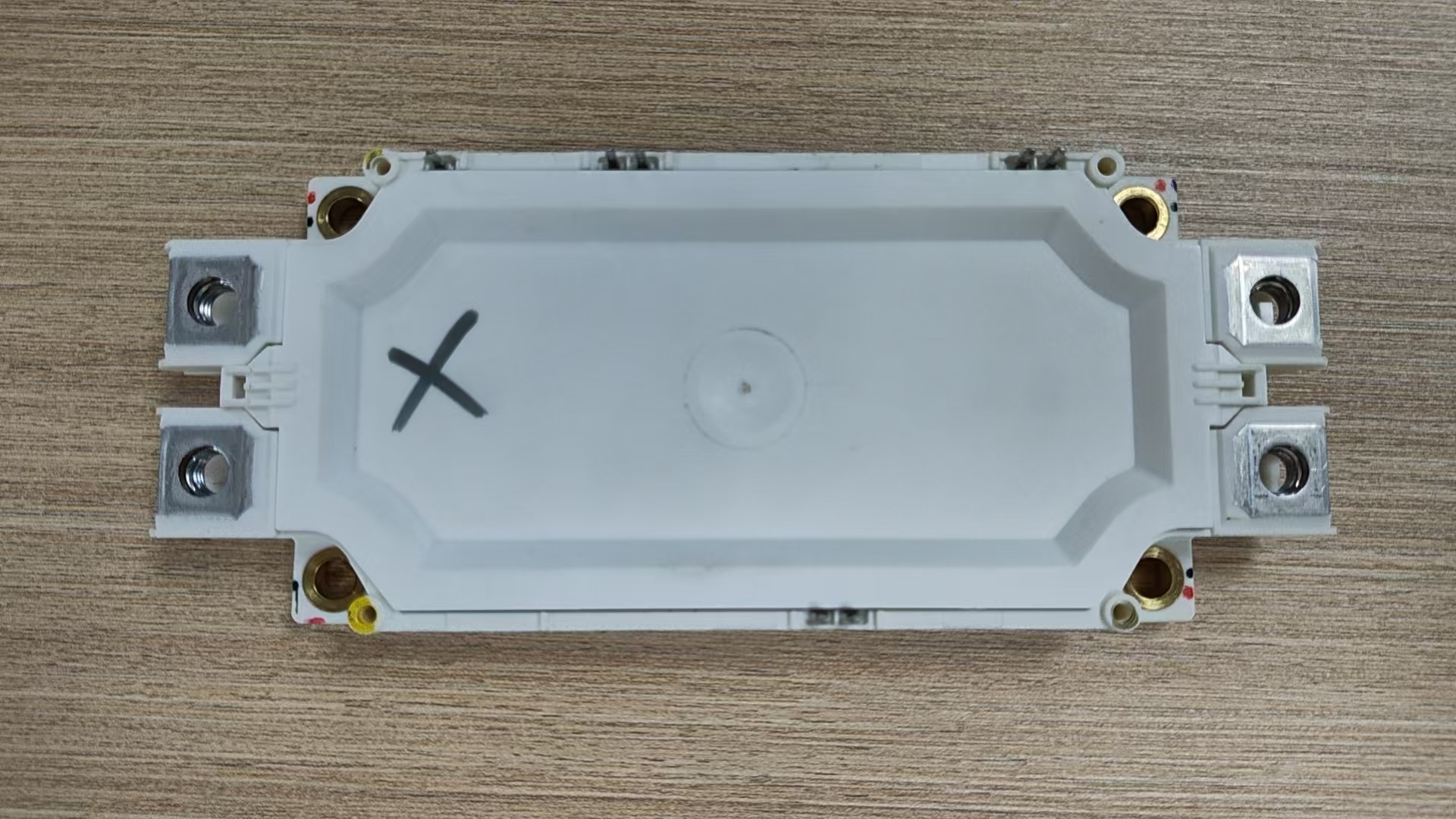

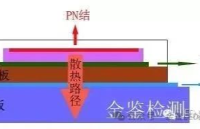



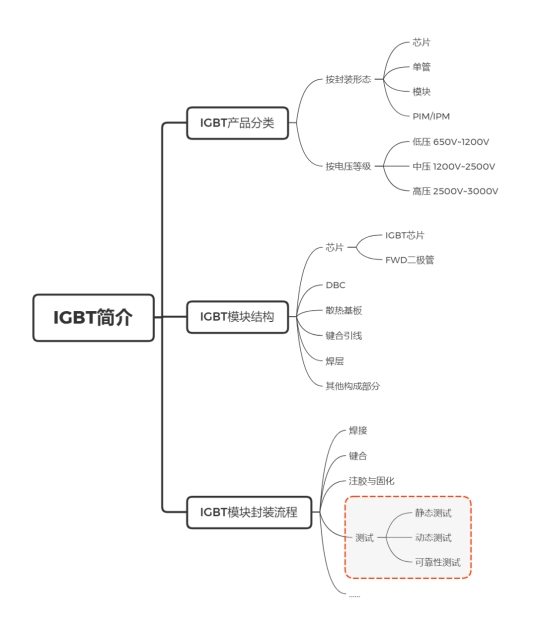

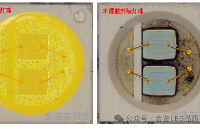



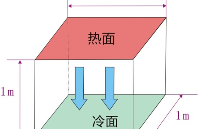



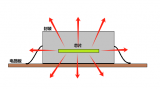
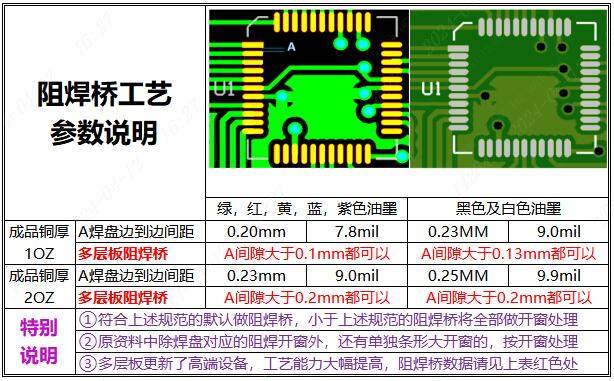


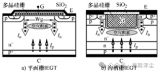

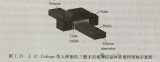















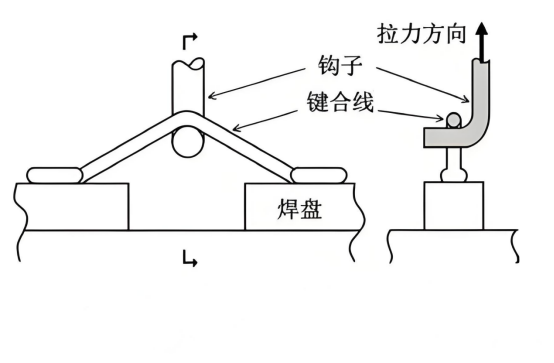

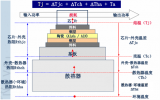


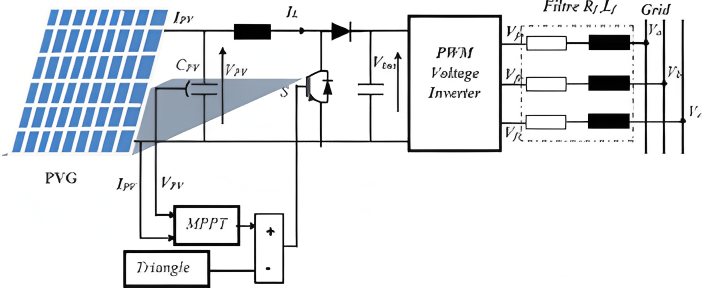


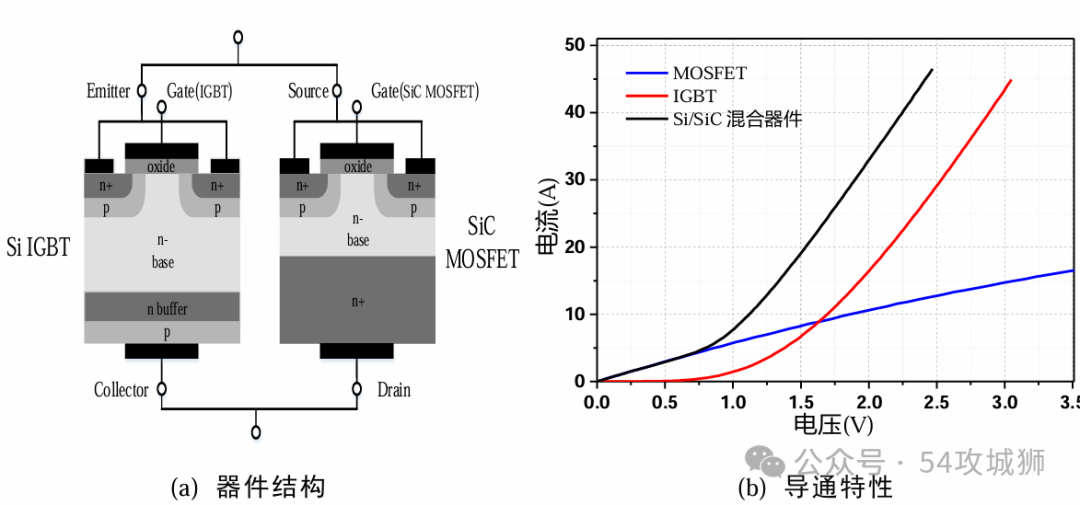
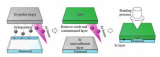



評論