在電子器件(如導熱材料或導熱硅脂)上涂覆導熱材料的目的是幫助發熱器件加快散熱。此舉旨在降低器件每單位電能耗散所產生的溫升。衡量每功耗所產生溫升的指標稱為熱阻,而給器件涂抹導熱材料的目的正是為了降低元件的熱阻。
本文將簡要解釋熱阻的概念,并介紹導熱材料的特性如何影響熱阻。
導熱材料和熱阻
導熱材料一詞源自它在器件上發揮的作用,也被稱為導熱填充物。將導熱材料涂敷于器件表面,并在機械壓力作用下將散熱器安裝到器件上時,導熱材料會填充器件與散熱器接觸面之間的微觀間隙。換言之,界面處的空氣被具有高導熱系數的材料取代,從而能高效地將熱量傳導至散熱片。通過在器件與散熱器之間建立高效導熱路徑,可最大化兩者之間的熱通量。
由于空氣導熱性較差,通過在壓力下涂覆導熱材料,排出空氣,可顯著提升接觸界面的整體導熱性能。最終形成的導熱材料與空氣體積占比將決定界面的熱阻值。該值可用于預測導熱材料對器件熱阻的影響(見下文)。
熱阻預測
在實際器件中,熱阻的大小取決于多種因素,包括用于定義溫升的環境溫度。在元器件產品手冊中,封裝材料的熱導系數幾乎從不會出現在材料特性或封裝數據表中。通常取而代之的是標注器件兩個特定區域或部分之間的實測熱阻值。
為了預測帶散熱器的器件熱阻變化,封裝到環境或裸片到環境的熱阻值扮演重要作用。裸片到封裝的熱阻可能非常低,這意味著熱量能輕易從裸片器件傳導至封裝外殼。但封裝到環境的熱阻值(尤其是環氧樹脂基封裝)可能會非常高。下表列出了不同器件封裝的典型熱阻值范圍:

可使用一個簡易模型,基于空氣與導熱材料的導熱系數來評估封裝熱阻的變化。首先,我們可以利用空氣和熱界面材料(TIM)的導熱系數來計算封裝至環境的熱阻:
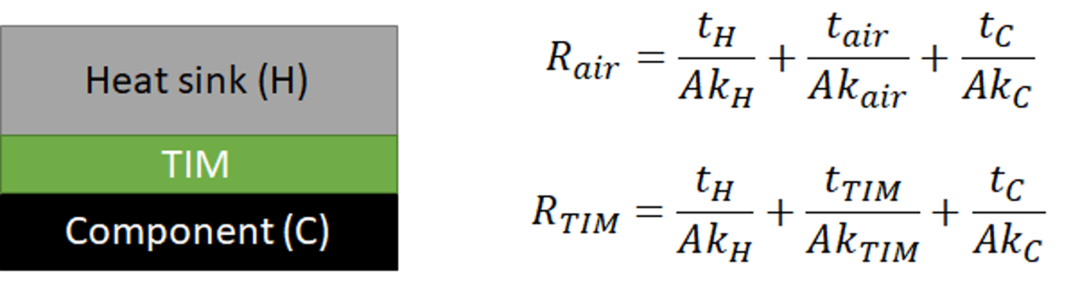
分別計算空氣暴露部分和 TIM 暴露部分的封裝至環境熱阻。
接下來計算這兩個數值的差值,即可得知導熱材料(TIM 層)降低熱阻的程度:

分別計算空氣暴露部分和 TIM 暴露部分的封裝至環境熱阻。
運用該公式的難點在于確定導熱材料與空氣的體積比,該比值可能介于 10:1 至 1000:1 之間,甚至更大。具體數值還會因導熱膏類型而異;某些多孔導熱墊片的比值較低,而導熱膏能高效填充元件與散熱器接觸面的微觀間隙,其比值可能高出許多。
哪種導熱材料效果最佳?
通過上述一維模型分析可知,決定哪種導熱材料最能有效降低熱阻的關鍵因素有四個:
1
導熱材料的成分,決定了其導熱系數
2
組裝工藝過程,決定了空氣及填充材料比例
3
導熱材料涂覆區域的大小
4
導熱材料涂覆/完全固化后的厚度
由于系統中存在許多變量,很難對所有導熱材料的效果做出籠統的比較性論斷。導熱材料選擇通常不以熱阻變化為主要考量,而是基于其他工程特性,如是否可以重工、清潔度、組裝成本、脫氣性等。選定材料后需通過原型組裝驗證,方可投入量產。
該流程本身并無問題,除非發現最初選用的導熱材料無法提供足夠的散熱效果。為此應當采用包含熱傳導與氣流分析在內的綜合熱仿真方案,以確定關鍵元器件的目標熱阻要降低到什么程度。通過這種方式,可以設定系統必須滿足的新標準,并將其作為性能目標,而非僅關注成本或組裝工藝。對于高可靠性設計而言,這可能是一種更優的策略。
如需全面分析系統熱特性,Cadence Celsius Thermal Solver支持各個方面的熱分析,是第一種專為電氣與機械工程師設計的熱分析技術,可以快速準確地識別 IC 封裝、PCB 和電子系統中的熱問題。它采用創新的大規模并行求解器技術,仿真速度比傳統熱仿真器最高可快10 倍,同時顯著減少內存使用。它包括一個強大的有限元分析(FEA)場求解器,用于分析復雜固體結構中的瞬態和穩態以及熱傳導,并利用計算流體力學(CFD)引擎進行對流和輻射熱傳遞分析。
-
電子器件
+關注
關注
2文章
636瀏覽量
33403 -
熱阻
+關注
關注
1文章
121瀏覽量
17412 -
導熱材料
+關注
關注
1文章
192瀏覽量
11083
發布評論請先 登錄
導熱界面材料對降低接觸熱阻的影響分析
Kensflow2365 導熱相變材料
導熱材料,導熱相變材料,導熱硅膠,igbt散熱
導熱塑料散熱器的好壞取決于安規條件與熱阻效能
什么是熱阻?對導熱材料而言又有什么影響呢?
芯片發熱為什么要應用導熱界面材料散熱?
熱阻對導熱材料究竟有哪些影響?
導熱系數/熱阻鑒定解決方案
導熱硅膠片導熱系數、熱阻、壓縮的關系
導熱材料亂象多,金鑒導熱系數/熱阻鑒定一統江湖
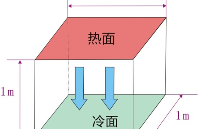



 技術資訊 I 導熱材料對熱阻的影響
技術資訊 I 導熱材料對熱阻的影響





評論