在電子設備的散熱設計中,熱阻(Thermal Resistance)是一個至關重要的物理量,它定量描述了材料或系統對熱量傳遞的阻礙能力。從本質上看,熱阻是熱傳遞路徑上的“阻力標尺”,其作用可類比于電路中的電阻——電阻限制電流,熱阻則限制熱流。
定義與公式:
熱阻定義為物體兩端溫度差(ΔT,單位:℃或K)與通過它的熱功率(P,單位:瓦特,W)的比值,數學表達式為:Rθ = ΔT / P。熱阻越大表示熱越不容易傳導,因此物體溫度就會越高。
這一公式揭示了熱阻的核心意義:單位熱功率下產生的溫差。例如,若某散熱器的熱阻為0.5℃/W,當芯片功耗為10W時,散熱器兩端溫差將達5℃。
一、熱阻參數解析
常見熱阻參數包括:結到外殼的熱阻(RθJC),結到環境熱阻(RθJA),結到板熱阻(RθJB),外殼到散熱器熱阻(RθCS),結到頂部熱阻(RθJT)。
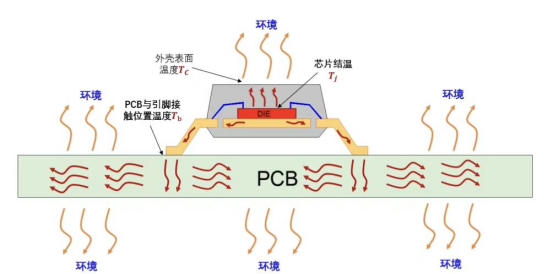
圖1:芯片熱阻模型示意圖
結到外殼的熱阻
RθJC, Junction-to-Case Thermal Resistance
定義:芯片內部發熱結(Junction)與封裝外殼(Case)之間的熱阻,反映封裝內部的導熱能力。
計算公式:RθJC = (Tj-Tc)/PH
測試條件:通常在標準冷卻條件(如強制風冷)下測量,外殼需與散熱器緊密接觸。
影響因素:基板材料(陶瓷/塑料/金屬)、TIM(導熱界面材料)性能、芯片與基板的連接工藝(如焊線、倒裝焊)。
典型值:陶瓷封裝(如QFN)可能低至1-5℃/W,塑料封裝(如LQFP)可能高達10-30℃/W。
結到環境熱阻
RθJA, Junction-to-Ambient Thermal Resistance
定義:芯片結到周圍環境的總熱阻,綜合反映封裝、PCB、散熱器及空氣對流的散熱能力。
計算公式:RθJA=(Tj-TA) /PH
測試條件:分為自然對流(RθJA-NA)和強制風冷(RθJA-FA),結果差異顯著。
影響因素:PCB銅箔面積、散熱孔設計、空氣流動速度、封裝高度(如BGA比QFN更易散熱)。
典型值:小封裝(如SOT-23)可能高達200-500℃/W,大功率封裝(如TO-220)可能低至10-30℃/W。
結到板熱阻
RθJB, Junction-to-Board Thermal Resistance
定義:芯片結到PCB板(Board)的熱阻,反映熱量通過封裝底部傳導至PCB的能力。
計算公式:RθJB=(Tj-TB )/PH
測試條件:芯片底部與PCB緊密接觸,測量點位于PCB下方特定距離(如1mm或2mm)。
影響因素:封裝底部金屬層厚度、PCB銅箔面積和層數、焊盤設計。
典型值:帶散熱焊盤的QFN封裝可能低至10-20℃/W,無焊盤的SOP封裝可能高達50℃/W以上。
應用場景:優化PCB散熱設計,尤其適用于無散熱器的密閉空間設備。
外殼到散熱器熱阻
RθCS, Case-to-Sink Thermal Resistance
定義:封裝外殼與散熱器之間的熱阻,反映接觸界面的導熱效率。
計算公式:RθCS=(TC-TCS )/PH
影響因素:接觸壓力、導熱膏/墊的材質與厚度、表面粗糙度。
典型值:優質導熱膏(如硅脂)可將RθCS降至0.1-0.5℃/W,而空氣間隙可能導致RθCS超過1℃/W。
應用場景:指導散熱器安裝工藝,避免因接觸不良導致散熱失效。
結到頂部熱阻
RθJT, Junction-to-Top Thermal Resistance
定義:芯片結到封裝頂部的熱阻,反映熱量通過封裝頂部散出的效率。
計算公式:RθJT=(Tj-Tt)/PH
應用場景:適用于頂部散熱設計(如加裝散熱片或風扇),常見于高功率LED或功率模塊。
典型值:金屬頂蓋封裝(如TO-247)可能低至5-10℃/W,塑料封裝可能高達50℃/W以上。
其中:
Tj:結溫;
TA:環境溫度;
TB:PCB板溫度;
TC:外殼溫度;
TCS:散熱器溫度;
Tt:封裝頂部溫度;
PH:總功耗。
二、案例分析
我們以公司的一個產品設計和熱仿真結果作為真實案例,做一個熱阻分析。這款DDR4芯片采用9片die堆疊設計,采用兩半(4個die和5個die)進行堆疊。

圖2:DDR4芯片封裝示意圖
下圖是多芯片堆疊的熱仿真結果。本次仿真采用Ansys Icepak進行模擬,旨在評估BGA321封裝在不同熱路徑下的熱阻性能。仿真條件如下:環境溫度25℃,功率6.75W,PCB類型2s2p,散熱方式為自然對流。
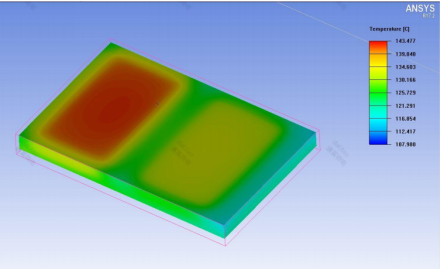
圖3:RθJA
在JA環境中,最高溫在5個芯片堆疊的芯片上表面,環境溫度為25℃,功耗為6.75W,計算可得熱阻JA為17.55℃/W。RθJA反映了芯片到環境空氣的整體散熱能力,在自然對流條件下RθJA的典型值為20~100℃/W。該芯片RθJA小于典型值,說明熱量更容易散熱到環境當中,芯片有很好的環境散熱性能。
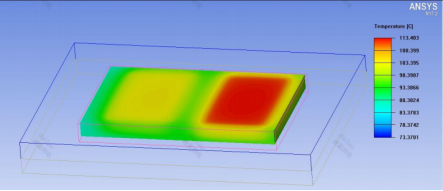
圖4:RθJB
在JB環境中,最高溫在5個芯片堆疊的芯片上表面,環境溫度為25℃,功耗為6.75W,計算得熱阻JB為11.61℃/W。RθJB表示芯片通過封裝底部向PCB傳遞熱量的能力,在自然對流條件下,RθJB典型值為5~20℃/W。該芯片RθJB在在典型值范圍內,說明芯片通過PCB板散熱的能力較好,即芯片熱量向電路板傳遞的效率更高,可以適用于高功率場景。
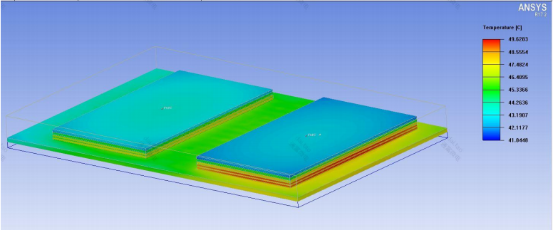
圖5:RθJC
在JC環境中,最高溫在5個芯片堆疊的芯片底面,環境溫度為25℃,功耗為6.75W,計算得熱阻JC為3.65℃/W。RθJC是芯片到封裝外殼的熱阻,在自然對流條件下,RθJC典型值為1~10℃/W。該芯片RθJC在典型范圍內,說明芯片通過封裝外殼散熱的性能較好,封裝導熱性好,便于安裝散熱器和導熱墊。
三、熱性能優化建議
如需進一步降低結溫,優化散熱路徑,下列方法可供參考:
通過改進PCB設計,例如使用高導熱材料或者增加散熱層。也可以通過提高PCB覆銅率來提高PCB面熱導率,如提高覆銅率至80%,PCB面內熱導率可以提升至150W/m*K,預計可以降溫6℃~8℃。
優化塑封料:隨著塑封料熱導率的增加,DDR 模組的最高溫度會逐漸降低。當前塑封料熱導率較低,為1W/m*K,根據傅里葉熱傳導定律,計算出當前塑封料熱阻為4.8℃/W,占系統總熱阻的27%。可以嘗試將塑封料熱導率提升至5W/m*K,預計結溫可以降級5℃左右。
優化散熱路徑。當前RθJC為3.65℃/W,說明封裝頂部是高效散熱路徑。可以添加頂部散熱器,或者采用高導熱界面材料,來進一步優化散熱降低結溫。
四、結論
在電子散熱設計中,熱阻是衡量芯片散熱性能的核心指標,直接影響設備的可靠性與壽命。通過對 RθJA(結到環境)、RθJB(結到板)、RθJC(結到外殼)等關鍵參數的解析,我們可以精準評估芯片的散熱路徑效率,并針對性地優化設計。較低 RθJA 表明芯片整體散熱性能優異,熱量能高效傳遞至環境;較低 RθJB 反映 PCB 導熱能力強,適合依賴電路板散熱的場景;較低 RθJC 則說明封裝內部導熱路徑高效,便于外接散熱器提升散熱能力。
通過優化 PCB 設計(如增加覆銅率、使用高導熱材料)、改進封裝工藝(如提升塑封料導熱率)以及增強散熱路徑(如加裝散熱器),可顯著降低芯片結溫,確保其在高溫、高負載下的穩定運行。精準的熱阻分析與優化,是提升電子設備性能與可靠性的關鍵一步。
-
封裝
+關注
關注
128文章
9302瀏覽量
148908 -
熱阻
+關注
關注
1文章
121瀏覽量
17412 -
散熱
+關注
關注
3文章
609瀏覽量
33339 -
DDR4
+關注
關注
12文章
349瀏覽量
43292
原文標題:解讀DDR4堆疊模組的熱仿真報告與散熱優化
文章出處:【微信號:封裝與高速技術前沿,微信公眾號:封裝與高速技術前沿】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
DDR4與DDR3的不同之處 DDR4設計與仿真案例






 DDR4堆疊模組的熱仿真案例分析
DDR4堆疊模組的熱仿真案例分析

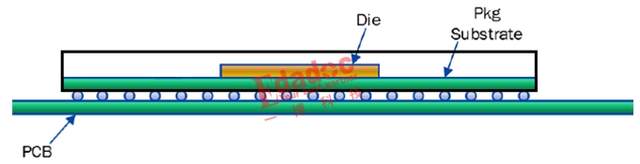



評論