晶圓常用的切割手段有很多,根據不同的材質和芯片設計采用不同的方式。常見的有砂輪切割、激光切割、金剛刀劃片劈裂、還有隱形切割等等。其中激光切割應用是越來越廣,激光切割也分為激光半劃、激光全劃、激光隱形劃切和異形芯片的劃切等工藝方法的特點。
2023-11-02 09:11:57 7219
7219 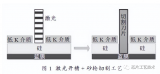
(GaAs)晶圓上實現的。光電子驅動砷化鎵(GaAs)晶圓市場增長GaAs晶圓已經是激光器和LED技術領域幾十年的老朋友了,主要應用有復印機、DVD播放器甚至激光指示器。近年來,LED推動了化合物半導體
2019-05-12 23:04:07
SiC SBD 晶圓級測試 求助:需要測試的參數和測試方法謝謝
2020-08-24 13:03:34
。這標志著我公司的產品將向集中化、規模化生產邁進!日本NTC線切割---宮本株式會社耗材配套供應商! 主要產品(一)LED藍寶石、半導體切割用樹脂墊條產品說明: LED藍寶石、半導體晶圓片切割樹脂墊條
2012-03-10 10:01:30
!日本NTC線切割---宮本株式會社耗材配套供應商! 二、主要產品(一)半導體切割用樹脂墊條產品說明: 半導體晶圓片切割樹脂墊條是公司根據國內晶圓片廠生產需要自主研發的新產品,使用效果好,規格和厚度
2012-03-17 08:59:45
`半導體激光在晶圓固化領域的應用1. 當激光照射工件到上,能量集中,利用熱傳導固化,比用烤箱,烤爐等方式效率高。烤箱是把局部環境的空氣(或惰性氣體)加熱,再利用熱空氣傳導給工件來固化膠水。這種方式
2011-12-02 14:03:52
作者: Robert GeeMaxim Integrated核心產品事業部執行業務經理 在半導體測試領域,管理成本依然是最嚴峻的挑戰之一,因為自動化測試設備(ATE)是一項重大的資本支出。那么,有沒有能夠降低每片晶圓的成本,從而提升競爭優勢的方法呢?有,答案就是提高吞吐率。
2019-07-29 08:11:12
,大功率直接半導體激光器在切割和焊接領域得到了廣泛應用。目前,全球半導體激光器市場規模較大,從2012年的35.4億美元增加值至2017年的53.1億美元,年復合增長率為8.4%。圖表
2019-04-01 00:36:01
,傳統半導體激光器難以直接用于金屬切割。近年來,隨著半導體耦合技術的提高,以及新型合束技術的逐漸成熟,部分千瓦級以上的光纖輸出的半導體激光器,也可以滿足切割對光束質量的要求。另外,由于半導體激光器波長
2019-05-13 05:50:35
有沒有能否切割晶圓/硅材質濾光片的代工廠介紹下呀
2022-09-09 15:56:04
`晶圓切割目的是什么?晶圓切割機原理是什么?一.晶圓切割目的晶圓切割的目的,主要是要將晶圓上的每一顆晶粒(Die)加以切割分離。首先要將晶圓(Wafer)的背面貼上一層膠帶(Wafer Mount
2011-12-02 14:23:11
晶圓切割主要采用金剛石砂輪刀片即輪轂型硬刀,半導體從業者不斷尋求能提高加工質量和加工效率的方法,以達到更低的加工成本。本文將分享從切割現場積累的經驗供半導體從業者參考。
2021-08-17 17:32:26
` 硅是由石英沙所精練出來的,晶圓便是硅元素加以純化(99.999%),接著是將些純硅制成硅晶棒,成為制造積體電路的石英半導體的材料,經過照相制版,研磨,拋光,切片等程序,將多晶硅融解拉出單晶硅晶棒
2011-09-07 10:42:07
;nbsp; 用激光對晶圓進行精密劃片是晶圓-尤其是易碎的單晶半導體晶圓如硅晶圓刀片機械劃片裂片的替代工藝。激光能對所有
2010-01-13 17:01:57
重復排列成非常固定的結構,這種材料稱為晶體。原子沒有固定的周期性排列的材料被稱為非晶體或無定形。塑料就是無定形材料的例子。晶體生長半導體晶圓是從大塊的半導體材料切割而來的。這種半導體材料,或稱為硅錠
2018-07-04 16:46:41
是最流行的半導體,這是由于其在地球上的大量供應。半導體晶圓是從錠上切片或切割薄盤的結果,它是根據需要被摻雜為P型或N型的棒狀晶體。然后對它們進行刻劃,以用于切割或切割單個裸片或方形子組件,這些單個裸片或
2021-07-23 08:11:27
` 晶圓是指硅半導體集成電路制作所用的硅晶片,由于其形狀為圓形,故稱為晶圓;在硅晶片上可加工制作成各種電路元件結構,而成為有特定電性功能之IC產品。晶圓的原始材料是硅,而地殼表面有用之不竭的二氧化硅
2011-12-01 11:40:04
元件來適應略微增加的開關頻率,但由于無功能量循環而增加傳導損耗[2]。因此,開關模式電源一直是向更高效率和高功率密度設計演進的關鍵驅動力。 基于 SiC 和 GaN 的功率半導體器件 碳化硅
2023-02-21 16:01:16
披覆(玻鈍)二極管等半導體晶圓的劃片和切割,技術領先于國內同行,在展會現場,即有半導體公司現場訂購此設備,同時天弘激光具備依據晶圓廠不定需求定制非標激光劃片機的設計、開發、制造能力。 
2010-03-21 00:50:07
高可靠性系統設計包括使用容錯設計方法和選擇適合的組件,以滿足預期環境條件并符合標準要求。本文專門探討實現高可靠性電源的半導體解決方案,這類電源提供冗余、電路保護和遠程系統管理。本文將突出顯示,半導體技術的改進和新的安全功能怎樣簡化了設計,并提高了組件的可靠性。
2021-03-18 07:49:20
``揭秘切割晶圓過程——晶圓就是這樣切割而成芯片就是由這些晶圓切割而成。但是究竟“晶圓”長什么樣子,切割晶圓又是怎么一回事,切割之后的芯片有哪些具體應用,這些可能對于大多數非專業人士來說并不是十分
2011-12-01 15:02:42
深愛半導體推出新品IPM模塊
IPM(Intelligent Power Module,智能功率模塊) 是集成了功率器件、驅動電路、保護功能的“系統級”功率半導體方案。其高度集成方案可縮減 PCB
2025-07-23 14:36:03
看到了晶圓切割的一個流程,但是用什么工具切割晶圓?求大蝦指教啊 ?
2011-12-01 15:47:14
%),接著是將這些純硅制成長硅晶棒,成為制造積體電路的石英半導體的材料,經過照相制版,研磨,拋光,切片等程序,將多晶硅融解拉出單晶硅晶棒,然后切割成一片一片薄薄的晶圓。我們會聽到幾寸的晶圓廠,如果硅晶圓的直徑
2011-12-02 14:30:44
; 2010年1月3日,蘇州天弘激光股份有限公司推出了新一代激光晶圓劃片機,該激光劃片機應用于硅晶圓、玻璃披覆(玻鈍)二極管等半導體晶圓的劃片和切割,技術領先于國內
2010-01-13 17:18:57
非常細小的切口,從而能夠在有限面積的晶圓上面切割出更多LED單體。激光刻劃對砷化鎵(GaAS)以及其他脆性化合物半導體晶圓材料尤為擅長。激光加工LED晶圓,典型的刻劃深度為襯底厚度的1/3到1/2這樣
2011-12-01 11:48:46
氧化鋯基氧化鋁 - 半導體晶圓研磨粉 (AZ) 系列半導體晶圓研磨粉是一種細粉磨料,是作為需要高精度的包裹材料而開發的。原材料粒度分布尖銳,粒度穩定,形狀呈塊狀。再以熔融氧化鋁為原料,鋯英
2022-05-31 14:21:38
半導體大規模生產過程中需要在晶圓上沉積集成電路芯片,然后再分割成各個單元,最后再進行封裝和焊接,因此對晶圓切割槽尺寸進行精準控制和測量,是生產工藝中至關重要的環節。
2023-04-28 17:41:49
中圖儀器WD4000半導體晶圓wafer厚度測量設備通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度,TTV,BOW、WARP、在高效測量測同時有效防止晶圓產生劃痕缺陷
2024-09-06 16:52:43
WD4000半導體晶圓量測設備采用高精度光譜共焦傳感技術、光干涉雙向掃描技術,完成非接觸式掃描并建立3D Mapping圖,實現晶圓厚度、TTV、LTV、Bow、Warp、TIR、SORI、等反應
2024-09-09 16:30:06
中圖儀器WD4000半導體晶圓幾何形貌量測設備兼容不同材質不同粗糙度、可測量大翹曲wafer、測量晶圓雙面數據更準確。它通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度
2024-09-29 16:54:10
WD4000半導體晶圓幾何表面形貌檢測設備兼容不同材質不同粗糙度、可測量大翹曲wafer、測量晶圓雙面數據更準確。它通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度
2025-01-06 14:34:08
中圖儀器WD4000系列半導體晶圓表面形貌量測設備通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度,TTV,BOW、WARP、在高效測量測同時有效防止晶圓產生劃痕缺陷
2025-04-21 10:49:55
由大族顯視與半導體自主研發的國內首臺柔性OLED激光切割設備在深圳柔宇科技正式投產。此款設備的順利投產是大族顯視與半導體在面板激光設備制造發展歷程上的又一重要里程碑,標志著“大族智造”國產柔性OLED激光切割設備成功取得實績,并助推柔性顯示技術的發展。
2018-06-25 15:45:00 1501
1501 大族激光是世界主要的激光加工設備生產廠商之一,國內激光設備占有率第一位。大族激光為國內外客戶提供一整套激光加工解決方案及相關配套設施,主要產品包括:激光打標機系列、激光焊接機系列、激光切割機系列、高
2018-06-15 09:40:00 1525
1525 大族激光PCB事業部傾力參與此次盛會,展出的大臺面激光直接成像系統LDI -E25L、UV激光切割成型機UV MAKERD650A、手臂式四線精密測試機MH300FW,分別為大拼板設計、精密尺寸要求
2018-11-02 17:23:32 3652
3652 晶圓(wafer) 是制造半導體器件的基礎性原材料。 極高純度的半導體經過拉晶、切片等工序制備成為晶圓,晶圓經過一系列半導體制造工藝形成極微小的電路結構,再經切割、封裝、測試成為芯片,廣泛應用到各類電子設備當中。
2018-12-29 08:50:56 28480
28480 
乘著“一帶一路”的春風,大族超能激光切割設備落戶新疆喀什地區。近日,大族超能一臺型號為MPS-4020D的光纖激光切割機落戶“一帶一路”中心區域——新疆喀什地區,這是大族超能在該區域交付的首臺中功率
2019-09-27 15:35:02 6527
6527 5月18日,中國長城官微表示,我國首臺半導體激光隱形晶圓切割機于近日研制成功,填補國內空白,在關鍵性能參數上處于國際領先。我國半導體激光隱形晶圓切割技術取得實質性重大突破,相關裝備依賴進口的局面將打破。
2020-05-19 15:58:51 5767
5767 近日,在中國長城科技集團股份有限公司旗下鄭州軌道交通信息技術研究院和河南通用智能裝備有限公司科研人員奮勇攻關、共同努力下,首臺半導體激光隱形晶圓切割機研制成功,填補國內空白,在關鍵性能參數上處于國際領先水平。我國半導體激光隱形晶圓切割技術取得實質性重大突破,相關裝備依賴進口的局面即將打破。
2020-05-28 15:32:23 970
970 激光隱形切割作為激光切割晶圓的一種方案,很好的避免了砂輪劃片存在的問題。如圖1所示,激光隱形切割是通過將脈沖激光的單個脈沖通過光學整形
2020-06-01 09:38:23 9732
9732 中國長城科技集團股份有限近日傳出好消息,旗下鄭州軌道交通信息技術研究院攜手河南通用智能裝備有限公公司,歷時1年成功研制出一臺半導體激光隱形晶圓切割機。 國產替代和自主可控一直都是國民高度關注
2020-06-29 08:07:50 1160
1160 晶圓切割機廣泛應用于光伏及半導體領域,日本DISCO公司是全球第一大供應商。在55nm以下的芯片工藝制程中,采用傳統晶圓切割技術對晶圓進行封裝時,容易導致晶體破碎;
2020-07-20 16:22:09 7109
7109 傳統刀片切割(劃片)原理——撞擊機械切割(劃片)是機械力直接作用于晶圓表面,在晶體內部產生應力操作,容易產生晶圓崩邊及晶片破損。由于刀片具有一定的厚度,由此刀具的切割(劃片)線寬較大。鉆石鋸片切割(劃片)能夠達到的最小切割線寬度一般在25-35μm之間
2020-12-24 12:38:27 4149
4149 晶圓切割(即劃片)是芯片制造工藝流程中一道不可或缺的工序,在晶圓制造中屬于后道工序。晶圓切割就是將做好芯片的整片晶圓按芯片大小分割成單一的芯片(晶粒)。最早的晶圓是用切片系統進行切割(劃片)的,這種方法以往占據了世界芯片切割市場的較大份額,特別是在非集成電路晶圓切割領域
2020-12-24 12:38:37 20276
20276 制造工藝形成微小的電路結構,再經過切割、封裝、測試等工序制成芯片,廣泛應用于各種電子設備中。 ADI晶圓半導體的優點是:高電子遷移率;高頻特性;寬帶寬;高線性度;高功率;材料選擇的多樣性和抗輻射性。 ADI又名亞德諾半導體,
2021-11-11 16:16:41 2313
2313 SiC晶圓由碳化硅制成,碳化硅是通過高溫加熱二氧化硅和碳制成的人造化合物。SiC晶圓用于功率半導體,因為它們具有高硬度,高耐壓和高耐熱性的特點。由于最近電動汽車市場的增長和5G服務的普及,對功率半導體的需求正在增加。
2021-03-05 11:58:11 2436
2436 半導體晶圓冷卻裝置在長時間的使用過程中,也需要對半導體晶圓冷卻裝置進行必要的檢查和維護保養,定期維護有利于半導體晶圓冷卻裝置制冷效率,同時也有利于延長壽命。
2021-04-04 16:17:00 2577
2577 意法半導體總裁兼首席執行官 Jean-Marc Chery 表示:“此次最新的擴大與科銳的長期晶圓供應協議,將繼續提高我們全球 SiC 襯底供應的靈活性。
2021-08-20 17:08:14 1660
1660 
1 晶圓切割 晶圓切割的方法有許多種,常見的有砂輪切割,比如disco的設備;激光切割、劃刀劈裂法,也有金剛線切割等等。 這個就是砂輪切割,一般就是切穿晶圓,刀片根據產品選擇,有鋼刀、樹脂刀等等
2021-11-02 16:41:52 12325
12325 
隨著厚度的不斷減薄,晶圓會變得更為脆弱,因此機械劃片的破片率大幅增加,而此階段晶圓價格昂貴,百分之幾的破片率就足以使利潤全無。另外,當成品晶圓覆蓋金屬薄層時,問題會變得更加復雜,金屬碎屑會包裹
2022-12-08 14:25:53 9688
9688 半導體集成電路是將許多元件集成到一個芯片中以處理和存儲各種功能的電子組件。由于半導體集成電路是通過在晶圓的薄基板上制造多個相同電路而產生的,因此晶圓是半導體的基礎,就像制作披薩時添加配料之前先做面團一樣。
2023-01-11 10:28:01 6502
6502 隨著厚度的不斷減薄,晶圓會變得更為脆弱,因此機械劃片的破片率大幅增加,而此階段晶圓價格昂貴,百分之幾的破片率就足以使利潤全無。另外,當成品晶圓覆蓋金屬薄層時,問題會變得更加復雜,金屬碎屑會包裹
2023-02-14 08:49:52 1799
1799 半導體晶圓清洗設備市場預計將達到129\.1億美元。到 2029 年。晶圓清洗是在不影響半導體表面質量的情況下去除顆粒或污染物的過程。器件表面晶圓上的污染物和顆粒雜質對器件的性能和可靠性有重大影響。本報告側重于半導體晶圓清洗設備市場的不同部分(產品、晶圓尺寸、技術、操作模式、應用和區域)。
2023-04-03 09:47:51 3427
3427 
本文介紹了激光在碳化硅(SiC)半導體晶圓制程中的應用,概括講述了激光與碳化硅相互作用的機理,并重點對碳化硅晶圓激光標記、背金激光表切去除、晶粒隱切分片的應用進行了介紹。
2023-04-23 09:58:27 2334
2334 
晶圓切割原理及目的:晶圓切割的目的主要是切割和分離晶圓上的每個芯片。首先在晶圓背面粘上一層膠帶,然后送入晶圓切割機進行切割。切割后,模具將有序排列并粘附在膠帶上。同時,框架的支撐可以防止因膠帶起皺而
2021-12-02 11:20:17 3039
3039 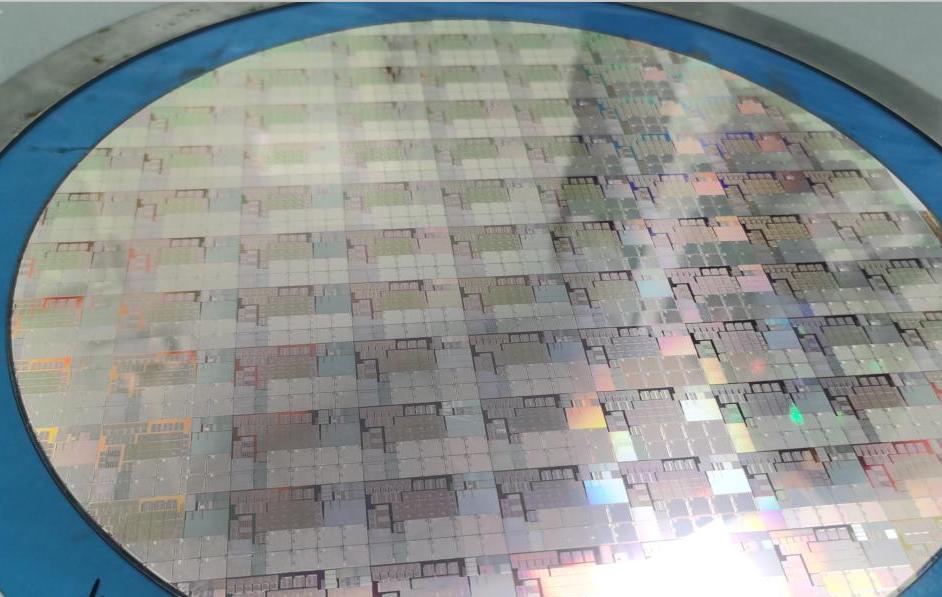
晶圓劃片機主要用于切割半導體晶圓、集成電路、QFN、發光二極管、LED芯片、太陽能電池、電子基板等。適用于硅、石英、氧化鋁、氧化鐵、砷化鎵、鈮酸鋰、藍寶石、玻璃等材料。其工作原理是通過空氣靜壓主軸
2021-12-23 14:01:57 2124
2124 
一、精密劃片機行業介紹劃片機是使用刀片或通過激光等方式高精度切割被加工物的裝置,是半導體后道封測中晶圓切割和WLP切割環節的關鍵設備。隨著集成電路沿大規模方向發展,劃片工藝呈現愈發精細化、高效化
2022-05-26 11:35:50 3634
3634 
1晶圓切割晶圓切割機的方法有許多種,常見的有砂輪切割,比如陸芯半導體的設備;激光切割、劃刀劈裂法,也有金剛線切割等等。這個就是砂輪切割,一般就是切穿晶圓,刀片根據產品選擇,有鋼刀、樹脂刀等等。但是
2022-02-20 08:00:00 2437
2437 
半導體晶圓切割機主軸采用空氣靜壓支承的電主軸。現在所使用的主軸有兩類:分別是交流主軸,及直流主軸。
2021-12-17 16:06:09 2423
2423 
切割機主要用于封裝環節,是將含有很多芯片的wafer晶圓分割成一個一個晶片顆粒的設備,例如用于LED晶片的分割,形成LED芯粒。精密劃片機目前以砂輪機械切割為主,激光
2022-04-29 14:24:09 2357
2357 
使用激光切割,激光切割可以減少剝落和裂紋的問題,但是在100um以上時,生產效率將大大降低;厚度不到30um的晶圓則使用等離子切割,等離子切割速度快,不會對晶圓表面造成
2022-10-08 16:02:44 16400
16400 
VT6000共聚焦顯微鏡廣泛應用于半導體制造及封裝工藝,能夠對具有復雜形狀和陡峭的激光切割槽的表面特征進行非接觸式掃描并重建三維形貌。清晰的成像系統能細致觀察晶圓表面是否出現崩邊、刮痕等缺陷。
2023-04-28 09:19:55 1903
1903 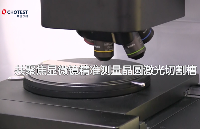
晶圓切割是半導體制造中的關鍵環節之一。提升晶圓工藝制程需要綜合考慮多個方面,包括切割效率、切割質量、設備性能等。針對這些問題,國產半導體劃片機解決方案可以提供一些幫助。首先,在切割效率方面,國產
2023-06-05 15:30:44 20195
20195 
SiC襯底切割是將晶棒切割為晶片,切割方式有內圓和外圓兩種。由于SiC價格高,外圓、內圓刀片厚度較大,切割損耗高、生產效率低,加大了襯底的成本。
2023-06-25 17:34:24 5408
5408 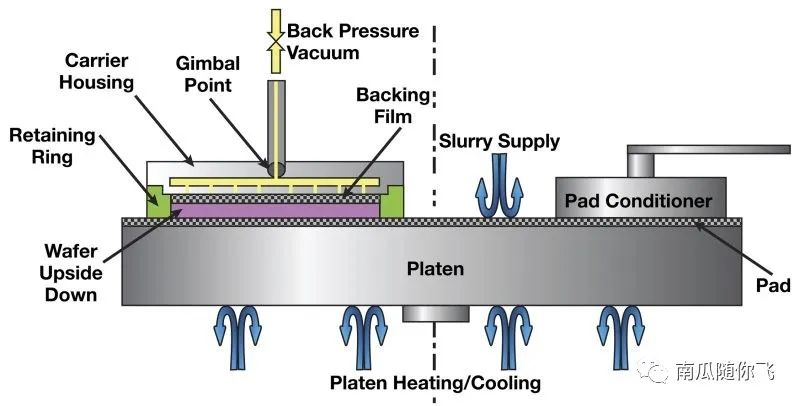
據華工激光半導體產品總監黃偉介紹,晶圓機械切割的熱影響和崩邊寬度約 20 微米,傳統激光在 10 微米左右,而經過一年努力,華工科技的半導體晶圓切割技術成功實現升級,熱影響降為 0,崩邊尺寸降至 5 微米以內,切割線寬可做到 10 微米以內。
2023-07-12 09:58:30 1014
1014 一個晶圓要經歷三次的變化過程,才能成為一個真正的半導體芯片:首先,是將塊兒狀的鑄錠切成晶圓;在第二道工序中,通過前道工序要在晶圓的正面雕刻晶體管;最后,再進行封裝,即通過切割過程,使晶圓成為一個完整
2023-07-14 11:20:35 2603
2603 
“半導體晶圓屬于硬脆材料,在一個12英寸的晶圓上有數千顆甚至數萬顆芯片,晶圓切割和芯片分離無論采取機械或激光方式,都會因物質接觸和高速運動而產生熱影響和崩邊,從而影響芯片性能,因此,控制熱影響的擴散范圍和崩邊尺寸是關鍵。”
2023-07-14 16:33:41 1329
1329 半導體晶圓的厚度測量在現代科技領域具有重要地位。在晶圓制造完成后,晶圓測試是評估制造過程的關鍵環節,其結果直接反映了晶圓的質量。這個過程中,每個芯片的電性能和電路機能都受到了嚴格的檢驗。
2023-08-16 11:10:17 1852
1852 
晶圓劃片機是一種用于將半導體晶圓切割成小尺寸芯片的設備。它在半導體制造過程中起著關鍵的作用。
2023-08-21 09:40:31 2556
2556 
顯微檢測設備,廣泛應用于半導體制造及封裝工藝,能夠對具有復雜形狀和陡峭的激光切割槽的表面特征進行非接觸式掃描并重建三維形貌。共聚焦顯微鏡重建晶圓激光切割槽三維形貌,精準檢測輪廓尺寸VT6000系列共聚焦
2023-05-09 14:12:38 3186
3186 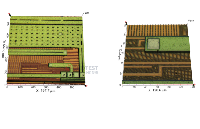
半導體制造及封裝工藝,能夠對具有復雜形狀和陡峭的激光切割槽的表面特征進行非接觸式掃描并重建三維形貌。VT6000系列共聚焦顯微鏡具有優異的光學分辨率,通過清晰的成像系統能夠細致觀察到晶圓表面的特征情況,
2023-05-09 14:08:43 0
0 10月27日,由大族激光智能裝備集團與法因數控強強聯合、共同研發的型鋼加工專機——H12560BF系列型材激光切割機重磅首發!該設備是大族激光智能裝備集團與法因數控結合兩家企業在各自領域的優勢,專為
2023-11-01 08:07:39 2397
2397 
大族半導體成功承接“十三五”規劃中的科技部重點研發計劃重點專項“超短脈沖激光隱形切割系統及應用”,以及“十四五”規劃中的科技部重點研發計劃重點專項“高品質激光剝離與解鍵合裝備開發及應用示范”。
2023-12-15 09:46:03 1693
1693 4月11日,大族激光全資子公司大族激光智能裝備集團有限公司(智能裝備集團)首臺150kW超高功率超大幅面激光切割機簽約大族激光“鐵桿老粉”——東進自動化設備有限公司,開啟全球超高功率激光切割工業應用全新時代!
2024-04-15 14:23:14 1204
1204 (以下簡稱“SiCrystal”)將擴大目前已持續多年的150mm SiC晶圓長期供應合同。 擴大后的合同約定未來數年向意法半導體供應在德國紐倫堡生產的SiC晶圓,預計合同期間的交易額將超過2.3億美元
2024-04-23 17:25:25 969
969 半導體行業中,“晶圓”和“流片”是兩個專業術語,它們代表了半導體制造過程中的兩個不同概念。
2024-05-29 18:14:25 17505
17505 集成電路生產中,晶圓切割技術至關重要。傳統切割技術難以滿足大規模生產需求,精密切割設備應運而生。德國SycoTec提供多款高速電主軸,具有高轉速、高精度、穩定性好等特點,廣泛應用于半導體晶圓切割等領域,提升切割質量和效率。
2024-06-12 14:37:32 1209
1209 
SiC晶圓片。該設備可以實現6寸和8寸SiC晶錠的全自動分片,包含晶錠上料,晶錠研磨,激光切割,晶片分離和晶片收集的全自動工藝流程,晶片拋光后的形貌可以達到LTV≤2μm,TTV≤5μm,BOW≤10μm,Warp≤20μm。 ? 圖:8英寸SiC晶錠激光全自動剝離設備 通用半
2024-07-15 15:50:04 1665
1665 
晶圓切割劃片技術作為半導體制造流程中的關鍵環節,其技術水平直接關聯到芯片的性能、良率及生產成本。
2024-11-08 10:32:59 3328
3328 
半導體晶圓片切割刃料的制備是一個復雜而精細的過程,以下是一種典型的制備方法:
一、原料準備
首先,需要準備高純度的原料,如綠碳化硅和黑碳化硅。這些原料具有高硬度、高耐磨性和高化學穩定性,是制備切割
2024-12-05 10:15:57 458
458 
,但是行業龍頭企業已經開始研發基于8英寸SiC晶圓的下一代器件和芯片。 近日,廣東天域半導體股份有限公司丁雄杰博士團隊聯合廣州南砂晶圓半導體技術有限公司、清純半導體(寧波)有限公司、芯三代半導體科技(蘇州)股份有限公司在《人工晶體學報》2
2024-12-07 10:39:36 2575
2575 
提高SiC(碳化硅)晶圓平整度是半導體制造中的一個重要環節,以下是一些提高SiC晶圓平整度的方法:
一、測量與分析
平整度檢測:首先,使用高精度的測量設備對SiC晶圓的平整度進行檢測,包括總厚度
2024-12-16 09:21:00 586
586 
隨著半導體器件的復雜性不斷提高,對精確可靠的晶圓測試解決方案的需求也從未像現在這樣高。從5G、物聯網和人工智能應用,到先進封裝和高帶寬存儲器(HBM),在晶圓級確保設備性能和產量是半導體制造過程中的關鍵步驟。
2025-02-17 13:51:16 1333
1333 高精度晶圓劃片機切割解決方案為實現高精度晶圓切割,需從設備精度、工藝穩定性、智能化控制等多維度優化,以下為關鍵實現路徑及技術支撐:一、核心精度控制技術?雙軸協同與高精度運動系統?雙工位同步切割技術
2025-03-11 17:27:52 798
798 
本文介紹了半導體集成電路制造中的晶圓制備、晶圓制造和晶圓測試三個關鍵環節。
2025-04-15 17:14:37 2165
2165 
一、引言
在半導體制造領域,晶圓切割是關鍵環節,其質量直接影響芯片性能與成品率。晶圓切割過程中,熱場、力場、流場等多物理場相互耦合,引發切割振動,嚴重影響晶圓厚度均勻性。探究多物理場耦合作用下
2025-07-07 09:43:01 600
600 
一、引言
在半導體晶圓制造流程里,晶圓切割是決定芯片質量與生產效率的重要工序。切割過程中,振動與應力的耦合效應顯著影響晶圓質量,尤其對厚度均勻性干擾嚴重。深入剖析振動 - 應力耦合效應對晶圓厚度均勻
2025-07-08 09:33:33 591
591 
一、引言
晶圓切割是半導體制造的關鍵環節,切割過程中的振動會影響晶圓表面質量與尺寸精度,而進給參數的設置對振動產生及切割效率有著重要影響。將振動監測系統與進給參數協同優化,能有效提升晶圓切割質量。但
2025-07-10 09:39:05 364
364 
預測控制原理,為實現晶圓高質量切割提供理論與技術參考。
一、引言
在半導體制造技術不斷進步的背景下,超薄晶圓的應用愈發廣泛,其切割工藝的精度要求也日益嚴苛。切割
2025-07-23 09:54:01 446
446 
切割工藝參數以實現晶圓 TTV 均勻性有效控制,為晶圓切割工藝改進提供新的思路與方法。
一、引言
在半導體晶圓切割工藝中,晶圓 TTV 均勻性是影響芯片制造質量與良
2025-07-25 10:12:24 420
420 
摘要
本論文圍繞超薄晶圓切割工藝,探討切割液性能智能調控系統與晶圓 TTV 預測模型的協同構建,闡述兩者協同在保障晶圓切割質量、提升 TTV 均勻性方面的重要意義,為半導體制造領域的工藝優化提供理論
2025-07-31 10:27:48 374
374 
晶圓切割,作為半導體工藝流程中至關重要的一環,不僅決定了芯片的物理形態,更是影響其性能和可靠性的關鍵因素。傳統的切割工藝已逐漸無法滿足日益嚴苛的工藝要求,而新興的激光切割技術以其卓越的精度和效率,為
2025-08-05 17:53:44 765
765 
經世智能半導體行業晶圓盒轉運復合機器人,復合機器人在半導體行業主要應用于晶圓盒轉運、機臺上下料等環節,通過“AGV移動底盤+協作機械臂+視覺系統"一體化控制方案實現高效自動化
2025-08-13 16:07:34 1853
1853 
在半導體制造中,晶圓切割是決定芯片良率的關鍵一步。面對切割道檢測中的重重挑戰,如何實現精準定位與高效檢測?本文將深入解析高低雙倍率視覺系統的創新解決方案,助您攻克技術難點,切實提升生產效能。
2025-11-25 16:54:12 703
703 
、高效率的切割解決方案,成為行業關注的焦點。精準切割的核心邏輯:技術原理通俗解析半導體切割的本質是將整片晶圓或基板“按需分割”為獨立芯片單元,既要保證切割精度,又要
2025-12-17 17:17:46 1051
1051 
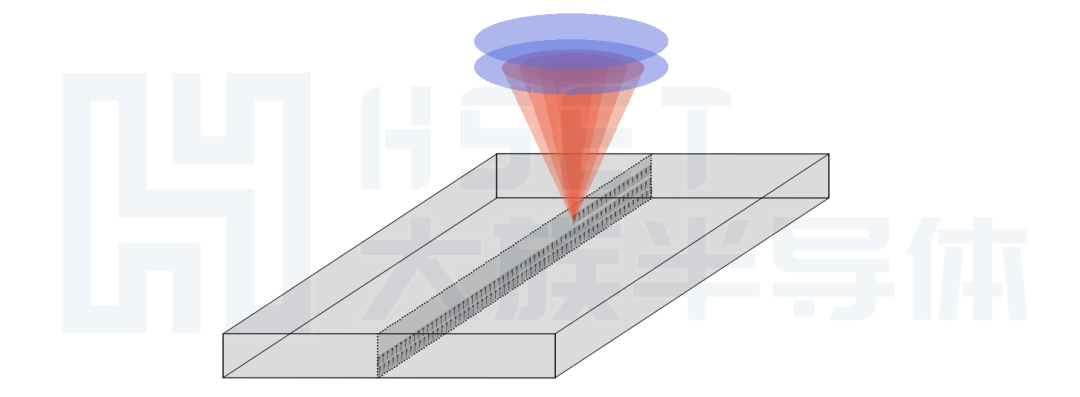

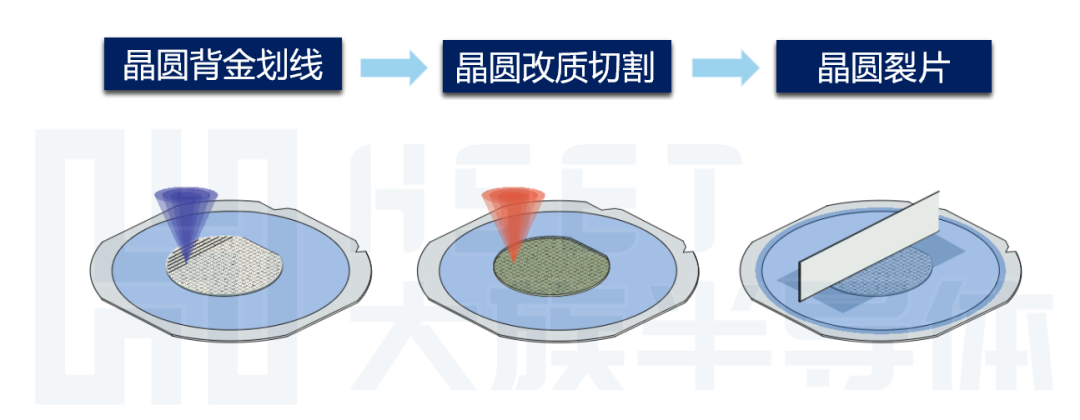


 電子發燒友App
電子發燒友App









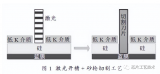




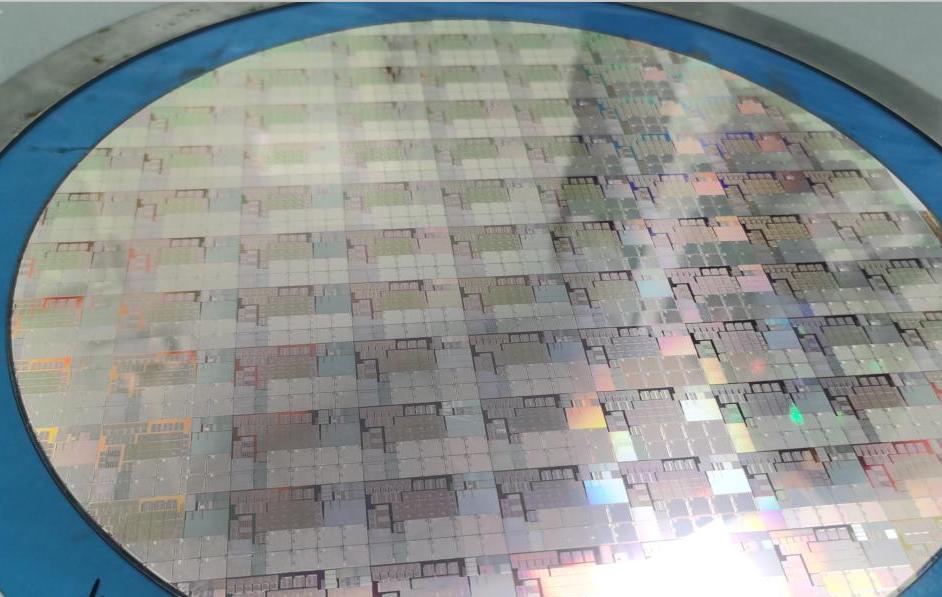






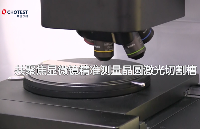

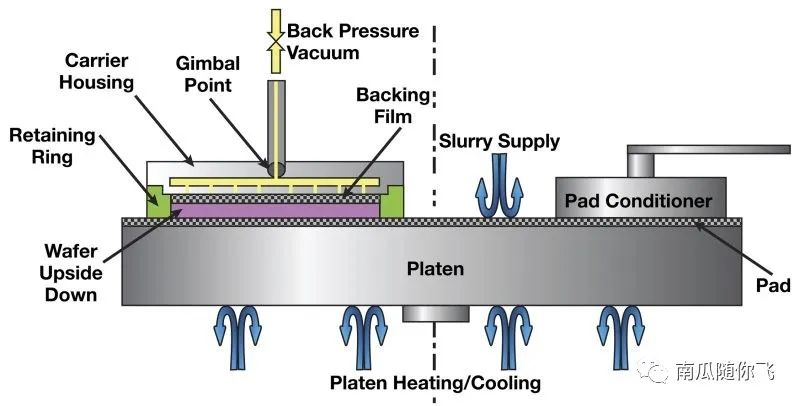



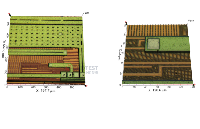


















評論