Chip First工藝
自從Fan-Out封裝問世以來,經過多年的技術發展,扇出式封裝已經形成了多種封裝流程、封裝結構以適應不同產品需要,根據工藝流程,可以分為先貼芯片后加工RDL的Chip First工藝和先制作RDL后貼裝芯片的Chip Last工藝兩大類,其中,結構最簡單的是采用Chip First工藝的eWLB,
其工藝流程如下:
1
將切割好的芯片Pad面向下粘貼在帶臨時鍵合膠的載片上;
2
從芯片背面對載片進行灌膠塑封;
3
移除臨時載片形成塑封后的二次晶圓(扇出式晶圓);
4
去除Pad上的殘留膠并在Pad面形成RDL層;
5
在RDL層上植球并切割成單個成品。
此技術的優勢是制程相對簡單,成本優勢明顯。但由于移除載片后,扇出晶圓的翹曲難以控制,對RDL線路的生長技術提出了挑戰,難以制作高密度的RDL,因此該技術主要應用于布線密度較低的中低端的產品。
真正讓Chip First扇出式封裝成為行業熱點的原因無疑是因為臺積電(TSMC)在2016年在I-phone7中使用了InFOTM結構。
其工藝流程如下:
1
在晶圓Pad上制作一層預制銅柱;
2
將切割好的芯片Pad面向上粘貼在帶臨時鍵合膠的載片上;
3
對載片進行灌膠塑封;
4
對塑封好的扇出晶圓進行研磨,露出預制銅柱的頂部;
5
在預制銅柱的頂部進一步制作RDL及植球移除載片;
6
將完成植球的扇出式晶圓切割成單個成品。
該技術由于布線工藝在載片上完成,沒有翹曲等因素的影響,因而能夠實現高密度布線,同時整體封裝厚度也能控制的很低,多應用在高端手機處理器等高價值芯片上。缺點是工藝控制要求高,而且RDL良率直接會影響到芯片成品率,因此最終成品價格較高。
以上方式都是先貼芯片后制作RDL的工藝,所以稱為Chip-First工藝,如果先制作RDL,然后在RDL上貼裝芯片,便稱為Chip-Last工藝。此工藝需要在RDL上倒裝植球后的芯片,通常適用于空間要求略高的FcBGA產品,但由于只在檢驗合格的RDL上貼裝芯片,可避免RDL工程良率給芯片帶來的損失,因此對于價格昂貴的高端芯片而言,有較明顯的價格優勢。
長電科技Chip Last工藝
長電科技2021年7月正式推出了一款使用Chip-Last封裝工藝的高密度扇出式封裝 — XDFOITM-FcBGA-H。
其工藝流程如下:
1
在帶臨時鍵合膠的載片上制作RDL線路層;
2
倒裝焊接上已植球切割好的芯片;
3
芯片底部焊接區域進行底部填充,再對整張貼好芯片的基板進行整體塑封;
4
移除載片并在圓片底部形成Bump;
5
對此整個扇出式原片進行研磨與切割后形成XDFOITM Fan-Out Unit顆粒;
6
將Fan-Out Unit倒裝封裝在基板上并進行底部填充;
7
貼裝散熱蓋及植球,最終形成XDFOITM-FcBGA-H封裝。
此技術的優點在于:避免了RDL良率造成的芯片損失,具有更高的成本競爭力,且直接在載片上布線RDL,簡化了工藝。另外RDL的布線間距也可以達到2um水準,大大提高布線密度,能滿足高性能產品封裝需求。
Fan-Out封裝發展趨勢
隨著Chip-Let技術會越來越得到半導體業界的重視,封裝技術的發展已經成為了半導體行業發展的重要支點,而先進高密度Fan-Out封裝也必然是發展中的熱點。
根據目前的發展趨勢看,Fan-Out封裝主要有以下幾個發展趨勢:
01|高密度布線
根據行業發展預測,下一代Fan-Out技術RDL的布線間距將達到1um以下,這將對RDL布線技術的發展提出進一步挑戰。
02|產品大型化
由于突破了單個硅芯片限制, 多Die合封的封裝單元尺寸很容易突破原有單顆硅芯片常規上限(通常為830mm2)的限制,各大OSAT的合封單元目標都在1500mm2以上,有的面積甚至將達到2500mm2,這對封裝工藝以及封裝材料開發提出了巨大的挑戰。
03|封裝結構復雜化
在Chip-Let技術發展路線圖中,芯片互聯種類越來越復雜,不僅有RDL互聯,還有硅基板Interposer互聯,橋接芯片互聯等封裝方式都在快速發展中。封裝模式的多元化對制程能力開發也提出了更高的要求。
臺積電、Intel、Samsung等國際頂尖半導體公司都已成功進軍先進封裝市場。各大先進半導體公司都確立發展高密度扇出式封裝為技術戰略方向。值此變革之時,長電科技緊跟時代潮流,在先進封裝上積極投入,率先在國內開發出了自己的先進高密度Fan-Out封裝。長電科技不但要在國內企業中保持技術領先優勢,還要進一步開拓進取,繼續在先進封裝上加大研發力度,力爭在后摩爾時代的半導體技術開發的國際競爭中占得先機。
責任編輯:haq
-
芯片
+關注
關注
463文章
54010瀏覽量
466012 -
封裝
+關注
關注
128文章
9249瀏覽量
148616 -
長電科技
+關注
關注
5文章
394瀏覽量
33485
原文標題:先進高性能計算芯片中的扇出式封裝(下篇)
文章出處:【微信號:gh_0837f8870e15,微信公眾號:長電科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
等離子清洗機的工藝流程是什么樣的呢?
激光焊接機在焊接儀表外殼的工藝流程
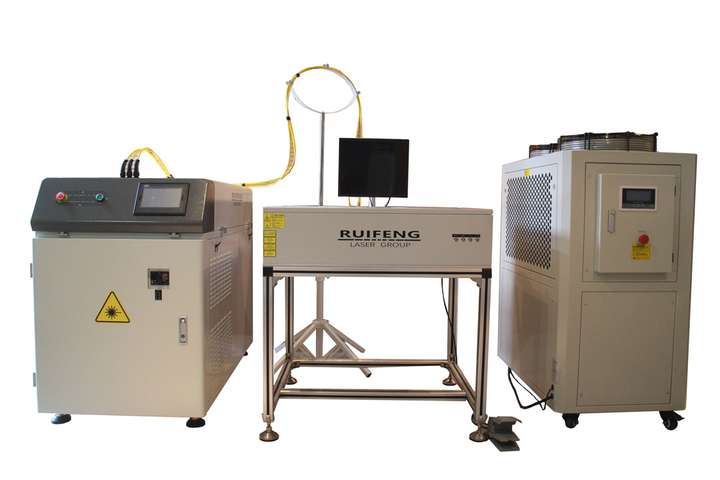
激光焊接機在焊接鋸片的工藝流程

晶圓級扇出型封裝的三大核心工藝流程

激光焊接機在焊接壓力腔組件的工藝流程
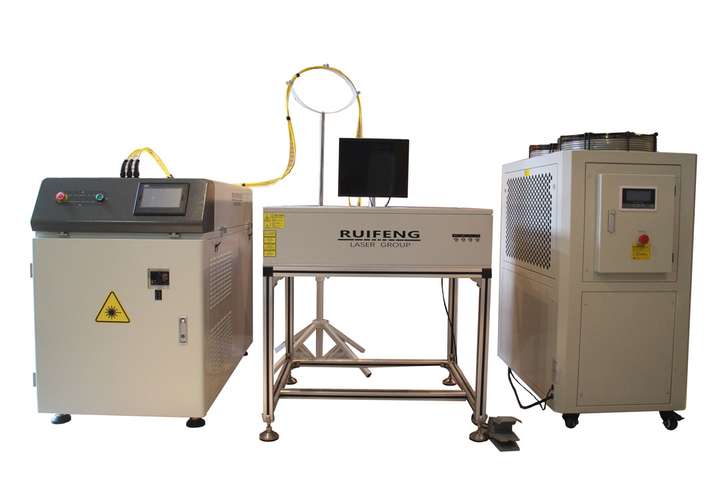
激光焊接機在焊接過濾器的工藝流程
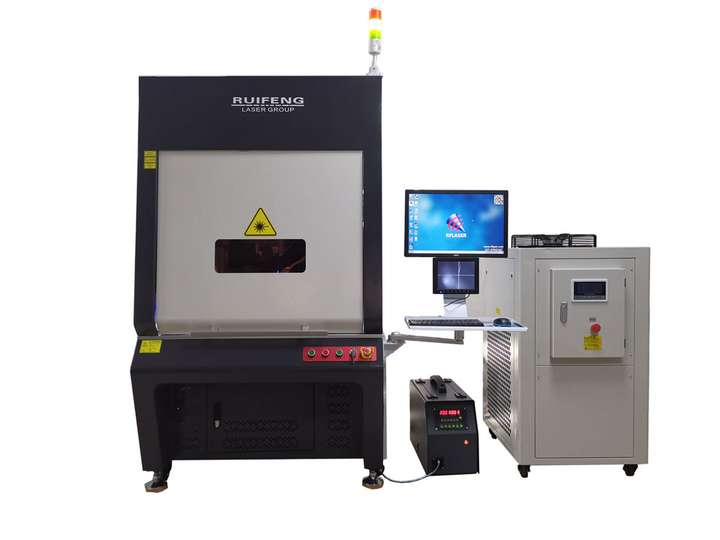
激光焊接機在焊接儲液器的工藝流程

激光焊接機在焊接電加熱管的工藝流程

晶圓蝕刻擴散工藝流程

扇出型晶圓級封裝技術的工藝流程

半導體封裝工藝流程的主要步驟

貼片電容生產工藝流程有哪些?




 扇出式封裝的工藝流程
扇出式封裝的工藝流程






評論