通過逐步的說明,本系列說明并向您展示了確保在當今最先進的節點中確保布局保真度所需的自對準模式創建的復雜性。第1部分介紹了SADP和SAQP。在本期的最后一部分中,我們將向您介紹自對準光刻蝕刻光刻
2021-04-11 10:54:14 12996
12996 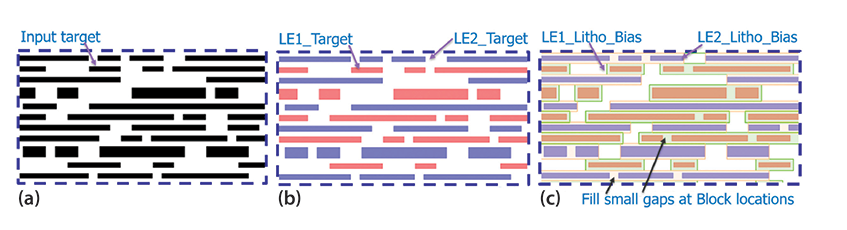
掩模版(Photomask)又稱光罩、光掩模、光刻掩模版、掩膜版、掩膜板等,是光刻工藝中關鍵部件之一,是下游行業產品制造過程中的圖形“底片”轉移用的高精密工具
2023-12-25 11:41:13 80529
80529 
`集成電路(IC)光掩模,又稱光罩、掩膜版、光刻掩膜版、掩模版等,是下游行業產品制造過程中的圖形“底片”轉移用的高精密工具,是承載圖形設計和工藝技術等知識產權信息的載體。掩膜版用于下游電子元器件
2019-12-10 17:18:10
300~500nmKrF:波長248.8nmArF:波長193nm衍射效應對光刻圖案的影響左圖是理想的光強分布,由于光的衍射效應,實際的光強分布如右圖所示。當光的波長與mask的特征尺寸可比時,會產生明顯的衍射效應。如上圖所示,透過mask的光相互疊加,使得不該受到光照的區域被曝光。
2014-09-26 10:35:02
光刻圖形轉化軟件可以將gds格式或者gerber格式等半導體通用格式的圖紙轉換成如bmp或者tiff格式進行掩模版加工制造,在掩膜加工領域或者無掩膜光刻領域不可或缺,在業內也被稱為矢量圖形光柵化軟件
2025-05-02 12:42:10
,對準精度的提高也受到較多的限制。一般認為,接觸式曝光只適于分立元件和中、小規模集成電路的生產。 非接觸式曝光主要指投影曝光。在投影曝光系統中,掩膜圖形經光學系統成像在感光層上,掩模與晶片上的感光膠
2012-01-12 10:51:59
,之后經過物鏡投射到曝光臺,這里放的就是8寸或者12英寸晶圓,上面涂抹了光刻膠,具有光敏感性,紫外光就會在晶圓上蝕刻出電路。 而激光器負責光源產生,而光源對制程工藝是決定性影響的,隨著半導體工業節點
2020-07-07 14:22:55
芯片制造流程其實是多道工序將各種特性的材料打磨成形,經循環往復百次后,在晶圓上“刻”出各種電子特性的區域,最后形成數十億個晶體管并被組合成電子元件。那光刻,整個流程中的一個重要步驟,其實并沒有
2020-09-02 17:38:07
SU-8光刻膠 SU-8光刻膠克服了普通光刻膠采用UV光刻深寬比不足的問題,在近紫外光(365nm-400nm)范圍內光吸收度很低,且整個光刻膠層所獲得的曝光量均勻一致,可得到具有垂直側壁和高深寬比
2018-07-12 11:57:08
(電子科技大學 微電子與固體電子學院,成都 610054)摘 要:光刻膠技術是曝光技術中重要的組成部分,高性能的曝光工具需要有與之相配套的高性能的光刻膠才能真正獲得高分辨率的加工能力。主要圍繞光刻
2018-08-23 11:56:31
光刻膠也稱為光致抗蝕劑,是一種光敏材料,它受到光照后特性會發生改變。光刻膠主要用來將光刻掩膜版上的圖形轉移到晶圓片上。光刻膠有正膠和負膠之分。正膠經過曝光后,受到光照的部分變得容易溶解,經過顯影后被
2019-11-07 09:00:18
這是我的版圖一部分,然后生成了圖案是這樣的: 感覺間距小的地方全都有殘留,間距大的地方沒有殘留;工藝參數:s9920光刻膠, evg 620‘未進行蒸汽底漆層涂覆,前烘:100攝氏度,90s
2016-11-29 14:59:18
在本示例中,模擬了衰減相移掩模。該掩模將線/空間圖案成像到光刻膠中。掩模的單元格如下圖所示:掩模的基板被具有兩個開口的吸收材料所覆蓋。在其中一個開口的下方,位于相移區域。 由于這個例子是所謂的一維
2021-10-22 09:20:17
在本示例中,模擬了衰減相移掩模。 該掩模將線/空間圖案成像到光刻膠中。 掩模的單元格如下圖所示:
掩模的基板被具有兩個開口的吸收材料所覆蓋。在其中一個開口的下方,位于相移區域。
由于這個例子是所謂
2025-03-12 09:48:30
感光膠,然后通過激光光刻或菲林拷貝制作掩模圖形。同傳統的菲林底版,玻璃干版和氧化鐵版相比,鉻板具有線條精細,邊緣銳利,刻蝕均勻,加工簡單,抗環境變化,硬度高抗劃傷,經久耐用等許多優點。由于LCD生產
2018-11-22 15:45:58
后,將負光掩模與涂覆晶片接觸并在汞燈的紫外輻射劑量10-250mJ/㎝2條件下進行曝光。曝光結束后,選擇合適的烘烤溫度及時間。將晶片在顯影液中浸漬顯影,隨后用氮氣吹干。SU-8光刻膠的優點:1
2018-07-04 14:42:34
,分別用針刷和無紡布研磨,火山灰,噴砂這些預處理。在研磨板之后進行焊接掩模工藝。焊接橋測試膜用于在對準期間進行焊接曝光。開發和固化后的PCB根據不同的方法進行比較和測試。1) 3M膠帶的拉伸試驗是在用
2019-08-20 16:29:49
摘要
在傳統的 Talbot 光刻中,在光敏層中僅使用一個圖像。 但是,可以使用特殊的相位掩模以深度方式生成相位掩模的兩個圖像。 在本案例中,按照 I.-H. Lee 等人在 VirtualLab
2025-02-26 08:54:28
lithography是一種平板印刷技術,在平面光波回路的制作中一直發揮著重要的作用。具體過程如下:首先在二氧化硅為主要成分的芯層材料上面,淀積一層光刻膠;使用掩模版對光刻膠曝光固化,并在
2018-08-24 16:39:21
,三合一工藝平臺,CMOS圖像傳感器工藝平臺,微電機系統工藝平臺。 光掩模版:基板,不透光材料 光刻膠:感光樹脂,增感劑,溶劑。 正性和負性。 光刻工藝: 涂光刻膠。掩模版向下曝光。定影和后烘固化蝕刻
2025-03-27 16:38:20
(DUV系統的透鏡)將掩模版上設計好的電路圖案縮小并聚焦到晶圓上的光刻膠。如之前介紹的那樣,當光線照射到光刻膠上時,會產生化學變化,將掩模版上的圖案印制到光刻膠涂層上。使曝光的圖案完全正確是一項棘手
2022-04-08 15:12:41
光刻技術中,涂有光刻膠的硅片與掩膜版直接接觸.由于光刻膠和掩膜版之間緊密接觸,因此可以得到比較高的分辨率.接觸式暴光的主要問題是容易損傷掩膜版和光刻膠.當掩膜版與硅片接觸和對準時,硅片上很小的灰塵
2012-01-12 10:56:23
可用性。圖1和圖2:B&W 800系列可變高通對準濾波器Vishay箔電阻器應用團隊提出了一項建議,以滿足電路中使用的每個電阻器的要求,以獲得正確的高通對準,使用VSH類型,為其應用提供比封裝S更高
2019-09-19 15:08:05
詳盡的聽力測試。VSH類型不僅提供最佳聲音,它們也是緊湊型設備,具有通孔可用性。圖1和圖2:B&W 800系列可變高通對準濾波器Vishay箔電阻器應用團隊提出了一項建議,以滿足電路中使用的每個電阻器
2019-04-02 16:23:12
更新所述基準標記的像素位置。兩掩模對準傳感器間距與兩基板對準傳感器間距相同。所述掩模對準傳感器和基板對準傳感器的排列方向相同,均與光刻機系統的掃描方向垂直,可以測出基板內的高階形變。所述第一標記和第二
2018-11-09 16:14:22
曝光:用紫外光(UV)通過預先制作好的電極圖形掩模版照射光刻膠表面,使被照光刻膠層發生反應,在涂有光刻膠的玻璃上覆蓋光刻掩模版在紫外燈下對光刻膠進行選擇性曝光:(如圖所示)F. 顯影:用顯影液處理玻璃
2016-06-30 09:03:48
相機曝光模式有哪幾種種類?如何設置曝光模式?
2022-03-02 09:34:48
分鐘,去除光刻膠中的溶劑。 (3)曝光 將高壓水銀燈的g線(l=436 nm), i線(l=365nm)通過掩模照射在光刻膠上,使光刻膠獲得與掩模圖形同樣的感光圖形。根據曝光時掩模的光刻膠的位置關系
2019-08-16 11:11:34
掩膜圖案的關鍵步驟。 而其中,還涉及到的材料就是光刻膠,我們要知道電路設計圖首先通過激光寫在光掩模板上,然后光源通過掩模板照射到附有光刻膠的硅片表面,引起曝光區域的光刻膠發生化學效應,再通過顯影
2020-07-07 11:36:10
151n光刻膠曝光顯影后開口底部都會有一撮殘留,找不到原因。各位幫分析下
2023-04-20 13:13:52
Straightness是獲得XY線性(重復)精度(Linear Positioning)的關鍵,是后續實現六自由度的控制的基石,是多層曝光對準精度的源頭。 SJ6000
2023-02-20 15:49:07
基于視頻共焦顯微鏡光刻對準系統設計研究王魯賓,周金運,宋超(廣東工業大學物理與光電工程學院,廣東 廣州 510006)摘要:針對目前研究的激光投影光刻機的對準需要
2009-12-17 14:47:42 15
15 掩模曝光劑量的精細控制工藝設計 胡廣榮 李文石(蘇州大學 電子信息學院 微電子學系,江蘇 蘇州 215021)摘要:本文從光學鄰近效應的機理出發, 基于區域劃分掩模特征線
2009-12-21 10:17:11 20
20 GK-1000光刻掩膜版測溫儀,光刻機曝光光學系統測溫儀光刻機是一種用于微納米加工的設備,主要用于制造集成電路、光電子器件、MEMS(微機電系統)等微細結構。光刻機是一種光學投影技術,通過將光線通過
2023-07-07 11:46:07
微機電系統(MEMS)、納米技術以及半導體市場晶圓鍵合和光刻設備領先供應商EV集團(EVG)今日宣布推出IQ Aligner NT,旨針對大容量先進封裝應用推出的全新自動掩模對準系統。IQ
2017-03-11 01:04:32 1367
1367 光刻機的工作過程是這樣的:逐一曝光完硅片上所有的場(field),亦即分步,然后更換硅片,直至曝光完所有的硅片;當對硅片進行工藝處理結束后,更換掩模,接著在硅片上曝光第二層圖形,也就是進行重復曝光
2018-01-18 11:40:45 14509
14509 
光刻是半導體芯片生產流程中最復雜、最關鍵的工藝步驟,耗時長、成本高。半導體芯片生產的難點和關鍵點在于將電路圖從掩模上轉移至硅片上,這一過程通過光刻來實現, 光刻的工藝水平直接決定芯片的制程水平和性能
2018-04-08 16:10:52 171954
171954 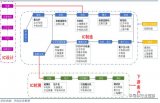
光刻機(Mask Aligner) 又名:掩模對準曝光機,曝光系統,光刻系統等。一般的光刻工藝要經歷硅片表面清洗烘干、涂底、旋涂光刻膠、軟烘、對準曝光、后烘、顯影、硬烘、刻蝕等工序。
2018-04-10 09:49:17 134949
134949 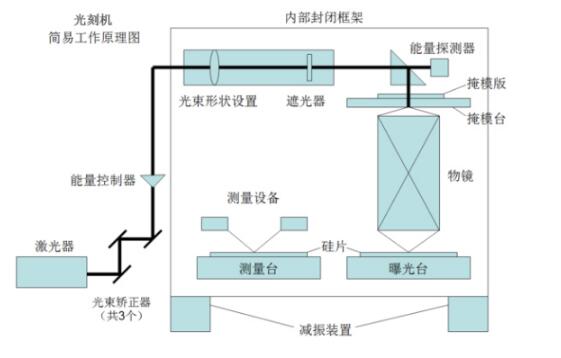
在半導體芯片制造設備中,投資最大、也是最為關鍵的是光刻機,光刻機同時也是精度與難度最高、技術最為密集、進步最快的一種系統性工程設備。光學光刻技術與其它光刻技術相比,具有生產率高、成本低、易實現高的對準和套刻精度、掩模制作相對簡單、工藝條件容易掌握等優點,一直是半導體芯片制造產業中的主流光刻技術。
2018-04-10 11:26:34 217055
217055 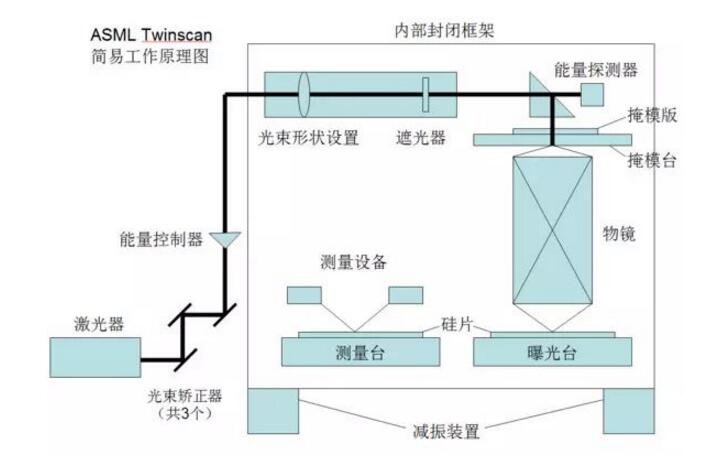
一般的光刻工藝要經歷硅片表面清洗、烘干、涂底、旋涂光刻膠、軟烘、對準曝光、后烘、顯影、硬烘、刻蝕等工序。最初的工序是用光來制作一個掩模版,然后在硅片表面均勻涂抹光刻膠,將掩模版上的圖形或者電路結構轉移復制到硅片上,然后通過光學刻蝕的方法在硅片上刻蝕出已經“復制”到硅片上的內容。
2018-05-03 15:06:13 21492
21492 
為縮短曝光光源波長、提高數值孔徑和改進曝光方式。
移相掩模
光刻分辨率取決于照明系統的部分相干性、掩模圖形空間頻率和襯比及成象系統的數值孔徑等。相移掩模技術的應用有可能用傳統
2018-06-27 15:43:50 13171
13171 ,該步驟利用曝光和顯影在光刻膠層上刻畫幾何圖形結構,然后通過刻蝕工藝將光掩模上的圖形轉移到所在襯底上。這里所說的襯底不僅包含硅晶圓,還可以是其他金屬層、介質層,例如玻璃、SOS中的藍寶石
2019-01-02 16:32:23 29613
29613 、半導體集成電路高密度/3D封裝光刻設備、TFT/OLED平板顯示器、觸摸屏、光掩模板光刻設備三大應用方向的技術實力。
2019-04-30 17:12:02 12667
12667 掩模和晶圓運動平臺上的控制致動器,以實現高精度的運動控制。可使光源以一定頻率閃爍,以便每次曝光晶圓上的不同區域。
光掩模與晶圓襯底精確對準,使得每片掩模上的圖案均可精確刻畫到已經存在的蝕刻圖形
2019-05-08 15:27:34 3275
3275 隨著半導體行業持續突破設計尺寸不斷縮小的極限,極紫外 (EUV) 光刻技術的運用逐漸擴展到大規模生產環境中。對于 7 納米及更小的高級節點,EUV 光刻技術是一種能夠簡化圖案形成工藝的支持技術。要在如此精細的尺寸下進行可靠制模,超凈的掩模必不可少。
2019-07-03 15:32:37 2675
2675 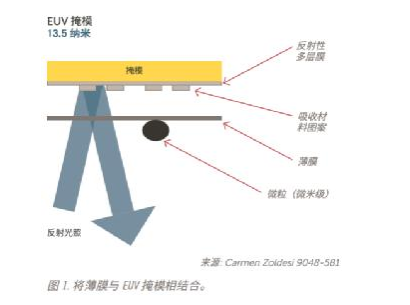
應用厚的光刻膠,并使用階梯式掩模形成圖案(A thick photoresist is applied and patterned with the stair-step mask.)。 蝕刻和收縮
2019-08-28 14:17:50 5350
5350 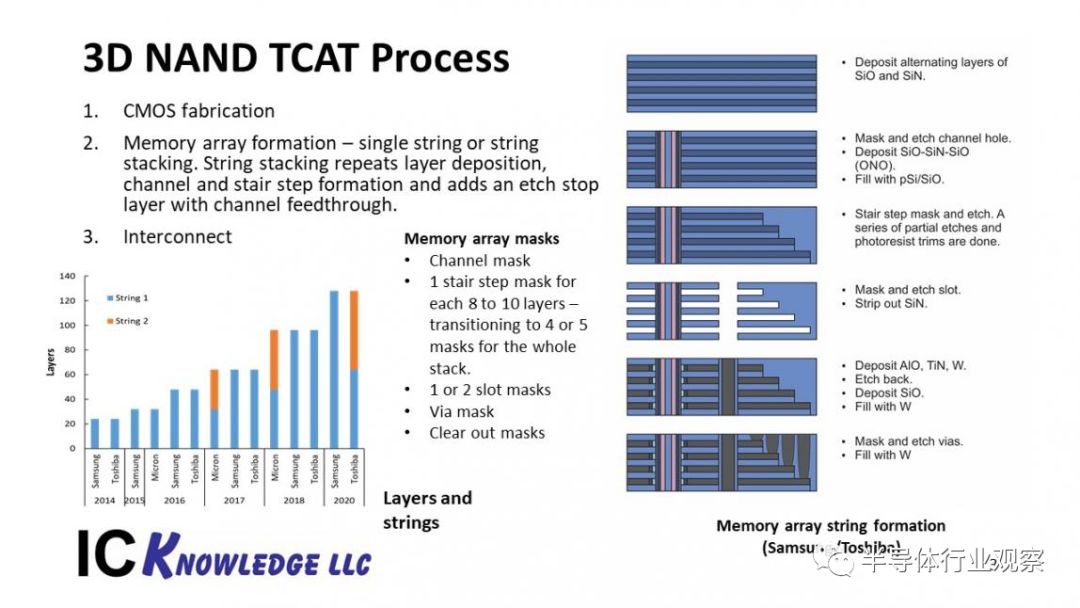
光刻膠和任何污染物在接觸印刷過程中粘附在面罩上,從而延長了面罩的曝光壽命。 EVG正在為每個掩模對準器提供技術許可。 據德國公司EVG稱,SCM掩模涂層大大延長了掩模清潔周期,但在使用過程中沒有明顯降低特征尺寸分辨率。被稱為電子視覺。這對
2020-02-14 11:06:26 2058
2058 
Aligner) 又名:掩模對準曝光機,曝光系統,光刻系統等。 光刻(Photolithography) 意思是用光來制作一個圖形(工藝);在硅片表面勻膠,然后將掩模版上的圖形轉移光刻膠上的過程將器件或電路結構臨時復制到硅片上的過程。 一般的光刻工藝要經
2020-08-28 14:39:04 15066
15066 
市場提供晶圓鍵合與光刻設備的領先供應商EV Group(EVG)今天推出LITHOSCALE無掩模曝光系統,該系統也是首個采用EV集團(EVG)革命性技術MLE(無掩膜曝光)的產品平臺。EV Group
2020-09-23 10:26:05 3693
3693 光刻機又名:掩模對準曝光機,曝光系統,光刻系統等,是制造芯片的核心裝備。它采用類似照片沖印的技術,把掩膜版上的精細圖形通過光線的曝光印制到硅片上。光刻機是半導體產業中最關鍵設備,光刻工藝決定了半導體線路的線寬,同時也決定了芯片的性能和功耗。
2020-09-30 16:17:13 6909
6909 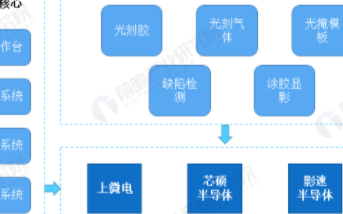
光刻機(Mask Aligner) 又名:掩模對準曝光機,曝光系統,光刻系統等,是制造芯片的核心裝備。它采用類似照片沖印的技術,把掩膜版上的精細圖形通過光線的曝光印制到硅片上。
2020-10-09 11:29:36 11493
11493 
光刻膠是由感光樹脂、增感劑和溶劑三種主要成份組成的、對光敏感的混合液體。利用光化學反應,經曝光、顯影、刻蝕等工藝將所需要的微細圖形從掩模版轉移到待加工基片上的圖形轉移介質,其中曝光是通過紫外光
2022-12-06 14:53:54 2357
2357 光刻機(Mask Aligner) 又名:掩模對準曝光機,曝光系統,光刻系統等。
2020-10-16 10:33:39 316026
316026 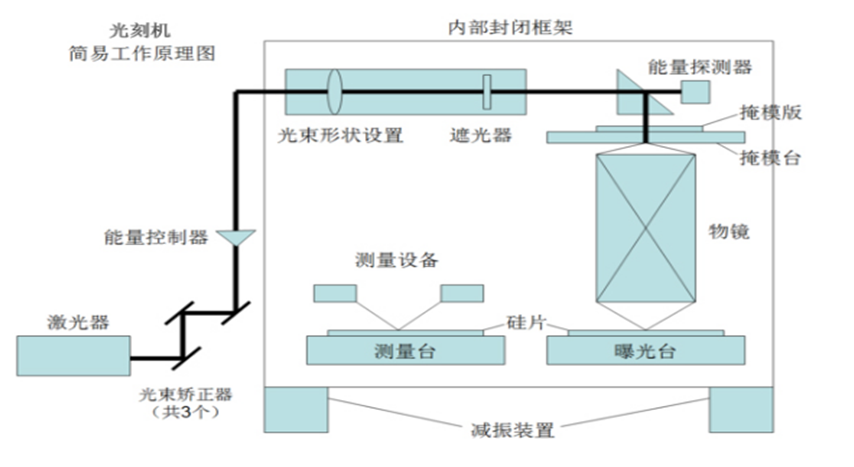
體上,三分之二的調查參與者認為這將產生積極的影響。前往EUV時,口罩的數量減少了。這是因為EUV將整個行業帶回單一模式。具有多個圖案的193nm浸入需要在高級節點處使用更多的掩模。
2020-11-23 14:42:09 1584
1584
***(Mask Aligner) 又名:掩模對準曝光機,曝光系統,光刻系統等。常用的***是掩膜對準光刻,所以叫 Mask Alignment System。一般的光刻工藝要經歷硅片表面清洗
2020-12-28 14:17:15 3559
3559
***(Mask Aligner) 又名:掩模對準曝光機,曝光系統,光刻系統等。常用的***是掩膜對準光刻,所以叫 Mask Alignment System。一般的光刻工藝要經歷硅片表面清洗
2020-12-29 09:14:54 2925
2925 ? 光刻對準技術由最初的明場和暗場對準發展到后來的干涉全息或外差干涉全息對準、混合匹配、由粗略到精細對準技術等。對準精度也由原來的微米級提高到納米級,極大促進了集成電路制造業的發展。目前的高精度光刻
2021-01-12 11:09:53 38013
38013 
光刻是集成電路工藝中的關鍵性技術。在硅片表面涂上光刻膠薄層,經過光照、顯影,在光刻膠上留下掩模版的圖形。
2021-04-09 14:27:19 64
64 極紫外光刻(EUVL)掩模壽命是要解決的關鍵挑戰之一,因為該技術正在為大批量制造做準備。反射式多層掩模體系結構對紫外線輻射高度敏感,容易受到表面氧化和污染。由于各種表面沉積過程造成的EUV標線的污染
2021-12-17 15:22:42 1649
1649 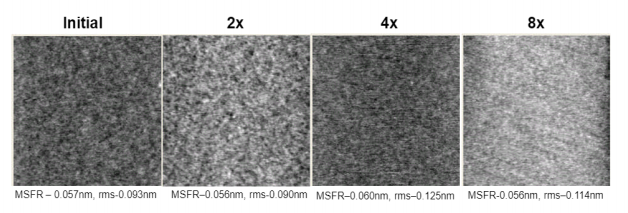
光刻機的曝光方式主要有三種,分別是接觸式曝光、非接觸式曝光和投影式曝光。
2022-01-03 17:31:00 8787
8787 口罩的透明部分傳播,使其暴露光刻膠不溶于顯影劑溶液,從而使之直接將掩模圖案轉移到晶圓上。 在定義模式之后,需要采用蝕刻工藝選擇性地去除屏蔽部分基本層。光刻曝光的性能由三個參數決定: 分辨率、注冊和吞吐量
2022-03-09 13:36:16 6355
6355 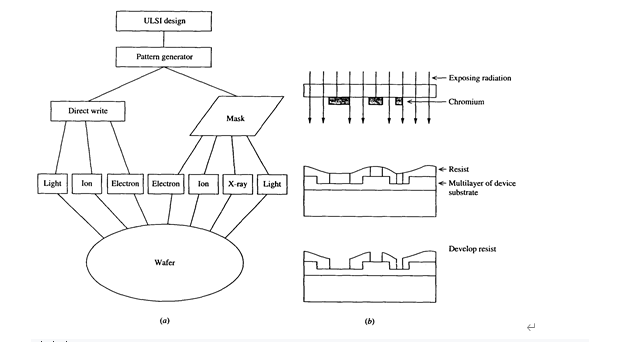
什么是光刻?光刻是將掩模上的幾何形狀轉移到硅片表面的過程。光刻工藝中涉及的步驟是晶圓清洗;阻擋層的形成;光刻膠應用;軟烤;掩模對準;曝光和顯影;和硬烤。
2022-03-15 11:38:02 1489
1489 
本文一般涉及處理光掩模的領域,具體涉及用于從光掩模上剝離光致抗蝕劑和/或清洗集成電路制造中使用的光掩模的設備和方法。
2022-04-01 14:26:37 1027
1027 
nm間距以下的特征。特別是,為了確保自對準通孔(SAV)集成,需要更厚的TiN-HM,以解決由光刻-蝕刻-光刻-蝕刻(LELE)未對準引起的通孔-金屬產量不足和TDDB問題。由于結構的高縱橫比,如果不去除厚的TiN,則Cu填充工藝明顯更加困難。此外,使用TiN硬掩模時,在線蝕刻和金屬沉積之間可
2022-06-15 16:28:16 3865
3865 
從 2D 擴展到異構集成和 3D 封裝對于提高半導體器件性能變得越來越重要。近年來,先進封裝技術的復雜性和可變性都在增加,以支持更廣泛的設備和應用。在本文中,我們研究了傳統光刻方法在先進封裝中的局限性,并評估了一種用于后端光刻的新型無掩模曝光。
2022-07-26 10:42:12 2070
2070 根據所使用的輻射,有不同類型的光刻方法用于曝光的:光刻(光刻)、電子束光刻、x射線光刻、光刻和離子束光刻。在光學光刻技術中,有部分不透明和部分不透明的圖案掩模(光片)半透明區域被使用。紫外線輻射或氣體激光的照射以1:1的比例完成或者以4:1或10:1的比例減少。
2022-07-27 16:54:53 4814
4814 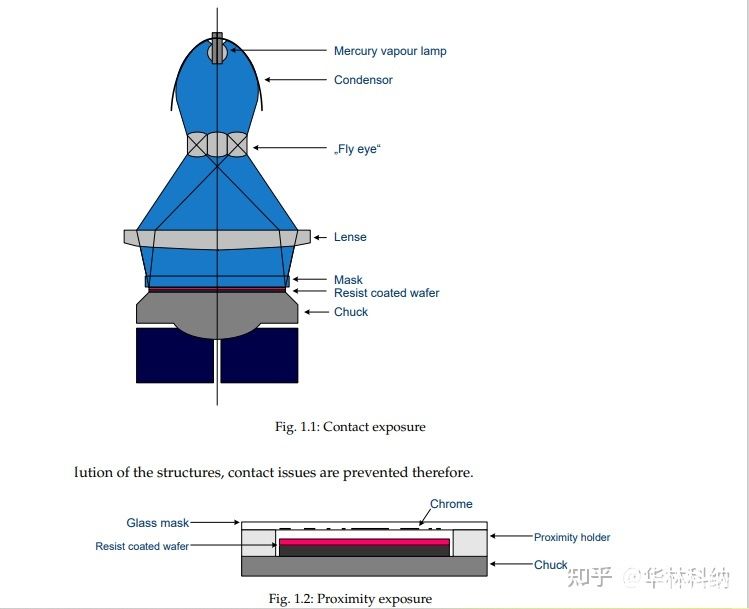
傳感器未對準通常是在其反饋回路中使用MEMS慣性測量單元(IMU)的高性能運動控制系統的關鍵考慮因素。對于IMU中的陀螺儀,傳感器未對準描述了每個陀螺儀的旋轉軸與系統定義的慣性參考系(也稱為全局系)之間的角度差。
2023-01-08 20:05:19 6251
6251 
光刻掩模版,別稱“掩模版”、“光刻板”、“光罩”、“遮光罩”,一般使用玻璃或者石英表面覆蓋帶有圖案的金屬圖形,實現對光線的遮擋或透過功能,是微電子光刻工藝中的一個工具或者板材。
2023-02-13 09:27:29 3473
3473 其全流程涉及了從 EUV 光源到反射鏡系統,再到光掩模,再到對準系統,再到晶圓載物臺,再到光刻膠化學成分,再到鍍膜機和顯影劑,再到計量學,再到單個晶圓。
2023-03-07 10:41:58 2615
2615 新的High NA EUV 光刻膠不能在封閉的研究環境中開發,必須通過精心設計的底層、新型硬掩模和高選擇性蝕刻工藝進行優化以獲得最佳性能。為了迎接這一挑戰,imec 最近開發了一個新的工具箱來匹配光刻膠和底層的屬性。
2023-04-13 11:52:12 2944
2944 光刻技術是將掩模中的幾何形狀的圖案轉移到覆蓋在半導體晶片表面的薄層輻射敏感材料(稱為抗蝕劑)上的過程
2023-04-25 09:55:13 2814
2814 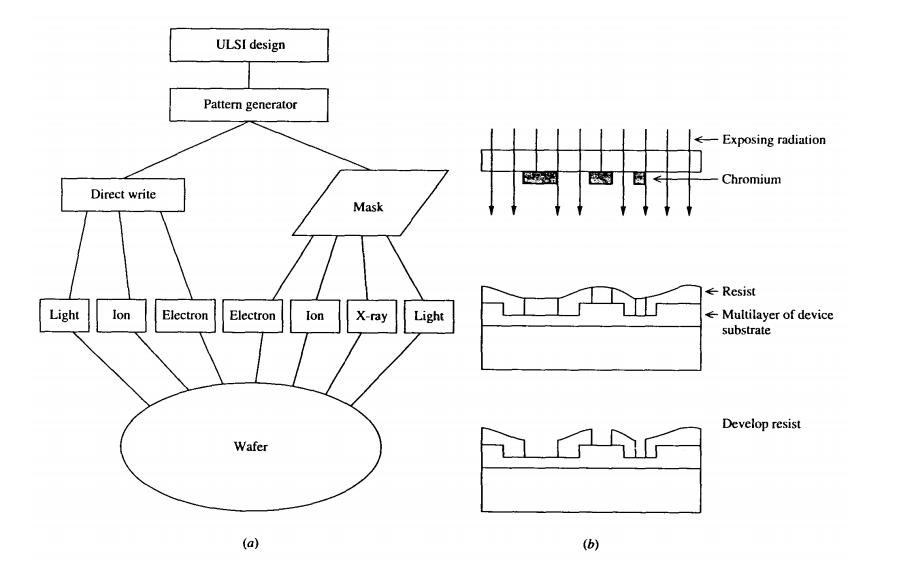
根據維基百科的定義,光刻是半導體器件制造工藝中的一個重要步驟,該步驟利用曝光和顯影在光刻膠層上刻畫幾何圖形結構,然后通過刻蝕工藝將光掩模上的圖形轉移到所在襯底上。這里所說的襯底不僅包含硅晶圓,還可以是其他金屬層、介質層,例如玻璃、SOS中的藍寶石。
2023-04-25 11:11:33 2606
2606 
晶圓廠通常使用光刻膠來圖案化抗蝕刻硬掩模,然后依靠硬掩模來保護晶圓。但是,如果光刻膠太薄,它可能會在第一個轉移步驟完成之前被侵蝕掉。隨著光刻膠厚度的減小,底層厚度也應該減小。
2023-04-27 16:25:00 1680
1680 
光刻膠可以通過光化學反應,經曝光、顯影等光刻工序將所需要的微細圖形從光罩(掩模版)轉移到待加工基片上。依據使用場景,這里的待加工基片可以是集成電路材料,顯示面板材料或者印刷電路板。
2023-05-11 16:10:49 8982
8982 
之前的小講堂有介紹過,光刻過程就好比用照相機拍照,將掩模版上的芯片設計版圖曝光到晶圓上,從而制造出微小的電路結構。ASML光刻機的鏡片組使用極其精密的加工手段制造,使得最終像差被控制在納米級別,才能穩定地通過曝光印刷微電路。
2023-05-25 10:13:28 1500
1500 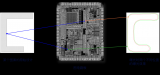
? 1、選用全局曝光的相機 工業相機的曝光模式分為全局曝光(Global Shutter)和卷簾曝光(Rolling Shutter)。CCD相機都是全局曝光,CMOS相機有全局曝光和卷簾曝光兩種
2023-05-30 10:15:27 4035
4035 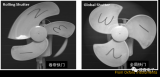
通常,光刻是作為特性良好的模塊的一部分執行的,其中包括晶圓表面制備、光刻膠沉積、掩模和晶圓的對準、曝光、顯影和適當的抗蝕劑調節。光刻工藝步驟需要按順序進行表征,以確保模塊末端剩余的抗蝕劑是掩模的最佳圖像,并具有所需的側壁輪廓。
2023-06-02 16:30:25 1663
1663 
光刻機需要采用全反射光學元件,掩模需要采用反射式結構。
這些需求帶來的是EUV光刻和掩模制造領域的顛覆性技術。EUV光刻掩模的制造面臨著許多挑戰,包括掩模基底的低熱膨脹材料的開發、零缺陷襯底拋光、多層膜缺陷檢查、多層膜缺陷修復等。
2023-06-07 10:45:54 3943
3943 
MODEL:XT-01-UVlitho-手動版一、產品簡介光刻技術是現代半導體、微電子、信息產業的基礎,是集成電路最重要的加工工藝。光刻膠在紫外光的照射下發生化學變化,通過曝光、顯影、刻蝕等工藝過程
2022-12-20 09:24:26 3273
3273 
中國科學院大學集成電路學院是國家首批支持建設的示范性微電子學院。為了提高學生對先進光刻技術的理解,本學期集成電路學院開設了《集成電路先進光刻技術與版圖設計優化》研討課。在授課過程中,除教師系統地講授
2023-06-26 17:00:19 1831
1831 
光刻是半導體芯片生產流程中最復雜、最關鍵的工藝步驟,耗時長、成本高。半導體芯片生產的難點和關鍵點在于將電路圖從掩模上轉移至硅片上,這一過程通過光刻來實現, 光刻的工藝水平直接決定芯片的制程水平和性能水平。
2023-08-23 10:47:53 5496
5496 
短波長透明光學元件的缺乏限制了深紫外光刻中的可用波長,而晶片上所需的最小特征繼續向更深的亞波長尺度收縮。這對用入射場代替掩模開口上的場的基爾霍夫邊界條件造成了嚴重的限制,因為這種近似無法考慮光刻圖像
2023-08-25 17:21:43 1075
1075 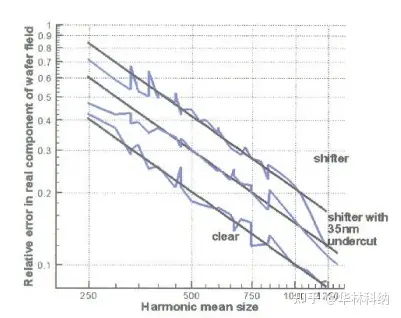
光刻膠作為影響光刻效果核心要素之一,是電子產業的關鍵材料。光刻膠由溶劑、光引發劑和成膜樹脂三種主要成分組成,是一種具有光化學敏感性的混合液體。其利用光化學反應,經曝光、顯影等光刻工藝,將所需要的微細圖形從掩模版轉移到待加工基片上,是用于微細加工技術的關鍵性電子化學品。
2023-10-09 14:34:49 5550
5550 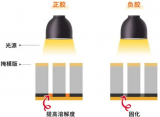
光學光刻是通過廣德照射用投影方法將掩模上的大規模集成電路器件的結構圖形畫在涂有光刻膠的硅片上,通過光的照射,光刻膠的成分發生化學反應,從而生成電路圖。限制成品所能獲得的最小尺寸與光刻系統能獲得的分辨率直接相關,而減小照射光源的波長是提高分辨率的最有效途徑。
2023-10-24 11:43:15 1810
1810 
隨著工藝節點不斷變小,掩模版制造難度日益增加,耗費的資金成本從數十萬到上億,呈指數級增長,同時生產掩模版的時間成本也大幅增加。如果不能在制造掩模版前就保證其設計有足夠高的品質,重新優化設計并再次制造一批掩模版將增加巨大的資金成本和時間成本。
2023-11-02 14:25:59 2453
2453 
掩模在芯片制造中起到“底片”的作用,是一類不可或缺的晶圓制造材料,在芯片封裝(構筑芯片的外殼和與外部的連接)、平板顯示(TFT-LCD液晶屏和OLED屏〉、印刷電路板、微機電器件等用到光刻技術的領域也都能見到各種掩模的身影。
2024-01-18 10:25:22 2481
2481 
光刻膠是一種涂覆在半導體器件表面的特殊液體材料,可以通過光刻機上的模板或掩模來進行曝光。
2024-03-04 17:19:18 9618
9618 在曝光過程中,掩模版與涂覆有光刻膠的硅片直接接觸。接觸式光刻機的縮放比為1:1,分辨率可達到4-5微米。由于掩模和光刻膠膜層反復接觸和分離,隨著曝光次數的增加,會引起掩模版和光刻膠膜層損壞、芯片良率下降等不良后果。
2024-03-08 10:42:37 3691
3691 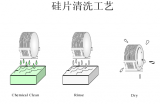
近日,合肥晶合集成電路股份有限公司(簡稱晶合集成)欣然宣布,其于7月22日成功推出安徽省首款半導體光刻掩模版,從而成功填補了安徽省在此領域的歷史空缺,進一步加強了本地區半導體產業的核心競爭力。
2024-07-24 16:00:41 1811
1811 為了成功紫外曝光并且根據所需要的分辨率,光刻膠掩模必須盡可能的靠近SU-8光刻膠放置,不要有任何干擾。如要這樣做,可檢查如下幾件事。 首先,光掩模和晶圓之間的灰塵或任何其他元素的存在都會導致不完
2024-08-23 14:39:42 1859
1859 光刻掩膜版的制作是一個復雜且精密的過程,涉及到多個步驟和技術。以下是小編整理的光刻掩膜版制作流程: 1. 設計與準備 在開始制作光刻掩膜版之前,首先需要根據電路設計制作出掩模的版圖。這個過程通常
2024-09-14 13:26:22 2269
2269 本文介紹了什么是邊緣芯片(edge die)。 邊緣芯片(edge die)是指位于晶圓邊緣區域的芯片,由于晶圓制造過程中的掩模對準誤差或晶圓切割等原因,這些芯片可能在設計上存在缺陷或尺寸不完整
2024-12-24 11:38:21 1501
1501 掩膜版(Photomask),又稱光罩,是芯片制造光刻工藝所使用的線路圖形母版。它如同照相過程中的底片,承載著將電路圖形轉印到晶圓上的重要使命。掩膜版主要由基板和遮光膜兩個部分組成,通過曝光過程,將
2025-02-19 10:03:57 1140
1140 隨著極紫外光刻(EUV)技術面臨光源功率和掩模缺陷挑戰,X射線光刻技術憑借其固有優勢,在特定領域正形成差異化競爭格局。
2025-05-09 10:08:49 1374
1374 
圖1.拼接曝光加工系統 衍射光柵廣泛應用于精密測量、激光脈沖壓縮、光譜分析等領域。干涉光刻作為一種無掩膜曝光光刻方法,在衍射光柵加工制造方面具有高效率、高靈活度的優勢。但干涉光刻加工的光柵尺寸在
2025-05-22 09:30:59 572
572 
在 MEMS(微機電系統)制造領域,光刻工藝是決定版圖中的圖案能否精確 “印刷” 到硅片上的核心環節。光刻 Overlay(套刻精度),則是衡量光刻機將不同層設計圖案對準精度的關鍵指標。光刻 Overlay 指的是芯片制造過程中,前后兩次光刻工藝形成的電路圖案之間的對準精度。
2025-06-18 11:30:49 1563
1563 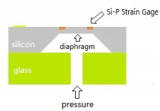
的應用。 改善光刻圖形線寬變化的方法 優化曝光工藝參數 曝光是決定光刻圖形線寬的關鍵步驟。精確控制曝光劑量,可避免因曝光過度導致光刻膠過度反應,使線寬變寬;或曝光不足造成線寬變窄。采用先進的曝光設備,如極紫外(EUV)光刻機
2025-06-30 15:24:55 740
740 
電子束光刻(EBL)是一種無需掩模的直接寫入式光刻技術,其工作原理是通過聚焦電子束在電子敏感光刻膠表面進行納米級圖案直寫。
2025-08-14 10:07:21 2555
2555 
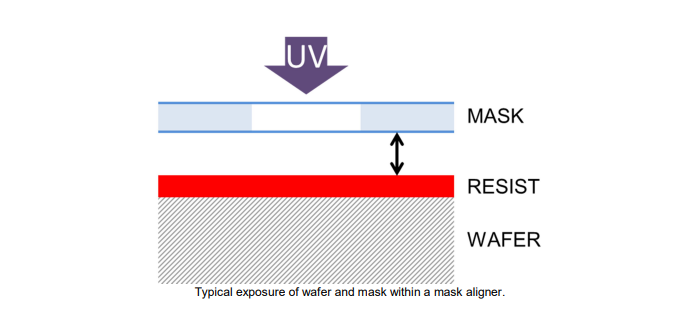
 電子發燒友App
電子發燒友App









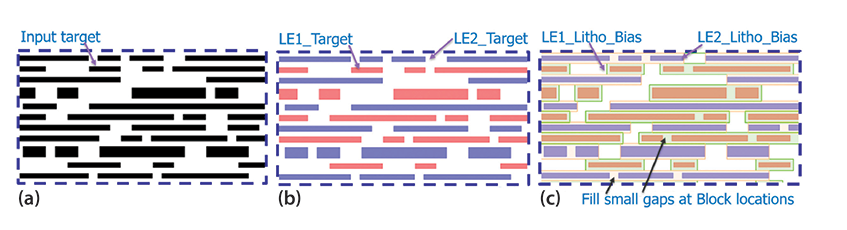



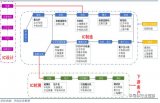
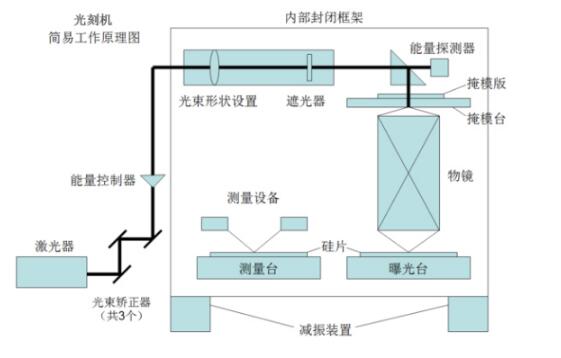
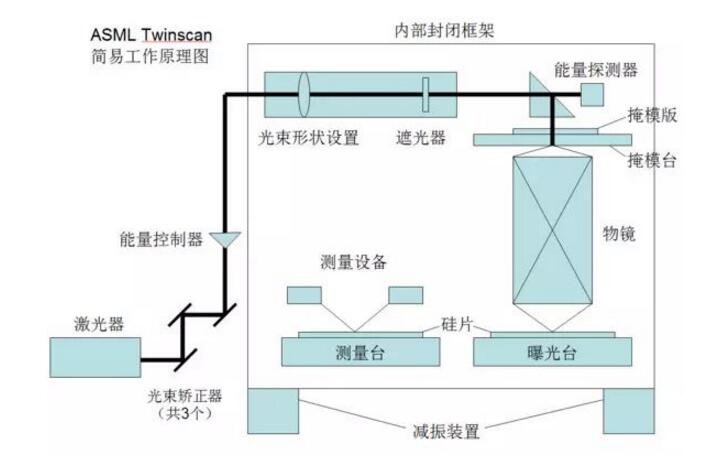

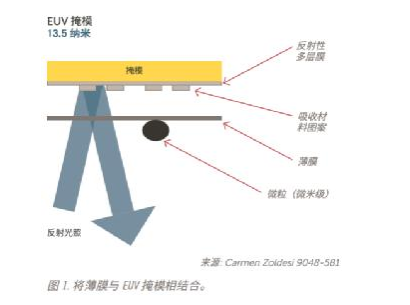
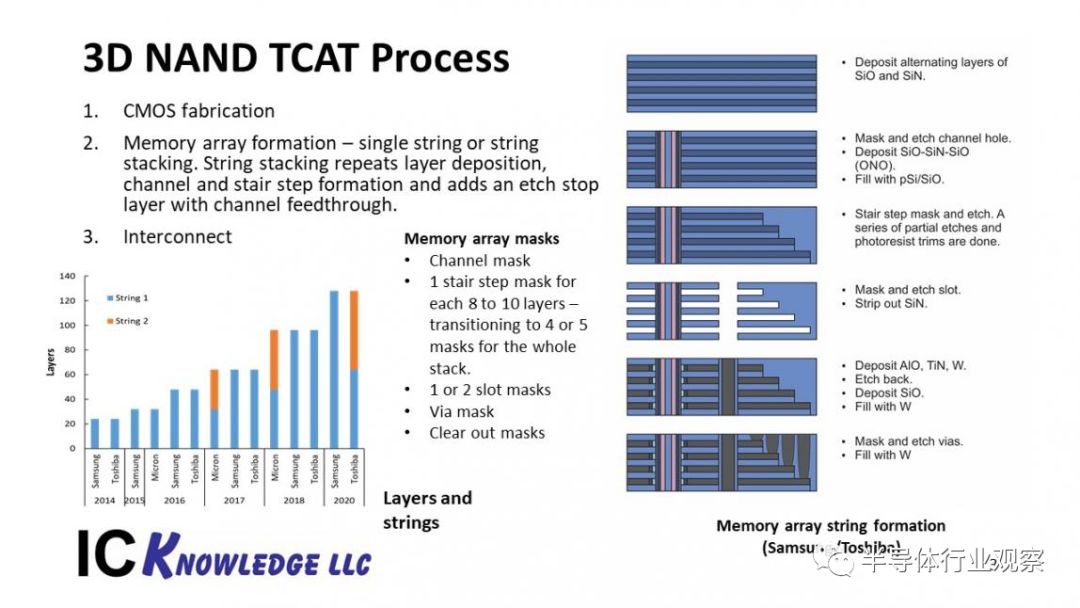


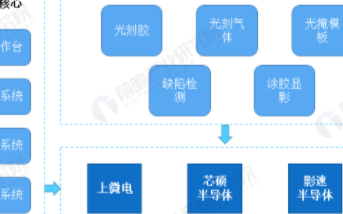


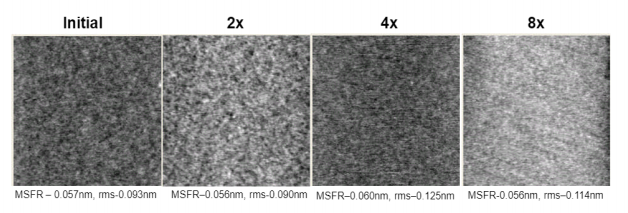
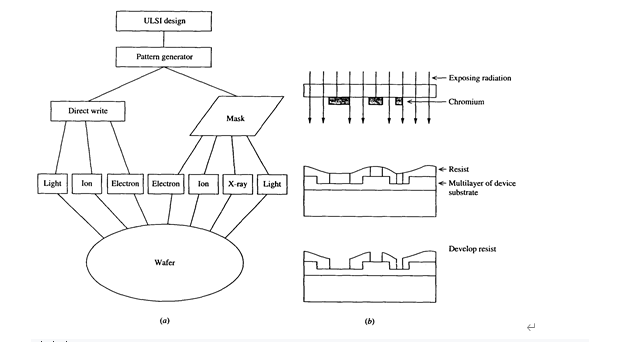



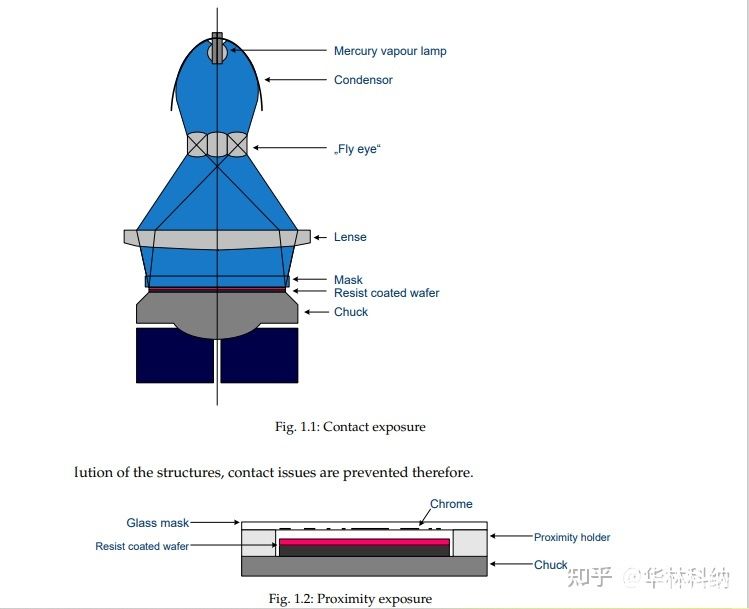

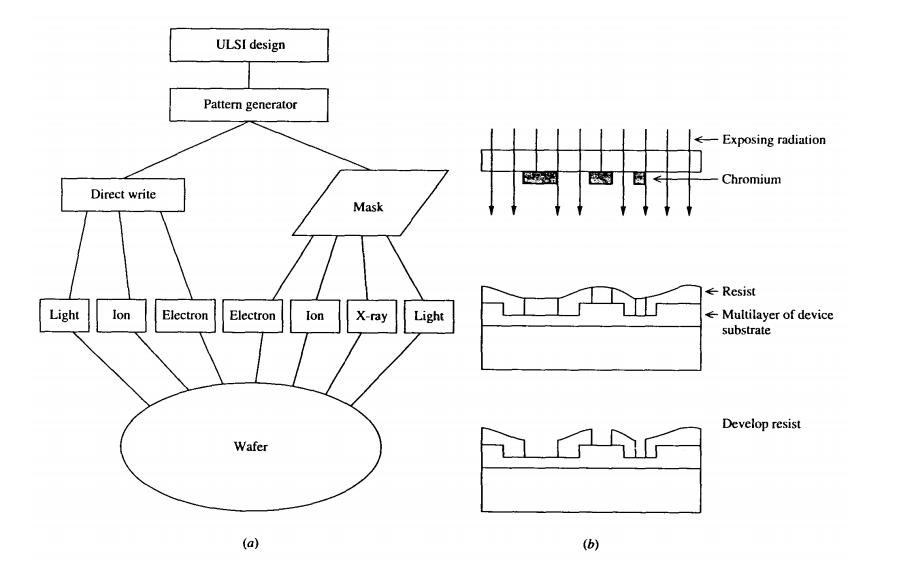



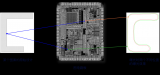
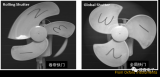





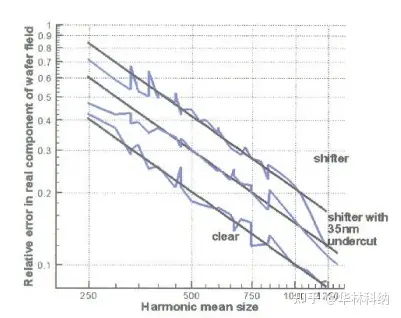
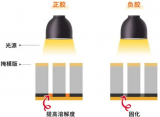



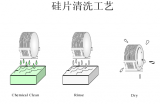


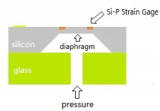





評論