掩膜版(Photomask),又稱光罩,是芯片制造光刻工藝所使用的線路圖形母版。它如同照相過程中的底片,承載著將電路圖形轉印到晶圓上的重要使命。掩膜版主要由基板和遮光膜兩個部分組成,通過曝光過程,將精密的線路圖形精確地復制到每一片晶圓上。
然而,在使用光掩模進行硅片光刻的過程中,當掩模板被光刻機中的激光持續照射一段時間后,掩模板上常常會出現一種被稱為霧狀缺陷(Deflate)的問題,其中最常見的一種表現形式就是“haze”(霧狀物)。尤其是在使用193nm或更短波長的光源時,這種缺陷更容易發生,全球大部分光掩模制造廠都面臨著這一挑戰。
硫酸銨:霧狀缺陷的“元兇”
經過分析發現,霧狀缺陷的主要成分是硫酸銨((NH?)?SO?)。這種鹽類化合物由硫酸根與氨根離子結合而成,是導致霧狀缺陷的“罪魁禍首”。許多研究機構針對掩膜版霧狀進行加速實驗,發現所使用的曝光光源照射能量越強(紫外光波數越短)以及掩模表面殘留離子濃度越高,Haze就越容易產生。離子殘余現象可能發生在掩膜版制造的各個階段,包括制造時的殘留、庫存運送期間的污染,以及在IC制造廠使用過程中的逐漸形成。
這種化合物是由硫酸根和氨根離子結合形成的鹽類物質。當光掩模暴露在高能量的紫外光下,尤其是波長較短的光源時,掩模表面的殘留離子濃度越高,霧狀缺陷就越容易產生。
離子殘留主要可能來源于以下情況
光掩模清洗工藝和使用的化學品,例如光掩模清洗溶液SPM和SC一1
使用清洗光掩模的水中含有離子
外來物質污染,例如保護膜、粘著劑、運輸用的包裝盒、包裝袋的outgassing
晶圓制造廠環境的空氣的污染(AMC)
在早期采用1-line或248nm光刻技術的時代,霧狀缺陷就已經成為了一個顯著的問題。隨著193nm光刻技術的廣泛應用,特別是在12英寸硅晶片的高產量制造中,霧狀缺陷問題變得更加嚴重。在某些情況下,光掩模的使用壽命大大縮短,甚至有些光掩模在短短幾個月內就會出現霧狀缺陷。這不僅增加了生產成本,還影響了芯片制造的效率。
預防策略:全方位防控
面對霧狀缺陷的挑戰,光掩模制造廠和晶圓制造廠需要采取全方位的防控措施:對所使用的化學清洗藥劑、純水、相關物料、包裝材料、運送材料以及廠區內環境進行定期離子含量檢測。
SGS半導體超痕量分析實驗室作為行業內的權威機構,長期為海內外各大光掩模制造廠和晶圓制造廠提供缺陷分析和離子分析服務,幫助工廠提前預防可能發生的光掩模缺陷。
-
芯片制造
+關注
關注
11文章
719瀏覽量
30464 -
光刻
+關注
關注
8文章
364瀏覽量
31337
原文標題:干貨分享 | 光掩模的霧狀缺陷預防指南
文章出處:【微信號:SGS半導體服務,微信公眾號:SGS半導體服務】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
“主動預防” vs “事后補救”:分布式光伏防逆流技術的代際革命,西格電力給出標準答案

高精密PCB制造關鍵工藝控制點與缺陷預防指南

開關柜局部放電的危害及其檢測預防

變壓器局部放電如何進行預防?
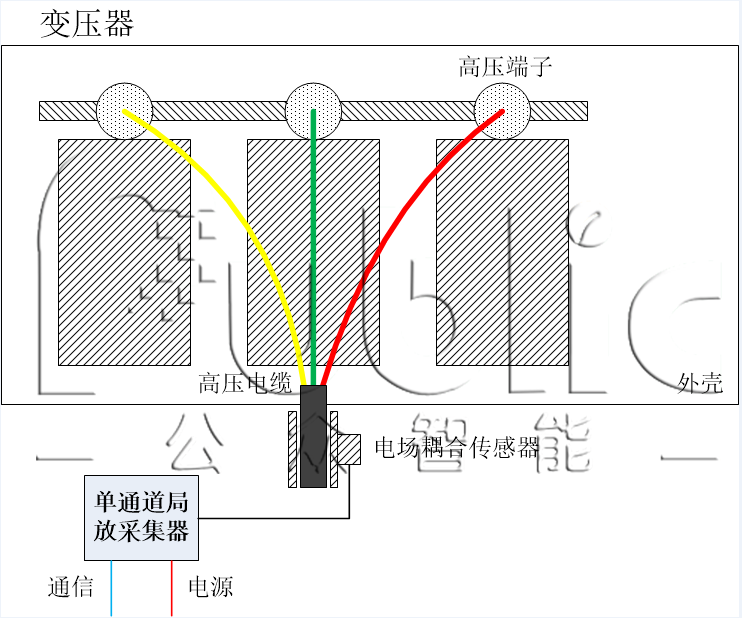
便攜式EL檢測儀:光伏組件缺陷檢測的移動“透視眼”

怎樣去預防貼片電容漏電流的發生?

國內材料巨頭入主掩模版,空白掩模有望國產化(附投資邏輯)

常見的電能質量在線監測裝置硬件故障如何預防?

便攜式EL檢測儀:光伏組件缺陷檢測的 “便攜顯微鏡”

風華貼片電感的失效模式有哪些?如何預防?
華大九天Empyrean GoldMask平臺重構掩模版數據處理方案

超景深顯微鏡觀測下鋰離子電池的焊接缺陷及預防

龍圖光罩90nm掩模版量產,已啟動28nm制程掩模版的規劃
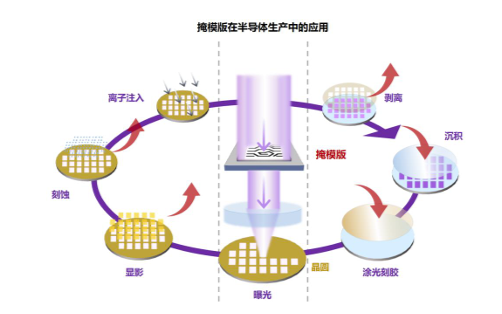



 預防光掩模霧狀缺陷實用指南
預防光掩模霧狀缺陷實用指南




評論