BGA焊點空洞的形成與防止
BGA空洞(圖1、圖2)會引起電流密集效應,降低焊點的機械強度。因此,從可靠性角度考慮,應減少或降低空洞。那么,
2010-01-25 09:14:33 3522
3522 SI-list【中國】BGA焊點空洞詳解
2017-12-16 07:55:00 22500
22500 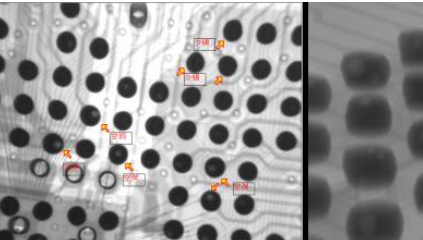
本文將系統、全面地介紹 BGA 和 CSP 封裝器件“枕頭效應”產生機理、原因分析、以及結合作者10多年來的現場實際改善案例經驗匯總,詳細講解“枕頭效應”的如何改善和預防的措施,希望此文能為電子裝聯的業界的朋友提供一些借鑒和參考作用,提升各自公司/工廠的SMT產線的CSP/BGA類器件的焊接工藝水平。
2021-11-04 17:20:18 32567
32567 
一、造成換向不良的電磁原因及改善方法 1、造成換向不良的電磁原因 直流電動機在換向過程中,電樞繞組元件內的電流以很快的速度改變方向,此時在元件中產生電抗電勢。另外,處于幾何中性面上的換向元件切割氣隙
2023-09-14 10:28:56 2628
2628 BGA 焊點外面的keepout是干嘛用的
2015-01-08 14:58:52
區焊膏融化,對SMD進行焊接,發生冶金反應,形成可靠連接,冷卻區使焊點快速凝固,形成焊點。任何一個溫度設定不合理都會導致不良焊點產生。 對于BGA焊點,邊緣與中心焊球的溫差△T是影響其焊點質量
2020-12-25 16:13:12
`請問BGA不飽滿焊點的解決辦法?`
2019-12-24 14:49:38
內存容量兩到三倍。在目前主板控制芯片組的設計中,BGA封裝技術得到廣泛應用,成為集成電路封裝領域的主流。 BGA封裝技術采用圓形或柱狀焊點按陣列形式分布在封裝下面的I/O端子,優點在于雖然I/O引腳
2023-04-11 15:52:37
更小,更易于加工。 BGA設計規則 凸點塌落技術,即回流焊時錫鉛球端點下沈到基板上形成焊點,可追溯到70年代中期。但直到現在,它才開始快速發展。目前,Motorola、IBM、Citizen
2018-09-05 16:37:49
BGA的焊點在晶片的下面,焊接完成后,用肉眼難判斷焊接質量。在沒有檢測設備下,可先目視芯片外圈的塌陷是否一致,再將晶片對準光線看,如果每排每列都能透光,則以初步判斷沒有連焊。但用這種方法無法判斷里面焊點
2018-12-30 14:01:10
電鍍填平當BGA封裝的焊盤間距小而無法出線時,需設計盤中孔,將孔打在焊盤上面,從內層走線或底層走線,這時的盤中孔需要 樹脂塞孔電鍍填平 ,如果盤中孔不采取樹脂塞孔工藝,焊接時會導致焊接不良,因為焊盤
2023-03-24 11:58:06
焊盤。如下圖24.6所示。NSMD在大多數情況下推薦使用,它的優點是球形焊盤直徑比阻焊層尺寸大,焊接中焊球有更大接觸面,熱風整平表面光滑、平整,焊盤之間的走線空間更大些。且在BGA焊點上應力集中較小
2020-07-06 16:11:49
BGA 錫球焊點檢測 (BGA Solder Ball)使用BGA 焊點檢查機 (BGA Scope),是采用45°棱鏡的光學折射原理,從芯片側邊檢查BGA焊點接面(Solder Joint)、錫球
2018-09-11 10:18:26
想問下,怎么給整板上的焊點都加粗
2012-05-15 11:32:02
電鍍填平當BGA封裝的焊盤間距小而無法出線時,需設計盤中孔,將孔打在焊盤上面,從內層走線或底層走線,這時的盤中孔需要 樹脂塞孔電鍍填平 ,如果盤中孔不采取樹脂塞孔工藝,焊接時會導致焊接不良,因為焊盤
2023-03-24 11:52:33
提升方法進行分析。 BGA有不同類型,不同類型的BGA有不同的特點,只有深入了解不同類型BGA的優缺點,才能更好地制定滿足BGA制程要求的工藝,才能更好地實現BGA的良好裝配,降低BGA的制程成本
2016-08-11 09:19:27
`SMT焊點的染色與品牌焊錫絲滲透試驗隨著SMT技術與一些品牌焊錫絲及元器件高密封裝技術的迅速發展,很多品牌焊錫絲隱藏的焊點缺陷很難用直觀的方法發現,焊點的質量與可靠性的檢測試驗技術必須適應這種快速
2016-05-03 17:46:40
SMT制程不良原因及改善對策
2012-08-11 09:58:31
減少BGA故障方法編輯制造過程、搬運及印刷電路組裝 (PCA) 測試等都會讓封裝承受很多機械應力,從而引發故障。隨著格柵陣列封裝變得越來越大,針對這些步驟應該如何設置安全水平也變得愈加困難。多年來
2014-05-28 10:00:48
,將建 立視像檢查標準來幫助確定焊點的好壞。這些研究的目的在于豐富知識和經驗數據庫,以便創建適于統 計的合s理質量標準,可為其他同樣致力于創建THR互連和業界質量標準的人們提供幫助。 典型的熱循環與熱
2018-09-05 16:38:57
電鍍填平當BGA封裝的焊盤間距小而無法出線時,需設計盤中孔,將孔打在焊盤上面,從內層走線或底層走線,這時的盤中孔需要 樹脂塞孔電鍍填平 ,如果盤中孔不采取樹脂塞孔工藝,焊接時會導致焊接不良,因為焊盤
2023-03-24 11:51:19
焊點質量 ,尤其對BGA、DCA元件的焊點檢查,作用不可替代,無須測試模具,缺點是價格目前相當昂貴。
BGA焊接不良原因
1、BGA焊盤孔未處理
BGA焊接的焊盤上有孔,在焊接過程中 焊球會與焊料
2023-05-17 10:48:32
手機天線TIS的改善都有哪些方法?
2013-09-06 16:10:19
改善PCB設計的基本問題需要掌握一些方法和技巧,有誰了解嗎
2023-04-14 14:41:09
` 誰來闡述一下熱風槍bga焊接方法?`
2020-02-24 15:12:47
本文主要羅列出客戶端常見的晶振不良問題及解決方法。
2021-06-08 09:35:22
BGA元件的維修技術及操作方法
球柵列陣封裝技術(Ball Gird Arroy),簡稱BGA封裝早在80年代已用于尖端軍備、導彈和航天科技中。
2010-04-20 14:17:59 9026
9026 
BGA焊接的工藝方法很值得學習呀,BGA焊接的工藝方法很值得學習呀,BGA焊接的工藝方法很值得學習呀。
2015-11-17 15:41:57 0
0 bga走線方法
2017-09-18 15:49:24 16
16 BGA返修臺是對應焊接不良的BGA重新加熱焊接的設備,它不可以修復BGA元件本身出廠的品質問題。不過按目前的工藝水平,BGA元件出廠有問題的幾率很低。有問題的話只會在SMT工藝端和后段的因為溫度原因
2017-11-13 11:06:20 14389
14389 錫膏”+“錫球”:這是最好最標準的植球法,用這種方法植出的球焊接性好,光澤好,熔錫過程不會出現跑球現像,較易控制并撐握。具體做法就是先用錫膏印刷到BGA的焊盤上,再在上面加上一定大小的錫球,這時錫膏
2017-11-13 11:21:37 32503
32503 顯卡虛焊是指顯卡芯片的BGA焊點與主板接觸不良,一般是由于顯卡高溫導致的。
2018-04-09 09:03:30 166664
166664 
在線燒錄因集燒錄測試一體的優勢受到眾多用戶喜愛,但卻往往因連接工裝,夾具導致接線過長,進而增加不穩定性和燒錄不良率,這究竟要如何改善呢?
2019-01-06 09:12:14 5058
5058 本文首先介紹了什么是BGA,其次介紹了BGA主要工藝,最后介紹了BGA焊盤脫落的補救方法及詳細步驟。
2019-04-25 14:30:48 14022
14022 BGA器件的結構可按焊點形狀分為兩類:球形焊點和校狀焊點。球形焊點包括陶瓷球柵陣列 CBGA、載帶自動鍵合球柵陣列TBGA、塑料球柵陣列PBGA。 CBGA、TBGA和PBGA是按封裝方式的不同而劃分的。
2019-05-21 15:08:04 7430
7430 BGA器件的封裝結構按焊點形狀分為兩類:球形焊點和柱狀焊點。BGA封裝技術是采用將圓型或者柱狀焊點隱藏在封裝體下面,其特點是引線間距大、引線長度短。
2019-06-13 14:23:33 27734
27734 BGA封裝技術早在20世紀60年代就已開始,并由IBM公司首次應用。然而,BGA封裝技術直到20世紀90年代初才進入實用階段。
2019-08-03 10:06:37 8220
8220 BGA的焊接是pcba加工的重要工序,但由于BGA焊后檢查和維修比較困難,必須使用X射線透視才能確保焊接連接的可靠性。所以在pcba加工的回流焊接時對BGA焊接不良的診斷就至關重要了。
2019-10-09 11:39:44 14529
14529 在PCBA加工的焊接過程中,由于工人操作不良或者焊料選料不精。導致焊接效果不能達到預期。那么PCBA加工焊接的不良現象有哪些呢?不良焊接又會導致電路板那些故障呢?下面介紹一下焊點不良及其原因分析。
2019-10-09 11:36:14 10858
10858 從本質上來講,絕大部分SMT焊點中出現的空洞都是因為再流焊接過程中熔融焊點截留的助焊劑揮發物在凝固期間沒有足夠的時間及時排出而形成的。
2019-10-12 11:45:40 13062
13062 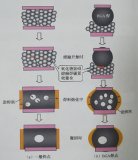
通孔再流焊技術的關鍵問題在于通孔焊點所需焊膏量比表面貼裝焊點所需焊膏量要大,而采用傳統再流工藝的焊膏印刷方法不能同時給通孔元器件及表面貼裝元器件施放合適的焊膏量,通孔焊點的焊料量通常不足,因此焊點強度將會降低。可以通過下面兩種不同工藝完成印刷。
2019-11-04 10:56:44 3474
3474 BGA(即Ball GridAray)有多種結構,如塑封BGA (P-BGA)、倒裝BGA( F-BGA )、載帶BGA(T-BGA)和陶瓷BGA(C-BGA)。其工藝特點如下:
2019-11-08 11:45:03 7161
7161 在smt貼片加工中,BGA空洞是經常出現的一個問題。那么BGA空洞又是怎么形成的呢,又該如何去解決BGA空洞呢?
2019-11-14 11:01:28 10340
10340 BGA是smt加工中很多高精密的電路板都會出現的最小焊點封裝,而BGA那么小,我們錫膏量要控制以外,如何加固BGA使得更加牢固呢?無鉛焊料降低了BGA封裝的可靠性,特別是抗沖擊與彎曲性能。采用傳統的底部填充工藝需要花費更多的時間,而采用角部點膠工藝可以有效增強BGA的抗沖擊與彎曲性能。
2020-01-17 11:23:20 9783
9783 本文主要闡述了bga封裝芯片的焊接方法及焊接技巧。
2020-02-25 08:35:34 13993
13993 焊接檢驗首先要看釬料的潤濕情況和焊點的幾何形狀,然后以焊點的亮度、光澤等為主進行檢查。
2020-04-07 17:50:17 12807
12807 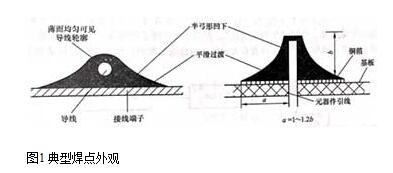
在貼片加工中有時候出現一種SMT貼片加工不良現象,那就是焊點剝離。焊點剝離就是焊點與焊盤之間出現斷層而發生剝離現象,這種情況一般發生在通孔波峰焊和回流焊的工藝當中。下面和大家簡單介紹一下這種現象怎么解決。
2020-06-17 09:30:09 4821
4821 焊接很像焊接電路板上的組件,因為有明顯的跡象表明焊點良好。例如,良好的焊接點將焊料施加到兩個要連接的元件上,并且不會有氣穴。擁有良好焊點的重要性 PCB 質量控制這是眾所周知的,因為不良的接頭可能
2020-10-09 18:50:17 2273
2273 一、PCBA返修工藝目的 ①再流焊、波峰焊工藝中產生的開路、橋接、虛焊和不良潤濕等焊點缺陷,需要通過手工借助必要的工具(比如:BGA返修臺、X-ray、高倍顯微鏡)進行修整后去除各種焊點缺陷,從而
2020-10-27 14:57:59 1660
1660 空洞可以中止焊點中裂紋的擴展,對裂紋的蔓延有抑制作用。
2021-03-23 17:38:36 8444
8444 一、PCBA返修工藝目的 ①再流焊、波峰焊工藝中產生的開路、橋接、虛焊和不良潤濕等焊點缺陷,需要通過手工借助必要的工具(比如:BGA返修臺、X-ray、高倍顯微鏡)進行修整后去除各種焊點缺陷,從而
2021-03-06 10:34:24 1574
1574 基于機器視覺的白車身焊點自動化檢測為車身焊接質量控制提供了有效的途徑,然而受環境光污染的影響,焊點自動化檢測裝備的機器視覺系統較難進行準確定位。為解決傳統的圖像處理方法受環境干擾大及魯棒性差
2021-03-17 11:18:01 9
9 對于這個BGA問題,其根本原因是焊膏不足。PCBA加工BGA返修中遇到的不飽滿焊點的另一個常見形成原因是焊料的芯吸現象引起的,BGA焊料由于毛細管效應流到通孔內形成信息。
2021-03-27 11:46:29 4490
4490 一、PCBA返修工藝目的 ①再流焊、波峰焊工藝中產生的開路、橋接、虛焊和不良潤濕等焊點缺陷,需要通過手工借助必要的工具(比如:BGA返修臺、X-ray、高倍顯微鏡)進行修整后去除各種焊點缺陷,從而
2021-09-10 17:25:49 2327
2327 后續的回流工藝標準化管理,進一步為產品的質量保駕護航。基于此,新陽檢測中心分享這篇技術文章,供各位討論學習。 BGA焊接評價提案背景 ? 焊點成型、焊接面積、焊點開裂以及焊接強度方面存在的問題可能會帶到批量階段,對量產的品
2022-06-13 14:33:58 3453
3453 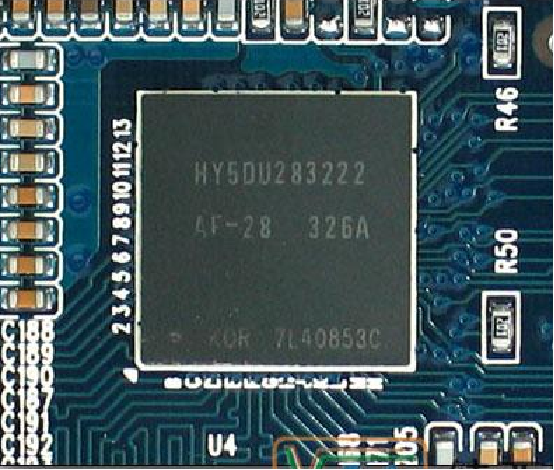
染色。一共染色四個BGA,拉開BGA后,可以看到絕大部分焊點是從PCB的焊盤與基材結合處拉開,也有部分是從焊盤側拉開的,但都有空洞存在,如圖2-60和圖2-61所示。
2022-08-23 11:25:43 1642
1642 焊接熱應力導致的焊點開裂,一般具有非常鮮明的分布特征和斷裂特征斷點均勻分布在四角或斜對角且從 IMC層斷開,而機械應力導致的開裂焊點則一般為非對稱分布。
2022-09-02 10:33:59 3916
3916 在本案例中,發現T面的BGA 封裝經歷了波峰焊工藝之后,在可靠性測試中出現了較多的早期失效—大多數焊點從封裝側的焊點界面斷裂,而且斷口平整
2022-10-09 10:36:49 3119
3119 就深圳宏力捷的經驗來看,BGA錫球裂開的問題其實很難僅靠工廠的制程管理與加強焊錫來得到全面改善,如果產品設計時RD可以多出一點力氣,制造上就會省下很多的成本。
2022-11-28 15:37:43 2785
2785 和焊點,檢測出其內部結構的改變,從而得出BGA焊接的質量狀況。X射線技術對BGA焊接的檢測可以檢測出焊點的熔化狀態、焊點的連接形狀和位置、焊點的錯誤和不良狀況以及焊點的完整性等狀態,并可以通過X射線技術檢測出BGA焊接過程中可能存在的缺陷,從而確
2023-03-28 11:07:01 1448
1448 BGA失效分析與改善對策
2023-04-11 10:55:48 1783
1783 一站式PCBA智造廠家今天為大家講講PCBA加工焊點失效是什么原因?PCBA加工焊點失效的解決方法。焊點質量是PCBA加工中最重要的一環。焊點質量的可靠性決定了PCBA產品的可靠性和使用壽命
2023-06-25 09:27:49 1597
1597 BGA失效分析與改善對策
2023-06-26 10:47:41 1593
1593 
BGA返修臺(Ball Grid Array Rework Station)是一種用于返修、拆裝和焊接BGA封裝(球柵陣列封裝)集成電路(IC)的專業設備。BGA封裝是一種常見的表面安裝技術,其焊點
2023-07-10 15:30:33 3501
3501 一站式PCBA智造廠家今天為大家講講PCBA加工怎樣做好BGA返修?BGA焊接返修實驗操作要點。PCBA加工中有時會出現一些BGA焊接不良的問題,如果某個BGA的焊接出現了問題整個板子都將
2023-07-25 09:25:02 1252
1252 在PCBA加工過程中,線路板焊接后可能會出現一些不良現象,如空洞(也常被稱為氣孔、氣泡、Void)等最常見的不良現象,這些現象會直接影響產品質量。因此,在日常加工過程中,應具體分析原因并解決問題
2023-07-27 15:24:17 3839
3839 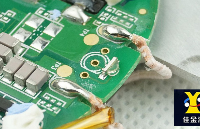
在波峰焊生產過程中,吹孔是比較常見的不良現象,即從焊點表面肉眼可見較大的空洞,在IPC-A-610中被定義為需要改善項。
2023-08-16 10:33:21 2899
2899 返修站的主要功能包括: 精確的溫度控制:全電腦控制BGA返修站的熱風和紅外加熱系統可以精確地控制加熱溫度和時間,確保焊點在正確的溫度下進行焊接或拆卸。 精確的定位系統:這種設備通常配備了高精度的光學定位系統,可以精確地定位BGA芯片的焊點,確保焊接和拆卸的準
2023-08-17 14:22:46 1386
1386 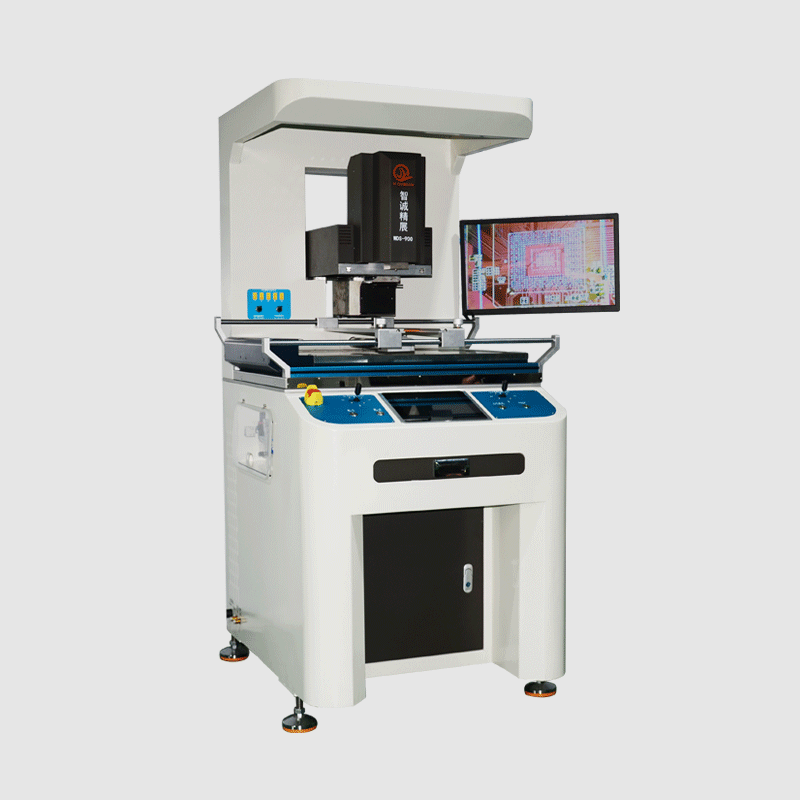
各位老師,請問BGA焊接后出現故障,取下后發現印制板上部分焊盤潤濕不良,需要從哪些方面去分析
2023-09-08 09:50:01 1066
1066 
引起BGA焊盤可焊性不良的原因:
1.綠油開窗比BGA焊盤小
2. BGA焊盤過小
3. 白字上BGA焊盤
4. BGA焊盤盲孔未填平
5. 內層埋孔未填孔
2023-10-17 11:47:32 1161
1161 
射線檢測(X-ray)通常用于檢測焊接質量,包括BGA(Ball Grid Array)焊接的質量。X射線檢測可以檢測到一些焊接缺陷,例如虛焊、焊點冷焊、焊點錯位等問題。虛焊是指焊點與焊盤之間存在空隙或者不完全焊接的情況。X射線檢測可以幫助檢測這種問題。
2023-10-20 10:59:35 1810
1810 常重要的一部分,由于PCBA的復雜性和重要性,其制造和維修需要高度的技能和專業知識。不良的PCBA板可能導致電子設備的故障,因此在現代工業中,PCBA板的質量控制和維修變得尤為重要。在本文中,我們將探討一些常見的PCBA板問題以及如何對其進行維修的方法。 常見的PCBA不良板問題 1. 焊點問題:PCBA板上的焊點連
2023-12-21 09:36:35 1873
1873 很多客戶在貼片的時候有遇到過BGA芯片不良,那這個時候就要對BGA進行維修,就要拆卸板子上的BGA了,那么SMT貼片加工中BGA芯片是如何拆卸的?
2023-12-21 09:42:40 1787
1787 BGA(Ball Grid Array)是一種高密度的表面貼裝封裝技術,它將芯片的引腳用焊球代替,并以網格狀排列在芯片的底部,通過回流焊與印刷電路板(PCB)上的焊盤連接。然而,BGA也存在一些可靠性問題,其中最常見的就是焊點失效。本文主要介紹兩種典型的BGA焊點失效模式:冷焊和葡萄球效應。
2023-12-27 09:10:47 2567
2567 在現代電子制造領域,smt貼片是一種廣泛應用的組裝技術,在電子產品制造過程中很常見。BGA則是一種常見的封裝類型,在smt貼片中使用較為廣泛。然而,由于各種因素,可能會導致smt貼片BGA焊點斷裂
2024-01-30 16:41:49 2380
2380 
當發現BGA 元件有缺陷時,需要進行返工過程來移除和更換它。焊點必須小心熔化,不要干擾鄰近的元件。這是通過 BGA 返修站實現的,該返修站利用目標熱量和氣流。
2024-04-18 11:45:59 8763
8763 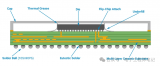
金脆化是一種焊接缺陷,指的是焊點中含有過多的金屬間化合物(IMC),導致焊點的脆性增加,可靠性降低。金脆化主要出現在BGA焊點的兩個位置,即BGA本體與錫球間和焊錫膏與沉金板焊盤間。而BGA焊點金脆化可細分為兩類,一是由熱量不充足引起的金脆化,二是金含量過高引起的金脆化。
2024-05-15 09:06:37 1592
1592 
在SMT貼片加工中,BGA焊點的飽滿度是一個關系到電路板穩定性和性能的關鍵因素。然而,在實際操作中,BGA焊點不飽滿是一個較常出現的問題。那么,這個問題究竟是由哪些因素引起的呢?下面深圳佳金源錫膏
2024-05-15 18:08:48 1073
1073 
一站式PCBA智造廠家今天為大家講講PCBA加工BGA如何檢查焊接質量?PCBA加工BGA焊點的品質檢驗方法。在PCBA貼片加工過程中,BGA器件扮演著核心角色,它們可被視為整個PCBA板的大腦
2024-06-05 09:24:11 2653
2653 
、控制)方法論,探討SMT TX插件撞傷不良改善的策略與實踐,以期推動電子制造行業的質量提升。 一、定義階段:明確撞傷不良問題 首先,我們需要明確SMT TX插件撞傷不良的具體表現及其影響。撞傷不良通常表現為插件引腳彎曲、斷裂或焊盤受損,這不
2024-06-19 14:47:49 903
903 的焊點表面需要形成穩固的合金層從而確保良好的導電性能,虛焊和假焊是SMT貼片加工中不能容忍的不良現象,需要避免出現這類加工不良。2、機械強度電子產品的實際應用環境
2024-06-25 16:37:51 3774
3774 
一站式PCBA智造廠家今天為大家講講smt貼片加工中bga芯片的拆卸方法有哪些?SMT貼片加工中BGA芯片的拆卸方法。BGA芯片在SMT貼片加工中的拆卸通常需要謹慎操作,因為BGA芯片的引腳連接方式
2024-07-29 09:53:42 1751
1751 的影響,導致開裂或脫落,從而影響電路的正常工作。本文將分析應力作用下BGA焊點開裂的原因,并提出相應的控制方法。
2024-11-06 08:55:42 1633
1633 
在回流焊接過程中,對于密腳(間距≤0.5mm)的μBGA、CSP封裝芯片來說,由于焊接部位的隱蔽性,熱量向焊球焊點部位傳遞困難,存在冷焊發生率較高的風險。在相同的峰值溫度和回流時間條件下,與其
2024-11-12 08:56:09 1034
1034 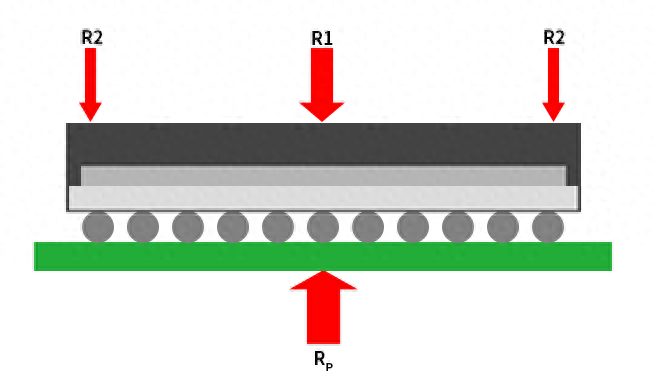
BGA問題,其根本原因是焊點錫膏不足,下面深圳佳金源錫膏廠家來講解一下原因和解決方法有哪些?一、產生原因BGA維修過程中遇到的不飽滿焊點的另一個常見產生原因是焊料的芯
2024-11-18 17:11:33 1728
1728 
BGA(Ball Grid Array,球柵陣列)封裝技術是一種集成電路封裝技術,它通過在芯片的底部形成一個球形焊點陣列來實現芯片與電路板之間的電氣連接。BGA封裝技術自20世紀90年代初開始商業化
2024-11-20 09:15:24 4293
4293 時,BGA內部的焊點可能會因為承受不住高溫而斷裂,導致BGA開裂。 機械應力過大 :強烈的沖擊或振動可能導致BGA承受不住機械應力而開裂。 焊接質量問題 :不良的焊接工藝或材料可能導致BGA開裂。 斷路 : 焊盤污染 :焊盤被污染會導致焊料不能潤濕,進而產生斷路。
2024-11-20 09:27:27 3313
3313 。 BGA封裝的散熱特點 高密度連接 :BGA封裝通過底部的球形焊點與電路板連接,這些焊點數量多,分布均勻,有助于熱量的分散。 熱阻 :BGA封裝的熱阻相對較低,因為它減少了芯片與電路板之間的熱阻。 熱傳導路徑 :BGA封裝的熱傳導路徑包括
2024-11-20 09:30:19 2482
2482 隨著電子技術的發展,BGA封裝因其高集成度和高性能而成為主流的集成電路封裝方式。然而,由于其復雜的結構和高密度的焊點,BGA封裝的測試與驗證變得尤為重要。 1. 視覺檢查 視覺檢查是BGA封裝測試
2024-11-20 09:32:23 3199
3199 的底部形成一個球形焊點陣列,這些焊點用于與電路板上的焊盤連接。BGA封裝相較于傳統的引腳封裝,具有更高的引腳密度和更好的電氣性能,同時還能提供更好的散熱性能。BGA封裝的這些優勢使其成為高性能、高密度電子設備的首選。 二、SMT技術簡介 SM
2024-11-20 09:33:43 1726
1726 一、BGA芯片的定義 BGA是一種表面貼裝技術(SMT)封裝方式,它通過在IC芯片的底部形成一個球形焊點陣列來實現與PCB的連接。這些球形焊點,也稱為焊球,通常由錫(Sn)、鉛(Pb)或其他金屬合金
2024-11-23 11:37:10 9106
9106 。 1. BGA芯片的特點 BGA芯片以其球狀焊點陣列而得名,這些焊點不僅提供了電氣連接,還承擔了機械固定的作用。與傳統的引腳式封裝相比,BGA芯片具有更高的I/O密度,更小的封裝尺寸,以及更好的電氣性能。這些特點使得BGA芯片在高性能計算、
2024-11-23 11:48:10 3629
3629 電子設備運行過熱時,BGA內部的焊點可能會因為承受不住高溫而斷裂,導致BGA開裂。 機械應力過大 :強烈的沖擊或振動可能導致BGA承受不住機械應力而開裂。 焊接質量問題 :不良的焊接工藝或材料可能導致BGA開裂。 斷路 焊盤污染 :焊盤被污染會導致焊料不能潤濕,進而產
2024-11-23 13:54:20 2436
2436 1. BGA芯片概述 BGA是一種表面貼裝技術(SMT)的封裝形式,它將芯片的引腳以球形焊點的形式分布在芯片的底部,這些焊點與PCB(印刷電路板)上的焊盤相連接。BGA封裝具有以下特點: 高密度
2024-11-23 13:56:31 1825
1825 在現代電子制造領域,球柵陣列(BGA)封裝技術因其高密度、高性能和良好的散熱特性,被廣泛應用于各種高端電子產品中。BGA封裝器件的可靠性直接關系到整個電子系統的穩定運行,而焊點作為連接芯片與基板
2025-01-14 14:32:49 1358
1358 
Bump Pattern Design(焊點圖案設計) 是集成電路封裝設計中的關鍵部分,尤其在BGA(Ball Grid Array)和Flip Chip等封裝類型中,焊點設計決定了芯片與封裝基板
2025-03-06 16:44:18 1603
1603 成為評估焊接質量的重要手段。科準測控小編將詳細介紹BGA焊球推力測試的原理、標準、儀器及測試流程,幫助工程師和研究人員掌握科學的測試方法,確保產品的可靠性。 一、檢測原理 BGA焊球推力測試是通過推拉力測試機對單個焊球施加垂直或水平方向的力,直至
2025-04-18 11:10:54 1614
1614 








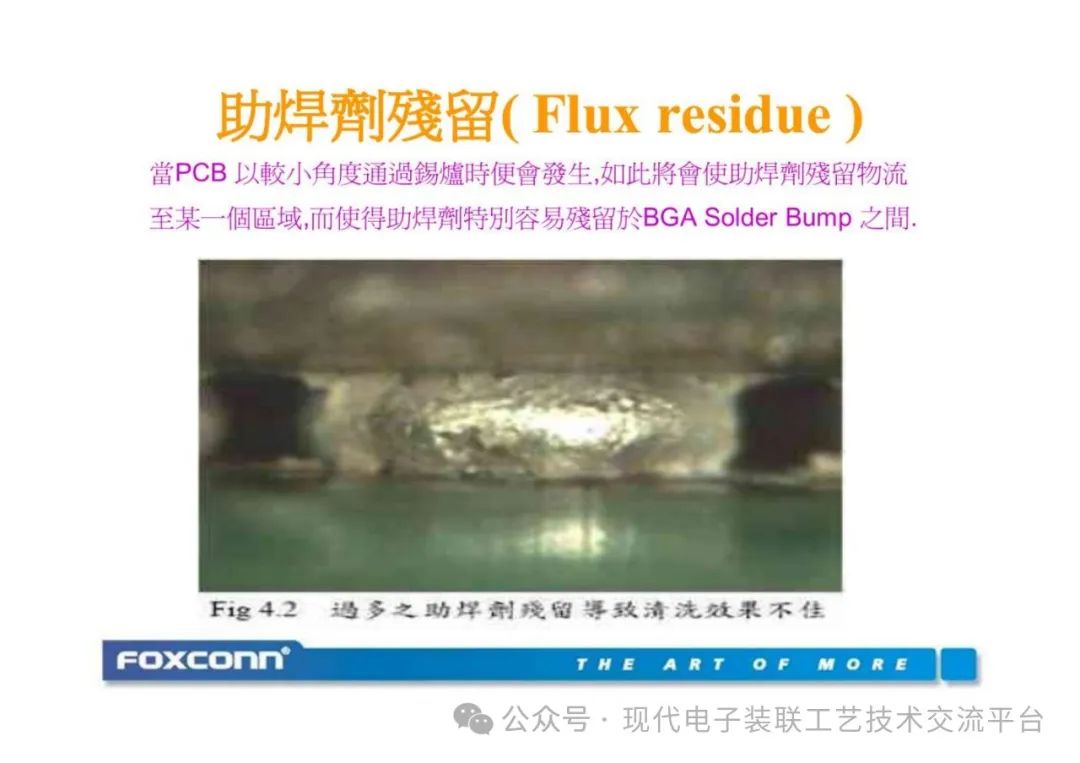
















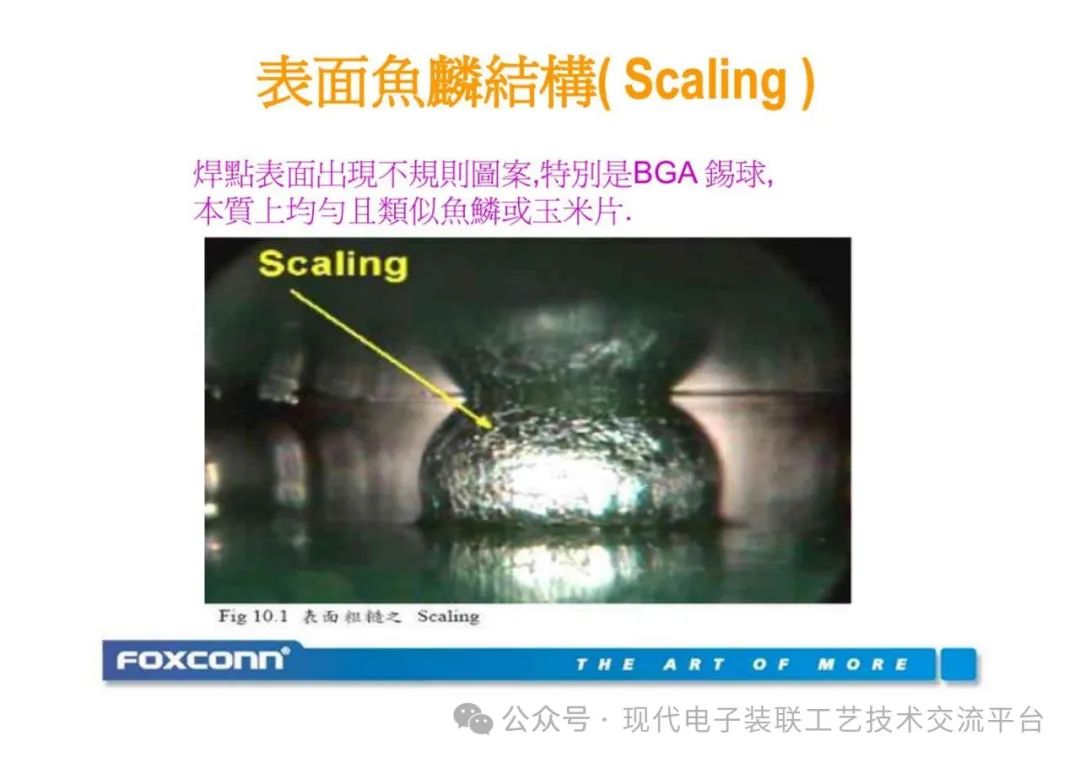

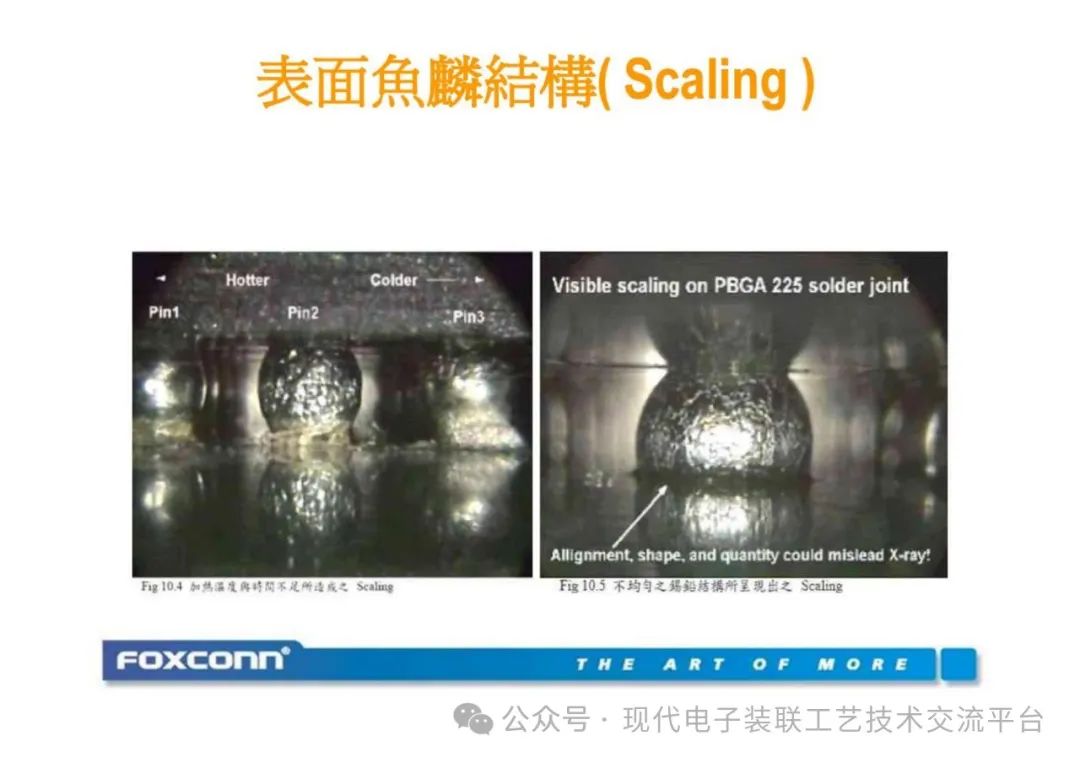










 電子發燒友App
電子發燒友App









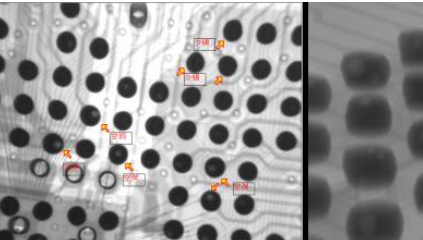




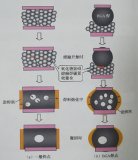
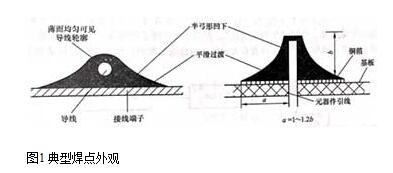
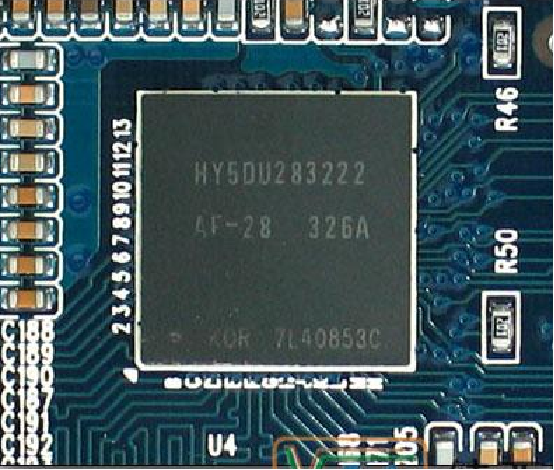

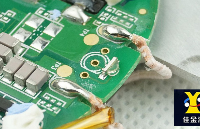
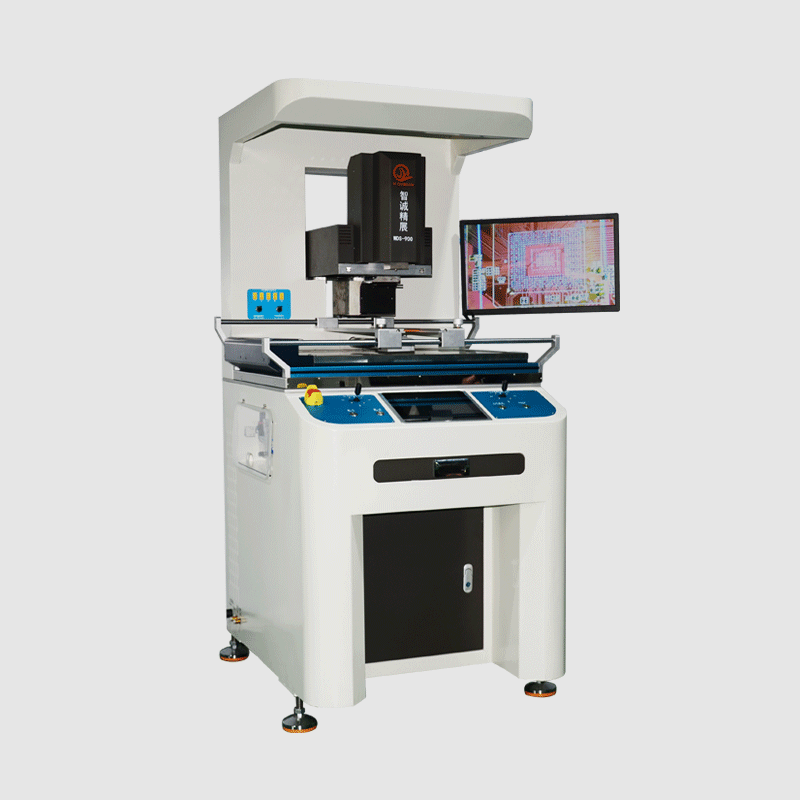



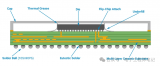





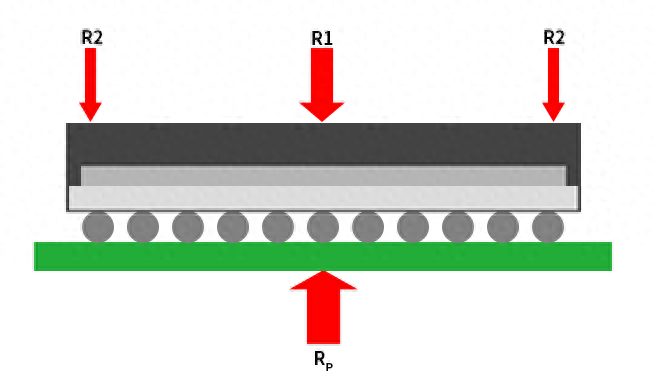






評論