一般公司的新產品開發偶爾會遇到裸機高處落下的【沖擊測試(drop test)】后發生BGA錫球裂開的問題,如果RD有比較好的sense,就應該把產品拿去做一下應力應變分析,而不是直接就把所有的BGA掉落問題都賴給PCBA制造工廠的SMT制程。
就深圳宏力捷的經驗來看,BGA錫球裂開的問題其實很難僅靠工廠的制程管理與加強焊錫來得到全面改善,如果產品設計時RD可以多出一點力氣,制造上就會省下很多的成本。
以下面這個案例來說,可以省下底材填充膠(Underfill)的材料費與工時費用,這還包含了間接管理與修復的費用,也可以提高產品的信賴度,更可以降低日后可能的市場商譽品質損失。
(BGA錫球開裂問題其實牽涉到很多的環節,「焊錫不良」只是其中一項而已,很多人一看焊錫開裂的第一個反應就是焊錫不良,但站在科學客觀的角度來看問題時,只要看到焊錫的IMC有均勻的長成,基本上焊錫就沒有太大的問題,再來就得探討應力與焊錫強度的關系了,因為不論焊錫再如何加強,其承受應力的能力提升總是有限的,一定應力大于焊錫強度,焊錫破裂是可想而知的,所以在檢討完焊錫品質后,接下來就該檢討如何消除應力的來源與加強機構的抗應力設計了,本案例已經是先確認焊錫沒有問題,所以才會要求RD加強機構設計來改善應力沖擊。)
其實BGA錫球開裂的最大問題十有八九都來自于應力(Stress),不管是SMT回焊高溫時板子彎曲變形所形成的應力,還是產品因為機構組裝所形成的應力,或是因為客戶使用時撞擊,或不慎掉落地面所造成的外力,這些其實都是應力的來源,如果設計之初就可以模擬各種狀況做應力應變分析,并針對可能產生應力的部份做一些設計調整以降低應力的影響,相信可以讓BGA產品的生產品質更加穩定,甚至還可以移除一些不必要的underfill制程,達到節省成本的利益。
不知是否因為深圳宏力捷對新產品有過多次的類似要求,還是大家終于認識到設計影響制造的嚴重性,公司這次新產品的設計團隊總算有個比較好的回應,也花了心思做了BGA錫球開裂的特性要因分析,發現應力的來源,并且做了設計變更來改善這個BGA錫球開裂的問題,當然有先用mockup的材料來做驗證,結果也著實讓人滿意,事后實際修模生產后再做最終QA驗證也都沒有再發現BGA開裂的問題,真心希望這個「應力應變驗證動作」以后會是RD驗證的標淮程序。
利用應變計(Strain Gauge)驗證機構設計變更前后對BGA錫球開裂位置的應變量分析
以下就是這款產品的大概設計外型與BGA所在位置,為了方便客戶使用時不至于發生屏幕反光,所以產品設計了一個類似收銀機的傾斜屏幕,也就是這個傾斜角讓BGA零件在產品做正背面落下測試時承受了巨大的電路板變形量,以致造成BGA錫球裂開,因為產品的側邊(side)及角落(corner)摔落都沒有發現問題,以前的例子幾乎都是在角落摔出問題的。

既然知道可能的問題出在電路板變形量過大,于是在電路板上黏貼【應變計(Strain Gauge)】,所先量測未改善前的應變量數據,然后在電路板等主要組件不變得情況下,更換改善后的機構再做一次應變量的量測。
改善方法是在BGA零件的附近新增塑膠機溝肋柱(rib)來頂住電路板以降低電路板在落下時的變形量,參考上圖的[New add rib]。


因為在做這個動作時產品的大部分設計都已經完成了,所以改善的方法就是盡量找到一個空間可以用來增加支撐柱,讓電路板在落下變形時有硬物可以支撐住,以降低其變形量。
既然知道可能的問題出在電路板變形量過大,于是在電路板上黏貼應力計(Stress Gauge)然后先量測未改善前的應力數據。改善方法是在BGA的附近新增機溝肋柱(rib)來頂住電路板以降低電路板在落下時的變形量。
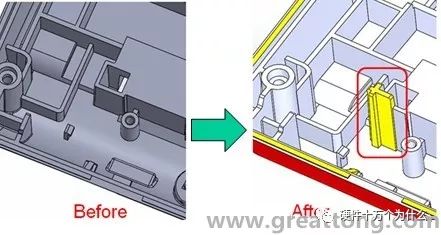
應變計量測機構改善前后的應變量
下表列出改善前與改善后(增加rib)的微應變量(Micro-Strain,x106)實際量測值。就如同預期的,在正面(傾斜面)落下時的應變量改善達到106,因為產品正面(Top)外型有個彎曲傾斜角,比較容易因為外力而造成彎曲;而背面(Bottom)為平面落下的應變量改善則比較小,只有42。
由此可見增加一根肋條(rib)就可以達到一定程度的電路板變形量改善。這個應變值量測的是電路板的Z方向,但是只有X軸的Z值,如果可以加測Y軸的Z值會更有參考價值。
| 改善前 | 改善后 | 改善量 | |
|---|---|---|---|
| 正面落摔 | -186 | -80 | 106 |
| 背面落摔 | 203 | 161 | 42 |
這項設計變更執行后,經過DQ重新驗證落下測試的效果,證實BGA沒有再出現開裂的問題。
、
-
焊錫
+關注
關注
0文章
328瀏覽量
19897 -
BGA
+關注
關注
5文章
584瀏覽量
51537 -
應變計
+關注
關注
0文章
116瀏覽量
12946
原文標題:[案例]BGA錫球裂開的改善對策
文章出處:【微信號:Hardware_10W,微信公眾號:硬件十萬個為什么】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
焊錫激光器如何選擇?揭秘錫球與錫絲、錫膏焊接的波長差異

GT-BGA-2003高性能BGA插座
DSP717HF Wafer植球錫膏重磅推薦

羅徹斯特電子為客戶提供廠內BGA封裝元器件重新植球服務
激光錫焊技術在BGA封裝的應用場景



BGA芯片陣列封裝植球技巧,助力電子完美連接

紫宸激光錫球焊錫機:點亮芯片0.07mm激光植球新征程

解析LGA與BGA芯片封裝技術的區別

BGA封裝焊球推力測試解析:評估焊點可靠性的原理與實操指南




 BGA錫球裂開的改善對策
BGA錫球裂開的改善對策





評論