BGA(Ball Grid Array)是一種高密度的表面貼裝封裝技術(shù),它將芯片的引腳用焊球代替,并以網(wǎng)格狀排列在芯片的底部,通過回流焊與印刷電路板(PCB)上的焊盤連接。然而,BGA也存在一些可靠性問題,其中最常見的就是焊點失效。本文主要介紹兩種典型的BGA焊點失效模式:冷焊和葡萄球效應(yīng)。
冷焊的基本內(nèi)容涵蓋三塊:焊點雜質(zhì)過量、不適當清洗、溫度不足。
我們平常所說的冷焊指的是溫度不足,即在焊接時由于某些因素導致的熱量不足,導致焊錫沒有完全熔化。
實際生產(chǎn)中溫度不足影響冷焊的因素
1.設(shè)備熱補償性能不足,空載時測溫合格,滿載時溫度不足導致冷焊;
2.測溫板制作不合格,測試溫度與實際生產(chǎn)溫度存在差異;
3.無測溫板,替代測溫板與實際產(chǎn)品熱容量不同,差異較大;
4.測溫時未使用載具,實際生產(chǎn)有使用載具過爐導致溫度差異大,以及使用載具與生產(chǎn)時使用載具熱容量不同導致溫度差異;
5.設(shè)備加熱器突然故障;
6.溫度曲線設(shè)置不合格,未測爐溫直接生產(chǎn);
7.設(shè)備報警,操作人員未確認直接按鍵導致設(shè)備降溫;
8.溫度曲線程序調(diào)用錯誤;
9.未升溫合格即開始過板;
10.物體遮擋導致溫度不足如料帶等異物遮蔽。
葡萄球效應(yīng)
另一類BGA 焊點失效模式稱為“葡萄球效應(yīng)”。
葡萄球效應(yīng)產(chǎn)生機理為錫膏助焊劑損耗過度無法清除焊接端表面的氧化膜及錫膏錫粉顆粒表層的氧化膜,錫粉熔化但無法融合,冷卻后成顆粒狀。
葡萄球效應(yīng)的產(chǎn)生很多時候是PCBA工藝人員照抄錫膏廠商推薦溫度曲線,未關(guān)注恒溫區(qū)溫度起止點及恒溫區(qū)起點到焊錫熔化溫度間總時間。
應(yīng)對策略
為了預(yù)防和避免冷焊和葡萄球效應(yīng)的發(fā)生,需要從以下幾個方面進行改進:
1.使用更長使用壽命的錫膏,減少錫膏受潮氧化和助焊劑揮發(fā)的可能性。
2.適當縮短回流焊曲線中的恒溫時間,避免助焊劑過度揮發(fā)。但是,恒溫時間也不能太短,否則會導致錫膏融化不均勻,影響焊接質(zhì)量和可靠性。一般來說,恒溫時間應(yīng)該控制在60~120s之間,以達到最佳的效果。
3.使用氮氣保護來降低錫膏氧化速度。
審核編輯 黃宇
-
BGA焊點
+關(guān)注
關(guān)注
0文章
5瀏覽量
11361 -
失效分析
+關(guān)注
關(guān)注
18文章
250瀏覽量
67737
發(fā)布評論請先 登錄
GT-BGA-2003高性能BGA插座
羅徹斯特電子為客戶提供廠內(nèi)BGA封裝元器件重新植球服務(wù)
拉力測試過關(guān),產(chǎn)品仍會失效?揭秘不可替代的半導體焊球-剪切測試

BGA植球中助焊劑的應(yīng)用工序及核心要求

BGA芯片陣列封裝植球技巧,助力電子完美連接

紫宸激光錫球焊錫機:點亮芯片0.07mm激光植球新征程

推拉力測試機在CBGA焊點強度失效分析中的標準化流程與實踐

基于硅基異構(gòu)集成的BGA互連可靠性研究

PCBA加工冷焊頻發(fā)?這些原因你必須知道!
BGA失效分析原因-PCB機械應(yīng)力是罪魁禍首

新能源汽車焊接材料五大失效風險與應(yīng)對指南——從焊點看整車可靠性

BGA封裝焊球推力測試解析:評估焊點可靠性的原理與實操指南




 BGA焊點失效分析——冷焊與葡萄球效應(yīng)
BGA焊點失效分析——冷焊與葡萄球效應(yīng)

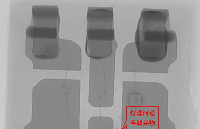



評論