引言
我們介紹了在氫氧化鉀溶液中蝕刻的車輪圖案和寬分離的V形槽的硅蝕刻速率測量。數據表明,當使用貨車輪圖案時,存在反應物耗盡效應,這掩蓋了真實的表面反應速率限制的蝕刻速率。與以前的報道相反,從受反應物傳輸影響較小的寬間隔V形槽獲得的蝕刻速率表明{ 111}蝕刻的活化能小于{ 100}蝕刻的活化能。我們的實驗得到{ 111}面的激活能為0.53 eV,而{ 100}面的激活能為0.62 eV。表觀活化能對{ 111}的微小角度偏差高度敏感。
介紹
氫氧化鉀和其它溶液中硅的各向異性腐蝕已廣泛用于我們的實驗室和其它地方,以制造用于光電子器件的V形槽,包括硅晶片板、OLED 1×N光纖分路器、1×N光開關和2×2光折射板開關。了解{ 111}面和{ 111}面附近的各向異性腐蝕行為對于V形槽腐蝕的精細設計和精確控制是必要的。 (111}硅平面的蝕刻速率遠低于{ 111 }硅平面的蝕刻速率其他晶面是各向異性蝕刻的基本性質。正是由于這種行為,深V形槽可以用精確定義的。頂角。盡管這一事實很重要,但晶體蝕刻速率各向異性的基本機制仍有爭議。
在這項工作中,除了用車輪掩模獲得的蝕刻速率之外,我們還研究了廣泛分離的V形槽蝕刻速率。我們發現,緊密間隔的V形槽始終以比寬間隔的V形槽更低的速率蝕刻,這意味著反應速率受到反應物和/或產物種類擴散的影響。為了獲得真實的反應速率限制的蝕刻速率的精確估計,這些擴散效應必須被最小化。此外,我們發現由晶片平面的輕微錯位引起的誤差也必須考慮在內。進行這些修正后,我們的結果表明{ 111}硅腐蝕的活化能小于{ 100}硅腐蝕的活化能。本文描述了我們的實驗,并討論了我們的結果和以前估計的{ 111}腐蝕速率激活能之間的差異。
討論
圖1顯示了在同一晶圓上測得的兩組橫向欠蝕刻數據。該實驗清楚地表明,寬間隔V形槽的{ 111}蝕刻速率大于緊密間隔的車輪圖案的蝕刻速率。這個結果可以解釋如下。在化學蝕刻過程中,反應物質在表面不斷被消耗。結果,建立了從反應表面到溶液主體的濃度梯度;這種濃度梯度是通過擴散將反應物種推向表面的力。蝕刻的整體動力學將由反應和擴散兩個過程中較慢的一個來決定。有一個通用的標準來區分水化學過程的動力學:表觀活性
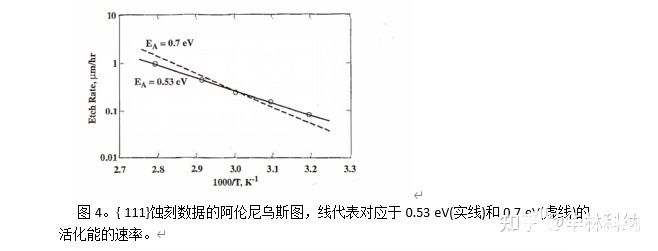
?

對于擴散限制過程,其能量約為0.13-0.26eV,而對于反應限制過程,其能量約為0.43-0.86eV。我們在實驗中發現的{111}蝕刻的活化能為0.53eV,在表面反應限制過程的范圍內。在使用馬車輪模式或緊密間隔的v型凹槽的實驗中,附近模式的存在導致了對可用反應物物種的競爭。這種競爭導致反應物的局部耗盡,驅動反應的速度比大間隔的模式更慢。
所有觀察到的蝕刻輪廓,其中蝕刻圖案中心的蝕刻深度比邊緣更淺。這種效應可以用靠近掩模邊緣和蝕刻圖案中心的反應物的擴散限制傳輸之間的差異來解釋。還報道了“一些損耗效應是可觀察到的”的氫氧化鉀蝕刻。
由于我們的樣品都有廣泛間隔的v型凹槽和緊密間隔的瓦輪模式,我們可以將觀察到的蝕刻行為與兩種掩模模式進行比較。由于馬車輪圖案的角增量較粗糙,我們不能從緊密間隔的圖案中引用{111}蝕刻的活化能的定量值。然而,對于{111}和{100}蝕刻的相對活化能,我們可以做出一個強有力的定性陳述。圖5顯示了在兩次蝕刻溫度下進行蝕刻后的馬車-車輪模式。虛線圈表示平面的橫向切割程度;這些圓的半徑成正比。
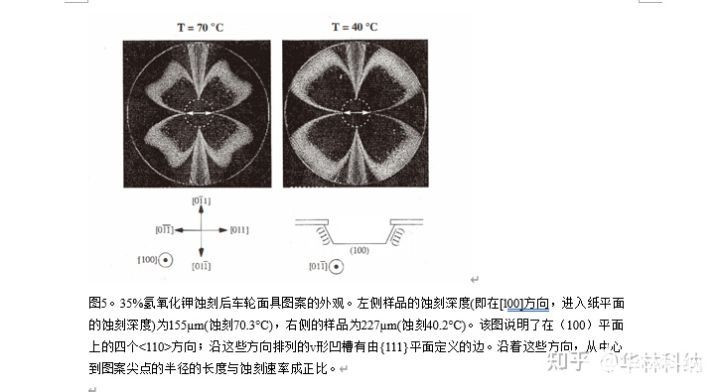
結論
通過比較從馬車輪和分離的v槽模式測量的反應速率,我們得出結論,由于反應物運輸的影響減少,從分離的v槽模式測量的{111}平面附近的反應速率提供了更準確的估計,即表面反應速率有限的活化能。我們在35%的氫氧化鉀中進行了各向異性硅蝕刻實驗,結果是{100}平面的活化能為0.62eV,{111}平面的活化能為0.53eV。車輪模式的定性結果顯示,{111}上的活化能高于{100}上,與以前報道的結果一致。
?
 電子發燒友App
電子發燒友App










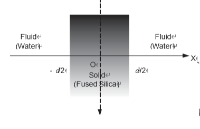



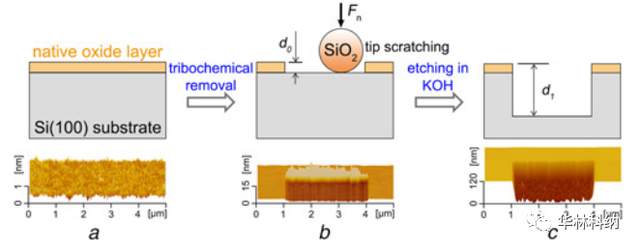
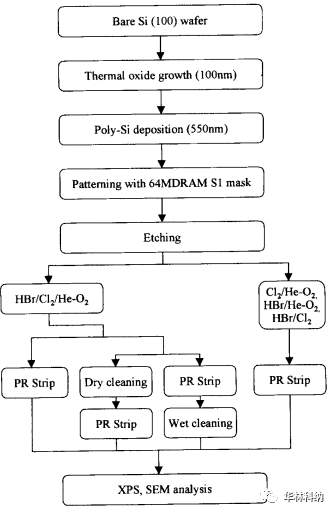

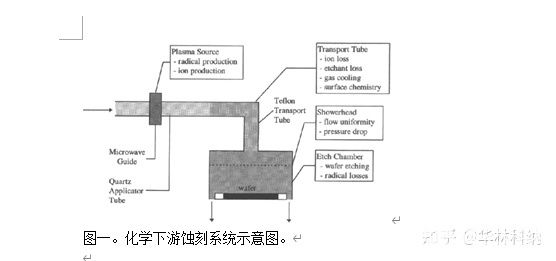

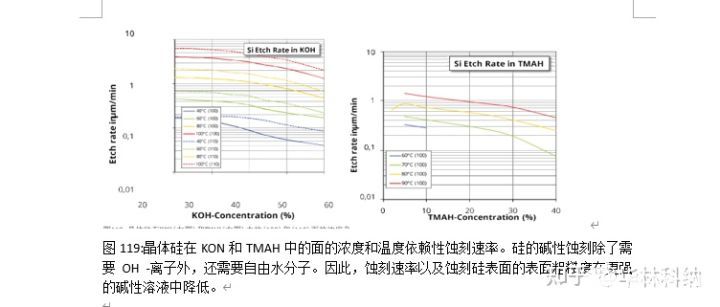


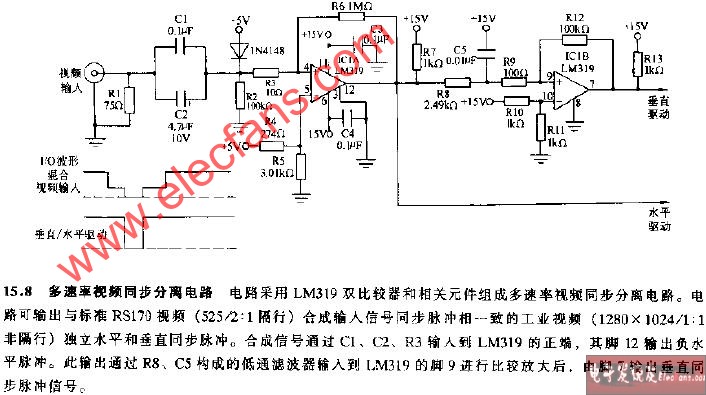
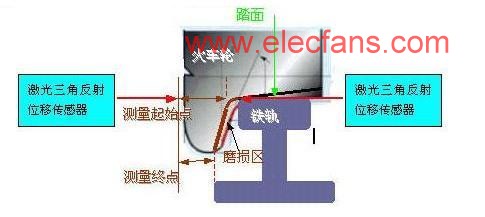


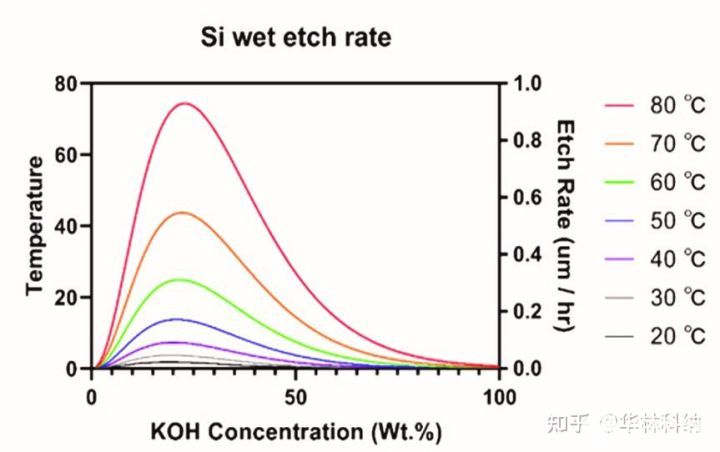
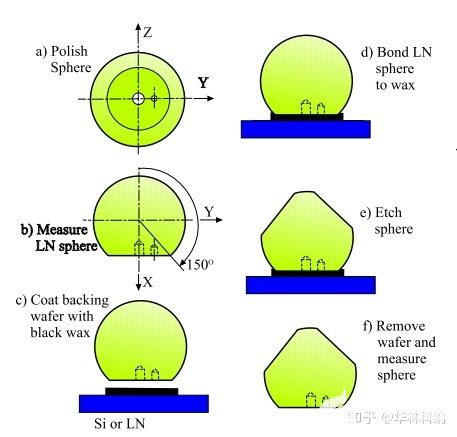
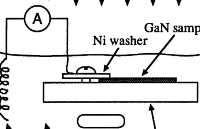

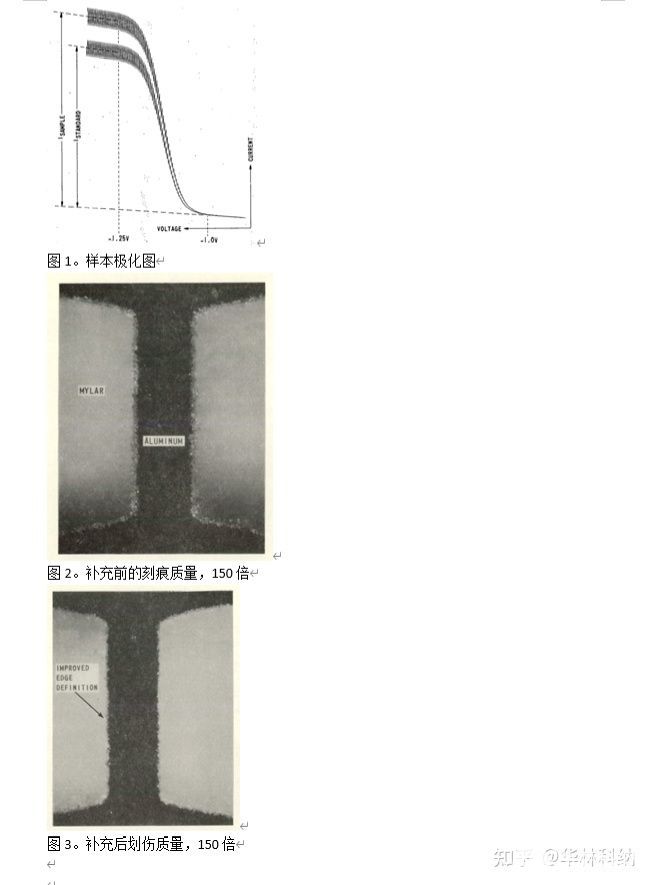

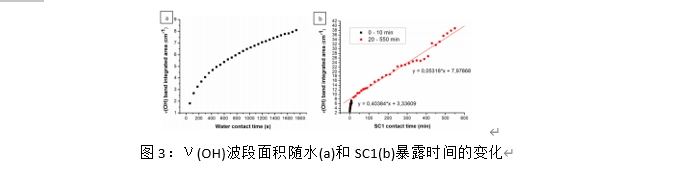
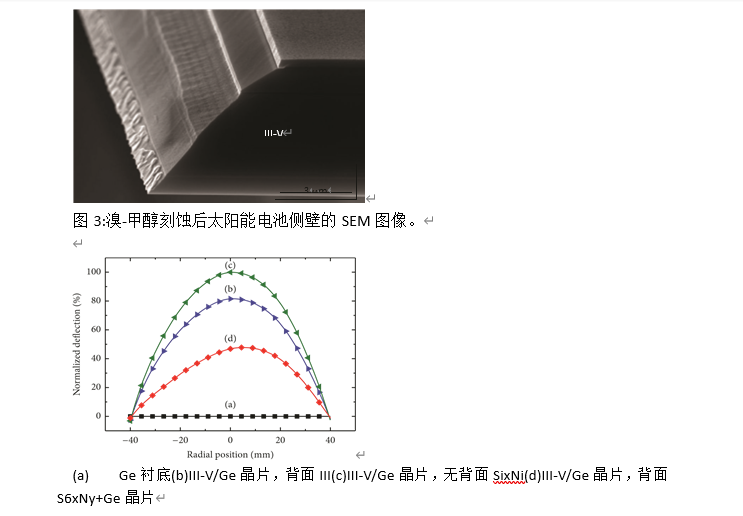






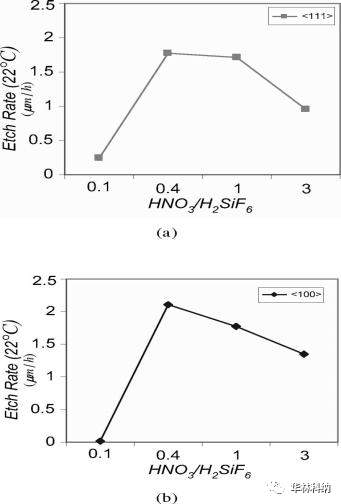
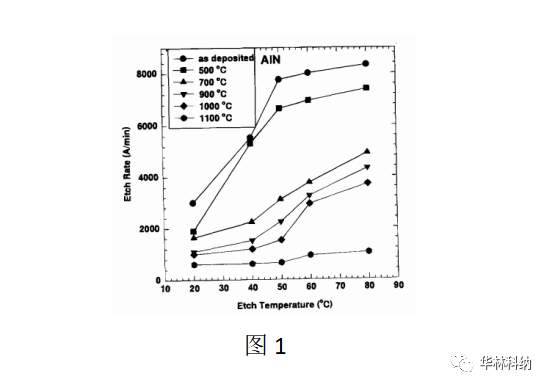
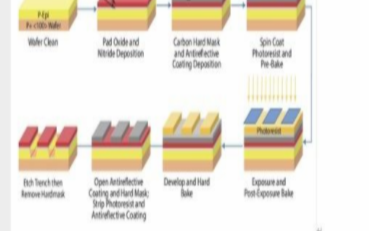
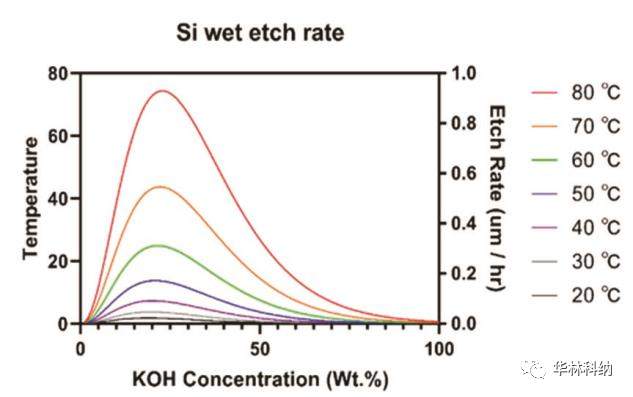

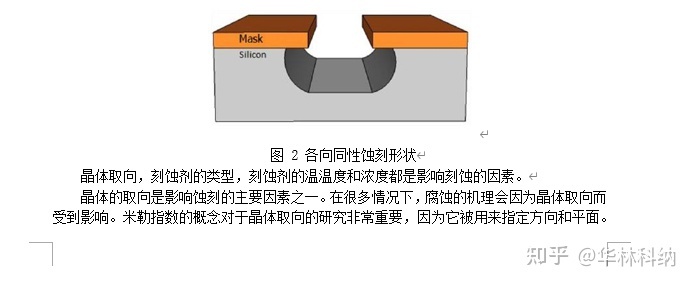

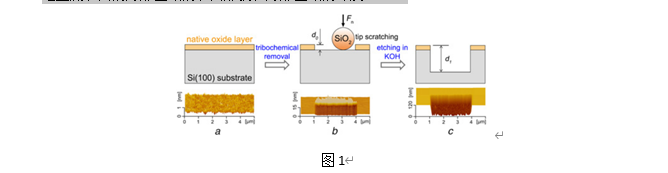

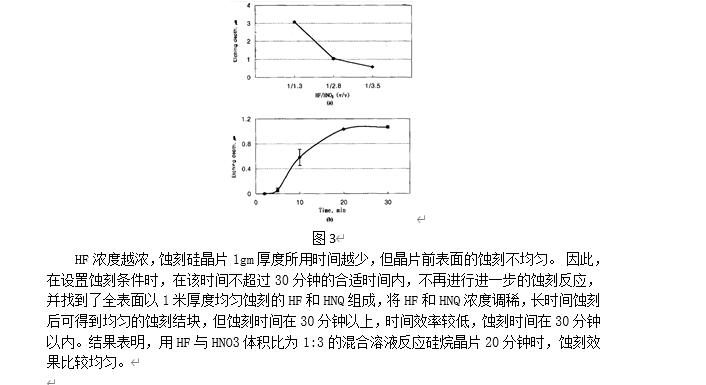
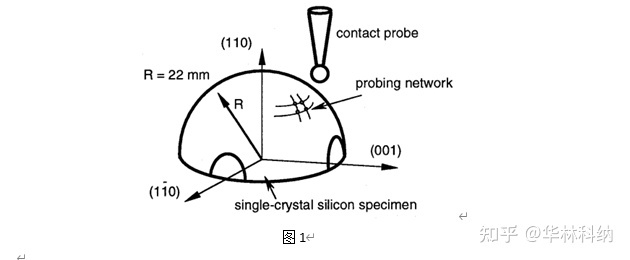

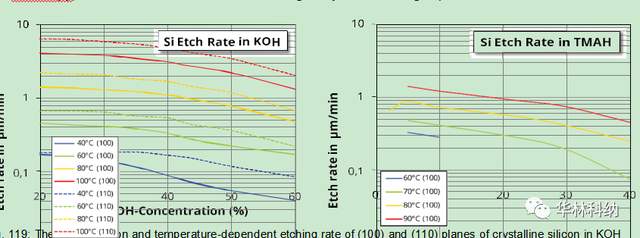
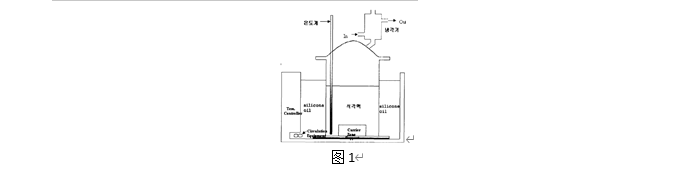


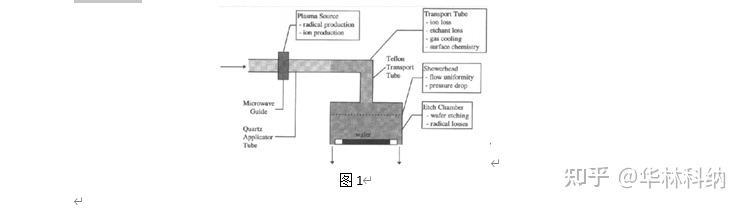

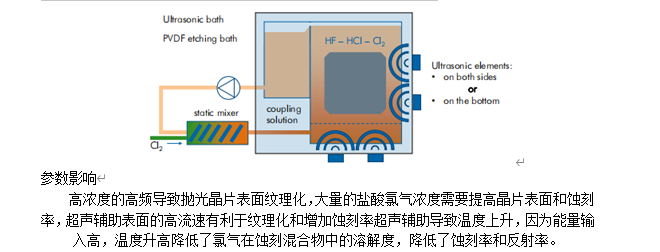
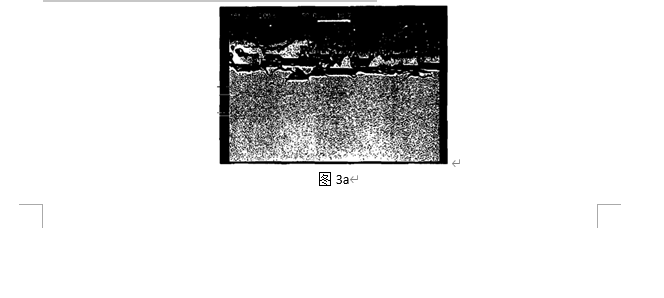

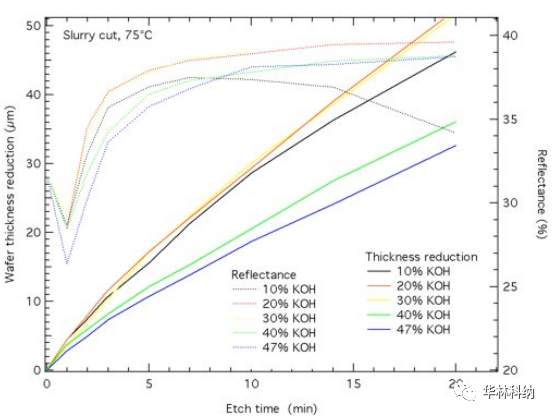
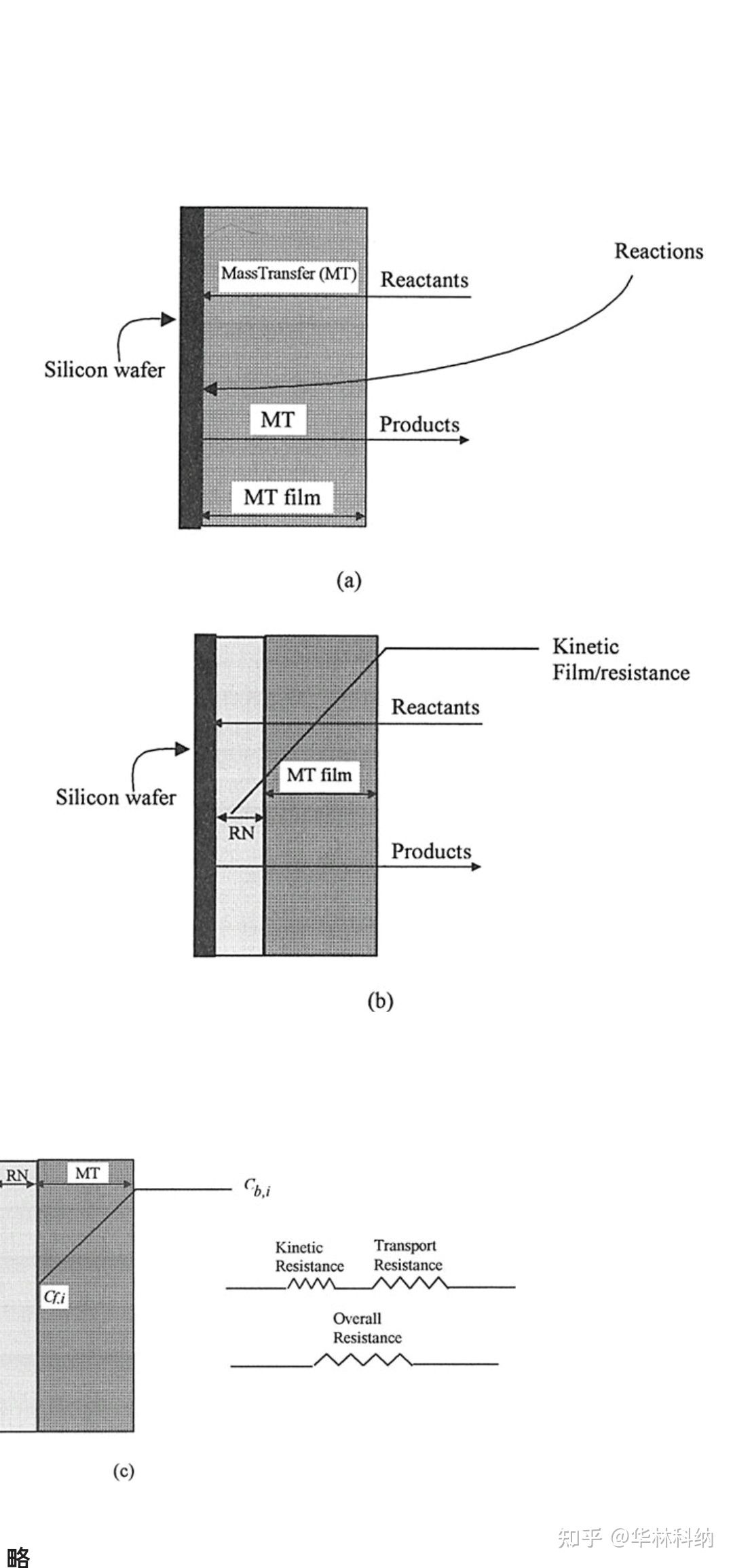
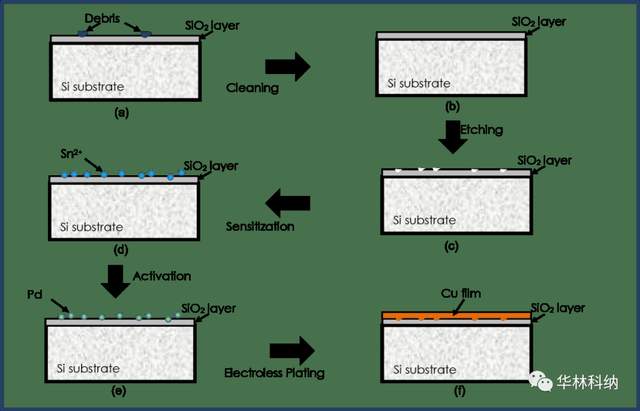
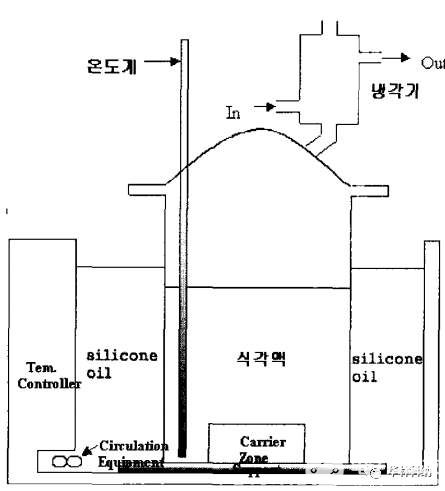

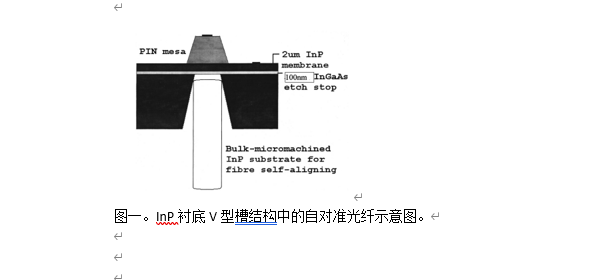
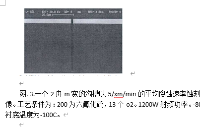
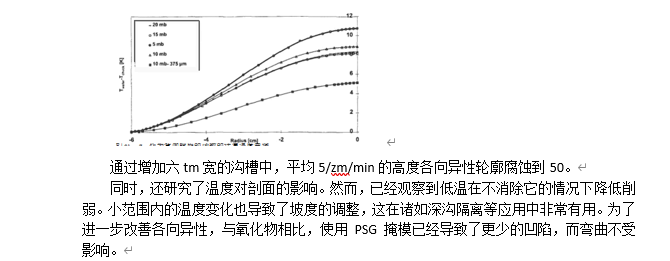

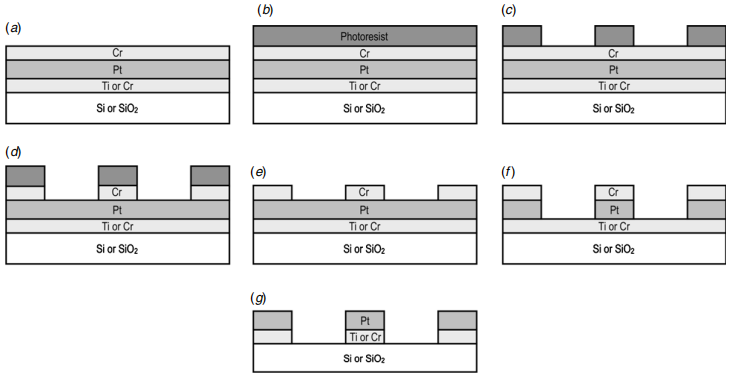




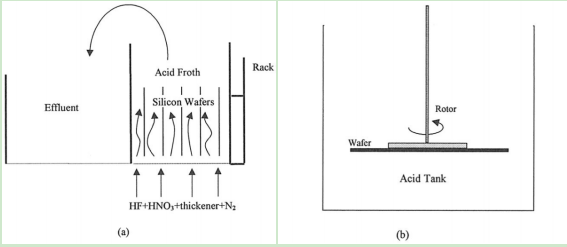



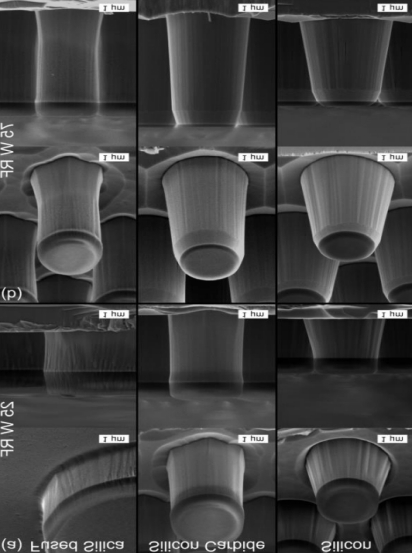
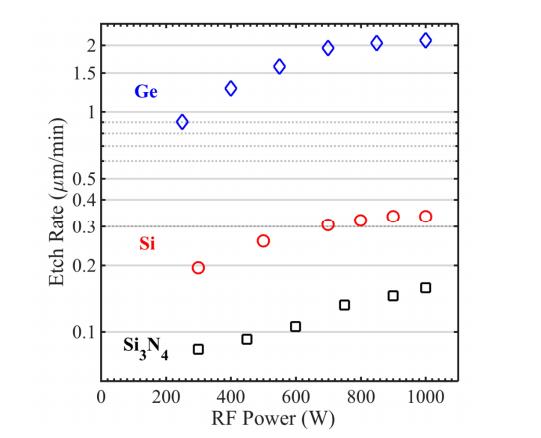







評論