引言
蝕刻是微結構制造中采用的主要工藝之一。它分為兩類:濕法蝕刻和干法蝕刻,濕法蝕刻進一步細分為兩部分,即各向異性和各向同性蝕刻。硅濕法各向異性蝕刻廣泛用于制造微機電系統(MEMS)的硅體微加工和太陽能電池應用的表面紋理化。
蝕刻速率受蝕刻劑中的雜質(或添加劑)的顯著影響。然而,四甲基氫氧化銨(TMAH)和氫氧化鉀溶液(KOH)最廣泛地用于硅濕體微加工中微結構的形成,兩種蝕刻劑各有利弊。
實驗與討論

圖1:純堿性溶液中的蝕刻機理
英思特公司研究了堿性溶液中控制蝕刻過程的化學反應,并提出了幾種模型。各向異性蝕刻由兩個交替反應組成,即(i)氧化(ii)蝕刻,其特點是氧化與蝕刻相比非常慢。通常,硅表面原子被氫封端。氫氧根(OH-)離子和水(H2O)分子是堿性溶液(KOH、TMAH)中的化學活性物質。圖1顯示了純堿性溶液中的蝕刻機制。氧化步驟可以通過化學氧化和/或電化學氧化發生。(江蘇英思特半導體科技有限公司)
在純堿性溶液中,蝕刻表面形貌主要取決于蝕刻劑濃度和蝕刻溫度。在KOH溶液的情況下,當濃度稀釋到小于8M(30wt%)時,微金字塔開始出現在Si{100}上,如圖2所示,已經提出了各種模型來解釋蝕刻過程中形成小丘的主要原因。
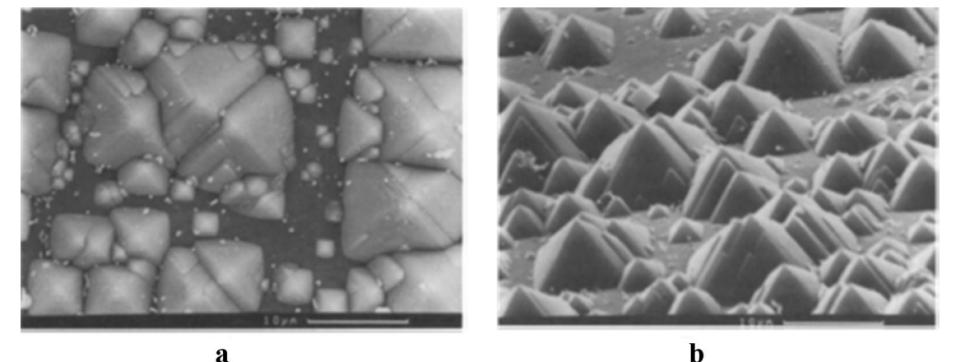
圖2:在70℃的4.0 M氫氧化鉀中蝕刻30 min后,Si{100}表面微金字塔的SEM圖像
為了研究硅(Si){100}表面的底切,通常使用由<110>方向形成的矩形掩模圖案,如圖3中示意性所示。底切的增加表明,當將羥胺(NH2OH)添加到TMAH/KOH中時,高折射率平面的蝕刻速率也顯著提高。底切的增量是純TMAH/KOH的三倍以上,這非常有利于從基板上快速釋放結構,從而最大限度地減少工業制造時間。
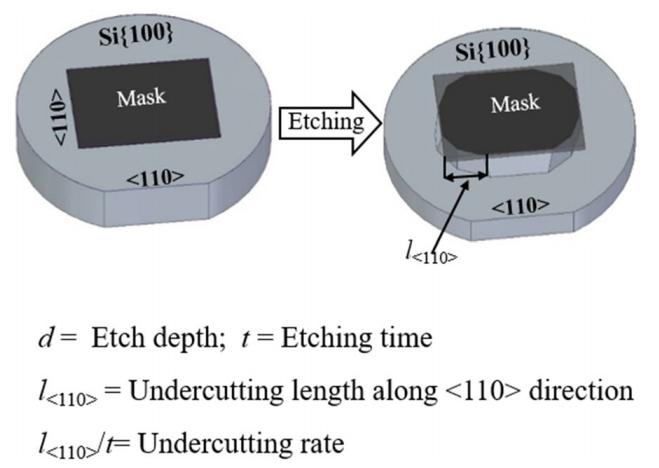
圖3:矩形掩模圖案的凸角處的下切示意圖
結論
蝕刻劑濃度顯著影響蝕刻速率。有兩種方法可以達到蝕刻速率的局部最大值,各有利弊。第一種方法是使用稀釋的氫氧化鉀(KOH)或四甲基氫氧化銨(TMAH)溶液蝕刻硅(Si)。優點是易于應用,缺點是蝕刻速率適度增加,微金字塔的出現不可避免地導致蝕刻表面粗糙度。第二種方法是使用50 wt% KOH 的高濃度溶液在接近沸點(通常為145℃)下進行蝕刻。優點是可用的蝕刻速率約為10μ/min,缺點是Si和氧化物掩模之間的蝕刻選擇性較低,需要替代掩模材料。(江蘇英思特半導體科技有限公司)
蝕刻特性受不同種類的添加劑的強烈影響。英思特已經研究了各種添加劑來提高硅的蝕刻速率。在KOH溶液中添加氧化還原體系和絡合劑可有效提高蝕刻速率,但這些添加劑未被其他研究人員進一步研究,因此在濕法各向異性蝕刻中并不常見。
江蘇英思特半導體科技有限公司主要從事濕法制程設備,晶圓清潔設備,RCA清洗機,KOH腐殖清洗機等設備的設計、生產和維護。
審核編輯黃宇
-
半導體
+關注
關注
339文章
31086瀏覽量
265806 -
蝕刻
+關注
關注
10文章
431瀏覽量
16670
發布評論請先 登錄
基于各向異性磁阻(AMR)的納芯微 MT68xx 編碼器:磁場—角度信號鏈與高精度校準技術-艾畢勝電子
[VirtualLab] 各向異性方解石晶體的雙折射效應
解讀VCE2758:18位各向異性磁阻(AMR)編碼器的技術魅力
深度解析VCE2755:18位各向異性磁阻(AMR)編碼器的卓越性能與應用
橢偏術精準測量超薄膜n,k值及厚度:利用光學各向異性襯底

【新啟航】碳化硅 TTV 厚度測量中的各向異性效應及其修正算法

基于各向異性磁阻(AMR)效應的MT6701磁編碼器原理及其在數控機床主軸精密位移測量中的性能研究

【新啟航】如何解決碳化硅襯底 TTV 厚度測量中的各向異性干擾問題

濕法刻蝕是各向異性的原因

微加工激光蝕刻技術的基本原理及特點
詳解各向異性導電膠的原理

碳化硅襯底厚度測量探頭溫漂與材料各向異性的耦合影響研究




 高速硅濕式各向異性蝕刻技術在批量微加工中的應用
高速硅濕式各向異性蝕刻技術在批量微加工中的應用






評論