這本文中,我們提出了一種精確的,低損傷的循環(huán)刻蝕AlGaN/GaN的新方法,用于精確的勢壘凹陷應用,使用ICP-RIE氧化和濕法刻蝕。設備功率設置的優(yōu)化允許獲得寬范圍的蝕刻速率~0.6至~11納米/周期,而相對于未蝕刻的表面,表面粗糙度沒有任何可觀察到的增加。
2021-12-13 16:07:58 3519
3519 
引言 用多能氬離子輻照x射線切割鈮酸鋰單晶,產生厚度為400納米的均勻損傷表面層,研究其在HF水溶液中的腐蝕行為。使用不同的酸溫度和濃度,表明可以通過將溫度從24℃提高到55℃來提高蝕刻速率,同時
2021-12-23 16:36:59 2054
2054 不同的蝕刻劑(氯化鐵和氯化銅)進行化學蝕刻。研究了選擇的蝕刻劑和加工條件對蝕刻深度和表面粗糙度的影響。實驗研究表明,氯化鐵產生的化學腐蝕速率最快,但氯化銅產生的化學腐蝕速率最快最光滑的表面質量。 關鍵詞:化學蝕刻;銅
2021-12-29 13:21:46 3441
3441 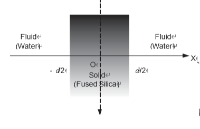
本文提出了一種利用原子力顯微鏡(AFM)測量硅蝕刻速率的簡單方法,應用硅表面的天然氧化物層作為掩膜,通過無損摩擦化學去除部分天然氧化物,暴露底下新鮮硅。因此,可以實現(xiàn)在氫氧化鉀溶液中對硅的選擇性蝕刻,通過原子精密的AFM可以檢測到硅的蝕刻深度,從而獲得了氫氧化鉀溶液中精確的硅蝕刻速率。
2022-04-22 14:06:01 1908
1908 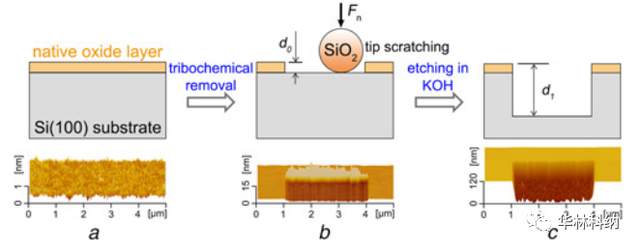
、Br、O和F的密度,測量300毫米硅片的蝕刻速率來檢查等離子體的均勻性,發(fā)現(xiàn)氯和溴在金屬上的復合概率與在陽極氧化鋁上的復合概率相似,然而,氟和氧的復合受到金屬殘留物的強烈影響,因此,對于基于氟和氧的等離子體,金屬殘留物顯示出對等離子體均勻性有影響。
2022-05-05 14:26:56 1508
1508 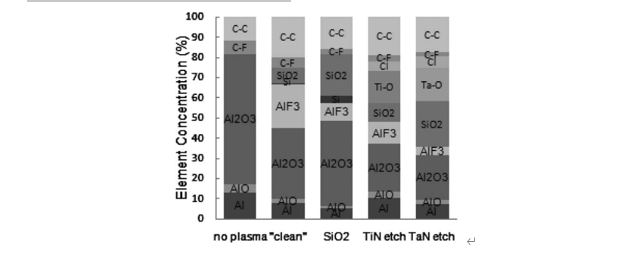
的電子和光電子器件的制造中對高選擇性濕法化學蝕刻劑的額外需求,還進行了廣泛的研究以檢驗多種蝕刻溶液。列出了這些蝕刻劑的蝕刻速率、選擇性和表面粗糙度,以驗證它們對預期應用的適用性。盡管頻繁使用GaSb或
2022-05-11 14:00:42 1844
1844 
引言 正在開發(fā)化學下游蝕刻(CDE)工具,作為用于半導體晶片處理的含水酸浴蝕刻的替代物。對CDE的要求包括在接近電中性的環(huán)境中獲得高蝕刻速率的能力。高蝕刻率是由含NF”和0的混合物的等離子體放電分解
2022-06-29 17:21:42 4326
4326 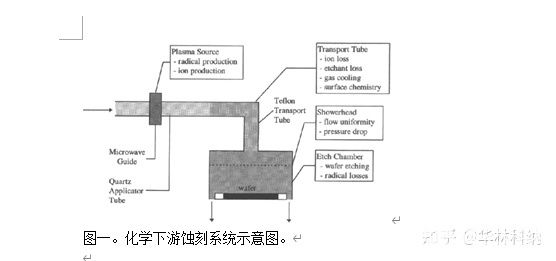
他方向上的蝕刻速度快,而各向同性蝕刻(如HF)會向所有方向侵蝕。使用KOH工藝是因為其在制造中的可重復性和均勻性,同時保持了較低的生產成本。異丙醇(IPA)經常添加到溶液中,以改變從{110}壁到{100}壁的選擇性,并提高表面光滑度。 氧化物和氮化物
2022-07-14 16:06:06 5995
5995 
通過高選擇性蝕刻,專用蝕刻工具可在 IC 生產過程中去除或蝕刻掉微小芯片結構中的材料
2023-03-20 09:41:49 2966
2966 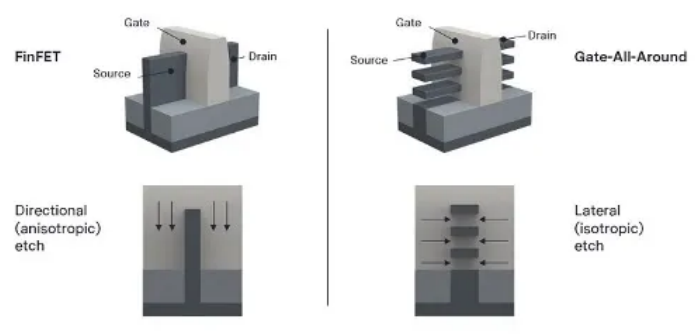
。攪拌蝕刻是使用旋轉輪把蝕刻液濺到基板上,這種蝕刻比較均勻。噴射蝕刻,顧名思義,就是用專門的工具把藥液噴射到基板上,其速度和噴射形狀、位置都可以控制,效果比較好。蝕刻所使用的藥液有多重,主要有硝酸系
2017-02-21 17:44:26
為了在基板上形成功能性的MEMS結構,必須蝕刻先前沉積的薄膜和/或基板本身。通常,蝕刻過程分為兩類:浸入化學溶液后材料溶解的濕法蝕刻干蝕刻,其中使用反應性離子或氣相蝕刻劑濺射或溶解材料在下文中,我們將簡要討論最流行的濕法和干法蝕刻技術。
2021-01-09 10:17:20
PCB制作工藝中的堿性氯化銅蝕刻液1.特性1)適用于圖形電鍍金屬抗蝕層,如鍍覆金、鎳、錫鉛合金,錫鎳合金及錫的印制板的蝕刻。 2)蝕刻速率快,側蝕小,溶銅能力高,蝕刻速率容易控制。 3)蝕刻液可以
2018-02-09 09:26:59
,國內也有少量企業(yè)用此法量產。 ②難點:板面鍍銅層厚度的均勻性較難控制。出現(xiàn)板四周銅層厚,中間薄的現(xiàn)象,蝕刻難以均勻,細線路難生產。 ③干膜蓋孔,尤其是孔徑大的孔,如掩蓋不住,蝕刻液進到孔內,孔內銅被
2018-09-21 16:45:08
蝕問題,蝕刻后的導線側壁接近垂直。 3)溫度:溫度對蝕刻液特性的影響比較大,通常在化學反應過程中,溫度對加速溶液的流動性和減小蝕刻液的粘度,提高蝕刻速率起著很重要的作用。但溫度過高,也容易引起蝕刻液
2018-09-11 15:19:38
化學反應過程中,溫度對加速溶液的流動性和減小蝕刻液的粘度,提高蝕刻速率起著很重要的作用。但溫度過高,也容易引起蝕刻液中一些化學成份揮發(fā),造成蝕刻液中化學組份比例失調,同時溫度過高,可能會造成高聚物抗
2013-10-31 10:52:34
的。但是所有有關蝕刻的理論都承認這樣一條最基本的原則,即盡量快地讓金屬表面不斷的接觸新鮮的蝕刻液。對蝕刻過程所進行的化學機理分析也證實了上述觀點。在氨性蝕刻中,假定所有其它參數不變,那么蝕刻速率主要由蝕刻液
2018-11-26 16:58:50
1.問題:印制電路中蝕刻速率降低 原因: 由于工藝參數控制不當引起的 解決方法: 按工藝要求進行檢查及調整溫度、噴淋壓力、溶液比重、PH值和氯化銨的含量等工藝參數到工藝規(guī)定值。 2.
2018-09-19 16:00:15
鍍銅的最大缺點是板面各處都要鍍兩次銅而且蝕刻時還必須都把它們腐蝕掉。因此當導線線寬十分精細時將會產生一系列的問題。同時,側腐蝕會嚴重影響線條的均勻性。 在印制電路板外層電路的加工工藝中,捷多邦王高工
2018-09-13 15:46:18
摘要
對于AR/MR(增強現(xiàn)實或混合現(xiàn)實)設備領域的光導系統(tǒng)的性能評估,眼盒中光分布的橫向均勻性是最關鍵的參數之一。為了在設計過程中測量和優(yōu)化橫向均勻性,VirtualLab Fusion提供了一
2025-04-30 08:49:14
性探測器,可以進行所需的研究。在本文件中,我們將演示可用的選項以及如何操作均勻性探測器。
案例演示
均勻性探測器
探測器功能:相干參數
?如果存在多個相干模式,則重疊的模可以相干疊加、非相干疊加
2025-02-08 08:57:22
關系 ,蝕刻表面保持光滑。相比之下,在 H2O2 含量較高的溶液中蝕刻會導致表面明顯粗糙。GaAs 的蝕刻速率與 InGaP 的蝕刻速率大致相同。因此,該溶液適用于非選擇性 MESA 蝕刻。這 HC1
2021-07-09 10:23:37
的歷史蝕刻工藝進行了兩個主要的工藝更改,這使得這項工作成為必要。首先,我們從 Clariant AZ4330 光刻膠切換到 Shipley SPR220-3。我們發(fā)現(xiàn)后者的光刻膠具有更好的自旋均勻性
2021-07-06 09:39:22
鏡面硅結構時,表面的平滑度和蝕刻速率是關鍵參數。我們展示了一種從單晶硅創(chuàng)建 45° 和 90° 蝕刻平面的方法,用作微流體裝置中的逆反射側壁。該技術使用相同的光刻圖案方向,但使用兩種不同的蝕刻劑。用
2021-07-19 11:03:23
:MacEtch 是一種濕法蝕刻工藝,可提供對取向、長度、形態(tài)等結構參數的可控性,此外,它是一種制造極高縱橫比半導體納米結構的簡單且低成本的方法。 3 該工藝利用了在氧化劑(例如過氧化氫 (H2O2))和酸(例如
2021-07-06 09:33:58
十分精細時將會產生一系列的問題。同時,側腐蝕會嚴重影響線條的均勻性。在印制板外層電路的加工工藝中,還有另外一種方法,就是用感光膜代替金屬鍍層做抗蝕層。這種方法非常近似于內層蝕刻工藝,可以參閱內層制作
2018-04-05 19:27:39
不均勻性的定義可以這樣說:組成系統(tǒng)是由傳輸線+功能電路,這中間會遇到大量的不均勻性或者說不連續(xù)性。對于不均性的研究有兩個方面,不均勻性分析方法和不均勻性的應用。嚴格分析不均勻性是一個相當復雜
2009-11-02 17:13:34
過程中的一些參數,改變噴淋的一些操作方式等進行相關研究工作。本文將從流體力學的角度,建立模型來分析流體在銅導線之間凹槽底部各個位置的相對蝕刻速度,從本質上研究蝕刻液流體的蝕刻過程的機理。 1. 模型建立
2018-09-10 15:56:56
噴灑在板子的表面。它把新鮮的溶液噴灑在板子上,具有很高的蝕刻速率。下列因素決定了蝕刻的均勻程度: 1 )噴灑樣式、力量、噴灑量的一致性和排放的位置; 2) 蝕刻劑的化學性能、泵的壓力、噴嘴的外形
2018-09-11 15:27:47
﹐就是盡速讓金屬表面不斷地接觸新鮮的蝕刻液。 在氨性蝕刻中﹐假定所有參數不變﹐那么蝕刻的速率將主要由蝕刻液中的氨(NH3)來決定。因此, 使用新鮮溶液與蝕刻表面相互作用﹐其主要目的有兩個﹕沖掉剛產生的銅
2017-06-23 16:01:38
內測試,結束后測量各鉛條的各段的殘厚也可以知道壓機 的均勻性,并且數值可以量化。另外,比較老土的方法是使用復寫紙放在一張白紙上面,進行壓合的操作,然后檢查經過壓合后白紙上留下的印痕,就可以知道壓機平臺
2018-08-30 10:49:21
壓機內測試,結束后測量各鉛條的各段的殘厚也可以知道壓機 的均勻性,并且數值可以量化。 另外,比較老土的方法是使用復寫紙放在一張白紙上面,進行壓合的操作,然后檢查經過壓合后白紙上留下的印痕,就可以知道
2018-11-22 15:41:50
圖像傳感器是什么?非均勻性多點校正法又是什么?該如何有效地降低圖像傳感器的非均勻性,從而獲得較為理想的圖像質量?
2021-04-12 07:03:01
晶片邊緣的蝕刻機臺,特別是能有效地蝕刻去除晶片邊緣劍山的一種蝕刻機,在動態(tài)隨機存取存儲單元(dynamic random access memory,DRAM)的制造過程中,為了提高產率,便采用
2018-03-16 11:53:10
我司是做濕法蝕刻藥水的,所以在濕法這塊有很多年的研究。所以有遇到濕法蝕刻問題歡迎提問,很愿意為大家解答。謝謝!QQ:278116740
2017-05-08 09:58:09
提供了均勻性探測器,可以進行所需的研究。在本文件中,我們將演示可用的選項以及如何操作均勻性探測器。
**案例演示 **
**均勻性探測器
**
**探測器功能:相干參數 **
?如果存在多個相干模式
2024-12-20 10:30:49
作用, 沖擊板面。而噴嘴不清潔,則會造成蝕刻不均勻而使整塊電路板報廢。 明顯地,設備的維護就是更換破損件和磨損件,因噴嘴同樣存在著磨損的問題, 所以更換時應包括噴嘴。此外,更為關鍵的問題是要保持蝕刻機沒有結渣
2017-06-24 11:56:41
工藝稱為“全板鍍銅工藝“。與圖形電鍍相比,全板鍍銅的最大缺點是板面各處都要鍍兩次銅而且蝕刻時還必須都把它們腐蝕掉。因此當導線線寬十分精細時將會產生一系列的問題。同時,側腐蝕會嚴重影響線條的均勻性
2018-09-19 15:39:21
因產品配置不同, 價格貨期需要電議, 圖片僅供參考, 一切以實際成交合同為準伯東公司日本原裝設計制造離子蝕刻機 IBE. 提供微米級刻蝕, 均勻性: ≤±5%, 滿足
2022-11-07 16:27:40
晶圓測溫系統(tǒng)tc wafer晶圓表面溫度均勻性測溫晶圓表面溫度均勻性測試的重要性及方法 在半導體制造過程中,晶圓的表面溫度均勻性是一個重要的參數
2023-12-04 11:36:42
中圖儀器NS系列軟膜材料臺階高度蝕刻速率測定儀利用光學干涉原理,通過測量膜層表面的臺階高度來計算出膜層的厚度,具有測量精度高、測量速度快、適用范圍廣等優(yōu)點。它可以測量各種材料的膜層厚度,包括金屬
2024-10-25 16:50:54
多層PCB壓機溫度和壓力均勻性測試方法
多層PCB加工過程中必不可少的就是使用到壓合機,而壓合機壓力的均勻性和溫度的均勻性
2009-11-19 08:44:06 1379
1379 本文重點討論在LED 并聯(lián)設計中, 如何提高亮度的均勻性。討論LED 的偏置電阻和發(fā)光亮度對LED背光源亮度均勻性的影響。
2012-03-06 16:13:43 2633
2633 
本文首先介紹了蝕刻機的分類及用途,其次闡述了蝕刻機的配件清單,最后介紹了蝕刻機的技術參數及應用。
2018-04-10 14:38:32 6554
6554 較大的側蝕,潑濺和噴淋式蝕刻側蝕較小,尤以噴淋蝕刻效果最好。
2)蝕刻液的種類:不同的蝕刻液化學組分不同,其蝕刻速率就不同,蝕刻系數也不同。例如:酸性氯化銅蝕刻液的蝕刻系數通常為3,堿性氯化銅
2018-10-12 11:27:36 7325
7325 維護PCB蝕刻設備的最關鍵因素就是要保證噴嘴的高清潔度及無阻塞物,使噴嘴能暢順地噴射。阻塞物或結渣會使噴射時產生壓力作用,沖擊板面。而噴嘴不清潔,則會造成蝕刻不均勻而使整塊電路板報廢。
2019-07-09 15:22:29 2443
2443 用戶在選擇高低溫試驗箱的時候,可參考設備的技術參數比如溫度范圍、均勻度、波動度、升溫速率和降溫速率等是否匹配自己所要達到的試驗條件。其中均勻度是我們需要引起重視的一個參數,在使用設備的過程中總是會有均勻度過大的故障產生。
2019-08-09 16:09:47 820
820 在噴淋蝕刻過程中,蝕刻液是通過蝕刻機上的噴頭,在一定壓力下均勻地噴淋到印制電路板上的。蝕刻液到達印制板之后進入干鏌之間的凹槽內并與凹槽內露出的銅發(fā)生化學反應。
2020-04-08 14:53:25 4792
4792 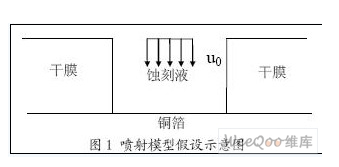
蝕刻:將覆銅箔板表面由化學藥水蝕刻去除不需要的銅導體,留下銅導體形成線路圖形,這種減去法工藝是當前印制電路板加工的主流
2021-01-06 14:32:01 12000
12000 界定蝕刻的質量,那么必須包括導線線寬的一致性和側蝕程度,即蝕刻因子,下面就簡要介紹蝕刻制程及蝕刻因子。 蝕刻的目的:蝕刻的目的是將圖形轉移以后有圖形的受抗蝕劑保護的地方保留,其他未受保護的銅蝕刻掉,最終形成線路,達到導通的目的
2021-04-12 13:48:00 46455
46455 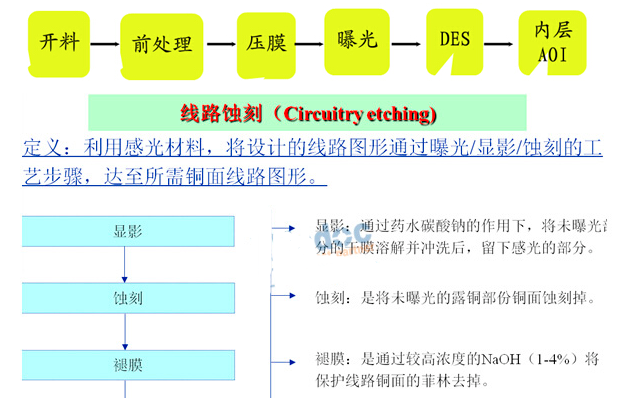
信息;然后利用場景和低頻非均勻性噪聲梯度的稀疏特性,建立關于非均勻性噪聲曲面參數的1正則化能量泛函并利用ADMM方法求解最優(yōu)的非均勻性噪聲曲面參數;最后將原始圖像減去估計的低頻非均勻性噪聲得到校正后的圖像。使用中波紅外
2021-04-27 15:14:14 11
11 電感耦合等離子體反應離子蝕刻獲得的高蝕刻速率和高度各向異性的輪廓。光增強濕法蝕刻提供了一種獲得高蝕刻速率而沒有離子誘導損傷的替代途徑。該方法適用于器件制造以及n-氮化鎵中位錯密度的估算。這有可能發(fā)展成為一種快
2021-12-30 10:36:17 2061
2061 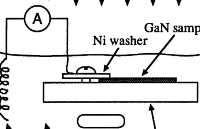
本文研究了濕化學清洗過程中硅(001)表面形成的天然氧化物的均勻性。均勻性由光激發(fā)氟刻蝕初始階段的表面形貌決定。由于光激發(fā)氟蝕刻硅的速度比蝕刻氧化硅快40倍,它突出了硅表面上的硅原生氧化物,使它們
2021-12-30 15:14:12 751
751 
性濺射制備的A1N的晶體質量,隨著退火溫度的增加,材料的濕蝕刻率降低。在1100°C退火后,在80°C蝕刻溫度下,蝕刻速率降低了約一個數量級。用金屬有機分子束外延生長的In019A1081N在硅上的蝕刻速率大約是在砷化鎵上的三倍。這與在砷化鎵上生長的材料的優(yōu)越
2022-01-17 16:21:48 754
754 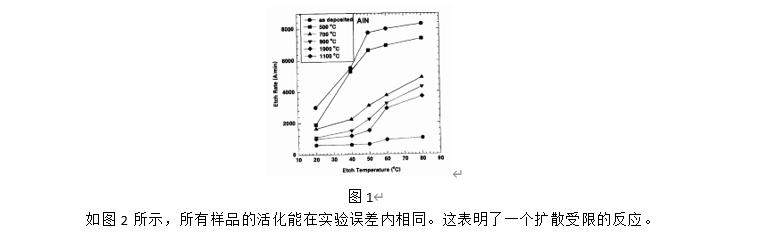
濕法蝕刻工藝已經廣泛用于生產各種應用的微元件。這些過程簡單易操作。選擇合適的化學溶液(即蝕刻劑)是濕法蝕刻工藝中最重要的因素。它影響蝕刻速率和表面光潔度。銅及其合金是各種工業(yè),特別是電子工業(yè)的重要
2022-01-20 16:02:24 3288
3288 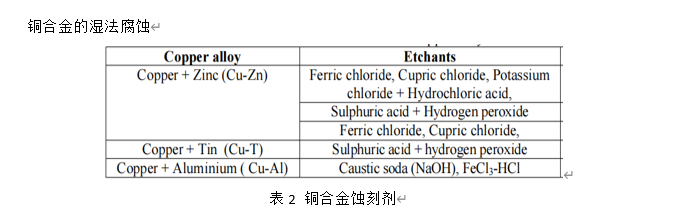
可以導致足夠的通過制造過程的速率。窄帶隙銦氮化鎵(InGaN)層將允許設計CL-PEC發(fā)射蝕刻過程,如果只有一個帶隙響應進入射光子,這是不可能的。
2022-02-09 16:11:40 991
991 
我們華林科納使用K2S2O8作為氧化劑來表征基于KOH的紫外(UV)光輔助濕法蝕刻技術。該解決方案提供了良好控制的蝕刻速率,并產生了光滑的高質量蝕刻表面,同時通過原子力顯微鏡測量的表面粗糙度降低最小
2022-02-14 16:14:55 1186
1186 
問題,而且包括蝕刻速率、均勻性和選擇性在內的工藝性能都是使該工藝難以從臺式轉換到單晶片型的障礙。在這里,我們提出了一種新穎的設計,該設計引入了上晶片加熱板,以保持磷酸蝕刻劑的高溫,從而克服在氮化物剝離工藝中單晶片處
2022-02-15 16:38:57 2730
2730 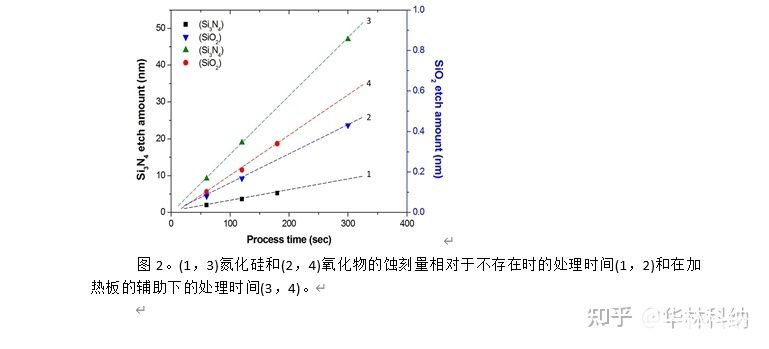
功率、施加到襯底支架的負偏壓和氫氣流速對蝕刻過程速率的影響。實驗結果首次評估了工藝參數對刻蝕速率的影響。結果表明,工藝參數對所研究條件的影響依次為:反應室壓力、偏壓、射頻功率、氫氣流速。
2022-02-17 15:25:42 2997
2997 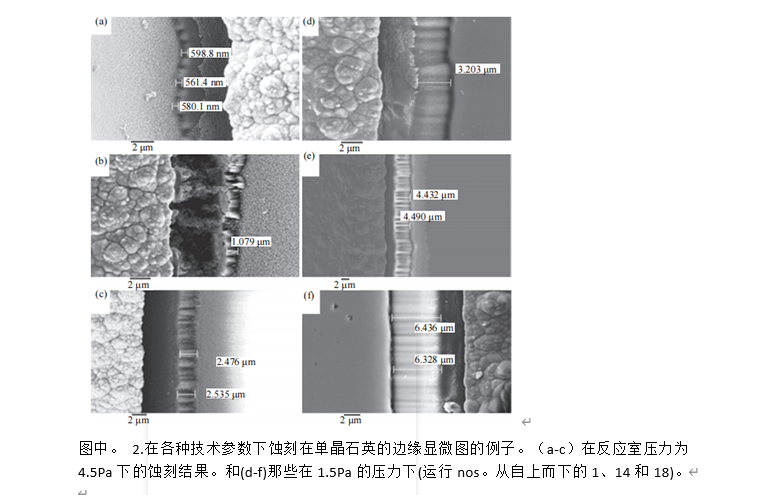
在 KOH 水溶液中進行濕法化學蝕刻期間,硅 (1 1 1) 的絕對蝕刻速率已通過光學干涉測量法使用掩膜樣品進行了研究。蝕刻速率恒定為0.62 ± 0.07 μm/h 且與 60 時 1–5 M
2022-03-04 15:07:09 1824
1824 
HF對基片進行了研究,主要分為隨機蝕刻和周期性蝕刻。 我們討論了蝕刻的問題機理、蝕刻速率、硬掩膜材料、周期性光俘獲結構。
2022-03-08 11:52:41 1825
1825 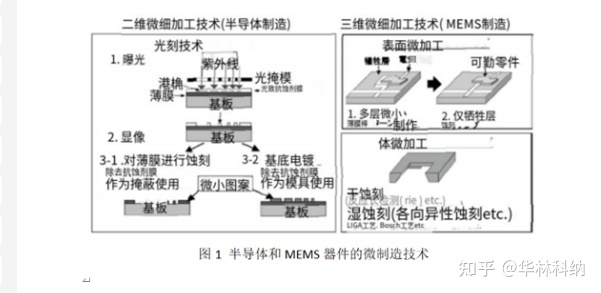
本文研究了KOH基溶液中AIN的濕式化學蝕刻與蝕刻溫度和材料質量的關系。這兩種材料的蝕刻速率都隨著蝕刻溫度的增加而增加,從20~80°C不等。通過在1100°C下快速熱退火,提高了反應性濺射制備
2022-03-09 14:37:47 815
815 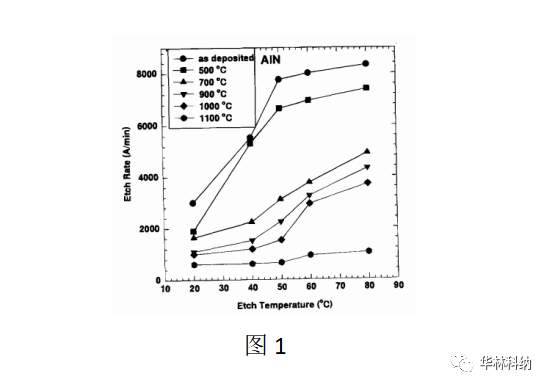
半導體生產過程中,蝕刻工藝是非常重要的工藝。蝕刻工藝中使用的方法通常有batch式和枯葉式兩種。Batch式是用傳統(tǒng)的方法,在藥液bath中一次性加入數十張晶片進行處理的方法。但是隨著半導體技術
2022-03-14 10:50:47 1463
1463 
本文研究了用金剛石線鋸切和標準漿料鋸切制成的180微米厚5英寸半寬直拉單晶硅片與蝕刻時間的關系,目的是確定FAS晶片損傷蝕刻期間蝕刻速率降低的根本原因,無論是與表面結構相關,缺陷相關,由于表面存在的氧化層,還是由于有機殘差。
2022-03-16 13:08:09 1159
1159 
控制。執(zhí)行蝕刻機制的成功之處在于,多層結構的頂層應該被完全去除,而在下層或掩模層中沒有任何種類的損傷。這完全取決于兩種材料的蝕刻速率之比,稱為選擇性。在一些蝕刻情況下,蝕刻會削弱掩模層,并產生形成空腔的傾斜側壁。底切的距離稱為偏差。
2022-03-16 16:31:58 1827
1827 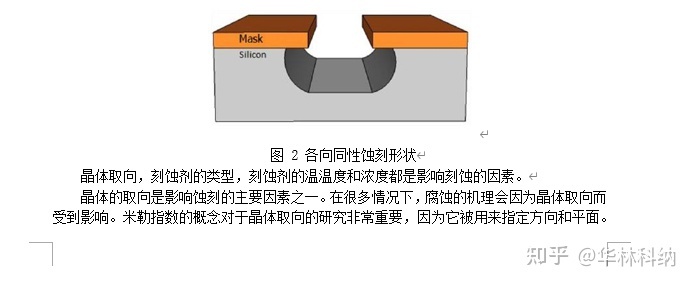
本文我們華林科納半導體有限公司研究了類似的現(xiàn)象是否發(fā)生在氫氧化鉀溶液中添加的其他醇,詳細研究了丁基醇濃度對(100)和(110)Si平面表面形貌和蝕刻速率的影響,并給出了異丙醇對氫氧化鉀溶液的蝕刻結果,為了研究醇分子在蝕刻溶液中的行為機理,我們還對溶液的表面張力進行了測量。
2022-03-18 13:53:01 769
769 
本文提出了一種利用原子力顯微鏡(AFM)測量硅蝕刻速率的簡單方法,應用硅表面的天然氧化物層作為掩膜,通過無損摩擦化學去除去除部分天然氧化物,暴露地下新鮮硅。因此,可以實現(xiàn)在氫氧化鉀溶液中對硅的選擇性蝕刻,通過原子精密的AFM可以檢測到硅的蝕刻深度,從而獲得了氫氧化鉀溶液中精確的硅的蝕刻速率。
2022-03-18 15:39:18 954
954 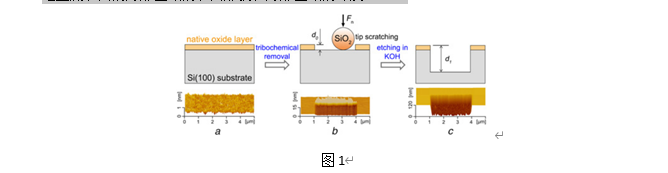
在本文章中,研究了球形試樣的尺寸參數,以確定哪種尺寸允許可靠地測量各向異性蝕刻中的方向依賴性,然后進行了一系列的實驗,測量了所有方向的蝕刻速率。這導致建立了一個涵蓋廣泛的氫氧化鉀蝕刻條件范圍的蝕刻
2022-03-22 16:15:00 966
966 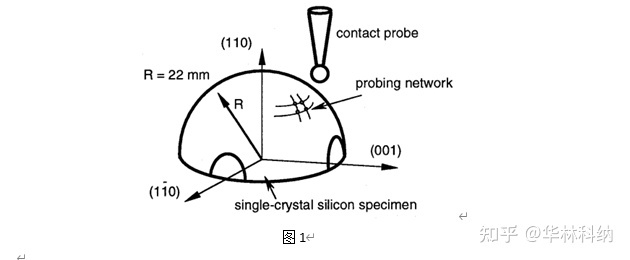
總流量、壓力、等離子體功率、氧流量和輸運管直徑來確定CDE系統(tǒng)的可運行特性,蝕刻速率和不均勻性與各種輸入和計算參數的相關性突出了系統(tǒng)壓力、流量和原子氟濃度對系統(tǒng)性能的重要性。
2022-04-13 15:33:19 765
765 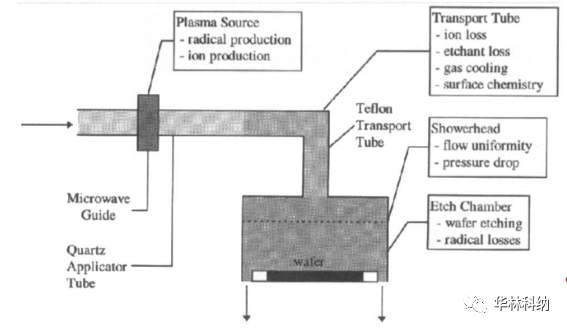
,該模型將濺射壓力和襯底溫度與膜結構和最終蝕刻相關聯(lián)特點,高度致密的ZnO膜在蝕刻時形成具有中或低凹坑密度和低蝕刻速率的表面,而低致密性導致小蝕刻結構和高蝕刻速率,該模型已經擴展到包括濺射氣氛中的氧含量和靶中的鋁摻雜濃度的影響。
2022-05-09 14:27:58 778
778 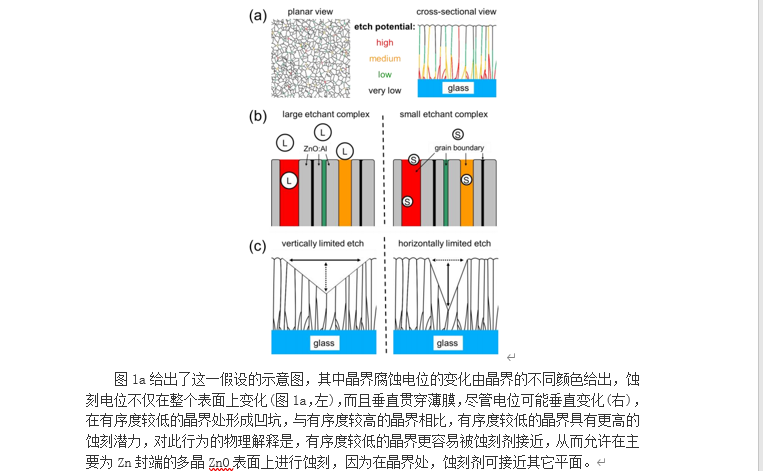
速度快,而各向同性蝕刻(如HF)會向所有方向侵蝕。使用KOH工藝是因為其在制造中的可重復性和均勻性,同時保持了較低的生產成本。異丙醇(IPA)經常添加到溶液中,以改變從{110}壁到{100}壁的選擇性,并提高表面光滑度。
2022-05-09 15:09:20 2627
2627 在使用低溫卡盤的低壓高密度等離子體反應器中研究了硅結構的深且窄的各向異性蝕刻。我們華林科納以前已經證明了這種技術在這種結構上的可行性。已經研究了蝕刻速率和輪廓的改進,并且新的結果顯示,在5 μm
2022-05-11 15:46:19 1455
1455 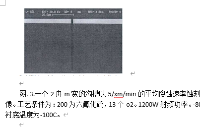
我們介紹了在氫氧化鉀溶液中蝕刻的車輪圖案和寬分離的V形槽的硅蝕刻速率測量。數據表明,當使用貨車輪圖案時,存在反應物耗盡效應,這掩蓋了真實的表面反應速率限制的蝕刻速率。與以前的報道相反,從受反應物傳輸
2022-05-11 16:30:56 659
659 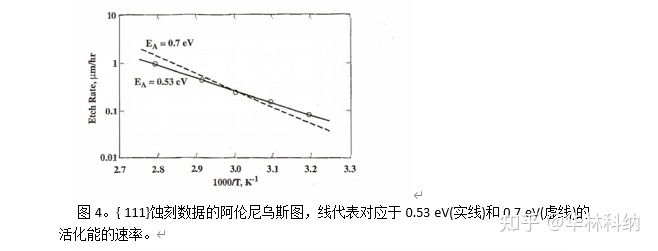
的組成和溫度對腐蝕速率的影響,陰離子表面活性劑的加入提供了防止由蝕刻反應產生的淤渣粘附的功能,一種新的配備有流動發(fā)生部件的濕法蝕刻試驗裝置被用于測試商用無堿玻璃和鈉鈣玻璃的蝕刻,通過使用中試裝置,將厚度
2022-05-20 16:20:24 5686
5686 本文講述了我們華林科納研究了M111N蝕刻速率最小值的高度,以及決定它的蝕刻機制,在涉及掩模的情況下,M111N最小值的高度可以受到硅/掩模結處的成核的影響,以這種方式影響蝕刻或生長速率的結可以被
2022-05-20 17:12:59 1881
1881 
通常在蝕刻過程之后通過將總厚度變化除以蝕刻時間或者通過對不同的蝕刻時間進行幾次厚度測量并使用斜率的“最佳擬合”來測量,當懷疑蝕刻速率可能不隨時間呈線性或蝕刻開始可能有延遲時,這樣做有時可以實時測量蝕刻速率。
2022-05-27 15:12:13 5836
5836 蝕刻,加入CHCI以控制各向異性。大量的氦有助于光致抗蝕劑的保存。已經進行了支持添加劑作用的參數研究。 高速率各向異性等離子體蝕刻工藝對于提高加工VLSI晶片器件的機器的效率非常重要。這篇論文描述了這樣一種用于以高速率( 5000埃/分
2022-06-13 14:33:14 1892
1892 
摘要 跨晶圓柵極臨界尺寸(CD)的一致性會影響芯片與芯片之間在速度和功耗方面的性能差異。隨著線寬減小到90 nm及以下,跨晶片CD均勻性的性能規(guī)格變得越來越嚴格。本文介紹了我們華林科納提出了一種
2022-06-22 14:58:34 3523
3523 
本文研究了室溫下鹽酸和王水溶劑對ITO膜腐蝕行為的影響,在王水中比在鹽酸中獲得更高的蝕刻速率,然而,通過XPS分析,發(fā)現(xiàn)在王水蝕刻劑中比在HCl中有更多的表面殘留副產物,在王水和HCl中的表面濃度
2022-07-01 16:50:56 2439
2439 
在本研究中,我們華林科納研究了在液晶顯示(LCD)技術中常用的蝕刻劑中相同的ITO薄膜的蝕刻速率,保持浴液溫度恒定,并比較了含有相同濃度的酸的溶液,對ITO在最有趣的解決方案中的行為進行了更詳細的研究,試圖闡明這些浴液中的溶解機制。
2022-07-04 15:59:58 2966
2966 
這兩種蝕刻液被廣為使用的原因之一是其再生能力很強。通過再生反應,可以提高蝕刻銅的能力,同時,還能保持恒定的蝕刻速度。在批量PCB生產中,既要保持穩(wěn)定的蝕刻速度,還要確保這一速度能實現(xiàn)最大產出率,這一點至關重要。蝕刻速度對生產速率會產生很大的影響,所以在對比蝕刻液的性能時,蝕刻速度是主要考量因素。
2022-08-17 15:11:19 16839
16839 反應性離子蝕刻綜合了離子蝕刻和等離子蝕刻的效果:其具有一定的各向異性,而且未與自由基發(fā)生化學反應的材料會被蝕刻。首先,蝕刻速率顯著增加。通過離子轟擊,基材分子會進入激發(fā)態(tài),從而更加易于發(fā)生反應。
2022-09-19 15:17:55 6526
6526 、效率高使用方便:有效地設計噴淋與被蝕刻金屬板的有效面積和蝕刻均勻程度;蝕刻效果、速度和操作者的環(huán)境及方便程度等方面都有改善;藥液使用充分,大大降低生產成本;3、蝕刻速度在傳統(tǒng)蝕刻法上大大提高:經反復實驗噴射壓力在1-2 kg/cm2的情況下被蝕刻
2022-12-19 17:05:50 976
976 金屬蝕刻是一種通過化學反應或物理沖擊去除金屬材料的技術。金屬蝕刻技術可分為濕蝕刻和干蝕刻。金屬蝕刻由一系列化學過程組成。不同的蝕刻劑對不同的金屬材料具有不同的腐蝕特性和強度。
2023-03-20 12:23:43 8844
8844 干法蝕刻與濕法蝕刻之間的爭論是微電子制造商在項目開始時必須解決的首要問題之一。必須考慮許多因素來決定應在晶圓上使用哪種類型的蝕刻劑來制作電子芯片,是液體(濕法蝕刻)還是氣體(干法蝕刻)
2023-04-12 14:54:33 2840
2840 蝕刻可能是濕制程階段最復雜的工藝,因為有很多因素會影響蝕刻速率。如果不保持這些因素的穩(wěn)定,蝕刻率就會變化,因而影響產品質量。如果希望利用一種自動化方法來維護蝕刻化學,以下是你需要理解的基本概念。
2023-05-19 10:27:31 1832
1832 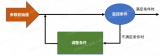
等離子體蝕刻是氮化鎵器件制造的一個必要步驟,然而,載體材料的選擇可能會實質上改變蝕刻特性。在小型單個芯片上制造氮化鎵(GaN)設備,通常會導致晶圓的成本上升。在本研究中,英思特通過鋁基和硅基載流子來研究蝕刻過程中蝕刻速率、選擇性、形貌和表面鈍化的影響。
2023-05-30 15:19:54 1476
1476 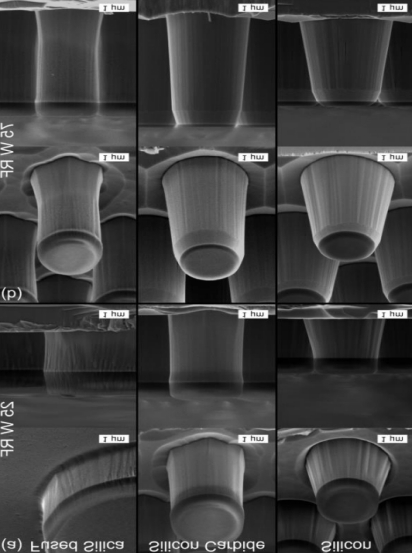
一.選擇高低溫試驗箱。應注意性能參數,包括溫度范圍、均勻性、波動性、升溫速度、降溫率等因素是確定高低溫試驗箱能否達到所需條件的試驗目的。均勻性在這四個因素中起著重要作用。這個參數要特別注意,因為我們
2022-07-21 14:26:58 1337
1337 
PCB蝕刻工藝中的“水池效應”現(xiàn)象,通常發(fā)生在頂部,這種現(xiàn)象會導致大尺寸PCB整個板面具有不同的蝕刻質量。
2023-08-10 18:25:43 4815
4815 GaN及相關合金可用于制造藍色/綠色/紫外線發(fā)射器以及高溫、高功率電子器件。由于 III 族氮化物的濕法化學蝕刻結果有限,因此人們投入了大量精力來開發(fā)干法蝕刻工藝。干法蝕刻開發(fā)一開始集中于臺面結構,其中需要高蝕刻速率、各向異性輪廓、光滑側壁和不同材料的同等蝕刻。
2023-10-07 15:43:56 2337
2337 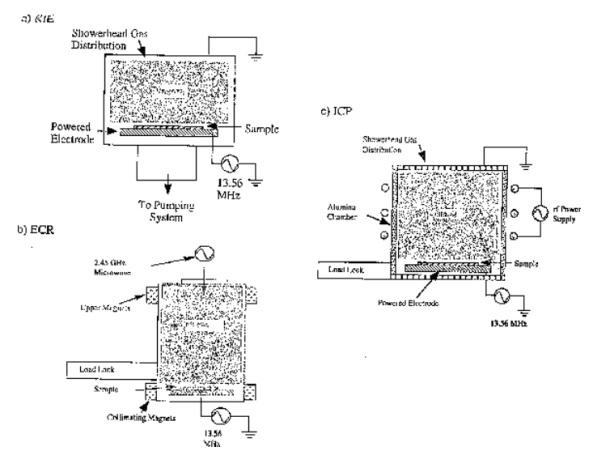
蝕刻液的化學成分的組成:蝕刻液的化學組分不同,其蝕刻速率就不相同,蝕刻系數也不同。如普遍使用的酸性氯化銅蝕刻液的蝕刻系數通常是&;堿性氯化銅蝕刻液系數可達3.5-4。而正處在開發(fā)階段的以硝酸為主的蝕刻液可以達到幾乎沒有側蝕問題,蝕刻后的導線側壁接近垂直。
2023-10-16 15:04:35 2432
2432 干法蝕刻(dry etch)工藝通常由四個基本狀態(tài)構成:蝕刻前(before etch),部分蝕刻(partial etch),蝕刻到位(just etch),過度蝕刻(over etch),主要表征有蝕刻速率,選擇比,關鍵尺寸,均勻性,終點探測。
2023-10-18 09:53:19 4739
4739 
片內和片間非均勻性是什么?有什么作用呢? 片內和片間非均勻性是指光學元件(如透鏡)表面上的厚度/形狀/折射率等參數的變化,以及元件之間的相對位置誤差所引起的光學性能差異。這種非均勻性在光學系統(tǒng)中
2023-12-19 11:48:19 1512
1512 干式蝕刻是為對光阻上的圖案忠實地進行高精密加工的過程,故選擇材料層與光阻層的蝕刻速率差(選擇比)較大、且能夠確保蝕刻的非等向性(主要隨材料層的厚度方向進行蝕刻),且能降低結晶缺陷、不純物的摻雜、帶電間題導致的損傷等。
2024-04-18 11:39:07 1813
1813 
光束均勻性是光學領域中的核心參數,它決定了光學設備在成像、照明和能量轉換等方面的性能。本文深入探討了光束均勻性的定義、影響、測試方法,并介紹了昊量光電提供的高性能光束分析儀產品解決方案。
2024-12-20 15:06:09 1728
1728 
、傳感器和光電器件的制造過程中。 與干法蝕刻相比,濕法蝕刻通常具有較低的設備成本和較高的生產效率,適合大規(guī)模生產。 化學原理 基于化學反應的選擇性,不同材料在特定化學溶液中的溶解速率不同,從而實現(xiàn)對目標材料的精
2024-12-27 11:12:40 1538
1538 華林科納半導體高選擇性蝕刻是指在半導體制造等精密加工中,通過化學或物理手段實現(xiàn)目標材料與非目標材料刻蝕速率的顯著差異,從而精準去除指定材料并保護其他結構的工藝技術?。其核心在于通過工藝優(yōu)化控制
2025-03-12 17:02:49 809
809 超薄晶圓因其厚度極薄,在切割時對振動更為敏感,易影響厚度均勻性。我將從分析振動對超薄晶圓切割的影響出發(fā),探討針對性的振動控制技術和厚度均勻性保障策略。
超薄晶圓(
2025-07-09 09:52:03 580
580 
TTV 厚度均勻性欠佳。淺切多道切割工藝作為一種創(chuàng)新加工方式,為提升晶圓 TTV 厚度均勻性提供了新方向,深入探究其提升機制與參數優(yōu)化方法具有重要的現(xiàn)實意義。
二
2025-07-11 09:59:15 471
471 
摘要:本文聚焦切割液多性能協(xié)同優(yōu)化對晶圓 TTV 厚度均勻性的影響。深入剖析切割液冷卻、潤滑、排屑等性能影響晶圓 TTV 的內在機制,探索實現(xiàn)多性能協(xié)同優(yōu)化的參數設計方法,為提升晶圓切割質量、保障
2025-07-24 10:23:09 500
500 
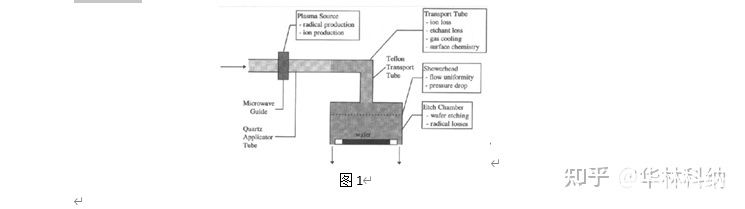
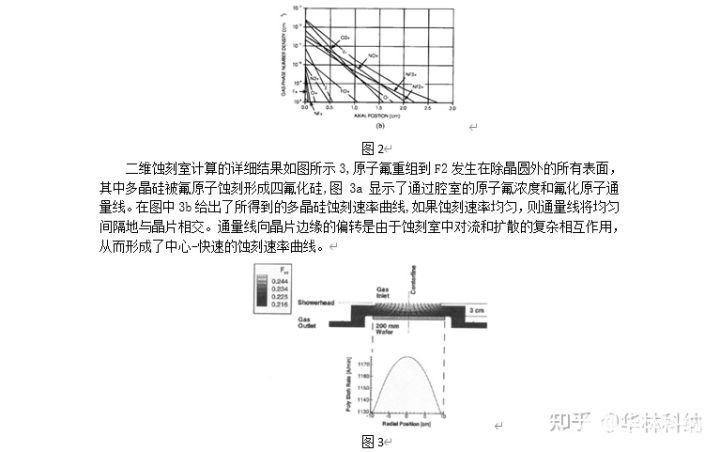
 電子發(fā)燒友App
電子發(fā)燒友App










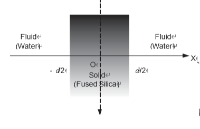
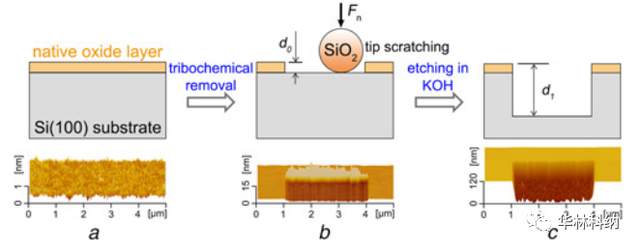
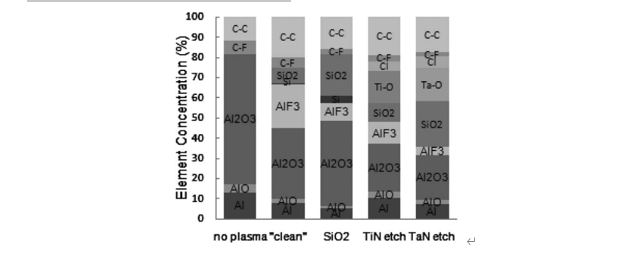

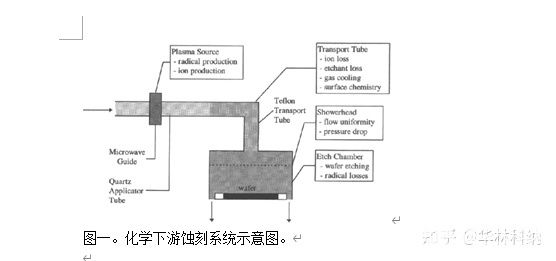


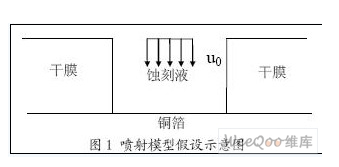
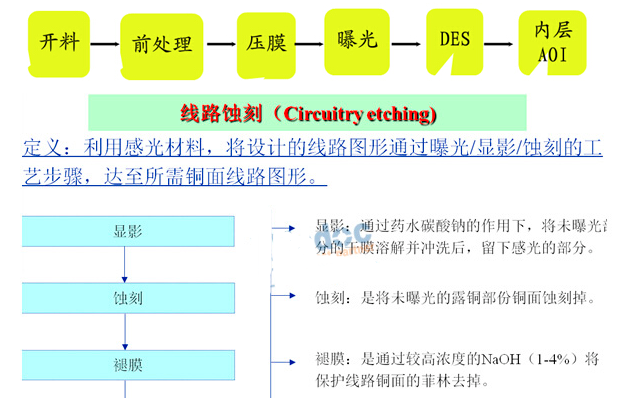

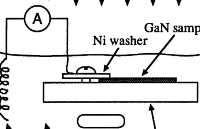

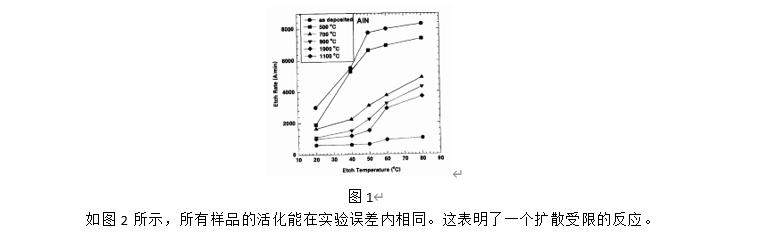
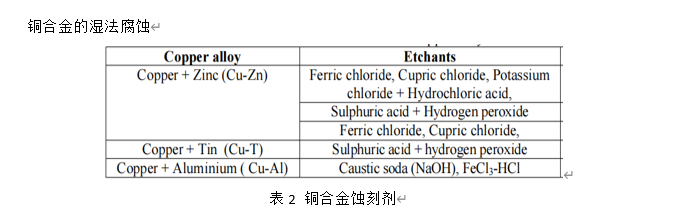


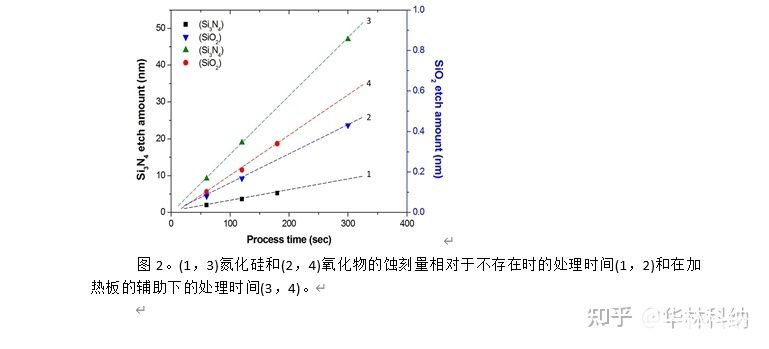
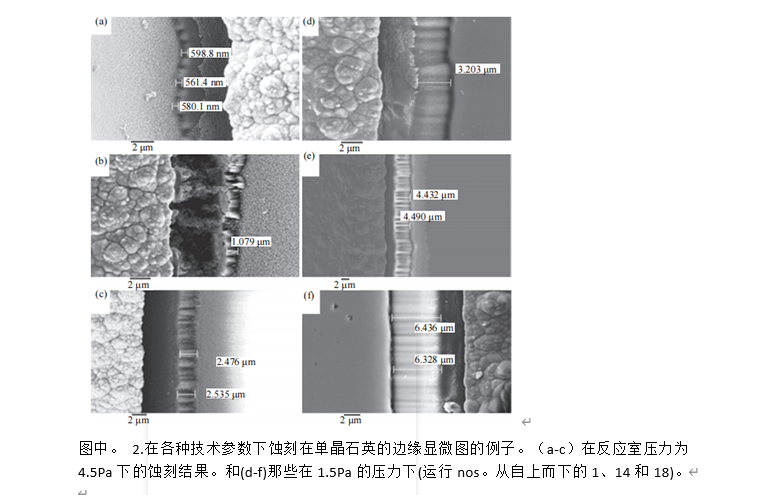

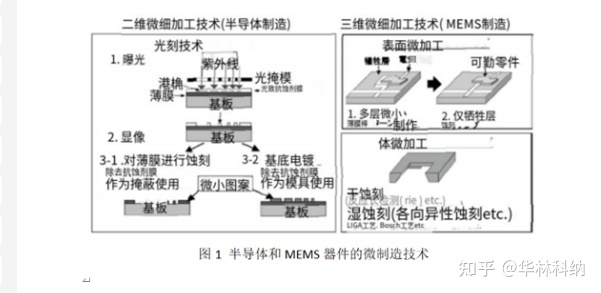
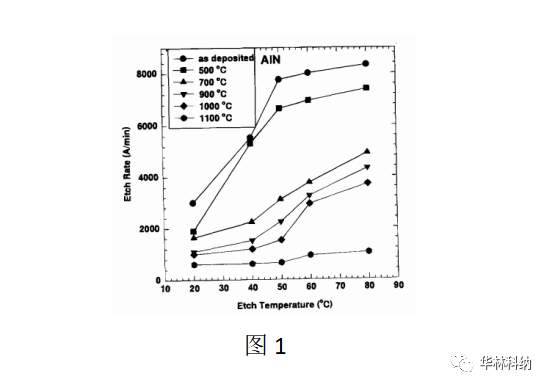


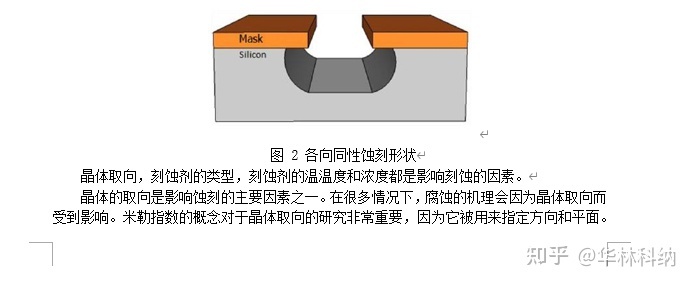

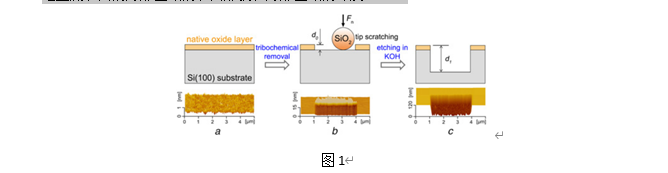
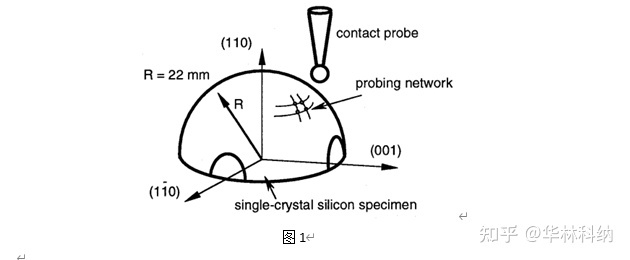
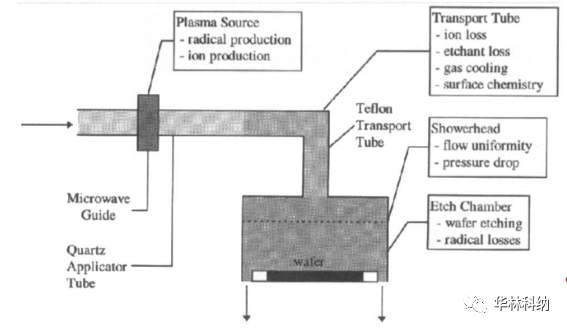
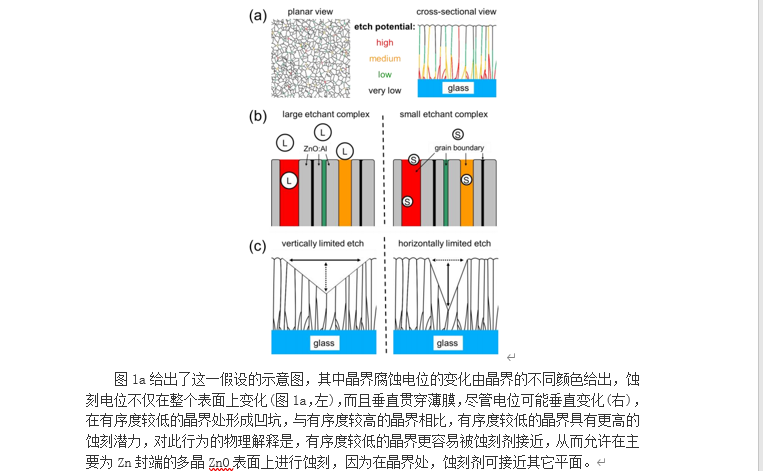
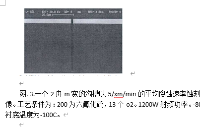
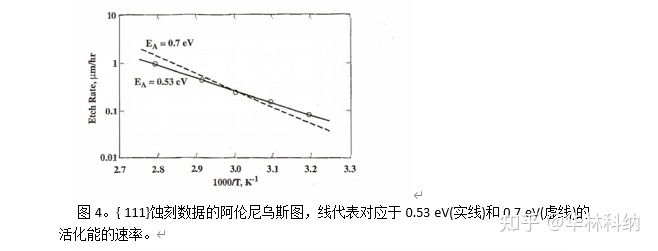





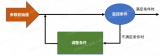
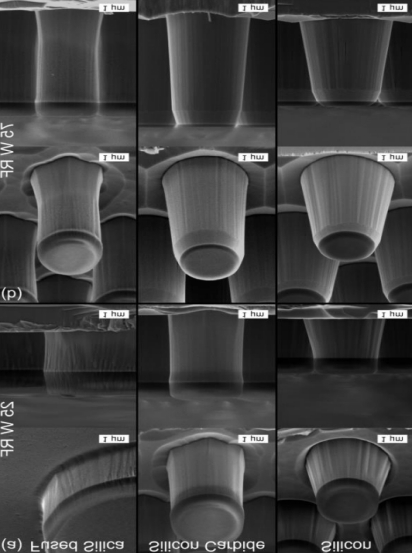

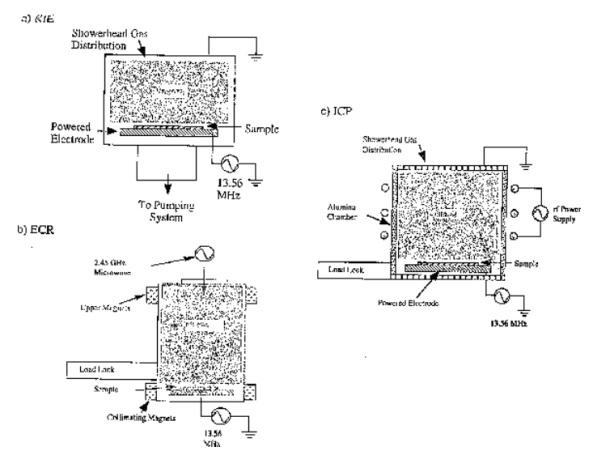







評論