硅和二氧化硅的濕化學蝕刻
硅是微電子學和微細力學中最常用的襯底材料。它不僅可用作無源襯底,也可用作電子或機械元件的有源材料。如本章所述,所需的圖案也可以通過濕化學蝕刻方法來實現。
腐蝕率
各向異性、絕對蝕刻速率和蝕刻的均勻性取決于兩種缺陷

晶體硅在KOH(左圖)和TMAH(右圖)中的(100)和(110)平面的濃度和溫度依賴性刻蝕速率。硅的堿性蝕刻除了需要OH離子外,還需要游離水分子。因此,當堿性溶液較強時,蝕刻速率降低,而且蝕刻硅表面的表面粗糙度降低。
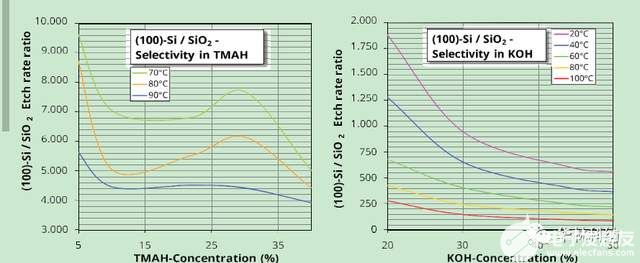
(100)- Si和sio2在TMAH(左圖)和KOH(右圖)中的刻蝕速率的濃度和溫度依賴性選擇性。在TMAH中,Si和sio2的腐蝕速率在不同的TMAH濃度下都有最大值,這就是為什么它們的比值呈現局部最小值的原因。
Si: sio2的刻蝕選擇性
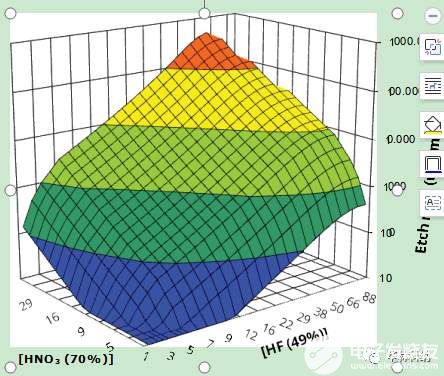
圖2:硅的蝕刻速率與室溫下蝕刻混合物的HNO濃度的關系
審核編輯:湯梓紅
 電子發燒友App
電子發燒友App









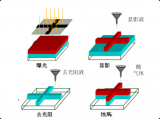














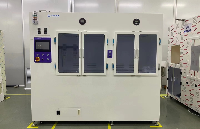












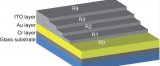


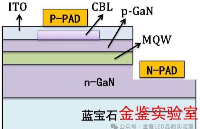








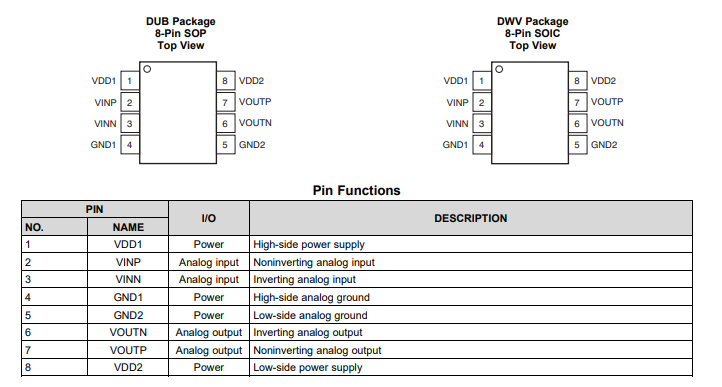
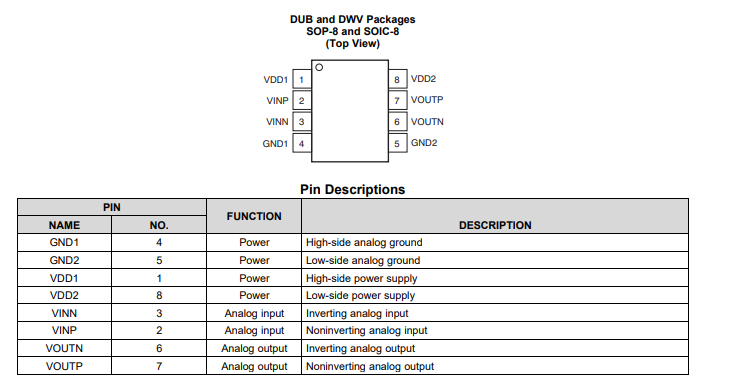
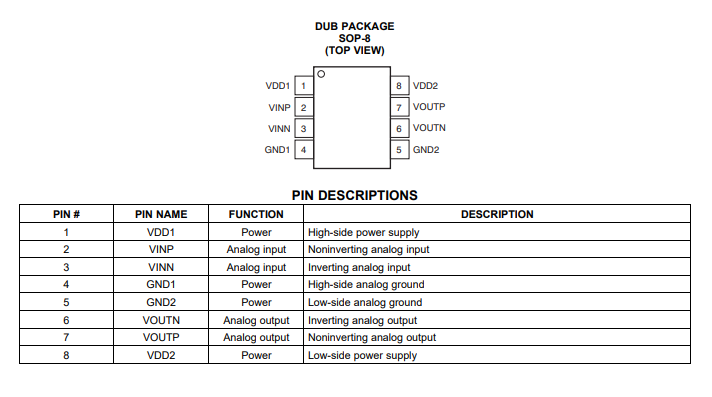

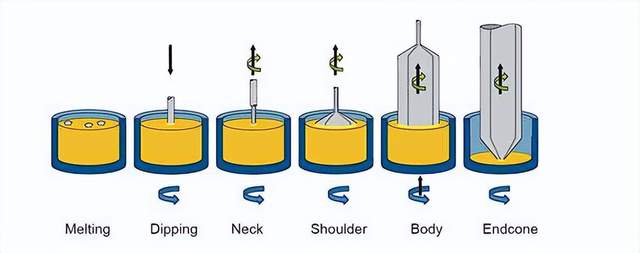


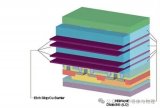

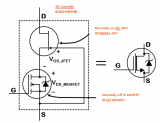

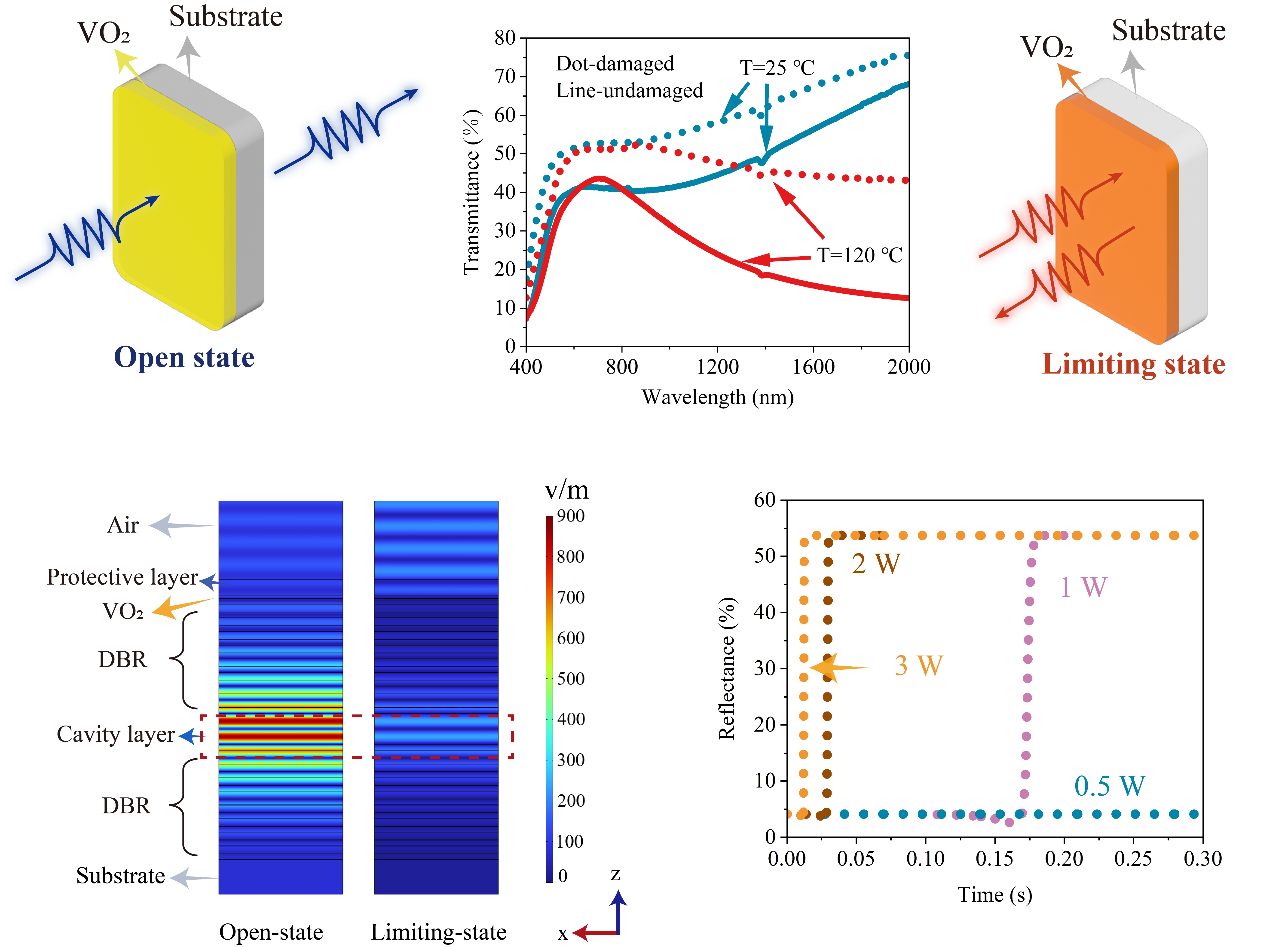


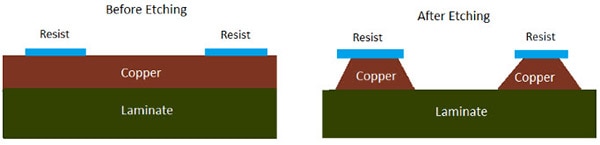






評論