摘要
為了能夠使用基于 GaAs 的器件作為化學(xué)傳感器,它們的表面必須進行化學(xué)改性。GaAs 表面上液相中分子的可重復(fù)吸附需要受控的蝕刻程序。應(yīng)用了幾種分析方法,包括衰減全反射和多重內(nèi)反射模式 (ATR/MIR) 中的傅里葉變換紅外光譜 (FTIRS)、高分辨率電子能量損失光譜 (HREELS)、X 射線光電子能譜 (XPS) 和原子用于分析用不同濕蝕刻程序處理的 GaAs (100) 樣品的力顯微鏡 (AFM)。通過與粉末狀氧化物(Ga2O3、As2O3 和 As2O5)相比,振動和 XPS 光譜中存在的表面氧化物導(dǎo)致的不同特征的分配。這里描述的蝕刻程序,即,使用低濃度 HF 溶液的那些,大大減少了砷氧化物 (100) 表面中存在的砷氧化物和脂肪族污染物的數(shù)量,并完全去除了氧化鎵。
介紹
GaAs (100) 表面具有高表面能。1 因此,它們具有很強的反應(yīng)性和化學(xué)穩(wěn)定性。GaAs (100) 表面上存在的不同氧化物的化學(xué)表征是有問題的,因為僅通過紅外光譜和高分辨率電子能量損失光譜 (HREELS) 3 對氧化物進行了幾次鑒定,并且在X 射線光電子能譜 (XPS) 值存在。
上述所有方法在表面成分和粗糙度方面的結(jié)果從未進行過比較。事實上,這些方法主要用于分子束外延 (MBE),其中應(yīng)通過在 580 °C 的熱清潔溫度以上真空下對 GaAs 樣品進行退火來進行第二步氧化物消除。工作,因為我們對在環(huán)境溫度下從液體溶液中吸附感興趣,所以不進行第二步。為了為我們的目的選擇最合適的濕法蝕刻,我們使用上述一些程序研究了濕法蝕刻的 GaAs (100) 表面。此外,必須研究隨后從液體溶液中吸附分子、溶劑(即水)對基材組成和形態(tài)的作用。
樣品制備
GaAs 樣品先在丙酮中超聲 5 分鐘,然后在乙醇中清洗。脫脂后的樣品隨后通過將它們浸入水溶液中使用不同的程序進行蝕刻(成分按體積比例給出):
(a) H2SO4 : H2O2 : H2O (4: 1: 1 at 70 °C) 10 分鐘,然后用鹽酸 5 分鐘,然后沖洗 5 秒;
(b) 改良的 RCA 處理:NH4OH : H2O2 : H2O (1:1:
100) 5 分鐘,然后漂洗 5 秒,然后再用 NH4OH : H2O2 : H2O (1:1: 30) 處理 5 分鐘,然后漂洗 5 秒;
(c) HCl : H2O (1:1) 1 分鐘并沖洗 1 分鐘;
(d) HF:H2O(不同濃度)5 秒,沖洗3 秒。
DIW 始終用于沖洗步驟。
通過將樣品浸入 H2O2 中 30 秒,然后將其在 DIW 中沖洗 2 分鐘來進行表面氧化。然后用氮氣流干燥樣品,并將通過 HREELS 和/或 XPS 分析的樣品在氬氣氣氛下轉(zhuǎn)移到 UHV 室中,并在氮氣流下引入。
在清潔玻璃器皿時要特別小心,以避免污染并防止來自洗滌劑的離子(如 NaC 和磷酸鹽)的存在。小心洗滌后,將所有玻璃器皿在沸水去離子水浴中漂洗 1.5 小時。
結(jié)論
本研究的目標是建立一種制備方法,以確保傳感器技術(shù)在 GaAs (100) 表面上有機層的良好吸附。我們將這項工作的重點放在比較不同蝕刻程序和確定其化學(xué)成分和形態(tài)方面的表面質(zhì)量上。通過不同的方法研究了 GaAs 樣品,通過與粉末氧化物分析中獲得的那些進行比較,獲得了表面氧化物的 ATR/MIR 和 XPS 分配。為了改進分析,還使用過氧化氫對 GaAs 晶片進行氧化,然后進行蝕刻,以便更容易識別不同的氧化物。還發(fā)現(xiàn)用有機溶劑進行脫脂不僅可以去除脂肪族污染物,還可以去除一些天然氧化物。
比較了不同濕法蝕刻方法的作用,并通過 HREELS 和 XPS 分析了極端表面。兩種方法都表明,蝕刻后氧化鎵的存在可以忽略不計,并且氧化砷仍然保留在表面上。XPS 還顯示蝕刻將氧化物厚度從 1.6 納米減少到 0.1 納米。還確定了 HF 濃度對表面最終質(zhì)量的影響,即其化學(xué)成分和粗糙度。AFM 圖像顯示,使用不同濕蝕刻方法(HF、HCl 或 NH3)的蝕刻表面具有非常低的粗糙度。在用三種程序蝕刻的樣品中觀察到的 HREELS 光譜中 GaAs (100) 的強烈表面聲子的存在也證明了非常規(guī)則的表面。

圖6 砷和鎵XPS區(qū)域(2p3/2 和3d) 在GaAs樣品中:原始(完整符號)并用1% HF(空符號)處理。3d 區(qū)域配有雙峰。為清楚起見,僅標記了GaAs組件的雙峰。使用AlK? 輻射和90的TOA記錄光譜

圖1 粉末狀三氧化二鎵(粗線)、三氧化二砷(線)和五氧化二砷(虛線)的 FTIRS 光譜

圖2 脫脂后 GaAs (100) 表面的 ATR/MIR 光譜。負峰和正峰分別與去除和不同物種的出現(xiàn)相關(guān)
審核編輯:湯梓紅
 電子發(fā)燒友App
電子發(fā)燒友App









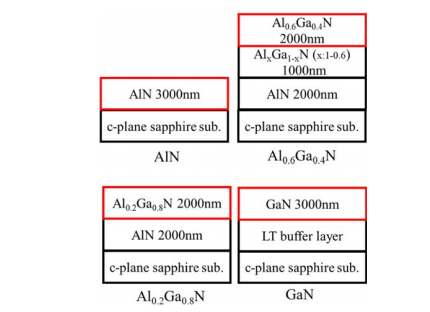

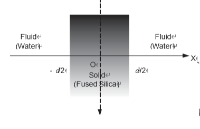




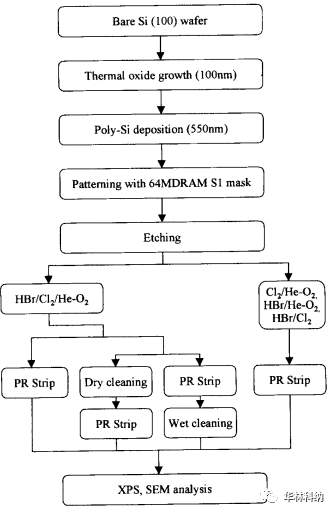

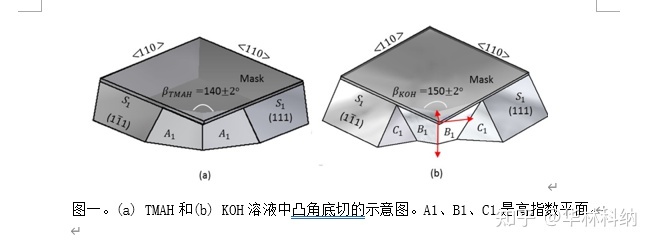
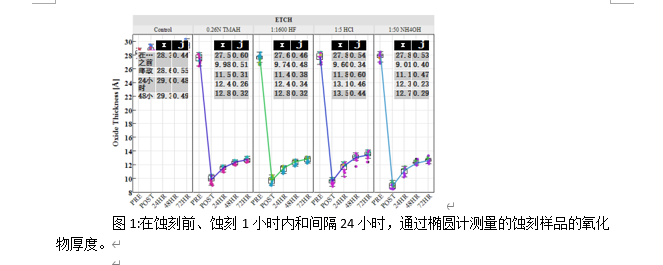




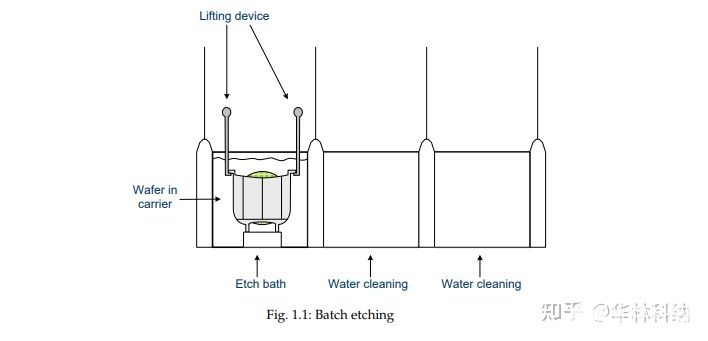
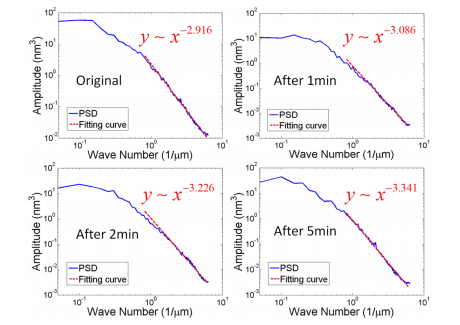
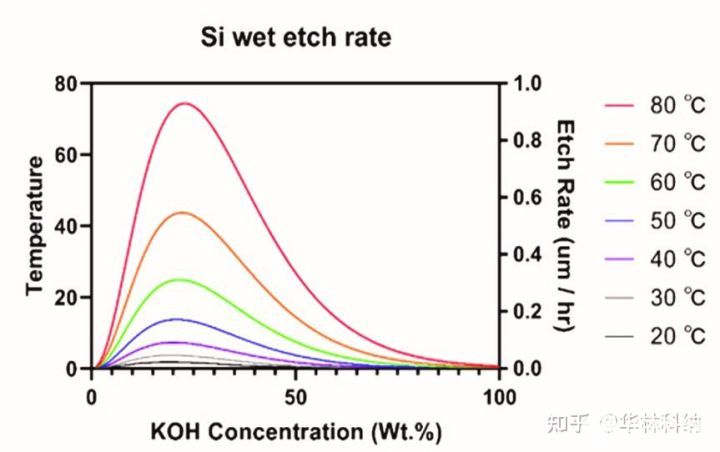





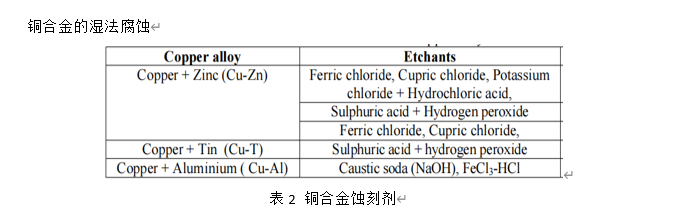
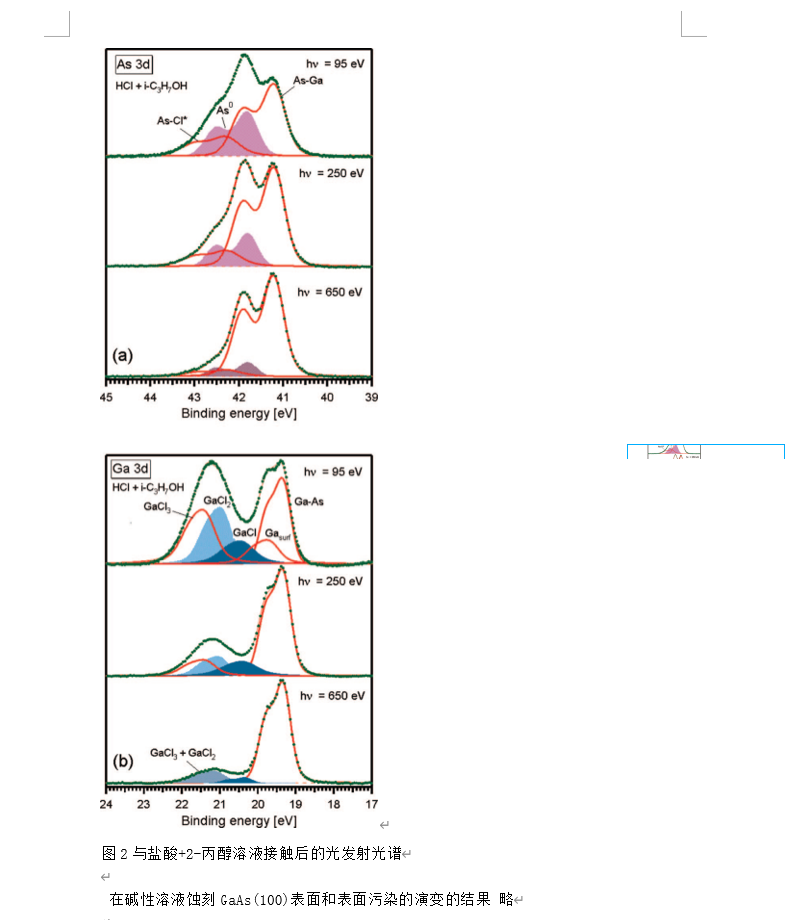
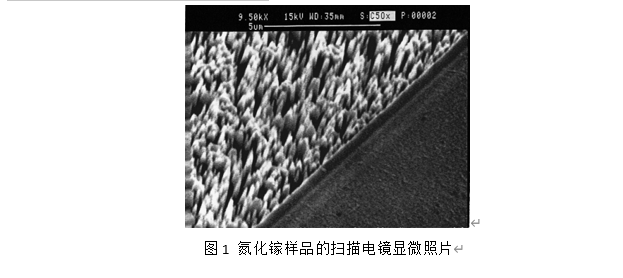
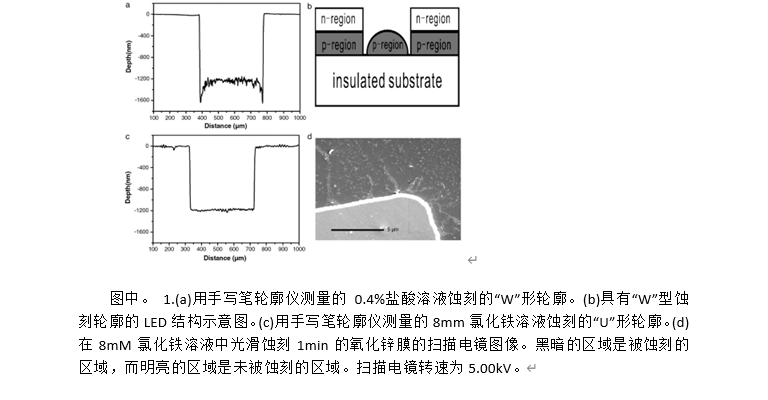
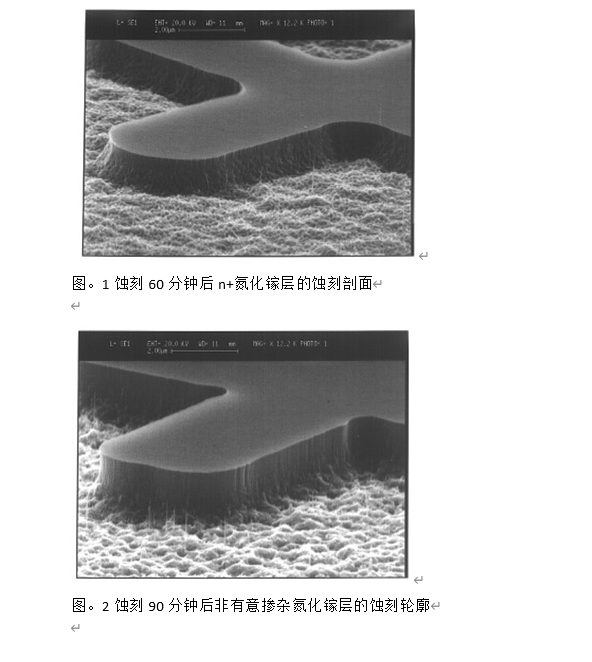

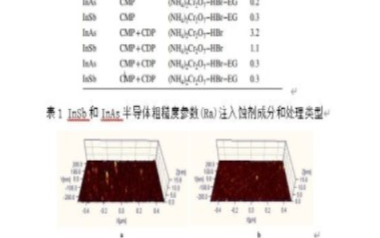
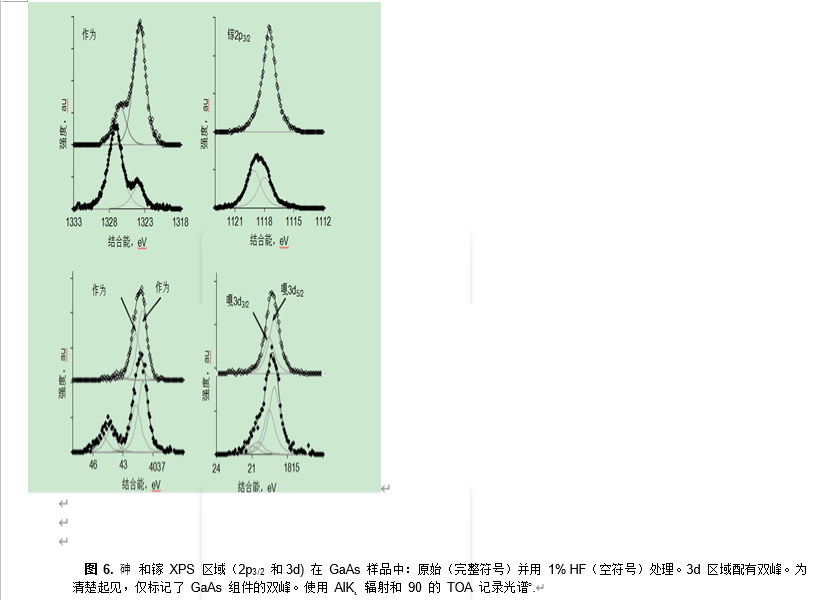

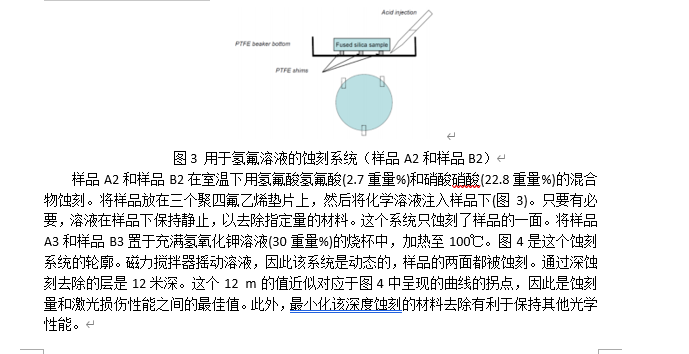


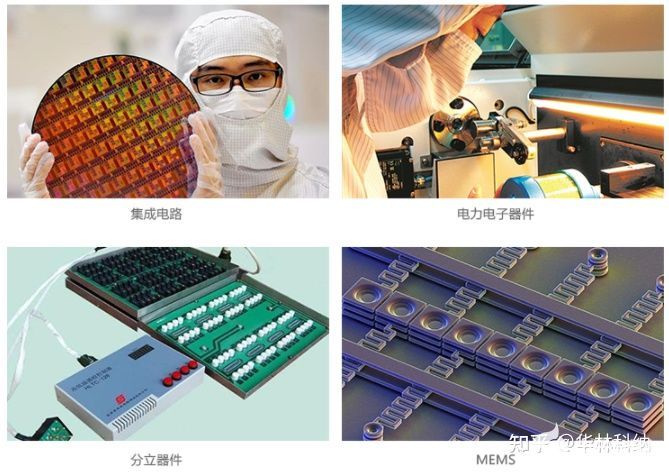
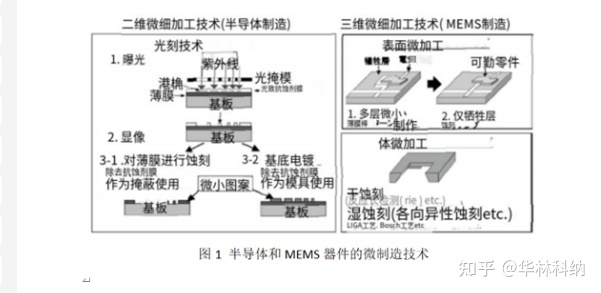
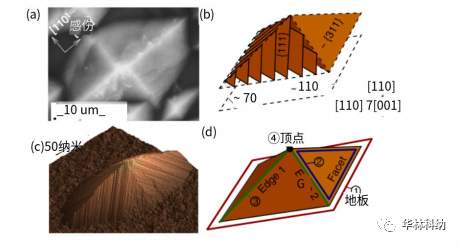
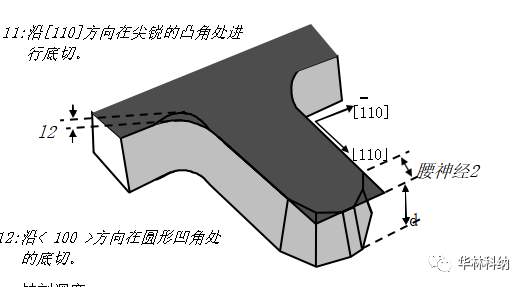

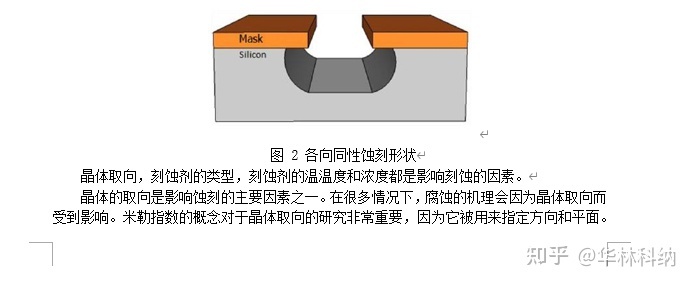

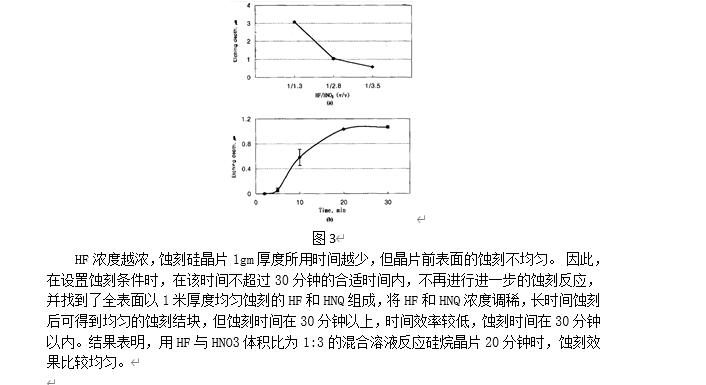

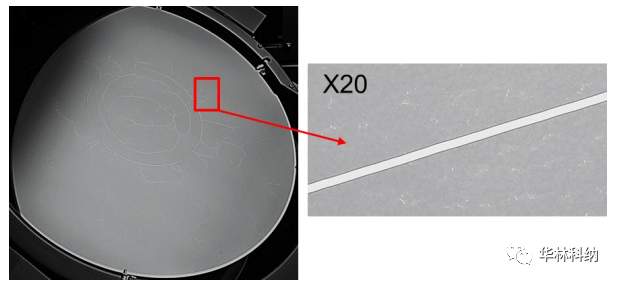
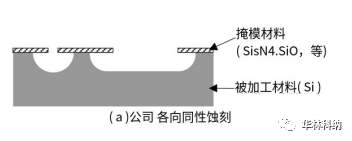

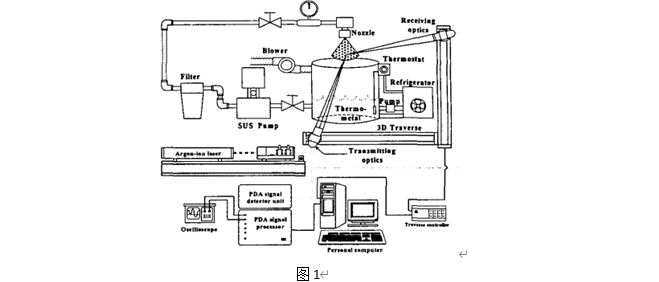
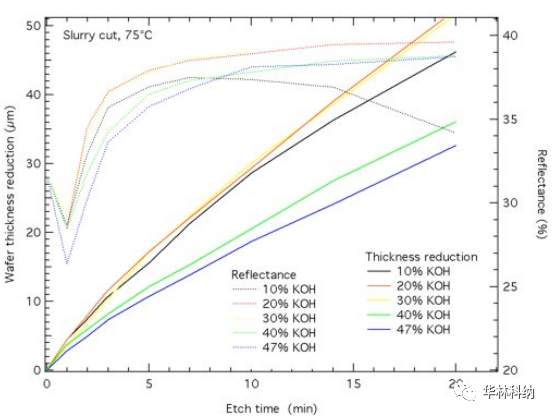

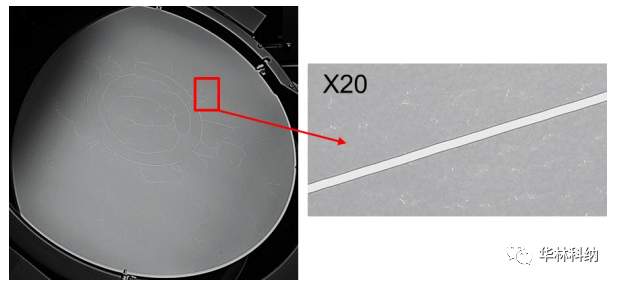
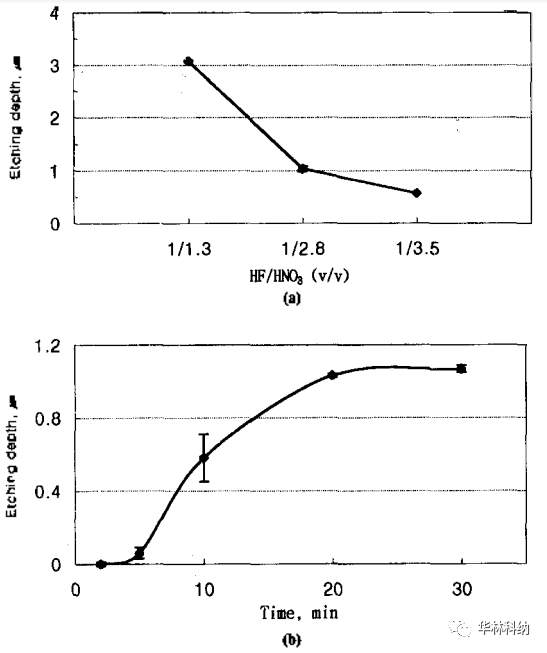
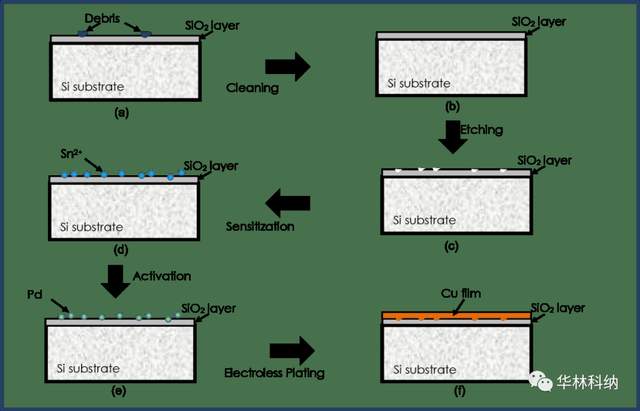
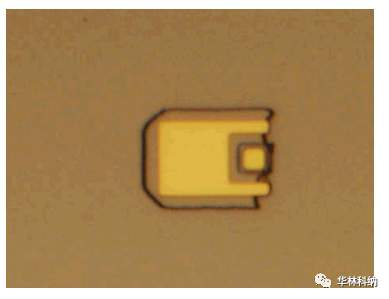
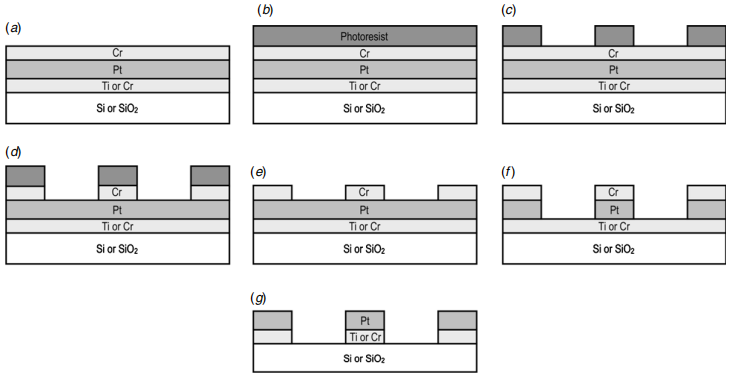

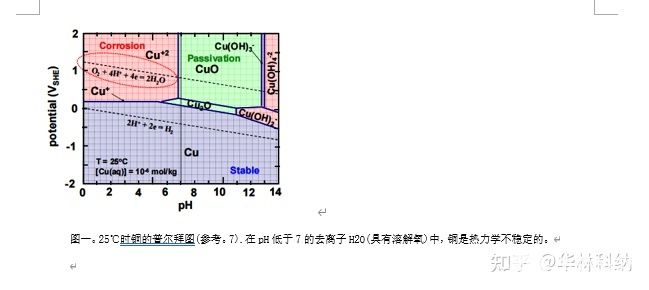
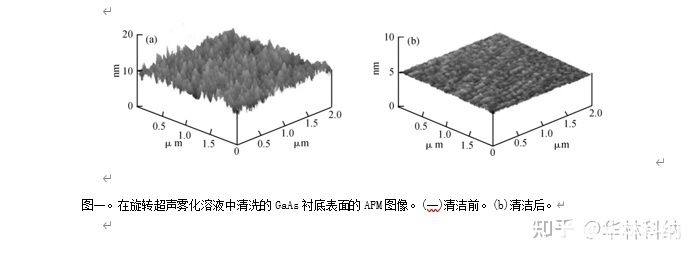




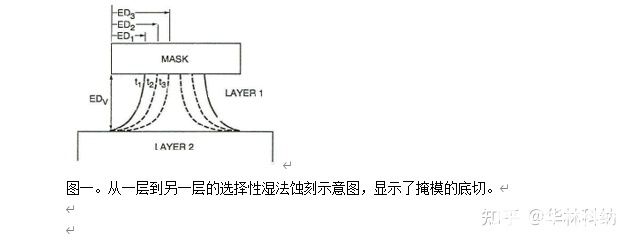





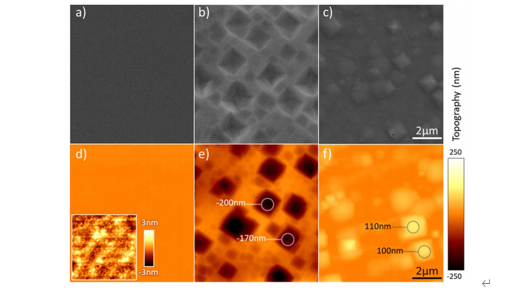
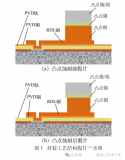
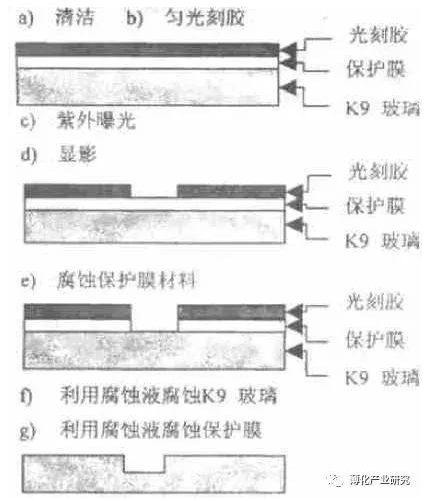


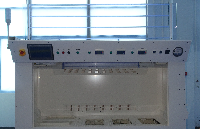




評論