熱壓鍵合機TC Bonder(Thermal Compression Bonding)是一種用于半導體封裝過程中熱壓鍵合的專用設備。在高帶寬內存(HBM)的制造過程中,TC Bonder通過施加熱量和壓力將多個DRAM芯片堆疊在一起,實現芯片間的電氣連接。
根據填充材料的不同,熱壓鍵合又可以分為TC-NCF, TC-NCP, TC-CUF, TC-MUF等等。取決于基板材料的不同,熱壓鍵合又可以分為Chip-to-Substrate (C2S) ,Chip-to-Wafer (C2W),Chip-to-Chip (C2C) 和Chip-to-Panel(C2P)。
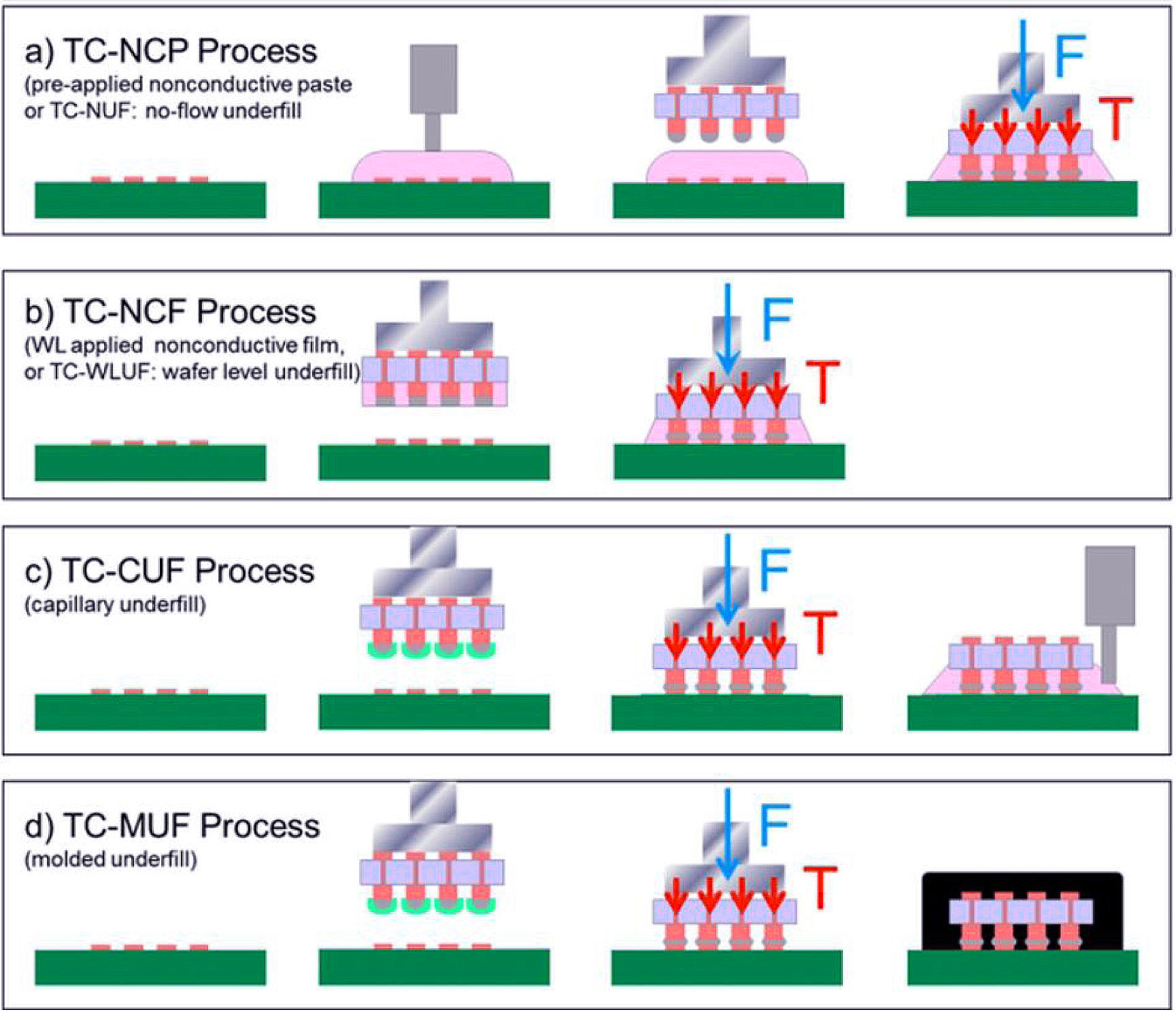
以常見的TC-CUF熱壓鍵合為例,整個芯片鍵合過程通常在1-5秒,熱壓鍵合機(TC Bonder)的具體步驟流程如下:
(1)將基板真空吸附到非常平整的pedestal上,并通常加熱到150oC到 200oC。將基板的溫度設定盡可能的高來減少鍵合時間。
(2)在基板的C4區域噴涂上足量的助焊劑 。
(3)將邦頭加熱到150oC到200oC之間,并用邦頭去拾取芯片。
(4)用上視和下視相機來確定芯片和基板的相對位置,通過校準過的算法算出芯片所需的空間位置調整來完全對照基板的凸點,通過設備上精密的機械控制來完成這個步驟。
(5)然后將邦頭連帶吸附的芯片一起以亞微米的精度靠近基板。此時芯片和基板都處在錫球融化溫度以下,所以錫球都是固體。錫球可以是在基板上也可以在芯片上或者兩者都有。
(6)在下降過程中邦頭一直處在壓力敏感控制,既進行著非常靈敏且實時的力測量。
(7)當芯片和基板接觸的那瞬間,系統探測到一個壓力上的變化,從而判斷接觸發生同時迅速將邦頭從壓力敏感控制轉為壓力和位置共同控制。
(8)此時通過邦頭上的加熱裝置迅速將芯片加熱至300oC以上。值得指出的是熱壓鍵合的溫度變化率一般都是在100 oC/s。相比之下,回流焊鍵合的溫度變化率要低很多,通常在2 oC/s。
(9)當錫球處于熔融狀態時,通過邦頭對芯片的精確位置控制來確保每對凸點都鍵合上,且將芯片間隙高度控制在合理的范圍內。值得指出的是,在加熱的過程中,真個系統都會熱膨脹,這部分的膨脹需要邦頭位置的精確控制來抵消。
(10)將邦頭的溫度迅速冷卻至錫球熔點以下,使得錫球變為固相。通常冷卻溫度變化率要比加熱溫度變化率要低一些,通常在?50 °C/s。
(11)關閉邦頭對芯片的真空吸附,芯片跟邦頭分離。芯片鍵合在基板上移出熱壓鍵合設備,鍵合完成。
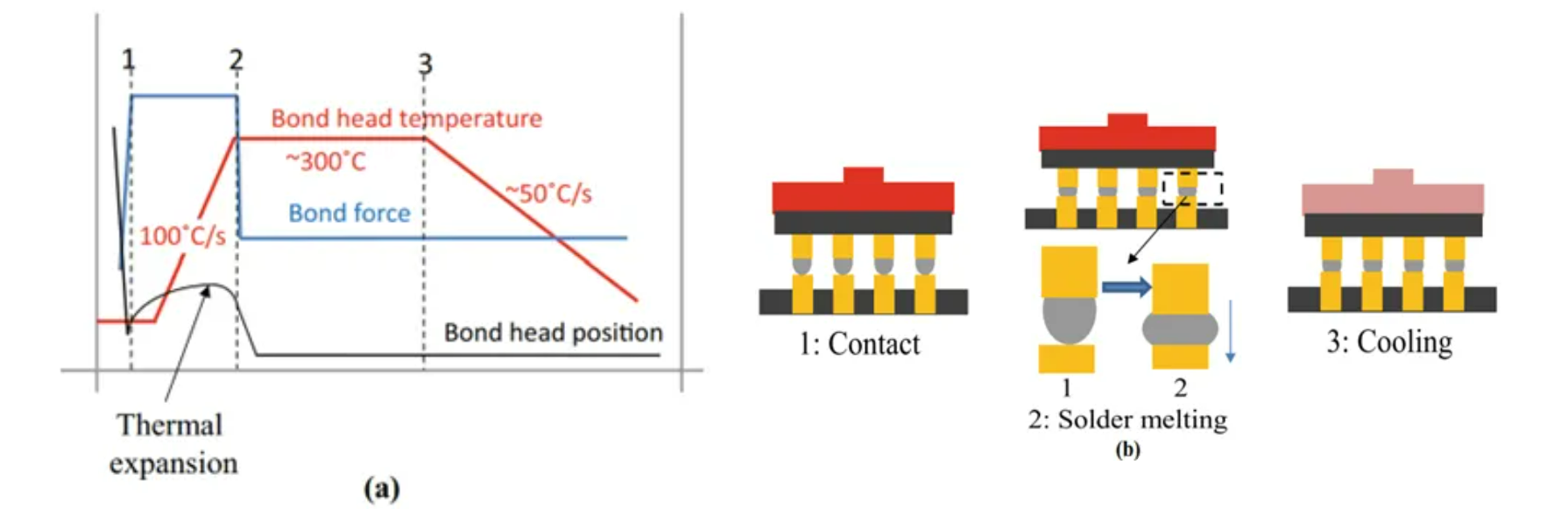
整個熱壓鍵合過程中,熱壓鍵合機會實時監測邦頭的溫度(Temperature),邦頭的應力( Bond Force)和Z方向的位移 (Bond Head Z Postion)。要求鍵合設備擁有亞微米甚至納米級別的位置對準精度,確保待鍵合芯片在高溫壓合時能精準對接。需要精準控制鍵合溫度、壓力和時間,以確保形成理想的金屬間化合物層,同時避免過度擴散導致的鍵合失效或電性能劣化。
熱壓鍵合機(TC Bonder)是HBM制程的核心設備,隨著人工智能(AI)和高性能計算(HPC)的需求增長,對HBM的需求供不應求,熱壓鍵合機(TC Bonder)的需求也將保持高增長趨勢,但,目前熱壓鍵合機基本被國外廠商所壟斷,國產替代任重而道遠。
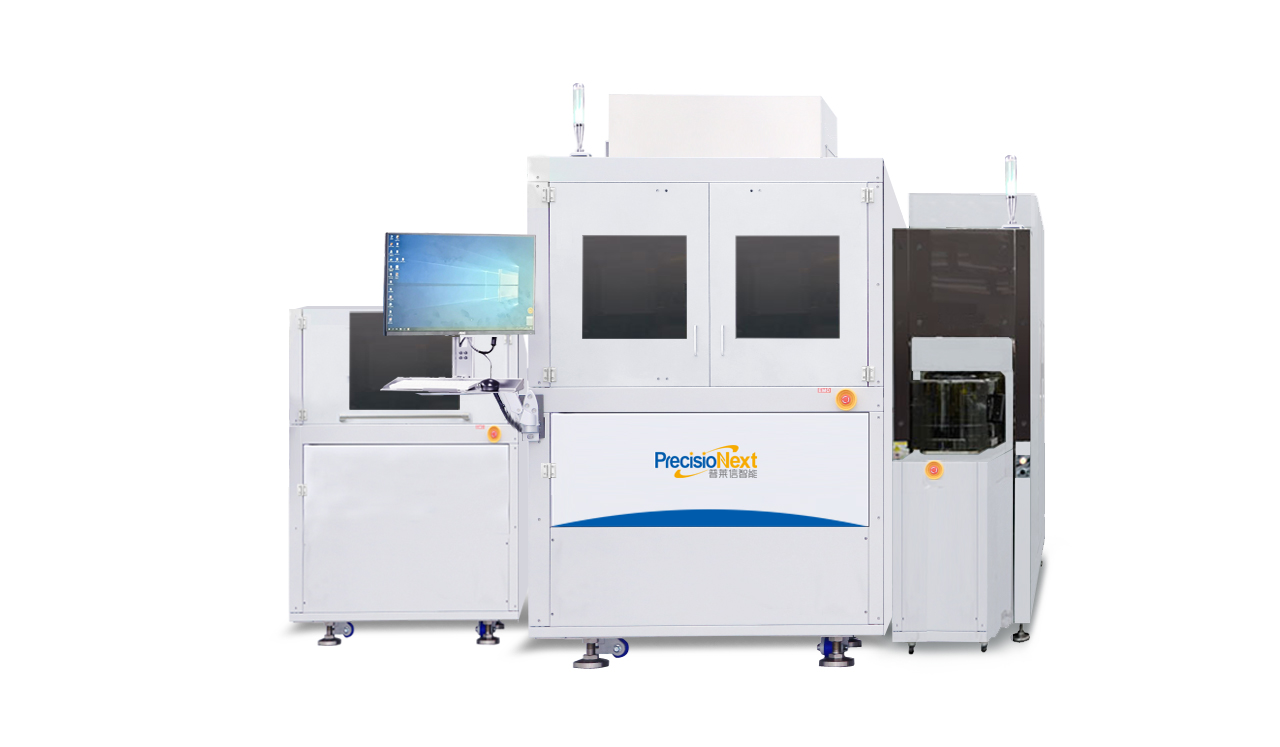
目前國產設備商積極布局該領域,例如普萊信的Loong系列熱壓鍵合機,擁有LoongWS和LoongF兩種機型,貼裝精度達到±1μm@3σ,其中LoongWS可以支持TC-NCF、MR-MUF等HBM堆疊鍵合工藝,LoongF支持FluxlessTCB無助焊劑熱壓鍵合工藝,適用于下一代HBM芯片。隨著中國半導體技術的進步和普萊信Loong系列TCB設備的推出和量產,國產廠商在HBM的研發和制造上,將在不遠的將來迎來爆發點。
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54007瀏覽量
465950 -
鍵合
+關注
關注
0文章
96瀏覽量
8272 -
HBM
+關注
關注
2文章
431瀏覽量
15831
發布評論請先 登錄
NTC熱敏芯片鍵合工藝介紹
熱壓鍵合工藝的技術原理和流程詳解

氧濃度監控在熱壓鍵合(TCB)工藝過程中的重要性

IGBT 芯片平整度差,引發鍵合線與芯片連接部位應力集中,鍵合失效

突破堆疊瓶頸:三星電子擬于16層HBM導入混合鍵合技術




 熱壓鍵合機(TC Bonder)在HBM的應用
熱壓鍵合機(TC Bonder)在HBM的應用










評論