隨著半導體產品高性能、輕薄化發展,封裝技術作為連接芯片與外界環境的橋梁,其重要性日益凸顯。在眾多封裝技術中,熱壓鍵合(Thermal Compression Bonding)工藝技術以其獨特的優勢,在高性能、高密度封裝領域占據了一席之地,傳統的倒裝回流焊封裝工藝,因其翹曲、橋接、移位等各種缺陷,逐漸被熱壓鍵合TCB所取代。本文主要跟大家分享的就是剖析熱壓鍵合技術,并探討氧氣濃度監控在TCB工藝中的重要性。
熱壓鍵合(TCB)工藝技術介紹
熱壓鍵合,英文全稱:Thermal Compression Bonding,簡稱:TCB,它是一種先進的封裝工藝技術,通過同時施加熱量和壓力,將芯片與基板或其他材料緊密連接在一起。這種技術能夠在微觀層面上實現材料間的牢固連接,為半導體器件提供穩定可靠的電氣和機械連接。TCB工藝技術廣泛應用于集成電路、微電子、光電子等行業,特別適用于需要高精度、高可靠性封裝的高端芯片。
TCB設備的核心組件
TCB設備的心臟是貼片頭(Bond Head),由線性伺服馬達(Linear Servo Motor)驅動空氣軸承(Air Bearing)運動,如圖7所示。有賴于高精度的伺服系統以及無摩擦的空氣軸承導軌,垂直方向的運動精度可以控制在1um以內,從而實現錫球熔化過程下的微移動的精準控制。

貼片頭配備了應力控制單元(Force Sensor),快速升降溫脈沖加熱器(Pulse Heater),還配備了一套主動傾斜控制系統(Active Tip Tilt)。
主動傾斜控制系統(Active Tip Tilt)可以精確調節脈沖加熱器的共面度,使其與基板(Substrate)所在的加熱板(Hot Pedestal)的表面完美貼合,在22mm x 33mm的區域內,可使上下兩個平面共面間距不超過3um,幾乎可以消除芯片翹起相關的失效。
壓力傳感器(Force Sensor)與壓力傳動方向同步,可實時監測貼片頭在垂直方向運動中的應力反饋,從而得知芯片在貼片過程中的受壓狀態。線性伺服馬達驅動可提供貼片頭超過10N的貼片壓力,壓力伺服控制反饋系統可提供0.05N壓力控制精度。
脈沖加熱器(Pulse Heater)可提供每秒超過100度的升溫速率,以及超過50度/秒的降溫速度,這樣從約400度(貼片過程中的最高溫度)降到待機150度只需5秒左右。快速升溫降溫能力可以避免過多的熱量持續加載給基板,并且顯著縮短貼片所需時間。
加熱單元中的組件得到充分工程優化,有良好的溫度均一性,以及100度/秒的升溫速率下,在22mm x 33mm區域內加熱塊表面的溫度差異不超過10度。由此保證了芯片和基板的接觸面錫球可以同步熔化。
貼片頭使用的芯片吸頭(Nozzle)為片狀,尺寸與芯片尺寸匹配,材質為單晶,有極佳的導熱性能,內有真空通道,可以將芯片牢牢吸附固定,且芯片吸頭可以自動更換,可實現同一個基板貼裝若干尺寸不同的芯片。
涂覆有液態助焊劑(Flux)的基板真空固定在加熱板(Pedestal)上,加熱板所在的平臺(Bond Stage)坐落在空氣軸承之上,在線性伺服馬達驅動下進行無摩擦的水平移動。加熱板最高可被加熱到200度,在基板的貼片過程中可以精準控制基板的溫度。芯片和基板通過上下同軸的高分辨率的相機系統對位(Up Looking and Down Looking Optics),該相機系統是熱控設計,可避免圖像因高溫畸變,如下圖所示。高精度的相機,以及無摩擦氣墊運動的基板平臺,保證了芯片和基板的極小的水平位置偏差,22mm x 33mm的芯片的偏移可小于2.5um且滿足Cpk 1.33。
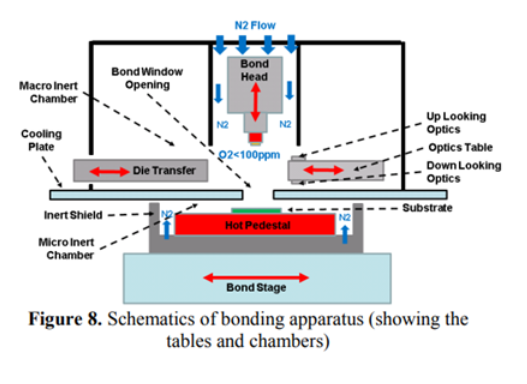
焊接裝置示意圖
貼片頭,光學相機板以及真空加熱板都位于密閉的腔體內,如上圖所示。冷卻板(Cooling Plate)將整個腔體分為上方的大的惰性氣體腔(Macro Inter Chamber)和小的惰性氣體腔(Micro Inert Chamber),冷卻板的正中央有一個開孔,貼片頭的芯片通過此開孔與基板結合。冷卻板可以防止下方大尺寸的加熱板的熱量傳遞到上方腔體,以避免影響貼片頭和光學相機板的功能。芯片轉移臂把芯片轉運到冷卻板的中央開孔處,之后貼片頭向下運動將芯片吸起,芯片轉移臂復位后,貼片頭進一步向下運動,穿過中央開孔,將芯片貼置于基板上。上方密封腔充滿了氮氣(N2),將氧氣的濃度控制在100ppm以下,以防止芯片在加熱過程中的氧化。同時下方密封腔也有氮氣氣流,氧氣的濃度同樣控制在100ppm以下,以保護基板在加熱過程中不被氧化。
氧氣濃度監控傳感器推薦:
在TCB工藝中,氧氣濃度監控是保障鍵合質量、提升封裝可靠性的關鍵技術之一。為了確保鍵合區域的低氧環境,通常采用氮氣保護,將氧氣濃度控制在100ppm以下,以防止芯片氧化。
對于氧氣濃度監控,奧地利SENSORE離子流氧氣傳感器- SO-B0-001是一款基于極限電流原理的微量氧傳感器,可以在焊接設備環境中穩定運行。傳感器檢測范圍10-1000ppm氧氣,最高可以在350℃環境工作,全量程精度20ppm,通過實時監測和控制鍵合區域的氧氣濃度,傳感器可以顯著提高焊接質量、穩定性和生產效率,是確保焊接過程順利進行和最大化效益的關鍵步驟。廣泛應用于波峰焊、回流焊、電子、半導體行業焊接爐及惰性氣體燒結爐等保護氣體在線氧分析。綜上,氧濃度監控是TCB工藝中保障鍵合質量、提升封裝可靠性的技術之一,其精度直接影響高性能芯片的長期穩定性?。
奧地利SENSOR離子流氧氣傳感器系列測量范圍,精度,重復性和響應時間

審核編輯 黃宇
-
封裝
+關注
關注
128文章
9290瀏覽量
148837 -
監控
+關注
關注
6文章
2388瀏覽量
59510
發布評論請先 登錄
IC引腳失效模式和影響分析(FMEA)的重要性
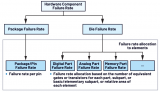



 氧濃度監控在熱壓鍵合(TCB)工藝過程中的重要性
氧濃度監控在熱壓鍵合(TCB)工藝過程中的重要性















評論