文章來源:學習那些事
原文作者:前路漫漫
本文主要講述芯片制造中的中間層鍵合。
依據中間層所采用的材料不同,中間層鍵合可劃分為黏合劑鍵合與金屬中間層鍵合兩大類,下文將分別對其進行詳細闡述。
黏合劑鍵合
黏合劑鍵合技術所選用的中間鍵合層材料,通常為玻璃漿料、聚合物等各類黏合介質。該方法能夠在相對較低的溫度環境下(最高溫度不超過450℃)實現較高的表面結合能,進而獲得優異的結合強度。這一特性對于緩解不同材料間因溫差產生的熱應力,以及避免由此引發的鍵合失效問題具有重要意義。與此同時,黏性鍵合層的存在提升了對被鍵合表面顆粒雜質、污漬及各類缺陷的適配能力,即便表面存在一定瑕疵,也可順利完成晶圓間的鍵合操作。
1. 玻璃漿料黏合劑鍵合
玻璃漿料黏合劑鍵合的核心原理,是采用低熔點玻璃作為專用中間層材料,且該玻璃的熔點需嚴格控制在450℃以下。該技術在晶圓級封裝與密封領域應用廣泛,具備密封性優良、工藝合格率高、界面應力小以及可靠性強等諸多優勢。玻璃漿料黏合劑鍵合的完整流程主要包含以下幾個關鍵階段,具體如圖1所示。
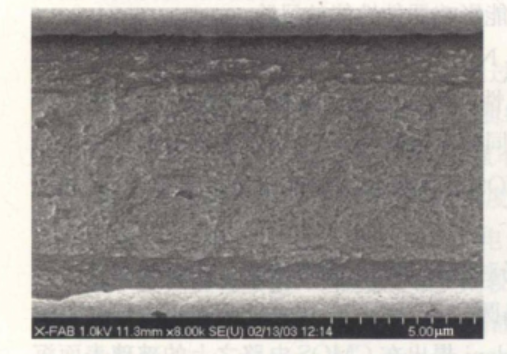
(1)首先,將玻璃粉末與特定溶劑充分混合,調配成均勻的漿料狀物質。
(2)隨后借助絲網印刷技術,在刮刀的作用下,將玻璃漿料填充至絲網模板的孔隙中,在硅晶圓表面形成分布均勻的預設圖案。
(3)進行預燒結處理,目的是徹底去除漿料中含有的水分與有機溶劑,使圖案表面達到近熔融狀態,以保障其平整度符合后續工藝要求。
(4)在最終的鍵合工序中,通過對準標記實現晶圓的精準對位貼合,之后在鍵合設備中通過升溫加壓的方式完成鍵合操作。
由于玻璃漿料黏合劑在鍵合過程中會轉變為熔融狀態,因此其對鍵合面的粗糙度具有較強的容忍性。在該鍵合技術中,玻璃漿料在特定溫度區間內的熱膨脹系數與硅、玻璃材料相近,由此產生的熱應力較小,這使得玻璃漿料黏合劑鍵合成為一種工藝簡便且封裝效果理想的鍵合技術。
通常而言,玻璃漿料黏合劑鍵合對絲網印刷工藝的精度要求極高,這也是整個流程中極具挑戰性的環節。晶圓自身的幾何結構特征、網版的定位移動精度、絲網印刷時刮刀的壓力與運行速度,以及漿料自身的物理特性(如黏度大小、顆粒尺寸等),都會對最終圖案的成型質量與位置精度產生顯著影響。因此,在開展具體鍵合操作前,需對以下幾個關鍵環節進行細致考量與優化。
(1)網版孔洞的結構設計參數;
(2)印刷過程中圖案在微觀尺度上的擴展規律;
(3)絲網印刷過程中出現的偏差,以及絲網自身因受力產生的伸展變形問題。
該設備的印刷頭上配備了透明保護罩,能夠為玻璃漿料的印刷作業提供穩定良好的環境條件。在整個印刷過程中,通過對各項印刷參數的精準調控,玻璃漿料在刮刀壓力的作用下,經由絲網孔洞均勻分布在晶圓表面,可形成一致性良好的密封環結構。

需要重點說明的是,采用絲網印刷成型的玻璃漿料黏合劑框架為三維實體結構,其中玻璃層的厚度主要由網版設計參數(線寬與預設膜厚)決定,但同時也會受到多種因素的綜合影響。為確保器件具備可靠的密封性,玻璃層的厚度必須設定明確的設計標準,即便玻璃漿料黏合劑在鍵合過程中會發生一定程度的流動,也需保證最終形成氣密性鍵合效果。由于線寬是影響絲網印刷結構厚度的核心因素(圖3展示了不同線寬對結構厚度的影響關系),因此在設計階段需確保晶圓上所有結構的線寬保持一致。即便在矩形結構的拐角處厚度會出現輕微增加,這種厚度增量也必須控制在合理范圍內,以保障整個工藝過程的穩定性。

聚合物黏合劑鍵合
聚合物黏合劑是由大量小分子(單體)通過聚合反應連接形成的大分子(高分子)化合物,單體之間的連接過程被稱為聚合反應。聚合物黏合劑通常可分為熱塑性、熱固性、彈性體及混合型四大類。在鍵合工藝中,聚合物黏合劑需以液態、半液態或黏彈性體的形態存在,以保證與被鍵合表面實現緊密接觸;后續通過特定處理,聚合物黏合劑需轉變為固態,從而能夠承受鍵合過程中施加的溫度與壓力。
不同類型的聚合物黏合劑具有各自獨特的性能特點,因此選擇適配的聚合物黏合劑至關重要。聚合物黏合劑及其所含的溶劑、添加劑,必須與晶圓表面材料、內部器件保持良好的兼容性,同時還要適配前期的薄膜沉積工藝以及鍵合后的后續處理工序。例如,在選型過程中,需要充分考慮聚合物的熱穩定性、機械穩定性、蠕變強度,以及在后續工序中對SC-1、SC-2、酸堿溶液及SPM等有機溶劑的耐腐蝕性能。

在采用黏合劑材料進行臨時鍵合的工藝中,解鍵合過程是不可或缺的關鍵環節。根據臨時鍵合所用黏合劑的性能特點,解鍵合方法通常可分為三大類。
(1)化學方法
部分臨時鍵合材料能夠對特定化學反應劑產生響應,在接觸反應劑后自身特性發生改變,從而實現載片與器件晶圓的分離。為加快溶劑與黏合劑的反應速率,可對浸泡在解鍵合溶劑中的晶圓進行加熱處理及超聲波輔助處理,以促進黏合劑的溶解。但化學解鍵合存在明顯不足:浸泡時間較長,通常需要數小時;且晶圓表面與溶劑直接接觸,在取放晶圓的過程中可能會對其造成損傷。此外,即便化學反應劑可循環利用,也需充分考慮其消耗速度快、易產生廢棄物等潛在問題及環境影響。
(2)熱處理方法
當鍵合所用黏合劑被加熱至液態時,可較為輕松地將載片與器件晶圓分離。該方法尤其適用于熱塑性黏合劑材料,因為加熱會導致這類黏合劑的黏度顯著下降,當黏度降至1~2Pa·s時,鍵合的兩片晶圓便會開始自然分離。常見的分離方式主要有兩種:滑動剝離法與楔入剝離法。滑動剝離法是沿水平方向使載片與器件晶圓分離,而楔入剝離法則是沿垂直方向完成分離操作。多數解鍵合工藝中會優先采用楔入剝離法,部分復合黏合材料中還專門增設了紫外光敏感層,在紫外光照射下,該敏感層會發生破壞,導致鍵合強度大幅降低,此時僅需施加較小的外力即可完成分離。
此外,采用的多層復合膜呈現“三明治”結構,由兩層黏附層與一層核心基膜構成(圖4),且兩層黏附層的外側均設有保護膜,以防止褶皺或污物影響鍵合效果。該鍵合工藝的具體流程如下:首先去除外層保護膜,將復合膜精準貼合在器件晶圓表面;隨后將該晶圓與一塊可透過紫外光的石英玻璃緊密貼合,并在特定溫度下施加足夠壓力,確保兩者實現牢固結合;接著采用特定波段(波長405nm)的紫外光穿透石英玻璃照射復合膜表面,使復合膜固化并強化兩者間的結合力;完成該步驟后,即可開展刻蝕、光刻、晶圓減薄等一系列后續工藝;最終,將待解鍵合的石英晶圓置于特定紫外光(波長254nm)下照射,該過程會促使氮氣釋放,從而完成解鍵合操作,具體流程如圖5所示。

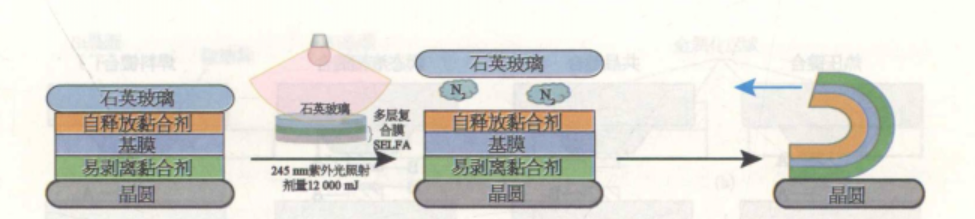
半自動解鍵合設備,能夠高效完成超薄器件晶圓的解鍵合工藝(圖6)。該設備利用紫外光照射石英玻璃及150μm厚的超薄器件晶圓,使石英與硅晶圓表面之間產生氣體,再通過楔入剝離法,可實現兩片晶圓的高效、無損分離。
(3)激光處理方法
對于無法通過化學腐蝕或熱處理方法實現剝離的臨時鍵合膠,需在鍵合膠中添加專用釋放層材料。目前應用較為廣泛的先進釋放層為光熱轉換(LTHC)層材料,當該材料暴露于特定頻率的激光下時,高能激光會在材料表面形成微小孔洞,從而顯著削弱鍵合強度,之后通過楔入剝離法即可實現載晶圓與器件晶圓的分離。
-
芯片制造
+關注
關注
11文章
719瀏覽量
30464 -
鍵合
+關注
關注
0文章
96瀏覽量
8272
原文標題:芯片制造中的中間層鍵合
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄



 詳解芯片制造中的中間層鍵合技術
詳解芯片制造中的中間層鍵合技術







評論