人工智能(AI)芯片缺貨,英偉達(dá)H100和A100芯片均采用臺積電CoWoS先進(jìn)封裝,但CoWoS產(chǎn)能受限待爬坡。法人分析,CoWoS封裝所需中介層因關(guān)鍵制程復(fù)雜、高精度設(shè)備交期拉長而供不應(yīng)求,牽動CoWoS封裝調(diào)度及AI芯片出貨。
大語言模型訓(xùn)練和推理生成式AI(Generative AI)應(yīng)用,帶動高端AI服務(wù)器和高性能計算(HPC)數(shù)據(jù)中心市場,內(nèi)置集成高帶寬內(nèi)存(HBM)的通用繪圖處理器(GPGPU)供不應(yīng)求,主要大廠英偉達(dá)(Nvidia)A100和H100繪圖芯片更是嚴(yán)重缺貨。
研調(diào)機(jī)構(gòu)集邦科技(TrendForce)指出,AI及HPC芯片對先進(jìn)封裝技術(shù)需求大,其中以臺積電的2.5D先進(jìn)封裝CoWoS技術(shù),是目前AI芯片主力采用者。
美系外資法人分析,英偉達(dá)是采用臺積電CoWoS封裝的最大客戶,例如英偉達(dá)H100繪圖芯片采用臺積電4納米先進(jìn)制程,A100繪圖芯片采用臺積電7納米制程,均采用CoWoS技術(shù),英偉達(dá)占臺積電CoWoS產(chǎn)能比重約40%至50%。
至于英偉達(dá)8月上旬推出的L40S繪圖芯片,未采用HBM內(nèi)存,因此不會采用臺積電CoWoS封裝。
產(chǎn)業(yè)人士指出,通用繪圖處理器采用更高規(guī)格的高帶寬內(nèi)存,需借由2.5D先進(jìn)封裝技術(shù)將核心晶粒(die)集成在一起,而CoWoS封裝的前段芯片堆棧(Chip on Wafer)制程,主要在芯片廠內(nèi)通過65納米制造并進(jìn)行硅穿孔蝕刻等作業(yè),之后再進(jìn)行堆棧芯片封裝在載板上(Wafer on Substrate)。
不過臺積電CoWoS封裝產(chǎn)能吃緊,在7月下旬法人說明會,臺積電預(yù)估CoWoS產(chǎn)能將擴(kuò)張1倍,但供不應(yīng)求情況要到明年底才可緩解。臺積電7月下旬也宣布斥資近新臺幣900億元,在竹科轄下銅鑼科學(xué)園區(qū)設(shè)立先進(jìn)封裝芯片廠,預(yù)計2026年底完成建廠,量產(chǎn)時間落在2027年第2季或第3季。
英偉達(dá)首席財務(wù)官克芮斯(Colette Kress)在8月24日在線上投資者會議透露,英偉達(dá)在CoWoS封裝的關(guān)鍵制程,已開發(fā)并認(rèn)證其他供應(yīng)商產(chǎn)能,預(yù)期未來數(shù)季供應(yīng)可逐步爬升,英偉達(dá)持續(xù)與供應(yīng)商合作增加產(chǎn)能。
美系外資法人集成AI芯片制造的供應(yīng)鏈消息指出,CoWoS產(chǎn)能是AI芯片供應(yīng)產(chǎn)生瓶頸的主要原因,亞系外資法人分析,CoWoS封裝產(chǎn)能吃緊,關(guān)鍵原因在中介層供不應(yīng)求,因為中介層硅穿孔制程復(fù)雜,且產(chǎn)能擴(kuò)展需要更多高精度設(shè)備,但交期拉長,既有設(shè)備也需要定期清洗檢查,硅穿孔制程時間拉長,因此牽動CoWoS封裝調(diào)度。
法人指出,除了臺積電,今年包括聯(lián)電和日月光投控旗下硅品精密,也逐步擴(kuò)展CoWoS產(chǎn)能。
臺廠也積極布局2.5D先進(jìn)封裝中介層,臺積電在4月下旬北美技術(shù)論壇透露,正在開發(fā)重布線層(RDL)中介層的CoWoS解決方案,可容納更多高帶寬內(nèi)存堆棧;聯(lián)電在7月下旬說明會也表示,加速展開提供客戶所需的硅中介層技術(shù)及產(chǎn)能。
美系外資法人透露,臺積電正將部分硅中介層(CoWoS-S)產(chǎn)能轉(zhuǎn)移至有機(jī)中介層(CoWoS-R),以增加中介層供應(yīng)。
日月光投控在7月下旬說明會也表示,正與芯片廠合作包括先進(jìn)封裝中介層組件;IC設(shè)計服務(wù)廠創(chuàng)意去年7月指出,持續(xù)布局中介層布線專利,并支持臺積電的硅中介層及有機(jī)中介層技術(shù)。
-
數(shù)據(jù)中心
+關(guān)注
關(guān)注
18文章
5647瀏覽量
75009 -
語言模型
+關(guān)注
關(guān)注
0文章
571瀏覽量
11310 -
CoWoS
+關(guān)注
關(guān)注
0文章
169瀏覽量
11505 -
AI芯片
+關(guān)注
關(guān)注
17文章
2126瀏覽量
36770
原文標(biāo)題:AI芯片CoWoS封裝產(chǎn)能受限,中介層不足成關(guān)鍵
文章出處:【微信號:robotn,微信公眾號:產(chǎn)業(yè)大視野】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
【深度報告】CoWoS封裝的中階層是關(guān)鍵——SiC材料

AI芯片發(fā)展關(guān)鍵痛點就是:CoWoS封裝散熱

CoWoS產(chǎn)能狂飆下的隱憂:當(dāng)封裝“量變”遭遇檢測“質(zhì)控”瓶頸
先進(jìn)封裝市場迎來EMIB與CoWoS的格局之爭
CoWoS產(chǎn)能狂飆的背后:異質(zhì)集成芯片的“最終測試”新范式
臺積電CoWoS技術(shù)的基本原理

臺積電CoWoS平臺微通道芯片封裝液冷技術(shù)的演進(jìn)路線

HBM技術(shù)在CowoS封裝中的應(yīng)用
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+具身智能芯片
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+半導(dǎo)體芯片產(chǎn)業(yè)的前沿技術(shù)
CoWoP能否挑戰(zhàn)CoWoS的霸主地位

2.5D封裝為何成為AI芯片的“寵兒”?

玻璃中介層:顛覆傳統(tǒng)封裝,解鎖高性能芯片 “新密碼”
國產(chǎn)AI芯片破局:國產(chǎn)TCB設(shè)備首次完成CoWoS封裝工藝測試
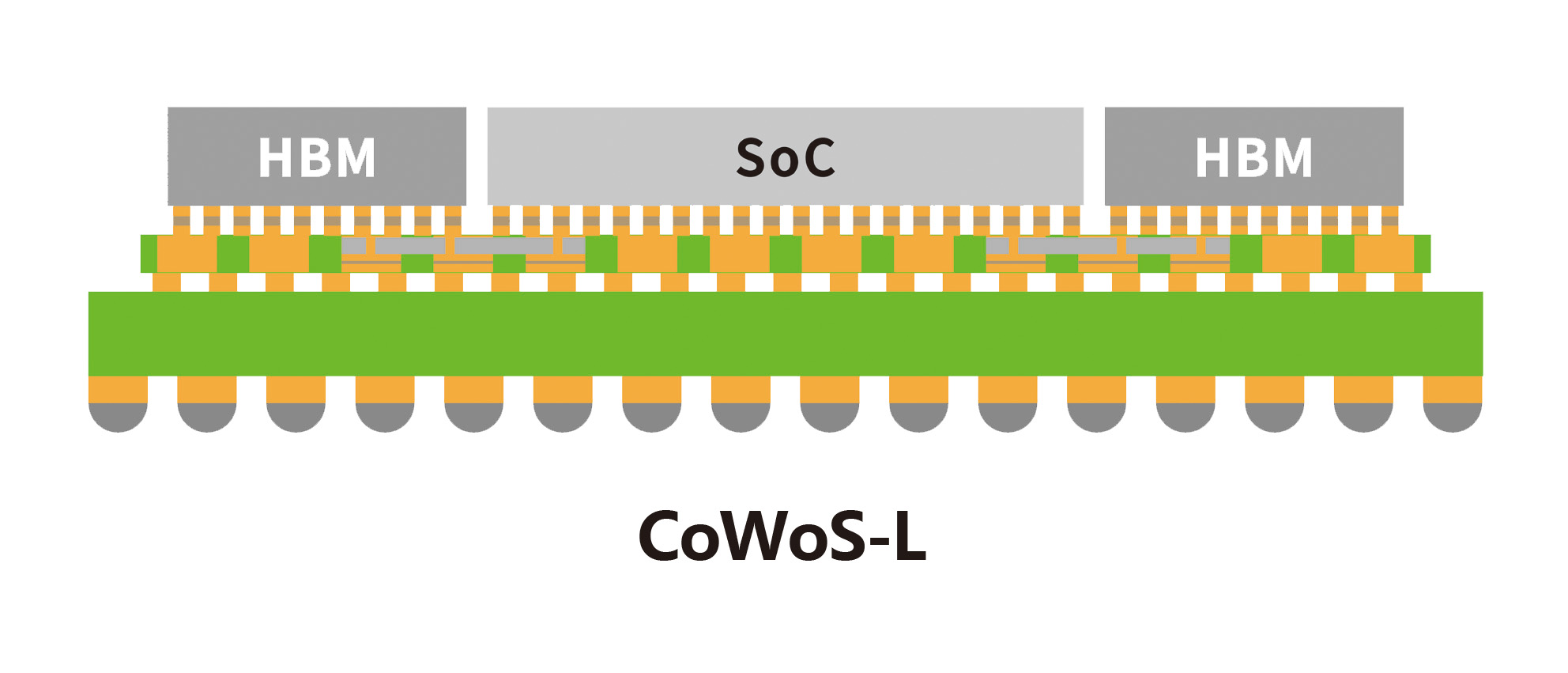



 AI芯片CoWoS封裝產(chǎn)能受限,中介層不足成關(guān)鍵
AI芯片CoWoS封裝產(chǎn)能受限,中介層不足成關(guān)鍵

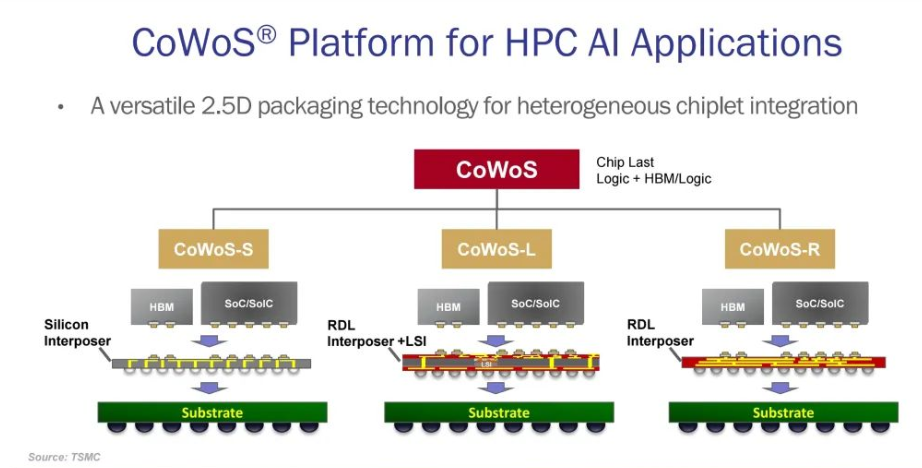



評論