如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習! 在全球半導體技術飛速迭代的今天,芯片作為支撐現代科技運轉的 “核心引擎”,正朝著更輕薄、高性能的方向加速演進。而晶圓減薄技
2025-12-31 21:38:57 36
36 
用于單向可見光成像的多層衍射光學處理器的晶圓級納米制造。 加州大學洛杉磯分校薩繆利工程學院的研究人員與博通公司光學系統部門合作,報告了一種寬帶、偏振不敏感的單向成像儀,該成像儀在可見光譜中運行,能夠
2025-12-02 07:38:38 125
125 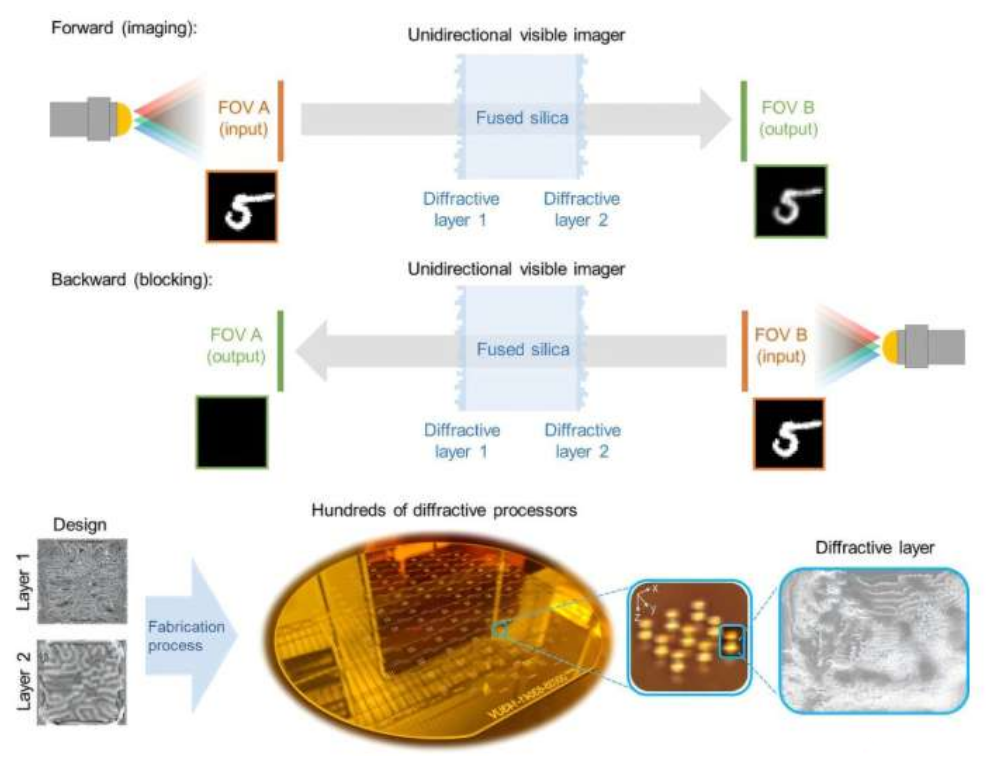
如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習! 晶圓減薄(Grinder)是半導體制造過程中一個關鍵的步驟,它主要是為了滿足芯片在性能、封裝、散熱等方面的需求。隨著技術的不斷進步
2025-12-01 17:47:57 1352
1352 
的均勻性直接影響光刻工藝中曝光深度、圖形轉移精度等關鍵參數 。當前,如何優化玻璃晶圓 TTV 厚度在光刻工藝中的反饋控制,以提高光刻質量和生產效率,成為亟待研究的重要
2025-10-09 16:29:24 576
576 
2.0)研究報告》(以下簡稱“報告”)。報告闡述了AI時代數據中心網絡的演進趨勢與挑戰,并從AI大腦、AI聯接、AI網元三層網絡架構明確了數據中心網絡代際演進的關鍵技術方向,同時也展示了華為面向AI時代的智能算網方案的技術領導力和影響力。
2025-09-25 09:37:39 534
534 再生晶圓與普通晶圓在半導體產業鏈中扮演著不同角色,二者的核心區別體現在來源、制造工藝、性能指標及應用場景等方面。以下是具體分析:定義與來源差異普通晶圓:指全新生產的硅基材料,由高純度多晶硅經拉單晶
2025-09-23 11:14:55 774
774 
在第十一屆中國國際大數據產業博覽會“數字政府”交流活動上,國家數據發展研究院攜手華為技術有限公司(以下簡稱“華為”)聯合發布《AI CITY城市智能體前瞻研究報告》,旨在探索人工智能新時代下的AI CITY智能體應用和架構,為城市全域數字化轉型建設提供前瞻指引,為城市智慧化演進注入創新活力。
2025-09-01 10:37:01 1119
1119 晶圓處理前端模塊是現代半導體制造裝備中的重要組成部分,承擔著在超凈環境中安全傳輸晶圓的關鍵任務。這類設備不僅要維持極高的潔凈度標準,還必須實現精準可靠的晶圓轉移,以滿足現代半導體制造對工藝精度和生產
2025-08-26 09:57:53 391
391 WD4000晶圓厚度翹曲度測量系統兼容不同材質不同粗糙度、可測量大翹曲wafer、測量晶圓雙面數據更準確。它通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度,TTV
2025-08-25 11:29:30
WD4000晶圓顯微形貌測量系統通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度,TTV,BOW、WARP、在高效測量測同時有效防止晶圓產生劃痕缺陷。WD4000晶圓顯微
2025-08-20 11:26:59
晶圓清洗后的干燥是半導體制造中的關鍵步驟,其核心目標是在不損傷材料的前提下實現快速、均勻且無污染的脫水過程。以下是主要干燥方式及其技術特點:1.旋轉甩干(SpinDrying)原理:將清洗后的晶圓
2025-08-19 11:33:50 1111
1111 
WD4000晶圓膜厚測量系統通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度,TTV,BOW、WARP、在高效測量測同時有效防止晶圓產生劃痕缺陷。WD4000晶圓膜厚測量
2025-08-12 15:47:19
本文主要講述TSV工藝中的硅晶圓減薄與銅平坦化。 硅晶圓減薄與銅平坦化作為 TSV 三維集成技術的核心環節,主要應用于含銅 TSV 互連的減薄芯片制造流程,為該技術實現短互連長度、小尺寸、高集成度等特性提供了重要支撐。
2025-08-12 10:35:00 1545
1545 
我將從超薄晶圓研磨面臨的挑戰出發,點明聚氨酯墊性能對晶圓 TTV 的關鍵影響,引出研究意義。接著分析聚氨酯墊性能與 TTV 的關聯,闡述性能優化方向及 TTV 保障技術,最后通過實驗初步驗證效果。
超薄晶圓(
2025-08-06 11:32:54 585
585 
退火工藝是晶圓制造中的關鍵步驟,通過控制加熱和冷卻過程,退火能夠緩解應力、修復晶格缺陷、激活摻雜原子,并改善材料的電學和機械性質。這些改進對于確保晶圓在后續加工和最終應用中的性能和可靠性至關重要。退火工藝在晶圓制造過程中扮演著至關重要的角色。
2025-08-01 09:35:23 2027
2027 
摘要:本文圍繞基于納米流體強化的切割液性能提升及對晶圓 TTV 均勻性的控制展開研究。探討納米流體強化切割液在冷卻、潤滑、排屑等性能方面的提升機制,分析其對晶圓 TTV 均勻性的影響路徑,以及優化
2025-07-25 10:12:24 420
420 
晶圓清洗工藝是半導體制造中的關鍵步驟,用于去除晶圓表面的污染物(如顆粒、有機物、金屬離子和氧化物),確保后續工藝(如光刻、沉積、刻蝕)的良率和器件性能。根據清洗介質、工藝原理和設備類型的不同,晶圓
2025-07-23 14:32:16 1368
1368 
晶圓清洗機中的晶圓夾持是確保晶圓在清洗過程中保持穩定、避免污染或損傷的關鍵環節。以下是晶圓夾持的設計原理、技術要點及實現方式: 1. 夾持方式分類 根據晶圓尺寸(如2英寸到12英寸)和工藝需求,夾持
2025-07-23 14:25:43 929
929 尺寸與清洗挑戰小尺寸晶圓(2-6英寸)特點:面積小、厚度較薄(如2英寸晶圓厚度約500μm),機械強度低,易受流體沖擊損傷。挑戰:清洗槽體積較小,易因流體不均勻導致
2025-07-22 16:51:19 1332
1332 
厚度不均勻 。切割深度動態補償技術通過實時調整切割深度,為提升晶圓 TTV 厚度均勻性提供了有效手段,深入研究其提升機制與參數優化方法具有重要的現實意義。
二、
2025-07-17 09:28:18 406
406 
超薄晶圓厚度極薄,切割時 TTV 均勻性控制難度大。我將從闡述研究背景入手,分析淺切多道切割在超薄晶圓 TTV 均勻性控制中的優勢,再深入探討具體控制技術,完成文章創作。
超薄晶圓(
2025-07-16 09:31:02 469
469 
我將從超薄晶圓淺切多道切割技術的原理、TTV 均勻性控制的重要性出發,結合相關研究案例,闡述該技術的關鍵要點與應用前景。
超薄晶圓(
2025-07-15 09:36:03 486
486 
的背面減薄,通過研磨盤實現厚度均勻性控制(如減薄至50-300μm),同時保證表面粗糙度Ra≤0.1μm。 在化學機械拋光(CMP)工藝中,研磨盤配合拋光液對晶圓表面進行全局平坦化,滿足集成電路對層間平整度的要求。 ? 芯片封裝前處理 ? 對切
2025-07-12 10:13:41 893
893 產生的切削熱分布及其與工藝的耦合效應,會對晶圓 TTV 產生復雜影響 。深入研究兩者耦合效應對 TTV 的作用機制,對優化晶圓切割工藝、提升晶圓質量具有重要意義。
二、
2025-07-12 10:01:07 437
437 
WD4000晶圓厚度THK幾何量測系統兼容不同材質不同粗糙度、可測量大翹曲wafer、測量晶圓雙面數據更準確。它通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度,TTV
2025-07-10 13:42:33
超薄晶圓因其厚度極薄,在切割時對振動更為敏感,易影響厚度均勻性。我將從分析振動對超薄晶圓切割的影響出發,探討針對性的振動控制技術和厚度均勻性保障策略。
超薄晶圓(
2025-07-09 09:52:03 580
580 
On Wafer WLS無線晶圓測溫系統通過自主研發的核心技術將傳感器嵌入晶圓集成,實時監控和記錄晶圓在制程過程中的溫度變化數據,為半導體制造過程提供一種高效可靠的方式來監測和優化關鍵
2025-06-27 10:37:30
6月24日消息,市場調研機構Counterpoint Research最新公布的研究報告指出, 2025年第一季,全球晶圓代工2.0(Foundry 2.0)市場營收達720億美元,較去年同期增長
2025-06-25 18:17:41 440
440 在半導體制造的精密流程中,晶圓載具清洗機是確保芯片良率與性能的關鍵設備。它專門用于清潔承載晶圓的載具(如載具、花籃、托盤等),避免污染物通過載具轉移至晶圓表面,從而保障芯片制造的潔凈度與穩定性。本文
2025-06-25 10:47:33
WD4000晶圓厚度測量設備兼容不同材質不同粗糙度、可測量大翹曲wafer、測量晶圓雙面數據更準確。它通過非接觸測量,將晶圓的三維形貌進行重建,強大的測量分析軟件穩定計算晶圓厚度,TTV,BOW
2025-06-18 15:40:06
在半導體制造向納米級精度持續突破的進程中,精密傳感器已成為設備性能的“神經末梢”。作為工業傳感領域的代表品牌,明治的傳感器憑借在極端工況下的穩定性與測量精度,深度嵌入半導體三大核心設備——晶圓
2025-06-17 07:33:23 1019
1019 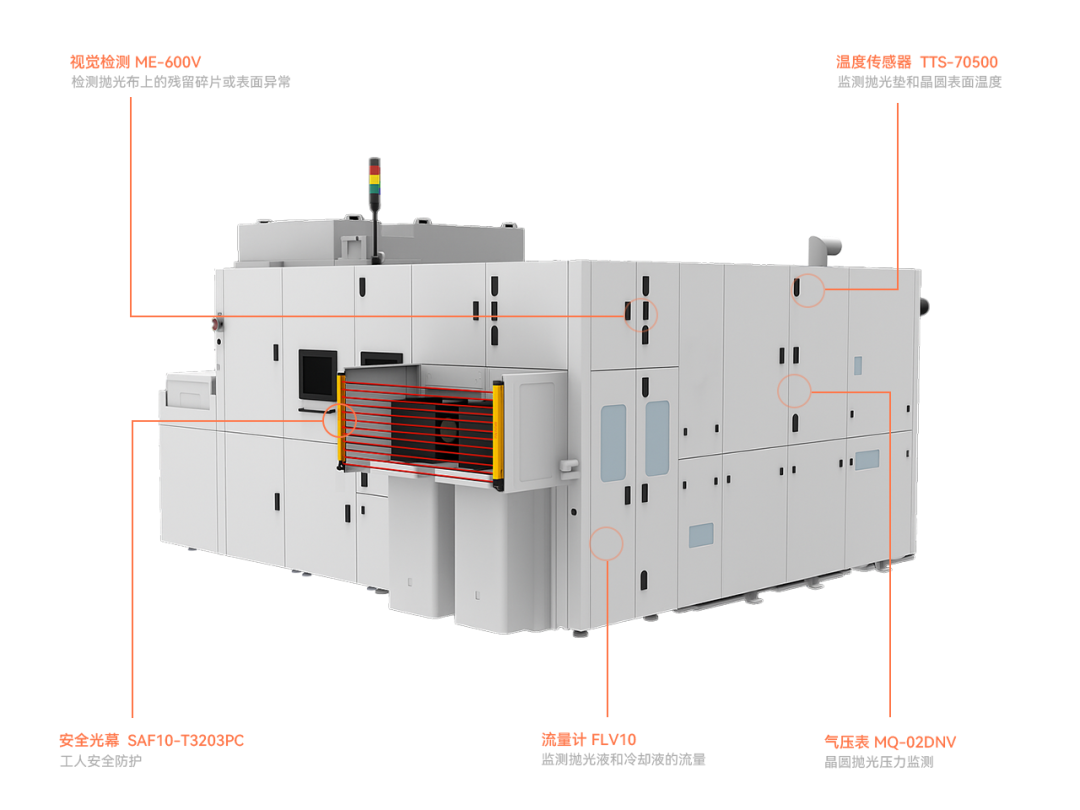
摘要:本文探討晶圓邊緣 TTV 測量在半導體制造中的重要意義,分析其對芯片制造工藝、器件性能和生產良品率的影響,同時研究測量方法、測量設備精度等因素對測量結果的作用,為提升半導體制造質量提供理論依據
2025-06-14 09:42:58 552
552 
晶圓經切割后,表面常附著大量由聚合物、光致抗蝕劑及蝕刻雜質等組成的顆粒物,這些物質會對后續工序中芯片的幾何特征與電性能產生不良影響。顆粒物與晶圓表面的粘附力主要來自范德華力的物理吸附作用,因此業界主要采用物理或化學方法對顆粒物進行底切處理,通過逐步減小其與晶圓表面的接觸面積,最終實現脫附。
2025-06-13 09:57:01 866
866 貼膜是指將一片經過減薄處理的晶圓(Wafer)固定在一層特殊的膠膜上,這層膜通常為藍色,業內常稱為“ 藍膜 ”。貼膜的目的是為后續的晶圓切割(劃片)工藝做準備。
2025-06-03 18:20:59 1180
1180 
電子發燒友網站提供《光電耦合器行業研究報告.docx》資料免費下載
2025-05-30 15:33:13 0
0 “減薄”,也叫 Back Grinding(BG),是將晶圓(Wafer)背面研磨至目標厚度的工藝步驟。這個過程通常發生在芯片完成前端電路制造、被切割前(即晶圓仍然整體時),是連接芯片制造和封裝之間的橋梁。
2025-05-30 10:38:52 1658
1658 測量。
(2)系統覆蓋襯底切磨拋,光刻/蝕刻后翹曲度檢測,背面減薄厚度監測等關鍵工藝環節。
晶圓作為半導體工業的“地基”,其高純度、單晶結構和大尺寸等特點,支撐了芯片的高性能與低成本制造。其戰略價值不僅
2025-05-28 16:12:46
關鍵詞:鍵合晶圓;TTV 質量;晶圓預處理;鍵合工藝;檢測機制 一、引言 在半導體制造領域,鍵合晶圓技術廣泛應用于三維集成、傳感器制造等領域。然而,鍵合過程中諸多因素會導致晶圓總厚度偏差(TTV
2025-05-26 09:24:36 854
854 
摘要:本文針對激光退火后晶圓總厚度偏差(TTV)變化的問題,深入探討從工藝參數優化、設備改進、晶圓預處理以及檢測反饋機制等方面,提出一系列有效管控 TTV 變化的方法,為提升激光退火后晶圓質量提供
2025-05-23 09:42:45 583
583 
使用直接晶圓到晶圓鍵合來垂直堆疊芯片,可以將信號延遲降到可忽略的水平,從而實現更小、更薄的封裝,同時有助于提高內存/處理器的速度并降低功耗。目前,晶圓堆疊和芯片到晶圓混合鍵合的實施競爭異常激烈,這被
2025-05-22 11:24:18 1405
1405 
摘要:本文針對濕法腐蝕工藝后晶圓總厚度偏差(TTV)的管控問題,探討從工藝參數優化、設備改進及檢測反饋機制完善等方面入手,提出一系列優化方法,以有效降低濕法腐蝕后晶圓 TTV,提升晶圓制造質量
2025-05-22 10:05:57 511
511 
摘要:本文聚焦于降低晶圓 TTV(總厚度偏差)的磨片加工方法,通過對磨片設備、工藝參數的優化以及研磨拋光流程的改進,有效控制晶圓 TTV 值,提升晶圓質量,為半導體制造提供實用技術參考。 關鍵詞:晶
2025-05-20 17:51:39 1028
1028 
WD4000晶圓Warp翹曲度量測系統采用高精度光譜共焦傳感技術、光干涉雙向掃描技術,完成非接觸式掃描并建立3D Mapping圖,實現晶圓厚度、TTV、LTV、Bow、Warp、TIR、SORI
2025-05-20 14:02:17
完成后,晶圓才會進入封裝環節進行減薄處理。晶圓為什么要減薄封裝階段對晶圓進行減薄主要基于多重考量。從劃片工藝角度,較厚晶圓硬度較高,在傳統機械切割時易出現劃片不均、
2025-05-16 16:58:44 1110
1110 
英寸晶圓厚度約為670微米,8英寸晶圓厚度約為725微米,12英寸晶圓厚度約為775微米。盡管芯片功能層的制備僅涉及晶圓表面幾微米范圍,但完整厚度的晶圓更有利于保障復雜工藝的順利進行。直至芯片前制程完成后,晶圓才會進入封裝環節進行減薄處理。
2025-05-09 13:55:51 1976
1976 ,帶來更加多元的智能互動體驗,智能汽車將成為面向未來的智能空間。4月22日,德賽西威發布《德賽西威AI出行趨勢研究報告》(以下簡稱“報告”)。
2025-04-23 17:43:40 1070
1070 本文介紹了半導體集成電路制造中的晶圓制備、晶圓制造和晶圓測試三個關鍵環節。
2025-04-15 17:14:37 2160
2160 
晶圓浸泡式清洗方法是半導體制造過程中的一種重要清洗技術,它旨在通過將晶圓浸泡在特定的化學溶液中,去除晶圓表面的雜質、顆粒和污染物,以確保晶圓的清潔度和后續加工的質量。以下是對晶圓浸泡式清洗方法的詳細
2025-04-14 15:18:54 766
766 在半導體行業的核心—晶圓制造中,材料的選擇至關重要。PEEK具有耐高溫、耐化學腐蝕、耐磨、尺寸穩定性和抗靜電等優異性能,在晶圓制造的各個階段發揮著重要作用。其中晶圓夾用于在制造中抓取和處理晶圓。注塑
2025-03-20 10:23:42 802
802 
3月12日,備受矚目的《2025中國AIAgent行業研究報告》由甲子光年重磅發布!在這份極具前瞻性的行業報告中,中科視語憑借卓越的實力脫穎而出,成功入選為國內重點AIAgent廠商的典型案例。該報告
2025-03-13 16:24:49 1000
1000 
芯片制造的畫布 芯片制造的畫布:晶圓的奧秘與使命 在芯片制造的宏大舞臺上,晶圓(Wafer)扮演著至關重要的角色。它如同一張潔白的畫布,承載著無數工程師的智慧與夢想,見證著從砂礫到智能的奇跡之旅。晶
2025-03-10 17:04:25 1544
1544 嵌入式軟件測試技術深度研究報告 ——基于winAMS的全生命周期質量保障體系構建 一、行業技術瓶頸與解決方案框架 2025年嵌入式軟件測試領域面臨兩大核心矛盾: ? 安全合規與開發效率的沖突
2025-03-03 13:54:14 876
876 日本硅晶圓制造商Sumco宣布,將在2026年底前停止宮崎工廠的硅晶圓生產。 Sumco報告稱,主要用于消費、工業和汽車應用的小直徑晶圓需求仍然疲軟。具體而言,隨著客戶要么轉向200毫米晶圓,要么在
2025-02-20 16:36:31 817
817 佐思汽研發布了《2025年汽車微電機及運動機構行業研究報告》。
2025-02-20 14:14:44 2121
2121 
?→ Pre-treatment?→back metal ? 即貼膠紙→減薄→硅刻蝕→撕膠紙→前處理→背面金屬化 ? ? 1,tape ? ? 在晶圓正面貼上上圖所示的藍色膠帶,保護晶圓正面的圖形
2025-02-12 09:33:18 2057
2057 
Dicing 是指將制造完成的晶圓(Wafer)切割成單個 Die 的工藝步驟,是從晶圓到獨立芯片生產的重要環節之一。每個 Die 都是一個功能單元,Dicing 的精準性直接影響芯片的良率和性能。
2025-02-11 14:28:49 2947
2947 在半導體制造的復雜流程中,晶圓歷經前道工序完成芯片制備后,劃片工藝成為將芯片從晶圓上分離的關鍵環節,為后續封裝奠定基礎。由于不同厚度的晶圓具有各異的物理特性,因此需匹配不同的切割工藝,以確保切割效果與芯片質量。
2025-02-07 09:41:00 3050
3050 
在半導體制造領域,晶圓作為芯片的基礎母材,其質量把控的關鍵環節之一便是對 BOW(彎曲度)的精確測量。而在測量過程中,特氟龍夾具的晶圓夾持方式與傳統的真空吸附方式有著截然不同的特性,這些差異深刻影響
2025-01-21 09:36:24 520
520 
的。 全自動晶圓清洗機工作流程一覽 裝載晶圓: 將待清洗的晶圓放入專用的籃筐或托盤中,然后由機械手自動送入清洗槽。 清洗過程: 晶圓依次經過多個清洗槽,每個槽內有不同的清洗液和處理步驟,如預洗、主洗、漂洗等。 清洗過程中可
2025-01-10 10:09:19 1113
1113 在半導體制造領域,晶圓的加工精度和質量控制至關重要,其中對晶圓 BOW(彎曲度)和 WARP(翹曲度)的精確測量更是關鍵環節。不同的吸附方案被應用于晶圓測量過程中,而晶圓的環吸方案因其獨特
2025-01-09 17:00:10 639
639 
晶圓是集成電路、功率器件及半導體分立器件的核心原材料,超過90%的集成電路均在高純度、高品質的晶圓上制造而成。晶圓的質量及其產業鏈供應能力,直接關乎集成電路的整體性能和競爭力。今天我們將詳細介紹
2025-01-09 09:59:26 2100
2100 
如果你想知道8寸晶圓清洗槽尺寸,那么這個問題還是需要研究一下才能做出答案的。畢竟,我們知道一個慣例就是8寸晶圓清洗槽的尺寸取決于具體的設備型號和制造商的設計。 那么到底哪些因素會影響清洗槽的尺寸呢
2025-01-07 16:08:37 569
569 碳化硅(SiC)作為一種高性能半導體材料,因其出色的熱穩定性、高硬度和高電子遷移率,在電力電子、微電子、光電子等領域得到了廣泛應用。在SiC器件的制造過程中,碳化硅片的減薄是一個重要環節,它可以提高
2025-01-06 14:51:09 392
392 
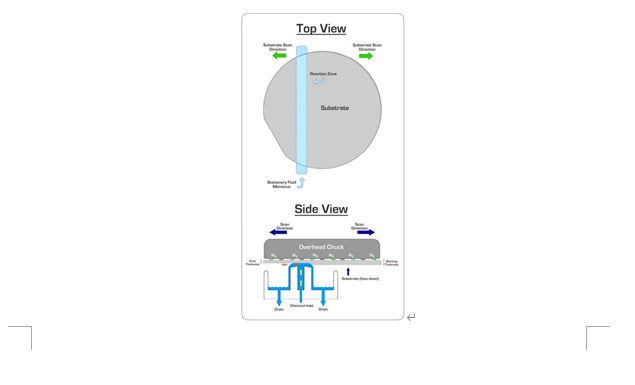
 電子發燒友App
電子發燒友App










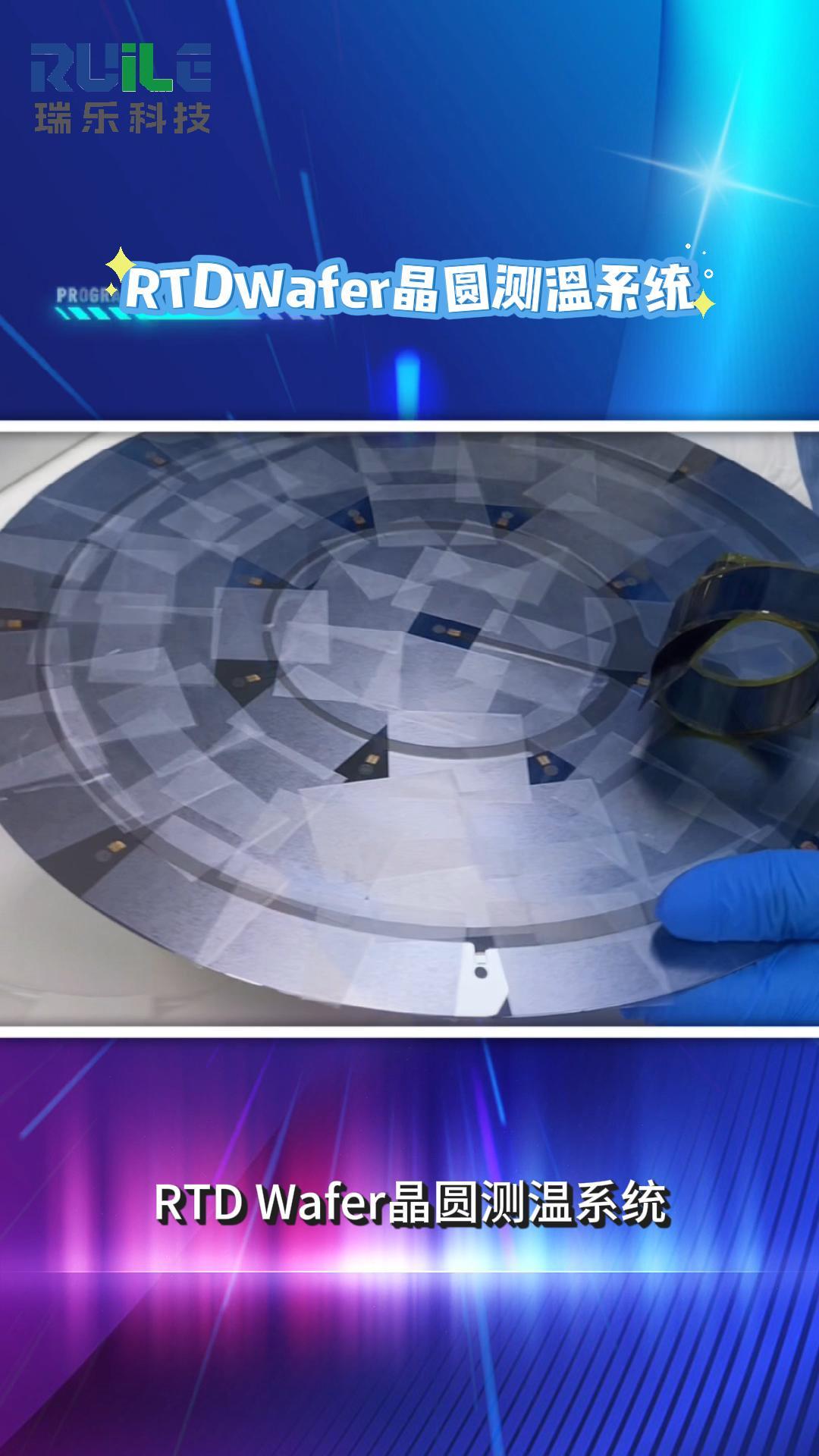




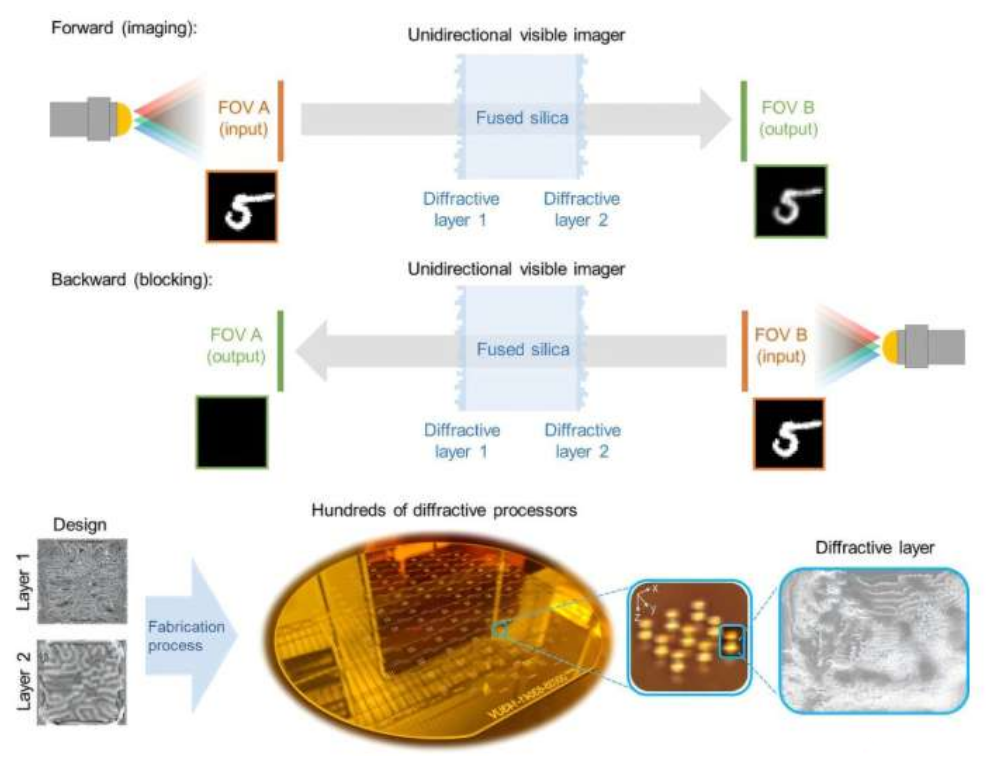
























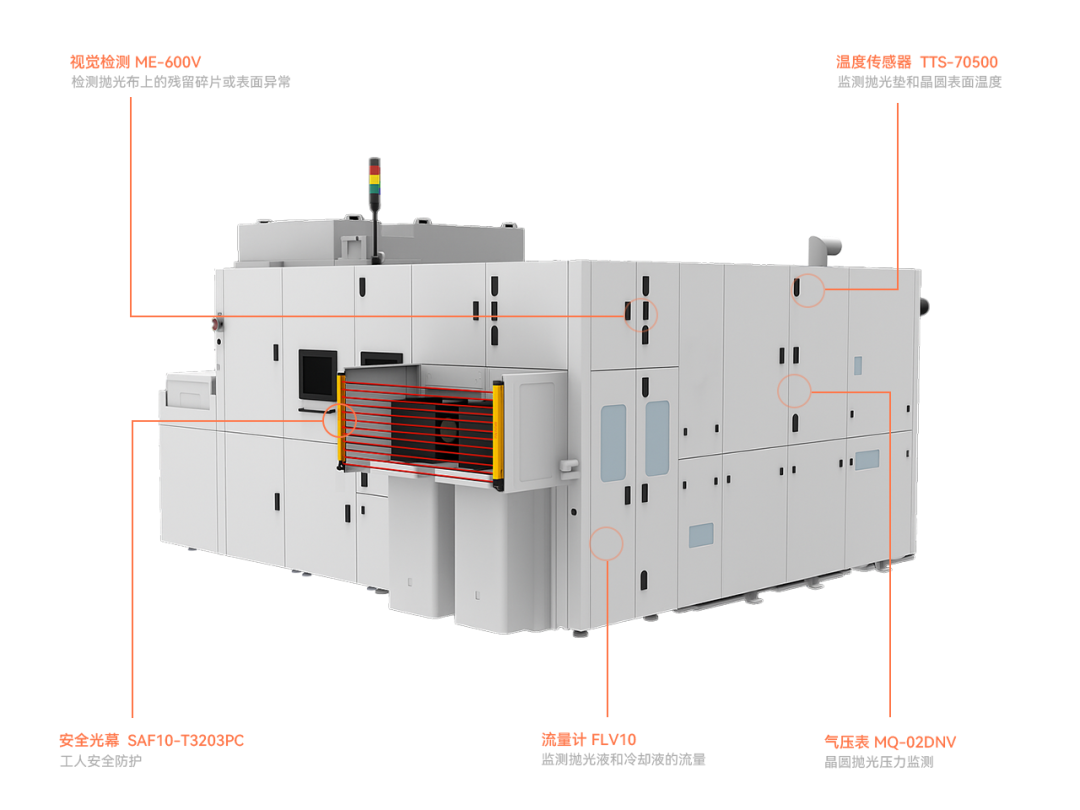
































評論