Ⅲ族氮化物半導體是紫外至可見光發光器件的關鍵材料。傳統c面取向材料因極化電場導致量子限制斯塔克效應,降低發光效率。采用半極性(如m面)生長可有效抑制該效應,尤其(11-22)取向在實現高銦摻入InGaN量子阱方面優勢顯著。然而,半極性薄膜在異質外延中面臨晶體質量差、應力各向異性等挑戰。Flexfilm全光譜橢偏儀可以非接觸對薄膜的厚度與折射率的高精度表征,廣泛應用于薄膜材料、半導體和表面科學等領域。
本章采用MOCVD方法在m面藍寶石襯底上生長了不同厚度的AlN和GaN薄膜,并利用橢圓偏振光譜、XRD、OT、PL 和 Raman 等多種手段,系統研究了薄膜厚度對其晶體質量、光學性質、應力狀態及缺陷行為的影響。
1
實驗方法
flexfilm
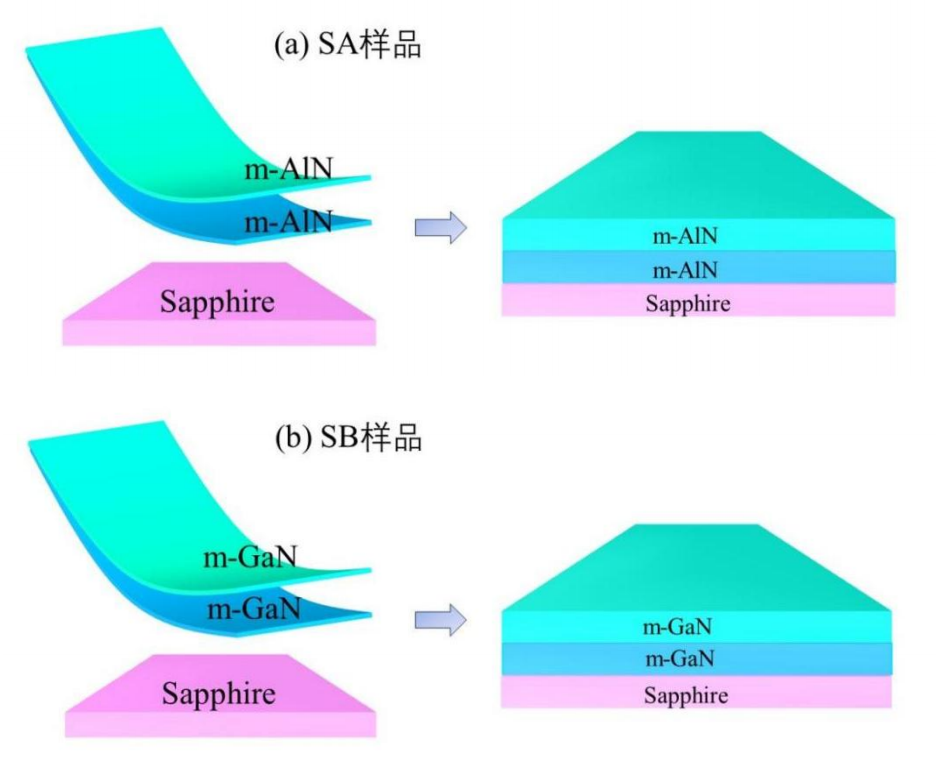
(a)m-AlN和(b)m-GaN樣品結構示意圖
采用金屬有機化學氣相沉積在m面藍寶石襯底上生長樣品:
AlN系列:通過氨脈沖流工藝生長,外延層設計厚度分別為1 μm (SA1)、2 μm (SA2)、3 μm (SA3)。
GaN系列:采用連續流工藝生長,外延層設計厚度分別為900 nm (SB1)、1800 nm (SB2)、2700 nm (SB3)。
利用高分辨率X射線衍射、Flexfilm全光譜橢偏儀、光學透射譜、光致發光譜及拉曼光譜進行系統表征。
2
m-AlN薄膜厚度效應
flexfilm

A:室溫時,3片m-AlN樣品測試(彩色實線)與模型擬合(黑色虛線)的Ψ(λ)和Δ(λ)光譜;B:通過SE測試得到三個m-AlN樣品外延層與光子能量的關系圖;C:m-AlN樣品SE擬合數據分析結果;D:室溫下三個樣品的擬合光學常數(折射率n和消光系數k)
晶體質量:XRD分析表明所有樣品均沿(11-22)方向外延生長。隨厚度增加,(11-22)衍射峰強度增強,半高寬減小(SA1: 1.107°→SA3: 0.569°),顯示晶體質量顯著提升。
光學特性:
橢圓偏振光譜擬合顯示表面粗糙度從SA1的2.86 nm降至SA3的2.72 nm。
光學帶隙約為5.9 eV,Urbach帶尾能量隨厚度增加而降低(SA1: 366 meV→SA3: 300 meV),表明結構無序度減小。
光學透射譜在透明區顯示清晰法布里-珀羅振蕩,佐證薄膜均勻性良好。
應力與缺陷:
拉曼光譜中E?(High)模峰位變化顯示,SA1為拉應力狀態,SA2、SA3轉為壓應力,且壓應力隨厚度增加。
E?(High)模半高寬減小(8.58→5.49 cm?1),表明缺陷密度降低。
光致發光光譜中,深能級缺陷發光峰位從391 nm藍移至385 nm,強度減弱,說明氧相關缺陷隨厚度增加而減少。
3
m-GaN薄膜厚度效應
flexfilm

A:室溫時,3片m-GaN樣品測試(彩色實線)與模型擬合(黑色虛線)的Ψ(λ)和Δ(λ)光譜;B:m-GaN樣品E擬合數據分析結果;C:通過SE測試得到三個m-GaN樣品外延層與光子能量的關系圖;D:室溫下三個樣品的擬合光學常數(折射率n和消光系數k)
結構特性:XRD結果確認(11-22)取向生長成功。衍射峰半高寬隨厚度增加逐漸減小(SB1: 1.207°→SB3: 1.141°),結晶質量改善。
光學性質:
橢圓偏振光譜擬合獲得的光學帶隙分別為3.391 eV (SB1)、3.398 eV (SB2)、3.408 eV (SB3)。
表面粗糙度從1.02 nm降至0.81 nm。
發光性能:
光致發光譜顯示本征發光峰位于3.42 eV附近,Voigt擬合識別出自由激子發射及其聲子伴峰(FX-1LO與FX-2LO)。
隨著厚度增加,FX-1LO與FX-2LO的強度比值從2.50增至3.42,表明晶體質量提升。
應力狀態:拉曼光譜中E?(High)模顯示所有樣品均處于壓應力狀態,但應力值隨厚度增加略有降低,同時該模半高寬減小(4.71→4.46 cm?1),反映缺陷減少。
4
厚度影響晶體質量的機理
flexfilm

薄膜厚度增加后薄膜晶體質量提升的示意圖
生長初期,由于襯底與薄膜間的晶格失配,緩沖層中晶粒排列無序、缺陷密度高。隨著外延層厚度增加,晶粒逐漸融合并沿晶體學方向有序排列,晶界處的位錯與缺陷通過延伸、相互作用或湮滅而減少,從而顯著提升薄膜的整體結晶質量。
本章通過 MOCVD 方法在m面藍寶石上成功生長了不同厚度的半極性AlN和GaN薄膜。系統研究表明,隨著薄膜厚度增加:晶體質量顯著提升:XRD 半高寬減小,表面粗糙度降低;光學性質改善:Urbach 帶尾能量降低,缺陷發光峰藍移且強度減弱;應力狀態演變:AlN 由拉應力轉為壓應力,GaN 壓應力隨厚度略有弛豫;發光性能優化:GaN 本征發光峰強度比隨厚度增加而增大。研究建立了“厚度增加—缺陷減少—質量提升”的物理模型,為半極性氮化物薄膜在光電器件中的應用提供了重要的實驗依據與理論支持。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領域中單層或多層納米薄膜的層構參數(如厚度)和物理參數(如折射率n、消光系數k)
- 先進的旋轉補償器測量技術:無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術,高信噪比的探測技術。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm全光譜橢偏儀能非破壞、非接觸地原位精確測量超薄圖案化薄膜的厚度、折射率,結合費曼儀器全流程薄膜測量技術,助力半導體薄膜材料領域的高質量發展。
原文參考:《Ⅲ族氮化物半導體薄膜的結構和光學性質研究》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
半導體
+關注
關注
339文章
30725瀏覽量
264020 -
薄膜
+關注
關注
0文章
359瀏覽量
46153 -
GaN
+關注
關注
21文章
2366瀏覽量
82210
發布評論請先 登錄



 橢偏儀在半導體的應用|不同厚度m-AlN與GaN薄膜的結構與光學性質
橢偏儀在半導體的應用|不同厚度m-AlN與GaN薄膜的結構與光學性質






評論