橢偏儀是一種基于橢圓偏振分析的光學(xué)測量儀器,通過探測偏振光與樣品相互作用后偏振態(tài)的變化,獲取材料的光學(xué)常數(shù)和結(jié)構(gòu)信息。Flexfilm全光譜橢偏儀可以非接觸對薄膜的厚度與折射率的高精度表征,廣泛應(yīng)用于薄膜材料、半導(dǎo)體和表面科學(xué)等領(lǐng)域,在材料光學(xué)特性分析領(lǐng)域具有重要地位。
1
橢偏儀的基本原理
flexfilm
當(dāng)偏振光波穿過介質(zhì)時(shí),會(huì)與介質(zhì)發(fā)生相互作用,這種作用會(huì)改變光波的偏振態(tài)。橢偏儀通過檢測偏振態(tài)的變化,再經(jīng)過分析擬合,最終得到所需的材料相關(guān)信息。在描述薄膜反射線形成橢圓偏振光的特性時(shí),常用薄膜的橢圓函數(shù) ρ 來表示,表達(dá)公式:

Tanψ:反射光兩個(gè)偏振分量的振幅系數(shù)之比;ψ:偏振角;rp:反射光在 P 平面的偏振分量;rs:反射光在 S 平面的偏振分量
2
關(guān)鍵光學(xué)模型及其應(yīng)用
flexfilm
構(gòu)建與參數(shù)匹配良好的橢偏儀數(shù)據(jù)處理模型至關(guān)重要,若模型錯(cuò)誤,測量結(jié)果會(huì)與真實(shí)值偏差極大,誤導(dǎo)實(shí)驗(yàn)。以下為幾種常用的材料物理模型:
NK 模型
適用于已知組分的同類多層膜。
柯西模型
適用于透明材料,如Al?O?、SiO?、MgF?、SiN4、TiO?、ITO、KCl 等。在透明波段,采用柯西公式表達(dá)材料的光學(xué)常數(shù),能獲得較高的準(zhǔn)確度,其公式為:

Aj經(jīng)驗(yàn)參數(shù),λ為波長
柯西指數(shù)模型
與柯西模型相比,它的顯著特點(diǎn)是吸收系數(shù)隨頻率呈指數(shù)變化。它適用于堿鹵化物、堿土金屬的氟化物、氧化物以及半導(dǎo)體(如可見光和紅外波段的Si、GaAs )等材料。
Sellmeier 模型
非常適用于透明材料(Al?O?、SiO?、MgF?、SiN4、TiO?、ITO、KCl 等)和吸收材料(處于紅外波段的 Ge、Si、GaAs)。在透明波段的光學(xué)常數(shù)具有較高的精準(zhǔn)度,對于電子躍遷情況,當(dāng)光波能量遠(yuǎn)高于帶寬時(shí),需同時(shí)考慮電子和晶格的貢獻(xiàn),其表達(dá)式為:

這就是 Sellmeier 公式,在實(shí)際應(yīng)用中用波長代替能量作為參量,公式為:

ε(E):介電函數(shù),(E):折射率,Sj、Ej、Aj、λj均為相關(guān)參數(shù)
EMA(有效介質(zhì))模型
主要應(yīng)用于由兩種或兩種以上不同組份構(gòu)成的混合介質(zhì)體系,將混合介質(zhì)視為一種在特定光譜范圍內(nèi)具有單一有效介電常量張量的“有效介質(zhì)”,從而建立起均勻薄膜微觀結(jié)構(gòu)與宏觀介電常數(shù)之間的聯(lián)系。該模型包含以下3 種有效介質(zhì)類型:
(1)Lorentz-Lorenz 有效介質(zhì)模型
對于介電函數(shù)分別為εa和εb的兩種介質(zhì)隨機(jī)混合形成的最簡單異構(gòu)介質(zhì),其有效介電函數(shù)可通過以下公式估算:

fa、fb分別為兩種介質(zhì)的份額,且滿足fa+fb=1
(2)Maxwell-Garnett 有效介質(zhì)模型
上述 Lorentz-Lorenz 模型假設(shè)主介質(zhì)為真空(即ε=1),而 Maxwell-Garnett 模型考慮了更一般的情況,即主介質(zhì)的介電函數(shù)為εa,次要介質(zhì)分散于主介質(zhì)中。

當(dāng)εh=εa時(shí),有效介質(zhì)函數(shù)ε的表達(dá)式
(3)Bruggeman有效介質(zhì)模型
當(dāng)不同成分混雜在一起,無法區(qū)分主介質(zhì)時(shí),可采用Bruggeman有效介質(zhì)模型,fj為第j種介質(zhì)所占的體積份額,且Σfj=1。在擬合實(shí)驗(yàn)數(shù)據(jù)時(shí),若出現(xiàn)fj<0或fj>1的情況,表明有效介質(zhì)近似不適用,或者物質(zhì)的組成模型與實(shí)際情況不相符。通常,有效介質(zhì)模型可用于薄膜粗糙表面和過渡層的分析,其公式為:

Graded 模型
Graded 模型與 EMA 模型有相似之處,均適用于兩種材料的混合材料,但不同的是,Graded 模型中混合材料層內(nèi)不同深度的混合比是確定的,這一特性使其在特定混合結(jié)構(gòu)薄膜的分析中具有獨(dú)特優(yōu)勢。
Drude 模型
Drude 模型主要用于金屬自由電子氣、硅化物以及半導(dǎo)體等材料中的載流子吸收情況,其表達(dá)式為:

ωp:等離子共振頻率,γ:碰撞頻率,ε∞:為高頻介電常數(shù),E:光子能量
洛侖茲振子模型
洛侖茲認(rèn)為,物質(zhì)分子是由一定數(shù)量的重原子核和外圍電子構(gòu)成的復(fù)雜帶電系統(tǒng),固體的介電函數(shù)可通過一定數(shù)量的洛侖茲振子的和近似表示,這一近似被稱為簡諧振子近似,簡諧振子模型適用于晶態(tài)半導(dǎo)體材料,當(dāng)材料特征不明確時(shí),選用該模型進(jìn)行分析是較為合適的選擇,其表達(dá)式為:

Aj:振幅,與載流子密度、電荷、質(zhì)量相關(guān);E0j:振子的共振能量;Γj:振子的展寬系數(shù),與振子的阻力有關(guān)
Forouhi-Bloomer 模型
Forouhi 和 Bl oomer 針對非晶態(tài)半導(dǎo)體,通過量子力學(xué)處理并結(jié)合Kramers-Kronig關(guān)系,推導(dǎo)出包含 5 個(gè)參數(shù)的 Forouhi-Bloomer 模型,該模型更適合分析鐵電薄膜與半導(dǎo)體薄膜材料,其相關(guān)公式如下:


n(∞):無窮大能量時(shí)的折射率,Eg、A、B、C均為正的常數(shù),κ(E):吸收系數(shù),n(E):折射率
形模型
為了在較寬的頻譜范圍內(nèi)準(zhǔn)確表達(dá)物質(zhì)的光學(xué)常數(shù),通常需要綜合考慮上述多種模型,由此形成了形模型,其表達(dá)式為:

L(E):某些特定的線形,如高斯線形、洛倫茲形、臨界點(diǎn)線形等,B(E):能量緩變的背景
3
數(shù)據(jù)處理程序
flexfilm
主要包含以下步驟:設(shè)計(jì)參數(shù)→在設(shè)計(jì)窗口輸入材料→最優(yōu)化窗口導(dǎo)入數(shù)據(jù)→材料窗口挑選物理模型→對透射系數(shù)、吸收系數(shù)、反射系數(shù)以及橢偏參數(shù)Δ、Ψ等進(jìn)行計(jì)算→設(shè)定最大和最小厚度
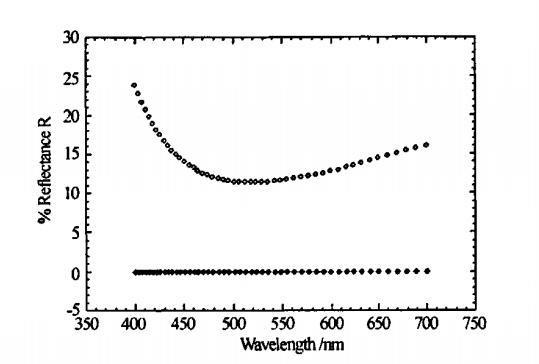
Si襯底上某種薄膜反射率的最優(yōu)化圖像
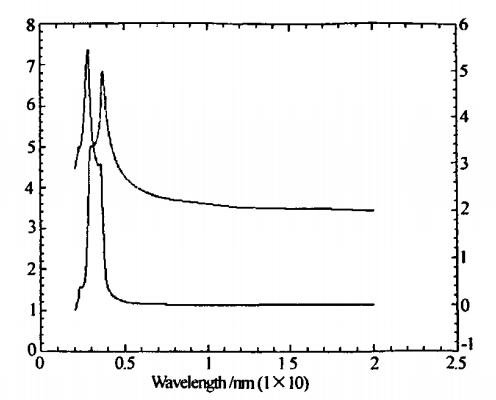
Si襯底的n、k圖
橢偏儀測量薄膜具有廣泛適用性,尺寸要求極低,方式靈活,較快的測量速度,表面造成的損傷最小,從偏振態(tài)變化提取結(jié)構(gòu)信息,介電函數(shù)分析電子與幾何結(jié)構(gòu)等優(yōu)點(diǎn)。橢偏光譜技術(shù)可以應(yīng)用在固體薄膜光學(xué)性質(zhì)測量、物理吸附與化學(xué)吸附、界面與表面分析、電化學(xué)、微電子等領(lǐng)域。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領(lǐng)域中單層或多層納米薄膜的層構(gòu)參數(shù)(如厚度)和物理參數(shù)(如折射率n、消光系數(shù)k)
- 先進(jìn)的旋轉(zhuǎn)補(bǔ)償器測量技術(shù):無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進(jìn)的光能量增強(qiáng)技術(shù),高信噪比的探測技術(shù)。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達(dá)0.05nm。
Flexfilm全光譜橢偏儀能非破壞、非接觸地原位精確測量超薄圖案化薄膜的厚度、折射率,結(jié)合費(fèi)曼儀器全流程薄膜測量技術(shù),助力半導(dǎo)體薄膜材料領(lǐng)域的高質(zhì)量發(fā)展。
原文參考:《橢偏儀的原理和應(yīng)用》
*特別聲明:本公眾號(hào)所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學(xué)術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號(hào)相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請聯(lián)系,我們將在第一時(shí)間核實(shí)并處理。
-
材料
+關(guān)注
關(guān)注
3文章
1559瀏覽量
28682 -
測量
+關(guān)注
關(guān)注
10文章
5673瀏覽量
116869 -
數(shù)據(jù)處理
+關(guān)注
關(guān)注
0文章
650瀏覽量
30049 -
薄膜材料
+關(guān)注
關(guān)注
0文章
38瀏覽量
4558
發(fā)布評論請先 登錄
橢偏儀原理和應(yīng)用 | 精準(zhǔn)測量不同基底光學(xué)薄膜TiO?/SiO?的光學(xué)常數(shù)

薄膜厚度測量技術(shù)的綜述:從光譜反射法(SR)到光譜橢偏儀(SE)

橢偏儀測量薄膜厚度的原理與應(yīng)用

橢偏儀與DIC系統(tǒng)聯(lián)用測量半導(dǎo)體超薄圖案化SAM薄膜厚度與折射率

薄膜測厚選臺(tái)階儀還是橢偏儀?針對不同厚度范圍提供技術(shù)選型指南

橢偏儀在半導(dǎo)體薄膜厚度測量中的應(yīng)用:基于光譜干涉橢偏法研究

橢偏儀在精密薄膜中的應(yīng)用:基于單驅(qū)動(dòng)變角結(jié)構(gòu)的高重復(fù)性精度控制系統(tǒng)

橢偏術(shù)精準(zhǔn)測量超薄膜n,k值及厚度:利用光學(xué)各向異性襯底

橢偏儀在半導(dǎo)體的應(yīng)用|不同厚度c-AlN外延薄膜的結(jié)構(gòu)和光學(xué)性質(zhì)

光譜橢偏儀在二維材料光學(xué)表征中的應(yīng)用綜述




 橢偏儀的原理和應(yīng)用 | 薄膜材料或塊體材料光學(xué)參數(shù)和厚度的測量
橢偏儀的原理和應(yīng)用 | 薄膜材料或塊體材料光學(xué)參數(shù)和厚度的測量





評論