聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
封裝
+關注
關注
128文章
9248瀏覽量
148613
發布評論請先 登錄
相關推薦
熱點推薦
半導體芯片制造技術——“芯片鍵合”工藝技術的詳解;
如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習! 作為半導體制造的后工序,封裝工藝包含背面研磨(Back Grinding)、劃片(Dicing)、芯片鍵合(Die Bonding)、引

熱壓鍵合工藝的技術原理和流程詳解
熱壓鍵合(Thermal Compression Bonding,TCB)是一種先進的半導體封裝工藝技術,通過同時施加熱量和壓力,將芯片與基板或其他材料緊密連接在一起。這種技術能夠在微

氧濃度監控在熱壓鍵合(TCB)工藝過程中的重要性
隨著半導體產品高性能、輕薄化發展,封裝技術作為連接芯片與外界環境的橋梁,其重要性日益凸顯。在眾多封裝技術中,熱壓鍵合(Thermal Compression Bonding)

wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量的設備
通過退火優化和應力平衡技術控制。
3、彎曲度(Bow) 源于材料與工藝的對稱性缺陷,對多層堆疊和封裝尤為敏感,需在晶體生長和鍍膜工藝中嚴格調控。
在先進制程中,三者共同決定了晶
發表于 05-28 16:12
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
隨著半導體工藝復雜度提升,可靠性要求與測試成本及時間之間的矛盾日益凸顯。晶圓級可靠性(Wafer Level Reliability, WLR)技術通過直接在未封裝
發表于 05-07 20:34
面向臨時鍵合/解鍵TBDB的ERS光子解鍵合技術
,半導體制造商傾向于采用厚度小于 100 μm的薄晶圓。然而,晶圓越薄就越容易破損,為此,行業開發了各種臨時鍵
發表于 03-28 20:13
?869次閱讀



 晶圓鍵合工藝技術詳解(69頁PPT)
晶圓鍵合工藝技術詳解(69頁PPT)















































































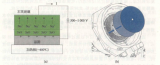









評論