【博主簡介】本人“愛在七夕時”,系一名半導體行業質量管理從業者,旨在業余時間不定期的分享半導體行業中的:產品質量、失效分析、可靠性分析和產品基礎應用等相關知識。常言:真知不問出處,所分享的內容如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習!
鍵合工藝發展經歷了從引線鍵合到混合鍵合的過程。從上世紀70年代起,其發展歷程涵蓋了引線鍵合、倒裝、熱壓貼合、扇出型封裝和混合鍵合,連接方式從最初的引線鍵合到錫球再到銅 - 銅鍵合,單位面積連接密度提高了超過2000倍。
引線鍵合(Wire Bonding)是一種常見的封裝技術。它通過加熱、加壓、超聲波能量等方式將金屬引線與基板焊盤緊密焊合,實現芯片與基板間的電氣互連和芯片間的信息互通。

現有的用于引線鍵合工藝的金屬引線主要有金線、鋁線和銅線,這幾種金屬引線各有優劣。比如金線具有導電性好,耐腐蝕能力強等特點,但是金線的成本高。鋁線的成本低廉,但是其容易腐蝕,且很容易斷裂,所以常用在一些相對低端的封裝中。銅線價格也比較便宜,而且現有的芯片金屬布線大多采用銅布線,因此采用銅線鍵合能更好地與芯片工藝兼容。但銅線的硬度太高,鍵合過程中容易產生裂紋甚至剝落現象。

而隨著半導體技術的飛速發展,集成電路封裝的高密度、高強度、低成本要求日益增長。在這一背景下,銅絲鍵合技術因其成本效益和優異的物理性能,逐漸成為金絲鍵合的有力替代品。銅絲不僅價格低廉,而且具有更高的機械強度、更低的電阻率以及更慢的銅鋁金屬間化合物(IMC)生長速度,這些特性使得銅絲在高密度封裝中展現出獨特的優勢。
然而,銅絲鍵合技術在實際應用中也面臨著一系列挑戰。銅絲易氧化、硬度高,這些特性在鍵合過程中可能導致芯片損傷、氧化層形成等問題,影響鍵合的質量和可靠性。此外,銅絲在封裝后還可能受到塑封材料中鹵化物的腐蝕,進一步增加了失效風險。
所以,根據采用的金屬引線的材質不同,鍵合工藝也有差異。比如金線普遍采用熱超聲鍵合,且采用球形鍵合,即將鍵合引線垂直插入毛細管劈刀的工具中,引線端部受熱熔成球狀,在劈刀的引導下接觸晶片的鍵合區,加壓后,使金球和焊盤金屬焊接在一起,然后劈刀提起,沿著預定的軌道移動,到達第二個鍵合點時,利用壓力和超聲能量形成月牙式焊點,劈刀垂直運動截斷金屬絲的尾部,鍵合過程完成。鋁絲鍵合則較多地采用楔形引線鍵合法,將金屬絲穿入楔形劈刀背面的一個小孔,通過移動劈刀將金屬絲壓在焊區表面,采用超聲或熱聲焊實現前一個焊點的鍵合,隨后劈刀上升并移動到第二個鍵合點時,再次利用壓力和超聲能量形成第二個鍵合焊點,劈刀垂直向下運動截斷金屬絲的尾部,完成鍵合。
引線鍵合主要分為兩種形式:球形鍵合(Ball Bonding)和楔形鍵合(Wedge Bonding)。這兩種技術都涉及三個基本步驟:在芯片上形成第一焊點、形成線弧、以及在引線框架或基板上形成第二焊點。它們的主要區別在于第一焊點的形成方式:球形鍵合在每次焊接開始時會形成一個焊球,然后將其焊接到焊盤上;而楔形鍵合則是直接將引線焊接到芯片焊盤上。

一、楔形鍵合(Wedge Bonding)工藝的介紹
楔形鍵合,英文全稱:Wedge Bonding,此工藝其實是半導體超聲熱壓鍵合的一種基本工藝技術。該技術利用超聲波發生器產生的高頻振動,使鍵合設備的鉚釘在水平方向上產生彈性振動,同時施加向下的壓力。這種振動和壓力共同作用,使鉚釘帶動引線在被焊件金屬表面快速摩擦,從而在焊接區造成塑性變形,并去除金屬表面的氧化層。引線與鍵合區因此得以緊密接觸,完成焊接。超聲波楔鍵合工藝兩端的鍵合點一般呈楔形,這種形狀有助于增強鍵合的牢固度和穩定性。

二、楔形鍵合(Wedge Bonding)工藝的原理
楔形鍵合通過楔形劈刀傳遞熱能、壓力和超聲能量給金屬線,形成焊接。這種焊接過程中不形成焊球。在劈刀壓力和超聲作用下,金屬線與焊盤金屬接觸形成連接。楔形鍵合是單向焊接工藝,第二焊點需與第一焊點對齊。旋轉式楔形劈刀可適應不同角度的焊線。楔形鍵合通常用于室溫下的鋁線超聲波鍵合,成本和溫度較低。由于焊點小,適合微波和大功率器件的封裝。
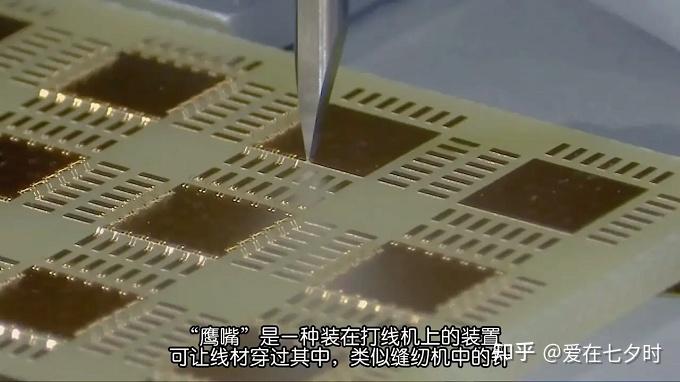
楔形鍵合是用楔形劈刀將熱、壓力、超聲傳給金屬線,在一定時間形成焊接,焊接過程中不出現焊球。在劈刀的壓力和超聲波能量的作用下,金屬線和焊盤金屬的純凈表面接觸并最終形成連接。楔形鍵合是一種單一方向焊接工藝(即第二焊點必須對準第一焊點的方向)。傳統的楔形鍵合僅僅能在線的平行方向上形成焊點,旋轉的楔形劈刀能使楔形鍵合機適合不同角度的焊線,在完成引線操作后移動到第二焊點之前劈刀旋轉到程序規定的角度。常見楔形鍵合工藝是室溫下的鋁線超聲波鍵合,其成本和鍵合溫度較低。由于楔形鍵合形成的焊點小于球形鍵合,特別適用于微波器件,尤其是大功率器件的封裝。
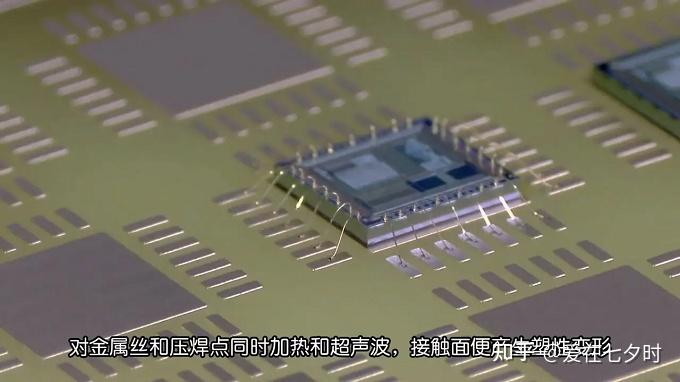
三、楔形鍵合(Wedge Bonding)工藝流程
因為楔形鍵合是通過加壓和加熱的方式,使金屬引線與焊區接觸面的原子之間達到原子引力范圍,從而實現鍵合。這種方法的具體過程如下:
1、準備金屬引線
金屬引線的一端成球形,另一端成楔形。
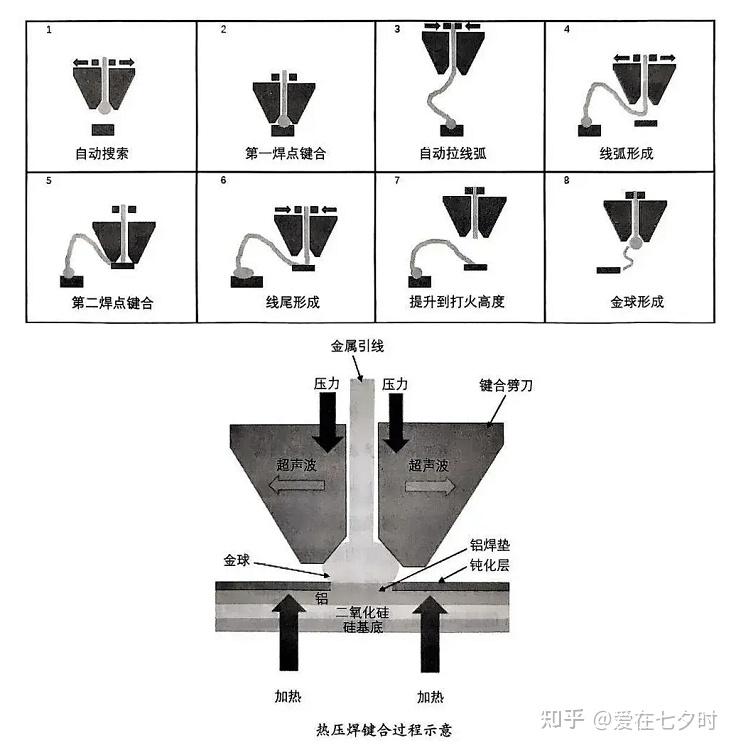
2、鍵合過程
鍵合頭將金球下壓在已預熱到150~250℃的第一焊點,進行球形鍵合。在鍵合時,金球因受壓力而略微變形,以增加鍵合面積、降低鍵合面粗糙度對鍵合的影響,并穿破金屬表面氧化層等阻礙鍵合的因素,形成緊密的鍵合。

3、焊點形狀
熱壓焊鍵合完成后,會形成兩個焊點,第一焊點呈球形,第二焊點即金屬引線鍵合結束時的焊點,呈楔形。
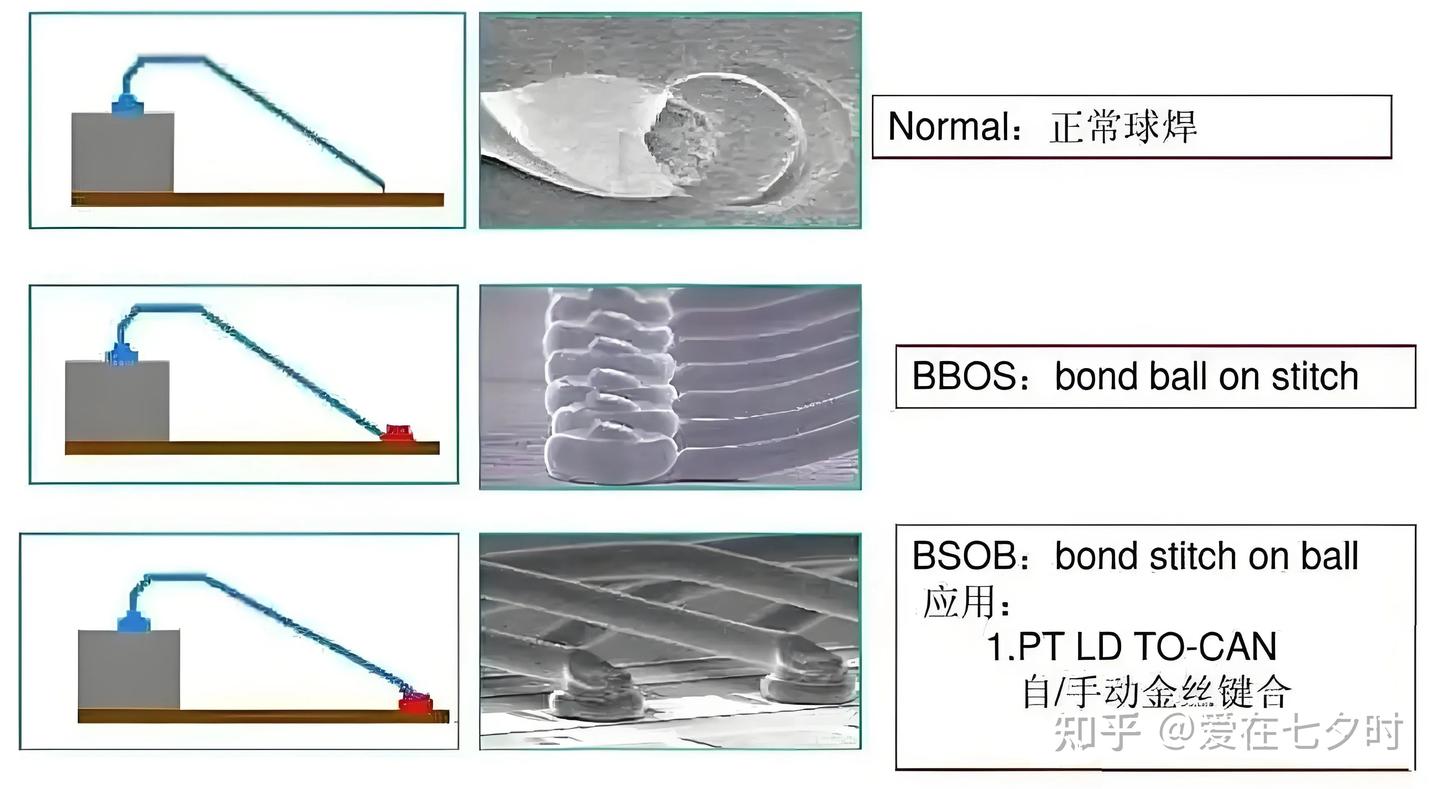
四、楔形鍵合(Wedge Bonding)工藝技術的重點介紹




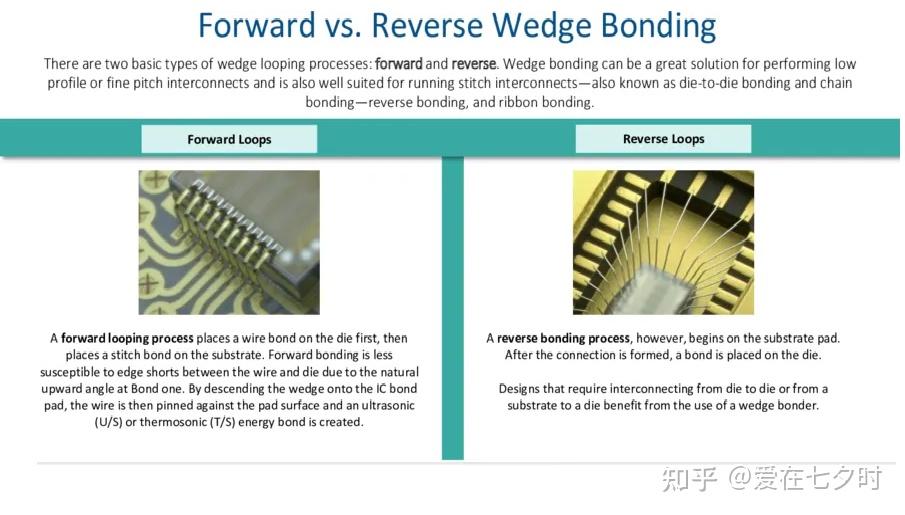
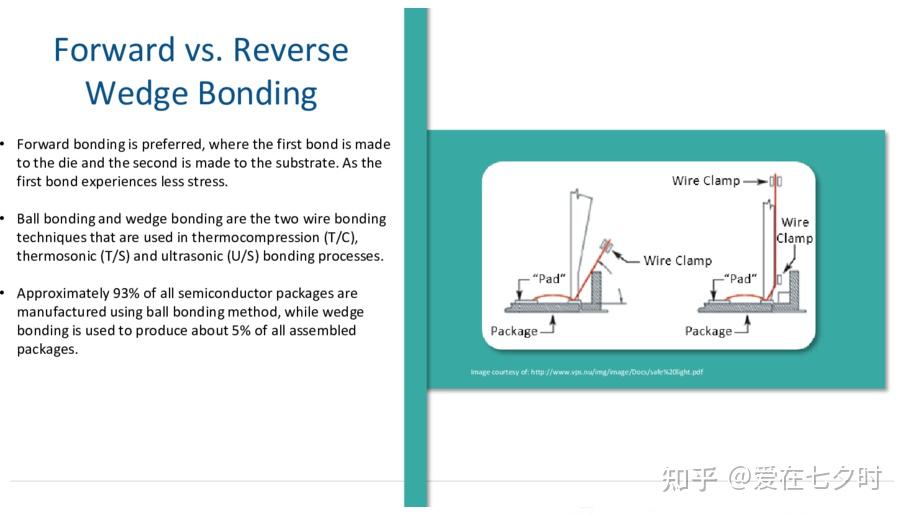
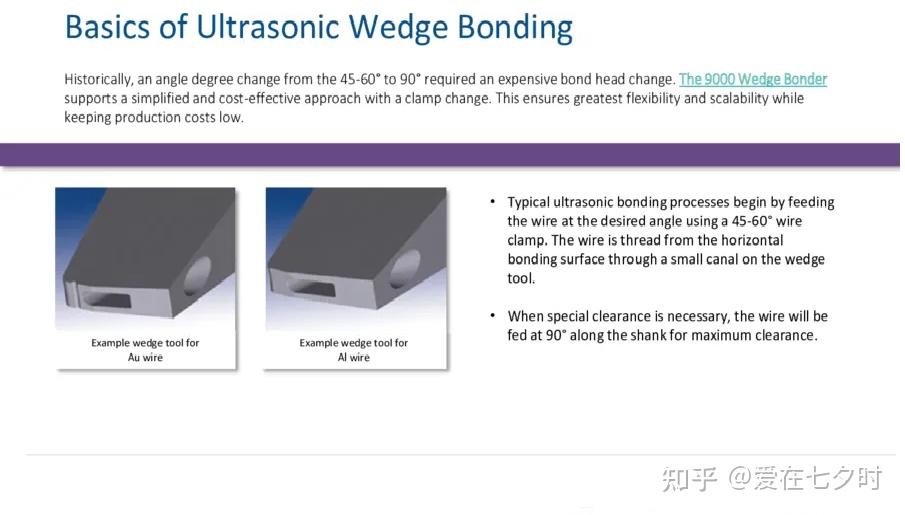

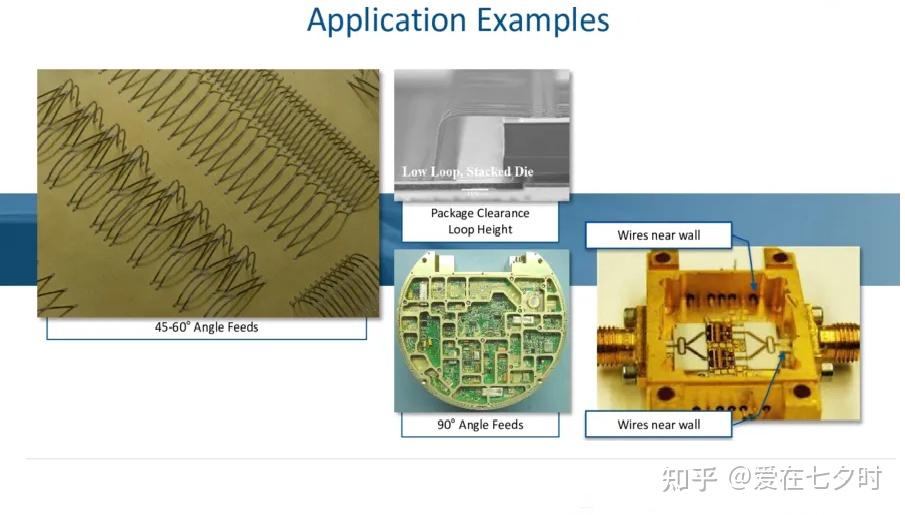
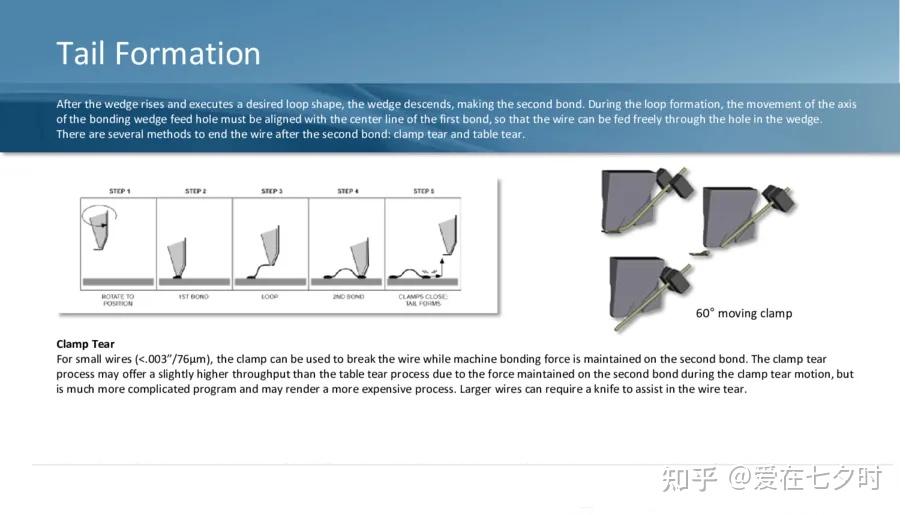
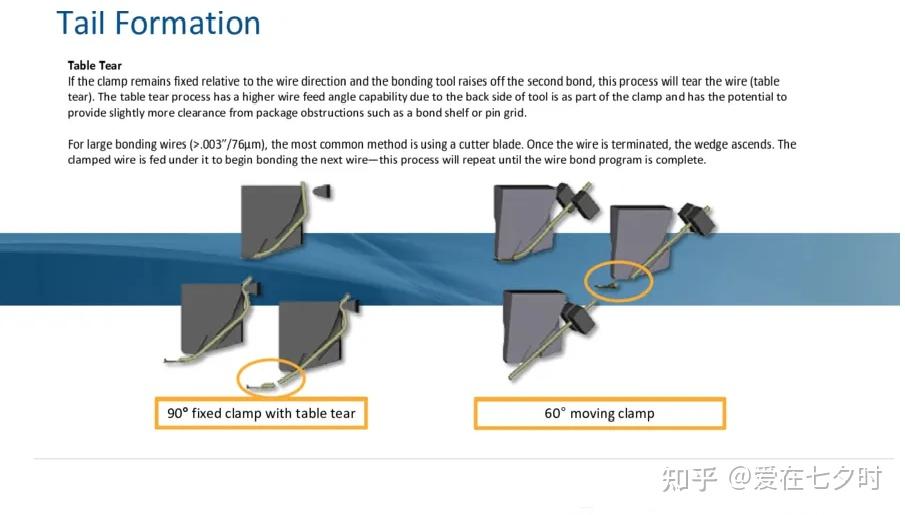
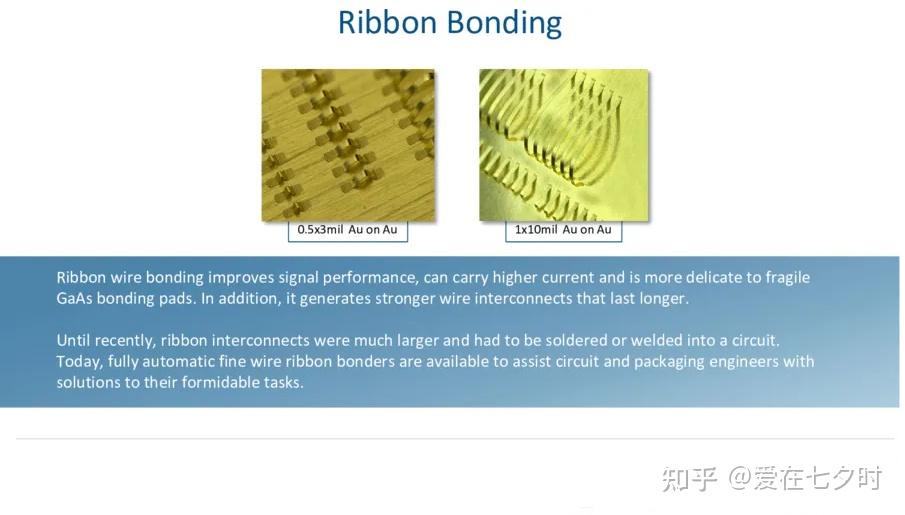



http://weixin.qq.com/r/QhAjO9TE64mUrZBY90VQ (二維碼自動識別)
因為本PPT章節太多,剩下部分如有朋友有需要,可加入我“知識星球”免費下載PDF版本。注意:此資料只可供自己學習,不可傳閱,平臺有下載記錄,切記!文末有加入“星球”方式,歡迎加入后一起交流學習。
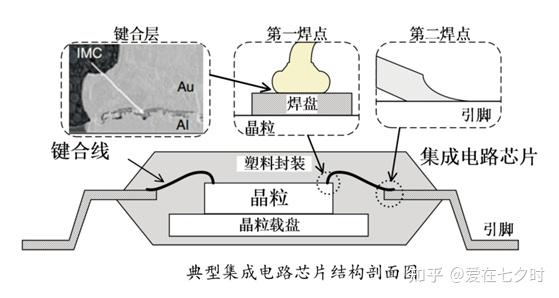
五、鍵合工藝技術的挑戰和發展
隨著芯片設計日益復雜,鍵合工藝也面臨著不少挑戰。例如,隨著芯片上的元件數量的增加,需要更精細、更緊湊的鍵合技術來滿足設計要求。
另外,隨著物聯網和人工智能的興起,對高性能和低功耗的需求也在增加。這要求鍵合技術不僅要有高的信號傳輸速度,而且要有低的功耗。
為了滿足這些挑戰,各種鍵合技術都在持續進行研究和發展,如引入新材料、改進設備和工藝等,以提高性能和降低成本。
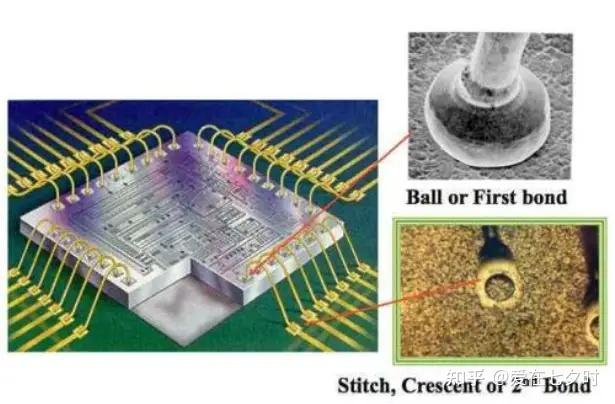
總結一下
在半導體封裝領域,鍵合技術經歷了從引線鍵合、TAB到倒裝芯片再到混合鍵合的演進過程。下表對四種鍵合方式的特點、優缺點及應用情況做了詳細對比:

總的來說:芯片鍵合工藝是半導體制造中不可或缺的一環。它確保了各種設備的高效、可靠和持久運行。雖然Wedge、Ball和Bump鍵合各有優勢,但選擇哪種方法取決于具體的應用、設計和環境要求。隨著科技的不斷進步,我們可以預期,這些鍵合技術將更加先進,更加精細,以滿足未來更高的技術和性能要求。

免責聲明
【我們尊重原創,也注重分享。文中的文字、圖片版權歸原作者所有,轉載目的在于分享更多信息,不代表本號立場,如有侵犯您的權益請及時私信聯系,我們將第一時間跟蹤核實并作處理,謝謝!】
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54224瀏覽量
468146 -
半導體
+關注
關注
339文章
31063瀏覽量
265715
發布評論請先 登錄
半導體金線鍵合(Gold Wire Bonding)封裝工藝技術簡介;

半導體芯片制造技術——“芯片鍵合”工藝技術的詳解;

半導體封裝Wire Bonding (引線鍵合)工藝技術的詳解;

半導體封裝“焊線鍵合(Wire Bonding)”線弧相關培訓的詳解;

半導體“光刻(Photo)”工藝技術的詳解;

半導體后道制程“芯片鍵合(Die Bonding)”工藝技術的詳解;




 半導體“楔形鍵合(Wedge Bonding)”工藝技術的詳解;
半導體“楔形鍵合(Wedge Bonding)”工藝技術的詳解;











評論