【博主簡介】本人“愛在七夕時”,系一名半導(dǎo)體行業(yè)質(zhì)量管理從業(yè)者,旨在業(yè)余時間不定期的分享半導(dǎo)體行業(yè)中的:產(chǎn)品質(zhì)量、失效分析、可靠性分析和產(chǎn)品基礎(chǔ)應(yīng)用等相關(guān)知識。常言:真知不問出處,所分享的內(nèi)容如有雷同或是不當(dāng)之處,還請大家海涵。當(dāng)前在各網(wǎng)絡(luò)平臺上均以此昵稱為ID跟大家一起交流學(xué)習(xí)!

引線鍵合技術(shù)是半導(dǎo)體封裝工藝中的一個重要環(huán)節(jié),主要利用金、鋁、銅、錫等金屬導(dǎo)線建立引線與半導(dǎo)體內(nèi)部芯片之間的聯(lián)系。這種技術(shù)能夠?qū)⒔饘俨己竻^(qū)或微電子封裝I/O引線等與半導(dǎo)體芯片焊區(qū)連接,是確保半導(dǎo)體功能得以正常發(fā)揮的關(guān)鍵步驟。
在引線鍵合過程中,金屬線被焊接到芯片引線或基板上的金屬引腳上。這種技術(shù)特別適用于微小封裝和高密度布局,能夠提供良好的電性能和較低的電阻。焊線的目的是將晶粒上的接點(diǎn)以極細(xì)的金線(18~50μm)連接到引線架上的內(nèi)引腳,從而將集成電路晶粒的電路信號傳輸?shù)酵饨纭?/p>

引線鍵合工藝中所用的導(dǎo)電絲主要有金絲、銅絲和鋁絲。不同的金屬絲在鍵合過程中有各自的特點(diǎn)和適用場景。例如,金絲因其良好的導(dǎo)電性能和穩(wěn)定性而被廣泛使用,但成本較高;銅絲則具有較低的生產(chǎn)成本和良好的導(dǎo)電性能,因此在半導(dǎo)體封裝以及集成電路、LED等眾多領(lǐng)域得到推廣應(yīng)用;鋁絲則常用于超聲鍵合工藝中。

引線鍵合的主要方式包括熱壓鍵合、超聲鍵合和熱聲鍵合。熱壓鍵合利用加壓和加熱的方法,使得金屬絲與焊區(qū)接觸面的原子間達(dá)到原子間的引力范圍,從而實(shí)現(xiàn)鍵合;超聲鍵合則是利用超聲波發(fā)生器使劈刀發(fā)生水平彈性振動,同時施加向下的壓力,使得劈刀帶動引線在焊區(qū)金屬表面迅速摩擦,完成焊接;熱聲鍵合則是結(jié)合了熱壓和超聲兩種方法的特點(diǎn)。
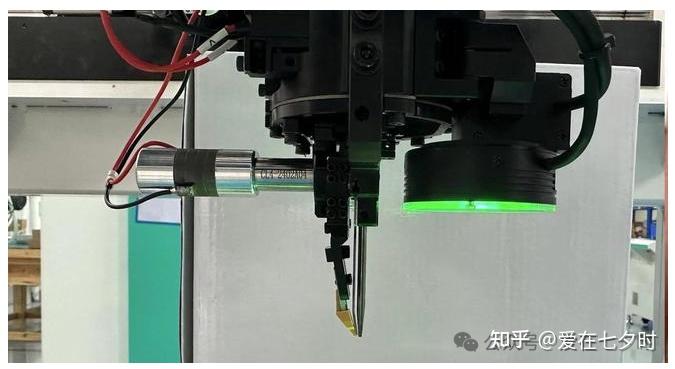
此外,引線鍵合技術(shù)還直接影響到封裝的總厚度,因此在封裝設(shè)計(jì)時需要綜合考慮。總的來說,引線鍵合技術(shù)是半導(dǎo)體封裝中不可或缺的一環(huán),其施工質(zhì)量對于半導(dǎo)體功能應(yīng)用的發(fā)揮具有較大影響。以下就是今天要跟大家分享的關(guān)于引線鍵合工藝技術(shù)的相關(guān)內(nèi)容,講得不對或是有遺漏之處,還希望大家多多批評指正;

一、Wire Bonding(引線鍵合)的原理
引線鍵合通過金屬線(通常為金線、銅線或鋁線)將芯片的焊盤(Bond Pad)與封裝基板或引線框架連接,實(shí)現(xiàn)電氣和機(jī)械連接。
1、IC封裝中電路連接的三種方式
(1)、倒裝焊(Flip chip bonding)
原理:將芯片正面朝下,通過焊球(Bump)直接與基板連接。
特點(diǎn):(a)連接路徑短,電氣性能優(yōu)越;(b)支持高密度封裝,適用于高頻應(yīng)用;(c)工藝復(fù)雜,成本較高。
(2)、載帶自動焊(TAB---tape automated bonding)
原理:使用柔性載帶(Tape)上的金屬引線將芯片與基板連接。
特點(diǎn):(a)適合多引腳、高密度封裝;(b)生產(chǎn)效率高,適合大規(guī)模生產(chǎn);(c)設(shè)備和材料成本較高。
應(yīng)用:液晶顯示器驅(qū)動 IC、傳感器等。
(3)、引線鍵合(wire bonding)
原理:通過金屬線(如金線、銅線或鋁線)將芯片的焊盤與封裝基板或引線框架連接。
特點(diǎn):(a)技術(shù)成熟,成本較低;(b)適用于多種封裝類型(如 QFP、BGA);(c)對焊盤和引線框架的精度要求較高。
應(yīng)用:廣泛用于消費(fèi)電子、汽車電子等領(lǐng)域。
二、Wire Bonding(引線鍵合)的作用
電路連線,使芯片與封裝基板或?qū)Ь€框架完成電路的連線,以發(fā)揮電子訊號傳輸?shù)墓δ埽韵率且€鍵合的主要作用:
1、電氣連接
信號傳輸:將芯片的焊盤(Bond Pad)與封裝基板或引線框架連接,實(shí)現(xiàn)信號和電力的傳輸。
低電阻路徑:通過金屬線(如金線、銅線或鋁線)提供低電阻的電氣連接,確保電路性能。
2、機(jī)械連接
固定芯片:將芯片牢固地固定在封裝基板或引線框架上,防止移動或損壞。
應(yīng)力緩沖:金屬線的柔韌性可以緩解熱膨脹或機(jī)械振動帶來的應(yīng)力,保護(hù)芯片。
3、熱管理
散熱路徑:金屬線可以作為輔助散熱路徑,幫助芯片將熱量傳導(dǎo)到封裝外部。
熱應(yīng)力分散:通過合理設(shè)計(jì)鍵合線布局,分散熱應(yīng)力,提高封裝可靠性。
4、工藝靈活性
適應(yīng)多種封裝類型:引線鍵合適用于多種封裝形式,如 QFP、BGA 等。
兼容不同材料:支持金線、銅線、鋁線等多種材料,滿足不同應(yīng)用需求。
5、成本效益
技術(shù)成熟:引線鍵合工藝成熟,設(shè)備成本相對較低。
生產(chǎn)效率高:適合大規(guī)模生產(chǎn),降低封裝成本。
6、應(yīng)用領(lǐng)域
汽車電子:如發(fā)動機(jī)控制單元、傳感器等。
總之,引線鍵合在半導(dǎo)體封裝中扮演著至關(guān)重要的角色,不僅實(shí)現(xiàn)了電氣和機(jī)械連接,還提供了熱管理和成本效益的優(yōu)勢。隨著技術(shù)進(jìn)步,引線鍵合工藝在高密度封裝和高頻應(yīng)用中不斷優(yōu)化,繼續(xù)發(fā)揮著重要作用。
三、Wire Bonding(引線鍵合)的分類
引線鍵合(Wire Bonding)是半導(dǎo)體封裝中的關(guān)鍵技術(shù),它的分類方式多樣,根據(jù)鍵合方式、材料、形狀、應(yīng)用場景和自動化程度的不同,可以選擇合適的工藝和技術(shù)。每種分類方式都有其特定的應(yīng)用領(lǐng)域和優(yōu)勢,需根據(jù)實(shí)際需求進(jìn)行選擇。
1、按鍵合形狀的分類
球鍵合(Ball Bonding):第一鍵合點(diǎn)形成球狀,第二鍵合點(diǎn)為楔形。適用于金線和銅線。
楔鍵合(Wedge Bonding):第一鍵合點(diǎn)和第二鍵合點(diǎn)均為楔形。適用于鋁線和金線。
2、按鍵合方式的分類
熱壓鍵合(Thermocompression Bonding):通過加熱和壓力將金屬線與焊盤連接。適用于金線和銅線。
超聲波鍵合(Ultrasonic Bonding):利用超聲波振動和壓力實(shí)現(xiàn)連接。適用于鋁線和金線。
熱聲鍵合(Thermosonic Bonding):結(jié)合熱壓和超聲波技術(shù),適用于金線。
| 1.熱壓焊 | 300-500℃ | 無超聲 | 高壓力 | 引線:Au |
| 2.超聲焊 | 室溫22~28 | 有超聲 | 低壓力 | 引線:Al、 Au |
| 3.熱超聲焊 | 100~150℃ | 有超聲 | 低壓力 | 引線:Au |

3、按金屬材料的分類
金線鍵合:導(dǎo)電性好,耐腐蝕,成本高。適用于高可靠性應(yīng)用。
銅線鍵合:成本低,導(dǎo)電性好,但易氧化。適用于低成本和高功率應(yīng)用。
鋁線鍵合:成本低,適用于大電流應(yīng)用。常用于功率器件和汽車電子。
4、按應(yīng)用場景的分類
傳統(tǒng)引線鍵合:用于標(biāo)準(zhǔn)封裝(如 QFP、BGA)。
細(xì)間距引線鍵合:用于高密度封裝,支持更小的焊盤間距。
功率器件引線鍵合:用于大電流和高功率應(yīng)用,通常使用鋁線或銅線。
5、按自動化程度的分類
手動引線鍵合:適用于小批量生產(chǎn)或特殊應(yīng)用。
自動引線鍵合:適用于大規(guī)模生產(chǎn),效率高,一致性好。
四、Wire Bonding(引線鍵合)的四要素
引線鍵合的四要素(材料選擇、工藝參數(shù)、設(shè)備與工具、工藝控制與優(yōu)化)共同決定了鍵合的質(zhì)量和可靠性。通過合理選擇和優(yōu)化這些要素,可以實(shí)現(xiàn)高效、穩(wěn)定的引線鍵合工藝。
1、材料選擇
金屬線:常用的金屬線包括金線、銅線和鋁線,選擇依據(jù)包括導(dǎo)電性、成本和應(yīng)用場景。
金線:導(dǎo)電性好,耐腐蝕,成本高。
銅線:成本低,導(dǎo)電性好,但易氧化。
鋁線:成本低,適用于大電流應(yīng)用。
焊盤材料:通常為鋁或銅,需與金屬線兼容。
2、工藝參數(shù)
溫度:熱壓鍵合和熱聲鍵合需要精確控制溫度。
壓力:適當(dāng)?shù)膲毫Υ_保金屬線與焊盤的良好接觸。
超聲波能量:超聲波鍵合需優(yōu)化能量和頻率,以實(shí)現(xiàn)可靠的連接。
時間:鍵合時間影響連接質(zhì)量和效率。
3、設(shè)備與工具
鍵合機(jī):自動或半自動鍵合機(jī),提供精確的控制和高效的生產(chǎn)。
鍵合頭:包括毛細(xì)管(用于球鍵合)和楔形工具(用于楔鍵合)。
檢測設(shè)備:如顯微鏡和拉力測試儀,用于質(zhì)量檢測。
4、工藝控制與優(yōu)化
表面處理:清潔焊盤和引線框架,確保良好的鍵合表面。
線弧控制:優(yōu)化金屬線的弧度和長度,避免短路或應(yīng)力集中。
質(zhì)量控制:通過拉力測試、剪切測試和視覺檢查確保鍵合質(zhì)量。
工藝優(yōu)化:根據(jù)產(chǎn)品需求調(diào)整參數(shù),提高良率和可靠性。
五、Bonding(鍵合)用 Wire(引線)
Au WIRE 的主要特性
1、具有良好的導(dǎo)電性,僅次于銀、銅。電阻率(μΩ?cm)的比較
Ag(1.6)<Cu(1.7)<Au(2.3)<Al(2.7);
2、具有較好的抗氧化性 。
3、具有較好的延展性,便于線材的制作。常用Au,Wire直徑為23μm,25 μm,30 μm;
4、具有對熱壓縮 Bonding最適合的硬度;
5、具有耐樹脂 Mold的應(yīng)力的機(jī)械強(qiáng)度;
6、成球性好(經(jīng)電火花放電能形成大小一致的金球) ;
7、高純度(4N:99.99%);


六、Bonding(鍵合)用 Capillary(引線咀)
Capillary的選用Hole徑(H),Hole徑是由規(guī)定的Wire徑WD(Wire Diameter)來決定H=1.2~1.5WD;

1、Capillary主要的尺寸
H: Hole Diameter (Hole徑)
T:Tip Diameter
B:Chamfer Diameter(orCD)
IC:Inside Chamfer
IC ANGLE:Inside Chamfer Angle
FA:Face Angle (Face角)
OR:Outside Radius


a 15(15XX):直徑1/16 inch (約1.6mm),標(biāo)準(zhǔn)氧化鋁陶瓷
b XX51:capillary產(chǎn)品系列號
c 18:Hole Size 直徑為0.0018 in.(約46μm )
d 437:capillary 總長0.437 in.(約11.1mm)
e GM:capillary tip無拋光; (P:capillary tip有拋光)
f 50:capillary tip 直徑T值為0.0050 in. (約127μm)
g 4: IC為0.0004 in. (約10μm)
h 8D:端面角度face angle為 8°
i 10:外端半徑OR為0.0010 in.(約25μm)
j 20D:錐度角為20°
k CZ1:材質(zhì)分類,分CZ1,CZ3,CZ8三種系列

2、Capillary尺寸對焊線質(zhì)量的影響
(1)、Chamfer徑(CD)
Chamfer徑過于大的話、Bonding強(qiáng)度越弱,易造成虛焊;

(2)、Chamfer角(ICA )
Chamfer角:小→Ball Size:小
Chamfer角:大→Ball Size:大

將Chamfer角由90°變更為120°可使Ball形狀變大,隨之Ball的寬度變寬、與Pad接合面積也能變寬。

(3)、OR(Outer Radius)及FA(Face Angle)
對Hill Crack、Capillary的OR(Outer Radius)及FA(Face Angle)的數(shù)值是重要影響因素。


FA(Face Angle)0°→8°變更
FA 0°→8°的變更并未能增加Wire Pull的測試強(qiáng)度,但如下圖所示,能夠增加2nd Neck部的穩(wěn)定性。

(4)、焊接時間順序圖
| 次序 | 動作 |
| 1 | 焊頭下降至第一焊點(diǎn)之搜索高度 |
| 2 | 第一焊點(diǎn)之搜索 |
| 3 | 第一焊點(diǎn)的接觸階段 |
| 4 | 第一焊點(diǎn)的焊接階段 |
| 5 | 返回高度 |
| 6 | 返回距離 |
| 7 | 估計(jì)線長高度 |
| 8 | 搜索延遲 |
| 9 | 焊頭下降至第二焊點(diǎn)之搜索高度 |
| 10 | 第二焊點(diǎn)之搜索 |
| 11 | 第二焊點(diǎn)的接觸階段 |
| 12 | 第二焊點(diǎn)的焊接階段 |
| 13 | 線尾長度 |
| 14 | 焊頭回到原始位置 |

3、焊頭動作步驟
(1)、焊頭在打火高度( 復(fù)位位置 )

(2)、焊頭由打火高度下降到第一焊點(diǎn)搜索高度

(3)、第一焊點(diǎn)接觸階段

(4)、第一焊點(diǎn)焊接階段

(5)、完成第一點(diǎn)壓焊后, 焊頭上升到反向高度

(6)、反向距離

(7)、焊頭上升到線弧高度位置

(8)、搜索延遲

(9)、XYZ 移向第二壓點(diǎn)搜索高度

(10)、第二焊點(diǎn)接觸階段

(11)、第二壓點(diǎn)焊接階段

(12)、焊頭在尾絲高度

(13)、拉斷尾絲

(14)、金球形成,開始下一個壓焊過程

4、BSOB&BBOS

BSOB : BOND STICH ON BALL

BBOS : BOND BALL ON STICH
(1)、BSOB的應(yīng)用

(2)、BSOB 時BOND HEAD的動作步驟

(3)、BSOB的兩個重要參數(shù)
Ball Offset:設(shè)定范圍: -80?20, 一般設(shè)定: -60
此項(xiàng)設(shè)定植球時,當(dāng)loop base 拉起后,capillary 要向何方向拉弧

設(shè)定值為正值 : 代表capillary 向lead 的方向拉弧
設(shè)定值為負(fù)值 : 代表capillary 向die 的方向拉弧

2 nd Bond Pt Offset
此項(xiàng)是設(shè)定2銲點(diǎn)魚尾在BALL上的偏移距離,
其單位是 x y Motor Step = 0.2 um ,一般設(shè)定:60
此參數(shù)主要目的以確保2銲點(diǎn)魚尾與植球有最大的黏著面積


Wire Offset 0

Wire Offset 45

Wire Offset 55

Wire Offset 65

BSOB BALL



最佳BSOB效果

FAB過大,BASE參數(shù)過小

BASE參數(shù)過大

正常

BALL過大,STICH BASE參數(shù)過小

BALL過小,STICH BASE參數(shù)過大

正常




BSOB 2nd stich不良
七、Wire bonding(引線鍵合)loop

1、Q-Loop

2、Square Loop

3、Penta loop

4、‘M’ – loop
Q-LOOP輪廓及參數(shù)說明:










Reverse Distance Angle 功能在定義Reverse Distance 方位
注意:假如反向拉弧的角度超過20度,可能會產(chǎn)生neck crack

好

不好

好

不好
八、Wire bond(引線鍵合)的不良分析
在半導(dǎo)體引線鍵合(Wire Bonding)工藝中,不良現(xiàn)象可能導(dǎo)致產(chǎn)品性能下降或失效。它的不良現(xiàn)象可能由多種因素引起,包括材料、工藝參數(shù)、設(shè)備狀態(tài)等。通過分析不良現(xiàn)象的根本原因,并采取相應(yīng)的優(yōu)化措施,可以提高鍵合質(zhì)量和產(chǎn)品可靠性。建議結(jié)合具體生產(chǎn)情況進(jìn)行深入分析和驗(yàn)證。

總結(jié)一下
引線鍵合工藝作為集成電路封裝技術(shù)的重要環(huán)節(jié),在電子產(chǎn)品的性能和可靠性方面發(fā)揮著關(guān)鍵作用。未來,引線鍵合工藝將繼續(xù)在多元化、高性能、低成本和環(huán)保可持續(xù)性等方面取得突破,以滿足不斷變化的市場需求和技術(shù)挑戰(zhàn)。今天,我們主要講了引線鍵合法與材質(zhì)之間的相互作用,以及引線鍵合的具體方法。在本文中,對可靠性和引線鍵合中可能出現(xiàn)的問題只是進(jìn)行了簡短的介紹,但要銘記,在引線鍵合過程中,發(fā)現(xiàn)問題,并找出克服問題的解決方案,理解相互之間的權(quán)衡關(guān)系是非常重要的。我還建議讀者可以了解一下,封裝種類及技術(shù)的進(jìn)步,給鍵合方法帶來了什么樣的變化。

免責(zé)聲明
【我們尊重原創(chuàng),也注重分享。文中的文字、圖片版權(quán)歸原作者所有,轉(zhuǎn)載目的在于分享更多信息,不代表本號立場,如有侵犯您的權(quán)益請及時私信聯(lián)系,我們將第一時間跟蹤核實(shí)并作處理,謝謝!】
審核編輯 黃宇
-
半導(dǎo)體封裝
+關(guān)注
關(guān)注
4文章
321瀏覽量
15262
發(fā)布評論請先 登錄
介紹芯片鍵合(die bonding)工藝
有償求助本科畢業(yè)設(shè)計(jì)指導(dǎo)|引線鍵合|封裝工藝
半導(dǎo)體引線鍵合清洗工藝方案
先進(jìn)封裝技術(shù)的發(fā)展趨勢
集成電路封裝中的引線鍵合技術(shù)

IGBT模塊銀燒結(jié)工藝引線鍵合工藝研究
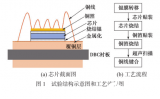
引線鍵合之DOE試驗(yàn)
帶你一文了解什么是引線鍵合(WireBonding)技術(shù)?

引線鍵合的基礎(chǔ)知識

半導(dǎo)體“楔形鍵合(Wedge Bonding)”工藝技術(shù)的詳解;

半導(dǎo)體封裝“焊線鍵合(Wire Bonding)”線弧相關(guān)培訓(xùn)的詳解;

半導(dǎo)體芯片制造技術(shù)——“芯片鍵合”工藝技術(shù)的詳解;




 半導(dǎo)體封裝Wire Bonding (引線鍵合)工藝技術(shù)的詳解;
半導(dǎo)體封裝Wire Bonding (引線鍵合)工藝技術(shù)的詳解;


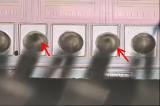




評論